Een vergelijkend onderzoek naar de ferro-elektrische prestaties in atomaire laag afgezet Hf0.5Zr0.5O2 dunne films met behulp van tetrakis(ethylmethylamino) en tetrakis(dimethylamino) voorlopers
Abstract
De chemische, fysische en elektrische eigenschappen van de afgezette atoomlaag Hf0,5 Zr0,5 O2 dunne films met behulp van tetrakis(ethylmethylamino) (TEMA) en tetrakis(dimethylamino) (TDMA) voorlopers worden vergeleken. Het ligand van de metaal-organische voorlopers heeft een sterke invloed op de resterende C-concentratie, korrelgrootte en de resulterende ferro-elektrische eigenschappen. Hf0,5 . storten Zr0,5 O2 films met de TDMA-precursoren resulteren in een lagere C-concentratie en een iets grotere korrelgrootte. Deze bevindingen zijn gunstig om meer ferro-elektrische fase-dominante film te laten groeien, wat het wake-up-effect ervan verzacht. Uit de wektest van de TDMA-Hf0.5 Zr0,5 O2 film met een cyclisch veld van 2,8 MV/cm, werd het nadelige wekeffect goed onderdrukt tot 10 5 cycli, met een redelijk hoge dubbele remanente polarisatiewaarde van ~40 μC/cm 2 . De film toonde ook betrouwbaar schakelen tot 10 9 fietsen met het fietsveld van 2,5 MV/cm zonder het wekeffect, maar met het typische vermoeidheidsgedrag.
Inleiding
Atoomlaag afgezet Hf1-x Zrx O2 (HZO, x ~ 0,5) dunne films waren de grootste kanshebber als de ultradunne ferro-elektrische (FE) laag op het gebied van halfgeleiderinrichtingen voor geheugen- en logische toepassingen. Dit komt omdat de FE HZO-film met fluorietstructuur zelfs onder 10 nm kan worden verkleind en homogeen kan worden afgezet op driedimensionale nanostructuren door gebruik te maken van gerijpte technieken voor atoomlaagafzetting (ALD). Bovendien is het compatibel met de conventionele TiN-elektrode [1, 2], wat nauwelijks kan worden bereikt met de conventionele ferro-elektriciteit met perovskietstructuur. Ondanks de aanzienlijke verbetering in de HZO-filmverwerking en apparaatfabricage met behulp van de op ALD gebaseerde dunne films in de afgelopen jaren, zijn er verschillende onopgeloste tekortkomingen. Vooral de betrouwbaarheid van de ferro-elektriciteit met fluorietstructuur is onzeker. Momenteel worden het wake-up-effect en het beperkte aantal uithoudingsvermogen beschouwd als de meest ernstige problemen [3]. Over het algemeen zijn de polarisatie-elektrisch veld (P-E) krommen geknepen in de oorspronkelijke staat, wat suggereert dat het coërcitieve veld (Ec ) is ruimtelijk niet-uniform en verschillende FE-domeinen zijn vastgezet [4]. Na elektrisch veld fietsen met een veldsterkte hoger dan Ec , kunnen meer symmetrische en vierkante P-E-curven worden bereikt, een fenomeen dat bekend staat als een wake-up-effect. In sommige gevallen duurt zo'n wekproces 10 4 –10 5 cycli, wat een typische uithoudingscyclus is van ca. flash-geheugen, waardoor de bediening van het apparaat en het systeem ingewikkeld wordt [5]. Het beperkte aantal uithoudingsvermogen is een ander kritiek punt als het bedoeld is om als werkgeheugen te worden gebruikt (uithoudingsvermogen> 10 15 Is benodigd). Voor de structuur van een metaal-ferro-elektrisch-metaalcondensator is het maximale gerapporteerde uithoudingsvermogen minder dan 10 11 [6], en voor metaal-ferro-elektrische halfgeleider gate-stack in ferro-elektrische veldeffect-transistor, is het uithoudingsvermogen beperkt tot 10 5 keer [3, 7].
In de literatuur werden verschillende oorzaken van het wake-up-effect gesuggereerd. De voorgestelde mechanismen zijn het vastzetten van domeingrenzen door defecten, zoals onzuiverheden, zuurstofvacatures en de aanwezigheid van de niet-ferro-elektrische fase (kubische of tetragonale fase) op de grensvlakken naast de elektroden of het halfgeleiderkanaal in de ongerepte staat [5, 8 ,9,10]. De concentratie van de pinning-site zal naar verwachting afnemen tijdens het herhaaldelijk wisselen van polarisatie. Ook transformeert elektrisch veld fietsen de interfaciale tetragonale of kubische fasen in de FE orthorhombische fase [5]. Deze studie was voornamelijk gericht op het verbeteren van de elektrische prestaties van de HZO-film of het elimineren van het wekeffect door alternatieve Hf- en Zr-precursoren te gebruiken tijdens het ALD-proces, wat kan resulteren in een lagere onzuiverheidsconcentratie, met name koolstofonzuiverheid.
Voor de ALD-processen waarbij gebruik wordt gemaakt van de metaal-organische voorlopers, is het bijna onvermijdelijk om resterende onzuiverheden, zoals C, N en H, in de gegroeide film te induceren, die hoogstwaarschijnlijk afkomstig zijn van de organische liganden. Kim et al. [11, 12] toonden aan dat door het veranderen van de depositietemperatuur van HfO2 en HZO-film, het polymorfisme en de resulterende elektrische eigenschappen konden worden gecontroleerd. Uit Auger-elektronenspectroscopie (AES) nam de C-concentratie in ALD HZO-dunne film toe met afnemende depositietemperatuur, wat het gevolg zou kunnen zijn van de imperfecte liganduitwisselingsreacties [11, 12]. Ook nam de laterale korreldiameter af met toenemende C-concentratie. De vorming van de onstabiele of metastabiele fasen (tetragonaal, orthorhombisch en kubisch) in plaats van de stabiele monokliene fase in dergelijke films met fluorietstructuur hangt nauw samen met het korrelgrootte-effect [13,14,15,16]. Het beheersen van de onzuiverheidsconcentratie is dus cruciaal om de gewenste fase (FE orthorhombisch) te bereiken en om de elektrische betrouwbaarheid van de film te verbeteren.
Voor de ALD van FE HZO dunne films zijn de meest gebruikte metaal-organische Hf- en Zr-precursoren de tetrakis[ethylmethylamino]hafnium (TEMAH) en tetrakis[ethylmethylamino]zirconium (TEMAZ) [11, 12, 17]. Deze voorlopers werden ontwikkeld voor de metaal-organische chemische dampdepositie met de bedoeling de liganden gemakkelijk te ontleden via de elektrische ladingsoverdracht tussen de methyl- en ethylgroepen [18,19,20]. Dit type thermisch geïnduceerde ligandontleding en daaropvolgende verwijdering van de (fragmenten van) organische liganden hebben echter een nadelige invloed op de gemakkelijke ALD-reactie, resulterend in de opname van onzuiverheden (C, H en N) in de film [11, 17,18, 19,20].
Daarentegen hebben de tetrakis[dimethylamino]hafnium (TDMAH) en tetrakis[dimethylamino]zirconium (TDMAZ)-precursoren, die ook zijn gebruikt om de FE HZO-films [21,22,23,24] af te zetten, alleen methylgroepen in hun liganden. Daarom is een dergelijk nadelig effect misschien niet ernstig, hoewel de volledige onderdrukking van de thermische ontleding niet kan worden gegarandeerd.
Deze studie voerde een vergelijkende analyse uit tussen de HZO-films die zijn gegroeid door de ALD-processen met twee verschillende metaalprecursoren; TEMAH/TEMAZ en TDMAH/TDMAZ. Dit laatste proces resulteerde in de lagere C-concentratie in de film, wat de elektrische prestaties van de HZO-film aanzienlijk verbeterde. Onder de geoptimaliseerde schakelcyclusomstandigheden werd bijna geen wekeffect bereikt terwijl de schakelbare polarisatie op ~ 40 μC/cm 2 bleef .
Methoden/experimenteel
Voorbereiding van de Hf0.5 Zr0,5 O2 Dunne films
Dit werk onderzocht de invloed van soorten metaal-organische voorlopers op de structuur en elektrische prestaties van de atomaire laag-afgezette Hf0.5 Zr0,5 O2 dunne films. De dunne HZO-films werden afgezet met behulp van een thermische ALD-reactor met een diameter van 4 inch met TDMAH (of TEMAH), TDMAZ (of TEMAZ) en ozon (190 g/m 3 concentratie) als respectievelijk de Hf-precursor, Zr-precursor en zuurstofbron. Het geoptimaliseerde ALD-proces met TEMAH/TEMAZ-precursoren was zoals in de eerdere studies van de auteurs [5, 9, 11,12,13,14,15,16]. De dunne HZO-films met TDMAH/TDMAZ-precursoren werden bereid door thermische ALD bij een substraattemperatuur van 260°C. Voor de elektrische test werd een Hf:Zr-verhouding van 50:50 gekozen, aangezien de samenstelling naar verluidt de grootste remanente polarisatie vertoont (Pr ) waarde in eerdere onderzoeken [17, 25, 26]. De dunne HZO-films met de TDMAH/TDMAZ-precursoren werden afgezet met een 1:1 ALD-cyclusverhouding van Hf- en Zr-precursoren op TiN/Ti/SiO2 /Si-substraat. Eén ALD-cyclus bestond uit bronvoeding (2 s) - bronzuivering (20 s) - ozontoevoer (3 s) - ozonzuivering (10 s) proces. De groeisnelheid van de HZO-film was 0,13 nm per cyclus en de 10 nm dikke HZO-dunne films werden bereid door TDMAH / TDMAZ-precursoren voor de experimenten. De optimale omstandigheden kunnen variëren afhankelijk van het volume van de ALD-kamer. Tabel 1 toont de vergelijking van fysieke eigenschappen van de TEMA- en TDMA-bronnen. De TiN (50 nm) en Ti (5 nm) films werden afgezet met behulp van sputteren met een sputtervermogen van 5 kW op de thermisch geoxideerde p-type Si-substraten met behulp van een commercieel sputtergereedschap (Endura, Applied Materials). De afgezette HZO-films zijn slechts gedeeltelijk kristallijn of amorf in de afgezette toestand, dus de daaropvolgende gloeiing voor kristallisatie werd uitgevoerd met behulp van een snel thermisch proces (RTP) bij 450 ° C in N2 sfeer.
Karakterisatie van de chemische/fysische eigenschappen van de Hf0.5 Zr0,5 O2 Dunne films
De kristallijne structuren van de afgezette films werden geanalyseerd met behulp van een röntgendiffractometer (XRD, X'pert pro, Panalytical) binnen een grazende invalgeometrie met een invalshoek van 0, 5 °. De microstructuren van de monsters werden geanalyseerd met behulp van een scanning-elektronenmicroscopie (SEM, S-4800, Hitachi), en de korrelgrootteverdeling werd geanalyseerd met behulp van een Gwyddion-software [29] via een waterscheidingsmethode. De chemische samenstelling van de afgezette HZO-film werd geanalyseerd met behulp van röntgenfluorescentie (XRF, Quant'X, Thermo SCIENTIFIC), en de diepgaande variaties in chemische samenstellingen, inclusief onzuiverheden zoals C, werden geanalyseerd met behulp van een time-of- vlucht Auger-elektronenspectroscopie (AES, PHI-700, ULVAC-PHI).
Karakterisering van de elektrische eigenschappen van de Hf0.5 Zr0,5 O2 Dunne films
Om de elektrische eigenschappen van de HZO-films te analyseren, werden de bovenste TiN-elektroden reactief afgezet via een sputterproces met een vermogen van 100 W onder de 92,6%-Ar/7,4%-N2 atmosfeer. De TiN-topelektroden werden van een patroon voorzien met behulp van een schaduwmasker met cirkelvormige gaten met een diameter van 300 m. De P–E-karakteristieken werden geanalyseerd met behulp van een ferro-elektrische tester (TF-analysator 2000, Aixacct-systemen) met een meetfrequentie van 1 kHz. De duurtest werd uitgevoerd met rechthoekige bipolaire pulsen met een hoogte en breedte van respectievelijk 2,8 ~ 3,8 MV/cm en 10 μs, gegenereerd door een pulsgenerator (81110A, Agilent) en een ferro-elektrische tester (TF-analysator 2000, Aixacct-systemen). De karakteristieken van de capaciteit-spanning (C-V) werden gemeten met behulp van een impedantie-analysator (4194A, Hewlett-Packard) onder de sinusvormige AC-pulsen met een frequentie van 10 kHz en een hoogte van 50 mV gecombineerd met DC-bias. De diëlektrische constanten van HZO-films werden berekend uit de gemeten capaciteit en het elektrodegebied gemeten door optische microscopie en de dikte gemeten met behulp van spectroscopische ellipsometrie (ESM-300, J.A. Woollam). De karakteristieken van de stroomdichtheid-elektrisch veld (J-E) werden geanalyseerd met behulp van een halfgeleiderparameteranalysator (4155B, Hewlett-Packard) onder DC-bias met een vertragingstijd van 1 s.
Resultaten en discussie
Figuur 1a toont de röntgendiffractiepatronen (GIXRD) van grazing-incidentie van 10 nm dikke Hf0,5 Zr0,5 O2 dunne films afgezet met TDMAH/TDMAZ (TDMA-HZO, zwarte curve) en TEMAH/TEMAZ (TEMA-HZO, rode curve) met een invalshoek van 0,5°. De referentiepatronen uit de literatuur voor de monokliene, tetragonale en orthorhombische fasen zijn toegevoegd in het onderste gedeelte. Van beide GIXRD-patronen van de TDMA- en TEMA HZO-films waren de intensiteiten van de diffractiepieken van de monokliene fase verwaarloosbaar en er kon geen opmerkelijk verschil in de piekvormen en -intensiteiten worden geïdentificeerd. Er werden dus geen significante verschillen in de kristallografische structuur tussen TDMA en TEMA HZO experimenteel bevestigd door GIXRD.

(a) GIXRD-patronen van HZO-dunne films afgezet met TDMAH/TDMAZ (zwarte curve) en TEMAH/TEMAZ (rode curve), de referentiepatronen uit de literatuur voor de monokliene, tetragonale en orthorhombische fasen zijn bevestigd in de onderste panelen. (b) Het vlakke SEM-beeld van TDMA HZO-films en (c) de korrelgrootteverdeling van TEMA (rood; overgenomen uit Ref. [15]), TDMA (zwart) HZO. (d) Het diepteprofiel van de TDMA HZO dunne films geanalyseerd met behulp van time-of-flight Auger-elektronenspectroscopie, en (e) het vergrote lage concentratiegebied van het HZO-filmdeel. Gemiddelde C-concentratie van TDMA (zwarte stippellijn), TEMA (rode stippellijn; overgenomen uit ref. [12]), HZO wordt weergegeven
De microstructuur, inclusief laterale korrelgrootte, is een andere kritische factor die de FE-eigenschappen van HZO-dunne films sterk kan beïnvloeden [13,14,15,16, 30]. Zo werden de microstructuren van de TDMA- en TEMA HZO-films geanalyseerd met behulp van scanning-elektronenmicroscopie (SEM). Figuur 1b toont het vlakke SEM-beeld van TDMA HZO-films. Verschillende eerdere studies meldden dat de dunne HZO-films die werden afgezet met behulp van thermische ALD een kolomvormige korrelstructuur vertoonden, wat suggereert dat de verticale korrelgrootte even groot is als de filmdikte [1, 5, 11, 31]. De verdeling van de laterale korrelgrootte geanalyseerd met behulp van de bovengenoemde software [29], werd uitgerust met de Gauss-functie. De korrelgrootteverdeling van TEMA HZO (rode curve) is afkomstig uit een eerdere studie [15] en uitgezet met die van TDMA HZO (zwarte curve) in Fig. 1c. Zoals getoond in Fig. 1c, was de gemiddelde laterale korreldiameter van de TDMA HZO (8,5 nm) groter dan die van de TEMA HZO (7,1 nm). Dit zou de belangrijkste reden kunnen zijn voor de verbeterde FE-prestaties van de TDMA HZO. Volgens eerdere rapporten wordt de vorming van de metastabiele fasen, zoals orthorhombische en tetragonale fasen, aangedreven door de kinetische oorsprong, en de tetragonale en orthorhombische fasen hebben de voorkeur in het gebied met kleine korrelgrootte [13, 16]. Veel grotere korrels geven de voorkeur aan monokliene fasen, kleinere korrelgrootte geeft de voorkeur aan de tetragonale fase en de iets grotere korrelgrootte geeft de voorkeur aan de orthorhombische fase. De bijna overlap van de piekposities van de twee fasen (tetragonale en orthorhombische fasen) in de diffractiepatronen maakte geen eenduidige identificatie van de hoofdfase in de twee films mogelijk. De SEM en bijbehorende korrelgrootteanalyse gaven echter aan dat de TDMA HZO-film een hoger deel van de orthorhombische fase zou kunnen hebben in vergelijking met de TEMA HZO-film.
De verschillende korrelgroottes zouden kunnen ontstaan als gevolg van het verschillende niveau van de C-onzuiverheidsconcentratie in de twee films. De concentraties van onzuiverheden kunnen de microstructuur en de resulterende ferro-elektrische eigenschappen van HZO-dunne films sterk beïnvloeden [11, 12, 32]. Daarom werd de chemische samenstelling van de TDMA en TEMA HZO dunne films geanalyseerd met behulp van time-of-flight AES, en de resulterende diepgaande concentraties van verschillende atomen zoals Hf, Zr, O, C, Ti en N in TDMA HZO film werden uitgezet als een functie van de sputtertijd in Fig. 1d. Figuur 1e toont het vergrote lage concentratiegebied van figuur 1d (rode gestippelde doos) in het HZO-filmgedeelte. De gemiddelde C-concentratie in TDMA HZO-film (zwart vierkant) was ~-2,4%, wat ~-38% kleiner is dan die (~-3,9%) van TEMA HZO-film (rode driehoek) [12], waarvan AES-gegevens werden gerapporteerd in de eerdere studie van de auteurs [12]. Alle andere concentraties, inclusief N, vertoonden geen noemenswaardige verschillen.
Cho et al. suggereerde dat de resterende C-onzuiverheden gevormd tijdens het ALD-proces de korrelgroei vertraagden en resulteerden in de kleine korrelgrootte van de uiteindelijk afgezette films [32]. Een vergelijkbare trend werd waargenomen voor ferro-elektrische Hf0,5 Zr0,5 O2 dunne films en pure HfO2 films van Kim et al. toen de depositietemperatuur daalde van 280 naar 200 °C [11, 12]. Jung et al. gebruikte computationele simulaties om aan te tonen dat het vrije-energieverschil tussen de tetragonale en monokliene fase afneemt met toenemende C-concentratie in HfO2 , wat suggereert dat het opnemen van C-onzuiverheid de stabiliteit van de metastabiele tetragonale fase [33] verbetert. Kuenneth et al. onderzocht ook het effect van C-concentratie op de vrije energiewaarden van HfO2 . Ze rapporteerden echter dat de toename van de C-concentratie niet resulteerde in de afname van het vrije-energieverschil tussen de orthorhombische en monokliene fase [34]. In het werk van Kuenneth et al. werden de vervangende C-defecten overwogen, hoewel de C-onzuiverheden algemeen bekend staan als interstitiële defecten in HfO2 [33, 35]. Daarom onthulden de theoretische berekeningen niet duidelijk dat de C-onzuiverheden het vrije-energieverschil tussen de tetragonale en orthorhombische fasen konden verminderen. Experimenten hebben echter bevestigd dat de toename van C-onzuiverheden de tetragonale fasefractie in de ALD HZO-dunne films zou kunnen verhogen [11, 12, 33].
De lagere C-onzuiverheidsconcentratie in de TDMA HZO-film kan worden toegeschreven aan de verschillende thermische ontledingsaard van de TDMA- en TEMA-liganden. De buitenste koolstofatomen in de TEMA-liganden zijn vatbaar voor thermische dissociatie en blijven tijdens het ALD-proces op het filmoppervlak [11, 12], wat mogelijk niet het geval is in TDMA-ligand.
Als volgende stap wordt het effect van de C-concentratie en de resulterende microstructuur op de ferro-elektrische eigenschappen besproken. Afbeelding 2a en b tonen de P–E-curven van MFM-condensatoren met respectievelijk de TDMA HZO- en TEMA HZO-films, gemeten in een ongerepte toestand en vermoeide toestanden geschakeld met 10 2 , 10 3 , 10 4 , en 10 5 keer met behulp van de 3,8 MV/cm hoge en 10 μs brede bipolaire rechthoekige pulsen. Van de P-E-curven in Fig.-2a en b (ongerepte toestand), is de P-E-curve van de TEMA HZO-condensator (zwarte curve, Fig.-2b) sterker geknepen in de ongerepte toestand in vergelijking met de TDMA HZO-condensator (zwart kromme, Fig. 2a). Figuur 2b toont duidelijk de bulten in de ongerepte P-E-curve van de TEMA HZO-condensator, wat niet het geval is voor de ongerepte P-E-curve van de TDMA HZO-condensator. De bulten in de P-E-curve zijn afkomstig van de splitsing van schakelstroompieken, die over het algemeen het gevolg zijn van de ruimtelijke inhomogeniteit in het interne elektrische veld en/of het dwangveld. Afbeelding 2c toont de veranderingen in 2Pr waarden van TDMA en TEMA HZO condensatoren als functie van vermoeiingspulsen. De 2Pr waarden na 10 5 tijden van elektrische pulsen, vergeleken met de ongerepte 2Pr waarden van TDMA- en TEMA HZO-condensatoren zijn respectievelijk ~ -80 en ~ -69%. Dit suggereert dat de TEMA HZO-film een hoger wekgedrag heeft in vergelijking met de TDMA HZO-film.

De polarisatie-elektrisch veld (P-E) krommen van (a ) de TDMA HZO en (b ) TEMA HZO (overgenomen van Ref. [5]) condensatoren gemeten in ongerepte toestand en vermoeide toestanden gepulseerd met 10 2 , 10 3 , 10 4 , en 10 5 keer bij 3,8 MV/cm hoge en 10 μs brede bipolaire rechthoekige pulsen. (c) De veranderingen in 2Pr waarden van TDMA (zwart) en TEMA (rood) HZO-condensatoren als functie van vermoeiingspulsen. De diëlektrische constante–elektrische veldkrommen van (d ) de TDMA HZO en (e ) TEMA HZO (overgenomen van Ref. [5]) condensatoren met de bovenste en onderste TiN-elektroden gemeten in ongerepte toestand en vermoeide toestanden. (f) De veranderingen in diëlektrische constante waarden met toenemend aantal vermoeiingspulsen voor TDMA (zwart) en TEMA (rood) HZO-condensatoren
Figuur 2d en e tonen de diëlektrische constante-elektrisch veld (εr - E) krommen van de TDMA HZO- en TEMA HZO-condensatoren gemeten in een onberispelijke staat en vermoeide toestanden geschakeld met 10 2 , 10 3 , 10 4 , en 10 5 keer met behulp van de 3,8 MV/cm hoge en 10 μs brede bipolaire rechthoekige pulsen. De εr waarden van TDMA HZO-condensatoren zijn onder alle testomstandigheden aanzienlijk lager dan die van TEMA HZO-condensatoren. Afbeelding 2f toont de veranderingen in εr waarden met het toenemende aantal vermoeiingsschakelcycli voor TDMA- en TEMA HZO-condensatoren. De εr waarden werden berekend door middel van εr waarden gemeten bij de hoogste en laagste elektrische velden in Fig. 2d en e. Uit de GIXRD-patronen in Fig. 1a waren de monokliene fasefracties in beide films verwaarloosbaar. Dus het verschil in εr waarde kan worden bepaald door de relatieve fracties van de tetragonale en orthorhombische fasen of de defectconcentratie, waarvan wordt verwacht dat deze de gemiddelde diëlektrische constante verlaagt met lokale roostervervormingen. De εr waarde van de tetragonale fase (35-40) was hoger dan die van de orthorhombische fase (25-30). Dus de hoge εr waarde van de TEMA HZO-condensator geeft aan dat deze een hogere tetragonale fasefractie heeft in vergelijking met de TDMA HZO-condensatoren. Met het toenemende aantal vermoeidheidspulsen, wordt de εr waarde van zowel TEMA HZO- als TDMA HZO-condensatoren neemt af, zoals weergegeven in Fig. 2f. De omvang van de afname in εr waarde gedurende 10 5 keer polarisatie-omschakeling voor TDMA HZO-condensator (26,8 tot 25,3) was ~-42% kleiner dan die voor TEMA-HZO-condensator (32,2 tot 29,6). Dit komt overeen met het ontwaakgedrag dat wordt getoond in Fig. 2c.
Het verschil in tetragonale fasefractie en de resulterende verschillende εr waarde van TDMA en TEMA HZO dunne films kon worden begrepen uit het verschil in C-concentratie. Volgens Kim et al. [12], de toename van de C-concentratie verlaagt de vrije energie van de tetragonale fase in vergelijking met die van de orthorhombische fase (tetragonale fase is nog gunstiger in vergelijking met de orthorhombische fase). Als resultaat wordt verwacht dat met de toenemende C-concentratie de tetragonale fasefractie zal toenemen. Aangezien de C-concentratie van TDMA HZO-film lager is dan die van de TEMA HZO-film, wordt verwacht dat de tetragonale fasefractie in TDMA HZO-film lager is dan die van de TEMA HZO-film. Het verschil in korrelgrootte getoond in Fig. 1c ondersteunt ook dezelfde trend in relatieve kristallijne fasefracties. Volgens Materlik et al. [30], de vrije oppervlakte-energie van de tetragonale fase (2,5 J/m 2 ) lager is dan dat (2,9 J/m 2 ) van de orthorhombische fase, hoewel deze vrije oppervlakte-energieën werden geschat om de experimentele waarnemingen in HZO dunne films met verschillende diktes en Zr-concentraties te verklaren. Batra et al. [36] berekende de vrije oppervlakte-energie van de verschillende kristallijne fasen met verschillende oriëntaties en toonde aan dat de vrije oppervlakte-energie van de tetragonale fase lager is dan die van de orthorhombische en monokliene fase. Het is algemeen aanvaard dat de energie van de hoge-hoekkorrelgrens ruwweg 1/3 van de vrije oppervlakte-energie is [37]. De korrelgrensenergie van de tetragonale fase is dus het laagst in vergelijking met de orthorhombische en monokliene fasen, waardoor het de meest stabiele fase is bij de kleinste korrelgrootte. Deze zijn consistent met het idee dat de kleinere korrelgrootte van de TEMA HZO de neiging heeft een groter deel van de niet-ferro-elektrische tetragonale fase te bevatten in vergelijking met de TDMA HZO-film, die een grotere gemiddelde korrelgrootte had. Daarom ondersteunen de experimenteel waargenomen C-concentratie en korrelgrootte consequent de verschillende kristallijne structuur en de resulterende elektrische eigenschappen van de TDMA- en TEMA HZO-dunne films.
Om het mechanisme achter het wekeffect te verduidelijken, de pulsomschakelmeting, die de grensvlakcapaciteit kan schatten (Ci ) afkomstig van de niet-ferro-elektrische laag nabij elektroden, werd uitgevoerd op TDMA HZO- en TEMA HZO-condensatoren [5]. Figuur 3a en b tonen de veranderingen in Ci , contactweerstand (Rc ), en Ec waarden met het toenemende aantal vermoeiingspulsen voor respectievelijk de TDMA HZO- en TEMA HZO-condensatoren. De gedetailleerde meetmethode en resultaten zijn opgenomen in de online ondersteunende informatie. De gegevens voor de TEMA HZO-condensator zijn ontleend aan het eerdere werk van Kim et al. [5], waar de Ci waarde neemt toe met het toenemende aantal elektrische veldcycli [5]. In de ongerepte staat, de Ci (37.6 μF/cm 2 ) waarde van de TDMA-condensator is hoger dan die (21,1 μF/cm 2 ) van de TEMA HZO-condensator met ~ -75%, wat suggereert dat de dikte van de niet-ferro-elektrische grenslaag in TDMA HZO veel kleiner is dan die in TEMA HZO-film. Aan de andere kant is het verschil in Ec waarde in de ongerepte staat van TDMA- en TEMA HZO-condensatoren is slechts 13%, wat suggereert dat de belangrijkste reden voor het verschil in de ongerepte P-E-kenmerken van TDMA- en TEMA HZO-condensatoren de verschillende dikte van de niet-ferro-elektrische grensvlaklagen is. Sinds Rc waarde sterk wordt beïnvloed door de contactweerstand voor de elektrische testopstelling, kan deze minder belangrijk zijn in vergelijking met de andere twee factoren. Daarom konden de verschillende P-E-kenmerken in de ongerepte staat van de TDMA- en TEMA HZO-condensator consistent worden begrepen op basis van het vorige wake-upmodel dat werd gesuggereerd door Kim et al. [5]. Volgens de eerdere studies is de concentratie van de zuurstofleegstand in de buurt van de TiN-elektroden hoger dan die van het filmbulkgebied in de ongerepte staat. Volgens Hoffmann et al. [38], de toename van de zuurstofvacatureconcentratie verbetert de stabiliteit van de tetragonale fase in vergelijking met die van de orthorhombische fase. Tijdens het herhaaldelijk wisselen van polarisatie in de duurtest, leek de tetragonale grensvlakfase om te zetten in de FE orthorhombische fase door de zuurstofvacatures naar het bulkgebied van de film te diffunderen. Het aangelegde veld induceerde ook faseovergang van de niet-FE-grensvlakfase naar de FE-fase. Aangezien de dikte van de grenslaag van de TDMA-HZO-condensator kleiner is dan die van de TEMA-HZO-condensatoren in ongerepte staat, kan het wekeffect tijdens de veldcycli worden verzacht.
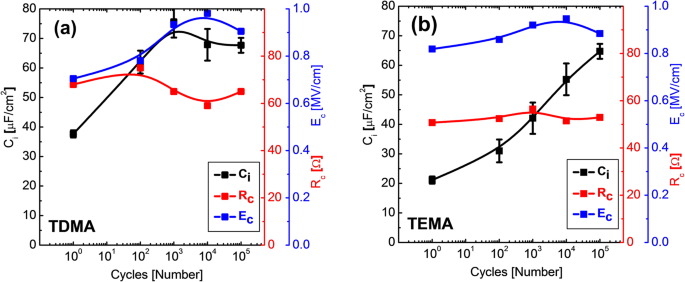
De wijzigingen van (a ) TDMA HZO en (b ) TEMA HZO (overgenomen van Ref. [5]) in grensvlakcapaciteit (Ci ), contactweerstand (Rc ), en dwangveld (Ec ) waarden met toenemend aantal vermoeidheidspulsen
Ook is de amplitude van de vermoeidheidspuls een andere cruciale factor die de ontwaakfenomenen van de fluoriet-structuur ferro-elektriciteit sterk kan beïnvloeden [6, 8]. Daarom werd het wekeffect van de TDMA HZO-condensator onderzocht met behulp van vermoeiingspulsen met verschillende amplituden van 2,8, 3,1, 3,5 en 3,8 MV/cm. Afbeelding 4a, b en c tonen de P–E-curven gemeten tijdens de ontwaaktest met vermoeidheidspulshoogten van respectievelijk 2,8, 3,1 en 3,5 MV/cm. De veranderingen in 2Pr tijdens de wektest werden samengevat in Fig. 4d. Vergelijkbaar met het ontwaaktestresultaat getoond in Fig. 2a, werd de P-E-meting uitgevoerd bij het metende elektrische veld van 3,8 MV / cm, na een bepaald aantal ontwaakcycli met de gegeven veldamplitude. De veranderingen in P-E-hysterese nemen af met afnemende amplitude van vermoeidheidspulsen, zoals weergegeven in Fig. 4a-c. Afbeelding 4d toont een samenvatting van de wijzigingen in 2Pr waarde tijdens de duurtest met 2,8, 3,1, 3,5 en 3,8 MV/cm amplitude vermoeidheidspulsen. Zoals te zien is in Fig. 4d, is de grootte van 2Pr verhogen na 10 5 tijden van veldcycli waren 0,41, 5,18, 9,93 en 9,94 μC/cm 2 voor de verschillende amplitude van het vermoeidheidsveld, die respectievelijk overeenkomen met ~-1, ~-13, ~-26 en ~-24% veranderingen. Dit resultaat houdt in dat het wekeffect verwaarloosbaar is wanneer een vermoeidheidspuls met een amplitude van 2,8 MV/cm werd toegepast, waarbij een redelijk hoge 2Pr waarde (~ 40 μC/cm 2 ) nog kan worden bereikt.
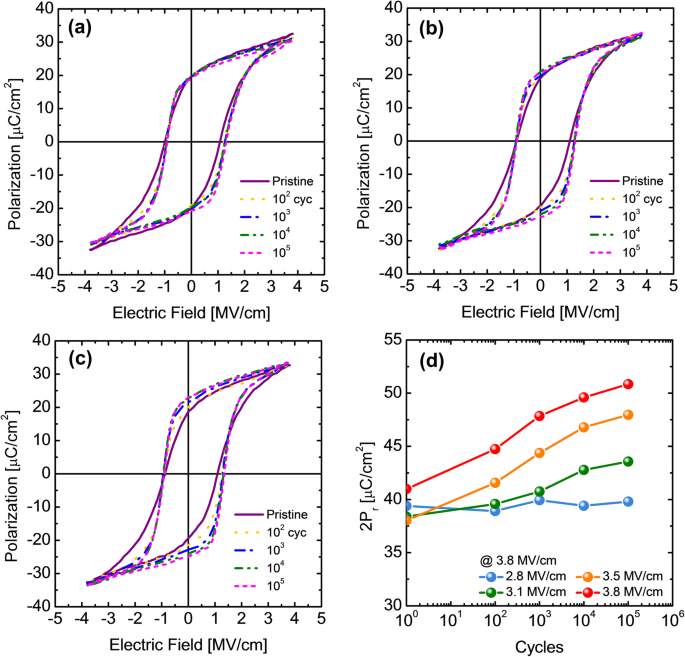
De polarisatie-elektrisch veld (P-E) curves gemeten tijdens de ontwaaktest met de vermoeidheidspulshoogte van (a ) 2.8, (b ) 3.1, en (c ) 3,5 MV/cm. (d) De veranderingen in 2Pr waarde tijdens de duurtest met 2,8, 3,1, 3,5 en 3,8 MV/cm hoge vermoeidheidspulsen
Het wekeffect is sterk gerelateerd aan de drift van zuurstofvacatures en de resulterende faseovergang van de tetragonale fase naar de orthorhombische fase, voornamelijk in de grenslaag [9, 10]. De drift van zuurstofvacatures moet sterk worden beïnvloed door de amplitude van de vermoeidheidspulsen, en een geschikte lagere veldamplitude van de vermoeidheidstest (2,8 MV/cm in dit geval) kan een dergelijk nadelig effect grotendeels verminderen. Hoewel het haalbare maximum 2Pr waarde is verlaagd van ~ 51 μC/cm 2 (bij 3,8 MV/cm) tot ~ 40 μC/cm 2 (bij 2,8 MV/cm), ~ 40 μC/cm 2 is nog steeds een redelijk hoge waarde voor ferro-elektrische geheugenapparaten. Voor het geval van de TEMA HZO-film zou een vergelijkbare strategie kunnen worden toegepast om het ontwaakprobleem te verminderen, maar de aanvankelijk lage 2Pr waarde (~ 30 μC/cm 2 ) zou het potentiële probleem kunnen zijn voor een dergelijke methode.
De invloed van de C-concentratie werd verder verduidelijkt door de duurtest tot 10 9 cycli, zoals getoond in Fig. 5a en b, die de variaties in Pr . lieten zien onder veldamplitude van 2, 5 en 3, 0 MV / cm voor respectievelijk de TEMA- en TDMA HZO-films. In beide gevallen is de Pr waarden werden geschat door de P-E-lussen met het maximale elektrische veld van dezelfde sterkte als het fietsveld, dus de geschatte Pr waarden zijn over het algemeen kleiner dan die waarden in Fig. 4, waar de P-E-tests werden uitgevoerd met 3,8 MV / cm. Toen het maximale veld (3,8 MV/cm) voor de P–E-test in Fig. 4 werd gebruikt voor de duurtests, werden de films vroegtijdig afgebroken, waardoor de duurtests tot de maximale cyclusaantallen werden verboden. De twee films vertoonden consistente trends in de evolutie van de Pr vs. cycle behavior:TEMA HZO film kept increasing the Pr values, whereas the trend was much lower for the case of the TDMA HZO film. The TEMA HZO film showed unsteady Pr changes before break down at ~ 10 7 and ~ 10 9 cycles using 3.0 and 2.5 MV/cm field cycling, respectively. In contrast, the TDMA HZO film showed no indication of breakdown up to ~ 10 7 and ~ 10 9 cycles at 3.0 MV/cm and 2.5 MV/cm field cycling, and sudden breakdown was observed. The Pr value decreased slightly after ~ 10 7 under the cycling field strength of 2.5 MV/cm, which corresponds to the genuine fatigue behavior. Similar decay in the Pr performance with the switching cycles has been extensively reported for conventional perovskite ferroelectrics, which usually ascribed to the domain wall pinning by the increasing defect density [40, 41]. In the previous studies on the HZO-based ferroelectric thin films, such genuine fatigue behaviors have hardly been observed due to the involvement of significant wake-up and early breakdown, which was also the case in Fig. 5a. The data shown in Fig. 5b reveals that the HZO film may also suffer from the fatigue effect, known in the perovskite ferroelectric film, under the condition that the wake-up and early breakdown are appropriately addressed.
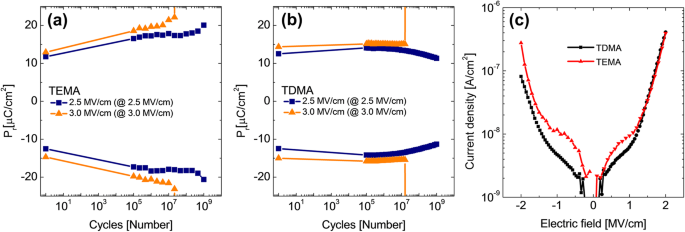
The results of endurance test of (a ) TEMA HZO (reproduced from Ref. 39) and (b ) TDMA HZO with the electric field cycling and pulse field amplitude of 2.5 and 3.0 MV/cm. The frequency of the rectangular double pulse for the endurance test was fixed at 100 kHz. (c) The current density–electric field curves of TDMA HZO (black) and TEMA HZO (red; reproduced from Ref. [39])
Figure 5c shows the comparison in the leakage current density performance of the two types of films. Due to the lower C concentration, TDMA HZO film had a lower leakage current than that of the TEMA HZO film at field strength <~ 1.5 MV/cm, where the trap-assisted tunneling may dominate. As a result of the leakage current improvement in TDMA HZO, the film did not show the breakdown up to 10 9 cycles, with relatively low field strength of 2.5 MV/cm.
However, in the higher field strength region, the difference becomes diminished, which may indicate that the high-field leakage current is more dominated by the interface Schottky barrier property, and such barrier property was less sensitive to the C concentration. Further research will be performed to more precisely identify the leakage current mechanism in subsequent work. The similar leakage currents in the high field region coincide with the no significant difference in the number of switching cycles before the breakdown at 3.0 MV/cm, shown in Fig. 5a and b.
Conclusie
In conclusion, this work examined the influence of types of metal-organic precursors on the structure and electrical performances of the atomic layer-deposited Hf0.5 Zr0.5 O2 thin films. The adopted Hf and Zr precursors have either TEMA or TDMA ligands, where the former is more prone to the thermal decomposition compared to the latter. The ALD process using the precursors with TDMA ligands resulted in a lower C impurity concentration (~2.4 atomic % vs. ~3.9 atomic %) in the HZO film, which induced a slightly larger grain size (~8.5 nm vs. ~7.1 nm). As the slightly larger grain size prefers to have the ferroelectric orthorhombic phase rather than the non-ferroelectric tetragonal phase, the TDMA HZO film outperformed the TEMA HZO film, especially for the wake-up performance. When the wake-up field cycle was 2.8 MV/cm, the TDMA HZO film showed almost no wake-up effect, while a high 2Pr value of ~40 μC/cm 2 could be achieved. This is significant merit over the severely waking-up property of the TEMA HZO film. The TDMA HZO film also contained a lower portion of the interfacial non-ferroelectric phase with the TiN electrodes, compared with the TEMA HZO film. Due to the lower C concentration, the TDMA HZO film showed a lower leakage current in the low field region (<~1.5 MV/cm), but the high-field leakage current behaviors were similar. As a result, the number of switching cycles before breakdown was similar when the cycling field was as high as 3.0 MV/cm (~10 7 cycles), but it could be extended over 10 9 cycles when the cycling field was lower (2.5 MV/cm) for the case of the TDMA HZO film. The TDMA HZO film revealed that the typical fatigue behavior, i.e., decreasing Pr value with the increasing switching cycles, could be observed after ~ 10 7 cycles at 2.5 MV/cm, which might be ascribed to the domain wall pinning by the accumulated defects, as for the conventional perovskite ferroelectric films.
Beschikbaarheid van gegevens en materialen
The datasets supporting the conclusions of this article are included within the article and its Additional file 1.
Afkortingen
- TEMA:
-
Tetrakis(ethylmethylamino)
- TDMA:
-
Tetrakis(dimethylamino)
- TEMAH:
-
Tetrakis[ethylmethylamino]hafnium
- TEMAZ:
-
Tetrakis[ethylmethylamino]zirconium
- TDMAH:
-
Tetrakis[dimethylamino]hafnium
- TEMAZ:
-
Tetrakis[dimethylamino]zirconium
- TDMA HZO:
-
Hf0.5 Zr0.5 O2 thin films deposited using TDMAH/TDMAZ
- TEMA HZO:
-
Hf0.5 Zr0.5 O2 thin films deposited using TEMAH/TEMAZ
- ALD:
-
Atoomlaagafzetting
- AES:
-
Auger electron spectroscopy
- RTP:
-
Rapid thermal process
- XRD:
-
Röntgendiffractometer
- GIXRD:
-
Begrazingsincidentie Röntgendiffractie
- SEM:
-
Scanning elektronenmicroscopie
- HZO:
-
Hf1-x Zrx O2 , x~0.5
- FE:
-
Ferroelectric
- Pr :
-
Remanente polarisatie
- Ec :
-
Dwingend veld
- P–E:
-
Polarization–electric field
- C–V:
-
Capacitance–voltage
- J–E:
-
Current density–electric field
- Ci :
-
Interfacial capacitance
- Rc :
-
Contact resistance
Nanomaterialen
- Onthulling van de atomaire en elektronische structuur van gestapelde koolstof nanovezels
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- First-Principles Study on the Stability and STM Image of Borophene
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Vervaardiging van SrGe2 dunne films op Ge (100), (110) en (111) substraten
- Het bestuderen van de hechtkracht en glasovergang van dunne polystyreenfilms door Atomic Force Microscopy
- Een onderzoek naar koolstofnanovezels en actieve koolstof als symmetrische supercondensator in waterige elektrolyt:een vergelijkend onderzoek
- Voorbereiding en thermo-elektrische kenmerken van ITO/PtRh:PtRh Thin Film Thermokoppel
- TEM- en STEM-onderzoeken naar de transversale morfologieën van dubbel-/drielaags breedband SiO2-antireflectiefilms
- Vergelijkende studie van de elektrochemische, biomedische en thermische eigenschappen van natuurlijke en synthetische nanomaterialen
- Een handige en effectieve methode om Low-Defect-Density nc-Si:H Thin Film van PECVD te deponeren



