Een handige en effectieve methode om Low-Defect-Density nc-Si:H Thin Film van PECVD te deponeren
Abstract
Dunne film van gehydrogeneerd nanokristallijn silicium (nc-Si:H) heeft veel aandacht gekregen als een veelbelovend materiaal voor transistors met platte beeldschermen, zonnecellen, enz. De meerfasenstructuur van nc-Si:H leidt echter tot veel defecten. Een van de grootste uitdagingen is hoe u de defecten gemakkelijk kunt verminderen. In dit werk hebben we een eenvoudige en effectieve methode ontwikkeld om nc-Si:H dunne film met lage defectdichtheid af te zetten. Deze methode is eenvoudigweg door de depositiedruk in een hogedrukbereik af te stemmen in een plasma-enhanced chemical vapour deposition (PECVD) -proces. Microstructuren van de nc-Si:H werden gekenmerkt door Raman, AFM en SEM. Verder hebben we ons gericht op de defectdichtheid die het belangrijkste kenmerk was voor fotovoltaïsche materialen en hebben we de defectdichtheid van 3.766 × 10 16 bereikt. cm −3 . Deze defectdichtheid is lager dan die van eerdere onderzoeken naar de fabricage van nc-Si:H met een lage defectdichtheid door andere complexe methoden in het PECVD-proces. De levensduur van de minderheidsdrager van nc-Si:H wordt dus sterk verbeterd. Bovendien hebben we het mechanisme over het effect van depositiedruk op het ionenbombardement gedemonstreerd en bewezen dat de defectdichtheid het belangrijkste kenmerk is van nc-Si:H fotovoltaïsch materiaal.
Achtergrond
Een belangrijke mijlpaal in de vooruitgang van dunne-film siliciumtechnologie is de ontwikkeling van hoogwaardig gehydrogeneerd nanokristallijn silicium (nc-Si:H). Vergeleken met gehydrogeneerd amorf silicium (a-Si:H), heeft nc-Si:H een veel hogere mobiliteit, een veel betere respons bij golflengten groter dan 800 nm, en is het veel minder gevoelig voor de Staebler-Wronski-degradatie [1, 2]. nc-Si:H dunne film kan worden afgezet met behulp van plasma-enhanced chemical vapour deposition (PECVD), waardoor het compatibel is met de goed ontwikkelde industrie voor geïntegreerde schakelingen. Daarom heeft nc-Si:H dunne film een brede toepassing in verschillende apparaten, zoals dunnefilmtransistors [3], fotodetectoren [4] en zonnecellen [5].
Als meerfasig materiaal heeft nc-Si:H dunne film echter zijn eigen gebreken, zoals holtes en bungelende bindingen op de grensvlakken van kristallen/amorfe fase en tussen kristallen. Het is bekend dat de atomaire waterstof de sleutel is tot de depositie van hoogwaardig nc-Si:H dat minder defecten heeft [6]. De atomaire waterstof kan bungelende bindingen verzadigen, en er is opgemerkt [7] dat de atomaire waterstof op het groeioppervlak aanleiding geeft tot kristalgroei bij een temperatuur die veel lager is dan de smeltende. Zo is meer atomaire waterstof gunstig voor de depositie van hoogwaardig nc-Si:H. Om de atomaire waterstofflux op het groeioppervlak te vergroten, zou een hoge waterstofverdunning of silaanuitputting essentieel zijn voor nc-Si:H-groei.
Het leveren van silaanuitputting in PECVD is het verhogen van het radiofrequentievermogen (RF) [7]. Maar door simpelweg het vermogen te vergroten, zal het ionenbombardement op het groeioppervlak dramatisch toenemen, wat waarschijnlijk tot meer defecten zal leiden. Er moet dus een gelijkstroomvoorspanning (DC) worden gebruikt om het ionenbombardement te onderdrukken. Als het RF-vermogen echter wordt verhoogd om meer atomaire waterstof te verkrijgen, moet ook de DC-bias worden gewijzigd. Anders kan de DC-bias het ionenbombardement niet effectief verlichten. En de geschikte DC-bias onder bepaald RF-vermogen kan niet worden gevonden zonder de uitgebreide experimenten. Een andere methode om het atomaire waterstofgehalte te verhogen is het verhogen van de depositiedruk. De botsingsfrequentie van elektronen en moleculen neemt toe met de depositiedruk. Het maakt de dissociatiesnelheid van SiH4 en H2 stijgende lijn. Een dissociatie van SiH4 en H2 genereert de atomaire waterstof [8]. Als gevolg hiervan zou een toenemende depositiedruk het atomaire waterstofgehalte kunnen verhogen.
In dit artikel stellen we dus voor om de depositiedruk in een hogedrukbereik af te stemmen om meer atomaire waterstof te verkrijgen (de conventionele depositiedruk is 50-100 Pa). Het is een handige en effectieve methode in het PECVD-proces. Door deze methode te gebruiken, heeft de film die onder een bepaalde druk is afgezet een lagere defectdichtheid in vergelijking met eerdere onderzoeken naar de fabricage van nc-Si:H met een lage defectdichtheid [5, 9, 10]. En er is een lange levensduur van de minderheidsdrager bereikt. Bovendien hebben we, vergeleken met de eerdere rapporten over het effect van verschillende depositiedrukken op de macroscopische of algemene eigenschappen van de monsters [11, 12], het bereik van de depositiedruk aanzienlijk uitgebreid en ons niet alleen gericht op het effect ervan op de algemene eigenschappen (bijv. kristalliniteit), maar ook op de defectdichtheid en de levensduur van minderheidsdragers, die belangrijke kenmerken zijn voor fotovoltaïsch materiaal van hoge kwaliteit. Verder hebben we het mechanisme over het effect van depositiedruk op het ionenbombardement aangetoond, terwijl eerdere rapporten alleen algemene discussies gaven. En we hebben verder bewezen dat het ionenbombardement niet hoe zwakker des te beter is voor de filmgroei (de mate van ionenbombardement zou geschikt moeten zijn). Uiteindelijk hebben we bewezen dat de defectdichtheid het belangrijkste kenmerk is van nc-Si:H fotovoltaïsch materiaal.
Methoden/experimenteel
De dunne nc-Si:H-films werden op Corning-glas gekweekt door een capacitief gekoppeld PECVD-systeem (het schematische diagram van de reactor wordt getoond in Fig. la) bij verschillende depositiedruk. De depositiedruk werd verhoogd van 150 naar 1050 Pa, met een stap van 150 Pa. Alle monsters werden gedeponeerd met een RF van 13,56 MHz en een vermogensdichtheid van 0,32 W/cm 2 , met een totaal gas (SiH4 en H2 ) stroomsnelheid van 110 sccm (de SiH4 concentratie was 0,727%). De substraattemperatuur werd op 250 °C gehouden en de depositietijd was 2 uur.
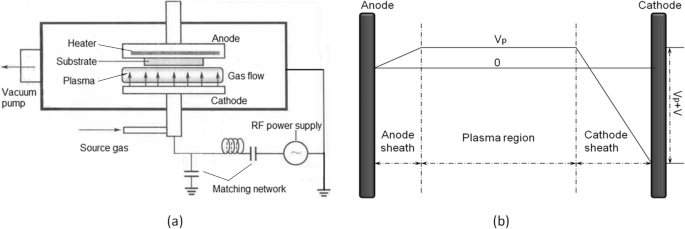
Het schematische diagram van a de PECVD-reactor en b de potentiaalverdeling tussen elektroden (V p , de plasmapotentiaal; V , het wortelgemiddelde RF-potentiaal)
De kristalliniteit X c werd berekend uit Raman-spectra gemeten met een UV-micro-Raman-spectrometer (Jobin Yvon LabRam, HR800) in terugverstrooiingsmodus met behulp van een Ar-ion-laser bij 514,5 nm. De vermogensdichtheid van de laser werd gehouden op 1 mW/mm 2 om elke bundelgeïnduceerde kristallisatie te voorkomen. De defectdichtheid van de monsters werd gekenmerkt door de spindichtheid Ns, die werd berekend uit de resultaten gemeten met een elektronenspinresonantie (ESR) spectrometer (Bruker, EMX-8X-band) op 9,8 GHz en 5 mW. De effectieve levensduur van een minderheidsdrager τ werd gemeten met een Semilab WT-1200A. De oppervlaktemorfologie van deze films werd waargenomen door een atoomkrachtmicroscoop (AFM, SII Nanonavi E-Sweep) en de micromorfologie werd waargenomen door een scanning-elektronenmicroscoop (SEM, Sirion 200).
Resultaten en discussie
Structureel onderzoek door Raman-analyse
Voor het structurele onderzoek van de onder verschillende druk neergeslagen nc-Si:H dunne film werden micro-Raman metingen uitgevoerd. In Fig. 2 werden vier representatieve monsters gekozen om de Raman-spectra te tonen. Ze worden afgezet onder respectievelijk 300 Pa, 450 Pa, 750 Pa en 1050 Pa. Elk spectrum (open cirkels) onder bepaalde druk kan worden gedeconvolueerd in drie Gauss-pieken:(1) een brede Gauss-verdeling van ongeveer 480 cm −1 , die wordt toegeschreven aan de transversale optische (TO1 ) modus van amorf silicium; (2) een piek in de buurt van 520 cm −1 , die behoort tot de asymmetrische TO2 vibratiemodus van kristallijn silicium [13, 14]; en (3) de piek rond 506 cm −1 die wordt toegeschreven aan de tussenliggende reeks [1, 15]. De kristalliniteit (X c ) in nc-Si:H kan worden berekend met [16, 17]:
$$ {X}_c=\left({I}_{520}+{I}_{506}\right)/\left({I}_{520}+{I}_{506}+\gamma {I}_{480}\right) $$ (1)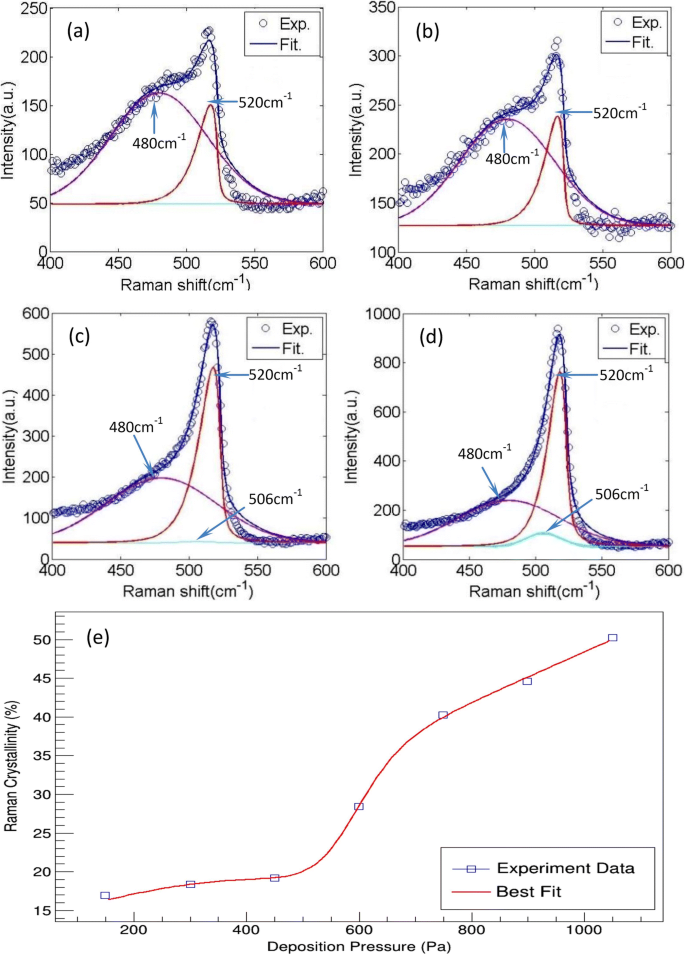
Raman-spectra en hun deconvolutie van typische monsters afgezet onder 300 Pa (a ), 450 Pa (b ), 750 Pa (c ), en 1050 Pa (d ) en de berekende kristalliniteit van nc-Si:H dunne films afgezet onder verschillende drukken (e )
waar γ is de verhouding van de geïntegreerde Raman-doorsnede voor c-Si tot a-Si (γ = 1 [17, 18]), en I 520 , ik 506 , ik 480 zijn de geïntegreerde intensiteit van de pieken waargenomen bij 520, 506, 480 cm −1 , respectievelijk. De kristalliniteit als functie van verschillende depositiedrukken is uitgezet in Fig. 2e.
Het is bekend dat de atomaire waterstof (H), voornamelijk wordt gegenereerd door de volgende twee botsingen in met waterstof verdund silaanplasma [8]:
- een.
De primaire elektron-silaanreactie
- b.
De elektron-waterstofreactie
Volgens de formules S(1) en S(2) in het aanvullende bestand 1 kunnen we \( {n}_e=\frac{P}{RT}\bullet \mu \) (P , afzettingsdruk; R , ideale gasconstante; T , absolute temperatuur van gas vóór lossing; μ , ionisatiesnelheid; en n e , elektronendichtheid). μ constant is vanwege het ongewijzigde RF-vermogen, en T is ook constant. De elektronendichtheid n e neemt dus toe met de depositiedruk P . Volgens chemische vergelijkingen. (2) en (3) neemt de dichtheid van H die in het plasma wordt geproduceerd toe met n e . Dit is de theoretische analyse in een ideale toestand. Het ontslagproces is zo complex dat de analyse van het ontslagproces (d.w.z. plasmadiagnoses) een zelfstandige discipline wordt. De verandering van H met de depositiedruk in de werkelijke toestand moet worden gemeten door middel van plasmadiagnoses. Yang et al. de intensiteit van \( {H}_{\alpha}^{\ast } \) (\( {I}_{H_{\alpha}^{\ast }} \)) gemeten met optische emissiespectra (OES) en laat zien dat \( {I}_{H_{\alpha}^{\ast }} \) eerst toeneemt en daarna afneemt [19]. Volgens eerdere rapporten over plasmadiagnoses geeft de intensiteit van \( {H}_{\alpha}^{\ast } \) de hoeveelheid atomair waterstof aan [20, 21]. Dus de dichtheid van H in het plasma neemt eerst toe en neemt vervolgens af wanneer de depositiedruk blijft toenemen. Deze trend wijkt een beetje af van onze theoretische analyse. Het verschil houdt verband met de secundaire reactie van H:
$$ \mathrm{H}+{\mathrm{SiH}}_4\to {\mathrm{H}}_2+{\mathrm{SiH}}_3 $$ (4)waar SiH4 is degene die niet ontleed is, d.w.z. de resterende SiH4 . In ons experiment wordt de depositiedruk verhoogd door de uitstroom van gassen waaronder SiH4 . te verminderen . Met andere woorden, het komt overeen met het verhogen van het supplement van SiH4 .Wanneer de depositiedruk tot een bepaald niveau stijgt, neemt de snelheid van SiH4 supplement zijn ontledingssnelheid overschrijdt. Er zijn dus meer hoeveelheden SiH4 links. Er is een afstand voor H vanaf zijn ontsnapping uit het plasma tot zijn aankomst bij het filmgroeiende oppervlak. H zal reageren met de resterende SiH4 op deze afstand, zoals weergegeven in de secundaire chemische Vgl. (4). De dichtheid van H neemt dus af. Dientengevolge neemt de atomaire waterstofdichtheid eerst toe en vervolgens af wanneer de depositiedruk blijft toenemen. Het is bekend dat een grotere hoeveelheid H gunstig is voor de afzetting van nc-Si:H met een lage defectdichtheid. Daarom vertoont de defectdichtheid van nc-Si:H afgezet in ons experiment dezelfde neiging van de atomaire waterstofdichtheid, d.w.z. de defectdichtheid neemt eerst af en neemt vervolgens toe. De discussies over de trend van defectdichtheid in detail worden getoond in de laatste sectie.
In figuur 2e is duidelijk te zien dat de kristalliniteit van nc-Si:H, X c , neemt toe met de depositiedruk. Dit geeft aan dat toenemende druk X . kan verhogen c . De kristalliniteit wordt niet alleen beïnvloed door de atomaire waterstof maar ook beïnvloed door het gehalte aan groeiprecursor SiHn (n = 1,2,3, voornamelijk n = 3) wat kan worden aangegeven door SiH * bij OES-meting [21, 22]. Hsieh et al. hebben aangetoond dat \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ (de intensiteitsverhouding \( {H}_{\alpha}^{\ast } \)/SiH * ) neemt toe met de depositiedruk [20]. Het is algemeen aanvaard dat \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ is de index voor X c , d.w.z. X c neemt toe met de toename van \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ [21, 23]. Daarom is de \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ trend ondersteunt sterk ons resultaat over de tendens van X c .
De gemiddelde korrelgrootte d kan ook worden afgeleid uit het Raman-spectrum, volgens de formule [24, 25]:
$$ d=2\pi \sqrt{B/\Delta \upnu} $$ (5)waar ∆ν is de frequentie in cm −1 verschuiving, die werd gedefinieerd als het verschil tussen de waargenomen piekfrequentiewaarde en die van het bulk Si. De gebruikelijke waarde van B . gebruiken van 2,0 cm −1 nm 2 [25], d = 4,07~4,50 nm.
Oppervlaktemorfologie en het mechanisme over de invloed van de afzettingsdruk op het ionenbombardement
Naast de structurele analyse door Raman-spectroscopie, werd de morfologie van de monsters ook gekarakteriseerd door AFM, zoals weergegeven in Fig. 3. Om de ruwheidsevolutie van de filmoppervlakken te detecteren, werd het wortelgemiddelde vierkant (RMS) als functie van de depositiedruk weergegeven in Fig. 3h (RMS-waarde werd gemiddeld over verschillende locaties in elke film). In Fig. 3h neemt de RMS af naarmate de depositiedruk toeneemt. De toenemende druk veroorzaakt een verergerde botsing tussen deeltjes en het daaropvolgende verlies van kinetische energie wanneer deze deeltjes het filmgroeiende oppervlak bereiken. Ionen met lagere energie die aankomen op het filmgroeiende oppervlak leiden tot een zwakker ionenbombardement. Het suggereert dat de toenemende druk gunstig is voor het onderdrukken van het ionenbombardement, dat ook in het vorige rapport is genoemd [7]. Het mechanisme over de invloed van de depositiedruk op het ionenbombardement is echter niet aangetoond. Het zal als volgt worden onderzocht.

AFM-beelden van nc-Si:H dunne films die een verandering van de oppervlaktemorfologie door verschillende depositiedrukken laten zien. een 150 Pa, b 300 Pa, c 450 Pa, d 600 Pa, e 750 Pa, f 900 Pa en g 1050 Pa. De kraters in a en b worden gemarkeerd door gestippelde cirkels en RMS-ruwheid van filmoppervlakken onder verschillende depositiedrukken gemarkeerd als h
De potentiaalverdeling tussen de twee elektroden kan in drie gebieden worden verdeeld:plasmagebied in het midden, anodemantel en kathodemantel (zie figuur 1b). De ionen die tot ionenbombardement leiden, moeten uit het plasmagebied diffunderen en door de anodemantel gaan. Het potentieel van plasma is hoger dan dat van andere secties van de reactor omdat elektronen sneller diffunderen dan ionen. Omdat onze reactorwand geaard is, is de potentiaal van plasma positief (zie figuur 1). Anionen worden dus gevangen in het plasmagebied; alleen de neutrale deeltjes en kationen kunnen naar de anodemantel diffunderen en uiteindelijk het filmgroeiende oppervlak bereiken. Met andere woorden, het ionenbombardement in ons experiment wordt alleen veroorzaakt door kationen. Kationen passeren de anodemantel zonder botsing, aangezien de breedte van de mantel erg klein is (het bewijs in detail wordt getoond in aanvullend bestand 1). Hierdoor worden kationen pas versneld door het elektrische veld van de anodemantel wanneer ze de mantel binnenkomen. Daarom hangt de sterkte van het ionenbombardement alleen af van de beginsnelheid van kationen wanneer ze net de anodemantel binnenkomen (v 0 ) en de mate van versnelling door het elektrische veld van de anodemantel daarna.
Ten eerste de correlatie van v 0 met de depositiedruk zal worden geanalyseerd. Deeltjes inclusief kationen verliezen hun kinetische energie in het plasmagebied als gevolg van de verzwarende botsing wanneer de depositiedruk toeneemt. Dus, v 0 neemt af naarmate de druk toeneemt. Vervolgens zal de variatie in de mate van versnelling door het elektrische veld van de mantel met de depositiedruk worden aangetoond. Het is bekend dat [22]:
$$ {V}_p-{V}_f=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$waar m e is de massa van het elektron; m ik is de massa van ionen; T e en T ik zijn respectievelijk de temperatuur van elektron en ion; V p is de plasmapotentiaal; en V f is de drijvende potentiaal. Terwijl het substraat in onze reactor hangt, wordt de spanning van de anodemantel, V schede is gelijk aan V p − V f , dan hebben we:
$$ {V}_{\mathrm{schede}}=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$ (6)In het plasmagebied, T e neemt af naarmate toenemende depositiedruk de botsing tussen de deeltjes (inclusief elektronen en ionen) verergert. Hsieh et al. hebben aangetoond dat T e neemt af met de toenemende depositiedruk door de OES-meting [20]. Dit suggereert dat de trend van T e door onze theoretische analyse is absoluut correct. Vergeleken met T e , T ik neemt zo weinig af dat het als onveranderd kan worden beschouwd. Als resultaat, V schede neemt af wanneer de druk toeneemt volgens formule (6). Het verzwakt de mate van versnelling door de anodemantel. In combinatie met vallende v 0 , kunnen we een conclusie trekken dat de kinetische energie van kationen die het filmgroeiende oppervlak bereiken veel kleiner wordt wanneer de druk toeneemt. Met andere woorden, toenemende depositiedruk maakt het ionenbombardement zwakker. Daarom blijft de RMS van het filmoppervlak dalen van 150 naar 1050 Pa. Volgens het vorige rapport, hoe lager de ionenenergie, hoe beter de kristalliniteit [7]. Het ondersteunt ook de conclusie over de correlatie tussen kristalliniteit en depositiedruk die we al hebben getrokken. Bovendien zijn de filmoppervlakken die onder veel lagere drukken (150 Pa en 300 Pa) worden afgezet, ruwer, en we kunnen ook zien dat deze oppervlakken veel kraters bevatten, zoals weergegeven in Fig. 4a, b. Dat is het gevolg van een sterk ionenbombardement. Volgens Fig. 3 kunnen we blijkbaar concluderen dat de film die is afgezet onder 450 Pa het meest compact is (vooral weergegeven in Fig. 5c en 6d) en uniform.
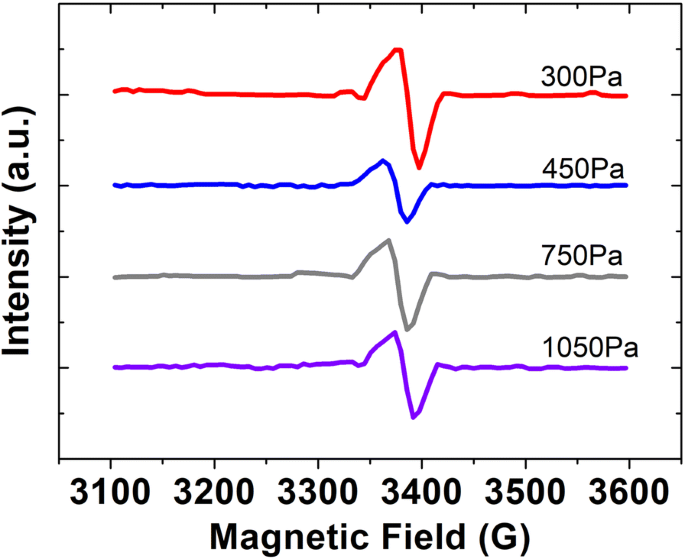
De ESR-spectra van typische monsters die zijn afgezet onder 300 Pa, 450 Pa, 750 Pa, 1050 Pa
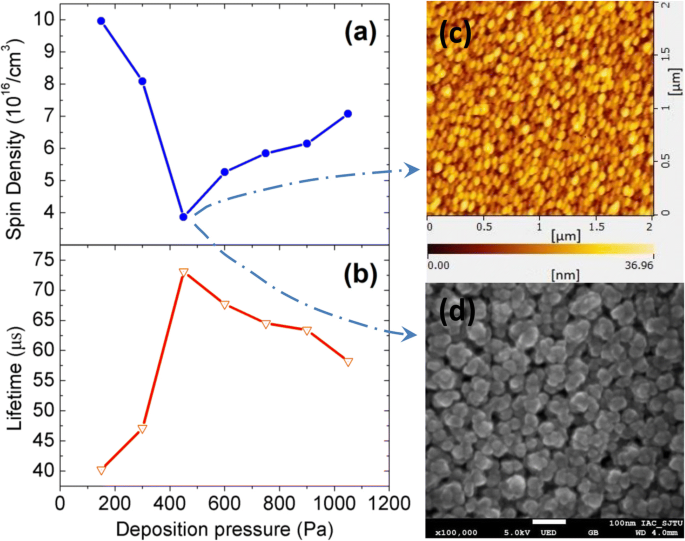
Afhankelijkheid van spindichtheid (a ) en effectieve levensduur van minderheidsmaatschappijen (b ) op verschillende depositiedrukken. Het AFM-beeld met hoge resolutie (c ) en SEM-afbeelding (d ) van nc-Si:H dunne film afgezet onder 450 Pa

Schematisch diagram van deeltjesdiffusie op het groeioppervlak
Defectdichtheid en elektrische eigenschappen
Het effect van de depositiedruk op de defectdichtheid van nc-Si:H dunne film werd onderzocht met ESR-techniek. Figuur 4 toont de vier ESR-spectra van typische monsters die werden afgezet onder respectievelijk 300 Pa, 450 Pa, 750 Pa, 1050 Pa. De gegevens van figuur 5a worden berekend uit het ESR-spectrum van elk monster. Zoals getoond in figuur 5a, wanneer de druk toeneemt, neemt de spindichtheid eerst af en vervolgens toe. Er is een minimum van 450 Pa. Volgens het ESR-principe is het aantal ongepaarde spins recht evenredig met de dichtheid van neutrale bungelende bindingen. Deze bindingen bevinden zich meestal in het filmgroeiende oppervlak en vormen het stationaire defect van het filmgroeiende oppervlak, terwijl de defectdichtheid in de resulterende film in wezen wordt bepaald door deze stationaire defectdichtheid [26]. Daarom zijn de uit de ESR-spectra berekende resultaten inderdaad de defectdichtheid van de resulterende film. Deze resultaten in Fig. 5a laten zien dat de defectdichtheid in nc-Si:H een minimum bereikt bij 450 Pa, wat 3.766 × 10 16 is. cm −3 . Chowdhury et al. bestudeerde hoe nc-Si:H met lage defectdichtheid kon worden gefabriceerd. Toen ze 13,56 MHz RF-bron gebruikten, deden ze hun best om de lage defectdichtheid te bereiken. De waarden waren 1.1 × 10 17 en 7,0 × 10 16 cm −3 . Toen ze een zeer hoge frequentie (VHF) excitatiebron (54,24 MHz) gebruikten, bereikten ze de laagste defectdichtheid van 4,3 × 10 16 cm −3 [10]. Het is bekend dat de ionenenergie in VHF-plasma laag is en dat de dichtheid van de ionenstroom hoog is. Vanwege deze twee factoren heeft de dunne film die door VHF-PECVD is afgezet een lage defectdichtheid en is dus van hoge kwaliteit [27]. De defectdichtheid is echter hoger dan die van ons, en de excitatiebron van 54,24 MHz is veel duurder dan zijn tegenhanger van 13,56 MHz. Om een lage defectdichtheid te bereiken, hebben Wen et al. extra toegepaste DC-bias. Het minimum is echter 4,0 × 10 16 cm −3 [9]. Het vinden van een geschikt RF-vermogen is niet eenvoudig, laat staan een geschikte DC-bias. De reden is dat de DC-bias moet worden afgestemd zodra het RF-vermogen is gewijzigd. Anders kan de DC-bias het ionenbombardement niet effectief verlichten. Daarentegen is onze methode eenvoudig. Onlangs hebben Jadhavar et al. hebben een hoogwaardige nc-Si:H gedeponeerd door PECVD met een lage defectdichtheid. De defectdichtheid is ongeveer 8,75 × 10 16 cm −3 [5]. Daarom is onze methode om een dunne film met een lage defectdichtheid te bereiken handig en effectief. Rekening houdend met het feit dat hoe lager de defectdichtheid is, hoe hoger de levensduur van de minderheidsdrager zou moeten zijn, hebben we de meting van de levensduur van de minderheidsdrager rechtstreeks uitgevoerd. Zoals getoond in figuur 5b, bereikt de effectieve levensduur van minderheidsdragers zijn maximum bij 450 Pa. De trend van de levensduur van minderheidsdragers synchroniseert met die van de defectdichtheid berekend uit de ESR-spectra. Hieruit blijkt dat de defectdichtheid van de films absoluut kan worden gemeten door ESR.
Relatie tussen ionenbombardement en defectdichtheid
Toenemende druk kan het ionenbombardement onderdrukken. In zekere zin zou de defectdichtheid continu moeten dalen van 150 naar 1050 Pa. In feite neemt het af en neemt vervolgens toe. Er is nog een factor die niet mag worden genegeerd:de diffusie van H en SiH3 (in het plasma is de belangrijkste filmprecursor SiH3 [26]). Het schematische diagram van deeltjesdiffusie op het groeioppervlak wordt getoond in Fig. 6. Van 150 tot 1050 Pa neemt de kinetische energie van deeltjes af. Het ionenbombardement wordt zeker steeds lager. De kinetische energie van deeltjes neemt echter aanzienlijk af van 450 tot 1050 Pa vanwege de toenemende botsingsfrequentie van deeltjes. De atomaire waterstof, die de sleutel is tot de afzetting van hoogwaardig nc-Si:H, verliest zijn kinetische energie zo veel dat het niet verder kan diffunderen om meer bungelende bindingen te verzadigen, laat staan dat de dichtheid begint af te nemen, wat wordt getoond in de "Structureel onderzoek door Raman-analyse." Aan de andere kant verliezen deeltjes, waaronder atomaire waterstof, hun kinetische energie dramatisch, zodat ze niet meer energie kunnen overbrengen naar het groeioppervlak. Dus de diffusielengte van SiH3 voorloper kan niet worden verbeterd. Het is bekend dat als SiH3 geabsorbeerd aan het oppervlak de energetisch gunstige groeiplaatsen zou kunnen vinden, wordt een atomair meer geordende structuur gevormd. Maar nu, SiH3 heeft niet genoeg diffusielengte om hun energetisch gunstige groeiplaatsen te vinden. Daarom kan de geordende structuur niet worden gevormd. Met andere woorden, de afgezette film heeft meer gebreken. Als resultaat begint de spindichtheid in Fig. 5a daarentegen te stijgen vanaf 450 Pa. Het is echter vermeldenswaard dat de spindichtheden van 600 tot 1050 Pa nog steeds lager zijn dan die van 150 tot 300 Pa. Het is het resultaat van het zwakkere ionenbombardement. Bovendien, als gevolg van de verminderde diffusielengte, SiH3 voorloper heeft de neiging zich op te stapelen om aggregaten te vormen. Zoals getoond in Fig. 3, begonnen aggregaten te verschijnen bij 750 Pa, en ze agglomereerden geleidelijk intensief toen de depositiedruk bleef toenemen. Volgens de bovenstaande punten is het ionenbombardement niet hoe zwakker hoe beter voor de filmgroei. De mate van ionenbombardement moet geschikt zijn.
Defectdichtheid:het belangrijkste kenmerk van nc-Si:H fotovoltaïsch materiaal
Kristalliniteit en defectdichtheid zijn beide kenmerken van nc-Si:H-zonnecelmaterialen. De eerste neemt toe met de depositiedruk. In zekere zin zou dat laatste moeten blijven dalen. Dat is echter niet het geval. Volgens de Raman-karakterisering is, hoewel de kristalliniteit toeneemt, de variatie van de korrelgrootte erg klein (4,07-4,50 nm). Het geeft aan dat alleen het aantal korrels toeneemt, niet de grootte van de korrels. In deze omstandigheden stijgt het volume van de korrelgrenzen. Het is bekend dat korrelgrenzen bulkdefecten en recombinatiecentra zijn. Meer korrelgrenzen zullen de defectdichtheid verhogen. Wanneer de kristalliniteit tot een bepaald niveau stijgt, overwint het negatieve effect van een toename van het korrelgrensvolume op de defectdichtheid het positieve effect van het stijgende aantal korrels. Daarom blijft de defectdichtheid niet afnemen naarmate de kristalliniteit toeneemt; integendeel, het stijgt nadat de kristalliniteit een bepaald niveau heeft bereikt. Dit resultaat suggereert dat nc-Si:H dunne films met een hogere kristalliniteit niet noodzakelijk een betere kwaliteit hebben, wat wordt bevestigd door een andere onderzoeksgroep. In de afgelopen jaren is gemeld dat de optimale nc-Si:H-laag voor zonnecellen wordt verkregen nabij de faseovergangsgrens, dat wil zeggen dat het optimum wordt verkregen net na de a-Si:H-naar-nc-Si:H overgang. De kristalliniteit van optimale nc-Si:H-lagen is niet hoog [28,29,30]. Mukhopadhyay et al. hebben verder aangetoond dat nc-Si:H-lagen met een hoge kristalliniteit, en dus een lage door licht geïnduceerde degradatie, geen zonnecellen van hoge kwaliteit produceren. De gestabiliseerde efficiëntie van cellen die zijn afgezet net na de a-Si:H-naar-nc-Si:H-overgang is hoger dan die van cellen waarin de i-laag een hoge kristalliniteit heeft, hoewel de eerste meer degradeert dan de laatste vóór stabilisatie [31]. Han et al. hebben verder bewezen dat door licht geïnduceerde afbraak van de nc-Si:H-laag wordt geïntroduceerd door de vorming van metastabiele bungelende bindingen. Terwijl de door licht geïnduceerde structurele verandering een voorloperproces is van de vorming van metastabiele bungelende bindingen [30]. De metastabiele bungelende binding is een van de defecten [32]. Daarom is het belangrijkste kenmerk van hoogwaardige nc-Si:H fotovoltaïsche materialen de defectdichtheid in plaats van kristalliniteit, lichtstabiliteit of andere kenmerken.
Conclusies
nc-Si:H dunne films werden afgezet door de druk te variëren tussen 150 en 1050 Pa. Het bereik van depositiedruk is hoger dan de conventionele depositie in het PECVD-proces. Gebleken is dat de kristalliniteit toeneemt en de ruwheid van de filmoppervlakken afneemt met een toename van de depositiedruk. De gemiddelde korrelgrootte d = 4,07~4,50 nm. Verder hebben we ons gericht op de invloed van depositiedruk, niet alleen op de macroscopische of gebruikelijke eigenschappen van monsters, maar ook op de defectdichtheid en de levensduur van minderheidsdragers, die belangrijkere kenmerken zijn. Het blijkt dat de defectdichtheid van monsters eerst afneemt en vervolgens toeneemt wanneer de depositiedruk stijgt. De defectdichtheid bereikt zijn minimum (3.766 × 10 16 cm −3 ) bij 450 Pa. Het is lager dan dat van de eerdere onderzoeken naar de fabricage van nc-Si:H dunne films met lage defectdichtheid. Dit werk biedt een handige en effectieve manier om nc-Si:H met een lage defectdichtheid door PECVD te deponeren. En we hebben het mechanisme aangetoond over het effect van depositiedruk op het ionenbombardement. Bovendien is bewezen dat het ionenbombardement niet des te zwakker is, des te beter voor de filmgroei. De mate van ionenbombardement moet geschikt zijn.
Afkortingen
- AFM:
-
Atoomkrachtmicroscoop
- DC:
-
Gelijkstroom
- H:
-
Atoomwaterstof
- nc-Si:H:
-
Gehydrogeneerd nanokristallijn silicium
- PECVD:
-
Plasma-versterkte chemische dampafzetting
- SEM:
-
Scanning elektronenmicroscopie
- VHF:
-
Zeer hoge frequentie
Nanomaterialen
- Mesh huidige methode en analyse
- C# abstracte klasse en methode
- C# Gedeeltelijke klasse en gedeeltelijke methode
- C# verzegelde klasse en methode
- Antifog pc-film voor vizieren, lenzen en brillen
- Java String Replace(), ReplaceAll() en ReplaceFirst() methode
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- Een efficiënt en effectief ontwerp van InP-nanodraden voor maximale oogst van zonne-energie
- Vervaardiging van SrGe2 dunne films op Ge (100), (110) en (111) substraten
- Voorbereiding en optische eigenschappen van GeBi-films met behulp van de moleculaire straal-epitaxiemethode
- Snelle gereedschapsservice en de effectieve toepassingen ervan



