Temperatuurafhankelijke HfO2/Si-interface structurele evolutie en zijn mechanisme
Abstract
In dit werk wordt hafniumoxide (HfO2 ) dunne films worden afgezet op p-type Si-substraten door afzetting van een atomaire laag op afstand op p-type Si bij 250 ° C, gevolgd door een snelle thermische annealing in stikstof. Effect van de temperatuur na het gloeien op de kristallisatie van HfO2 films en HfO2 /Si-interfaces worden onderzocht. De kristallisatie van de HfO2 films en HfO2 /Si-interface wordt bestudeerd door veldemissietransmissie-elektronenmicroscopie, röntgenfoto-elektronspectroscopie, röntgendiffractie en atoomkrachtmicroscopie. De experimentele resultaten laten zien dat tijdens het gloeien de zuurstof uit HfO2 naar Si-interface. Voor gloeitemperaturen onder 400 °C, de HfO2 film en grenslaag zijn amorf en de laatste bestaat uit HfO2 en siliciumdioxide (SiO2 ). Bij een gloeitemperatuur van 450-550 °C is de HfO2 film wordt meerfasig polykristallijn en een kristallijn SiO2 is te vinden op de interface. Ten slotte, bij een gloeitemperatuur boven 550 ° C, de HfO2 film wordt gedomineerd door eenfasig polykristallijn en de grenslaag is volledig getransformeerd in kristallijn SiO2 .
Inleiding
Hafniumoxide (HfO2 ) dunne film is een interessant materiaal voor tal van toepassingen. Het kan worden gebruikt in meerlaagse optische coating [1], beschermende coating [2], poortdiëlektricum [3], passiverende laag [4,5,6], enzovoort vanwege zijn uitstekende eigenschappen, zoals hoge dichtheid, hoge breking index, brede bandafstand en relatief hoge thermische stabiliteit. Er zijn veel methoden gebruikt om HfO2 . voor te bereiden dunne film, zoals elektronenstraalverdamping [7], depositie van chemische oplossingen [8], reactief sputteren [9], metaal-organische chemische dampdepositie [10], moleculaire bundelepitaxie [11] en atoomlaagafzetting (ALD). ALD is een veelbelovende methode voor het verkrijgen van dunne films met zowel een zeer nauwkeurige dikteregeling als een hoge nauwkeurigheidsuniformiteit. Post-annealing blijkt een significante invloed te hebben op ALD HfO2 films [12,13,14,15]. Volgens het onderzoek, HfO2 dunne films kunnen kristalliseren bij een uitgloeitemperatuur hoger dan 500 °C [16,17,18]. De kristallijne structuur van HfO2 heeft een sterke invloed op optische en elektrische eigenschappen. Bijvoorbeeld de structurele verandering van HfO2 van amorfe naar monokliene kristallijne fase zou kunnen leiden tot veranderingen in de brekingsindex van 1,7 tot 2,09, optische opening van 5,75 tot 6,13 eV en diëlektrische constante van 24,5 tot 14,49 [19, 20]. Voor ALD HfO2 afgezet op siliciumsubstraten, wordt meestal een oxidelaag waargenomen bij HfO2 /Si-interface [21, 22]. De aanwezigheid van deze grenslaag zou de diëlektrische constante verlagen [22]. Bovendien, Kopani et al. [23] presenteerde de structurele eigenschappen van 5-nm HfO2 films na salpeterzuuroxidatie van n-gedoteerde Si-substraten. Ze ontdekten dat een hoge uitgloeitemperatuur de groeisnelheid van kristallijne kernen verhoogt. Hun kristallisatie-eigenschappen, met name HfO2 /substrate-interface zijn nauwelijks bestudeerd. Daarom beïnvloedt de gloeitemperatuur de kristallisatie-eigenschappen van HfO2 dunne films gemaakt door ALD waren de moeite waard voor verder onderzoek.
In dit werk, de HfO2 dunne films werden vervaardigd door een atomaire laagafzetting op afstand (RP-ALD) op p-type siliciumsubstraten. Nagloeien werd uitgevoerd door een snel thermisch uitgloeisysteem (RTA) bij verschillende temperaturen. De structurele veranderingen en kristallisatie-eigenschappen van HfO2 dunne films door RTA werden gekarakteriseerd door atoomkrachtmicroscopie (AFM), grazing incident röntgendiffractie (GIXRD), röntgenfoto-elektronspectroscopie (XPS) en transmissie-elektronenmicroscopie met hoge resolutie (HR-TEM). De temperatuurafhankelijke HfO2 De structurele evolutie van de /Si-interface en het mechanisme ervan worden ook onderzocht.
Methode
Dubbelzijdig gepolijste (100) georiënteerde p-type 2-inch 250 μm Czochralski Si-wafels met een soortelijke weerstand van 30 cm werden gebruikt. Voorafgaand aan de afzetting werden Si-wafels gereinigd met een standaard Radio Corporation of America-methode, gevolgd door dompelen in verdunde fluorwaterstofzuuroplossing (5%) gedurende 2 min om mogelijke verdwaalde oxiden te verwijderen zonder de laatste spoeling met water. Na reiniging werden alle wafels gedroogd met zuivere stikstof (N2 ) gas en gemonteerd op de substraathouder. Ongeveer 15 nm HfO2 (168 ALD-cycli) dunne films werden afgezet op Si-wafels door RP-ALD (Picosun R-200, Finland) met behulp van tetrakis (ethylmethylamino) hafnium (TEMAH) en zuurstof (O2 ) in afwisselende puls met N2 zuivering van de reactiekamer tussen pulsen. De TEMAH en O2 plasma werd in de volgende volgorde in de reactor gepulseerd:TEMAH-puls 1,6 s; N2 zuiver 10 s; O2 plasmapuls 10 s, en N2 zuiver 12 s. Na het deponeren van de HfO2 dunne films, het snelle thermische gloeien werd uitgevoerd in N2 omgevingstemperatuur gedurende 10 min. De uitgloeitemperaturen werden gevarieerd van 400 tot 600 °C om het effect op de kristallisatie van het HfO2 te onderzoeken. dunne films en HfO2 /Si-interface. Tabel 1 geeft een overzicht van de typische omstandigheden van RPALD en nagloeien.
AFM-metingen werden uitgevoerd in tikkende modus voor het onderzoeken van de oppervlaktemorfologie van de HfO2 dunne films. De AFM-afbeeldingen die in dit werk worden getoond, zijn scans van 2 μm × 2 μm met een resolutie van 256 punten × 256 lijnen. De structuur van HfO2 films werden gekenmerkt door grazende invallende röntgendiffractie (GIXRD, Rigaku TTRAXIII, Japan) metingen met een Cu long-fine-focus röntgenbuis. Röntgenstralen met een golflengte van 0,154 nm werden geproduceerd bij een bedrijfsspanning van 50 kV en een stroomsterkte van 300 mA. Er werd een invalshoek van 0,5° gekozen om diffractiepatronen te verkrijgen over een 2θ bereik van 20-60°. Röntgenfoto-elektronspectroscopie (XPS, Thermo Fisher K-alpha) werd ook uitgevoerd met behulp van monochromatische Al Kα-röntgenstraling (hν = 1486.6 eV). Voor de XPS-analyse werd een vlek met een diameter van 100 m gebruikt en werden foto-elektronen verzameld onder een starthoek van 45°. De doorsneden van de HfO2 dunne films werden bereid door een gefocusseerde ionenbundel-lift-out-techniek in een Hitachi NX2OOO-systeem. De dwarsdoorsnedebeelden van de HfO2 dunne films werden onderzocht met een veldemissie transmissie-elektronenmicroscopie met hoge resolutie (HR-TEM, JEM-2100F, VS).
Resultaten en discussie
Afbeelding 1 toont de AFM-afbeeldingen voor de HfO2 films gegloeid bij verschillende temperaturen. De waarden van het wortel-gemiddelde-kwadraat (RMS) en de gemiddelde oppervlakteruwheid (Ra) worden weergegeven om de oppervlakteruwheid aan te geven. De RMS-waarde is 0,44 nm voor de film zoals gedeponeerd. Het neemt iets toe tot 0,47 nm wanneer de gloeitemperatuur stijgt tot 500 °C. Verdere verhoging van de gloeitemperatuur tot 600 °C leidt tot een significante verbetering van de oppervlakteruwheid met een RMS die stijgt tot 0,69 nm. Dezelfde tendens wordt waargenomen in Ra-waarden. De toename van de oppervlakteruwheid van de gegloeide films zou een structurele verandering kunnen afleiden.
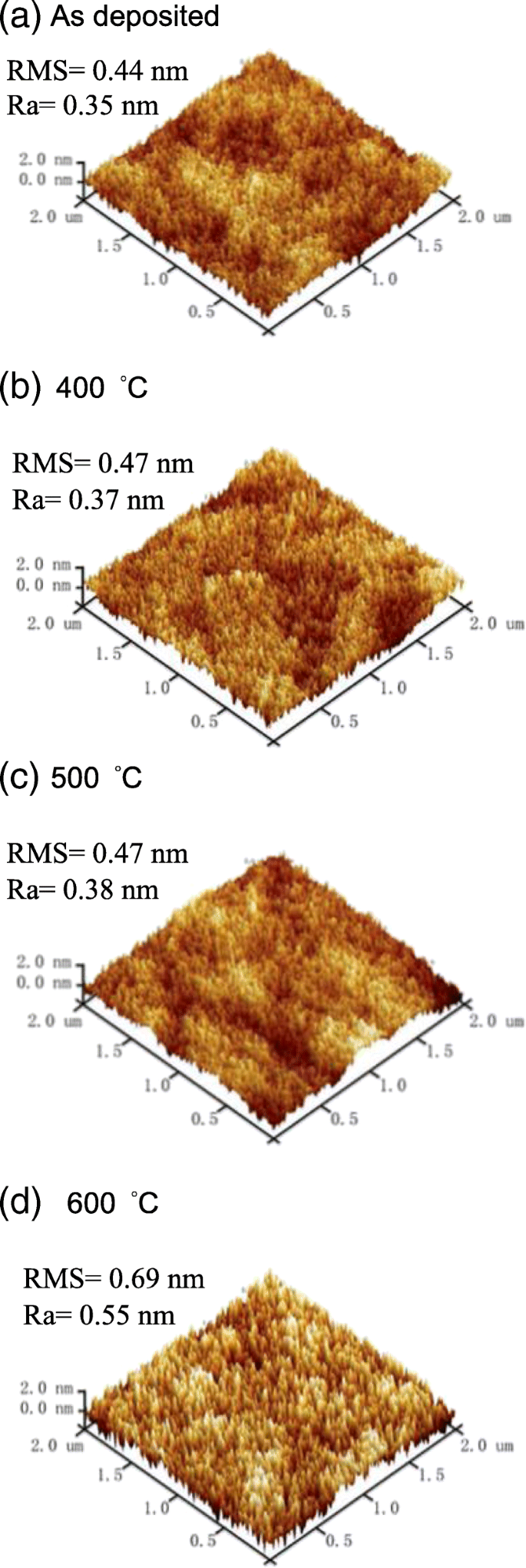
AFM-beelden van a zoals gedeponeerd, b 400 °C-gegloeid, c 500 °C-gegloeid, en d 600 °C-gegloeid HfO2 films
Afbeelding 2 toont de temperatuurafhankelijke GIXRD-spectra van verschillende HfO2 dunne films. De als gedeponeerde HfO2 films is amorf en blijft amorf na gloeien bij 400 en 450 °C. Bij een uitgloeitemperatuur hoger dan 500 °C verschijnen diffractiepieken, wat wijst op de vorming van kristallijn HfO2 . De pieken bij 1/d = 0.319 en 0.354 Å −1 komen overeen met respectievelijk de − 111- en 111-vlakken van de monokliene fase (ICDD PDF#34-0104, ruimtegroep P21/c). De piek bij 1/d = 0.340 Å −1 komt overeen met het (111) vlak van de orthorhombische fase (ICDD PDF#21-0904, ruimtegroep Pbcm). Andere pieken in de buurt van 1/d = 0.380~0.395 zijn de 200, 020 en 002 vlakken van de monokliene en het 020 vlak van de orthorhombische fasen. De resultaten laten ook zien dat de monokliene fase afneemt en de orthorhombische fasen toenemen met de gloeitemperatuur. De orthorhombische HfO2 domineert de kristallijne structuur bij hogere gloeitemperaturen. De diffractiepieken van orthorhombische HfO2 werden waargenomen bij een lagere 1/d (een kleinere d-afstand) in vergelijking met die in de ICDD PDF#21-0904. Bovendien is de verschuiving van 1/d = 0.340 Å −1 naar een hogere waarde geeft aan dat de d-afstand afneemt met de gloeitemperatuur.
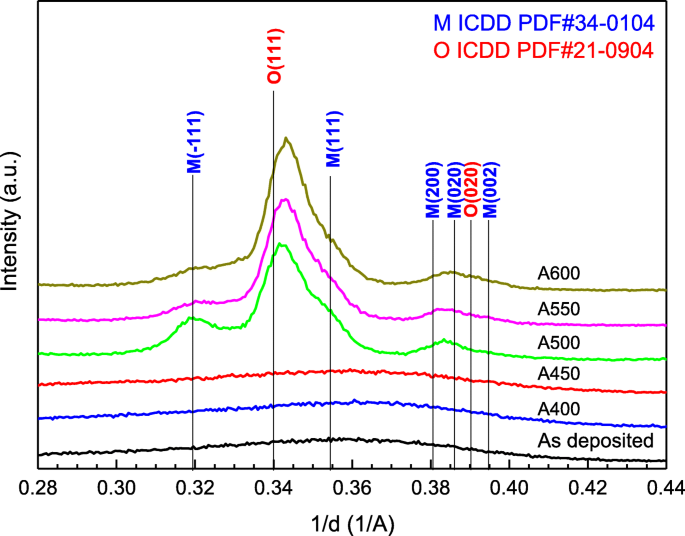
GIXRD-spectra van HfO2 dunne films gegloeid bij verschillende temperaturen
De concentraties van Hf en O binnen de HfO2 films werden gemeten met behulp van dieptegeprofileerde XPS. Afbeelding 3 toont de O/Hf-samenstellingsverhouding van de afgezette en nagegloeide HfO2 films. De O/Hf-verhouding neemt af van 1,60 naar 1,29 met de gloeitemperatuur. Vanwege het gebruik van N2 tijdens het gloeien, de HfO2 wordt zuurstofarm met de temperatuur. De zuurstofarme HfO2 film resulteert ook in een kleinere d-afstand zoals eerder vermeld.

Atomaire verhouding van zuurstof tot hafnium voor HfO2 dunne films gegloeid bij verschillende temperaturen
Afbeelding 4a, b, c, d, e en f tonen de HR-TEM-afbeeldingen in dwarsdoorsnede met hoge resolutie van als gedeponeerde 400 °C-, 450 °C-, 500 °C-, 550 °C- en 600 °C-gegloeid HfO2 dunne films op Si-substraten, respectievelijk. Het is te zien dat de HfO2 laag en Si-substraat zijn duidelijk te zien in deze afbeeldingen. Bovendien een dunne laag met een dikte van 1–2 nm tussen HfO2 en Si-substraat zou de SiO2 . kunnen zijn film. Zoals getoond in Fig. 4a, is er geen duidelijke roosteropstelling in de zoals gedeponeerde HfO2 film, wat aangeeft dat deze film amorf is. Na gloeien bij 400 °C, hoewel de meeste regio's van HfO2 film nog steeds amorf zijn, kunnen we zien dat een fractie van roosterarrangementen met de d-afstandswaarden van 2,82 en 3,12 A in deze film wordt gevormd. Deze twee d-afstandwaarden zijn geïndexeerd op monokliene HfO2 (111) en monokliene HfO2 (− 111) vlakken, respectievelijk, en de 400 °C-uitgegloeide film toont de nanokristallijne structuur. Met het verhogen van de gloeitemperatuur van 400 naar 600 °C, wordt de kristalkwaliteit van HfO2 film wordt geleidelijk verbeterd. Wanneer de HfO2 film wordt uitgegloeid bij 500–550 °C, de belangrijkste roosterrangschikkingen bestaan uit monokliene HfO2 (− 111), monokliene HfO2 (200), en orthorhombische HfO2 (111) kan worden geïdentificeerd. Door de gloeitemperatuur echter verder te verhogen tot 600 °C, wordt de roosterstructuur van orthorhombische HfO2 (111) bestaat nog steeds in de film en de andere twee roosterarrangementen verdwijnen geleidelijk. Aan de andere kant zijn de d-afstandswaarden van orthorhombische HfO2 (111) vlakken voor de 500 °C-, 550 °C- en 600 °C-gegloeide HfO2 films worden bepaald op respectievelijk 2,93, 2,90 en 2,88 A. Dit komt goed overeen met het XRD-resultaat dat de orthorhombische HfO2 (111) diffractiepiek verschuift naar de richting van de hoge hoek met toenemende gloeitemperatuur van 500 tot 600 °C. Het resultaat laat zien dat het zuurstofgehalte van HfO2 film neemt geleidelijk af naarmate de gloeitemperatuur wordt verhoogd. Het andere interessante fenomeen is te vinden in de veranderingen van de kristalstructuur en dikte van de SiO2 laag. In de gedeponeerde toestand is de SiO2 laag is amorf. Zelfs als het monster wordt uitgegloeid bij 400 ° C, is de thermische energie niet hoog genoeg om de structuur van SiO2 te transformeren laag van amorf naar kristallijn. Desalniettemin, door de gloeitemperatuur te verhogen van 450 naar 600 °C, wordt het kristallijne SiO2 laag (met de kubische SiO2 (220) structuur) wordt gevormd en de dikte neemt toe van 1,0 tot 1,6 nm. Opgemerkt kan worden dat het amorfe SiO2 laag transformeert volledig naar kubieke SiO2 structuur na gloeien van het monster bij 600 °C. Met een toename van de gloeitemperatuur van 550 tot 600 ° C, de d-afstandswaarde van kubieke SiO2 (220) stijgt van 2,48 naar 2,56 Å. Dit betekent dat het zuurstofgehalte van SiO2 laag neemt toe door de gloeitemperatuur te verhogen. Er kan redelijkerwijs worden gespeculeerd dat de toevoeging van zuurstofgehalte in de SiO2 laag wordt toegeschreven aan de diffusie van zuurstofatomen afkomstig van de HfO2 film. Bovendien neemt de totale dikte af voor de gloeitemperatuur van 550 en 600 °C en kan dit verband houden met de toename van de filmdichtheid veroorzaakt door kristallisatie en waterstofverwijdering.
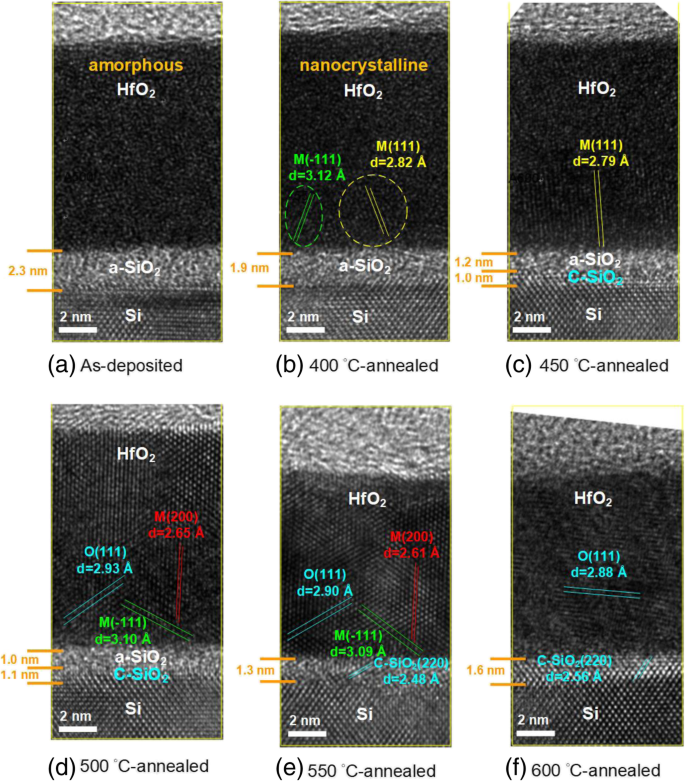
Transversale TEM-afbeeldingen van a zoals gedeponeerd, b 400 °C-gegloeid, c 450 °C-gegloeid, d 500 °C-gegloeid, e 550 °C-gegloeid, en f 600 °C-gegloeid HfO2 /Si
Op basis van de bovenstaande resultaten illustreert figuur 5 de mechanismen van de HfO2 films met verschillende gloeitemperaturen. Aangezien de uitgloeitemperatuur lager is dan 400 ° C (figuur 5a), is de film amorf waarbij de Hf- en O-atomen willekeurig zijn gerangschikt. De grenslaag tussen HfO2 en c-Si-wafel is een gemengd oxide dat bestaat uit a-SiO2 en a-HfO2 . Bij een gloeitemperatuur van 450–550 °C (Fig. 5b) zal de HfO2 film ontvangt thermische energie die leidt tot een structurele verandering van amorf naar polykristallijn met monokliene en orthorhombische fasen. De kristallijne oriëntatie en d-afstand worden aangegeven volgens de HR-TEM- en GIXRD-resultaten. Een kristallijn SiO2 laag wordt gevormd. Verschillende werken rapporteerden een geordende siliciumoxidelaag op het grensvlak van a-SiO2 en (100) c-Si, maar het mechanisme en de structuur op atomaire schaal zijn controversieel gebleven. Thermische oxidatie van silicium kan worden beschouwd als opeenvolgende invoegbewerkingen van zuurstofatomen in Si-Si-bindingen, en dit veroorzaakt een grote accumulatie van compressieve spanningen in de geoxideerde gebieden en zou mogelijk een structurele transformatie in geordend oxide aan de SiO2 kunnen veroorzaken. /sub> /c-Si-interface [24]. Er is ook gemeld dat kristallijne zuurstofbevattende fase zou kunnen worden gevormd onder omstandigheden van hoge zuurstofoververzadiging van Si [25] of een lage dichtheid van het grensvlakdefect [26]. Van de XPS- en TEM-afbeeldingen in dit werk, de HfO2 laag is zuurstofarm. De aanzienlijke hoeveelheden zuurstof diffunderen uit HfO2 richting siliciumsubstraat, en dit kan leiden tot oververzadiging van zuurstof op het c-Si-grensvlak en vorming van kristallijn SiO2 . In dit temperatuurbereik is het kristallijne SiO2 laagdikte zou toenemen, maar de a-HfO2 + a-SiO2 gemengde laagdikte neemt af met toenemende gloeitemperatuur. Bij een gloeitemperatuur hoger dan 550 °C (Fig. 5c) zal de HfO2 structuur wordt gedomineerd door polykristallijne orthorhombische (111) enkele fase. De grenslaag wordt volledig bepaald door kristallijn SiO2 . De d-afstand neemt af voor orthorhombische HfO2 laag en verhogingen voor c-SiO2 . Hoewel het uitgloeien van HfO2 is noodzakelijk voor het bereiken van hoge Si-wafelpassivering en diëlektrische constante, bij hoge temperaturen, de resulterende kristallisatie van de HfO2 en het grensvlak SiO2 kan de filmeigenschappen verminderen. De gloeitemperatuur van 500 °C blijkt de beste diëlektrische constante van 17,2 te verkrijgen. Verdere verhoging van de gloeitemperatuur leidt tot een verlaging van de diëlektrische constante, mogelijk als gevolg van de verandering in de kristallijne fase. Tomida et al. meldde dat de diëlektrische constante van HfO2 neemt af wanneer de structuur transformeert van polykristallijne naar monokliene eenfase [27]. De beste passivering van HfO2 /Si kan ook worden verkregen bij een gloeitemperatuur van 500 °C, omdat hogere temperaturen kunnen leiden tot een volledige c-SiO2 grenslaag en dehydrogenering op het grensvlak.
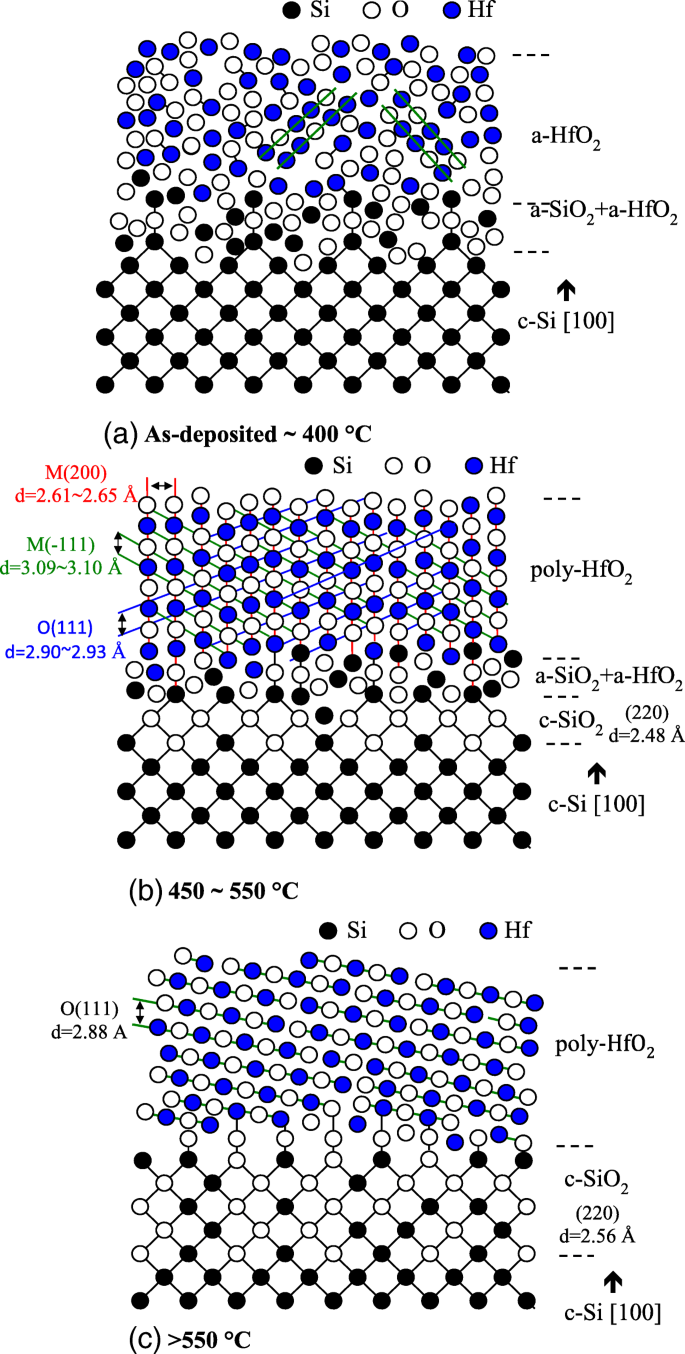
Diagrammen van het mechanisme van kristallisatie van HfO2 films en grenslaag in het temperatuurbereik a zoals gedeponeerd tot 400 °C, b 450 tot 550 °C, en c boven 550 °C. De d-afstandswaarde en kristallijne oriëntatie worden ook aangegeven
Conclusie
HfO2 films worden bereid met behulp van RP-ALD en het effect van de gloeitemperatuur op de kristallijne structuur van de HfO2 is onderzocht. Voor als gedeponeerde HfO2 en dat gloeide onder 400 °C, de HfO2 en de grenslaag zijn amorf. Bij toenemende gloeitemperatuur neemt de d-afstand van orthorhombische af, terwijl die van de c-SiO2 grenslaag neemt toe, wat wijst op de zuurstofdiffusie van HfO2 naar Si-interface. Onthardingstemperatuur hoger dan 550 °C toont een HfO2 laag met polykristallijn orthorhombisch enkelfasig, en de grenslaag transformeert volledig naar c-SiO2 . Hoewel gloeien vereist is voor HfO2 in veel toepassingen, zoals het bereiken van een hoge passivering van Si-wafels en een hoge diëlektrische constante, zou de kristallisatie schadelijk kunnen zijn voor de filmeigenschappen. De gloeitemperatuur van 500 °C kan de beste Si-wafelpassiveringskwaliteit en diëlektrische constante hebben.
Afkortingen
- AFM:
-
Atoomkrachtmicroscopie
- a-HfO2 :
-
Amorf hafniumoxide
- ALD:
-
Atoomlaagafzetting
- a-SiO2 :
-
Amorf siliciumdioxide
- c-SiO2 :
-
Kristallijn siliciumdioxide
- GIXRD:
-
Röntgendiffractie bij grazende incidenten
- HfO2 :
-
Hafniumoxide
- HR-TEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- N2 :
-
Stikstof
- O2 :
-
Zuurstof
- RMS:
-
Wortel-gemiddelde-kwadraat
- RP-ALD:
-
Atomaire laagafzetting op afstand
- RTA:
-
Snel thermisch gloeien
- TEMAH:
-
Tetrakis (ethylmethylamino) hafnium
- XPS:
-
Röntgenfoto-elektronenspectroscopie
Nanomaterialen
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Bereiding van palladium(II)-ion-imprinted polymere nanosferen en de verwijdering van palladium(II) uit waterige oplossing
- Geleidingsmechanisme en verbeterd uithoudingsvermogen in HfO2-gebaseerd RRAM met nitridatiebehandeling
- Vervaardiging van SrGe2 dunne films op Ge (100), (110) en (111) substraten
- De structurele, elektronische en magnetische eigenschappen van Ag n V-clusters (n = 1–12) onderzoeken
- Vervaardiging van CA/TPU spiraalvormige nanovezels en de mechanisme-analyse
- Dikte-afhankelijke magnetische en microgolfresonantiekarakterisering van gecombineerde FeCoBSi-films met streeppatroon
- Een theoretische simulatie van de stralingsreacties van Si, Ge en Si/Ge-superrooster op laag-energetische bestraling
- Gecontroleerde synthese en selectieve adsorptie-eigenschappen van Pr2CuO4-nanobladen:een discussie over het mechanisme
- Toxiciteitsbeoordeling van PEG-PCCL-nanodeeltjes en voorlopig onderzoek naar het antitumoreffect van Paclitaxel-loading



