Co-dosering van ozon en gedeïoniseerd water als oxidatieve voorlopers van ZnO-dunne-filmgroei door afzetting van atoomlagen
Abstract
Kenmerken van door atoomlaagafzetting (ALD) gegroeide ZnO-dunne films op saffiersubstraten met en zonder drie-gepulseerde ozon (O3 ) als oxidant precursor en post-depositie thermische annealing (TA) worden onderzocht. Depositietemperatuur en dikte van ZnO-epillagen zijn respectievelijk 180 ° C en 85 nm. Post-depositie thermisch gloeien wordt uitgevoerd bij 300 °C in de omgeving van zuurstof (O2 ) gedurende 1 uur. Met sterk oxidatiemiddel O3 en na depositie van TA in groeiend ZnO, worden intrinsieke spanning en stress verminderd tot respectievelijk 0,49% en 2,22 GPa, met een extreem lage achtergrondelektronenconcentratie (9,4 × 10 15 cm −3 ). Dit komt voort uit een lagere dichtheid van thermisch geactiveerde defecten in de analyses van thermische uitdoving van de geïntegreerde intensiteit van fotoluminescentie (PL) spectra. TA vergemakkelijkt verder herkristallisatie waarbij meer defectvrije korrels worden gevormd en vermindert vervolgens de spanning en spanningstoestand, wat een opmerkelijke afname van de elektronenconcentratie en verbetering van de oppervlakteruwheid veroorzaakt.
Inleiding
Bij de groei van ZnO worden verschillende oxidatiemiddelen gebruikt. Ze zijn inclusief water (H2 O), waterstofperoxide (H2 O2 ), zuurstof (O2 ), en ozon (O3 ) [1,2,3,4,5,6]. H2 O is een veelgebruikt oxidatiemiddel bij de groei van ZnO met atomaire laagafzetting (ALD). ALD is een laag-voor-laag zelfbeperkend groeimechanisme. Specifieke oppervlakteliganden wisselen reacties uit met opeenvolgende pulsen van respectieve voorlopers. Oppervlaktereacties stoppen en verzadigen wanneer de reactieve plaatsen van het oppervlak volledig zijn uitgeput. ALD-groei van dunne films heeft voordelen zoals superieure conforme afzetting op oppervlakken en zijgebieden, uitstekende stapdekking van randen, hoge uniformiteit over een groot gebied, precisie in laagdiktecontrole en geschikt voor lage depositietemperatuur [7,8,9] .
Sterke oxidatiemiddelen beïnvloeden niet alleen de materiaalstructuren, maar ook de opto-elektrische eigenschappen van ALD-afgezet ZnO. H2 O2 oxidant zorgt voor meer zuurstofrijke omstandigheden dan veelgebruikte H2 O voorloper om defecten zuurstofvacatures te passiveren (VO ) en zink-interstitials (Zni ) in ALD-gegroeide ZnO-films bij lage groeitemperaturen van 80 tot 150 ° C. Kolomvormige oppervlaktemorfologieën met (002) preferentiële oriëntatie van het groeivlak deden zich voor wanneer het gebruik van oxidatiemiddel werd gewijzigd van H2 O tot H2 O2 [2]. H2 O2 oxidant verhoogt de groeisnelheid met ongeveer 70% in vergelijking met het gebruik van O3 gasreagens van ALD-gegroeid ZnO bij 200 ° C. De toename van de dichtheid van de hydroxylgroep (OH) op het groeioppervlak van de films is verantwoordelijk voor de toename van de groeisnelheid [3]. De toename van de groeisnelheid van ZnO ongeveer 60% voor het gebruik van pure O2 in plaats van H2 O als oxidatiemiddel wordt ook gerapporteerd [4].
O3 is een effectieve oxidator in ALD-gegroeide oxidematerialen. Het hoge elektrochemische potentieel van O3 geeft aanleiding tot snelle reactiesnelheden bij een lage groeitemperatuur. O3 is vluchtiger dan H2 O, H2 O2 , en O2 , en het is gemakkelijker te zuiveren. Daarom kunnen de spoeltijden in elke cyclus worden verkort. De afwezigheid van waterstof in O3 molecuul leidt tot minder waterstof- en hydroxylverontreiniging in de groei. Minder uniform in dikte als gevolg van recombinatief oppervlakteverlies van ZnO wordt getoond voor 10 s van O3 belichtingstijden bij een groei van 200 °C [5]. ALD-geprepareerde ongedoteerde ZnO-films met O3 oxidatiemiddelen vertonen een dubbele thermo-elektrische arbeidsfactor vergeleken met monsters met H2 O oxidatiemiddel. H2 O- en O3 -gegroeide ZnO-films hebben dezelfde defectniveaus van VO maar verschillende Zn-gerelateerde defectniveaus. Voldoende oxidatiekracht van de O3 resulteert in een lager gehalte aan native Zni en dus een grotere thermo-elektrische arbeidsfactor. Sterk oxiderend effect van O3 verhoogt de thermo-elektrische prestaties van ongedoteerde ZnO-films [6]. Co-dosering O3 en H2 O zou de uniformiteit en conformiteit van dunne ZnO-film kunnen verbeteren voor goede ALD-processen [5].
Intrinsieke en extrinsieke stammen komen voor in ZnO-film die van nature op een saffiersubstraat wordt gekweekt. Intrinsieke stam is afkomstig van kristallografische onvolkomenheden met hoge dichtheid in ZnO. Kristallografische onvolkomenheden omvatten waterstofcomplexen, zinkinterstitials (Zni ), zuurstofvacatures (VO ), threading dislocaties (TD's) en korrelgrenzen (GB's) [10,11,12,13,14,15,16,17,18,19,20,21]. Extrinsieke spanning wordt gegenereerd door een grote mismatch van roosterconstanten en thermische uitzettingscoëfficiënten tussen ZnO-epillaag en saffiersubstraat. Er worden verschillende manieren gebruikt om de intrinsieke en extrinsieke spanning van ZnO-materialen op saffieren te verminderen. Een dunne MgO-bufferlaag kan de extrinsieke spanning verminderen, de oppervlakteruwheid met 58,8% verminderen en oppervlaktescheuren van de dunne ZnO-film op saffier onderdrukken [22]. Extrinsieke spanning van ZnO op saffier is volledig ontspannen waarbij de dikte 30 nm bereikt, bereid door sputterdepositie in de magnetron bij 550 ° C [23]. Versoepeling van de drukspanning van 1,77 tot 1,47 GPa van ZnO-films die zijn afgezet door de sproeipyrolysemethode met de stijging van de glassubstraattemperaturen van 350 tot 450 °C wordt vertoond [24].
ALD ZnO gekweekt bij 180 °C met één-gepulste voorlopers (DEZn en H2 O) toont achtergrondelektronenconcentratie zo hoog als ~ 10 18 cm −3 zelfs met post-depositie TA [25]. Veelgebruikte eenpuls H2 O-voorlopers van ALD-processen genereren geen ideale monolaag van zuurstofatomen. Voorlopers met drie pulsen (DEZn en H2 O) zou meerdere hits of botsingen van precursormoleculen met oppervlakteligand kunnen genereren om de reactiewaarschijnlijkheid voor het ALD ZnO gekweekt bij lage temperatuur 100 ° C te bevorderen. De keuze van "drie" pulsen helpt ervoor te zorgen dat reactanten de open chemisorptie- of reactieplaats op de juiste manier lokaliseren. Extreem lage achtergrondelektronenconcentratie 8,4 × 10 14 cm −3 , hoge elektronendriftmobiliteit 62,1 cm 2 /Vs, en uitgesproken verbetering van near bandgap edge (NBE) fotoluminescentie (PL) van drie-gepulseerde voorlopers ZnO met geschikte bufferlaag en RTA-omstandigheden worden verkregen [26]. Verschillende rapporten tonen een verbetering van de materiaalkwaliteit van dunne ZnO-films en ZnO/ZnMgO-multiple quantumputjes met thermisch uitgloeien [27, 28]. In dit rapport, drie-gepulseerde O3 en daaropvolgende eenpuls H2 O als oxidatiemiddelen per ALD-cyclus worden gebruikt om dunne ZnO-films te laten groeien bij 180 ° C. Post-depositie thermische annealing (TA) wordt toegepast om de kristallijne kwaliteit van de monsters te verbeteren. Materiële micro- en nanostructurele, fotoluminescentie- en Hall-effectkenmerken van ALD-gegroeide ZnO-dunne films worden onderzocht.
Experimentele methoden
ZnO-epillagen worden afgezet op conventionele c-face saffier (c-Al2 O3 ) substraten door Cambridge NanoTech Savannah 100 ALD-systeem. In de groei van ALD ZnO dunne films, voorlopers waaronder gedeïoniseerd (DI) H2 O, O3 , en diethylzink (DEZn, Zn(C2 H5 )2 ) worden gebruikt. Tabel 1 toont de condities van het pulsgetal van O3 en post-depositie TA van drie exemplaren genaamd A, B en C. Een schematisch diagram van pulssequentie met tijd per ALD-cyclus van monsters wordt weergegeven in Fig. 1. In deze afbeelding bevat één ALD-cyclus zes opeenvolgende stappen. De eerste stap is de injectie van één-puls gedeïoniseerd (DI) H2 O in een meterschaalreactor om een hydroxyl (OH)-getermineerd oppervlak op saffier te maken of om te reageren met de bungelende ethylgroepen (C2 H5 ) het vormen van zink-zuurstof (Zn-O) bruggen op het Zn-oppervlak met hydroxyl-oppervlaktegroepen. Er wordt één atomaire laag zuurstof (O) gevormd. De tweede stap is de zuivering van zeer zuiver stikstofgas (N2 ) om overtollige voorlopermoleculen en vluchtige bijproducten te verwijderen en om vermenging van volgende voorlopers na elke blootstelling van reactanten te voorkomen. De derde stap is de injectie van drie-gepulseerde O3 in reactoren om de vermindering van natieve defecten te vergemakkelijken. De vierde stap is het zuiveren van de kamer door N2 gas. De vijfde stap is de injectie van één-gepulseerde DEZn in reactoren om één atomaire laag zink (Zn) op de zuurstoflaag te produceren. De laatste stap is ook het zuiveren van de kamer door N2 gas. Precursoren gepulseerd in de reactiekamer door dragen gas N2 met een kamerdruk van 4 × 10 −1 Torr. De optimale conditie van blootstellingstijd voor de reactanten DI H2 O, O3 , en DEZn is respectievelijk 0,01, 0,5 en 0,015 s. De pulstijd van de evacuatie van de kamer is 5 s. De dikte van dunne ZnO-films is 85 nm met 500 ALD-cycli van elk monster. Andere gunstige omstandigheden van depositieparameters zijn weergegeven in de eerdere rapporten [29]. Post-depositie TA bij 300 °C in de atmosfeer van O2 gedurende 1 uur in een oven wordt verwerkt op monster C.
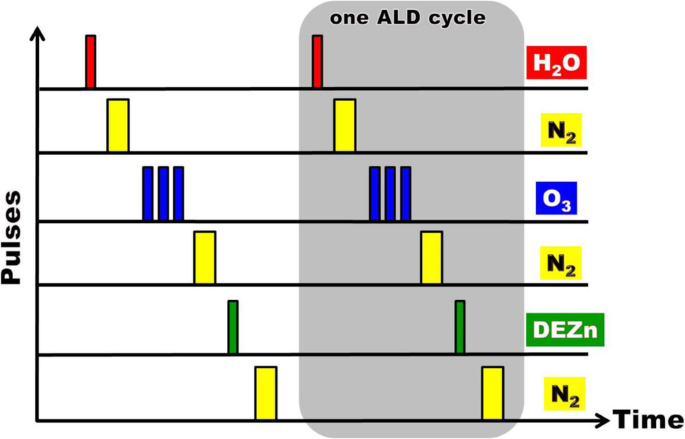
ALD-gegroeide ZnO-films op saffiersubstraten met pulssequentie H2 O/N2 /O3 /N2 /DEZn/N2 met DI-water, O3 , en Zn(C2 H5 )2 als de voorlopers
Materiaal structurele, optische en elektrische eigenschappen van monsters worden uitgevoerd door de volgende metingen. De röntgendiffractie (XRD) patronen worden gemeten met een diffractiehoek (2θ ) bereik van 33 tot 38° en een golflengte van 0,154 nm van koper Kα-straling met behulp van het instrument D2 phaser (Bruker Corporation). Hall-effectmeting maakt gebruik van het Ecopia HMS-3000-systeem en monsters worden in vierkanten gesneden met een oppervlakte van 0,7 × 0,7 cm 2 . Vier hoeken van de specimens zijn gesoldeerd door kleine indiumblobs met ohmse contacten in van der Pauw-configuratie. De dichtheid, mobiliteit en soortelijke weerstand van de films worden gemeten. Fotoluminescentie (PL) spectra worden uitgevoerd van 10 tot 300 K met een excitatiegolflengte van 325 nm en een vermogen van 55 mW van He-Cd-laser. Thermische uitdoving van geïntegreerde intensiteit van PL-spectra met de temperatuurstijging wordt geanalyseerd. Oppervlaktetextuur en ruwheid van monsters die zijn onderzocht met afbeeldingen met hoge resolutie van de atomic force microscope (AFM) zijn gemaakt door het instrument van Veeco Dimension 3100.
Resultaten en discussie
Figuur 2 toont de kristallijne aard van de monsters door de metingen van XRD-patronen. Twee Bragg-diffractiepieken (002) en (101) komen overeen met de hexagonale wurtzietstructuur van ZnO. De sterkste piekintensiteit van XRD-patronen is genormaliseerd voor vergelijking van piekintensiteit tussen monsters. Twee groene pijlen op de bovenste horizontale as tonen diffractiehoeken 34,4° en 36,2° van (002) en (101), respectievelijk, van spanningsvrij bulk ZnO verkregen uit de materiaalgegevenssets die zijn vrijgegeven door de organisatie van het Paritair Comité voor poederdiffractie Standaarden (JCPDS). In de figuur kan men de (002) en (101) pieken waarnemen in de benadering van monster B en C en de diffractiehoeken van (002) en (101) van spanningsvrij bulk-ZnO nader benaderen.

XRD-patronen van ZnO-films met kristallijne oriëntaties langs (002) en (101) richtingen van de monsters. De pijlen geven respectievelijk de diffractiehoeken 34,4° en 36,2° van (002) en (101) van bulk ZnO aan
Biaxiale rek langs de c -as van de epitaxiale lagen kan worden verkregen door de verschuiving van XRD-patronen langs (002) in tegenstelling tot spanningsvrij bulk ZnO. Gemiddelde stam (ε z ) in het rooster van ZnO-films wordt geschat op basis van de roosterparameters met behulp van de volgende uitdrukking.
$$ {\varepsilon}_z=\frac{c-{c}_0}{c_0}\times 100\% $$ (1)waar c en c 0 zijn de roosterconstanten langs de c -as berekend uit Bragg's diffractiehoeken van (002) pieken van ZnO-films en bulk. De gemiddelde spanning (σ ) in het vlak van de films kan worden berekend met behulp van het biaxiale rekmodel:
\( \sigma =\frac{2{c}_{13}^2-{c}_{33}\left({c}_{11}+{c}_{12}\right)}{c_ {13}}\times {\varepsilon}_z=-453.6\times {\varepsilon}_z\left(\mathrm{GPa}\right) \) (2)waar c 11 =209,7 GPa, c 12 =121.1 GPa, c 13 =105.1 GPa, en c 33 =210,9 GPa zijn de elastische stijfheidsconstanten van bulk ZnO. In Tabel 1 zijn de spanningen/spanningen (ε z /σ ) van A-, B- en C-monsters zijn respectievelijk 1,08%/4,90 GPa, 0,74%/3,37 GPa en 0,49%/2,22 GPa. Spanning/stress wordt verminderd en verder verminderd in monsters B en C.
PL-spectra bij verschillende temperaturen van 10 tot 300 K van monsters worden weergegeven in Fig. 3. Sterke recombinatie van excitonen in de buurt van de rand van de band met spectrale piekenergie rond 3,34 eV is dominant in PL-spectra van alle monsters. Longitudinaal-optische (LO) fonon-geassisteerde optische emissie wordt waargenomen bij de lagere energieschouder van de PL-spectra van monsters. In Fig. 4a-c vertoont het de Arrhenius-plot van geïntegreerde intensiteit van PL-spectra versus het omgekeerde van temperatuur. Thermische blussen van geïntegreerde intensiteit van PL met toenemende temperatuur kan worden aangepast door de volgende Arrhenius-formule.
$$ I(T)=\frac{A}{1+{D}_{nr1}\exp \left(\frac{-{E}_{A1}}{k_{\mathrm{B}}T} \right)+{D}_{nr2}\exp \left(\frac{-{E}_{A2}}{k_{\mathrm{B}}T}\right)} $$ (3)waar ik (T ) vertegenwoordigt de geïntegreerde PL-intensiteit. A is een constante. D nr 1 en D nr 2 zijn constanten die verband houden met de dichtheid van niet-stralingsrecombinatiecentra. E A 1 en E A 2 zijn de activeringsenergieën die overeenkomen met het niet-stralingsrecombinatieproces van respectievelijk donorgebonden excitonen bij lage temperatuur en vrije excitonen bij hoge temperatuur. k B is de Boltzmann-constante. De kleinste-kwadratenmethode in regressieanalyse wordt gebruikt om de gegevens te passen die de parameters van D . tonen nr 1 , D nr 2 , E A 1 , en E A 2 met rode fittingcurves in Tabel 2 en Fig. 4a-c. Het aanpasresultaat laat zien dat variaties van D nr 1 , E A 1 , en E A 2 onder de monsters zijn licht. D nr 2 zijn respectievelijk 132,7, 153,6 en 110,8 van de monsters A, B en C, die een groot verschil in de hoeveelheid defectdichtheid laten zien. De kleinste waarde van D nr 2 suggereert de laagste dichtheid van thermisch geactiveerde defecten in monster C.
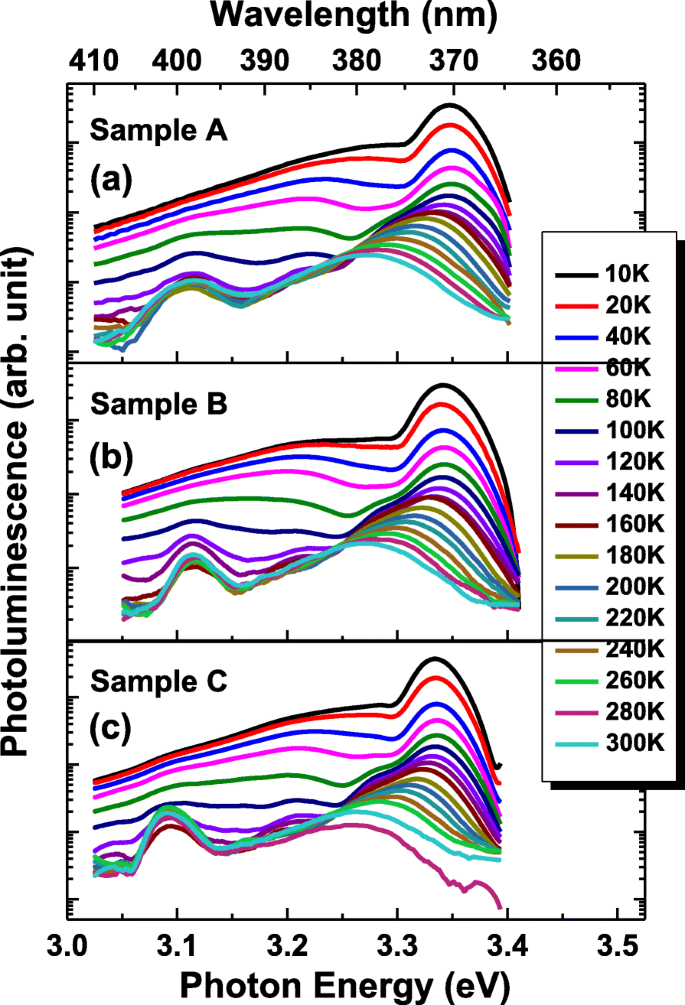
een –c Temperatuurafhankelijke PL-spectra van monsters
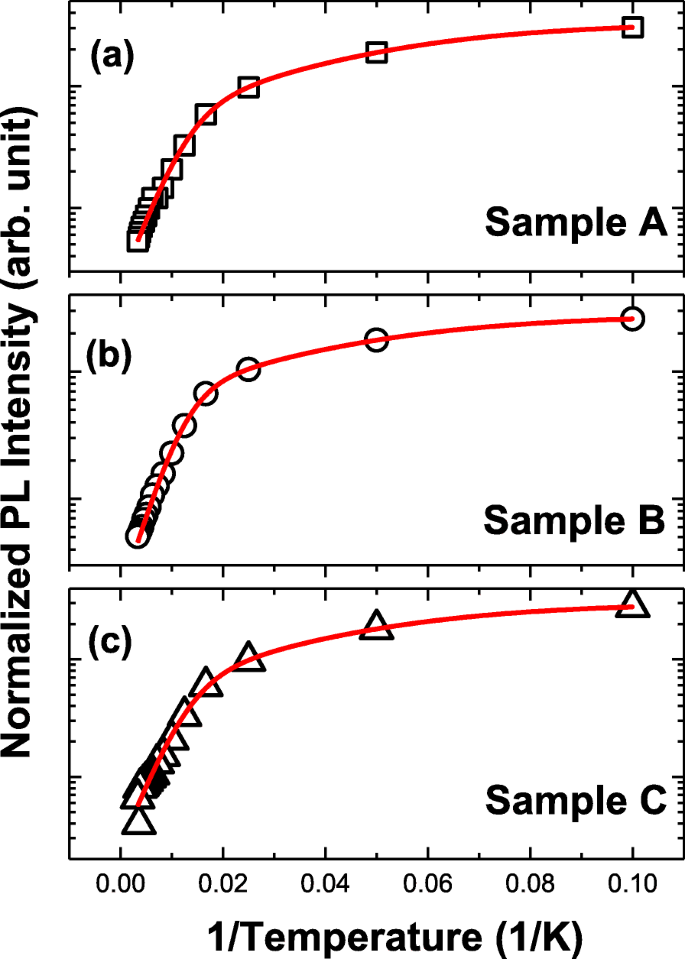
een –c Arrhenius-grafieken van thermische uitdoving van geïntegreerde intensiteit van PL-spectra en rode passende curven van monsters
Achtergrondelektronenconcentratie, mobiliteit en soortelijke weerstand van Hall-effectmetingen van monsters staan vermeld in Tabel 2. In monster B worden twee ordes van grootte afname van dragerconcentratie met afname van mobiliteit getoond in vergelijking met monster A. Verdere enorme afname van dragerconcentratie naar de laagste waarde van 9,4 × 10 15 cm −3 en de opkomst van mobiliteit tot een waarde van 6,1 cm 2 /V's worden waargenomen in monster C in vergelijking met monster B. De minste hoeveelheid elektronenconcentratie is te wijten aan de grootste relaxatie van spannings-/stresstoestanden en opmerkelijke vermindering van de dichtheid van de natuurlijke defecten in monster C.
Figuren 5a-c en d-f zijn 2D- en 3D AFM-afbeeldingen van specimens. RMS-ruwheid van A, B en C is respectievelijk 1,92, 4,30 en 2,18 nm, zoals weergegeven in tabel 2. De laagste ruwheid van de oppervlaktetextuur trad op in monster A. Met het gebruik van O3 precursor in monster B, wordt de oppervlakteruwheid verhoogd. Vermindering van ruimtelijke uniformiteit van de ALD ZnO-films is te wijten aan het oppervlakteverlies van O3 [21]. Oppervlakteverlies van O3 is gerelateerd aan de overgang van reactie- naar recombinatie-beperkte groei en kan het primaire atomaire verlieskanaal vormen om de films te vernietigen, wat resulteert in een slechte dikte-uniformiteit. Dit is gecorreleerd met de vermindering van de diffractiepiekintensiteit langs (002) in monster B in figuur 2. Met de behandeling van post-depositie TA in monster C wordt de uniformiteit van het oppervlak verbeterd. Ondertussen wordt een dramatische afname van de achtergrondelektronenconcentratie en een toename van de mobiliteit bereikt. Thermisch gloeien zorgt voor migratie in het kristalrooster; aldus vindt metallurgische herkristallisatie plaats. Herkristallisatie gaat gepaard met de vermindering van de sterkte van spanning/spanning en intrinsieke onvolkomenheden in het kristalrooster; daarom wordt een betere kwaliteit van de dunne ZnO-film bereikt. Dit resultaat is consistent met de verbetering van twee diffractiepiekintensiteiten in het XRD-patroon in monster C. Het is vermeldenswaard dat de mobiliteit van elektronen kan worden beïnvloed door verstrooiingsbronnen zoals onzuiverheden, roosters en defecten. Die verstrooiingsbronnen zouden de gemiddelde elektronensnelheid kunnen veranderen. In het algemeen leidt een vermindering van de defectdichtheid en dus een afname van de elektronenconcentratie tot een toename van de mobiliteit. In dit rapport zou een toename van de ruwheid van de oppervlaktetextuur als gevolg van de werking van het doseren van ozonprecursor een lagere elektronenmobiliteit in monster C dan A kunnen veroorzaken. In Fig. 6 illustreert een piramidediagram met drie driehoeken in verschillende kleuren de drie belangrijkste groei- en verwerkingsomstandigheden om ALD ZnO-epilagen van hoge kwaliteit te verkrijgen in dit rapport.
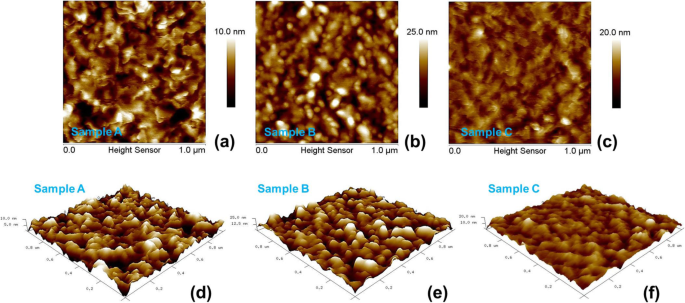
een –c 2D en d –f 3D AFM-beelden van specimens. De hoogteschaal in 2D-afbeeldingen wordt weergegeven op de rechterkleurenbalk

Een piramidediagram. In de piramide zijn vier driehoeken afgebeeld in verschillende kleuren. Drie driehoeken aan de randen van de piramide tonen de belangrijkste groei- en verwerkingsomstandigheden van ZnO. Combinatie van deze drie cruciale componenten in de groei bevordert de kwaliteit van ALD ZnO-epilagen, weergegeven door de driehoek in het midden van de piramide
Conclusies
Eenpuls H2 O en sterk oxidant met drie pulsen O3 voorlopers in de ALD-processen kunnen de spanning/stress verminderen en daardoor de elektronenconcentratie in de dunne ZnO-film opvallend verminderen, maar de oppervlakteruwheid vergroten. Post-depositie TA bij 300 °C in de atmosfeer van zuurstof (O2 ) gedurende 1 uur kan de vorming van meer defectvrije korrels met lagere spanning/stress, lagere achtergrondelektronenconcentratie en verbetering van de oppervlakteruwheid verder vergemakkelijken na de groei van het gebruik van drie-gepulseerde O3 voorlopers. De laagste spanning/stress en achtergrondelektronenconcentratie die 0,49%/2,22 GPa en 9,4 × 10 15 zijn cm −3 , respectievelijk, als gevolg van de dramatische afname van intrinsieke natieve defecten van ALD-gegroeide ZnO-dunne films worden bereikt.
Beschikbaarheid van gegevens en materialen
De gegevens die de bevindingen van deze studie ondersteunen, zijn op redelijk verzoek verkrijgbaar bij de corresponderende auteur (Yung-Chen Cheng).
Afkortingen
- ALD:
-
Atoomlaagafzetting
- O3 :
-
Ozon
- TA:
-
Thermisch gloeien
- O2 :
-
Zuurstof
- PL:
-
Fotoluminescentie
- H2 O:
-
Water
- H2 O2 :
-
Waterstofperoxide
- OH:
-
Hydroxyl
- Zni :
-
Zink interstitials
- VO :
-
Zuurstof vacatures
- TD's:
-
Dislocaties inrijgen
- GB's:
-
Korrelgrenzen
- NB:
-
Dichtbij de rand van de bandgap
- c-Al2 O3 :
-
c-face saffier
- DI:
-
Gedeïoniseerd
- C2 H5 :
-
Ethylgroepen
- N2 :
-
Stikstofgas
- Zn:
-
Zink
- XRD:
-
Röntgendiffractie
- AFM:
-
Atoomkrachtmicroscoop
- RMS:
-
Wortelgemiddelde kwadraat
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Het bestuderen van de hechtkracht en glasovergang van dunne polystyreenfilms door Atomic Force Microscopy
- Voorbereiding en thermo-elektrische kenmerken van ITO/PtRh:PtRh Thin Film Thermokoppel
- Een handige en effectieve methode om Low-Defect-Density nc-Si:H Thin Film van PECVD te deponeren
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN



