Invloed van tedoping op katalysatorvrije VS InAs-nanodraden
Abstract
We rapporteren over de groei van Te-gedoteerde katalysator-vrije InAs-nanodraden door moleculaire bundelepitaxie op silicium (111) substraten. Veranderingen in de draadmorfologie, d.w.z. een afname in lengte en een toename in diameter, zijn waargenomen bij een stijgend dopingniveau. Kristalstructuuranalyse op basis van transmissie-elektronenmicroscopie en röntgendiffractie onthult een verbetering van de zinkblend/(wurtziet+zinkblend) segmentverhouding als Te wordt verschaft tijdens het groeiproces. Bovendien tonen elektrische tweepuntsmetingen aan dat verhoogde Te-doping een winst in geleidbaarheid veroorzaakt. Twee vergelijkbare groeireeksen, die alleen verschillen in As-partiële druk met ongeveer 1 × 10 −5 Torr, terwijl alle andere parameters constant werden gehouden, werden geanalyseerd op verschillende Te-dopingniveaus. Hun vergelijking suggereert dat de kristalstructuur sterk wordt beïnvloed en dat de geleidbaarheidswinst duidelijker is voor draden die zijn gegroeid bij een vergelijkbaar hogere As-partiële druk.
Achtergrond
Nanodraden (NW's) hebben de afgelopen tien jaar veel aandacht getrokken omdat ze worden beschouwd als een veelbelovende bouwsteen voor opkomende en toekomstige technologie. Hun technische toepassingen zijn divers, variërend van veldeffecttransistoren en optische apparaten tot zonnecellen [1, 2]. De brede toepasbaarheid van NW's is gebaseerd op hun opmerkelijke eigenschappen, zoals een hoge aspectverhouding, ultralage vermogensdissipatie en, in het geval van InAs, de afwezigheid van een Schottky-barrière op het grensvlak met metalen contacten [3,4,5] . Dit laatste is te wijten aan het feit dat InAs een oppervlakteaccumulatielaag vertoont, waardoor ohms contact mogelijk is [6]. Vanuit natuurkundig oogpunt hebben InAs NW's uitstekende eigenschappen, d.w.z. een hoge elektronenmobiliteit [7], een lage effectieve massa [8], een grote g-factor [9] en een sterke Rashba spin-baankoppeling [10, 11]. Hierdoor werden ze een belangrijk ingrediënt voor onderzoek naar kwantuminformatie [5, 12,13,14].
InAs NW's worden gewoonlijk gekweekt via een damp-vloeistof-vaste stof (VLS) groeimethode met gouden druppeltjes als katalysator. Het gebruik van Au heeft ten minste twee nadelen. Enerzijds bevat het als onbedoelde onzuiverheid in de NW's die hun materiaaleigenschappen aantasten [2, 15, 16], aan de andere kant de integratie van reeds aangetoonde belangrijke toepassingen zoals NW-veldeffecttransistoren (FET) [17], tunnel-FET's [18], fotodetectoren [19], enz., op de op silicium gebaseerde technologie is niet mogelijk. Zo werd binnen deze communicatie een katalysatorvrije groei in de eerder ontwikkelde damp-vaste (VS) modus toegepast [20]. Naast de kubische zinkblende (ZB) fase, die de stabiele fase is in bulk III-V materialen, is de hexagonale wurtziet (WZ) fase ook aanwezig in nanodraden. ZB-WZ polytypisme en andere defecten zoals roterende tweelingen en stapelfouten worden vaak gemeld. Fasezuiver, bijna vrij van stapelfouten InAs NW's kunnen worden verkregen door Au-geassisteerde VLS-groei [21, 22] maar niet met behulp van de katalysatorvrije VS-methode [23,24,25]. Deze defecten hebben een nadelige invloed op het transport [26, 27] en optische eigenschappen [28].
Een manier om het verminderde ladingstransport tegen te gaan is het gebruik van doping, d.w.z. het inbouwen van extra dragers. De gevestigde doteringsmethoden die worden gebruikt voor III-V samengestelde halfgeleiderlagen kunnen echter niet eenvoudig worden overgedragen op de draadstructuren. De nanodraden hebben axiale en radiale groeifacetten met verschillende kristaloriëntatie en oppervlaktereconstructies, wat resulteert in een zeer anisotrope groei die verondersteld wordt de opname van het doteringsmiddel te beïnvloeden. De situatie wordt gecompliceerd door de verschillende groeiwijzen, damp-vloeibaar-vast (VLS) en VS, van de deelnemende facetten [29, 30] en het eigenaardige polytypisme in de kristalfase [31]. Al deze specifieke kenmerken resulteren in een inhomogene doteringsverdeling, zowel axiaal als radiaal [29, 32, 33]. Het groep IV element Si is algemeen gebruikt als n-type doteringsmiddel voor MBE gegroeide III-V dunne films. Het is echter bekend dat Si amfoteer gedrag vertoont, d.w.z. Si-atomen kunnen worden opgenomen als donoren op kationenroosterplaatsen of acceptoren op anionenroosterplaatsen, afhankelijk van de substraatoriëntatie en groeiomstandigheden [34, 35]. Dit gedrag werd ook waargenomen bij nanodraden die gecorreleerd waren met de verschillende kristaloriëntaties van de facetten die betrokken zijn bij de groei, groeimechanismen en groeitemperatuur [29, 36, 37]. Aan de andere kant is het groep VI-element Te een zeer effectieve n-type doteringsstof in epilagen [38] die geen risico op amfoteer gedrag met zich meebrengt. Bovendien heeft Te enkele andere voordelen:een lagere ionisatie-energie in vergelijking met andere n-type doteermiddelen die gewoonlijk worden gebruikt in III-V-materiaalsystemen, wat mogelijk leidt tot het bereiken van hogere doteringsniveaus [39]; een lagere diffusiecoëfficiënt [40] en een zwakker geheugeneffect in vergelijking met andere groep VI-elementen, namelijk S en Se, die belangrijk zijn voor abrupte interfaces [41]. Het uitsluitend n-type doteringsgedrag van Te is gerapporteerd voor Au-gekatalyseerde [42] en zelfgekatalyseerde GaAs-nanodraden die het potentieel tot rijke hoge doteringsconcentratie laten zien, maar ook de impact op de draadmorfologie en kristalstructuur [43, 44] .
In deze mededeling onderzoeken we Te-doping in InAs NW's, waarbij we informatie verstrekken over de impact van doping op de NW-morfologie en het schakelen tussen de ZB- en de WZ-structuur binnen de VS-groei in aanwezigheid van Te. Onderzoeken op basis van scanning-elektronenmicroscopie (SEM) onthulden een sterke impact van Te op de NW-morfologie. Hoge resolutie transmissie-elektronenmicroscopie (HR-TEM) [45] en röntgendiffractie (XRD) metingen dienden om een verandering in de ZB/(WZ + ZB) verhouding aan te tonen en elektrische tweepuntsmetingen toonden een toename in geleidbaarheid met verhoging van het te-dopingniveau.
Methoden/experimenteel
InAs NW's werden gekweekt in de VS-modus zonder het gebruik van vreemde katalysatoren op n-type Si (111) substraten.
Substraatvoorbereiding
Voorafgaand aan de groei werden de substraten gereinigd met HF en DI-water. Een opeenvolgende waterstofperoxidebehandeling gedurende 45 s leidt tot de vorming van een SiO2-film met een dikte van enkele angstrom die gaatjes bevat, die dienen als nucleatiecentra voor de NW-groei [20]. Na de oxidatie werden de substraten onmiddellijk overgebracht naar de laadsluis waarin ze gedurende 45 minuten werden verwarmd tot 200 ° C. Dit werd gevolgd door een ontgassingsstap in de voorbereidingskamer, waarbij de monsters nog eens 45 min werden verwarmd tot 400 °C.
Groei van de InAs-nanodraden
De NW's werden gekweekt bij een substraattemperatuur van 475 ° C gedurende 1:20 ° C in een Omicron Pro 100 moleculaire bundel epitaxie (MBE) kamer. Een groeipercentage van 0,1 μmh −1 werd gebruikt voor de NW-groei. Arseen werd geleverd via een As-krakercel en de As4-beam-equivalentdruk (BEP) werd aangepast tot waarden van 2,3 × 10 –5 Torr en 3,3 × 10 –5 Torr. De eerste monsterreeks (reeks A) werd gekweekt bij hogere As-partiële druk in vergelijking met een tweede reeks groei (reeks B) (zie tabel 1), terwijl alle andere parameters constant werden gehouden. Tellurium werd tijdens de groei geleverd met stoichiometrische GaTe. De bedrijfstemperatuur van de effusiecel werd gevarieerd tussen 401 °C en 562 °C op basis van kalibraties uitgevoerd op Te-gedoteerde GaAs-lagen via Hall-metingen. De GaTe-celtemperaturen van 401 °C, 447 °C, 500 °C en 561 °C komen overeen met een dragerconcentratie van ongeveer 1 × 10 15 cm −3 , 4 × 10 16 cm −3 , 5 × 10 17 cm −3 , en 6 × 10 19 cm −3 respectievelijk in GaAs (100)-lagen die worden gebruikt voor kalibratie.
Apparaatverwerking
Om tweepuntscontacten te verwerken, werden de NW's mechanisch overgebracht op een Si-substraat met vooraf patroon dat was bedekt met 200 nm SiO2. Een schematisch diagram van de contactstappen vindt u in Aanvullend bestand 1:Afbeelding S1. Voorafgaand aan metaalafzetting werden de draden spin-coated door een drielaags systeem van 50 K (AR-P639.04), 50 K en 950 K (AR-P679.04) PMMA-resist waarop de contactvorm werd gedefinieerd via e-beam lithografie. Na ontwikkeling werd het contactoppervlak gepassiveerd met verdunde 3,5% ammoniumpolysulfide (H2 O:(NH4)2 S3 , 34:1) bij 60 °C gedurende 30 min. De elektroden, bestaande uit 100 nm titanium en 40 nm goud, werden afgezet via een elektronenstraalverdamper.
De volledige lijst van monsters die zijn onderzocht via SEM-, TEM-, XRD- en elektrische metingen wordt weergegeven in Tabel 1. Hier geven de letters A, B en C de monsterreeksen aan die elk bij verschillende As-partiële drukken werden gekweekt, maar afgezien daarvan onder gelijke voorwaarden. Een GaTe-temperatuur van 0 °C komt overeen met een gesloten celsluiter.
Resultaten en discussie
Morfologie
SEM-beeldvorming werd gebruikt om de invloed van Te-doping op de draadmorfologie te onderzoeken. De resultaten worden weergegeven in Afb. 1. Elk gegevenspunt in de grafieken vertegenwoordigt het gemiddelde van ten minste 40 draden en de foutbalk hun standaarddeviatie.

Nanodraad morfologie. Nanodraad gemiddelde lengte en diameter bij verschillende GaTe-celtemperaturen. een Serie A werd gekweekt bij een As-partiële druk van ongeveer 3,3 × 10 –5 Torr. b Serie B is gekweekt bij een As-partiële druk van 2,3 × 10 –5 Torr. De onderbroken lijnen zijn een leidraad voor de ogen. De SEM-microfoto die in de inzet wordt getoond, toont ongedoteerde InAs NW's omringd door kristallieten die tijdens de groei zijn gevormd. De schaalbalk is respectievelijk 300 nm en 120 nm
Figuur 1a toont de morfologie van draadreeks A gegroeid bij een As-partiële druk van ongeveer 3,3 × 10 −5 Torr. De temperatuur van de GaTe-cel varieerde van 0 °C tot 561 °C. Rekening houdend met de foutbalk, wordt geen duidelijke trend van de NW-diameter en -lengte waargenomen tot een celtemperatuur van 500 °C. Bij 561 °C is de toevoer van Te echter duidelijk nadelig, wat leidt tot een sterke toename van de diameter en een afname van de NW-lengte. Groeireeks B, afgebeeld in Fig. 1b, is gekweekt bij een vergelijkbaar lagere As-druk van 2,3 × 10 −5 Torr. De inzet toont een voorbeeldig SEM-zijaanzicht van een gegroeid monster, met InAs NW's en clusters op het substraatoppervlak. Verdere SEM-afbeeldingen van serie A en B worden getoond in Aanvullend bestand 1:Afbeelding S2. Hier werd een GaTe-celtemperatuurbereik van 0 °C tot 462 °C onderzocht. We zien een afname in lengte wanneer Te tijdens de groei wordt toegevoegd voor serie B bij een celtemperatuur van 401 °C. Wanneer we de metingen van reeksen A en B in hetzelfde temperatuurinterval vergelijken, zien we dat met name de afname van de NW-lengte duidelijker is bij vergelijkbaar lagere As-drukken (reeks B). Dezelfde algemene trend, d.w.z. een afname in NW-lengte wordt waargenomen voor beide series en een toename in diameter voor serie A.
Si-doping leidt op vergelijkbare wijze tot een grotere diameter en verminderde lengte voor InAs en GaAs, onafhankelijk van de groeimethode (MBE of metaalorganische dampfase-epitaxie (MOVPE)) [46, 47]. Dezelfde verandering in afmetingen werd waargenomen voor Te-doping van katalysatorvrije GaAs NW's gegroeid door MBE [44]. Het lijkt erop dat onafhankelijk van het gebruikte materiaalsysteem, dwz IIIV-materialen gedoteerd met groep IV (InAs/Si, GaAs/Si) of groep VI-materialen (GaAs/Te, InAs/Te), dezelfde algemene trend met betrekking tot morfologie wordt waargenomen.
Te vertoont een vrij grote covalente straal ten opzichte van de gastheerroosteratomen en kan daarom als oppervlakteactieve stof werken [48, 49]. Het waargenomen gedrag zou dus kunnen worden veroorzaakt door een verminderde diffusie van de In-atomen veroorzaakt door Te. Dit zou op zijn beurt de toename van radiale groei en een afname in lengte kunnen veroorzaken, aangezien de In-adatomen worden gehinderd op hun weg naar de NW-punt waar ze de groei beheersen [46]. Als we Fig. 1a (reeks A) en Fig. 1b (reeks B) vergelijken, zien we dat de As-druk beïnvloedt hoe de draadmorfologie wordt beïnvloed door de Te-toevoeging. De bevinding suggereert dat het mogelijk zou kunnen zijn om de afnemende impact van Te op de radiale en axiale dimensie van de InAs-draad tegen te gaan door de As-druk tot op zekere hoogte te verhogen.
Kristalstructuur
De impact van de Te-doteringen op de kristalstructuur werd onderzocht met behulp van TEM en XRD. Het overnemen van de classificatie die wordt gebruikt door Caroff et al. [49] werd een kristalstapelvolgorde toegewezen aan een ZB (zie figuur 2a) of een WZ (zie figuur 2d) segment als de stapelvolgorde precies vier dubbellagen van atomen volgde. Dit betekent dat ...ABCA... werd geteld als een ZB-segment en ...ABAB... als een WZ-segment. Dit wordt geïllustreerd in Fig. 2b, e. Hier vertegenwoordigt elke letter een dubbellaag van atomen. Sommige draadsecties worden onderbroken door stapelfouten (SF's) bestaande uit een ontbrekende of overtollige laag in de kristalreeks, zoals weergegeven in Fig. 2c, f. Hoewel het zelden wordt waargenomen, is er in sommige segmenten ook roterende twinning (hier niet weergegeven).
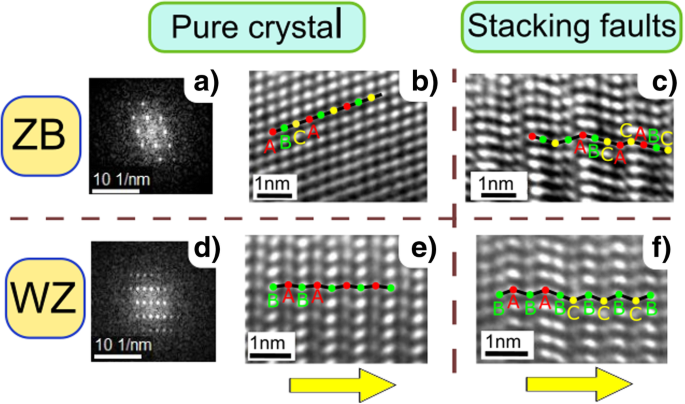
Kristalstructuuranalyse. HR-TEM-afbeeldingen van InAs NW's, ter illustratie van de ZB- en WZ-kristalstructuren met en zonder stapelfouten. De gele pijlen geven de groeirichting [111] aan. De gekleurde stippen en de zwarte lijnen zijn een leidraad voor de ogen om de stapelkarakteristiek te volgen. een FFT-diffractiepatroon voor defectvrije ZB. b , c ZB-structuur. d FFT-diffractiepatroon voor foutloze WZ en e –f WZ-structuur
Kristalsecties werden alleen geïdentificeerd als ZB- of WZ-segmenten als één volledige sequentie bestaande uit vier dubbellagen van atomen werd waargenomen. De overige secties werden toegeschreven aan SF's of roterende tweelingen.
De kristalstructuur op drie verschillende dopingniveaus, geëvalueerd volgens de verklaarde kenmerken, wordt geïllustreerd in Fig. 3. Verschillende WZ- en ZB-gebieden worden gemarkeerd. Voor de analyse werden echter alleen individuele segmenten geteld. Om de invloed van de Te-doping op de NW-kristalstructuur te kwantificeren, werd een totale lengte van ongeveer 150 nm aan segmenten van 10 NW's voor elk dopingniveau geanalyseerd en gemiddeld (zie Fig. 3b-d). De ZB/(WZ + ZB) segmentverhouding werd bepaald door het aantal enkele ZB- en WZ-segmenten te tellen. De monsters B1, B3, C1 en A4 bij 0 ° C, 447 ° C en 500 ° C werden respectievelijk geanalyseerd (zie Fig. 4). We zien een verbetering van de ZB/(WZ + ZB) segmentverhouding met toenemende GaTe-celtemperatuur. Deze trend wordt geïllustreerd in Fig. 4. Bij vergelijking van de eerste twee datapunten (0 ° C en 447 ° C), is de verbeterde verhouding te wijten aan een sterkere toename van ZB-segmenten in vergelijking met de toename van WZ-segmenten van ongedoteerd naar de laagste dopingtemperatuur (zie inzet Fig. 4). Beide structuurtypen zijn verbeterd en het aantal SF's is afgenomen. Voor het derde punt wijkt de trend echter af. Wanneer we het hoogste met het laagste dopingniveau (500 °C en 447 °C) vergelijken, zien we dat het aantal WZ-segmenten afneemt en het aantal ZB-segmenten vrijwel constant blijft (zie inzet Fig. 4) terwijl het aantal SF's neemt toe. Dit leidt tot een verhoogde ratio. Toch wordt de ZB-sectie gepromoot in vergelijking met de ongedoopte zaak. Ten slotte laten de bevindingen zien dat de Te-doping inderdaad de ZB/(WZ + ZB) segmentverhouding verbetert. Het blijft echter dubbelzinnig of de vorming van ZB-segmenten strikt wordt bevorderd door Te incorporatie.
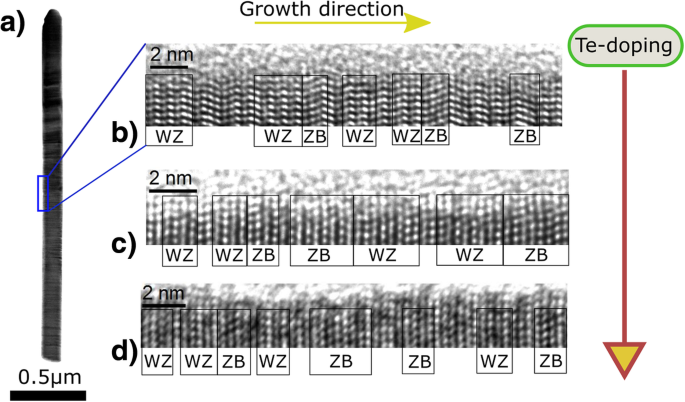
Te-doping invloed op de kristalstructuur. TEM-afbeeldingen die de kristalstructuur weergeven in niet-gedoteerde en Te-gedoteerde InAs NW's. een Zijaanzicht van een InAs NW. b –d HR-TEM-afbeeldingen van de InAs NW-kristalstructuur (afbeelding 90 ° met de klok mee gedraaid). De gebieden WZ en ZB zijn gelabeld. De volgende monsters en GaTe-celtemperaturen zijn gekozen:b B1 (Als4 -BEP = 2.3 × 10 −5 Torr), ongedoteerd, d.w.z. 0°C. c B3 (Als4 -BEP = 2.3 × 10 −5 Torr), 447°C. d C1 (Als4 -BEP = 3.0 × 10 −5 Torr), 500 °C

Verhouding tussen ZB- en WZ-segmenten. Verhouding van het aantal ZB-segmenten en het totale aantal segmenten geïdentificeerd als WZ of ZB in afhankelijkheid van de GaTe-celtemperatuur. Voor de eerste twee metingen zijn B1 en B3 geanalyseerd. Bij 500 °C werden de resultaten van draden C1 en A4 samengevoegd terwijl ze werden gekweekt bij vergelijkbare As-BEP. De staafgrafiek in de inzet geeft de geaccumuleerde lengte weer van alle WZ- en ZB-segmenten die respectievelijk in het NW aanwezig zijn bij de aangegeven celtemperatuur
Om de waarnemingen van TEM aan te vullen, werden XRD-metingen uitgevoerd. We voerden φ-scans uit die gericht waren op de kubische (220) en de hexagonale [10,11,12,13,14,15]-reflexen. Deze reflexen kunnen ondubbelzinnig worden toegeschreven aan respectievelijk de ZB- en de WZ-structuur. De meting van de respectieve intensiteiten maakte het mogelijk om de I . te extraheren ZB /(Ik ZB + Ik WZ ) intensiteitsverhouding. De φ-scans afgebeeld in Fig. 5a, dienden om de relatieve intensiteiten van de ZB- en WZ-pieken bij elke GaTe-celdoteringstemperatuur te bepalen. Voor de ZB-reflex treden zes pieken op, hoewel het kubische rooster slechts tot een 3-voudige symmetrie zou moeten leiden. We wijzen deze pieken toe aan symmetrische tweelingen in de ZB-structuur. De zesvoudige symmetrische pieken die optreden in de WZ-scan zijn kenmerkend voor de hexagonale kristalstructuur en komen overeen met onze verwachtingen. Hier wordt aangenomen dat de signaalintensiteit van InAs-oppervlakkristallieten (zie inzet in Fig. 1) twee ordes van grootte kleiner is dan het NW-signaal [50] en kan dus worden verwaarloosd. De bijbehorende intensiteitsverhouding I ZB /(Ik ZB + Ik WZ ) is uitgezet in Fig. 5b (gekleurde driehoeken voor serie A). Het toont een toename van de I ZB /(Ik ZB + Ik WZ ) intensiteitsverhouding met toenemende GaTe-celtemperatuur, zichtbaar na 401 °C voor serie A. Dit resultaat is in overeenstemming met de waarneming die al is verkregen uit de TEM-analyse. Merk op dat de gegeven intensiteitsverhoudingen niet de werkelijke ZB/WZ-verhouding vertegenwoordigen, maar een kwalitatief resultaat vormen. Dit komt door het feit dat verschillende reflexen van verschillende intensiteit zijn, afhankelijk van de structuurfactor waarmee niet expliciet rekening is gehouden. De vergelijking tussen de datapunten blijft echter geldig. Dezelfde reflexgevoelige meting werd uitgevoerd voor serie B die werd gekweekt bij een lagere As-druk dan de hierboven gepresenteerde serie A. De resultaten weergegeven in Fig. 5b (zwarte stippen) laten een vergelijkbare trend zien als de A-reeks, d.w.z. een toename van de ZB/(WZ + ZB) intensiteitsverhouding bij hogere celtemperaturen. De impact van de Te-atomen op de kristalstructuur is echter minder duidelijk in vergelijking met hogere As-drukken en een duidelijke toename wordt pas waargenomen bij 462 °C. Hoewel serie B alleen een verbetering van de ZB/(WZ + ZB) intensiteitsverhouding in de XRD laat zien voor de hoogste GeTe-celtemperatuur van 462 °C, vertoont serie A duidelijk een toename bij 447 °C en 500 °C celtemperatuur. Deze waarneming suggereert dat de As-atomen de opname van Te-atomen vergemakkelijken, wat op zijn beurt leidt tot een verandering in de kristalstructuur. Daarom wordt een sterkere impact op de ZB/(WZ + ZB)-verhouding waargenomen voor de respectievelijke hogere As-druk. De afname van de intensiteitsverhouding bij 447 °C in figuur 5b kan te wijten zijn aan schaduweffecten, aangezien de NW-dichtheid voor monster B3 boven het gemiddelde lag, hoewel dit nog niet volledig wordt begrepen.

Röntgenanalyse van de roosterstructuur. een φ scans verkregen via röntgenmetingen op InAs NW's A1-A4. b Resulterend Ik ZB /(Ik WZ + Ik ZB ) intensiteitsverhouding versus GaTe-celtemperatuur. De driehoekige gegevenspunten worden geëxtraheerd uit de metingen weergegeven in (a ) voor monsters A1-A4. De zwarte stippen geven de datapunten van monsters B1-B4 aan
Uit de hierboven gepresenteerde TEM-resultaten kan worden geconcludeerd dat de NW's die onder Te-aanvoer zijn gekweekt, een verhoogd aantal ZB- en WZ-segmenten vertonen en dus minder SF's in vergelijking met het ongedoteerde geval. Verder geven de XRD-metingen aan dat de ZB/(WZ + ZB) intensiteitsverhouding toeneemt met toenemend Te-dopingniveau (bij hogere temperaturen), wat kwalitatief in lijn is met de TEM-metingen. In tegenstelling tot de gebruikelijke elementen die worden gebruikt voor het doteren van III-V-materialen zoals Si (InAs/Si [30], GaAs/Si), C (GaAs/C) of Be (GaAs/Be), beïnvloedt Te duidelijk de kristalstructuur van het NW. De bevordering van de waargenomen ZB-vorming kan afkomstig zijn van een verandering van oppervlakte-energieën, waardoor de energiebarrière voor ZB-kiemvorming wordt verlaagd. Dit werd ook waargenomen in met zink gedoteerde InP-nanodraden [51] waar Au-gekatalyseerde VLS-groei werd gebruikt. Er is echter verder onderzoek nodig om het onderliggende mechanisme te verduidelijken.
Elektrische metingen
De geleidbaarheid gedefinieerd door σ = A·R·L −1 w werd geëxtraheerd uit tweepuntsmetingen met behulp van Ti / Au-contacten. Hierin is A de zeshoekige doorsnede van de draad met A = 3√3d 2 NW /8 waar d NW is de maximale diameter, R de weerstand, en Lw de afstand tussen de elektrische contacten. L w en d NW zijn voor elke draad afzonderlijk gemeten via SEM-beeldvorming. Voorbeeldige IV-kenmerken van ongedoteerde en gedoteerde InAs NW's worden weergegeven in Fig. 6a-d. De grafieken tonen het verwachte ohmse gedrag als gevolg van de oppervlakteaccumulatielaag van InAs [6, 52]. De geleidbaarheid in afhankelijkheid van het dopingniveau werd bepaald op basis van de I–V-metingen en de NW-geometrie. De resulterende afhankelijkheid tussen de geleidbaarheid en de GaTe-celtemperatuur wordt geïllustreerd in Fig. 6e. Bij elke temperatuur werden ten minste 20 NW's onderzocht op serie A. Bij vergelijking van ongedoteerde en gedoteerde draden wordt een toename van de gemiddelde geleidbaarheid van ongeveer één orde van grootte op het hoogste doteringsniveau waargenomen. Bij een GaTe-celtemperatuur van 500 °C werd een gemiddelde geleidbaarheid van ongeveer 80 S/cm bepaald (vergeleken met ongeveer 8 S/cm voor 0 °C). Hoewel de spreiding in geleidbaarheid voor hogere dopingniveaus vrij duidelijk is, blijkt uit onze waarneming dat de opname van Te inderdaad een sterke impact heeft, wat leidt tot een gemiddeld verhoogde geleidbaarheid. De vergelijking van de XRD en de geleidbaarheidsmeting suggereert dat beneden 401 °C de invloed van Te op de kristalstructuur en transporteigenschappen slechts een ondergeschikte rol speelt. De grote variantie in geleidbaarheid van InAs NW's die hierboven zijn genoemd, is op dezelfde manier gerapporteerd in de literatuur [53]. Er werd geen trend van de geleidbaarheid waargenomen met betrekking tot een verandering in NW-diameter of contactafstand, zoals verwacht [26]. We sluiten dus de verschillende beeldverhoudingen uit als een foutbron. We identificeren drie hoofdredenen die verantwoordelijk zijn voor de sterke variantie in geleidbaarheid:(i) de contactpassiveringsmethode met ammoniumpolysulfide zou kunnen leiden tot een heterogene contactkwaliteit. (ii) Het draadoppervlak is niet gepassiveerd en de oppervlaktetoestanden kunnen worden beïnvloed door een inhomogene verzadiging van de bungelende bindingen aan de draadzijdefacetten via water en zuurstof, wat uiteindelijk resulteert in niet-uniforme oppervlakte-oxidatie. Dit heeft weer een sterke invloed op de transportkarakteristieken, wat leidt tot grote fouten [54]. Een manier om deze heterogene oppervlaktetoestanden te voorkomen is de passivering via in situ depositie van Al2 O3 [53, 55]. (iii) Inhomogene doping langs het NW, zoals waargenomen voor Si-doping [26], kan ook de grote gegevensspreiding veroorzaken, hoewel we dat probeerden uit te sluiten door de contacten gecentreerd voor elke draad te plaatsen. Ten slotte kunnen variaties in NW-lengte (zie Fig. 1) en dichtheid leiden tot schaduweffecten, waardoor homogene Te-opname over het monster wordt voorkomen. Er is echter meer systematisch onderzoek nodig om de oorsprong van de waargenomen grote variantie te identificeren. Bovendien werden geleidbaarheidsmetingen uitgevoerd voor NW's van serie B die bij een vergelijkbaar lagere As-druk waren gegroeid. Hier werden voor elke GaTe-celtemperatuur minstens zes draden gemeten. De resultaten weergegeven in Fig. 6e vertonen een soortgelijk gedrag als die hierboven zijn besproken voor serie A. De geleidbaarheid van InAs NW's wordt verhoogd voor hogere GaTe-celtemperaturen. Het effect is echter minder uitgesproken in vergelijking met serie A, gekweekt bij een hogere As-druk. Als we de geleidbaarheid van beide reeksen bij 401 °C en 447 °C in Fig. 6e vergelijken, zien we dat de waarden voor reeks A ongeveer twee keer zo groot zijn als die voor B. De hierboven gepresenteerde XRD-resultaten (zie Fig. 5 ) illustreren dat de kristalstructuur in serie A sterker wordt beïnvloed door de Te-opname dan in serie B. De combinatie van beide bevindingen geeft aan dat de verhoogde geleidbaarheid gerelateerd is aan de verandering in kristalstructuur, dwz de verhoogde ZB/(WZ + ZB) intensiteitsverhouding. Het is uit de literatuur bekend dat een wijziging in de InAs NW-kristalstructuur van gedomineerd door WZ naar gedomineerd door ZB, de geleidbaarheid verbetert [50, 53, 56]. Gebaseerd op TEM-onderzoeken op InAs1 − x Sbx NW's, Sourribes et al. rapporteerde een toename van de geleidbaarheid met 1,5 voor een winst in de NW ZB-fractie van 20 tot 80% [50]. Onze TEM-resultaten (zie Fig. 4) laten een verhoogde ZB/(WZ + ZB)-verhouding zien van 32% (ongedopeerd NW) tot 43% (maximaal gedoteerd NW), terwijl de gemiddelde geleidbaarheidswaarde met ongeveer een factor 10 toeneemt. vergelijking suggereert dat de veranderde kristalstructuur niet de enige reden is voor de verbetering van de geleidbaarheid. Hoewel de wijziging van de kristalstructuur het transport van de drager beïnvloedt, is het waargenomen effect waarschijnlijk ook te wijten aan een verhoogde dragerdichtheid die wordt veroorzaakt door Te optreden als donor.
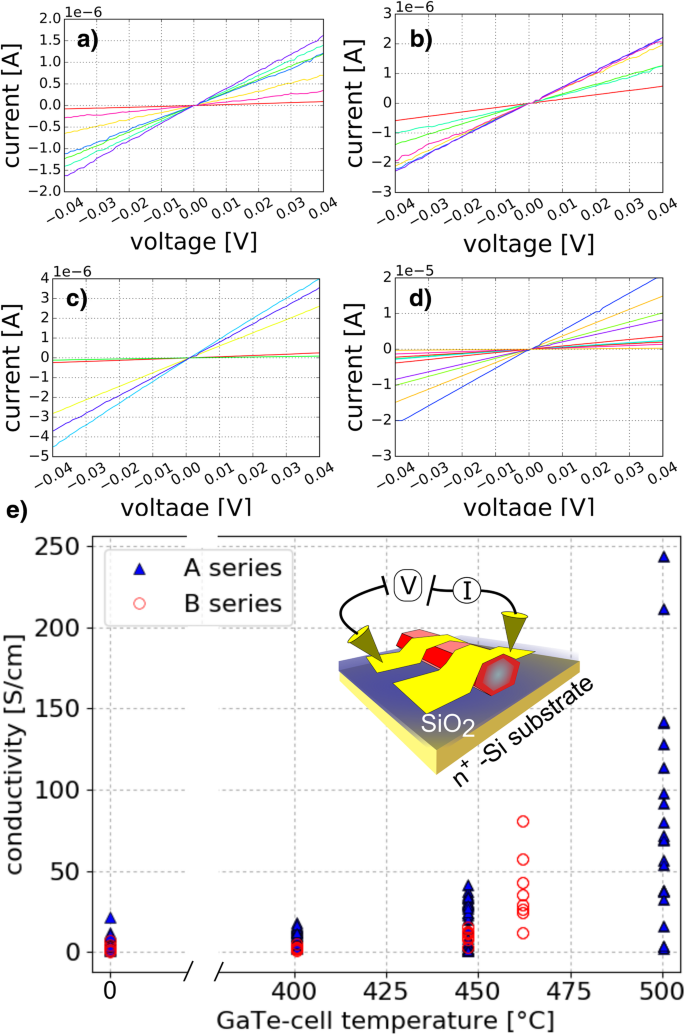
Elektrische karakterisering. een –d Voorbeeldige IV-metingen van InAs NW's bij een GaTe-celtemperatuur van 0 °C, 401 °C, 447 °C en 500 °C (serie A) gemeten via tweepuntscontacten. e Bepaalde geleidbaarheidswaarden van Te-gedoteerde InAs NW's in afhankelijkheid van GaTe-celtemperatuur voor de A (high As-BEP) en B (low As-BEP) series. De inzet toont een schema van de elektrische meetconfiguratie
Conclusie
Samenvattend hebben we Te-gedoteerde katalysatorvrije InAs NW's op Si (111) substraten gekweekt via de damp-vaste groeimethode. Te werd geleverd door een GaTe-cel die de groei van Te-gedoteerde InAs NW's op verschillende doteringsniveaus mogelijk maakte door de celtemperatuur aan te passen. Twee monsterreeksen gekweekt bij verschillende As-BEP's werden gekenmerkt door SEM-, TEM-, XRD- en elektrische metingen. We hebben aangetoond dat Te de NW-morfologie verandert, wat leidt tot een algemene trend van een verhoogde radiale en verminderde axiale groeisnelheid. De impact is sterker bij vergelijkbaar lagere As-partiële drukken. TEM- en XRD-metingen onthulden dat de NW-kristalstructuur wordt beïnvloed door Te-additie, wat resulteert in een toename van de ZB/(WZ + ZB)-verhouding voor beide groeireeksen. De invloed op de NW-kristalstructuur die bij een vergelijkbaar hogere As-BEP was gegroeid, was sterker dan waargenomen voor NW's die bij een lagere As-BEP waren gegroeid. Elektrische tweepuntsmetingen toonden een toename van de gemiddelde geleidbaarheid aan voor draden die onder Te-voeding waren gegroeid. Dit werd waargenomen voor twee groeireeksen, gekweekt bij verschillende As-drukken. De vergelijking tussen de twee monsterreeksen toonde aan dat de kristal- en elektrische eigenschappen van InAs NW's sterker worden beïnvloed door Te-additie bij hogere As-drukken. Het resultaat geeft aan dat de verbeterde gemiddelde geleidbaarheid sterk gerelateerd is aan de verandering in de kristalstructuur, d.w.z. de toename in ZB/(WZ + ZB)-verhouding. We schrijven de verbeterde transporteigenschappen toe aan zowel het opgenomen groep VI-element Te als een donor als een veranderde kristalstructuur. Dit werk vormt een belangrijke bijdrage om de opties voor NW-doping uit te breiden, wat van groot belang is om de achteruitgang van transporteigenschappen door SF's tegen te gaan.
Afkortingen
- Als:
-
Arseen
- BEP:
-
Straal equivalente druk
- C:
-
Koolstof
- GaAs:
-
Galliumarsenide
- GaTe:
-
Galliumtelluride
- HR-TEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- InAs:
-
Indiumarsenide
- MBE:
-
Moleculaire bundelepitaxie
- MOVPE:
-
Metaalorganische dampfase-epitaxie
- NW:
-
Nanodraad
- SEM:
-
Scanning elektronenmicroscopie
- SF:
-
Stapelfout
- Si:
-
Silicium
- Te:
-
Telluur
- VS:
-
Dampvast
- WZ:
-
Wurtziet
- XRD:
-
Röntgendiffractie
- ZB:
-
Zinkmengsel
Nanomaterialen
- IoT-groei ondersteunen
- Groei van CMMS voor kleine bedrijven
- Materiaalwetenschappers leren nanodraden te 'dansen'
- Over halfgeleidende nanodeeltjes
- Onderzoek naar leegstandsstructuren gerelateerd aan hun groei in h-BN-blad
- Zelfgekatalyseerde groei van verticale GaSb-nanodraden op InAs-stengels door metaal-organische chemische dampafzetting
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- Theoretisch onderzoek van biaxiaal trekvaste Germanium-nanodraden
- Groei beheersen Hoge uniformiteit Indiumselenide (In2Se3) nanodraden via het snelle thermische gloeiproces bij lage temperatuur
- Invloed van elastische stijfheid en oppervlakteadhesie op het stuiteren van nanodeeltjes
- Ultraviolet licht-ondersteund koperoxide nanodraden Waterstofgassensor



