Samenstellingsafhankelijkheid van structurele en elektronische eigenschappen van quaternair InGaNBi
Abstract
Om haalbare bandstructuur-engineering en dus verbeterde luminescentie-efficiëntie te realiseren, is InGaNBi een aantrekkelijke legering die kan worden gebruikt in fotonische apparaten van zichtbaar licht en midden-infrarood. In de huidige studie worden de structurele, elektronische eigenschappen zoals bandgap, spin-orbit splitsingsenergie en substraatspanning van InGaNBi versus In- en Bi-samenstellingen bestudeerd met behulp van eerste-principeberekeningen. De roosterparameters nemen bijna lineair toe met toenemende In- en Bi-samenstellingen. Door bismutdoping zou de quaternaire InGaNBi-bandgap een breed energiebereik kunnen dekken van 3,273 tot 0,651 eV voor Bi tot 9,375% en In tot 50%, wat overeenkomt met het golflengtebereik van 0,38-1,9 µm. De berekende spin-baan splitsingsenergie is respectievelijk ongeveer 0,220 eV voor 3,125%, 0,360 eV voor 6,25% en 0,600 eV voor 9,375% Bi. We hebben ook de spanning van InGaNBi op GaN laten zien; het geeft aan dat door het aanpassen van In- en Bi-samenstellingen, InGaNBi kan worden ontworpen op GaN met een acceptabele spanning.
Inleiding
In de afgelopen jaren heeft wurtziet (WZ) In x Ga 1−x N-legeringen en InGaN/GaN-kwantumbronnen (QW's) hebben brede aandacht getrokken vanwege hun grote potentieel voor het ontwikkelen van zonnecellen, zeer efficiënte lichtgevende dioden (LED's) en laserdiodes (LD's) [1-10]. De veelgebruikte [0001]-georiënteerde In x Ga 1−x N/GaN QW's lijden aan een intens ingebouwd elektrisch veld dat wordt veroorzaakt door biaxiale drukspanning van de In x Ga 1−x N-laag [11], die aanleiding geeft tot de afname van QW-emissie-energie en oscillatorsterkte van elektron-gatparen. Bovendien bestaat er een hoge dichtheid aan geometrische defecten in In x Ga 1−x N-legeringen, inclusief stapelfouten en draaddislocaties (TD's) [12]; deze TD's hebben een grote correlatie met niet-stralingsrecombinatiecentra. Defecten, elektronenlekkage en Auger-recombinatie zijn de drie bronnen voor de efficiëntiedaling van In x Ga 1−x N LED's, waarvan de Auger-recombinatie de belangrijkste oorzaak is [13].
Evenzo is voor op GaAs gebaseerde infrarooddiodes al voorgesteld dat bismutlegering een effectieve methode is om de bandgap te verkleinen (E g ) evenals het verbeteren van de spin-orbit (SO)-splitsing om de onderdrukking van het Auger-recombinatieproces te bereiken [14]. Het grootste groep V-element van bismut onthult aantrekkelijke effecten op de fysische eigenschappen van bismidelegeringen. De veranderingen in de bandstructuur van bimidelegeringen zijn zowel experimenteel als theoretisch onderzocht voor verschillende ternaire legeringsmaterialen, zoals AlNBi [15], GaNBi [16, 17], GaSbBi [18, 19], InPBi [20, 21], en InSbBi [19, 22-24]. De bandgap wordt voornamelijk gemodificeerd door de grote Bi-atoom-geïnduceerde stam in hoge concentratie in InPBi. De opname van Bi verstoort de valentiebanden (VB's) vanwege de interactie van Bi-onzuiverheidstoestanden met banden voor zware/lichte gaten en spin-baan-afsplitsingsbanden [21]. Meer recentelijk hebben quaternaire bismide-legeringen (bijvoorbeeld GaAsNBi [25-27], InGaAsBi [28, 29], GaAsPBi [30]) ook veel aandacht gekregen. De lokale vervormingen rond P- en Bi-atomen dragen aanzienlijk bij aan de bandgap-modificatie van GaAsPBi. Een samenstellingsvereiste voor Ga As 1−x −j P j Bi x om een lagere Auger-recombinatieverhouding te bereiken dan GaAs werd verkregen [30]. Het combineren van bismut en een ander III- of V-atoom vergroot de reikwijdte van bandstructuurtechniek, inclusief controle van bandgap, spin-baansplitsing, geleiding (CB) en valentieband-offsets, en spanning [25]. Daarom is het van groot belang om het effect van Bi-substitutie op de [0001] In . te beschrijven x Ga 1−x N/GaN, het afstemmen van de structurele en elektronische eigenschappen en daarmee de luminescentie-efficiëntie. In de huidige studie, met behulp van eerste-principeberekeningen [31], worden de structurele, elektronische eigenschappen zoals bandgap, spin-orbit-splitsingsenergie (Δ ZO ), en substraatstam van InGaNBi versus In- en Bi-samenstellingen worden bestudeerd. Gezien de grote mismatch in het rooster en de slechte kwaliteit voor een In-gehalte hoger dan 55-60% in het InGaN-monster [32] en de lage oplosbaarheid van bismut in verdunde bismide-legeringen, worden de concentraties van In en Bi tot 50% gecontroleerd en 9,375%, respectievelijk. Het blad is als volgt ingedeeld. In de sectie "Methoden" presenteren we de gedetailleerde rekenmethoden. De structurele, elektronische eigenschappen en substraatspanning worden gegeven in de sectie "Resultaten en discussie". Ten slotte wordt een korte samenvatting samengevat.
Methoden
Onze theoretische berekeningen zijn gebaseerd op de dichtheidsfunctionaaltheorie (DFT) [31] zoals geïmplementeerd in de VASP-code [33, 34]. In de berekeningen van structurele eigenschappen worden de elektron-ion- en uitwisseling-correlatie-interacties behandeld met de projector augmented wave-methode (PAW) [35, 36] en de gegeneraliseerde gradiëntbenadering (GGA) van de Perdew-Burke-Ernzerhof (PBE) [37], respectievelijk. De valentie-elektronconfiguraties voor In-, Ga-, N- en Bi-atomen worden gebruikt als 4d 10 5s 2 5p 1 , 3d 10 4s 2 4p 1 , 2s 2 2p 3 , en 5d 10 6s 2 6p 3 , respectievelijk. Om de onderschatting van PBE-potentiaal op de bandgap van de elektronische eigenschappen te overwinnen, gebruiken we het gemodificeerde Becke-Johnson-uitwisselingspotentieel in combinatie met lokale dichtheidsbenaderingscorrelatie (MBJLDA) [38]. Bismut heeft een groot spin-orbit-koppelingseffect (SOC) en daarom wordt SOC meegenomen in de elektronische berekeningen. In alle berekeningen worden de structuren ontspannen totdat de krachten op elk atoom minder worden dan 0,02 eV/Å en de maximale energieverandering in de orde van 10 −4 is. eV. Om de nauwkeurigheid van de berekeningen te garanderen, is een vlakke-golfgrenswaarde van 450 eV ingesteld. Een Monkhorst-Pack van 4×4×4k -point mesh wordt toegepast in de eerste Brillouin-zone.
Resultaten en discussie
Structurele eigenschappen
De supercellen bestaan uit 4×2×2 WZ-GaN primitieve cellen, inclusief 64 atomen. We onderzoeken 36 composities van I n j Ga 1−y N 1−x Bi x met 0≤x ≤0.09375,0≤y ≤0.5 gebaseerd op recente experimenten waarbij het InGaN-monster een grote roostermismatch en een slechte kwaliteit vertoont voor een In-gehalte van meer dan 55-60% [32], evenals de lage oplosbaarheid van bismut in verdunde bismide-legeringen. Er wordt één representatieve configuratie beschouwd waarbij de In- en Bi-atomen gelijkmatig zijn verspreid. We hebben de berekende roosterparameters van ternair In . samengevat j Ga 1−y N en quaternair In j Ga 1−y N 1−x Bi x legeringen samen met andere theoretische en experimentele gegevens in Fig. 1. Voor ongerept GaN, de roosterparameters a =3.211, c =5.235 Å, die goed overeenkomen met andere theoretische berekeningen a =3.155,3.22 Å, c =5.144,5.24 Å [39–41] en experimentele gegevens 3.19 Å voor a , 5.19 Å voor c [42]. De roosterparameters (a , c ) van In j Ga 1−y N stijgt wanneer de samenstelling wordt verhoogd en vertoont een bijna lineaire variatie, zoals weergegeven in figuur 1a. De huidige berekeningen voorspellen a =3.304 Å, c =5,365 Å voor In 0,25 GaN en a =3.397 Å, c =5.509 Å voor In 0,5 GaN, die allemaal goed overeenkomen met eerdere resultaten van a =3.33 Å, c =5.39 Å voor In 0,25 GaN en a =3.43.3.485 Å, c =5.55,5,488 Å voor I n 0,5 GaN [39, 40, 43, 44]. In het geval van quaternaire legeringen In j Ga 1−y N 1−x Bi x Er zijn wat ons betreft geen experimentele en theoretische waarden voor structurele eigenschappen. In figuur 1b nemen de verkregen roosterparameters ook bijna lineair toe met toenemende In- en Bi-samenstellingen. Vanwege grotere ionische stralen van In en Bi dan van Ga- en N-atomen, leidt de substitutie van In over Ga en Bi over N tot verbeterde roosterparameters van InGaNBi.

De roosterparameters voor a ternaire legeringen In j Ga 1−y N , met 0≤y ≤0.5 en b quaternaire legeringen In j Ga 1−y N 1−x Bi x , met 0≤x ≤0.09375, 0≤y ≤0.5. Ter vergelijking voegen we enkele andere berekeningen en experimentele gegevens toe van Ref. [39-44] in afb. 1a. De ononderbroken lijn staat voor a en de stippellijn is c
In- en Bi-opname zal de kristalperiodiciteit doorbreken en geometrische vervorming introduceren in een zwaar gelegeerde structuur. We kiezen voor In 0,25 GaN Bi 0,0625 als voorbeeld voor vier statistieken over chemische bindingen, zoals weergegeven in figuur 2; de gemiddelde lengten van de Ga-N-, In-N-, Ga-Bi- en In-Bi-bindingen zijn respectievelijk 2,09, 2,195, 2,592 en 2,704 . Merk op dat de lengte van de Ga-N-binding in ongerepte bulk GaN 1,970 is. De lengte van de In-N-binding is groter dan die van Ga-N, wat aangeeft dat het In-atoom het N-atoom duidelijk wegduwt. Evenzo betekent de grotere bindingslengte van Ga-Bi dan van Ga-N dat Bi-atoom het Ga-atoom wegduwt en een goede consistentie vindt met de orde van covalente stralen van Ga (1,22 ), In (1,42 Å), N (0,71 ), en Bi (1,48 ) [45]. Andere configuraties vertonen hetzelfde gedrag. Roostervervorming en ongelijkheid in elektronegativiteit tussen de gastheer en het doteringsmiddel hebben een aanzienlijk effect op de elektronische en optische eigenschappen.

Histogram van bindingslengte in In 0,25 GaNBi 0,0625 . De waarden in het paneel geven de gemiddelde lengte aan van de vier soorten bindingen
Elektronische eigenschappen
Het is aangetoond dat de functionele of correctiepotentialen en het SOC-effect grote invloed hebben op de voorspelde nauwkeurigheid van de bandgap-energie van de III-V-legering, de valentieband en de spin-baansplitsingsenergie. Daarom valideren we onze resultaten met behulp van MBJLDA-potentieel en vergelijken we met andere theoretische berekeningen en experimenten. Afbeelding 3 is een grafiek van bandgap-energie versus In-samenstelling in In j Ga 1−y N evenals een fit met de gegevens. Sommige bandgap-waarden verkregen door experimenten, theoretische HSE06-, mBJ- en LMTO-CPA-MBJ-functionaliteiten zijn ook uitgezet. De voorspelde bandgap van GaN is 3,273 eV, wat goed overeenkomt met de huidige berekeningen en experimenten, 3,33 eV volgens mBJ [40], 3,261, 3,23 eV volgens HSE06 [39, 46] en 3,40-3,50 eV volgens experimenten [47- 49]. Zoals waargenomen in I n j G een 1−y N, onze DFT-resultaten bevestigen dat E g waarden van I n j G een 1−y N continu afnemen als y wordt verhoogd van 0 naar 50%. E g neemt geleidelijk af van 3.273 naar 1.546 eV. Dit komt goed overeen met die van theoretische (HSE06, mBJ-potentialen) [39, 40, 46] en experimentele resultaten [50, 51].
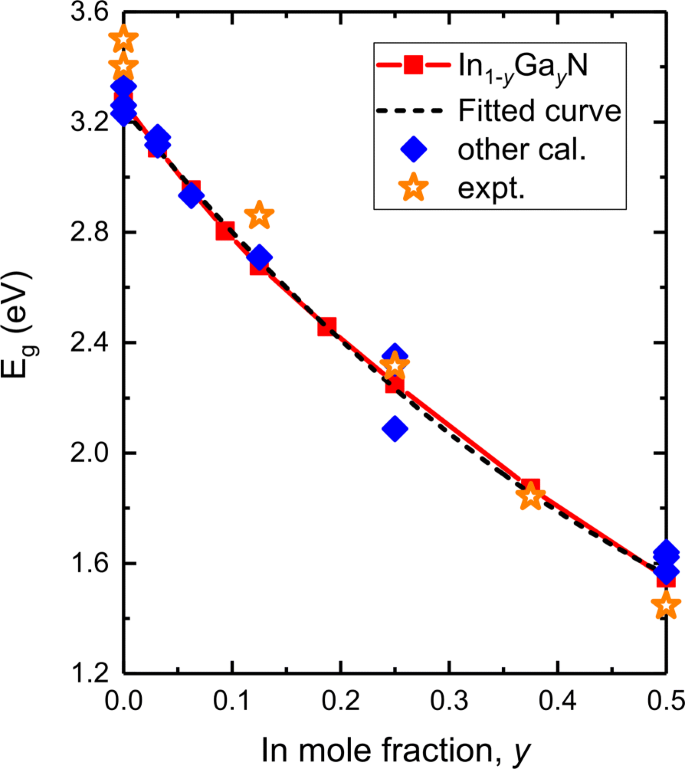
Voorspelde bandgap-energie (E g , rode ononderbroken lijn) als functie van In compositie in I n j G een 1−y N evenals een aanpassing aan de gegevens (zwarte stippellijn). Andere theoretische [39, 40, 46] en experimentele [47-51] resultaten zijn ook uitgezet
De contourplot voor de bandgap van quaternair I n j G een 1−y N 1−x B ik x legeringen wordt getoond in Fig. 4. De bandafstanden van de quaternaire legeringen vertonen een niet-lineaire trend als functie van de samenstelling, die afneemt met toenemende In- en Bi-gehalten. Uit de resultaten blijkt dat de InGaNBi-bandgap een breed energiebereik zou kunnen dekken van 3,273 tot 0,651 eV voor Bi tot 9,375% en in tot 50%, wat overeenkomt met het golflengtebereik van 0,38 tot 1,9 µm, wat hun potentiële opto-elektronische toepassingen in zichtbaar licht en mid-infrarood scope.

Contourplot van de bandgap-waarden voor I n j G een 1−y N 1−x B ik x legeringen, als functie van Bi(x ) en In(y ) composities
Vergeleken met InGaN induceert de opname van Bi een scherpere vermindering van de bandgap. Maar buiten dat, een aanzienlijke toename van Δ ZO wordt verkregen door het sterke SOC-effect van bismut, waarbij de geavanceerde interactie tussen de elektronenspin en het baanimpulsmoment de SO-bandenergie verlaagt. Bovendien verbetert de verbeterde valentiebandrand die voortkomt uit het anti-kruiseffect van de valentieband van bimidelegeringen ook grotendeels Δ ZO [28]. Onze berekende Δ ZO waarden zijn respectievelijk ongeveer 0,220 eV voor 3,125%, 0,360 eV voor 6,25% en 0,600 eV voor 9,375% Bi, wat een onbeduidende variatie heeft met de indiumfractie. Eerdere onderzoeken hebben aangetoond dat verschillende Bi-arrangementen van grote invloed zijn op bandstructuren van bimidelegeringen, inclusief spin-baansplitsingsenergie [21, 52]. De huidige resultaten laten zien dat de I n 0,5 G een N B ik 0.09375 bandgap-waarde (0,651 eV) ligt zeer dicht bij die van Δ ZO (0,577 eV). Aangezien het InGaN-monster een grote roostermismatch en een slechte kwaliteit vertoont voor een In-gehalte hoger dan 55-60% [32], evenals de lage oplosbaarheid van bismut in verdunde bismide-legeringen, hebben we de inhoud van In tot 50% en Bi tot maximaal 9,375%. Wij zijn van mening dat een hoger gehalte aan indium of bismut Δ . zal opleveren ZO >E g in quaternair InGaNBi-monster om de efficiëntie van op InGaNBi gebaseerde LED's en LD's te verbeteren.
De geprojecteerde bandstructuren en totale toestandsdichtheid (TDOS) van ongerept GaN, I n 0,25 GaN, en I n 0,25 G een N B ik 0,03125 legeringen worden weergegeven in Fig. 5. De bijdragen van In en Bi worden gemarkeerd door kleur:blauw (rood) komt overeen met de toestand die afkomstig is van In (Bi). De In-vervanging in I n 0,25 GaN heeft grote invloed op zowel de geleidingsband als de valentieband, waar het geleidingsbandminimum (CBM) wordt gepusht naar lagere energieën met betrekking tot het Fermi-niveau en een smallere energiekloof weerspiegelt. In tegenstelling tot bismut dat de defecte band introduceert in de verboden opening nabij het Fermi-niveau, vertonen de In-atomen een hybridisatie met het diepe niveau van het VB. Voor quaternaire legering I n 0,25 G een N B ik 0,03125 , is duidelijk te zien dat de vermindering van bandgap het gevolg is van zowel opwaartse valentiebandmaximum (VBM) en neerwaartse CBM, en CBM verandert significanter in vergelijking met I n 0,25 GaN, dat wordt toegeschreven aan een grotere drukspanning in InGaNBi door de toevoeging van bismut. Het defectniveau gemarkeerd door rode kleur heeft een sterke interactie met de VB-rand, die is afgeleid van de hybridisatie voornamelijk tussen Bi- en de nabije Ga-atomen. De TDOS in Afb. 5e geeft ook het lokale defectniveau weer bij -1,0 tot -0,5 eV.
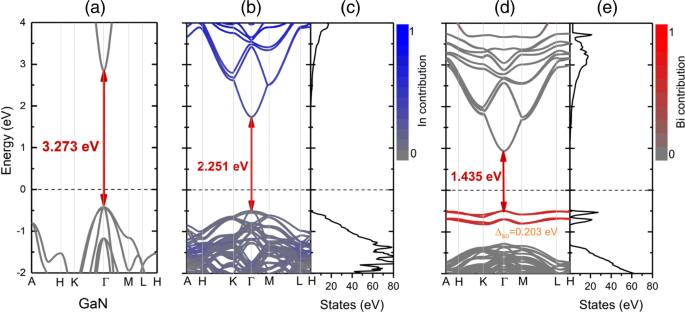
De geprojecteerde bandstructuren en hun overeenkomstige totale toestandsdichtheid (TDOS) van a GaN, b , c Ik n 0,25 G een N , en d , e Ik n 0,25 G een N B ik 0,03125 . De zwarte stippellijn geeft het Fermi-niveau weer, dat op nul staat. De relatieve bijdragen van In en Bi zijn gemarkeerd met een kleur:blauw (rood) komt overeen met de toestand afkomstig van In (Bi)
Strain van InGaNBi op GaN
Het op [0001] georiënteerde I n j G een 1−y N/GaN gespannen kwantumbronnen worden algemeen toegepast in huidige LED- en LD-apparaten, waarin I n j G een 1−y N lagen ondergaan een biaxiale drukspanning. Lokale fluctuaties in de samenstelling en verschillende covalente stralen van In- en Ga-atomen leiden tot de spanningen in I n j G een 1−y N lagen [53]. Afbeelding 6 toont de spanning van InGaNBi op een GaN-substraat. Aangezien het indiumatoom groter is dan het galliumatoom, is het bismutatoom groter dan het stikstofatoom; dus het opnemen van In- en Bi-atomen in InGaNBi induceert compressieve spanning InGaNBi op GaN. Het is aangetoond dat in het In-gehalte van 50% en het Bi-gehalte van 9,375%, InGaNBi onder een hoge drukbelasting van 8,5% staat. Voor In-fractie binnen 6,25% en Bi-fractie binnen 2,8%, ligt de spanning van InGaNBi op GaN binnen 1%. Dat wil zeggen, door de In- en Bi-samenstellingen aan te passen, kan InGaNBi worden ontworpen op GaN met een acceptabele spanning.

Stam van InGaNBi-legeringen op GaN-substraat bij verschillende In (0-0,5) als een functie van Bi-fractie. Positieve waarden van spanning geven aan dat InGaNBi onder druk staat
Conclusies
De structurele, elektronische eigenschappen en spanning van InGaNBi op GaN versus In- en Bi-samenstellingen worden onderzocht op basis van dichtheidsfunctionaaltheorie. De roosterparameters van InGaNBi nemen bijna lineair toe met toenemende In- en Bi-samenstellingen. Omdat In- en Bi-atomen een grotere atoomstraal hebben dan die van Ga- en N-atomen, zijn de In-N- en Ga-Bi-bindingslengtes groter dan die van Ga-N. Voor elektronische eigenschappen hebben we de contourplot getoond voor de bandgap van quaternair I n j G een 1−y N 1−x B ik x legeringen. De bandgap van quaternaire legeringen zou een breed energiebereik kunnen dekken van 3,273 tot 0,651 eV voor Bi tot 9,375% en In tot 50%, wat overeenkomt met het golflengtebereik van 0,38 tot 1,9 µm. De berekende Δ ZO waarden zijn respectievelijk ongeveer 0,220 eV voor 3,125%, 0,360 eV voor 6,25% en 0,600 eV voor 9,375% Bi, wat een onbeduidende variatie heeft met de indiumfractie. Wij zijn van mening dat een hogere indium- of bismutsamenstelling Δ . zal opleveren ZO >E g in quaternair InGaNBi-monster om de efficiëntie van op InGaNBi gebaseerde LED's en LD's te verbeteren. De bandstructuuranalyses laten zien dat het indium een grote invloed heeft op zowel CB als VB, en bismut heeft een sterke interactie met de VB-rand. Ten slotte onderzoeken we de spanning van InGaNBi op GaN. Door de In- en Bi-samenstellingen aan te passen, kan InGaNBi worden ontworpen op GaN met een acceptabele spanning.
Nanomaterialen
- Koolstofvezelversterkte PPA voor structurele auto- en elektronische componenten
- Structuur en elektronische eigenschappen van met overgangsmetaal gedoteerde kaoliniet nanoklei
- Modulatie van elektronische en optische anisotropie-eigenschappen van ML-GaS door verticaal elektrisch veld
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Optische en elektronische eigenschappen van door femtoseconde laser-geïnduceerde zwavel-hyperdoped silicium N+/P fotodiodes
- Structurele en zichtbare infrarood optische eigenschappen van Cr-gedoteerde TiO2 voor gekleurde koele pigmenten
- De structurele, elektronische en magnetische eigenschappen van Ag n V-clusters (n = 1–12) onderzoeken
- Afhankelijkheid van de toxiciteit van nanodeeltjes van hun fysische en chemische eigenschappen
- Elektronische structuur en IV-kenmerken van InSe Nanoribbons
- Automotive PCB-eigenschappen en ontwerpoverwegingen
- Eigenschappen en samenstelling van ruwijzer



