Negatief differentieel weerstandseffect in Ru-gebaseerd RRAM-apparaat vervaardigd door Atomic Layer Deposition
Abstract
In dit werk, Ru-gebaseerde RRAM-apparaten met atomaire laag afgezet AlOy /HfOx functionele laag werden gefabriceerd en bestudeerd. Een negatief differentieel weerstandsgedrag (NDR) werd waargenomen tijdens het spanningsinstellingsproces en de fysieke oorsprong ervan werd onderzocht. Op basis van het fysica-begrip van resistief schakelen, wordt aangenomen dat het gemeten NDR-gedrag verband houdt met het gedeeltelijk unipolaire reset-effect, dat te wijten is aan de recombinatie tussen zuurstofvacatures en de thermisch vrijgekomen zuurstofionen van de RuO2 interface laag. De gemeten elektrische karakteristieken en röntgenfoto-elektronspectroscopie (XPS) resultaten bevestigden de fysieke interpretatie.
Inleiding
Als een van de meest veelbelovende opkomende niet-vluchtige geheugens, is resistief willekeurig toegankelijk geheugen (RRAM) uitgebreid bestudeerd met betrekking tot materiaaloptimalisatie, prestatieverbetering en apparaatintegratie [1,2,3,4]. Vanwege de significante voordelen zoals een eenvoudige celstructuur, hoge operationele snelheid, laag stroomverbruik en onvergelijkbaar miniaturisatiepotentieel [5], is RRAM op grote schaal toegepast in op de hersenen geïnspireerde neuromorfische computing en herconfigureerbare Booleaanse logica [6,7,8,9 ,10] en vertoont ook een groot potentieel voor toepassingen met opslagklassegeheugen (SCM) [11]. Zoals aangegeven door de International Roadmap for Devices and Systems 2017 (https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf), zijn uitdagingen zoals schaalbaarheid, apparaatbetrouwbaarheid en procescompatibiliteit echter nog steeds een belemmering ontwikkelingen van RRAM. Daarom is de constructie van CMOS-compatibele RRAM-apparaten met superieure prestaties van groot belang voor toepassingen die zijn gebaseerd op de 1T1R-structuur van RRAM-cellen [12,13,14]. Volgens een eerdere studie [15] vertoont een op Ru gebaseerd RRAM-apparaat een groot potentieel in vergelijking met op Pt gebaseerde apparaten, terwijl negatieve differentiële weerstand (NDR) werd aangetoond tijdens een spanningsinstellingsproces. De NDR-fenomenen die gepaard gaan met resistief schakelen zijn onderzocht in andere RRAM-structuren, die voornamelijk te wijten waren aan de val / detrap van elektronische dragers tussen diep gelokaliseerde toestanden veroorzaakt door geïmplanteerde metalen nanodeeltjes [16, 17], of de accumulatie van defecten veroorzaakt door herinstallatie van de junctie [18]. Hoewel het verschijnen van NDR in Ru-gebaseerde RRAM-cellen onder grote stroom nog steeds hangende is, werden in dit werk de elektrische prestaties van een op Ru-gebaseerd RRAM-apparaat gefabriceerd door atomic layer deposition (ALD) techniek geëvalueerd. Op basis van de röntgenfoto-elektronspectroscopie (XPS)-karakterisering en elektrische metingen met verschillende stimulus, kan het NDR-fenomeen in het op Ru gebaseerde RRAM worden verklaard in het kader van het zuurstofvacature conductive filament-model.
Methoden
Het schematische diagram van de apparaatstructuur en de gefabriceerde RRAM-array worden respectievelijk getoond in Fig. 1a, b. De Ru/AlOy /HfOx /TiN RRAM-apparaat is vervaardigd op een thermisch geoxideerde 300-nm SiO2 substraat. Een 80-nm Ru-dunne film werd afgezet op een 20-nm Ti-adhesielaag als een bodemelektrode door middel van DC-magnetronsputtering (Angstrom Engineering NEXDEP) met behulp van een Ru-metaaldoel. SiO2 gegroeid door plasma-versterkte chemische dampafzetting (PECVD) dient als diëlektricum om elektroden te isoleren en vormt de via's. Dan de resistieve laag van 2 nm AlOy en 3 nm HfOx werd afgezet door een atomair laagafzettingssysteem (PICOSUN R200) bij 300 ° C met trimethylaluminium (TMA) en tetrakis [ethylmethylamino] hafnium (TEMAH) voorlopers. Daarna werd 80 nm TiN reactief gesputterd met behulp van een Ti-doel en geëtst om de patronen van de bovenste elektrode te vormen. Er werd ook nog een droge etsing uitgevoerd om de onderste elektrode bloot te leggen voor elektrisch contact.
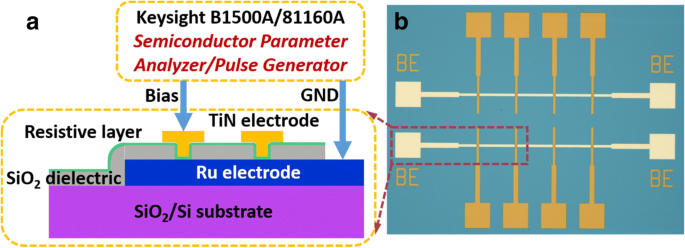
een Schematisch diagram van een Ru-gebaseerd apparaat. b Gefabriceerde RRAM-array
De elementanalyse werd uitgevoerd door een röntgenfoto-elektronspectroscopie (XPS) -systeem (Thermo Scientific ESCALAB 250Xi) met behulp van het verse monster zonder een topelektrode. Voorafgaand aan de meting werd voorafgaand aan de meting oppervlaktereiniging uitgevoerd met Ar-plasma om de invloed van C te elimineren. De piekpositie van Al 2p werd gebruikt voor kalibratie. De elektrische metingen zijn uitgevoerd bij kamertemperatuur door een halfgeleiderapparaatanalysator (Agilent B1500A) en een willekeurige generator met pulsfunctie (Agilent 81160A).
Resultaten en discussie
De typische IV-kenmerken van op Ru-gebaseerde RRAM-apparaten worden getoond in figuur 2a. Na het elektroformeren werd een positieve spanning (2,5 V) toegepast voor het instelproces om de cel over te schakelen van een hoge-weerstandstoestand (HRS) naar een lage-weerstandstoestand (LRS) met een compliantiestroom van 1 mA om de permanente storing tijdens de geleidende filament (CF) vorming. Na de ingestelde overgang werd een negatieve spanning (− 2,3 V) gebruikt om het apparaat van LRS naar HRS te schakelen met een geleidelijk afnemende stroom. Om de weerstandsvariabiliteit van apparaat tot apparaat te evalueren, werden willekeurig 10 Ru-gebaseerde RRAM-cellen gekozen. Zoals weergegeven in figuur 2b, demonstreren de statistische resultaten de uitstekende uniformiteit van HRS en LRS met een weerstandsvenster groter dan 10 3 , wat een veelbelovende kandidaat zou kunnen zijn voor NVM-gebaseerde logische toepassingen. Vergeleken met de eerder gerapporteerde Pt-gebaseerde apparaten [2], is het vermeldenswaard dat een NDR-fenomeen werd waargenomen tijdens het set-proces, waarbij de stroom afneemt met de toenemende spanning (set-fase 1) in een beperkte spanningsschaal gevolgd door toenemende naar conformiteitsstroom (instelfase 2).

een DC-kenmerken. b HRS/LRS statistische distributies van 10 Ru-gebaseerde RRAM-apparaten
De cyclus-tot-cyclus-variabiliteit van op Ru-gebaseerde RRAM-apparaten werd ook onderzocht in de pulsmodus om de fietsuniformiteit te bestuderen. De pulsen voor set (2,4 V, 15 ns) en pulse (-3 V, 100 ns) worden gebruikt om het apparaat te schakelen tussen LRS en HRS met een leesspanning van 0,1 V na elke puls. Zoals weergegeven in figuur 3a, heeft het apparaat van 1000 cycli een uniforme verdeling met standaarddeviaties van 379 Ω en 3 × 10 5 Ω voor LRS en HRS, wat resulteert in een stabiel geheugenvenster groter dan 100. Er treedt geen verslechtering van het uithoudingsvermogen op, zelfs niet na 10 6 schakelcycli zoals eerder gerapporteerd in Ref. [15]. Bovendien vertoont het apparaat ook een uitstekende retentie-eigenschap, zoals weergegeven in figuur 3b. Zowel de LRS- als de HRS-weerstand behouden een constante waarde van meer dan 10 5 s bij 120 °C zonder storing.

een 1000 uithoudingscycli. b Retentiegedrag bij hoge temperatuur van een Ru/AlOy /HfOx /TiN RRAM-apparaat
Om het NDR-fenomeen te onderzoeken, heeft de I–V curven werden gemeten in zowel de spanningszwaaimodus als de stroomzwaaimodus. Afbeelding 4a toont het vormingsproces van vijf willekeurig geselecteerde verse RRAM-cellen. De stroom neemt geleidelijk toe, gevolgd door een abruptie, wat wijst op de vorming van CF, terwijl er geen NDR werd waargenomen. Na het elektroformeren worden in dezelfde cel instelbewerkingen in verschillende zwaaimodi uitgevoerd om de stroomvariatie te observeren, zoals weergegeven in figuur 4b. Voor de stroomgestuurde set neemt de stroom langzaam toe met een plotselinge afname van de spanning, wat de overgang van weerstand van HRS naar LRS aantoont. Dit gedrag verschilt van het kenmerk dat wordt aangedreven door spanning, wat te wijten kan zijn aan de verschillende stimuli-geïnduceerde Joule-verwarming over de CF. Bovendien werden opeenvolgende set / reset-bewerkingen onder verschillende vooroordelen uitgevoerd om de tussenliggende weerstandstoestand in het NDR-gebied te onderzoeken. Tijdens het instelproces werd een geschikte stopspanning van 1 V toegepast, zoals weergegeven in figuur 4c, om de zwaai op de bodem van de vallei te beëindigen. Een niet-vluchtige weerstandstoestand werd verkregen nadat de spanning was verwijderd, die een unipolair resistief schakelgedrag vertoonde. Daarom wordt dit NDR-fenomeen voorlopig toegeschreven aan een tweede reset van de CF tijdens het instelproces.
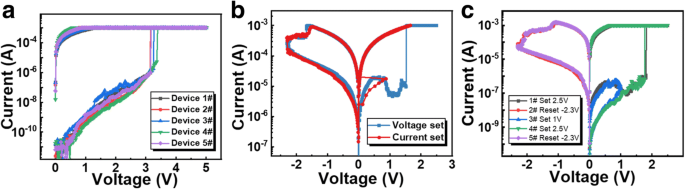
een Spanningsvorming van vijf Ru-gebaseerde RRAM-apparaten. b Spanningsgestuurde en stroomgestuurde setprocessen in dezelfde RRAM-cel. c Onvolledig instelproces met de stopspanning op de bodem van de huidige vallei
Gecombineerd met de metingen in verschillende modi en fabricageprocessen van apparaten, evenals de eigenschappen van RuO2 , werd de fysieke oorsprong van het NDR-fenomeen voorgesteld, zoals geïllustreerd in Fig. 5. Een eerdere studie [19, 20] suggereerde dat het genereren en recombinatie van elektronenarme zuurstofleegte (V o ) en zuurstofion (O 2− ) onder verschillende elektrische polariteiten zijn verantwoordelijk voor de conventionele HfOx -gebaseerde bipolaire RRAM-apparaten, die vergelijkbaar zijn met de set-phase 2 en reset-processen. In tegenstelling tot het conventionele instelproces vindt er echter een tweede breuk van de CF plaats, waarbij de Ru-elektrode en CF worden losgekoppeld en naar de NDR wordt geleid. Over het algemeen dissociëren de zuurstofatomen in V o en O 2− onder elektrisch veld met het afdrijven van de O 2− naar de bovenste elektrode, waarbij de V o om de CF te vormen die wordt gebruikt voor elektronentransport. Maar vanwege de Joule-verwarming veroorzaakt door het elektrische veld, werd de gevormde RuO2 interfacelaag zou langzaam ontleden bij ~ 600 °C en O 2− vrijgeven die zou kunnen recombineren met het elektron verarmde V o (V o 2+ ) nabij de Ru-elektrode (instelfase 1) [21], wat resulteert in een stroomafname. Dit proces kan ook worden gezien als een gedeeltelijk unipolair resetproces. Met de verder toenemende spanning zal de CF tussen TE en BE worden gereconstrueerd door een accumulatie van V o zoals weergegeven in set-fase 2 en RRAM-cel schakelt over naar LRS. Tijdens het resetten vinden twee processen tegelijkertijd plaats:(1) de O 2− vrijkomt uit de TiN-elektrode recombineert snel met de positief geladen V o vanwege de verbeterde opnamesectie, (2) de O 2− afdrijvend naar BE reageert met Ru en hervormt de RuO2 interfacelaag als gevolg van de lokale Joule-verwarming [22]. In deze toestand schakelt de RRAM-cel over naar HRS.

Fysieke processen van resistief schakelen in op Ru gebaseerde RRAM. een NDR-effect (set-fase 1). b Gemeenschappelijke SET (set-fase 2) processen. c RESET-proces van het apparaat
XPS-analyse van de RuO2 interfacelaag, die werd gevormd tijdens het fabricageproces van het apparaat, ondersteunt ook de voorgestelde verklaring van het NDR-effect. Afbeelding 6a toont het volledige XPS-spectrum van het monster, inclusief O 1s-, Ru 3d-, Al 2p- en Hf 4f-kernniveaus. De andere ongemarkeerde pieken komen allemaal overeen met deze elementen met verschillende elektronenbanen. De aanpassingscurve in Fig. 6b past perfect bij de experimentele gegevens en is verdeeld in vier pieken, die overeenkomen met de Ru 3d5/2 (280,01 eV voor Ru en 280,75 eV voor RuO2 ) en Ru 3d3/2 (284,3 eV voor Ru en 285,26 eV voor RuO2 ) kernniveaus, die het naast elkaar bestaan van de Ru en RuO2 . aantonen in de dunne film [23]. De lage intensiteit van Ru 3d5/2 piek geeft aan dat de gevormde RuO2 interfacelaag is erg dun zoals we hadden verwacht.

XPS-spectra van a Ru/AlOy /HfOx dunne film en b Ru 3D-kernniveau. De RuO2 dunne film tussen Ru en AlOy formulieren tijdens ALD-proces [18]
Conclusie
In deze studie heeft de CMOS-compatibele Ru/AlOy /HfOx /TiN RRAM-apparaat is gefabriceerd. De uitstekende schakelprestaties werden bereikt met uniforme apparaat-naar-apparaat-weerstand en een groot weerstandsvenster, evenals een goede retentie-eigenschap bij hoge temperatuur. Op basis van de elektrische metingen en XPS-analyse kan het NDR-fenomeen in het setproces worden verklaard door de recombinatie van zuurstofvacatures en zuurstofionen die vrijkomen uit de RuO2 interfacelaag door de elektrisch geïnduceerde Joule-verwarming.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- CF:
-
Geleidend filament
- HRS:
-
Staat met hoge weerstand
- LRS:
-
Staat met lage weerstand
- NDR:
-
Negatieve differentiële weerstand
- PECVD:
-
Plasma verbeterde chemische dampafzetting
- RRAM:
-
Resistief willekeurig toegankelijk geheugen
- SCM:
-
Opslagklasse geheugen
- XPS:
-
Röntgenfoto-elektronenspectroscopie
Nanomaterialen
- Wat is het huideffect?
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- Het effect van sulfaatanionen op de ultrafijne Titania-kiemvorming
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Effecten van etsvariaties op Ge/Si-kanaalvorming en apparaatprestaties
- Temperatuureffect op de mechanische eigenschappen van Electrospun PU-nanovezels
- Atomaire laagafzetting bij lage temperatuur van SiO2 met behulp van koolstofdioxide



