Atomaire laagafzetting bij lage temperatuur van SiO2 met behulp van koolstofdioxide
Abstract
In dit werk rapporteren we de succesvolle groei van SiO2 . van hoge kwaliteit films door plasma-versterkte atomaire laagafzetting bij lage temperatuur met behulp van een oxidatiemiddel dat compatibel is met vocht/zuurstofgevoelige materialen. De SiO2 films werden gekweekt bij 90 °C met behulp van CO2 en bis(tertiair-butylamino)silaan als procesvoorlopers. Groei, chemische samenstelling, dichtheid, optische eigenschappen en restspanning van SiO2 films werden onderzocht. SiO2 films met een verzadigde groei-per-cyclus van ~ 1.15 Å/cyclus vertoonden een dichtheid van ~ 2.1 g/cm 3 , een brekingsindex van ~ 1,46 bij een golflengte van 632 nm en een lage trekspanning van ~ 30 MPa. Verder vertoonden de films lage onzuiverheidsniveaus met bulkconcentraties van ~ 2.4 en ~ 0.17 at. % voor respectievelijk waterstof en stikstof, terwijl het koolstofgehalte lager bleek te zijn dan de meetlimiet van de analyse van de elastische terugslagdetectie tijdens de vlucht. Deze resultaten tonen aan dat CO2 is een veelbelovende oxiderende voorloper voor vocht-/zuurstofgevoelige materialen die verband houden met plasma-versterkte atomaire laagafzettingsprocessen.
Achtergrond
SiO2 is een veelgebruikt materiaal voor toepassingen zoals micro-elektronica [1, 2], micro-elektromechanische systemen [3, 4], fotovoltaïsche systemen [5, 6] en optica [7, 8]. Terwijl SiO2 dunne films kunnen op verschillende manieren worden gekweekt, zoals thermische oxidatie, plasma-versterkte chemische dampafzetting (PECVD) of fysieke dampafzetting (PVD), atomaire laagafzetting (ALD) biedt het uitzonderlijke voordeel van een combinatie van nauwkeurige filmdiktecontrole, hoge uniformiteit , en conformiteit [9,10,11].
Veel ALD-processen, met verschillende Si-precursoren (chloorsilanen of aminosilanen) en oxidanten (H2 O, H2 O2 , of O3 ), zijn ontwikkeld voor de groei van SiO2 . Die processen vereisen doorgaans relatief hoge temperaturen (> 150 °C) [12,13,14,15,16]. Voor processen die compatibel zijn met thermisch gevoelige materialen zoals organische, biologische en polymere materialen, zijn de gekatalyseerde ALD [17,18,19] en plasma-enhanced atomic layer deposition (PEALD) [9, 20,21,22] gebruikt als een effectieve oplossing bij procestemperaturen onder 100 °C. De veelgebruikte H2 O en O2 Oxidanten op basis van oxidatie kunnen bij vocht/zuurstofgevoelige materialen leiden tot materiaaldegradatie. Vergeleken met H2 O en O2 , bij lage temperatuur, CO2 is niet chemisch reactief. Gebruik in dit geval CO2 als oxidatiemiddel kan de afbraak van vocht/zuurstofgevoelige materialen tot een minimum worden beperkt door onnodige oxidatie te vermijden. Bovendien, CO2 werd door King [23] gerapporteerd als een levensvatbaar oxidatiemiddel voor de groei van PEALD SiO2 films bij gebruik van SiH4 als een Si-voorloper. De groeitemperaturen van die PEALD-processen, die in het bereik van 250-400 °C lagen, zijn echter niet compatibel met materialen die gevoelig zijn voor hoge temperaturen.
In dit werk rapporteren we de ontwikkeling van een CO2 -gebaseerd PEALD-proces voor SiO2 films bij 90°C. De afhankelijkheid van de filmgroei van de procesparameters (precursorpuls/purgetijd en plasmavermogen) wordt onderzocht. We rapporteren ook de chemische samenstelling, structurele en optische eigenschappen en restspanningsanalyse van de films.
Methoden
Filmvoorbereiding
PEALD SiO2 films werden gekweekt op Si(100) en saffiersubstraten bij 90 °C met behulp van CO2 (99,5%, Air Products) plasma als zuurstofbron en bis(tertiair-butylamino)silaan (BTBAS) (97%, Strem Chemicals) als Si-precursor [22]. De processen werden uitgevoerd in een Beneq TFS 200-reactor met een plasmasysteem op afstand met behulp van een capacitief gekoppelde 13,56 MHz radiofrequentie (rf)-gestuurde bron. De N2 (99,999%, AGA) werd gebruikt als drager- en spoelgas met een doorstroom van 600 sccm in de reactor, terwijl een menggas van N2 (200 sccm) en CO2 (75 sccm) stroomde door het plasmasysteem. De gekozen plasmavermogens in deze studie waren gebaseerd op de stabiliteit van het plasmasysteem. De brontemperatuur van BTBAS was ingesteld op 21 °C en een N2 booster werd toegediend tijdens de precursorpuls. De details van procesparameters worden weergegeven in Tabel 1. Tijdens de PEALD-processen was de reactordruk ongeveer 1 hPa.
Filmkarakterisering
De dikte van PEALD SiO2 films werden bepaald met een SENTECH SE400adv-ellipsometer met behulp van een HeNe-laser bij een golflengte van 632,8 nm en bij een invalshoek van 70 °. De groei per cyclus (GPC) werd berekend met behulp van de verkregen filmdikte gedeeld door het aantal ALD-cycli. De afwijking van de GPC was gebaseerd op de niet-uniformiteit van de filmdikte.
De chemische samenstelling werd gemeten door optische emissiespectroscopie met gloeiontlading (GDOES), time-of-flight elastische terugslagdetectie-analyse (TOF-ERDA) en verzwakte totale reflectie Fourier-transformatie infraroodspectroscopie (ATR-FTIR). GDOES-metingen werden uitgevoerd op een Horiba GD-Profiler 2. Er werd gebruik gemaakt van een anode met een diameter van 4 mm en een RF-vermogen van 35 W in de gepulseerde modus. De elementaire intensiteiten werden gerapporteerd als waarden geïntegreerd over de gehele filmdikte zoals beschreven in Ref. [22]. Voor TOF-ERDA-metingen werden 40 MeV energie Br ionen verkregen uit een 5MV tandemversneller gericht op de gemeten monsters. De detectiehoek was 40°. ATR-FTIR-metingen werden uitgevoerd met een Thermo Electron Corporation Nicolet 380 ATR-FTIR-spectrometer met een diamantkristal als intern reflectie-element. De procedure omvatte een achtergrondverzameling van het Si-substraat en gegevensverzameling van de monsters. Een −1 . van 2 cm resolutie over de 800–4000 cm −1 golfnummerbereik werd gebruikt.
Röntgenreflectiviteitsanalyses (XRR) werden uitgevoerd met een Philips X'Pert Pro-diffractometer met behulp van Cu-Kα1 straling. De filmdichtheid werd verkregen uit de gemeten gegevens met behulp van een in-house ontwikkelde aanpassoftware [24]. Een grensvlak oxidelaag tussen het siliciumsubstraat en de PEALD SiO2 film werd gesimuleerd als onderdeel van het XRR-paslaagmodel. Met behulp van een PerkinElmer Lambda 900-spectrometer, transmissiespectrum van de PEALD SiO2 film werd opgenomen in het golflengtebereik van 360-800 nm na de groei op saffiersubstraat. De brekingsindex (n ) en extinctiecoëfficiënt (k ) werden bepaald met Cauchy-fitting uit het transmissiespectrum. Om een goede pasnauwkeurigheid te garanderen, is voor deze meting een 150 nm dikke SiO2 films werden gekweekt op saffiersubstraten.
De restspanning van 50 nm dikke PEALD SiO2 films werd bepaald met de wafercurvature-methode [25] en de vergelijking van Stoney [26]. De wafelkromming werd gemeten voor en na filmgroei met een TOHO FLX-2320-S-instrument. De wafels werden biaxiaal gescand met een scanlengte van 120 mm. Meetresultaten werden gepresenteerd met maximale meetonzekerheid [25].
Resultaten en discussie
Filmgroei
De afhankelijkheid van de SiO2 film GPC op de BTBAS-puls en spoeltijd werd onderzocht tijdens de oxidatiestap met een vast plasmavermogen van 180 W, een CO2 plasmablootstellingstijd van 3 s, en een CO2 plasma-spoeltijd van 2 s. Afbeelding 1a en b tonen de GPC-waarden als functie van respectievelijk de BTBAS-puls en de zuiveringstijd. Voor de afhankelijkheid van de pulstijd was de BTBAS-spoeltijd ingesteld op 3 s, terwijl voor de afhankelijkheid van de pulstijd de BTBAS-pulstijd was ingesteld op 0,3 s. Zoals getoond in Fig. 1a, wordt de laagste GPC verkregen met een BTBAS-puls van 0,05 s, terwijl een pulstijd van 0,1 s voldoende blijkt te zijn om een zelfbeperkende groei te bereiken met een GPC van ~ -1,15 /cyclus. Bovendien, wanneer een vaste BTBAS-puls van 0,3 s en een afnemende zuiveringstijd van 3 tot 0,5 s (Fig. 1b) worden gebruikt, wordt geen verandering van GPC waargenomen. Dit geeft aan dat de toegepaste korte spoeltijd van BTBAS voldoende is om CVD-componenten te voorkomen. Merk echter op dat de uniformiteit van de filmdikte werd verbeterd met toenemende spoeltijd.

GPC van PEALD SiO2 films gegroeid op Si-substraten als functie van BTBAS a pulstijd en b opruimtijd. Het toegepaste plasmavermogen was 180 W
De SiO2 groei tijdens de oxidatiestap werd onderzocht met behulp van een vaste BTBAS-puls en een zuiveringstijd van respectievelijk 0,3 en 3 s. Afbeelding 2a en b tonen de GPC van PEALD SiO2 films gegroeid op Si-wafels als functie van de CO2 respectievelijk plasmablootstelling en zuiveringstijd. Tijdens de studie van de effecten van blootstelling aan plasma werden plasmavermogens van 50, 180 en 300 W toegepast. Als algemene observatie wordt de hoogste GPC-waarde van 1,15 Å/cyclus, die kan worden beschouwd als de verzadigde GPC bij 90 °C [27], waargenomen in alle plasmavermogensomstandigheden. Voor het proces met een plasmablootstellingstijd van 1 s, onafhankelijk van het gebruikte vermogen, wijzen GPC-waarden onder 1,15 Å/cyclus op onvolledige filmgroei. Dit geeft aan dat de plasmablootstellingstijd van 1 s niet lang genoeg is om voldoende O-radicalen te genereren. Deze radicalen, die nodig zijn voor een volledige oppervlaktereactie, zijn het resultaat van CO2 plasmadissociatiereacties [28]. Voor een plasmavermogen van 50 W blijkt de GPC toe te nemen met een toename van CO2 plasmablootstellingstijd tot 6 s, waarna de GPC de verzadigde waarde van 1,15 Å/cyclus bereikt. Deze waarde blijft constant gedurende een belichtingstijd tot 15 s. Voor films die met een hoger vermogen (180 en 300 W) zijn gekweekt, wordt echter een inverse V-trend van de GPC waargenomen voor een plasmablootstellingstijd tussen 1 en 6 s. Volgens onze eerder gerapporteerde groeistadia van PEALD-films [27] en de verkregen hoogste GPC van 1,15 / cyclus in dit werk, wordt groeiverzadiging bereikt bij 180 en 300 W met een plasmablootstellingstijd van 3 s. Voor een plasmablootstellingstijd van 6 s is de verlaagde GPC waarschijnlijk een gevolg van de filmverdichting, vergelijkbaar met degene die we eerder hebben gerapporteerd voor PEALD van Al2 O3 dunne films [27]. Merk op dat deze twee curven (die de afhankelijkheid van de GPC van CO2 . weergeven plasmablootstellingstijd voor 180 en 300 W) volledig overlappen. De waargenomen overlapping van de GPC-curven suggereert dat de groei van de SiO2 films met 180 en 300 W hebben identieke mechanismen die verband kunnen houden met een vergelijkbare hoeveelheid ionen- en radicale fluxen die worden gegenereerd door plasma met hoog vermogen [29]. Vergeleken met het geval van hoge vermogens, is het groeigedrag van SiO2 dunne films met een plasmavermogen van 50 W is anders omdat er geen filmverdichting optreedt. Dit is hoogstwaarschijnlijk te wijten aan de relatief lage ionen- en radicale fluxen als gevolg van het lage vermogen van 50 W [29].

GPC van PEALD SiO2 films gegroeid op Si-substraten als functie van CO2 plasma a belichtingstijd met gevarieerde plasmavermogens van 50, 180 en 300 W, en b spoeltijd met een plasmavermogen van 180 W
Het effect van CO2 plasma-spoeltijd op de GPC wordt getoond in Fig. 2b. Net als in het geval van afhankelijkheid van de BTBAS-spoeltijd, blijken de GPC-waarden constant te blijven wanneer CO2 De spoeltijd wordt gevarieerd tussen 0,5 en 3 s. Er kan dus worden geconcludeerd dat de toegepaste zuiveringstijd van beide voorlopers een verwaarloosbare invloed heeft op de GPC van onze SiO2 dunne films. Dit verschilt van een eerder gerapporteerd PEALD-proces met SAM.24, verwante aminosilanen van BTBAS en O2 plasma [9], waarbij purgeerstappen met een purgeertijd korter dan 2 s een significant effect bleken te hebben op de filmgroei. Hier zou de onafhankelijkheid tussen onze toegepaste voorloperspoeltijd en de GPC kunnen worden toegewezen aan de effectieve verwijdering van resterende voorlopers en bijproducten die gedeeltelijk zouden kunnen profiteren van het ontwerp van de reactiekamer met behulp van de kruisstroom. Een dergelijke configuratie maakt de gasuitwisselingstijd tussen voorloperpulsen relatief kort. Toch kan de plakkerigheid van voorlopers niet worden uitgesloten. Gebaseerd op de resultaten getoond in Fig. 2a, door gebruik te maken van BTBAS puls/purge-tijd van 0,3 s/3 s en CO2 plasmablootstelling/spoeltijd van 3 s/2 s, de hoogste depositiesnelheid tijdens de verzadigde groei is 50 nm/h. Dit houdt in dat door het toepassen van een hoog plasmavermogen en het gebruik van BTBAS-puls/spoeltijd van 0,1 s/0,5 s en CO2 plasmablootstelling/spoeltijd van 3 s/0,5 s, een afzettingssnelheid tot 100 nm/u is haalbaar.
Filmeigenschappen
De dichtheid van de SiO2 films werden bestudeerd met XRR en de resultaten worden getoond in Fig. 3. De gemeten monsters werden gekweekt op Si-substraten met behulp van een gevarieerde plasmablootstellingstijd met een plasmavermogen van 180 W, een BTBAS-pulstijd van 0,3 s, een BTBAS-zuiveringstijd van 3 s, en een CO2 plasma-spoeltijd van 2 s. De bestudeerde monsters zijn gelabeld als "SiO1", "SiO3" en "SiO6" voor een plasmablootstellingstijd van respectievelijk 1, 3 en 6 s. Hoewel de waarden binnen de meetfoutmarge vallen, worden de laagste en hoogste gemiddelde waarden weergegeven in respectievelijk "SiO1" en "SiO6", wat suggereert dat de filmdichtheid enigszins wordt verhoogd met een toename van de blootstellingstijd aan het plasma. Dit ondersteunt onze hypothese van filmverdichting tijdens het proces met een plasmavermogen van 180 W en een belichtingstijd van 6 s. In het geval van verzadigde groei, hoewel onze filmdichtheid van 2,11 g/cm 3 komt goed overeen met waarden gerapporteerd in eerdere onderzoeken voor O2 -gebaseerde PEALD SiO2 films die commerciële ALD-reactoren gebruiken met groeitemperaturen tussen 50 en 300 °C [9, 21, 30], is lager dan de waarde (2,3 g/cm 3 ) gerapporteerd door King die de PEALD SiO2 . demonstreerde proces bij 400 °C in een gemodificeerde PECVD-reactor [23].

Dichtheid van SiO2 films gegroeid met een plasma-blootstellingstijd van 1, 3 en 6 s
De chemische samenstelling van PEALD SiO2 werd gemeten door GDOES. Omdat de metingen niet zijn gekalibreerd voor diepteprofilering van de samenstelling, d.w.z. er is geen rekening gehouden met de elementafhankelijke emissiesnelheid, kunnen alleen de intensiteiten van hetzelfde element tussen verschillende monsters worden vergeleken en is er geen vergelijking tussen verschillende elementen mogelijk. Daarom geven de GDOES-metingen in dit geval nogal kwalitatieve informatie over de chemische samenstelling. De gedetecteerde elementen, Si, O, H, N en C, worden weergegeven in Fig. 4. Zoals weergegeven in de afbeelding, hoewel de intensiteit van H in "SiO1" iets lager is dan in de andere monsters, rekening houdend met de fout marges worden geen significante effecten van de plasmablootstellingstijd op het Si-, O- en H-gehalte waargenomen. Deze bevinding is vergelijkbaar met plasma-power-effecten die zijn gerapporteerd in ons eerdere werk over PEALD SiO2 gekweekt met behulp van BTBAS en O2 plasma [22]. In het geval van het N-gehalte zijn de intensiteiten voor "SiO1" en "SiO3" vrij constant, terwijl een lagere intensiteit wordt gemeten voor "SiO6". Dit suggereert dat verwijdering van N onzuiverheden effectiever is tijdens de filmverdichting. Merk op dat, onafhankelijk van de groeiomstandigheden van het monster, alle gemeten monsters dezelfde intensiteit vertonen voor het C-gehalte.

Kwalitatieve chemische samenstelling van SiO2 films gegroeid met de plasmablootstellingstijd van 1, 3 en 6 s gemeten door GDOES. De meting heeft een nauwkeurigheid van ± 15% en de elementaire vergelijking van de intensiteiten is in dit werk niet mogelijk (er is geen kalibratiefactor beschikbaar)
Verdere evaluatie van de chemische samenstelling van de film werd uitgevoerd met behulp van TOF-ERDA- en ATR-FTIR-metingen. Rekening houdend met het feit dat verzadigde groei normaal gesproken het doelwit is van ALD-processen, richten we ons onderzoek in wat volgt op monsters gekweekt met een plasmavermogen van 180 W, een BTBAS-pulstijd van 0,3 s, een BTBAS-zuiveringstijd van 3 s, een CO 2 plasmablootstellingstijd van 3 s, en een CO2 plasma-spoeltijd van 2 s. TOF-ERDA diepteprofiel en elementsamenstelling worden getoond in Fig. 5a. Merk op dat de neerwaartse helling van O getoond in het filmdiepteprofiel wordt veroorzaakt door het effect van het Si-substraat, wat correleert met de diepteresolutie van TOF-ERDA voor onze SiO2 /Si voorbeeldstructuur. Bij de analyses van de elementsamenstelling is rekening gehouden met het substraateffect. Het onderzochte monster vertoont lage onzuiverheidsniveaus met bulkconcentraties van ~ 2.4 en ~ 0.17 at. % voor respectievelijk waterstof en stikstof, terwijl de totale C-concentratie in de hele film onder de meetlimiet van TOF-ERDA blijkt te zijn. Op basis van de informatie over het diepteprofiel worden de koolstoftellingen meestal verzameld van het filmoppervlak. Daarom speculeren we dat het C-gehalte dat is gedetecteerd door GDOES-metingen en weergegeven in Fig. 4 te wijten kan zijn aan de verontreiniging van het monster tijdens opslag of vanuit de testomgeving. Het is vermeldenswaard dat de H-concentratie ook hoger blijkt te zijn aan het oppervlak dan de bulk. Bovendien blijken de films een licht zuurstofrijke samenstelling te hebben met een Si/O-verhouding van ~~0,48. Dit resultaat komt overeen met het resultaat dat is gerapporteerd door Dingemans et al. voor PEALD SiO2 gekweekt met SAM.24 en O2 plasma in een temperatuurbereik tussen 100 en 300 °C [9]. Deze zuurstofrijke samenstelling is hoogstwaarschijnlijk te wijten aan de bijdrage van resterende -OH-soorten die aan de films zijn achtergebleven.
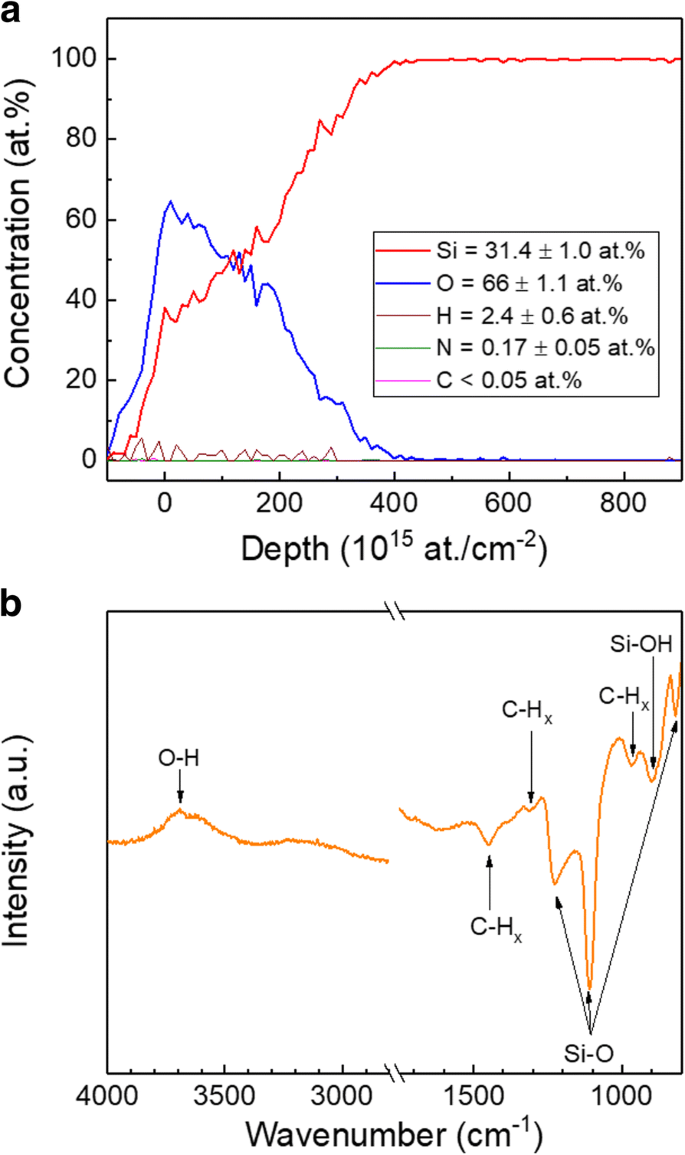
een TOF-ERDA diepteprofiel en b ATR-FTIR-transmissiespectrum van de SiO2 film. De beoogde filmdikte was 50 nm
Afbeelding 5b toont het ATR-FTIR-spectrum gemeten op hetzelfde monster. De breedbandfuncties bevinden zich in de 3200-3800 cm −1 regio, kan worden toegewezen aan het O-H-gedeelte van de Si-OH en water, maar de eerste is minder waarschijnlijk [14, 31]. Een andere band, die ook typerend is voor het Si-OH stuk [31], is zichtbaar op ~ 900 cm −1 . De aanwezigheid van –OH-groepen, die consistent is met de hierboven getoonde TOF-ERDA-resultaten, impliceert dat verbrandingsachtige reacties, waarbij de verbranding van –NH t Bu liganden en vorming van –OH-groepen, domineren de oxidatiestap. Er is eerder gemeld dat een soortgelijk mechanisme plaatsvindt tijdens de groei van Al2 O3 van trimethylaluminium en O2 plasma [32] en SiO2 van SAM.24 en O2 plasma [9]. Naast de –OH-groepen wordt het uitrekken van de Si-O-Si-binding gedetecteerd rond 1108 en 1226 cm −1 [14, 33] terwijl de bindingsbuiging wordt gezien bij ongeveer 820 cm −1 [34, 35]. Merk op dat in vergelijking met literatuurwaarden [14, 34, 35] de Si-O-Si-rekfrequentie in dit werk relatief hoog is. Dit kan worden veroorzaakt door de verandering van de lengte van de Si-O-binding, die kan worden beïnvloed door de restspanning van de film. Jutarosaga et al. rapporteerde dat hoe hoger de drukspanning is, hoe lager de Si-O-Si-rekfrequentie [36]. De banden op ~ 970, 1301 en 1450 cm −1 zijn toegewezen aan de CH3 rockend, CH3 symmetrische vervorming, en CH2 schaar, respectievelijk [14]. De bevinding van C-H-oppervlaktegroepen komt overeen met het resultaat van TOF-ERDA en is hoogstwaarschijnlijk te wijten aan de oppervlakteverontreiniging.
Uit de gegevens in Fig. 5 en op basis van eerder in de literatuur gerapporteerde resultaten [37], kunnen onze procesoppervlaktereacties tijdens de eerste ALD-halve cyclus als volgt worden beschouwd:
$$ \mathrm{Si}-{\mathrm{OH}}^{\ast }+{\mathrm{H}}_2\mathrm{Si}{\left[{NH}^t Bu\right]}_2\ naar \mathrm{Si}-\mathrm{O}-{\mathrm{SiH}}_2{{\left[{NH}^t Bu\right]}_{2-x}}^{\ast }+{ xH}_2{N}^t Maar $$ (1)waarbij oppervlaktesoorten worden aangegeven met de asterisk (*). In de eerste halfreactie, slechts één (x = 1) of beide (x = 2) van -NH t Bu liganden kunnen reageren met de oppervlakte-OH-groepen die t . vormen -butylamine moleculen.
De O-radicalen zijn de belangrijkste actieve soorten die worden gegenereerd tijdens de CO2 plasmadissociatiereacties [28] en domineren bijgevolg de oxidatiereacties. Daarom zijn de voorgestelde verbrandingsachtige reacties [9] in de tweede halve cyclus:
$$ {\mathrm{SiH}}_2{{\left[{NH}^t Bu\right]}_{2-x}}^{\ast }+\mathrm{O}\to \mathrm{Si} -{\mathrm{OH}}^{\ast }+{\mathrm{H}}_2\mathrm{O}+{\mathrm{CO}}_2+\mathrm{N}-\mathrm{bevat}\ \mathrm {soort} $$ (2)Vanwege de onzekerheid van de feitelijke reactieproducten is de voorgestelde oppervlaktereactie met opzet niet in evenwicht. Om deze reactie volledig te kunnen bepalen, zouden in-situ analyses tijdens de filmgroei, zoals bijproduct gasanalyses, nodig zijn.
De optische eigenschappen van SiO2 film gegroeid op een saffiersubstraat werden bestudeerd met spectrometrie. Figuur 6a toont de gemeten transmissie als functie van de golflengte samen met de Cauchy-aanpassing van de curve. De brekingsindexdispersie gesimuleerd uit het transmissiespectrum wordt getoond in figuur 6b. Van de fitting, bij een golflengte van 632 nm, een brekingsindex van 1.456 en nul k waarde werden verkregen. Deze waarde van de brekingsindex komt goed overeen met wat eerder werd gerapporteerd voor PEALD SiO2 bij lage temperaturen. [9, 21] en relatief laag vergeleken met waarden gerapporteerd voor processen bij hoge temperatuur [23]. Het is inderdaad bekend dat de groeitemperatuur de –OH-concentratie in de gegroeide films beïnvloedt en dus hun brekingsindex [38]. Bovendien is de verkregen nul k waarde is consistent met het lage koolstofgehalte in de films. Een vergelijkbare correlatie tussen de k waarde en de C-concentratie werd eerder gerapporteerd door Putkonen et al. voor SiO2 dunne films gekweekt door ALD [21].
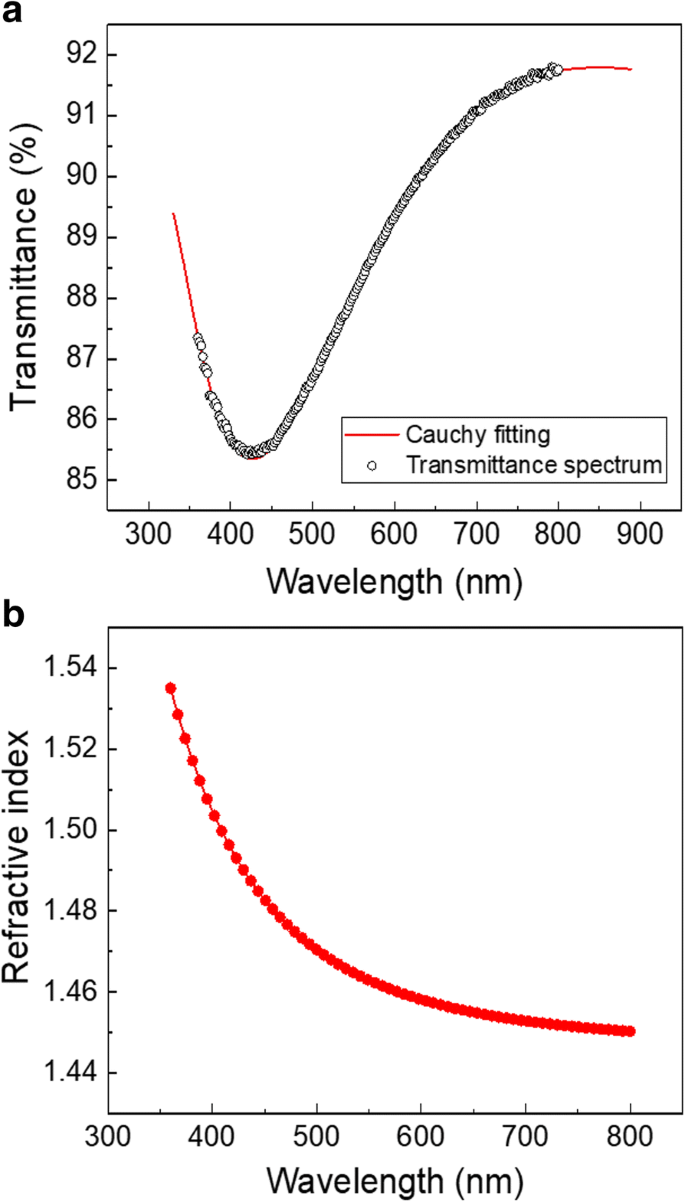
een Transmissiespectrum en Cauchy-fitting en b brekingsindexdispersies van de SiO2 film gegroeid op een saffiersubstraat met een plasmavermogen van 180 W, een BTBAS-pulstijd van 0,3 s, een BTBAS-zuiveringstijd van 3 s, een CO2 plasmablootstellingstijd van 3 s, en een CO2 plasma-spoeltijd van 2 s. Gerichte filmdikte was 150 nm
Restspanning van ALD-films omvat de bijdragen van thermische spanning en intrinsieke spanning. Thermische spanning is het gevolg van het verschil in thermische uitzetting tussen de film en het substraat. De intrinsieke stress wordt gedefinieerd als de interne stress die wordt gecreëerd tijdens de filmgroei, afhankelijk van de voorlopers, de groeitemperatuur en de ALD-methode [30, 39]. Afbeelding 7 toont de restspanning van SiO2 films als functie van de groeitemperatuur. De hoogste spanningswaarde, 150 MPa (samendrukkend) [23], werd verkregen uit het monster gekweekt bij 400 °C; in dit werk wordt echter een lage trekspanning van 30 ± 10 MPa verkregen bij 90 °C. Putkonen et al. en Shestaeva et al. toonde een duidelijke afhankelijkheid van SiO2 filmspanning op groeitemperatuur [21, 30]:hogere temperatuur resulteert in hogere drukspanning. De bijdrage van thermische spanning is groter bij hogere temperatuur. Ze rapporteerden ook bijna "nul" restspanningswaarden voor lage temperatuur PEALD SiO2 films [21, 30]. Rekening houdend met de restspanningswaarde die hier en in de literatuur wordt gerapporteerd, is de bijna "nul" spanning hoogstwaarschijnlijk een gevolg van de intrinsieke spanning in plaats van de thermische spanning. De intrinsieke spanning van PEALD SiO2 films kunnen dan worden veroorzaakt door het plasma-effect. Andere factoren zoals de gasstroom, de procesdruk of de gebruikte precursor kunnen echter niet worden uitgesloten [40].

Restspanning van SiO2 films als functie van de groeitemperatuur. Ons monster werd gekweekt met een plasmavermogen van 180 W, een BTBAS-pulstijd van 0,3 s, een BTBAS-zuiveringstijd van 3 s, een CO2 plasmablootstellingstijd van 3 s, en een CO2 plasma-spoeltijd van 2 s. Referenties zijn onder andere Putkonen et al. [21], Shestaeva et al. [30], en koning [23]. Gerichte filmdikte van ons monster was 50 nm
Conclusies
Dit werk demonstreert het potentieel van CO2 als oxidant voor het kweken van PEALD SiO2 . bij lage temperatuur op vocht/zuurstofgevoelige materialen. SiO2 films met lage onzuiverheidsniveaus en lage trekspanningen werden gekweekt bij 90 °C door PEALD met behulp van CO2 en BTBAS als voorlopers. De films vertoonden een verzadigde GPC van ~ 1.15 Å/cyclus samen met een dichtheid van ~ 2.1 g/cm 3 . Deze studie toont ook de mogelijkheid aan om een verzadigde groei van de films te bereiken met een zeer korte ALD-cyclustijd van ongeveer 4 s, wat aanzienlijk wenselijk is voor hoge doorvoer en dus industriële toepassingen.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- ATR-FTIR:
-
Verzwakte totale reflectie Fourier-transformatie infraroodspectroscopie
- BTBAS:
-
Bis(tertiair-butylamino)silaan
- GDOES:
-
Glow-discharge optische emissie spectroscopie
- GPC:
-
Groei-per-cyclus
- PEALD:
-
Plasma-versterkte atomaire laagafzetting
- PECVD:
-
Plasma-versterkte chemische dampafzetting
- PVD:
-
Fysische dampafzetting
- rf:
-
Radiofrequentie
- TOF-ERDA:
-
Time-of-flight elastische terugslag detectie analyse
- XRR:
-
Röntgenreflectie
Nanomaterialen
- Ocean Carbon afgebeeld op de atoomschaal
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Onthulling van de atomaire en elektronische structuur van gestapelde koolstof nanovezels
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Depositie in twee stappen van met Al-gedoteerde ZnO op p-GaN om ohmse contacten te vormen
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Vaste stof kooldioxidesensor
- Laagdikte meten met een microscoop



