Carrier-herverdeling tussen twee soorten gelokaliseerde staten in de InGaN/GaN Quantum Wells, bestudeerd door fotoluminescentie
Abstract
De InGaN/GaN multi-quantum-putten (MQW's) worden onder dezelfde omstandigheden geprepareerd door metaal-organische chemische dampafzetting (MOCVD), met uitzondering van de dikte van de afdeklagen die extra op elke InGaN-putlaag zijn gegroeid. De intensiteit van de fotoluminescentie (PL) van het monster van de dunne deklaag is veel sterker dan die van het monster van de dikkere deklaag. Interessant is dat het monster van de dikke kaplaag twee fotoluminescentiepieken heeft onder een hoog excitatievermogen, en de PL-piekenergie-temperatuurcurven vertonen een abnormale overgang van omgekeerd V-vormig naar normaal S-vormig met toenemend excitatievermogen. Ondertussen vertoont het een slechtere thermische stabiliteit van een monster van een dikke deklaag onder een hoger excitatievermogen dan dat onder een lager excitatievermogen. Een dergelijk atypisch fenomeen wordt toegeschreven aan de herverdeling van de drager tussen de twee soorten gelokaliseerde toestanden die wordt veroorzaakt door de inhomogene verdeling van de indiumsamenstelling in het dikke deklaagmonster. Bovendien heeft de luminescentie van diepe gelokaliseerde toestanden een betere thermische stabiliteit en heeft de luminescentie van ondiepe gelokaliseerde toestanden een slechte thermische stabiliteit. In feite kan een dergelijke ernstigere inhomogene indiumverdeling worden veroorzaakt door de achteruitgang van de daaropvolgende epitaxiale groei van het InGaN/GaN MQW-gebied als gevolg van een langere groeitijd van de GaN-deklaag bij lage temperatuur.
Inleiding
InGaN/GaN multi-quantum well (MQW) structuur heeft veel aandacht gekregen vanwege het brede gebruik in light-emitting diodes (LED's) en laserdiodes (LD's) [1,2,3,4,5,6]. Hoewel de hoge threading-dislocatiedichtheid en vermindering van de golffunctie elkaar overlappen, veroorzaakt door spontane en piëzo-elektrische polarisatie van InGaN/GaN MQW's, is hun luminantie-efficiëntie nog steeds verrassend hoog [7,8,9,10]. Een van de belangrijkste redenen is dat de lokalisatie van excitonen in potentiële minima als gevolg van fluctuaties van het indiumgehalte leidt tot de vorming van quantum-dot-achtige toestanden in InGaN/GaN-quantumbronnen [11]. Het blijft echter dubbelzinnig hoe de rollen lokalisatietoestanden spelen op het luminescentiemechanisme. Verschillende onderzoeken hebben het effect gerapporteerd van fluctuaties in de samenstelling van InGaN op stralings- en Auger-recombinaties [12,13,14]. Theoretische simulaties van atomaire strakke binding gebruikt door Jones vonden dat de lokalisatie zowel de stralings- als de Auger-recombinatiesnelheid verhoogt, maar de Auger-recombinatiesnelheid stijgt met een orde van grootte hoger dan die van straling [15]. Experimenteel leidt dragerlokalisatie tot de versoepeling van de k-selectieregel in het Auger-recombinatieproces en verbetert dus het Auger-recombinatieproces in polaire InGaN/GaN QW's onder hoge optische excitatie [16]. Het is algemeen bekend dat het temperatuurafhankelijke S-vormige gedrag van luminescentiepiekenergie een vingerafdruk is van dragerlokalisatie. Veel modellen, zoals het gelokaliseerde toestandensemble (LSE) -model, worden voorgesteld om de lokalisatie van de drager en het thermische herverdelingsgedrag te verklaren, wat aantoont dat de variatie van luminescentiepiekenergie met temperatuur kan worden beïnvloed door een uniek herverdelingsproces van dragers onder verschillende excitatieniveaus [17, 18,19,20,21]. Over het algemeen werken de vervaardigde apparaten zoals laserdiodes altijd met een hogere geïnjecteerde dragerdichtheid [22]. In dit geval kunnen de fotoluminescentiespectra van gelokaliseerde toestanden een uniek gedrag vertonen op verschillende excitatieniveaus die verband houden met de uniformiteit van gelokaliseerde toestanden. Verdere studies zijn daarom nodig om het effect van legeringsfluctuaties op InGaN-apparaten te begrijpen.
In dit werk worden twee typische monsters met verschillende diktes van GaN-kaplagen die bovendien op elke InGaN-putlaag worden gekweekt, voorbereid door een metaal-organisch chemisch dampafzettingssysteem (MOCVD). De eigenschappen van MQW's worden in detail gekenmerkt door metingen met hoge resolutie röntgendiffractie (HRXRD), temperatuurafhankelijke fotoluminescentie (TDPL) en vermogensafhankelijke fotoluminescentie (PDPL). Er is gevonden dat het monster van de dikke deklaag een abnormale piek vertoont aan de zijde met hogere energie bij een hoog optisch excitatievermogen. Dit impliceert het naast elkaar bestaan van twee verschillende soorten gelokaliseerde staten. Ondertussen neemt de PL-intensiteit sneller af bij lage temperaturen wanneer het excitatievermogen hoger wordt. Daarom kunnen we aannemen dat de fotoluminescentie van diepe gelokaliseerde toestanden een betere thermische stabiliteit heeft, en de fotoluminescentie van ondiepe gelokaliseerde toestanden een slechte thermische stabiliteit.
Methoden
Materialen
De InGaN / GaN MQW-monsters met verschillende diktes van de deklaag die zijn gekweekt op c-plane saffiersubstraat door een AIXTRON 3 × 2 in een nauw gekoppelde douchekopreactor, worden bestudeerd. Trimethylgallium (TMGa), trimethylindium (TMIn) en ammoniak (NH3 ) werden gebruikt voor de epitaxiale groei als respectievelijk Ga-, In- en N-bronvoorlopers, waarbij H2 en N2 waren respectievelijk het dragergas van de GaN- en InGaN-groei. MQW bestaat uit twee perioden van InGaN/GaN QW's. Tijdens de groei van elke putlaag werd de TMIn-stroomsnelheid constant gehouden. Vervolgens werd een GaN-deklaag gekweekt bij dezelfde temperatuur als laag, d.w.z. 710 ° C. Daarna werd de temperatuur opgevoerd tot 830 °C en enkele seconden blijven staan, waarna de barrièrelaag werd gegroeid tot 830 °C. Beide monsters A en B worden onder dezelfde omstandigheden gekweekt, behalve de groeitijd van de GaN-kaplaag, dwz deze is 30 s voor monster A en 200 s voor monster B. Het schematische diagram van structuur en groeiparameters van twee InGaN/GaN MQW's A en B worden weergegeven in Afb. 1.
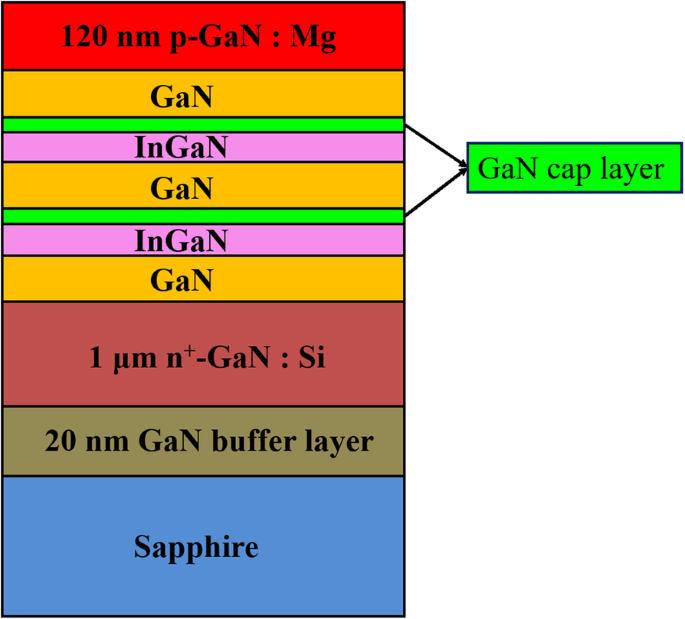
Het schematische dwarsdoorsnedediagram van de epilaagstructuren van twee MQW's
Karakterisering
Om het gemiddelde indiumgehalte, de periodedikte en de materiaalkwaliteit van twee InGaN/GaN MQW's te bepalen, worden röntgendiffractiemetingen (HRXRD) met hoge resolutie uitgevoerd met Rigaku Ultima IV met Cu-Ka-straling (λ = 1,54 ) die werkte. bij 40 kV en 30 mA. Voor temperatuurafhankelijke fotoluminescentie (TDPL) en excitatievermogensafhankelijke PL (PDPL) metingen werd een 405 nm laser gebruikt als excitatielichtbron met een puntgrootte van 0,5 mm 2 en het excitatievermogen varieerde van 0,01 tot 50 mW. De monsters werden gemonteerd in een He-cryostaat met gesloten cyclus en de temperatuur werd geregeld van 10 tot 300 K.
Resultaten en discussies
Om de structurele eigenschappen van twee monsters A en B te onderzoeken, zijn de ω-2θ symmetrische (0002) scans uitgevoerd, zoals weergegeven in figuur 2a. De substraatpiek is afkomstig van het GaN (002)-vlak en satellietpieken komen van MQW's. Satellietpieken tot de vierde orde kunnen duidelijk worden waargenomen in alle twee monsters, wat wijst op een goede laagperiodiciteit. Bovendien kunnen de gemiddelde indiumsamenstelling en periodieke dikte worden verkregen door de gemeten curven aan te passen, zoals weergegeven in tabel 1. Het is te zien dat naarmate de dikte van de afdeklaag toeneemt, de GaN-barrièredikte en de dikte en indiumsamenstelling van InGaN goed lagen nemen iets toe. Omdat de groeisnelheid van de afdeklaag zo klein is als 0,006 nm/s en de groeitemperatuur zo laag is als 710 K, is de verandering van de barrièredikte relatief klein. Merk echter op dat de groei van extra GaN-kaplagen niet alleen invloed kan hebben op de dikte van de barrièrelaag, maar ook op de diffusie, verdamping en herverdeling van In-atomen in de InGaN-putlagen, zoals later in detail zal worden besproken.

Omega-2theta-scans en wederzijdse ruimtetoewijzing van beide monsters worden uitgevoerd door HRXRD. een HRXRD Omega-2theta-curven op GaN (0002)-vlak voor monsters A en B. b Reciprocal space mapping (RSM) voor de GaN (10-15) diffractie van monster A
Ondertussen wordt, om de spanningstoestand van GaN QB- en InGaN QW-lagen te onderzoeken, reciproke ruimtekartering (RSM) in de buurt van het GaN (10-15) vlak uitgevoerd. Het resultaat van monster A wordt getoond in figuur 2b (het RSM-cijfer van B is vergelijkbaar, maar wordt hier niet getoond). We kunnen zien dat voor monster A de satellietpieken van MQW en GaN-piek goed op dezelfde verticale lijn zijn uitgelijnd, wat aangeeft dat de MQW's van beide monsters volledig zijn gespannen zonder enige ontspanning [23].
Figuur 3 toont de PDPL-metingen voor twee monsters bij 10 K. Het is interessant om te ontdekken dat de twee monsters heel verschillend gedrag vertonen. Voor monster A is er een kleine piek aan de kant van de lagere energie (piek A 1 ) van dominante piek A 2 . Het is bevestigd dat piek A 1 is een fonon-replica die 92 meV verwijderd is van de hoofdpiek A 2 . De fonon-replica van B 2 komt ook voor in monster B en wordt genoemd als piek B 1 . Aan de andere kant, in Fig. 3b, kan worden waargenomen dat er slechts één dominante luminescentiepiek is B 2 met het bekrachtigingsvermogen lager dan 5 mW. Wanneer het excitatievermogen echter hoger is dan 10 mW, zal een andere piek B 3 verschijnt abnormaal aan hogere energiekant van B 2 , en piek B 3 wordt geleidelijk de dominante emissiepiek in plaats van piek B 2 wanneer het excitatievermogen verder toeneemt. Hier kunnen we aannemen dat de meerderheid van de optisch geëxciteerde dragers eerst vast kwamen te zitten in het eerste type elektronische toestanden (bijv. gelokaliseerde toestanden gecreëerd door de lokale In-rijke clusters), en vervolgens radiatief recombineren, waardoor luminescentiepiek A wordt geproduceerd 2 en B 2 . [24].
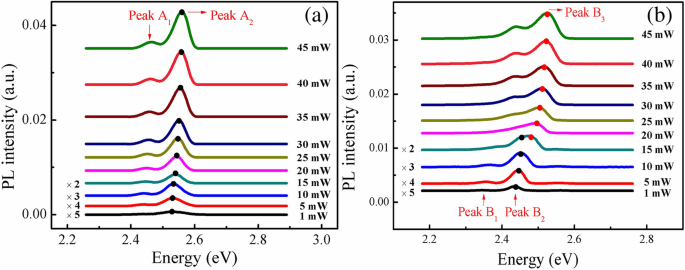
PL-spectra van monsters A (a ) en B (b ) bij verschillende excitatievermogens, gemeten bij temperaturen van 10 K
Om het gedrag van afwijkende piek B . te onderzoeken 3 van monster B verder hebben we de TDPL-metingen uitgevoerd onder verschillende excitatievermogens getoond in Fig. 4, waarin Fig. 4a en b de PL-spectra zijn verkregen onder een excitatievermogen van respectievelijk 5 mW en 40 mW. Merk op dat het fenomeen met twee pieken van de emissiespectra in figuur 4b duidelijk werd gezien bij temperaturen onder 200 K en vervaagde naar 300 K. Als we het gedrag van de emissiespectra samenvatten, kan men zien dat de overgang van de emissiepiek met lage energie naar de hoge energie-emissiepiek treedt op in een smal bereik van excitatievermogen en heeft een "schakelend" karakter. Buiten het smalle overgangsgebied, enkele lage energie (B 2 ) of hoge energie (B 3 ) emissiepiek domineert bij respectievelijk lage en hoge excitatievermogens.
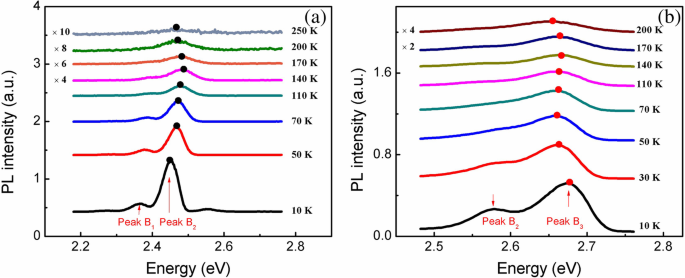
PL-spectra van monster B bij een temperatuurbereik van 10–300 K, gemeten bij een excitatievermogen van 5 mW (a ) en 40 mW (b )
Bovendien kunnen we bij een nadere inspectie van de variatie van dominante emissiepiekenergie met de temperatuur van beide monsters iets unieks vinden. Zoals getoond in Fig. 5a, wanneer het excitatievermogen toeneemt van 5 tot 40 mW voor monster A, vertoont de variatie van PL-piekenergie met toenemende temperatuur (hieronder ET-curve genoemd) "omgekeerde V-vorm" -curven, die verschilt van de reguliere "S"-vorm. De omgekeerde V-vorm is vrijwel onveranderd met toenemend excitatievermogen, behalve een algemene blauwe verschuiving van de piekenergie. De omgekeerde "V"-vormige temperatuurafhankelijkheid wordt verklaard als een gezamenlijke actie van het dragervuleffect op de luminescentiecentra en het krimpeffect van de bandgap samen met toenemende temperatuur [25, 26]. Aan de andere kant, zoals weergegeven in figuur 5b, tonen de E-T-curven voor monster B onder het excitatievermogen lager dan 5 mW een omgekeerde V-vorm. Deze situatie is vergelijkbaar met monster A. Wanneer het excitatievermogen echter geleidelijk toeneemt tot 40 mW, treedt een eerste roodverschuiving op bij een lager temperatuurbereik en hebben de E-T-curven een regelmatige S-vorm. Blijkbaar is dit fenomeen in tegenspraak met de verwachting dat wanneer het excitatievermogen groot genoeg is, het lokalisatie-effect volledig zal verdwijnen en het temperatuurgedrag van de piekenergie de wet van Varshni [27] nauw zal volgen.

PL emissie piekenergie als functie van temperatuur voor monsters A (a ) en B (b ) onder verschillende excitatiekrachten. De ononderbroken lijnen zijn theoretische aanpassingscurven met behulp van het LSE-model. De stippen zijn de experimentgegevens
Om de waargenomen abnormale afhankelijkheid van geëxciteerd optisch vermogen van luminescentie van gelokaliseerde toestanden kwantitatief te verklaren, werd het LSE-luminescentiemodel gebruikt om te passen bij de E-T-curves, zoals voorgesteld door Q. Li et al. Dit model kan in alle temperatuurbereiken worden gebruikt en past niet alleen in de "S" -vorm E-T-curven, maar ook in de "V" of omgekeerde "V" -vormen. Daarnaast werd ook bewezen dat het LSE-model bij hoge temperaturen kan worden teruggebracht tot het band-tailmodel van Eliseev et al. [24, 25]. In dit model kan de piekenergie als functie van de temperatuur worden beschreven als [18,19,20,21]:
$$ E(T)=\left({E}_0-\frac{\alpha {T}^2}{\theta +T}\right)-{xk}_BT $$ (1)waar θ is de Debye-temperatuur van het specifieke materiaal en a is de Varshni-parameter, k B is de Boltzmann-constante, en x kan numeriek worden opgelost door de volgende transcendentale vergelijking [18,19,20,21]:
$$ {xe}^x=\left[{\left(\frac{\sigma }{k_BT}\right)}^2-x\right]\left(\frac{\tau_r}{\tau_{tr} }\right){e}^{\left({E}_0-{E}_a/{k}_BT\right)} $$ (2)waar σ is de standaarddeviatie van de verdeling van de gelokaliseerde toestanden. Met andere woorden, het betekent de breedte van de toestandsdichtheidsverdeling van het Gauss-type. τ r en τ tr vertegenwoordigen de stralingsrecombinatie en ontsnappingslevensduur van de gelokaliseerde drager, en dus τ r /τ tr impliceert het deel van dragers dat niet-radiatief recombineert. E 0 is de centrale energie van de gelokaliseerde centra, en E een geeft een "markering" -niveau waaronder alle gelokaliseerde staten worden bezet door vervoerders op 0 K, wat net als het quasi-Fermi-niveau in de Fermi-Dirac-verdeling is. Het is duidelijk dat E 0 en E een samen zijn gerelateerd aan de oorsprong van luminescentie gelokaliseerde centra [17].
De verkregen aanpassingsparameters van beide monsters worden weergegeven in Tabel 2. Voor monster A is de centrale energie E 0 en E een verandert in respectievelijk 19 meV en 18 meV van 5 naar 40 mW. Het valt op dat de E 0 -E een en σ is vrijwel onveranderd. Het is omdat naarmate het opgewekte vermogen toeneemt, meer en meer dragers zullen worden opgewekt. Ten eerste zal het sterke piëzo-elektrische veld van InGaN-putten worden gescreend door de fotogegenereerde dragers, wat leidt tot een toename van de centrale energie E 0 . Ten tweede zullen steeds meer dragers hogere elektronische toestanden bezetten volgens het vuleffect, wat resulteert in een toename van het quasi-Fermi-niveau van gelokaliseerde dragers E een . Daarom, E 0 -E een vertegenwoordigt de gezamenlijke actie van het polarisatie-afschermingseffect en het dragervuleffect, en dus wordt een algehele blauwverschuiving in piekpositie voor monster A waargenomen. In tegenstelling tot monster A zijn er voor monster B, van 5 tot 40 mW, grotere verhogingen van E 0 en E een respectievelijk , 73 meV en 57 meV. E 0 -E een toename met 16 meV, τ r /τ tr veranderingen met verschillende ordes van grootte, en σ neemt een beetje af. Dergelijke veranderingen zijn zo groot dat we moeten aannemen dat de oorsprong van luminescentiecentra verschillend is bij verschillende excitatievermogens van 5 mW en 40 mW.
Daarom wordt gesuggereerd dat er voor monster B twee soorten lokalisatietoestanden zijn, die zich op twee verschillende energiediepten in de putlagen verspreiden vanwege de inhomogene verdeling van de indiumsamenstelling, dwz met een hogere indiumsamenstelling (diepe lokalisatietoestanden) en lagere indiumsamenstelling (ondiepe lokalisatietoestanden). Om het bovenstaande fenomeen van monster B te verklaren, zijn bovendien de schematische diagrammen die het mogelijke mechanisme van de herverdeling van de draaggolf tussen twee soorten gelokaliseerde toestanden aangeven, uitgezet in figuur 6. Bij 10 K, onder een lager excitatievermogen zoals 5 mW, getoond in Fig. 6a raakt de meerderheid van de optisch geëxciteerde dragers eerst gevangen in het eerste type elektronische toestanden (diepe gelokaliseerde toestanden) en dus domineert de lagere energiepiek, terwijl bij 40 mW, getoond in Fig. 6b, meer en meer fotogegenereerde dragers zullen het hogere energieniveau bezetten, en dan worden de ondiepe gelokaliseerde toestanden met de hogere energietoestandsdichtheid ook gevuld, en dus domineert de hogere energiepiek geleidelijk met de toename van het opgewekte vermogen. Daarom, E 0 en E een veel verhogen, en τ r /τ tr met verschillende orders toenemen, wat het ontsnappingsvermogen van vervoerders uit gelokaliseerde staten impliceert. Naarmate de temperatuur stijgt tot 30 K, bij 5 mW, zoals weergegeven in figuur 6c, worden de fotogegenereerde dragers met een bepaalde hoeveelheid thermische energie voornamelijk gebruikt om de diepere gelokaliseerde toestanden te vullen, wat resulteert in een eerste blauwverschuiving van E-T-curven; in Fig. 6d, als het gaat om 40 mW, gebaseerd op de veronderstelling dat ondiepe gelokaliseerde toestanden meer capaciteit hebben dan de diepe gelokaliseerde toestanden, blijft de meerderheid van de fotogegenereerde dragers in ondiepe gelokaliseerde toestanden, en het zal in staat zijn om over te dragen tot diep gelokaliseerde staten die een sterk vermogen hebben om vervoerders te binden. Daarom is de E-T-curve roodverschuiving. Met andere woorden, het uiterlijk van abnormale veranderingen van ET-curven houdt verband met meerdere soorten lokalisatietoestanden als gevolg van de inhomogene indiumverdeling in InGaN-putlagen van monster B. En dergelijke fluctuaties in de samenstelling zouden voornamelijk te wijten zijn aan de willekeurige fluctuaties in de legering op een atomaire schaal [28].

Schematische diagrammen die het mogelijke mechanisme van de abnormale variatie van de PL-piekenergie versus T-curves met verschillende excitatievermogens aangeven. De carrier-distributies bij lagere T (10 K) worden weergegeven in (a ) en (b ) voor P = 5 mW en 40 mW, respectievelijk. De carrier-distributies bij hogere T (30 K) worden weergegeven in (c ) en (d ) voor P =respectievelijk 5 en 40 mW
Bovendien leidt het verschijnen van een hoge energie-emissiepiek onder een hoog excitatievermogen van monster B ook tot een abnormale variatie van de PL-geïntegreerde intensiteit. In figuur 7 zijn de geïntegreerde intensiteit vs. temperatuurkrommen van monsters A en B, gemeten bij excitatievermogens van respectievelijk 5 mW en 20 mW, uitgezet. Merk allereerst op dat de thermische uitdoving van monster B duidelijk sneller is dan die van monster A. Over het algemeen wordt de thermische uitdoving door luminescentie van de InGaN MQW's gedomineerd door de niet-stralingsrecombinatieprocessen die kunnen worden beschreven door de Arrhenius-vergelijking. Daarom impliceert de snelle thermische uitdoving een slechte thermische stabiliteit van monster B. Bovendien, wanneer het excitatievermogen hoog genoeg is, zal de impact van niet-stralingsrecombinatiecentra bij relatief lage temperaturen niet zo veel significant zijn, omdat de niet-stralingsrecombinatiecentra gemakkelijk verzadigd zijn door overdragers [27]. Dit kan de langzamere variatie van PL geïntegreerde intensiteit vs. 1/T-curves perfect verklaren met de toename van het excitatievermogen van monster A. Het is echter best interessant voor monster B dat de genormaliseerde geïntegreerde intensiteit onder excitatievermogen van 5 mW zelfs hoger is dan die onder 20 mW wanneer de temperatuur lager is dan 125 K, en het wordt tegengesteld bij temperaturen hoger dan 125 K. Zoals eerder vermeld, wordt aangenomen dat slechts één lagere energie-emissiepiek die afkomstig is van diep gelokaliseerde toestanden dominant is bij 5 mW, terwijl een andere hogere afkomstig uit ondiepe gelokaliseerde toestanden dominant wordt bij 20 mW. Daarom wordt geconcludeerd dat de diep gelokaliseerde luminescentiecentra een betere luminescentie-efficiëntie hebben dan ondiepe luminescentiecentra. Dit komt goed overeen met het eerdere onderzoeksresultaat met betrekking tot de gelokaliseerde staten [28]. Daarom kan tot op zekere hoogte ook worden bewezen dat er twee soorten gelokaliseerde toestanden zijn die worden opgewekt bij 20 mW voor monster B.
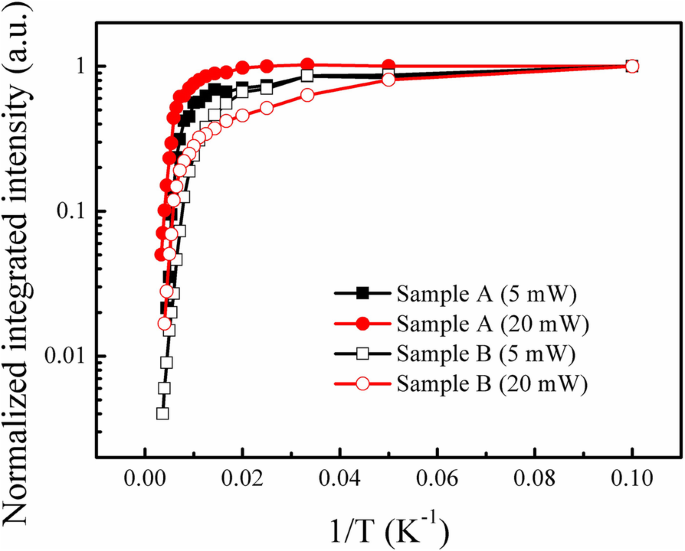
De geïntegreerde intensiteit geëxtraheerd uit PL-spectra van beide monsters bij een temperatuurbereik van 10-300 K, gemeten onder excitatievermogens van 5 mW en 20 mW
Op basis van al deze analyses laten we zien dat piek B 3 is afkomstig van de lokalisatietoestanden met een lager potentieel gerelateerd aan de inhomogene verdeling van de indiumsamenstelling van monster B. Het komt goed overeen met de experimentele resultaten van de hogere emissie-energiepiek B 3 en de reductie van IQE van monster B bij lage temperaturen bij een hoger excitatievermogen. In het groeiproces van QW's, gezien de trekkende effecten, zijn indiumatomen geneigd zich op te hopen aan de bovenkant van de InGaN QW-laag en een extra laag te vormen die bekend staat als indium-drijflaag [29]. Dikkere GaN-deklaaggroei bij lage temperatuur is nadelig voor de verdamping van deze indium-drijvende atomen. Bijgevolg kunnen In-atomen worden opgenomen in de GaN-kaplaag en de barrièrelaag na de QW-groei [30]. Uiteraard zal dit gedrag resulteren in een toename van de laagdikte van de put, en dus de QCSE wordt verbeterd. De hogere spanning en het sterkere piëzo-elektrische veld in het actieve QW zou leiden tot meer gelokaliseerde ontspanning en dus tot diepere gelokaliseerde potentialen en hogere barrières. Ondertussen worden meer dislocaties en defecten geïntroduceerd in de daaropvolgende groei van de GaN-barrièrelaag. Over het algemeen is er een grote trekspanning in de buurt van dislocaties, en indiumatomen kunnen de neiging hebben zich op te hopen nabij de dislocaties en zich inhomogeen te verspreiden. [31, 32] Daarom zijn er in de groei van de InGaN-putlaag meer indiumrijke en indiumarme gebieden die verband houden met de toenemende dislocatiedichtheid. Het betekent dat de omvang van indiumfluctuaties groter zal worden naarmate de deklaagdikte toeneemt. In onze experimenten laat het zien dat twee verschillende soorten lokalisatietoestanden worden geïntroduceerd in monster B met een dikkere afdeklaag, en de PL-piek van hogere emissie-energie wordt geactiveerd onder een hoger excitatievermogen. Aan de andere kant kan het fotogegenereerde dragerverblijf in diepe gelokaliseerde toestanden de defecten afschermen en heeft dus een betere thermische stabiliteit, terwijl het fotogegenereerde dragerverblijf in ondiepe gelokaliseerde toestanden zal worden opgevangen door de defectgerelateerde niet-stralingsrecombinatie zodra ze de relatief lagere slagboomhoogte.
Conclusies
Samenvattend worden de InGaN/GaN multi-quantum well (MQW)-monsters met verschillende diktes van GaN-cap-lagen die bovendien op de InGaN-well-lagen zijn gegroeid, bereid door een metaal-organisch chemisch dampafzettingssysteem (MOCVD). Hun structurele en optische eigenschappen worden onderzocht door HRXRD-, TDPL- en PDPL-metingen en geanalyseerd. PDPL-resultaten laten zien dat een extra hoge-emissie-energiepiek alleen wordt geëxciteerd bij een hoger excitatievermogen voor monster B dat is gegroeid met dikke deklagen. Ondertussen onthullen TDPL-resultaten gemeten bij verschillende excitatievermogens voor monster B dat de E-T-curven van dominante PL-piek veranderen van omgekeerde V-vorm naar normale S-vorm wanneer het excitatievermogen toeneemt. Bovendien werd een slechtere thermische stabiliteit van monster B bij een hoog excitatievermogen gevonden. Deze afwijkende verschijnselen impliceren dat er twee soorten gelokaliseerde toestanden van monster B zijn die worden veroorzaakt door de relatief inhomogene indiumverdeling. Deze conclusies geven ons een beter begrip van het fotoluminescentiemechanisme van groene InGaN/GaN-kwantumbronnen en het inhomogeniteitseffect bij een hoog excitatieniveau, wat ons kan helpen bij de productie van InGaN/GaN-laserdiodes.
Afkortingen
- HRXRD:
-
Röntgendiffractie met hoge resolutie
- LD's:
-
Laserdiodes
- LED's:
-
Lichtgevende dioden
- LSE:
-
Gelokaliseerd statenensemble
- MOCVD:
-
Metaal-organisch chemisch opdampsysteem
- MQW's:
-
Multi-kwantumbronnen
- NH3 :
-
Ammoniak
- PDPL:
-
Vermogensafhankelijke fotoluminescentie
- RSM:
-
Wederzijdse ruimtetoewijzing
- TDPL:
-
Temperatuurafhankelijke fotoluminescentie
- TMGa:
-
Trimethylgallium
- TMIn:
-
Trimethylindium
Nanomaterialen
- De atoomherschikking van op GaN gebaseerde meerdere kwantumbronnen in H2/NH3 gemengd gas voor het verbeteren van structurele en optische eigenschappen
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Meerkleurige emissie van op ultraviolet GaN gebaseerde fotonische quasicrystal nanopiramidestructuur met semipolaire InxGa1−xN/GaN meerdere kwantumbronnen
- Het detecteren van ruimtelijk gelokaliseerde excitatie in zelfgeorganiseerde InAs/InGaAs Quantum Dot Superroosters:een manier om de fotovoltaïsche efficiëntie te verbeteren
- Bismut Quantum Dots in gegloeide GaAsBi/AlAs Quantum Wells
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Optimale siliciumdoteringslagen van kwantumbarrières in de groeireeks die een zacht opsluitingspotentieel vormen van acht-periode In0.2Ga0.8N/GaN Quantum Wells of Blue LED's
- Een onderzoek naar een kristallijn-silicium zonnecel met zwarte siliciumlaag aan de achterkant
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Het groeimechanisme van GaN epitaxiale lagen op mechanisch geëxfolieerd grafiet begrijpen



