Onderzoek van energieband op atomaire laag afgezette AZO/β-Ga2O3 (\( \overline{2}01 \)) heterojuncties
Abstract
De met Al gedoteerde effecten op de band-offsets van ZnO/β-Ga2 O3 interfaces worden gekarakteriseerd door röntgenfoto-elektronenspectroscopie en berekend door eerste-principesimulaties. De geleidingsband-offsets variëren van 1,39 tot 1,67 eV, de valentieband-offsets nemen af van 0,06 tot -0,42 eV, en vertonen een bijna lineaire afhankelijkheid met betrekking tot de Al-dopingverhouding variërend van 0 tot 10%. Dientengevolge vormt zich een type-I banduitlijning op het grensvlak van ZnO/β-Ga2 O3 heterojunctie en de AZO/β-Ga2 O3 interface heeft een type II banduitlijning. Dit komt omdat het opnemen van Al in het ZnO de bandhiaten zou openen vanwege de sterke Al- en O-elektronenmenging, en de geleidings- en valentiebandranden bijgevolg naar het lagere niveau verschuiven.
Achtergrond
Onlangs heeft een oxidehalfgeleider Ga2 O3 heeft wijdverbreide belangstelling getrokken vanwege zijn unieke kenmerken, zoals de grote bandgap, de hoge verzadigingselektronensnelheid en de hoge temperatuurbestendigheid [1]. Er zijn vijf soorten isomeren voor Ga2 O3 :α, β, γ, δ en ε, waarbij β-Ga2 O3 kan gemakkelijker worden gekweekt en is uitgebreid bestudeerd [2]. In het bijzonder β-Ga2 O3 heeft een groter elektrisch doorslagveld dan dat van traditionele halfgeleidermaterialen van de derde generatie, zoals SiC en GaN [3]. De geleidende eigenschappen van het n-type kunnen worden gemoduleerd door Sn [4] of Si [5] te doteren. Dus β-Ga2 O3 -gebaseerde apparaten [6, 7] hebben brede toepassingsmogelijkheden op het gebied van informatietechnologie, energiebesparing en emissiereductie. Echter, β-Ga2 O3 -gebaseerde apparaten hebben een gemeenschappelijke beperking:het contact tussen β-Ga2 O3 en de meeste metalen hebben de neiging Schottky te zijn vanwege de grote barrière die wordt veroorzaakt door de brede bandafstand en de eindige dragerconcentratie. In de afgelopen jaren is het invoegen van een tussenlaag, zoals ITO [8] en AZO [9], tussen Ga2 O3 en metalen blijkt een geldige methode te zijn om de energiebarrière tussen β-Ga2 O3 en metaal.
Al-gedoteerd zinkoxide (ZnO) heeft veel aandacht gekregen vanwege de lage soortelijke weerstand en lagere fabricagekosten dan ITO [10]. Met name de hoge thermische stabiliteit, hoge mobiliteit en dragerconcentratie maken het een veelbelovende kandidaat voor de tussenliggende halfgeleiderlaag (ISL) [11]. Tot nu toe kunnen met Al-gedoteerde ZnO-films worden gekweekt met de volgende technieken:moleculaire bundelepitaxie (MBE) [12], magnetron sputteren [13], chemische dampafzetting (CVD) [14] en atoomlaagafzetting (ALD) [ 15]. In het bijzonder is ALD een bekende methode om nano-diktefilm te maken die een grote oppervlakte uitstekende uniformiteit vertoont en de groeisnelheid per cyclus verenigt vanwege de zelfbeperkende oppervlaktereactie inclusief de zelfbeperkende chemische adsorptie en zelfbeperkende sequentiële reactie [16]. Bovendien kan ALD de interface-stoornis verminderen en de Al-dopingconcentratie nauwkeuriger moduleren door de verhoudingen van groeicycli te veranderen.
Merk op dat de geleidingsbandoffset (CBO) de energiebarrière voor het elektronentransport bepaalt, dus een kleinere CBO is gunstig om een Ohms contact te vormen. Gebaseerd op ons eerdere werk [17], door de Al-dopingconcentratie te verhogen, verandert de met Al gedoteerde ZnO-film van polykristallijne naar amorfe aard, en de bandafstand wordt ook groter. De band-offsets van verschillende Al-gedoteerde ZnO/β-Ga2 O3 heterojuncties zijn niet op grote schaal onderzocht. In dit werk werden de ZnO-films met verschillende Al-doteringsverhoudingen respectievelijk afgezet op β-Ga2 O3 substraten van ALD. De resultaten laten zien dat de VBO en CBO bijna lineair afhankelijk zijn van de Al-dopingverhouding.
Methoden
De substraten zijn bulk β-Ga2 O3 (\( \overline{2}01 \)) en de dopingconcentratie is ongeveer 3 × 10 18 /cm 3 . Het reinigingsproces voor Ga2 O3 substraten werden gedurende elke 10 minuten ultrasoon gewassen in aceton en isopropanol en werden driemaal herhaald. Vervolgens heeft de Ga2 O3 substraten werden gespoeld met gedeïoniseerd water. Daarna werden de met Al-gedoteerde ZnO-films gekweekt op de Ga2 O3 substraat door ALD (Wuxi MNT Micro Nanotech Co., LTD, China). Er werden drie soorten monsters bereid. Ten eerste werden de ongedoteerde ZnO-films door ALD gekweekt met de voorlopers van Zn (C2 H5 )2 (DEZ) en H2 O om 200 o C. Ten tweede werden de Al-gedoteerde ZnO-films uitgevoerd door één puls trimethylaluminium (TMA) en H2 toe te voegen O elke 19e cyclus van DEZ en H2 O pulserend (aangeduid als 5% Al-doping) bij een substraattemperatuur van 200 o C tijdens ALD. Ten derde werden ook de met Al gedoteerde ZnO-films met een verhouding van 9:1 (aangeduid als 10% Al-doping) bereid. De groeisnelheid van ZnO en Al2 O3 was respectievelijk 0,16 en 0,1 nm/cyclus. Elke soort film bevatte twee verschillende diktes, d.w.z. 40 nm en 10 nm voor respectievelijk de dikke en dunne film. Bovendien is de β-Ga2 O3 substraat werd gebruikt om het bulkmateriaal te bestuderen. Ga 2p , Zn 2p CL's en het maximale valentieband (VBM) werden gemeten met röntgenspectroscopie (XPS) (AXIS Ultra DLD, Shimadzu) en de stap van resolutie XPS-spectra is 0,05 eV. Om de oppervlakteverontreiniging van het monster tijdens het overdrachtsproces van ALD naar XPS-kamer te voorkomen, werd Ar-ion-etsing uitgevoerd vóór de XPS-meting. Merk op dat het oplaadeffect het XPS-spectrum kan verschuiven, en de BE van C 1s peak is gekalibreerd op 284,8 eV om het probleem op te lossen.
Resultaten en discussies
De valentieband-offset (VBO) van met Al-gedoteerde ZnO/β-Ga2 O3 heterojunctie kan worden verkregen door de formule als volgt [18]:
$$ \Delta {E}_V=\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_{ \mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}\right)-\left({E}_{\mathrm{Zn}\ 2p}^{\mathrm{ AZO}}-{E}_{\mathrm{VBM}}}^{\mathrm{AZO}}\right)-\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga }}_2{\mathrm{O}}_3}-{E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}}\right) $$ (1)waarbij\( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) verwijst naar de bindingsenergie (BE) van Ga 2p kernniveau (CL) in bulk β-Ga2 O3 , \( {E}_{\mathrm{VBM}}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) verwijst naar de BE van VBM in bulk β-Ga2 O3 , \( {E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}} \) verwijst naar de BE van Zn 2p CL in dikke Al-gedoteerde ZnO-films, \( {E}_{\mathrm{VBM}}^{\mathrm{AZO}} \) verwijst naar de BE van VBM in dikke Al-gedoteerde ZnO-films. De laatste \( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) en \( {E}_{\mathrm{Zn }\ 2p}^{\mathrm{AZO}} \) verwijzen naar de BE van Ga 2p en Zn 2p CL's in dunne Al-gedoteerde ZnO-films, respectievelijk.
Vervolgens, op basis van de E g en ∆E V , de CBO bij de met Al-gedoteerde ZnO/β-Ga2 O3 interface kan worden berekend met de volgende vergelijking:
$$ \Delta {E}_C={E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_g^{\mathrm{AZO}}-\Delta {E }_V $$ (2)waarbij\( {E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) de bandgap van Ga2 is O3 en \( {E}_g^{\mathrm{AZO}} \) is de bandgap van Al-gedoteerde ZnO. De bandgaps voor ongedoteerd, 5% Al-gedoteerd ZnO, 10% Al-gedoteerd ZnO en β-Ga2 O3 zijn respectievelijk 3,20 eV, 3,25 eV, 3,40 eV en 4,65 eV [17, 19]. De bandgap neemt toe met een hogere Al-dopingverhouding, wat goed overeenkomt met de simulatie in het volgende deel.
Figuur 1 toont de Ga- en Zn-element CL's en VBM van bulk β-Ga2 O3 , dikke ongedoteerde en 5% en 10% Al-gedoteerde ZnO-films. Door het lineaire gebied en de vlakke bandzone uit het VBM-spectrum te passen, kan de VBM worden afgeleid [20]. Figuur 2 toont Ga 2p en Zn 2p CL van verschillende dunne Al-gedoteerde ZnO/β-Ga2 O3 heterojuncties. De BE-verschillen van Ga 2p en Zn 2p CL's voor het ongedoteerde, 5% Al-gedoteerde ZnO/β-Ga2 O3 , en 10% Al-gedoteerde ZnO/β-Ga2 O3 worden verkregen om respectievelijk 96,12 eV, 96,16 eV en 95,94 eV te zijn. Vervolgens wordt vastgesteld dat de VBO's op de interfaces 1,39 eV, 1,52 eV en 1,67 eV zijn voor het niet-gedoteerde, 5% Al-gedoteerde ZnO/β-Ga2 O3 , en 10% Al-gedoteerde ZnO/β-Ga2 O3 respectievelijk monsters.
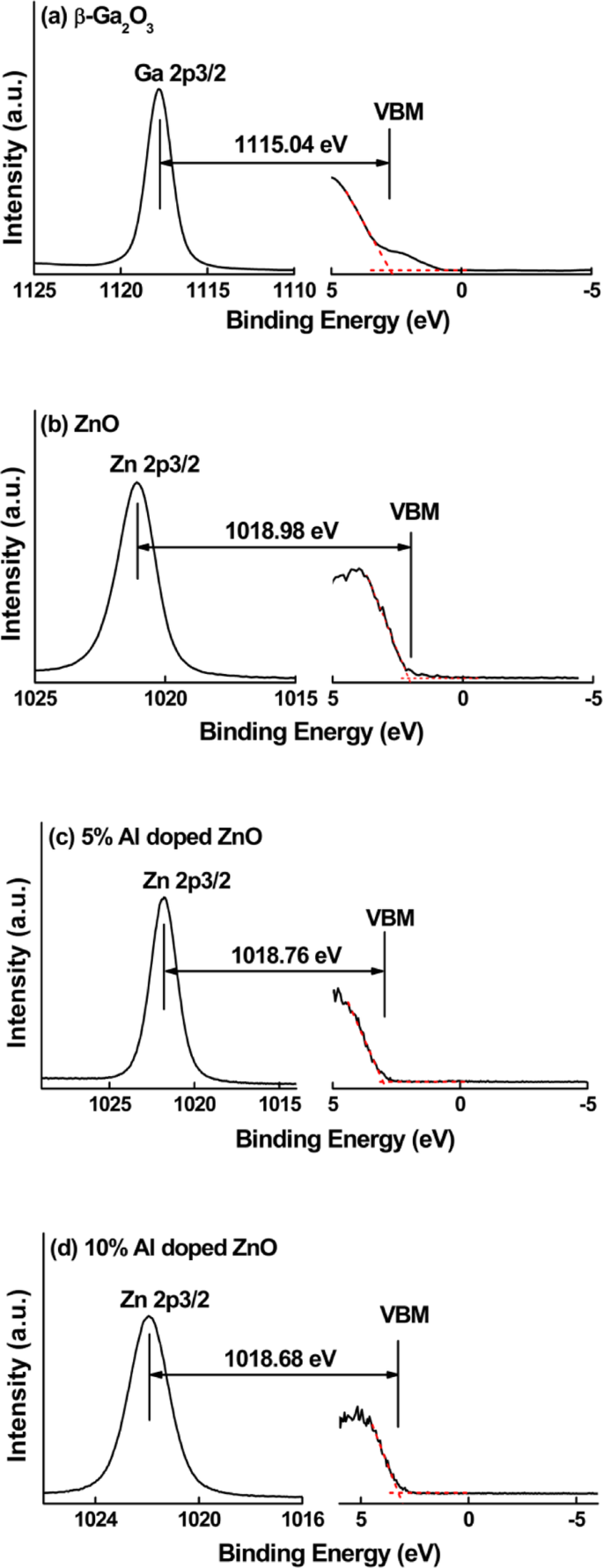
XPS-spectra met hoge resolutie voor kernniveau en maximale valentieband (VBM) van a Ga 2p kernniveauspectrum en VBM van kale β-Ga2 O3 , b Zn 2p kernniveauspectrum en VBM van dik zuiver ZnO/β-Ga2 O3 , c Zn 2p kernniveauspectrum en VBM van dik 5% Al-gedoteerd ZnO/β-Ga2 O3 , en d Zn 2p kernniveauspectrum en VBM van dik 10% Al-gedoteerd ZnO/β-Ga2 O3

De kernniveauspectra van Ga 2p en Zn 2p verkregen uit hoge resolutie XPS-spectra van a dun ZnO/β-Ga2 O3 , b dunne 5% Al-gedoteerde ZnO/β-Ga2 O3 , en c dunne 10% Al-gedoteerde ZnO/β-Ga2 O3
De systematische banduitlijning voor de 0%, 5% en 10% Al-gedoteerde ZnO/β-Ga2 O3 heterojuncties worden berekend door de bovenstaande vergelijkingen, zoals weergegeven in Fig. 3. De bandoffset van ongedoteerd ZnO/β-Ga2 O3 heterojunctie behoort tot type I. Terwijl zowel 5% als 10% Al-gedoteerde ZnO/β-Ga2 O3 heterojuncties hebben type II bandoffsets. Figuur 4 toont de banduitlijningen van Al-gedoteerde ZnO/β-Ga2 O3 interfaces hebben een vergelijkbare lineaire relatie met Al-dopingconcentratie. De CBO varieert van 1,39 tot 1,67 eV, waarbij de met Al gedoteerde concentratie toeneemt van 0 tot 10%. Terwijl de VBO daalt van 0,06 tot -0,42 eV, waarbij de met Al gedoteerde concentratie stijgt van 0 tot 10%. Opgemerkt wordt dat de CBO en VBO voor gesputterde AZO/β-Ga2 O3 zijn respectievelijk 0,79 eV en 0,61 eV [9]. Zowel de geleidings- als de valentieband verschuiven naar beneden in dit werk, wat te wijten kan zijn aan de verschillende samenstellingsverhoudingen en kristalstructuur die door gedeponeerde methoden zijn geïntroduceerd.

Schematisch banduitlijningsdiagram van a zuiver ZnO/β-Ga2 O3 , b 5% Al-gedoteerde ZnO/β-Ga2 O3 , en c 10% Al-gedoteerde ZnO/β-Ga2 O3

De geleidings- en valentieband-offsets van atomaire laag-afgezette AZO/β-Ga2 O3 heterojuncties vervaardigd met verschillende Al-dopingverhoudingen
Verder werden eerste-principesimulaties uitgevoerd door het Vienna Ab-initio Simulation Package (VASP) [21,22,23,24] om de elektronische bandstructuur en banduitlijning van met Al-gedoteerde ZnO/Ga2 te onderzoeken. O3 heterojuncties. Tijdens de berekening werden de elektron-ion-interacties behandeld door de ultrazachte pseudo-potentialen, en de golffuncties en potentialen werden uitgebreid met de vlakke-golfbasis [25]. Bovendien werd gegeneraliseerde gradiëntbenadering (GGA) voorgesteld door Perdew, Burke en Ernzerhof (PBE) geïmplementeerd om de uitwisselingscorrelatie-energieën te beschrijven [26]. Voorafgaand aan de start van de simulatie werden convergerende tests uitgevoerd. Het toonde aan dat de afsnijenergie van 450 eV voor de vlakke-golfbasis en k-ruimterasters van 3 × 3 × 3 met het Monkhorst Pack-schema de goed geconvergeerde resultaten opleverden. Bij de structuuroptimalisatie werd een geconjugeerde gradiëntmethode gebruikt en werd de restkracht vrijgegeven totdat deze minder was dan 0,01 eV/Å. Bovendien werden de hybride dichtheidsfuncties op basis van de semi-lokale PBE-benadering geïmplementeerd. Om de onderschatte bandgap te corrigeren, werd 35% van de PBE-uitwisseling vervangen door de exacte [27]. Om de bandrandverschuiving te identificeren met de verandering van het Al-dopingniveau, werd de gemiddelde elektrostatische potentiaal (AEP) berekend en uitgelijnd met het vacuümniveau dat werd geschaald naar 0 V. De VBM en het geleidingsbandminimum (CBM) werden bijgevolg uitgelijnd op de AEP op basis van het banddiagram [28]. In dit werk werd bulk ZnO met 16 O-atomen en 16 Zn-atomen in de supercel gebruikt. Om de Al-doping te introduceren, werden een of twee Zn-atomen in de supercel vervangen door de Al-atomen, waardoor de met Al gedoteerde structuur ontstond met een doteringsconcentratie van respectievelijk 3,21% en 6,25%.
Figuur 5 a-c toont de berekende banddiagrammen van respectievelijk de ongedoteerde, 3,21% Al-gedoteerde ZnO- en 6,25% Al-gedoteerde ZnO-structuren. Het laat duidelijk zien dat ZnO een directe bandgap-halfgeleider is met een bandgap van 3,42 eV, en zowel de CBM als de VBM bevonden zich op het Γ-punt van de Brillouin-zone. Deze theoretische simulatieresultaten komen redelijk goed overeen met de experimentele waarde [29]. Met de Al-doping kon worden vastgesteld dat de Fermi-niveaus naar boven verschoven in de geleidingsband, die het zuivere ZnO omzet in een n-type halfgeleider. Ondertussen namen de bandgaps ook toe tot 4,83 eV en 5,42 eV voor respectievelijk 3,21% Al-gedoteerde ZnO en 6,25% Al-gedoteerde ZnO. Hoewel de bandgaps hier voor het gedoteerde ZnO hoger zijn dan onze experimentele resultaten; dit kan echter worden toegeschreven aan het negeren van grensvlakdefecten en andere kristaldefecten.
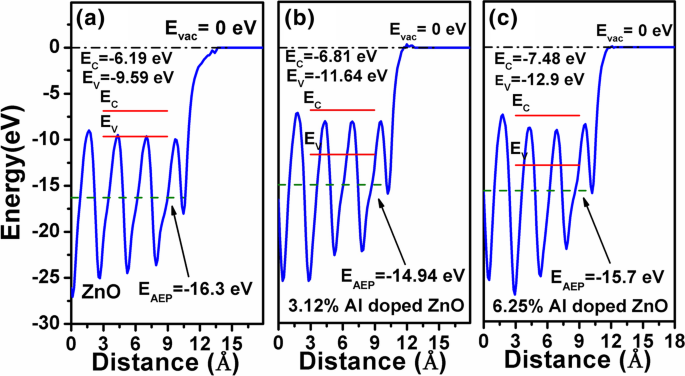
Het berekende bandendiagram van a ongedoteerde ZnO, b 3,21% Al-gedoteerde ZnO, en c 6,25% Al-gedoteerde ZnO-structuur. De Fermi-niveaus waren ingesteld op 0 eV
Figuur 6 a-c toont de banduitlijningen van ongedoteerd, 3,21% Al-gedoteerde ZnO en 6,25% Al-gedoteerde ZnO tot het vacuümniveau. Voor de geleidingsbanden van de materialen kon, vanwege de sterke elektronenmenging tussen het Al- en O-element, worden vastgesteld dat het energieniveau daalt van -6,19 eV van het ZnO tot -6,81 eV voor het 3,21% Al-gedoteerde ZnO ( ΔE = 0,62 eV ) en neemt verder af tot − 7,48 eV voor het 6,25% Al-gedoteerde ZnO (ΔE = 1,29 eV ). Ondertussen kon door de opening van de bandgap ook worden vastgesteld dat de rand van de valentieband naar beneden beweegt van -9,59 eV voor ZnO tot -11,64 eV voor 3,21% Al-gedoteerde ZnO (ΔE = 2,05 eV ) en − 12,9 eV voor het 6,25% Al-gedoteerde ZnO (ΔE = 3.31 eV ). Al met al, toegeschreven aan de sterke Al- en O-elektronenmenging, zou het kunnen worden begrepen dat het opnemen van Al in het ZnO de bandgaten zou openen. Bovendien zou het zowel de geleidingsband als de rand van de valentieband verschuiven naar het lagere energieniveau wanneer uitgelijnd met het vacuümniveau.
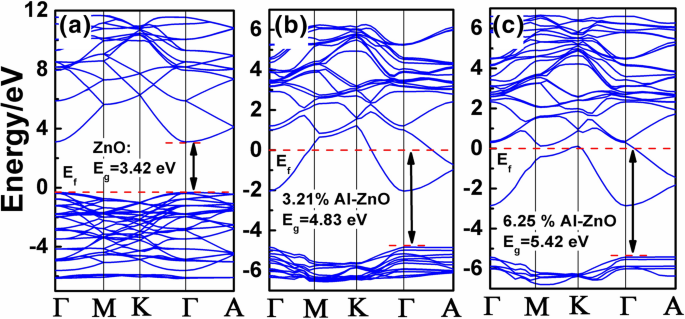
De banduitlijning van AZO/β-Ga2 O3 heterojuncties met a niet gedopeerd, b 3,21%, en c 6,25% Al-gedoteerde ZnO. De vacuümniveaus zijn geschaald naar 0 eV
Conclusies
Concluderend kunnen de banduitlijningen van verschillende Al-gedoteerde ZnO/β-Ga2 O3 (\( \overline{2} \)01) interfaces zijn onderzocht door XPS. Een type-I banduitlijning vormt zich op het grensvlak van ZnO/β-Ga2 O3 heterojunctie. Terwijl de AZO/β-Ga2 O3 interface heeft een type II banduitlijning. De CBO's variëren van 1,39 tot 1,67 eV en de VBO's nemen af van 0,06 tot -0,42 eV, waarbij de met Al gedoteerde concentratie stijgt van 0 tot 10%. Bovendien laten de dichtheidsfunctieberekeningen zien dat bandoffsets veranderen als gevolg van sterke Al- en O-elektronenmenging wanneer Al wordt opgenomen in ZnO. Deze resultaten suggereren dat het zuivere ZnO een geldige ISL is om de barrièrehoogte te verminderen en het elektronentransport te bevorderen.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit manuscript ondersteunen, zijn opgenomen in het manuscript.
Afkortingen
- AEP:
-
Gemiddeld elektrostatisch potentieel
- ALD:
-
Atoomlaagafzetting
- BE:
-
Bindende energie
- CBM:
-
Minimaal geleidingsband
- CBO:
-
Geleidingsband offset
- CL:
-
Kernniveau
- CL's:
-
Kernniveaus
- CVD:
-
Chemische dampafzetting
- DEZ:
-
Zn (C2 H5 )2
- Ga2 O3 :
-
Galliumoxide
- GaN:
-
Galliumnitride
- GGA:
-
Gegeneraliseerde gradiëntbenadering
- ISL:
-
Tussenliggende halfgeleiderlaag
- PBE:
-
Perdew, Burke en Ernzerhof
- SiC:
-
Siliciumcarbide
- TMA:
-
Trimethylaluminium
- VASP:
-
Wenen Ab initio simulatiepakket
- VBM:
-
Maximale valentieband
- VBO:
-
Valentieband-offset
- XPS:
-
Röntgenspectroscopie
- ZnO:
-
Zinkoxide
Nanomaterialen
- Bandtheorie van vaste stoffen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Een onderzoek naar een kristallijn-silicium zonnecel met zwarte siliciumlaag aan de achterkant
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
- Onderzoek naar energieband bij Atomic-Layer-Deposited ZnO/β-Ga2O3 (\( \overline{2}01 \)) Heterojuncties
- Onderzoek van de energieband bij de molybdeendisulfide- en ZrO2-heterojuncties
- Atomaire laagafzetting bij lage temperatuur van SiO2 met behulp van koolstofdioxide
- Atomaire laag afgezet Hf0.5Zr0.5O2-gebaseerde flexibele memristor met korte/lange termijn synaptische plasticiteit



