Experimentele en theoretische studies van Mo/Au Schottky Contact op mechanisch geëxfolieerde β-Ga2O3 dunne film
Abstract
We bestudeerden het mechanisme van tegenstroom van de Mo/β-Ga2 O3 Schottky-barrièrediode door de temperatuurafhankelijke stroom-spanning (IV) kenmerken van 298 tot 423 K. De variatie van tegenstroom met het elektrische veld geeft aan dat de Schottky-emissie het dominante dragertransportmechanisme is onder omgekeerde voorspanning in plaats van de Frenkel-Poole trap-geassisteerd emissiemodel. Bovendien werd een doorslagspanning van 300 V verkregen in Fluorinert-omgeving met een gemiddeld elektrisch veld van 3 MV/cm in Mo/β-Ga2 O3 Schottky-barrièrediode. De effecten van de oppervlaktetoestanden op de elektrische veldverdeling werden ook geanalyseerd door TCAD-simulatie. Naarmate de negatieve oppervlakteladingsdichtheden toenemen, neemt het elektrische piekveld monotoon af. Verder werd ook de hoogte-inhomogeniteit van de Schottky-barrière onder voorwaartse bias besproken.
Achtergrond
Onlangs heeft de ultrabrede bandgap-halfgeleider β-Ga2 O3 heeft veel belangstelling gewekt vanwege zijn uitstekende eigenschappen, zoals hoge chemische stabiliteit, grote directe brede bandafstand van 4,8-4,9 eV, hoog theoretisch doorslag elektrisch veld (E BR ) van 8 MV/cm en een hoge Baliga-waarde van 3400, wat ongeveer tien keer groter is dan dat van SiC en vier keer groter dan dat van GaN [1,2,3]. De combinatie van al deze eigenschappen met de hoge kwaliteit, grote oppervlakte en kosteneffectieve β-Ga2 O3 substraat gekweekt door smeltgroeitechnieken maakt β-Ga2 O3 een voorkeursmateriaal voor toepassingen in hoogspannings- en hoogvermogenelektronica [4,5,6,7,8,9]. Als een veelbelovend elektronisch apparaat, -Ga2 O3 Schottky-barrièrediodes (SBD) werden vervaardigd met verschillende anode-elektrodemetalen, waaronder Cu [8], Pd [10], Pt [5, 6, 11,12,13], Au [10, 14], Ni [13, 15 ,16,17,18], en TiN [12], en de voorwaartse en achterwaartse elektrische kenmerken, zoals de specifieke aan-weerstand, I aan /Ik uit verhouding, barrièrehoogten, omgekeerde lekstroom en doorslagspanning werden uitgebreid onderzocht. De inhomogene Schottky-barrièrehoogte en niet-verzadigende sperstroom werden gerapporteerd in β-Ga2 O3 SBD's [6, 8, 11, 18, 19], terwijl er veel minder informatie bekend was over het transportmechanisme van de drager onder omgekeerde voorspanning, wat essentieel is voor de verbetering van de doorslagspanning.
Bovendien is er geen onderzoek gedaan om de emissiemechanismen van Mo/β-Ga2 te analyseren. O3 contact. Als er vallen of defecten zijn in de β-Ga2 O3 substraat, zal de lekstroom in overeenstemming zijn met het Frenkel-Poole-emissiemodel, en de tegenstroom is de emissie van elektronen uit een opgesloten toestand nabij de metaal-halfgeleiderinterface. Anders zal het belangrijkste proces in tegenstroom worden gedomineerd door de Schottky-emissie die de elektronen over de Schottky-barrière resulteren in een tegenstroom. β-Ga2 O3 kristal heeft ook één unieke eigenschap, een grote roosterconstante van 12,23 in de richting [100], die een gemakkelijke splitsing in dunne banden of nanomembranen mogelijk maakt [9, 20]. Dus in dit werk hebben we mechanisch grootschalige β-Ga2 . geëxfolieerd O3 van bulksubstraat met een lage dislocatiedichtheid, en voor de eerste keer werd het thermisch stabiele molybdeen (Mo) gekozen als het anode-elektrodemetaal om de β-Ga2 te fabriceren O3 verticale Schottky-barrièrediodes. Het elektrische geleidingsmechanisme onder de omgekeerde voorspanning werd besproken bij het temperatuurbereik van 298 tot 423 K. Dit werk biedt inzicht in dragertransportmechanismen die kunnen helpen bij het verbeteren van de functionaliteiten van β-Ga2 O3 -gebaseerde apparaten.
Methoden/experimenteel
Zoals getoond in Fig. 1a, b, werd de Schottky-barrièrediode gefabriceerd op de β-Ga2 O3 (100) film mechanisch geëxfolieerd van de Sn-gedoteerde β-Ga2 O3 substraat, met een dikte van 15 μm en een elektronenconcentratie van 2 × 10 17 cm − 3 . Zoals weergegeven in Fig. 1d, e, werden de volledige breedte bij halfmaximum (FWHM) en wortelgemiddelde vierkant (RMS) geschat op respectievelijk 51,9 boogseconden en 0,19 nm, door röntgendiffractie met hoge resolutie (HRXRD) en atomaire krachtmicroscoop (AFM) metingen. Uitstekende kristalkwaliteit en glad oppervlak werden bevestigd door de meting. Na natte chemische reiniging werd de Ti/Au (20 nm/100 nm) metalen stapel afgezet met behulp van E-beam verdamping op de achterkant en gevolgd door de snelle thermische annealing (RTA) bij 600 ° C gedurende 60 s onder stikstofatmosfeer om vormen het Ohmse contact. De cirkelvormige Schottky-anode-elektroden met een diameter van 100 m werden aan de voorzijde gevormd door verdamping van Mo/Au (40 nm/100 nm) metalen en een opstijgproces. Figuur 1c toont de structuur van de schematische doorsnede van de β-Ga2 O3 SBD in dit werk.
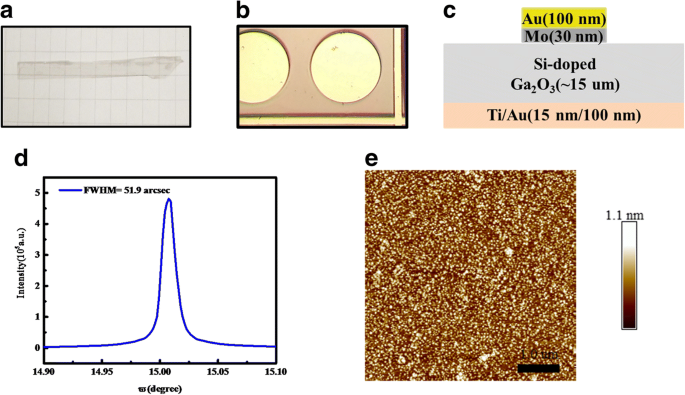
een De Sn-gedoteerde β-Ga2 O3 substraat met een dikte van 300 m. b De Schottky-anode-elektroden gevormd aan de voorzijde met een diameter van 100 m. c De structuur van het schematische dwarsdoorsnede van de β-Ga2 O3 SBD. d XRD schommelende curve en e AFM-beeld van de β-Ga2 O3 driftlaag mechanisch geëxfolieerd van (100) β-Ga2 O3 substraat
Resultaten en discussie
De stroom-spanning (I-V) kenmerken van Au/Mo/β-Ga2 O3 Schottky-barrièrediodes werden onderzocht met behulp van een Keithley 4200 halfgeleiderkarakteriseringssysteem tussen 298 en 423 K. Zoals weergegeven in figuur 2a, is de I aan /Ik uit verhouding is dicht bij 10 10 bij 298 K, wat wijst op een goed corrigerend gedrag. Voor de voorwaartse bias van 0,1 tot 0,7 V zijn de semilogaritmische IV-curven bijna liner en vertonen ze een sterk temperatuurafhankelijk gedrag. Naarmate de voorwaartse bias verder toeneemt, wordt de afwijking van de lineariteit van de IV-curven toegeschreven aan de serieweerstand van de Schottky-barrièrediode en kan de relatie tussen de aangelegde spanning en de stroom worden uitgedrukt als \( I={I}_s\left \{\exp \left[\frac{q\left(V-{IR}_s\right)}{nkT}\right]-1\right\} \) [21,22,23], waarbij V is de aangelegde spanning, R s de serieweerstand, T de absolute temperatuur, k de Boltzmann-constante, n de idealiteitsfactor, en I s is de omgekeerde verzadigingsstroom. De n en ik s kan worden bepaald aan de hand van de helling en het snijpunt van de ln I-V percelen, respectievelijk. Voor de ideale Schottky-barrièrediode is de idealiteitsfactor n moet gelijk zijn aan eenheid. Hoe hoger de n , hoe groter de afwijking van het thermische emissie (TE)-model. Bovendien, volgens de vergelijking \( {\phi}_b=\frac{kT}{q}\ln \left[\frac{AA^{\ast }{T}^2}{I_s}\right] \ ) [21,22,23], de waarden van ϕ b bij verschillende temperaturen werden ook bepaald, zoals weergegeven in Fig. 2b, waar ϕ b is de hoogte van de barrière, A is het diodegebied en A * is de effectieve Richard-constante 40,8 A cm −2 K − 2 met de β-Ga2 O3 effectieve massa van m * = 0,34 m 0 [5, 24]. Met een temperatuurstijging van 298 tot 423 K, de ϕ b neemt toe terwijl n neemt af, wat wijst op een ander transportmechanisme dat ook bijdraagt aan het huidige transport en leidt tot de afwijking van de IV-kenmerken van het pure TE-model, wat eerder is gerapporteerd in β-Ga2 O3 Schottky-barrièrediodes [25] en andere apparaten met brede bandgap [26,27,28,29,30]. De analyse van de inhomogeniteit van de barrièrehoogte kan worden beschreven door een Gauss-verdeling in barrièrehoogten,
$$ {\phi}_b=\overline{\phi_{b0}}\left(T=0\right)-\frac{q{\sigma}_s^2}{2 kT} $$ (1)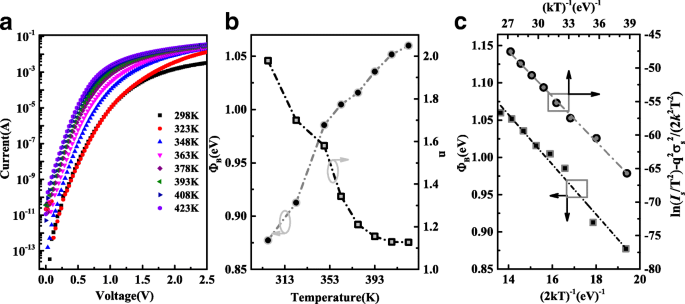
een Voorwaartse IV-kenmerken van Mo/β-Ga2 O3 Schottky-barrièrediodes bij verschillende temperaturen. b Temperatuurafhankelijkheid van de idealiteitsfactor en Schottky-barrièrehoogte van β-Ga2 O3 Schottky-barrièrediode. c Percelen van ϕ ap versus q/2k T en gewijzigde Richardson-plot versus 1/k T voor de β-Ga2 O3 Schottky-barrièrediodes
De waarden van de gemiddelde barrièrehoogte \( \overline{\phi_{b0}} \) en de standaarddeviatie σ s worden geëxtraheerd om respectievelijk 1,55 eV en 0,186 eV te zijn uit Fig. 2c. Bovendien wordt, rekening houdend met de inhomogeniteiten van de barrièrehoogte, de conventionele Richardson-plot als volgt gewijzigd:
$$ \ln \left(\frac{I_{\mathrm{s}}}{T^2}\right)-\left(\frac{q^2{\sigma}_{\mathrm{s}}^ 2}{2{k}^2{T}^2}\right)=\ln \left({AA}^{\ast}\right)-\frac{q\overline{\phi_{b0}}} {kT} $$ (2)Zoals getoond in Fig. 2c, is de gewijzigde \( \ln \left({I}_{\mathrm{s}}/{T}^2\right)-\left({q}^2{\sigma}_ {\mathrm{s}}^2/2{k}^2{T}^2\right) \) versus 1/kT is een rechte lijn. Het snijpunt van de curve wordt gebruikt om de A . te verkrijgen * van 44,7 A cm −2 K −2 , wat zeer dicht bij de theoretische waarde van β-Ga2 . ligt O3 van 40,8 A cm −2 k −2 . Vandaar dat de barrière-inhomogeniteiten bij metaal/halfgeleiderinterface voor β-Ga2 O3 SBD kan worden verklaard door TE met Gauss-verdeling van barrière over de SBH's.
De omgekeerde doorslagmeting bij kamertemperatuur werd ook uitgevoerd met behulp van Agilent B1505A hoogspannings-halfgeleideranalysatorsysteem, zoals weergegeven in Fig. 3. De doorslagspanning was 260 V terwijl het 300 V was met het monster ondergedompeld in Fluorinert ™ geproduceerd door 3M company die luchtafbraak onder hoge omgekeerde voorspanning kan voorkomen. Om de verdeling van het elektrische veld te begrijpen, werd numerieke simulatie uitgevoerd met ATLAS-software, zoals weergegeven in Fig. 4a, b. Naarmate de afstand vanaf het grensvlak tussen de halfgeleider en de anode toeneemt tot ongeveer 1 m, neemt het elektrische veld geleidelijk af. Op de positie van x = 4 μm, het gemiddelde elektrische veld is 3 MV/cm, berekend uit figuur 4c. Ook getoond in Fig. 4d, op de positie van y =-1 nm, het maximale elektrische veld bij doorslagspanning was ongeveer 8 MV/cm aan de rand van het Schottky-contact, wat ongeveer 2,7 keer zo groot is als het gemiddelde elektrische veld. Zoals gerapporteerd door AJ Green et al [31] en K. Zeng et al [32], waren het elektrische piekveld en het gemiddelde elektrische veld van de elektroderand respectievelijk 5,3, 3,8 MV/cm en 6,1, 4,4 MV/cm, en het elektrische piekveld van Mo/Ga2 O3 Schottky-diode is relatief hoog. Er wordt verondersteld dat de β-Ga2 O3 nanomembraan verkregen door mechanische afschilfering heeft een groot aantal bungelende bindingen en oppervlaktetoestanden die elektronen zullen vangen om de dragers van anode naar kathode uit te putten onder omgekeerde voorspanning [33]. Rekening houdend met de negatieve oppervlaktelading, toonde het simulatieresultaat aan dat het elektrische veld aan de rand van het Schottky-contact verminderd was met een negatieve oppervlaktelading die toenam van 0,5 × 10 13 cm −2 tot 3 × 10 13 cm −2 , respectievelijk. Vooral met de negatieve oppervlakteladingsdichtheid van 3 × 10 13 cm −2 , is het elektrische piekveld aan de rand van het Schottky-contact ongeveer 5,2 MV/cm. Daarom kan de omgekeerde doorslagspanning van 300 V worden bereikt op de β-Ga2 O3 nano-membraan met N D = 3 × 10 17 cm −2 zonder enige randafsluitingsstructuren. Zoals getoond in Fig. 4d, vanwege het bestaan van een interfacestatus op X -positie onder 2 μm, de elektronen kunnen worden gevangen en het uitputtingsgebied kan worden gevormd, wat resulteert in het elektrische veld in de Y richting. Naarmate de concentratie van de interfacetoestand toeneemt, neemt het elektrische veld in de Y richting neemt toe, hoewel het elektrische veld in de X richting nadert nul. Dus het elektrische veld neemt toe bij X -positie onder 2 μm.
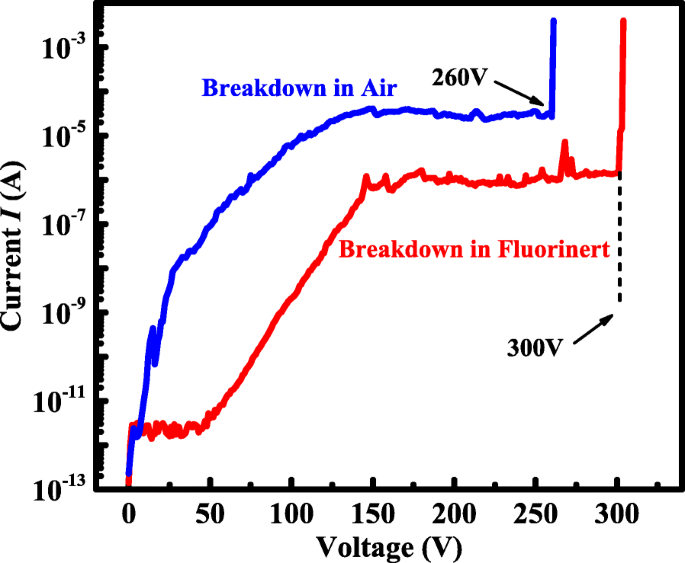
De omgekeerde IV-kenmerken van de β-Ga2 O3 monsters bij kamertemperatuur respectievelijk in Fluorinert en lucht

een Off-state TCAD elektrisch veldsimulatie van de Schottky-barrièrediodes onder een voorspanning van − 300 V. b De elektrische veldsimulatie van de geselecteerde regio's in een groen gestippeld vak. Het potentieel langs de y as op x = 4 μm is aanwezig in (c ), en het elektrische veld aan de rand van het Schottky-contact verminderd met verschillende effectieve negatieve oppervlakteladingsdichtheden zijn aanwezig in (d )
Aan de andere kant, met de omgekeerde bias V re toenemen, de lekstroom I re neemt toe in plaats van te verzadigen voor |V |> 3k B T/q , zoals weergegeven in figuur 5a, wat niet in overeenstemming is met de TE-theorie. Daarom werd de door het elektrisch veld versterkte thermionische emissie overwogen om de afhankelijkheid van de I te bespreken. re op V re , inclusief Poole-Frenkel-emissie en Schottky-emissie [34, 35]. Bij Poole-Frenkel-emissie transporteren de elektronen van metaal naar de halfgeleider via een opgesloten toestand en de I re wordt gegeven door
$$ {I}_{re}\propto E\exp \left(\frac{q}{kT}\sqrt{\frac{qE}{{\pi \varepsilon}_S}}\right) $$ (3 )terwijl bij Schottky-emissie de elektronen genoeg energie zullen krijgen om de barrière bij het metaal/halfgeleider te overwinnen om de stroom en de I te vormen re kan worden uitgedrukt door
$$ {I}_{re}\propto {T}^2\exp \left(\frac{q}{2 kT}\sqrt{\frac{qE}{{\pi \varepsilon}_S}}\right ) $$ (4)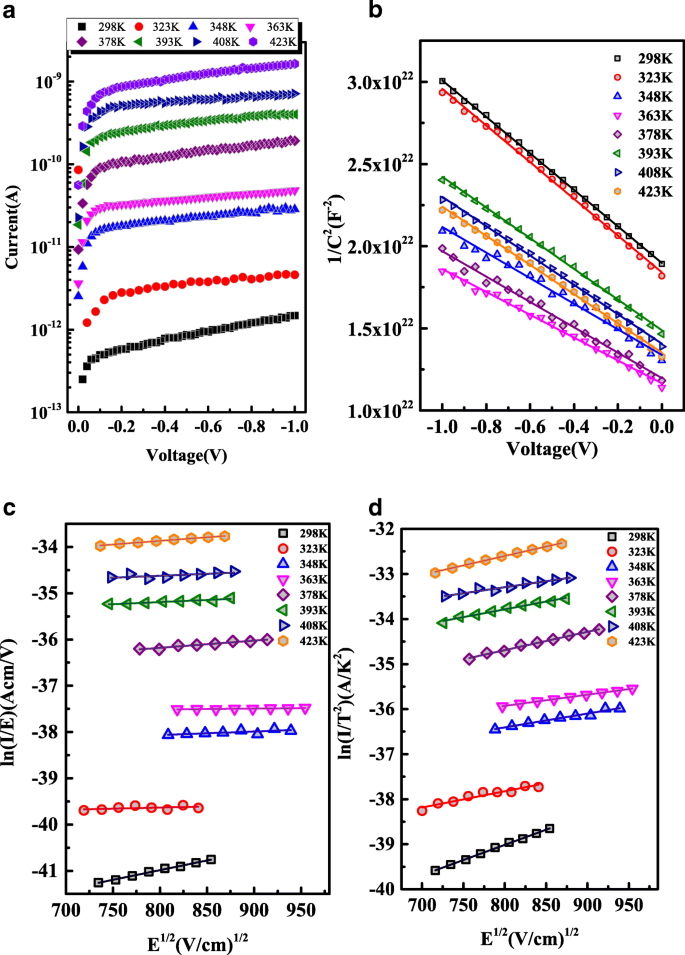
een Omgekeerde IV-kenmerken van Mo/β-Ga2 O3 Schottky-barrièrediodes bij verschillende temperaturen. b Temperatuurafhankelijkheid van 1/C 2 kenmerken van de Mo/ β-Ga2 O3 Schottky-barrièrediodes. De elektrische veldafhankelijkheidsanalyse van Mo/β-Ga2 O3 Schottky contact met ander mechanisme. c Poole-Frenkel-mechanisme (I /E ) versus E 1/2 en d Schottky-mechanisme ln (Ik /T 2 ) versus E 1/2
waar ε s is de permittiviteit van de β-Ga2 O3 (~ 10 ε0 ) en E is het aangelegde elektrische veld, berekend door \( E\kern0.5em =\kern0.5em \sqrt{\frac{2{qN}_D}{\varepsilon_S}\left(V+{V}_{bi}-\frac {k_BT}{q}\right)} \), N D is de donordichtheid van de β-Ga2 O3 , en V bi is het ingebouwde potentieel. Zoals getoond in Fig. 5b, N D en V bi kan worden geëxtraheerd uit de helling en het snijpunt van de inverse vierkante capaciteit (1/C 2 ) versus de V re plot met behulp van de volgende uitdrukking
$$ \frac{1}{C^2}=\frac{2\left({V}_{\mathrm{bi}}- kT/qV\right)}{q{\varepsilon}_s{A}^ 2{N}_D} $$ (5)Als de curve van ln (I/T 2 ) versus E 1/2 lineair is, is het Schottky-emissiemechanisme dominant. En als de plot van ln (Ik /E ) versus E 1/2 is voering, domineert de Poole-Frenkel-emissie het tegenstroomtransport. Afbeelding 5c, d toont de plots van ln (Ik /E ) en ln (Ik /T 2 ) versus E 1/2 , respectievelijk. Beide sets van de curven zijn lineair, wat aangeeft dat niet alleen de Poole-Frenkel-emissie maar ook de Schottky-emissie aanwezig is. Om het dominante transportmechanisme van de vervoerder te verduidelijken, kan de helling van de curven of de emissiecoëfficiënt worden uitgedrukt als [34,35,36].
$$ S=\frac{q}{nkT}\sqrt{\frac{q}{\pi \varepsilon}} $$ (6)waar n = 1 is voor de Poole–Frenkel-emissie (S PF ) en n = 2 voor de Schottky-emissie (S S ). De experimentele waarden van S worden aangeduid als S m-PF en S m-S voor Poole-Frenkel- en Schottky-emissie gegeven door de helling van de curven in respectievelijk Fig. 5c, d. De verhoudingen van de experimentele waarde tot de theoretische waarde, N PF (=S m-PF /S PF ) en N S (=S m-S /S S ), worden weergegeven in Fig. 6. Aangezien de waarden van N S zijn dichter bij eenheid dan die van N PF , wordt de tegenstroom gedomineerd door de Schottky-emissie.

Relatieve coëfficiëntgrafieken van Poole-Frenkel-emissie N PF (=S m-PF /S PF ) en Schottky-emissie N S (=S m-S /S S ) versus temperatuur
Conclusies
We hebben de elektrische eigenschappen onderzocht van Mo/Au Schottky-barrièrediodes die zijn gefabriceerd op de (100) β-Ga2 O3 film mechanisch geëxfolieerd van de Sn-gedoteerde β-Ga2 O3 substraat. Op basis van het TE-model, de geëxtraheerde ϕ b en n respectievelijk stijgt en daalt met de stijgende temperatuur. Door de Gauss-verdeling van inhomogene barrièrehoogte aan te nemen, werden de gemiddelde barrièrehoogte van 1,55 eV en de standaarddeviatie van 0,186 eV verkregen. Tot slot, volgens de ln (Ik /T 2 ) en ln (Ik /E ) versus E 1/2 plots, de parameter N S van Schottky-emissie is bijna één, wat illustreert dat de Schottky-emissie het dominante transportmechanisme van de tegenstroom is. De doorslagspanning van 300 V met monsters in Fluorinert wordt verkregen in Mo/Au Schottky-barrièrediodes met een gemiddeld elektrisch veld van 3 MV/cm, wat wijst op het grote potentieel van β-Ga2 O3 voor toepassingen in vermogenselektronica.
Afkortingen
- I-V:
-
Stroom-spanning
- Ma:
-
Molybdeen
- RTA:
-
Snel thermisch gloeien
- SBD:
-
Schottky-barrièrediode
- TE:
-
Thermionische emissie
Nanomaterialen
- Experimenteel onderzoek naar stabiliteit en natuurlijke convectie van TiO2-water nanovloeistof in behuizingen met verschillende rotatiehoeken
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Experimenteel onderzoek naar de stromings- en warmteoverdrachtskenmerken van TiO2-water-nanovloeistoffen in een spiraalvormig gecanneleerde buis
- Vervaardiging van SrGe2 dunne films op Ge (100), (110) en (111) substraten
- 5-aminolevulinezuur-squaleen nanoassemblages voor tumorfotodetectie en therapie:in vitro studies
- Het bestuderen van de hechtkracht en glasovergang van dunne polystyreenfilms door Atomic Force Microscopy
- Voorbereiding en thermo-elektrische kenmerken van ITO/PtRh:PtRh Thin Film Thermokoppel
- TEM- en STEM-onderzoeken naar de transversale morfologieën van dubbel-/drielaags breedband SiO2-antireflectiefilms
- Theoretische studies over InGaAs/InAlAs SAGCM lawinefotodiodes
- Een theoretische simulatie van de stralingsreacties van Si, Ge en Si/Ge-superrooster op laag-energetische bestraling
- Het groeimechanisme van GaN epitaxiale lagen op mechanisch geëxfolieerd grafiet begrijpen



