Theoretische studies over InGaAs/InAlAs SAGCM lawinefotodiodes
Abstract
In dit artikel geven we een gedetailleerd inzicht in InGaAs/InAlAs afzonderlijke absorptie-, grading-, ladings- en vermenigvuldigingslawinefotodiodes (SAGCM APD's) en wordt een theoretisch model van APD's gebouwd. Door theoretische analyse en tweedimensionale (2D) simulatie wordt de invloed van de ladingslaag en het tunneleffect op de APD's volledig begrepen. Het ontwerp van de ladingslaag (inclusief dopingniveau en dikte) kan worden berekend door ons voorspellende model voor verschillende vermenigvuldigingsdiktes. We vinden dat naarmate de dikte van de ladingslaag toeneemt, het geschikte bereik van het doteringsniveau in de ladingslaag afneemt. Vergeleken met een dunnere ladingslaag, varieert de prestatie van APD aanzienlijk via enkele procenten afwijkingen van de dopingconcentraties in een dikkere ladingslaag. Bovendien is de generatiesnelheid (G btt ) van band-naar-band tunnel wordt berekend en de invloed van het tunneleffect op het lawineveld werd geanalyseerd. We bevestigen dat lawineveld en vermenigvuldigingsfactor (M n ) in vermenigvuldiging zal afnemen door het tunneleffect. Het theoretische model en de analyse zijn gebaseerd op InGaAs/InAlAs APD; ze zijn echter ook van toepassing op andere APD-materiaalsystemen.
Achtergrond
In0,53 Ga0,47 As (hierna InGaAs genoemd) zijn lawinefotodiodes (APD's) de belangrijkste fotodetectoren voor kortegolf-infrarooddetectie. Ze zijn belangrijk op traditionele gebieden, zoals glasvezelcommunicatie, verkenningstoepassingen en teledetectie. InP en In0,52 Al0,48 As (hierna InAlAs genoemd) hebben dezelfde roosterafstand als InGaAs en hebben grote lawinedoorslagkarakteristieken; daarom zijn ze de geschikte vermenigvuldigingslaagmaterialen van InGaAs APD's in de traditionele toepassingen. In de afgelopen jaren, vanwege de snelle ontwikkeling van enkelvoudige fotondetectie in kwantumsleuteldistributie [1], tijdopgeloste spectroscopie [2], optische VLSI-circuitinspectie [3] en 3D-laserbereik [4], APD's als de sleutel component in deze toepassingen hebben steeds meer aandacht getrokken [5, 6]. Pellegrini et al. beschreef het ontwerp, de fabricage en de prestaties van InGaAs/InP-apparaten met vlakke geometrie die zijn ontwikkeld voor detectie van één foton met de enkelvoudige fotondetectie-efficiëntie (SPDE) 10% bij 1550 nm (200 K) [7]. Tosi et al. presenteerde de ontwerpcriteria van een nieuwe InGaAs/InP single-photon lawine fotodiode (SPAD) met hoge SPDE (30%, 225 K), weinig ruis en lage timing jitter [8]. In simulatie werd een apparaatmodel gebouwd op basis van experimentele gegevens om de dark count rate (DCR) en SPDE van InGaAsP/InP SPAD's in [9] te voorspellen, en een geïntegreerd simulatieplatform dat de kwantumsleuteldistributieprestaties van InGaAs in loktoestanden kan evalueren. /InP SPADs is gebouwd in [10]. Acerbi et al. presenteerde ontwerpcriteria voor InGaAs/InP single-photon APD's met een aangepaste SPAD-simulator [11]. Voor InGaAs/InAlAs APD's werd aangetoond dat een mesastructuur SPAD InGaAs/InAlAs de SPDE van 21% (260 K) bereikt; er werd echter een hoge DCR waargenomen en deze werd toegeschreven aan overmatige tunnelstroom [12]. [13] gebruikte vervolgens een dikke InAlAs-lawinelaag in InGaAs/InAlAs APD's om de SPDE (26%, 210 K) te verbeteren en de DCR te verlagen (1 × 10 8 Hz). Bij simulatie van op InAlAs gebaseerde APD's werd een apparaatmodel opgesteld dat gebaseerd is op de Monte Carlo-methode om de basiskarakterisering van InGaAs/InAlAs APD's in [14] te bestuderen, en de invloed van ladingslaag en vermenigvuldigingslaag op doorslagspanning en de doorslag. spanning werden bestudeerd met steady-state 2D numerieke simulaties in [15].
Vergeleken met op InAlAs gebaseerde APD's, zijn onderzoeken naar op InP gebaseerde APD's uitgebreider en diepgaander in theorie en simulatie. Op InAlAs gebaseerde APD wordt echter steeds vaker gebruikt in plaats van InP, omdat het een grotere band gap heeft die de doorslagkenmerken kan verbeteren, zowel in de APD's als in de SPAD's [16]. De ionisatiecoëfficiëntverhouding van elektron (α) tot gat (β) in InAlAs is groter in vergelijking met InP en heeft daarom een lage overruisfactor en een product met een hoge versterkingsbandbreedte. Bovendien vertoont InAlAs een grote toename van de kans op defecten met een overbias-ratio, waardoor InAlAs SPAD's een lagere DCR hebben [17]. Enkele belangrijke eigenschappen en conclusies met betrekking tot op InAlAs gebaseerde APD's werden verkregen uit eerdere studies, zoals de lage overmatige ruis die kan worden bereikt in InAlAs-structuren met zowel dikke als dunne lawinegebieden [18]. Het elektrische veld van de tunnelingdrempel in de absorptie (InGaAs) is 1,8 × 10 5 V/cm, en de tunnelstroom wordt de dominante component van de donkere stroom in het hoge veld [14]. Een structuur met verticale verlichting heeft een grotere optische tolerantie, maar er is een serieuzere afweging tussen de transittijd van de vervoerder en de responsiviteit [19]. Bovendien zijn theoretisch model, structuur (dikte en doping), elektrisch veld en andere op InAlAs gebaseerde APD-parameters bestudeerd in [20,21,22]. Deze onderzoeken waren echter alleen gericht op invloeden van algemene APD-structuurparameters, zoals de dikte van de absorptielaag, de vermenigvuldigingsdikte en het doteringsniveau van de ladingslaag. De relatie tussen de structuurparameters en de prestaties van de op InAlAs gebaseerde APD is nog niet volledig begrepen en geoptimaliseerd.
In dit artikel werd een theoretische studie en numerieke simulatieanalyse onderzocht op basis van de verticale structuur van InGaAs/InAlAs voor detectie van een golflengte van 1,55 μm. We hebben een theoretisch model gebouwd om de invloed van structuurparameters op het apparaat en de gedetailleerde relatie van elke laag in APD's te bestuderen. Het ontwerp van de ladingslaag met verschillende vermenigvuldigingsdiktes, de invloed van de dikte op het dopingniveau in de ladingslaag en het tunneleffect op het lawineveld in de vermenigvuldiging werden geanalyseerd en gesimuleerd.
Methoden
In deze sectie werd een wiskundige relatie tussen de apparaatparameters en de elektrische veldverdeling in het apparaat gebouwd, die werd toegepast om de ladingslaag en het tunneleffect te analyseren. Tegelijkertijd werd een simulatiemodel gebouwd met simulatiestructuur, materiaalparameters en fysieke basismodellen. Het theoretische analysemodel en simulatiemodel waren gebaseerd op de verticale structuur van SAGCM InGaAs/InAlAs APD.
Theoretisch model en analyse van de ladingslaag
Apparaatparameters, zoals dopingniveau, dikte, materialen en structuur, werden gebruikt om het wiskundige model te bouwen voor het berekenen van de elektrische veldverdeling in APD. De fysische basistheorieën die de Poisson-vergelijking, het uitputtingslaagmodel en het PN-junctiemodel van een halfgeleiderapparaat bevatten, zijn te vinden in de hoofdstukken 1, 2 en 4 in [23] en [24]. De junctie-vermenigvuldigingsfactorvergelijking is te vinden in [25], en de materiaalparameters van halfgeleider zijn afkomstig uit [26]. Het gepresenteerde model gebruikt de Poisson-vergelijking, de tunneling-stroomdichtheidsvergelijking, het uitputtingslaagmodel, het knooppunttheoriemodel en het lokale model van lawineversterking. Het vereenvoudigde wiskundige coördinatensysteem van de APD met basisstructuurparameters (materialen, dikte, dotering en diëlektrische constante) wordt weergegeven in figuur 1. Het is een vereenvoudigde SACM APD-structuur die de gradatielaag negeert. De materialen van de contactlaag, ladingslaag en vermenigvuldigingslaag zijn InAlAs en de absorptielaag is InGaAs. De overgangen van lagen worden gescheiden door X n , 0, X m , X c , en X een en X p door de x coördineren. Dopingniveaus worden uitgedrukt door N 0 , N 1 , N 2 , N 3 , en N 4 , de laagdiktes worden uitgedrukt door w 0 , w 1 , w 2 , w 3 , en w 4 , en diëlektrische constanten worden uitgedrukt door ε s0 , ε s1 , ε s2 , ε s3 , en ε s4 van respectievelijk contact A, vermenigvuldiging, lading, absorptie en contact B.
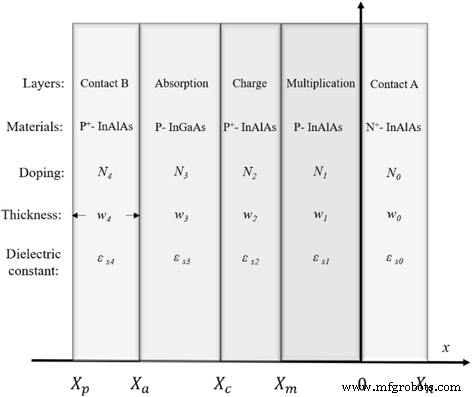
Het vereenvoudigde wiskundige coördinatensysteem van SACM InGaAs/InAlAs APD. Presenteert de vereenvoudigde structuren van een APD die wordt gebruikt om een theoretisch model te bouwen. Het vereenvoudigde wiskundige coördinatensysteem van de APD met basisstructuurparameters (materialen, dikte, dotering en diëlektrische constante)
Vergelijking 1 is de Poisson-vergelijking, die de elektrische potentiaalverdeling kan oplossen met behulp van de ladingsdichtheid ρ . In deze vergelijking, ρ is gelijk aan doteringsion N in het uitputtingslaagmodel, w gelijk is aan de dikte van de uitputtingslaag, en ε is de diëlektrische constante van het materiaal. In het gemeenschappelijke PN-junctie elektrisch velddistributiemodel, ρ is een variabele die afhangt van de dikte van de uitputtingslaag w en doteringsion N . In dit model verandert het na overweging van het tunneleffect. Voordat we echter rekening hielden met het tunneleffect, hebben we eerst de elektrische veldverdeling gebouwd met behulp van een algemene methode.
$$ \frac{d\xi}{d x}=\frac{\rho }{\varepsilon }=\frac{q\times N}{\varepsilon } $$ (1)Door de Poisson-vergelijking op te lossen met de apparaatparameters, wordt de wiskundige uitdrukking van het maximale elektrische veld verkregen. Deze uitdrukking wordt bepaald door de variatie in penetratiedikte in de uitputtingslaag die wordt weergegeven in formules 2 en 3. In deze uitdrukking worden de parameters die dopingniveaus bevatten (N ), diktes van de uitputtingslaag (w ), en diëlektrische constanten (ε) van verschillende lagen zijn te vinden in Afb. 1.
$$ {\xi}_{\max (w)}={\sum}_{k=1}^4\left(-\frac{q\times {N}_k\times {w}_k}{\ varepsilon_{sk}}\right) $$ (2) $$ {\xi}_{\max (w)}=\frac{q\times {N}_0\times {w}_0}{\varepsilon_{s0 }} $$ (3)Vervolgens kan de elektrische veldverdeling in alle punten worden afgeleid met formules 4 en 5. De randvoorwaarde negeert de ingebouwde potentiaal V br in formule 6; daarom kan de wiskundige relatie tussen de dikte van de uitputtingslaag en de voorspanning worden berekend.
$$ {\xi}_{\left(x,w\right)}={\xi}_{\max (w)}+{\sum}_{k=1}^4\left(\frac{ q\times {N}_k\times \left|x\right|}{\varepsilon_{sk}}\right)\left({X}_pVanuit het model kunnen formules 7-11 worden gebruikt om het elektrische veld in elke laag te analyseren zodra de grens van de uitputtingslaag het contactgebied bereikt. In de praktische APD worden de absorptie- en vermenigvuldigingslagen onbedoeld gedoteerd in intrinsieke lagen. N 3 en N 1 zijn kleiner dan N 2 . Formule 9 is dus ongeveer gelijk aan Formule 12. Dit is de reden dat de ladingslaag de elektrische veldverdeling in het apparaat kan regelen.
$$ {\displaystyle \begin{array}{l}\xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{\max \left({V}_ {\mathrm{bias}}\right)}+\frac{q\times {N}_1\times {w}_1}{\varepsilon_{s1}}+\frac{q\times {N}_2\times { w}_2}{\varepsilon_{s2}}+\frac{q\times {N}_3\times \left|x-{X}_c\right|}{\varepsilon_{s3}}\\ {}\kern4em \ongeveer {\xi}_{\max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times {N}_2\times {w}_2}{\varepsilon_{ s2}}\left({X}_{\mathrm{c}}\ge x\ge {X}_a\right)\end{array}} $$ (12)In formule 8 wordt het elektrisch veldverschil tussen vermenigvuldiging en absorptie bepaald met het product van N 2 en w 2 . N 2 is het dopingniveau in de ladingslaag en w 2 is de dikte van de ladingslaag. Voor een geschikte elektrische veldverdeling in InGaAs/InAlAs APD moet het elektrische veld in de absorptielaag (InGaAs) binnen de intervalwaarden van 50-180 kV/cm liggen die voldoende snelheid voor de foto-geïnduceerde dragers garanderen en het tunneleffect vermijden in de absorptielaag [10]. Dat wil zeggen, het lawineveld in vermenigvuldiging moet afnemen tot 50-180 kV / cm in absorptie door de ladingslaag. We kunnen dus formule 8 gebruiken om het optimale berekende dopingniveau en de dikte van de ladingslaag te vinden. Als de vermenigvuldigingslaag 200 nm is (het lawineveld E in de vermenigvuldiging is 6,7 × 10 5 V/cm terwijl de vermenigvuldigingslaag 200 nm is [27]); de berekende waarden van dopingniveau en dikte in de ladingslaag worden vergeleken met resultaten van [28,29,30,31,32,33] in Fig. 2. Het gebied van theoretische waarden komt goed overeen met de experimentele gegevens. Dit resultaat bewijst dat formule 8 kan worden gebruikt om het dopingniveau met verschillende diktes in de ladingslaag te voorspellen wanneer de vermenigvuldigingsdikte zeker is.
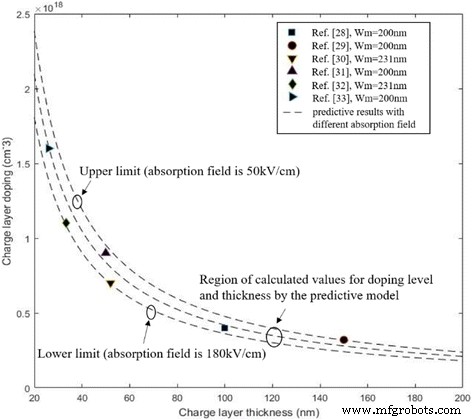
Vergelijking van theoretische resultaten en experimentgegevens uit verschillende rapporten (w m = 200 nm). Gesloten symbolen:het doteringsniveau en de dikte van de ladingslaag met een vermenigvuldigingsdikte van 200 nm (zwart vierkant, zwarte cirkel, zwarte driehoek, zwarte rechtswijzende driehoek) en 231 nm (zwarte ruit, zwarte naar beneden wijzende driehoek) in de referenties. Presenteert de berekende waarden van de ladingslaag (dopingniveau en dikte) volgens formule 8 (het absorptieveld is 50-180 kV/cm). Wanneer het absorptieveld 50 kV/cm is, kan de bovengrens van het doteringsniveau in de ladingslaag worden verkregen. Wanneer het absorptieveld 180 kV/cm is, kan de ondergrens van het doteringsniveau in de ladingslaag worden verkregen. We vergelijken de theoretische resultaten en experimentgegevens uit verschillende rapporten. Het gebied van theoretische waarden komt goed overeen met de experimentele gegevens. Gestippelde lijnen de berekende waarden van dopingniveau en dikte door de formule
We berekenen het optimale dopingniveau voor verschillende diktes van de ladingslaag met de vermenigvuldigingslaag van 300, 500 en 700 nm, en de resultaten zijn weergegeven in Fig. 3. Dit resultaat illustreert dat de tolerantie in het dopingniveau in de ladingslaag gerelateerd aan de dikte en het bereik van het dopingniveau neemt af met de diktetoename van de ladingslaag. Dat wil zeggen, als we een dik ladingsgebied toepassen, zou er slechts een klein bereik van doteringsniveaus in de ladingslaag bestaan om te voldoen aan het optimale elektrische veld. Als gevolg hiervan varieert de prestatie van APD aanzienlijk via afwijkingen van enkele procenten van dopingconcentraties in de dikkere ladingslaag. In de sectie "Resultaten en discussie" werden de praktische structuren van APD's gesimuleerd om de theoretische analyse te bestuderen en te verifiëren, waaronder de invloed van de dikte van de ladingslaag op het dopingniveaubereik in de ladingslaag en de verscheidenheid aan prestaties voor verschillende ladingslaagdiktes in APD's.

Het optimale doteringsniveau en de dikte van de ladingslaag voor verschillende vermenigvuldigingslagen. Ononderbroken lijn:w m = 300 nm. Stippellijn:w m = 500 nm. Puntlijn:w m = 700 nm. Presenteert de berekende waarden van de ladingslaag (dopingniveau en dikte) volgens de formule terwijl het veld van de absorptielaag geschikt is. De diktes van de vermenigvuldigingslaag zijn 300, 500 en 700 nm. Wanneer de dikte van de vermenigvuldigingslaag zeker is, kunnen we de formule gebruiken om het optimale dopingniveau en de dikte van de ladingslaag te vinden
Theoretisch model met aandacht voor tunneling
Het bovenstaande analysemodel gaat over de verdeling van elektrische velden in het apparaat en is gebaseerd op het uitgangspunt dat ρ is het doteringsion in de uitputtingslaag. Als er een voldoende hoog elektrisch veld bestaat binnen de absorptielaag, kan de lokale bandbuiging voldoende zijn om elektronen te laten tunnelen [34]. Daarom kan elektronentunneling optreden. Uit het tunneldiagram in Fig. 4, wanneer de absorptielaag een doorslagtunneling heeft, verandert het tunneleffect de ladingsdichtheid ρ , neemt de positieve lading in absorptie toe en neemt de negatieve lading in de vermenigvuldigings- en ladingslagen toe. Dus, ρ is niet gelijk aan de doteringsionenladingsdichtheid in de uitputtingslaag terwijl het tunneleffect optreedt. De formules die eerder zijn besproken, zullen veranderen nadat rekening is gehouden met het tunneleffect.

Tunnelproces en verandering van ladingsdichtheid in de vermenigvuldigings- en absorptielagen. Presenteert een schematisch diagram van het tunnelproces in het apparaat. Als er een voldoende hoog elektrisch veld bestaat binnen de absorptielaag, kan de lokale bandbuiging voldoende zijn om elektronen te laten tunnelen. Wanneer de absorptielaag een doorslagtunneling heeft, neemt de positieve lading in absorptie toe en neemt de negatieve lading in de vermenigvuldigings- en ladingslagen toe. Dus, ρ is niet gelijk aan de doteringsionenladingsdichtheid in de uitputtingslaag terwijl het tunneleffect verschijnt
De generatiesnelheid G bbt van band-naar-band tunnel wordt beschreven in formule 13 [35, 36].
$$ {G}_{bbt}={\left(\frac{2{m}^{\ast }}{E_g}\right)}^{1/2}\frac{q^2{E_p}^ {\gamma }}{{\left(2\pi \right)}^3{\hbar}^2}\exp \left(\frac{-\pi }{4{q\mathit{\hbar E}} _p}{\left(2{m}^{\ast}\times {E_g}^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex} {$2$}\right.}\right)=A\times {E_p}^{\gamma}\times \exp \left(-\frac{B}{E_p}\right) $$ (13)In Formule 13, E g is de energiebandafstand van InGaAs, m* (gelijk aan 0,04 m e ) is de effectieve gereduceerde massa, E p is het doorslag elektrische veld in de absorptielaag, en γ is een door de gebruiker te definiëren parameter die gewoonlijk beperkt is tot 1~2. De A en B zijn de karakteriseringsparameters. We berekenen de G bbt met verschillende γ , en de resultaten worden getoond in Fig. 5. Het kan worden gevonden dat G bbt past dezelfde orde van grootte aan voor het dopingniveau van de ladingslaag terwijl γ is beperkt tot 1~1,5.

De G btt voor verschillende velden in absorptielaag met verschillende γ . De waarden van γ is 1.0 (zwarte ster), 1.1 (zwarte naar beneden wijzende driehoek), 1.2 (zwarte ruit), 1.3 (zwarte driehoek), 1.4 (zwart vierkant), 1.5 (zwarte cirkel). Geeft de berekende resultaten van G . weer btt volgens formule 13. Wanneer het absorptieveld groter is dan 19 kV/cm, G bbt geleidelijk toeneemt. Het kan ook worden gevonden dat G bbt past dezelfde orde van grootte aan voor het dopingniveau van de ladingslaag terwijl γ is beperkt tot 1~1,5
Als resultaat wordt de ladingsdichtheid ρ is een variabele en wordt bepaald door het tunneleffect en het doteringsion in de absorptietunnel. Bij deze gelegenheid wordt Formule 1 gewijzigd in Formule 14 en wordt het elektrische veld in de vermenigvuldigingslaag beschreven door Formule 15. w tunnel is de effectieve uitputtingslaag van het tunnelproces [35]. Zo kan het veranderen van het lawineveld worden beschreven met formule 16, en het lawineveld zal afnemen in de vermenigvuldiging met het tunneleffect.
$$ \frac{d\xi}{dx}=\frac{\rho }{\varepsilon }=\frac{q\times \left(N+{G}_{btt}\right)}{\varepsilon }, {E}_p> 1.8\times {10}^5V/ cm $$ (14) $$ \xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{ \max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times \left({N}_1\times \left|x\right|+{G}_{bbt }\times {w}_{\mathrm{tunnel}}\right)}{\varepsilon_{s1}}\left(0\ge x\ge {X}_m\right) $$ (15) $$ \delta \xi \left(x,{V}_{\mathrm{bias}}\right)=\delta E=\frac{q\times {G}_{btt}\times {w}_{\mathrm{tunnel }}}{\varepsilon_{\mathrm{s}3}} $$ (16)De elektronen- en gat-ionisatiecoëfficiënten worden beschreven door formules 17 en 18 in [18]. E is het lawineveld in vermenigvuldiging.
$$ \alpha ={a}_n{e}^{\raisebox{1ex}{$-{b}_n$}\!\left/ \!\raisebox{-1ex}{$E$}\right.} $$ (17) $$ \beta ={a}_p{e}^{\raisebox{1ex}{$-{b}_p$}\!\left/ \!\raisebox{-1ex}{$E$ }\rechts.} $$ (18)Het effect van een dragerlawine wordt verklaard door het impactionisatiemodel. Gezien de extreem lage dragerdichtheid van de vermenigvuldigingslaag in vergelijking met de ladingslaag, is het redelijk om aan te nemen dat het elektrische veld uniform is door de vermenigvuldigingslaag. Daarom is de vermenigvuldigingsfactor (M n ) kan worden uitgedrukt als de volgende Vgl. 19. Hier, w m is de dikte van de vermenigvuldigingslaag en k is de impact-ionisatiecoëfficiëntverhouding gedefinieerd door α/β . Sinds k varieert zeer langzaam met het elektrische veld, k is ongeveer constant voor een kleine variatie van w m [37].
$$ {M}_n=\frac{k-1}{k\times {e}^{-\alpha \left(1-\raisebox{1ex}{$1$}\!\left/ \!\raisebox{ -1ex}{$k$}\right.\right){w}_m}-1} $$ (19)Uitgaande van constante w m en voorspanning, differentiatie van M n met betrekking tot elektronenionisatiecoëfficiënten staat in formules 20 en 21.
$$ \delta {M}_n\left|{}_{w=const\&V=const}\right.={M_n}^2{e}^{-\alpha \left(1-\raisebox{1ex} {$1$}\!\left/ \!\raisebox{-1ex}{$k$}\right.\right){w}_m}\times {w}_m\delta \alpha $$ (20) $$ \delta \alpha =\frac{\delta \alpha}{\delta E}={\alpha}_n{b}_n{e}^{\frac{-{b}_n}{E}}\frac{1 }{E^2} $$ (21)In formules 20 en 21, δα/δE is positief. Aangenomen wordt dat 20% van een totale uitputtingsabsorptielaag w . is tunnel en de absorptielaag is 400 nm dik. Door formule 16 op te lossen, wordt de relatie tussen de δE en het absorptieveld met verschillende γ wordt weergegeven in Fig. 6. Het kan worden gevonden dat δE past dezelfde orde van grootte aan voor het lawineveld in de vermenigvuldiging. Het tunneleffect heeft dus invloed op het lawineveld en de M n zal afnemen met het tunneleffect. In de analyse zijn we ervan uitgegaan dat de negatieve lading niet wordt vermenigvuldigd in de vermenigvuldiging en dat het model rigoureuzer zal zijn na overweging. Om de invloed van het tunneleffect op de praktische structuur van APD's te verifiëren en te analyseren, hebben we de relatie tussen het tunneleffect en het vermenigvuldigingslawineveld in detail gesimuleerd in de sectie "Resultaten en discussie".

De δE voor verschillende velden in de absorptielaag met verschillende γ . De waarden van γ is 1.0 (zwarte ster), 1.1 (zwarte naar beneden wijzende driehoek), 1.2 (zwarte ruit), 1.3 (zwarte driehoek), 1.4 (zwart vierkant), 1.5 (zwarte cirkel). Geeft de berekende resultaten van δE . weer met formule 16. Wanneer het absorptieveld groter is dan 19 kV/cm, δE geleidelijk toeneemt. Het kan ook worden gevonden dat δE past dezelfde orde van grootte aan voor het lawineveld in de vermenigvuldiging. Het tunneleffect heeft dus invloed op het lawineveld met het tunneleffect
Structuur- en simulatiemodel
Een halfgeleiderapparaatsimulatie van TCAD werd gebruikt voor simulatie en analyse. Deze simulatie-engine definieert fysieke modellen in simulatie en de resultaten hebben een fysieke betekenis [20]. De fysieke basismodellen werden als volgt gepresenteerd. De drift-diffusiemodellen, inclusief de Poisson- en carriercontinuïteitsvergelijkingen, werden gebruikt om de elektrische veldverdeling en diffusiestroom IDIFF te simuleren. . Band-to-band tunneling model werd gebruikt voor de band-to-band tunneling stroom IB2B , en het trap-assisted tunneling-model werd gebruikt voor trap-assisted tunneling stroom ITAT . De generatie-recombinatiestroom IGR werd beschreven door het Shockley-Read-Hall-recombinatiemodel en de Auger-recombinatiestroom IAUGER werd beschreven door het Auger-recombinatiemodel. De donkerstroom werd duidelijk beschreven door die mechanismen [38]. Lawinevermenigvuldiging werd beschreven door het Selberherr-impactionisatiemodel. Andere basismodellen, waaronder de Fermi-Dirac-draaggolfstatistieken, dragerconcentratie-afhankelijke, lage veldmobiliteit, snelheidsverzadiging en ray-tracing-methoden, werden gebruikt voor het simulatiemodel, en er werd een rigoureus simulatiemodel gebouwd.
Apparaatstructuren in de simulatie waren vergelijkbaar met de experimentele structuren in [13]. De schematische dwarsdoorsnede van de van boven verlichte SAGCM InGaAs/InAlAs APD wordt getoond in Fig. 7. De structuren van boven naar beneden worden achtereenvolgens genoemd als InGaAs-contactlaag, InAlAs-bekledingslaag, InAlGaAs-classificatielaag, InGaAs-absorptielaag, InAlGaAs-classificatie laag, InAlAs-ladingslaag, InAlAs-vermenigvuldigingslaag, InAlAs-bekledingslaag, InP-contactlaag en InP-substraat. De dikte en dotering van elke laag zijn ook weergegeven in Fig. 7. Om de invloed van dikte op simulatieresultaten te voorkomen, kiezen we twee simulatiestructuren. Eén simulatiestructuur wordt APD-1 genoemd (vermenigvuldigings- en absorptielagen zijn respectievelijk 800 en 1800 nm), en de andere simulatiestructuur wordt APD-2 genoemd (vermenigvuldigings- en absorptielagen zijn respectievelijk 200 en 600 nm).
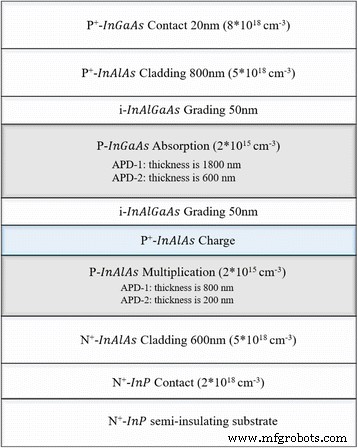
Simulatiestructuur en parameters van de APD. Presenteert de schematische doorsnede van de van boven verlichte SAGCM InGaAs/InAlAs APD-1 en APD-2. Het omvat structuur, materialen, doping en dikte
Om het simulatiemodel te testen, werden de experimentgegevens in [13] vergeleken met de simulatieresultaten. In deze simulatie gebruikten we dezelfde structuur in de referentie en werden de stroom-spanningskarakteristieken van het apparaat gegeven. Afbeelding 8 toont onze simulatieresultaten en de experimentresultaten in de referentie. Ze hebben dezelfde doorslagspanning V pt en doorslagspanning V br . Bovendien komen de simulatie- en experimentresultaten goed overeen. Daarom is het model in onze simulatie nauwkeurig. De hierboven genoemde parameters staan vermeld in Tabel 1.
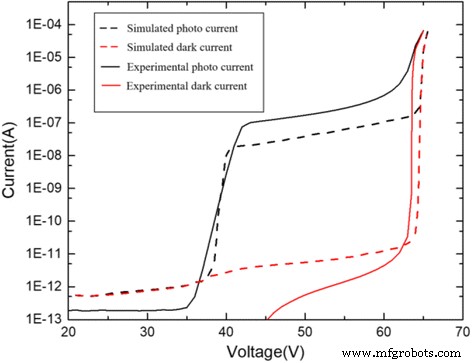
Simulatieresultaten vergeleken met de experimentresultaten (fotostroom en donkerstroom). Zwarte stippellijn:gesimuleerde fotostroom. Rode stippellijn:gesimuleerde donkerstroom. Zwarte ononderbroken lijn:experimentele fotostroom. Rode ononderbroken lijn:experimentele donkerstroom. Presenteert de vergelijking van de simulatieresultaten en experimentresultaten. Het simulatiemodel gebruikt dezelfde parameters van het experiment in de referentie
Resultaten en discussie
In deze sectie werden de theoretische analyse en conclusies in detail bestudeerd door middel van simulatie. Eerst werd de invloed van de dikte van de ladingslaag op de tolerantie van het dopingniveau in de ladingslaag bestudeerd in de sectie "Invloed van de dikte van de ladingslaag". Vervolgens werd de relatie tussen het tunneleffect en het vermenigvuldigingslawineveld geanalyseerd en geverifieerd in de sectie "Tunneling-effect op de elektrische veldverdeling".
Invloed van ladingslaagdikte
Vanaf [14] moet een geschikte veldverdeling in InGaAs/InAlAs APD aan die regels voldoen. De garantie V pt < V br en V br − V pt moet een veiligheidsmarge hebben voor het verwerken van variaties in temperatuurschommelingen en werkbereik. In de absorptielaag moet het elektrische veld groter zijn dan 50-100 kV / cm om voldoende snelheid voor de foto-geïnduceerde dragers te garanderen. Tegelijkertijd moet het elektrische veld kleiner zijn dan 180 kV/cm om het tunneleffect in de absorptielaag te voorkomen. De distributie van elektrische velden heeft een grote invloed op de prestaties van het apparaat. De keuze van het elektrische veld in de absorptielaag heeft een afweging van de afweging tussen kleine looptijd, donkerstroom en hoge responsiviteit voor de praktische eis.
In the simulation, we used the structure of APD-1 (multiplication is 800 nm thick) and adjusted the charge layer thickness from 50 to 210 nm to study the influence of charge layer thickness on doping level range and verify the theoretical conclusions in analytical model. In the simulation, we selected different doping level ranges in the charge layer so that the electric field distribution complies with the rules. The simulation results on the relationship between thickness and doping level range in the charge layer are presented in Fig. 9a. As the charge layer thickness increases, the suitable doping level range in charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. The simulation result of APD-2 (with a thickness of multiplication of 200 nm) is presented in Fig. 9b, which has a similar result. Moreover, it can be found that the calculated results of Fig. 2 and simulation results of Fig. 9b match well as shown in Fig. 9c. The small difference between the calculated results and simulation results is caused by the different values of avalanche field in the simulation and calculation. The avalanche field in simulation engine is used 6.4 × 10 5 V/cm, while in the calculation, we use the value of 6.7 × 10 5 V/cm from [27].

een Relationship between suitable doping level and thickness of charge layer (APD-1). The thickness of charge layer is 50 nm (black square), 90 nm (black circle), 130 nm (black triangle), 170 nm (black down-pointing triangle), 210 nm (black diamond). een presents the suitable doping level region for different thickness of charge layer. As the charge layer thickness increases, the suitable doping level range in the charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. b Relationship between suitable doping level and thickness of charge layer (APD-2). The thickness of charge layer is 50 nm (black square), 70 nm (black circle), 90 nm (black triangle), 110 nm (black down-pointing triangle), 130 nm (black diamond), and 150 nm (black pentagon). The figure description of b is similar to a . c Comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. Dashed line:calculated results. Closed symbols:simulated results (black square). c presents the comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. The calculated results and simulated results correspond well
The charge layer thicknesses of 210 and 50 nm (APD-1) were selected to show the simulation details and the influence of doping level on the electric field distribution. Figure 10a, c shows the current simulation results of different doping levels in thicknesses of 210 and 50 nm, respectively. Figure 10b, d shows the electric field distribution simulation results using the same structure. The simulation results show that thicknesses of 210 and 50 nm have doping level ranges of 1.0 × 10 17 –1.3 × 10 17 cm −3 and 3.9 × 10 17 –5.7 × 10 17 cm −3 , respectievelijk.

een Photocurrent and dark current with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in the charge layer is 1.3 × 10 17 cm −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 cm −3 . een Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the punch-through voltage, breakdown voltage, and current-voltage characteristic. b Avalanche field with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in charge layer is 1.3 × 10 17 cm −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 cm −3 . b Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influenced the electric field distribution. c Photocurrent and dark current with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 cm −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 cm −3 . c Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 50 nm has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the current-voltage characteristic. d Avalanche field with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 cm −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 cm −3 . d Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 50 nm only has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the electric field distribution
Clearly, the device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the current-voltage characteristic and electric field distribution. As a result, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. This conclusion is the same as the theoretical analysis. Concurrently, when designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability.
Finally, the relationship between charge layer and multiplication thickness was simulated. Figure 11a presents the avalanche field with multiplication region thicknesses of 100, 200, and 300 nm in the APD-2 structure (with a charge layer thickness of 70 nm). Figure 11b presents the charge layer doping range with different multiplication thicknesses at the suitable electric field distribution condition. The charge layer thicknesses are 50, 70, and 90 nm. Clearly, a high avalanche field exists in the thin multiplication layer. As the multiplication region thickness decreases, the electric field difference between multiplication and absorption layers increases. As a result, a thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field.

een Avalanche breakdown electric field with different multiplication thicknesses. Solid line:w m = 100 nm. Dashed line:w m = 200 nm. Dashed dot line:w m = 300 nm. een Presents the simulation results of electric field distribution with different w m . As the w m decreases, the avalanche field in the multiplication increase. b Relationship between multiplication thickness and charge layer. The thickness of multiplication is 300 nm (black square), 200 nm (black circle), 100 nm (black triangle). b Presents the relationship between multiplication thickness and charge layer. A thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field
Tunneling Effect on the Electric Field Distribution
The simulation in this part will study the tunneling effect on the electric field in the device. From the theoretical analysis, the tunneling effect has an influence on the avalanche field in multiplication. Thus, the simulation will design to study the influence of electric field in the absorption layer that exceeds the tunneling threshold value. First, group A, with the structure of APD-1, charge layer thickness of 90 nm, and different charge layer doping levels of 1.4 × 10 17 –2.4 × 10 17 cm −3 , was simulated for electric field distribution when the device avalanche breaks down. The result is shown in Fig. 12a. When the charge layer doping level exceeds 2.0 × 10 17 cm −3 , the field in the absorption layer becomes lower than the tunneling threshold field and the avalanche field in the multiplication layer reaches the same value. However, when the doping level is less than 2.0 × 10 17 cm −3 , the field in the absorption layer exceeds the tunneling threshold field and the avalanche field in the multiplication layer decreases with the decrease of the doping level in charge layer. Similar results were observed in the APD-2 structure (with a charge layer thickness of 90 nm and doping level of 2.2 × 10 17 –3.6*10 17 cm −3 ) (Fig. 12b). That is, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease.

een Avalanche breakdown electric field with different doping levels (APD-1). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. een Presents the simulation results of electric field distribution with different doping level while avalanche breakdown. When doping level of charge layer exceeds 2.0 × 10 17 cm −3 , the field in the absorption layer becomes lower than the tunneling threshold field, and the avalanche field in the multiplication layer reaches the same value with different doping level. However, when the doping level is less than 2.0 × 10 17 cm −3 , the field in the absorption layer exceeds the tunneling threshold field, and the avalanche field in the multiplication layer decreases with the decrease of the doping level. Thus, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease. Thus, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer when the device avalanche breaks down. b Avalanche breakdown electric field with different doping levels (APD-2). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. The figure description of b is similar to a . c Relationship between field and bias voltage in multiplication and absorption (APD-1). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). c Presents the relationship between the electric field and bias voltage in multiplication and absorption layers. When the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold. d Relationship between field and bias voltage in multiplication and absorption (APD-2). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). The figure legend of d is similar to a
Groups B (APD-1 thickness of 90 nm, doping level of 2.4 × 10 17 cm −3 in charge layer and APD-2 thickness of 90 nm, doping level of 3.6 × 10 17 cm −3 ) were designed to demonstrate the relationship between the threshold electric field in the absorption layer and avalanche field in the multiplication layer. The multiplication and absorption electric fields vary with the bias voltage on the device. As shown in Fig. 12c, d, when the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, when the absorption field exceeds the tunneling threshold, the avalanche breakdown electric field in the multiplication layer plummets. Furthermore, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold.
The phenomenon in Fig. 12 can be explained by the theoretical analysis that tunneling has an influence on the charge density in the “Methods” section. When the electric field reaches the tunneling threshold value in the absorption layer, the charge density ρ becomes unequal to the dopant ion. The multiplication field will decrease as the negative ion increases, and the absorption field will increase as the positive ion increases. Concurrently, the absorption field slope will increase due to the tunneling effect. As a result, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer and the low dark current when the device avalanche breaks down.
Conclusies
In summary, we have presented a theoretical study and numerical simulation analysis involving the InGaAs/InAlAs APD. The mathematical relationship between the device parameters and electric field distribution in the device was built. And the tunneling effect was taken into consideration in the theoretical analysis. Through analysis and simulation, the influence of structure parameters on the device and the detailed relationship of each layer were fully understood in the device. Three important conclusions can be obtained from this paper. First, the doping level and thickness of the charge layer for different multiplication thicknesses can be calculated by the theoretical model in the “Methods” section. Calculated charge layer values (doping and thickness) are in agreement with the experiment results. Second, as the charge layer thickness increases, the suitable doping level range in charge layer decreases. Compared to the thinner charge layer, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. When designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability. Finally, the G btt of tunneling effect was calculated, and the influence of tunneling effect on the avalanche field was analyzed. We confirm that the avalanche field and multiplication factor (M n ) in the multiplication will decrease by the tunneling effect.
Afkortingen
- 2D:
-
Tweedimensionaal
- APD:
-
Avalanche photodiode
- DCR:
-
Dark count rate
- SACM APDs:
-
Separate absorption, charge, and multiplication avalanche photodiodes
- SAGCMAPDs:
-
Separate absorption, grading, charge, and multiplication avalanche photodiodes
- SPAD:
-
Single-photon avalanche photodiode
- SPDE:
-
Single-photon detection efficiency
- SRH:
-
Shockley–Read–Hall
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Theoretisch onderzoek van biaxiaal trekvaste Germanium-nanodraden
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Een onderzoek naar een kristallijn-silicium zonnecel met zwarte siliciumlaag aan de achterkant
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Een theoretische simulatie van de stralingsreacties van Si, Ge en Si/Ge-superrooster op laag-energetische bestraling
- Zelfgezaaide MOCVD-groei en dramatisch verbeterde fotoluminescentie van InGaAs/InP Core-Shell-nanodraden
- Vormingsmechanismen van InGaAs-nanodraden geproduceerd door een vaste-bron tweestaps chemische dampafzetting



