Ontwerp van door spanning ontworpen GeSn/GeSiSn Quantum Dots voor Mid-IR Direct Bandgap Emission op Si-substraat
Abstract
Strain-engineered zelf-geassembleerde GeSn/GeSiSn-kwantumdots in Ge-matrix zijn numeriek onderzocht met als doel hun potentieel voor directe bandgap-emissie in het midden van het IR-bereik te bestuderen. Het gebruik van GeSiSn-legering als omringende media voor GeSn-kwantumdots (QD) maakt het mogelijk om de spanning rond de QD aan te passen door de variatie van Si- en/of Sn-samenstelling. Dienovereenkomstig is de roostermismatch tussen de GeSn-kwantumdots en de GeSiSn-omgevende laag afgestemd tussen -2, 3 en -4, 5% door de variatie van de Sn-barrièresamenstelling voor verschillende koepelvormige QD-groottes. De verkregen resultaten laten zien dat de emissiegolflengte, die voldoet aan de specifieke QD-directheidscriteria, achtereenvolgens kan worden afgestemd over een breed midden-IR-bereik van 3 tot 7 μm, wat nieuwe perspectieven opent voor groep IV-laserbronnen die volledig zijn geïntegreerd in Si-fotonische systemen voor detectietoepassingen.
Achtergrond
Onlangs heeft de demonstratie van directe bandgap-groep IV-materialen door de legering van Ge [1, 2] en SiGe [3, 4] met Tin geleid tot intense onderzoeksactiviteiten vanwege de echte en praktisch uitvoerbare mogelijkheden voor fotonica en elektronica die efficiënt is op de chip integratie. Het is inderdaad aangetoond dat GeSn-legering een directe bandgap vertoont voorbij een bepaalde samenstelling door de snellere afname van Γ in vergelijking met L-vallei [5,6,7,8]. Hoewel de gerapporteerde resultaten zeer bemoedigend zijn, zijn de materiaaleigenschappen en toepassingsmogelijkheden nog niet volledig onderzocht. Het belangrijkste werkelijk beschikbare pad om de werkingsgolflengte van op GeSn gebaseerde halfgeleiderlasers te vergroten, naar het transparantievenster van de atmosfeer dat overlapt met absorberende lijnen van verschillende gassen [9], omvat inderdaad de toename van het Sn-gehalte in de GeSn-lagen [10, 11] ]. Vanwege de grote roostermismatch tussen Ge en Sn (14%), lijkt het behoud van de kristallografische kwaliteit van het materiaal echter de belangrijkste uitdaging die dit doel verbiedt [12, 13]. Een potentieel interessante oplossing om de emissiegolflengte te vergroten en te zorgen voor betere opsluiting van dragers, wordt doorgegeven aan lagere dimensionale structuren zoals nanodraden [14,15,16], nanostaafjes [17] en kwantumdots [18]. Binnen de specifieke directheidscriteria is de directe bandgap-interbandemissiegolflengte theoretisch beperkt tot 4,3 μm [19]. Om deze beperkingen te overwinnen, is het noodzakelijk om een extra vrijheidsgraad te introduceren in de conceptie van op groep IV gebaseerde kwantumstructuren. Dit kan worden gegarandeerd door ternaire GeSiSn-laag [20,21,22] te gebruiken, als een omringend materiaal voor GeSn-kwantumdots (QD), wat de mogelijkheid biedt tot spanningsengineering door geschikte Si- en Sn-composities op te nemen. Dienovereenkomstig wordt verwacht dat het gebruik van de GeSiSn-stamtechnieklaag rond GeSn QD een groter bereik van toegankelijke directe bandgap-emissiegolflengten zal bieden.
In deze context rapporteren we over theoretische studie van het effect van spanningstechniek door de Sn-samenstelling in de GeSiSn-laag rond de GeSn QD te variëren op de directe bandgap-interbandemissiegolflengte.
Methoden
Aangezien de bandoffsets tussen binaire en ternaire Sn-bevattende groep-IV-legeringen en Ge niet experimenteel bekend zijn, wordt de relatieve banduitlijning tussen de verschillende groep-IV-halfgeleiders die bij dit werk betrokken zijn, geëvalueerd met betrekking tot de valentiebandrand van Ge, met behulp van Jaros' vereenvoudigde theorie van bandoffsets [23] zoals gedetailleerd door D'Costa et al. [24]. De spanningseffecten die voortkomen uit de roostermismatch tussen Ge-substraat en GeSiSn-laag en tussen de GeSn QD en het omringende GeSiSn-materiaal zijn geëvalueerd voor de geleidings- en valentiebandranden.
Inderdaad, de rand van de geleidingsband is verschoven met \( \delta {E}_c^i \) en die van de valentieband met δE v zoals weergegeven in vgl. (1) en (2):
$$ \delta {E}_c^i={a}_c^i\left({\varepsilon}_{xx}+{\varepsilon}_{yy}+{\varepsilon}_{zz}\right) $ $ (1) $$ \delta {E}_v={a}_v\left({\varepsilon}_{xx}+{\varepsilon}_{yy}+{\varepsilon}_{zz}\right)+ b\left({\varepsilon}_{xx}-{\varepsilon}_{zz}\right) $$ (2)waar ik geeft L of Γ vallei aan, a c en een v zijn respectievelijk het geleidings- en valentiebandvervormingspotentieel, en b is het afschuifvervormingspotentieel. \( {\varepsilon}_{xx}={\varepsilon}_{yy}=\varepsilon =\left(\frac{a_s-{a}_{\mathrm{l}}}{a_{\mathrm{l }}}\right) \) is de in-plan stam en \( {\varepsilon}_{zz}=-2\frac{C_{12}}{C_{11}}{\varepsilon}_{xx} \) is de rek in de groeirichting. een s en een l zijn respectievelijk de roosterparameter van het substraat en de gespannen laag. C 11 en C 12 zijn de stijfheidsconstanten.
De materiaalparameters van binaire en ternaire legeringen zijn afgeleid van die van Ge, Si en Sn door lineaire interpolatie. Deze parameters zijn overgenomen uit referentie [11].
De samenstellingsafhankelijke gespannen bandgaps kunnen worden geëvalueerd door de overeenkomstige door spanning gegenereerde energieverschuivingen toe te voegen aan de bandgap van het niet-gespannen materiaal gegeven in Vgl. (3) voor GeSn en Vgl. (4) voor GeSiSn:
$$ {E}_g^i\left({\mathrm{Ge}}_{1-{X}_d}{\mathrm{Sn}}_{X_d}\right)=\left(1-{X} _d\right){E}_g^i\left(\mathrm{Ge}\right)+{X}_d{E}_g^i\left(\mathrm{Sn}\right)-{b}^i{ X}_d\left(1-{X}_d\right) $$ (3) $$ {\displaystyle \begin{array}{l}{E}_g^i\left({\mathrm{Ge}}_ {1-{x}_b-y}{\mathrm{Si}}_y{\mathrm{Sn}}_{x_b}\right)=\left(1-{x}_b-y\right){E} _g^i\left(\mathrm{Ge}\right)+{x}_b{E}_g^i\left(\mathrm{Sn}\right)+{yE}_g^i\left(\mathrm{Si }\right)-{b}_{\mathrm{Ge}\mathrm{Sn}}^i{x}_b\Big(1-{x}_b-\\ {}y\Big)-{b}_ {\mathrm{Si}\mathrm{Sn}}^iy\left(1-{x}_b-y\right)-{b}_{\mathrm{Ge}\mathrm{Si}}^i{x} _by\end{array}} $$ (4)waar b is de corresponderende buigingsparameter van de bandgap van de binaire legeringen samengevat in tabel 1.
Om de begrensde toestanden van de dragers te bepalen en interband-overgangsenergieën af te leiden, is de enkelbandige effectieve massa-Schrödingervergelijking opgelost in Cartesiaanse coördinaten door de eindige-elementenmethode geleverd door COMSOL Multiphysics-software [25]:
$$ -\frac{{\mathrm{\hslash}}^2}{2}\nabla \left(\frac{1}{m^{\ast}\left(\overrightarrow{r}\right)}\ mathrm{\nabla \uppsi}\left(\overrightarrow{r}\right)\right)+V\left(\overrightarrow{r}\right)\uppsi \left(\overrightarrow{r}\right)=E\ uppsi \left(\overrightarrow{r}\right) $$ (5)E vertegenwoordigt de energie van de drager, en ψ is de corresponderende golffunctie. m* is de effectieve massa van de vervoerder, ћ is de gereduceerde constante van Planck, \( \overrightarrow{r} \) is de driedimensionale coördinaatvector, en V is het opsluitingspotentieel van de vervoerder (discontinuïteit van de band). Om de berekeningsprocedure van de QD-elektronische structuur te vereenvoudigen, hebben we de constante spanningsbenadering [26, 27] aangenomen in plaats van de rekenkundig dure atomaire simulatiebenadering die duidelijk meer precisie zou kunnen geven in het spanningsverdelingsprofiel [28, 29]. We beschouwen de dragers die het potentieel in de samendrukkend gespannen QD beperken inderdaad als voldoende diep om de impact van de niet-uniformiteit van de spanning op de elektronenbegrensde toestanden te minimaliseren [27]. Bovendien worden de randen van de geleidingsband, de belangrijkste parameters in dit werk, die het mogelijk maken om de directheid van de bandgap te bestuderen, alleen verschoven doordat de hydrostatische spanning minder gevoelig is voor de niet-uniformiteit van de spanning, vooral wanneer een relatief lage roostermismatch wordt overwogen [30].
Resultaten en discussie
Aangezien we ons vooral zorgen maken over de impact van de stam rond de GeSn QD, is de Sn-samenstelling van de QD vastgesteld op 28% en de Si-samenstelling van de GeSiSn op 35%; het onderzoek is daarom gericht op de impact van de samenstelling van de Sn-barrière (x b ) variatie tussen 6 en 22%. De resulterende in-plan rek in de GeSiSn-laag of in de GeSn QD wordt gegeven in figuur 1a.
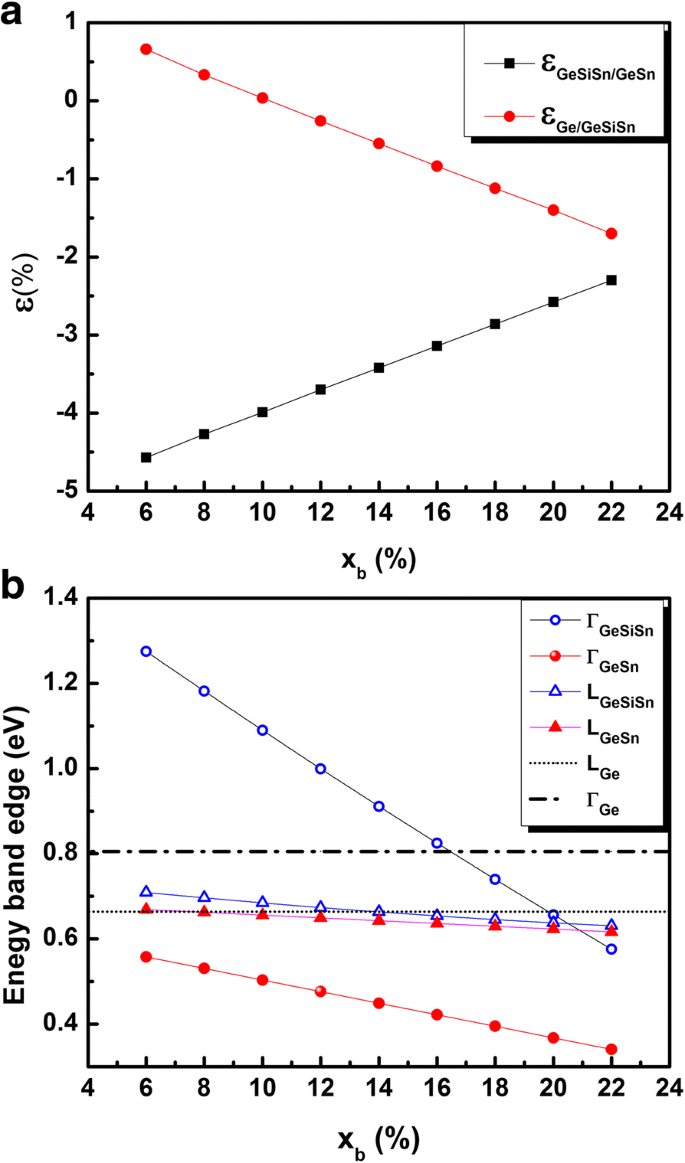
een Rooster komt niet overeen tussen Ge0.65-xb Si0.35 Sn xb en Ge (gevulde cirkels) en tussen Ge0,72 Sn0,28 en Ge0.65-xb Si0.35 Sn xb (gevulde vierkanten) als functie van x b . b Bandranden bij L- en G-dalen voor Ge0.65-xb Si0.35 Sn xb , Ge0,72 Sn0,28 , en Ge als functie van x b
De in-plan rek in de tweedimensionale laag van GeSiSn-materiaal varieert tussen 0,6% (x b = 6%) en − 1,7% (x b = 22%). We veronderstellen dat deze laag pseudomeorfisch gespannen blijft, waardoor de ontworpen structuur experimenteel realiseerbaar blijft. De GeSn is gekozen om samendrukkend te worden gespannen in het omringende GeSiSn-materiaal met een roostermismatch variërend van -2,3 tot -4,5%, waardoor gunstige omstandigheden worden gegarandeerd voor de vorming van zelfgeorganiseerde GeSn QD.
Figuur 1b toont de afhankelijkheid van de gespannen bandgap op L- en Γ-punten van Ge0,72 Sn0,28 en Ge(0.65-xb ) Si0.35 Sn xb als een functie van x b . De Γ vallei van Ge0,72 Sn0,28 materiaal blijft onder de L-dalen, wat getuigt van type I voor het hele onderzochte bereik van tinbarrièresamenstellingen. Ondertussen, wanneer rekening wordt gehouden met de elektronenopsluiting, neemt de effectieve bandgap toe en wordt het QD-grootte-effect beslissend [18], vooral voor zeer gespannen QD. In de aanwezigheid van kwantumopsluiting moet inderdaad de grondtoestandsenergie worden beschouwd in plaats van het minimum van de Γ-band. Dienovereenkomstig wordt verwacht dat kleinere QD's hogere beperkte energieniveaus hebben in de Γ-vallei die de L-vallei kunnen overschrijden (en/of grondtoestandelektronenenergieniveau in de L-vallei). Het is dus belangrijk om het bereik van de QD-maat te onderzoeken en daarbij te voldoen aan de specifieke directheidscriteria.
De gemodelleerde structuur wordt schematisch weergegeven in Fig. 2. De Ge0.72 Sn0,28 QD wordt beschouwd als een koepelvorm met een cirkelvormige basis met een diameter van D variërend van 15 tot 40 nm en een vaste hoogte-diameterverhouding gelijk aan 0,25. De QD is gepositioneerd in een 15 nm dikke GeSiSn-laag met een Si-samenstelling van 35% en een afstembare Sn-samenstelling. Deze structuur wordt verondersteld te worden gevormd op Ge-gebufferd substraat en afgedekt met een Ge-laag.
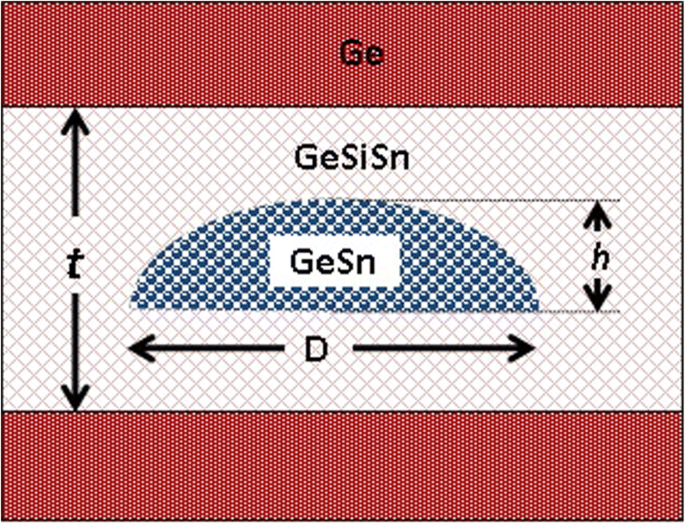
Schematische weergave van de gemodelleerde GeSn QD van hoogte (h ) en diameter (D ) binnen de GeSiSn-rekverminderende laag in Ge-matrix
Om een consistent QD-ontwerp te garanderen voor een betere werking van het lichtuitstralende apparaat, is een geschikte directheidsparameter geïntroduceerd die rekening houdt met de energieafstand tussen de laagste QD-begrensde energieniveaupositie in L- en G-valleien [18]. Deze parameter wordt aangeduid met GSL -GSΓ en moet hoger zijn dan de thermische energie bij kamertemperatuur om verlies van dragers door thermische activering te voorkomen, waarbij GSL (GSΓ ) vertegenwoordigt het energieniveau van de grondtoestand van het elektron in de L-vallei (Γ-vallei) met betrekking tot het maximum van de valentieband. De evaluatie van GSL -GSΓ wordt schematisch geïllustreerd in de inzet van Fig. 3.
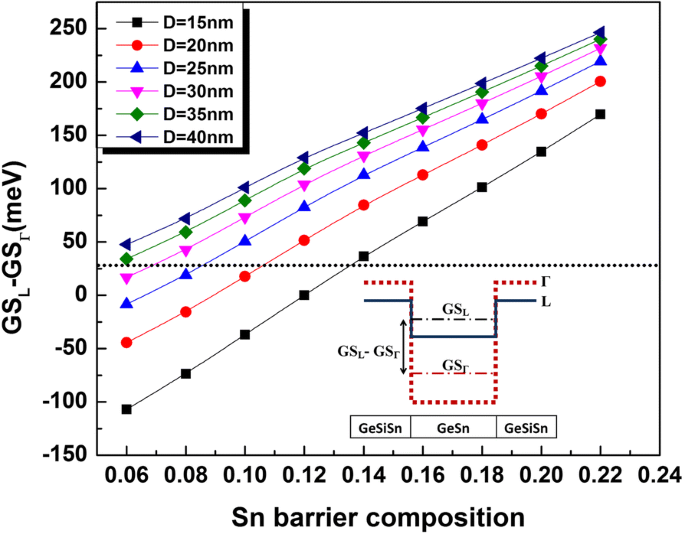
Directheidsparameter (GSL -GSΓ ) variatie als functie van de Ge0,72 Sn0,28 QD-grootte en Sn-samenstelling van de Ge0.65-x Si0.35 Sn x omringende laag. De stippellijn geeft de thermische energie bij kamertemperatuur aan. De inzet vertegenwoordigt een schematische definitie van de directheidsparameter
De berekening van de GeSn QD-elektronenenergieniveaus in Γ- en L-dalen voor verschillende diameters als een functie van de Sn-samenstelling in GeSiSn maakt het mogelijk om de corresponderende directheidsparameter (GSL -GSΓ ). De resultaten zijn uitgezet in Fig. 3. Voor een gegeven x b , de waarde van GSL -GSΓ wordt voornamelijk bepaald door de QD-grootte. Dienovereenkomstig vereisen de kleinere stippen met duidelijk hogere begrensde energietoestanden een lagere bandgap-energie door spanningsvermindering om aan de directheidscriteria te voldoen. Zoals weergegeven in Fig. 3, grotere stippen (D> 25 nm) voldoen aan GSL -GSΓ> 26 meV voor x b hoger dan 8%. Efficiënte directe bandgap van kleine QD blijkt echter te zijn verzekerd voor hogere waarden van x b (x b ≥ 14% voor D = 15 nm).
Binnen de aangenomen parameters in dit werk, en vooral de buigingsparameters van de binaire materialen, vermindert de toename van het Sn-gehalte van het GeSiSn-materiaal de vlek rond de QD en vermindert ook de bandgap van het omringende materiaal. Inderdaad, zoals weergegeven in figuur 1b, is de toename van x b van 6 tot 22% vermindert de discontinuïteit van de geleidingsband bij Γ vallei van 0,72 eV tot 0,23 eV. Inderdaad, zoals getoond in Fig. 4, waar de vierkante golffunctie \( {\left|\uppsi \left(\overrightarrow{r}\right)\right|}^2 \) van het grondtoestandselektron in kwantumdots van diameter 35 nm wordt weergegeven in het xy-plan voor Sn-barrièresamenstelling van 6% en 22%, de elektronen blijken volledig binnen de QD te zijn gelokaliseerd, ongeacht de barrièresamenstelling (discontinuïteit van de geleidingsband). De sterk opgesloten elektronen duiden op een hogere betrouwbaarheid van de onderzochte QD als actief medium voor lichtemitters op Si-substraat.

Kwadraat-elektron grondtoestandgolffunctie voor Ge0,72 . met een diameter van 35 nm Sn0,28 QD voor a Xb = 6% en b Xb = 22%
Door de QD-grootten te beperken voor een gegeven x b voor degenen die efficiënte directe bandgap-emissie veroorzaken, hebben we de QD-grondtoestand interbandemissiegolflengte beoordeeld. De resultaten worden getoond in Fig. 5, waar de emissiegolflengte is uitgezet tegen x b voor verschillende QD-formaten. Het is vermeldenswaard dat de grootste QD-grootte die in dit werk wordt overwogen (D = 40 nm) heeft een kleine energiescheiding aangetoond tussen de grondtoestand van het elektron en de eerste aangeslagen toestand (lager dan 26 meV) en is daarom in deze studie buiten beschouwing gelaten. Desalniettemin is de geëvalueerde emissiegolflengte als functie van x b is in Fig. 5 met een stippellijn bewaard gebleven.
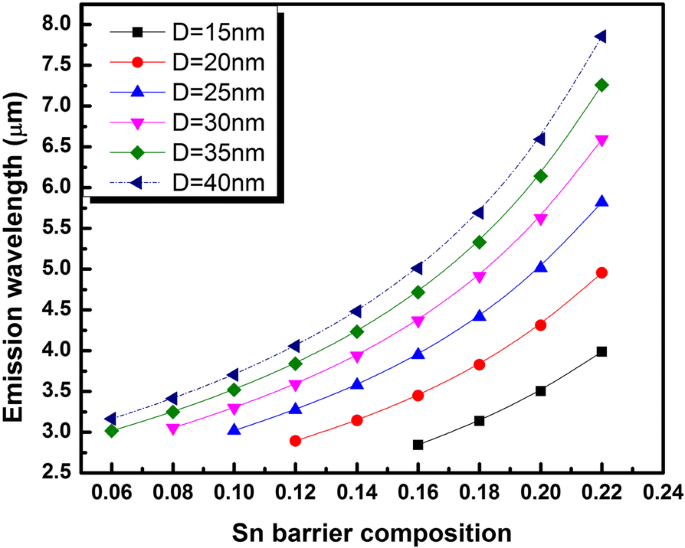
Emissiegolflengte in grondtoestand bij kamertemperatuur van directe bandgap Ge0,72 Sn0,28 QD als functie van grootte en Sn-samenstelling van de Ge0.65-xb Si0.35 Sn xb omringende laag
Het golflengtebereik dat naar verwachting door het voorgestelde QD-ontwerp wordt gedekt, varieert van 3 tot 7 m. Het opbrengstbereik is uitermate belangrijk voor gasdetectietoepassingen. De experimentele implementatie van deze structuur zou de mogelijkheid kunnen bieden om voor het eerst het hele mid-IR-bereik te bestrijken met een volledig compatibel materiaal met bestaande micro-elektronische technologie, wat de weg vrijmaakt voor nieuwe perspectieven in CMOS-compatibele QD-gebaseerde mid-IR-opto-elektronica.
Conclusies
GeSn QD in de GeSiSn-stamtechnieklaag op de Ge-matrix is onderzocht als een functie van de QD-grootte en de roostermismatch met omringend materiaal. Het verminderen van de spanning rond de GeSn QD door de Sn-samenstelling van GeSiSn-barrièremateriaal te variëren, blijkt de directe bandgap type I-emissiegolflengte van 3 tot 7 m te verbeteren. De ontworpen structuur opent nieuwe perspectieven in mid-IR lichtzender die volledig compatibel is met Si-technologie.
Afkortingen
- CMOS:
-
Complementaire metaaloxide-halfgeleider
- GSL :
-
Elektronenniveau grondtoestand in L-vallei
- GSΓ :
-
Grondtoestand elektronenniveau in Γ vallei
- QD:
-
Kwantumstippen
Nanomaterialen
- N,N-dimethylformamide die de fluorescentie van MXene Quantum Dots reguleert voor de gevoelige bepaling van Fe3+
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Synthese van door reabsorptie onderdrukte Type-II/Type-I ZnSe/CdS/ZnS Core/Shell Quantum Dots en hun toepassing voor immunosorbentassay
- Synthese van pyridinic-rijke N, S Co-gedoteerde Carbon Quantum Dots als effectieve enzymnabootsers
- Bismut Quantum Dots in gegloeide GaAsBi/AlAs Quantum Wells
- Bipolaire effecten in fotovoltage van metamorfe InAs/InGaAs/GaAs Quantum Dot heterostructuren:karakterisering en ontwerpoplossingen voor lichtgevoelige apparaten
- Groene synthese van InP/ZnS Core/Shell Quantum Dots voor toepassing in licht-emitterende diodes zonder zware metalen
- Een eenvoudige aanpak voor het synthetiseren van fluorescerende koolstofkwantumstippen uit tofu-afvalwater
- Synthese van in water oplosbare antimoonsulfide Quantum Dots en hun foto-elektrische eigenschappen
- Ontwerp voor het vervaardigen van PCB's
- Ontwerptips voor Direct Metal Laser Sintering 3D Printing



