Spanning-polariteitsafhankelijk programmeergedrag van amorf In–Ga–Zn–O dunnefilmtransistorgeheugen met een atomaire laag-afgezette ZnO-ladingvangst Laag
Abstract
Amorfe In-Ga-Zn-O (a-IGZO) dunne-filmtransistor (TFT) -geheugens trekken veel belangstelling voor toekomstige systeem-op-paneel-toepassingen; ze vertonen echter gewoonlijk een slechte wisefficiëntie. In dit artikel onderzoeken we het spanningspolariteitsafhankelijke programmeergedrag van een a-IGZO TFT-geheugen met een atomaire laag-afgezette ZnO-ladingsvanglaag (CTL). De ongerepte apparaten vertonen elektrisch programmeerbare kenmerken, niet alleen onder positieve poortvoorspanningen, maar ook onder negatieve poortvoorspanningen. Met name de laatste kan een veel hogere programmeerefficiëntie genereren dan de eerste. Bij het toepassen van een gate-biaspuls van +13 V/1 μs, vertoont het apparaat een drempelspanningsverschuiving (ΔVth ) van 2 V; en de ΔVde is zo groot als -6,5 V voor een gate-biaspuls van -13 V/1 μs. In het geval van 12 V/1 ms programmering (P) en −12 V/10 μs wissen (E), kan een geheugenvenster van wel 7,2 V worden bereikt bij 10 3 van P/E-cycli. Door de ZnO CTL's te vergelijken die zijn gegloeid in O2 of N2 met de zoals gedeponeerde, wordt geconcludeerd dat de zuurstofvacature (VO )-gerelateerde defecten domineren de bipolaire programmeerkenmerken van de TFT-geheugenapparaten. Voor programmering op positieve poortspanning worden elektronen geïnjecteerd vanuit het IGZO-kanaal in de ZnO-laag en bij voorkeur gevangen op diepe niveaus van enkelvoudig geïoniseerde zuurstofleegstand (VO + ) en dubbel geïoniseerde zuurstofvacature (VO 2+ ). Wat betreft het programmeren bij negatieve poortspanning, worden elektronen gemakkelijk ontdaan van neutrale zuurstofvacatures vanwege ondiepe donoren en tunnelen terug naar het kanaal. Dit leidt dus tot zeer efficiënt wissen door de vorming van extra geïoniseerde zuurstofvacatures met positieve ladingen.
Achtergrond
Een dunnefilmtransistor (TFT) op basis van amorf indium-gallium-zink-oxide (a-IGZO) is uitgebreid bestudeerd voor toepassing op flexibele en transparante elektronische systemen [1,2,3,4,5,6,7 ,8,9,10,11,12]. Dit wordt toegeschreven aan enkele specifieke eigenschappen van a-IGZO-films zoals goede uniformiteit, lage verwerkingstemperatuur, transparantie van zichtbaar licht en hoge elektronenmobiliteit [13]. Afgezien daarvan zijn ook a-IGZO TFT niet-vluchtige geheugens voorgesteld, en de niet-vluchtige gegevensopslagcapaciteit breidt de reikwijdte van het a-IGZO TFT-apparaatgebruik uit. Als een typische architectuur van niet-vluchtige geheugenapparaten, is de afgelopen jaren intensief onderzoek gedaan naar een floating-gated a-IGZO TFT-geheugen. Tot nu toe zijn verschillende materialen onderzocht als een zwevende poort (dwz ladingsopslagmedium), zoals diëlektrica [14, 15], metalen nanokristallen [16, 17] en halfgeleidende materialen [18,19,20,21] . Aangezien a-IGZO een natuurlijke n-type halfgeleider is, en gatinversie nauwelijks wordt gerealiseerd in een a-IGZO TFT onder een negatieve gate-bias, hebben de a-IGZO TFT-geheugens gewoonlijk een slechte wisefficiëntie. Met andere woorden, de meeste a-IGZO TFT-geheugens kunnen niet elektrisch worden gewist via gatinjectie uit het kanaal [14,15,16]. Niettemin, Zhang et al. [21] fabriceerde een TFT-geheugen met behulp van a-IGZO als zowel de ladingsvanglaag (CTL) als de kanaallaag, die elektrisch programmeerbare en wisbare kenmerken vertoonde, evenals een goede gegevensretentie. Ondertussen hebben Yun et al. onderzocht ook de kenmerken van de a-IGZO TFT-geheugens met verschillende IGZO CTL-composities, waarbij een afnemend geheugenvenster werd onthuld met toenemende O2 partiële druk (PO2 ) tijdens sputterdepositie van de CTL [18]. Bovendien, Bak et al. rapporteerde de prestaties van de a-IGZO TFT-geheugens met verschillende geleidende ZnO CTL's en concludeerde dat de geoptimaliseerde elektronische aard van de bandgap-structuur voor de ZnO CTL een van de belangrijkste factoren zou kunnen zijn om zeer functionele oxide-TFT-geheugens te realiseren [20]. Hoewel de bovengenoemde op oxidehalfgeleider CTL gebaseerde a-IGZO TFT-geheugens superieure elektrische programmeer-/wissnelheden vertonen, zijn de bipolaire programmeerkenmerken van de bovengenoemde apparaten niet gerapporteerd, en de corresponderende opnameprocessen van verschillende ladingen in de CTL van oxidehalfgeleider zijn dat niet. duidelijk, vooral voor het vangen van positieve ladingen.
In dit werk werd een bipolair programmeerbaar a-IGZO TFT-geheugen gefabriceerd met behulp van een atomaire laag-afgezette ZnO-film als een CTL. Door de bipolaire programmeerkenmerken van de TFT-geheugenapparaten te vergelijken met de gedeponeerde, O2 - of N2 -gegloeide ZnO-CTL's, werden de invangprocessen van verschillende ladingen in de ZnO-laag besproken. Het is gebleken dat defecten die verband houden met zuurstoftekort de bipolaire programmeerkenmerken van de a-IGZO TFT-geheugenapparaten domineren.
Methoden
P-type Si (100) wafels met een soortelijke weerstand van 0,001-0,005 Ω cm werden gereinigd met behulp van het standaard RCA-reinigingsproces en gebruikt als de achterpoort van het apparaat. Dan, 35-nm Al2 O3 en 20-nm ZnO-films werden achtereenvolgens afgezet door atomaire laagafzetting (ALD) bij 250 ° C en 200 ° C, die respectievelijk dienden als de blokkeerlaag en CTL van het TFT-geheugen. Het is vermeldenswaard dat de ZnO-film een root-mean-square (RMS) ruwheid van 0,553 nm heeft. Vervolgens werden fotolithografie en nat etsen uitgevoerd om de CTL van ZnO te definiëren. Daarna een 8-nm Al2 O3 tunnellaag werd gekweekt door ALD. De voorlopers van diethylzink (DEZ)/H2 O en TMA/H2 O werden gebruikt voor de groei van ZnO en Al2 O3 films resp. Daarna werd een 40-nm a-IGZO-film afgezet door radiofrequentie-magnetronsputtering als een kanaallaag bij kamertemperatuur met behulp van een InGaZnO4 doel. Het actieve kanaal met een breedte (W) / lengte (L) van 100/10 m werd vervolgens gedefinieerd door fotolithografie en verdund HCl-etsen. Bron- en afvoercontacten van Ti/Au (30 nm/70 nm) werden gevormd door e-beam-verdamping gevolgd door een lift-off-proces. Ten slotte werden alle gefabriceerde apparaten gegloeid bij 250 ° C in O2 gedurende 5 minuten om de prestaties te verbeteren. De elektrische karakteriseringen werden uitgevoerd met behulp van een halfgeleiderparameteranalysator (Agilent B1500A) bij kamertemperatuur. De drempelspanning (Vde ) wordt gedefinieerd als de poortspanning waarbij de afvoerstroom gelijk is aan W/L×10 −9 A. De dragerconcentratie van ZnO-films werd geëxtraheerd uit Hall-effectmetingen (Ecopia HMS-3000) bij kamertemperatuur.
Resultaten en discussie
Figuur 1 toont de schematische diagrammen van het gefabriceerde a-IGZO TFT-geheugenapparaat onder respectievelijk positieve en negatieve bias-programmering. Tijdens elektrische programmering wordt een elektrische puls toegepast op de achterpoort en worden de source- en drain-elektroden geaard. Figuur 2 toont de programmeerkenmerken van de oorspronkelijke geheugenapparaten onder verschillende omstandigheden. Voor het ongerepte geheugenapparaat vertoont het een aan / uit-stroomverhouding (I aan /Ik uit ) van 1,5 × 10 7 , veldeffectmobiliteit van 7,1 cm 2 V −1 s −1 , en een schommeling onder de drempel (SS) van 0,67 V/dec. In termen van 80 ms-programmering bij verschillende positieve vooroordelen, is de I d –V g curve beweegt geleidelijk in de richting van een positieve bias als functie van de programmeerspanning, bijvoorbeeld de resulterende Vth verschuiving ten opzichte van het oorspronkelijke apparaat (ΔVth ) neemt toe van 1,3 tot 4,8 V met toenemende programmeerspanning van 8 tot 13 V, met programmeerverzadiging bij 12 V, zoals weergegeven in Fig. 2a. Zo'n significante ΔVde suggereert dat aanzienlijke elektronen van het n-type a-IGZO-kanaal in de ZnO-CTL worden geïnjecteerd. Bovendien, wanneer de programmeerspanning is vastgesteld op 13 V, zal de ΔVde neemt langzaam toe van 2 naar 3,1 V met een verlenging van de programmeertijd van 1 μs tot 30 ms, zoals weergegeven in Fig. 2c. Interessant is dat wanneer het ongerepte geheugenapparaat is geprogrammeerd met een negatieve gate-bias, de Vde vertoont een opmerkelijke verschuiving naar een negatieve bias, getoond in figuur 2b. Voor een constante programmeertijd van 80 ms, de ΔVth vergroot van −5,2 tot −7.4 V met toenemende programmeerbias van −8 tot −13 V. Zelfs als het ongerepte geheugenapparaat is geprogrammeerd op -13 V gedurende 1 μs, kan het ook een ΔVde vertonen zo groot als -6,5 V, getoond in Fig. 2d. Dit betekent dat een zeer groot aantal elektronen van de CTL wordt ontdaan, wat resulteert in een overblijvend groot aantal positieve ladingen.
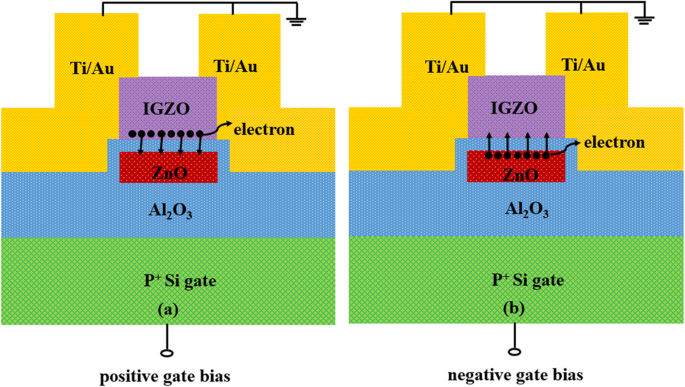
De schematische dwarsdoorsnedediagrammen van het a-IGZO TFT-geheugenapparaat geprogrammeerd onder een positieve gate-bias (a ) en een negatieve gate-bias (b ), respectievelijk.
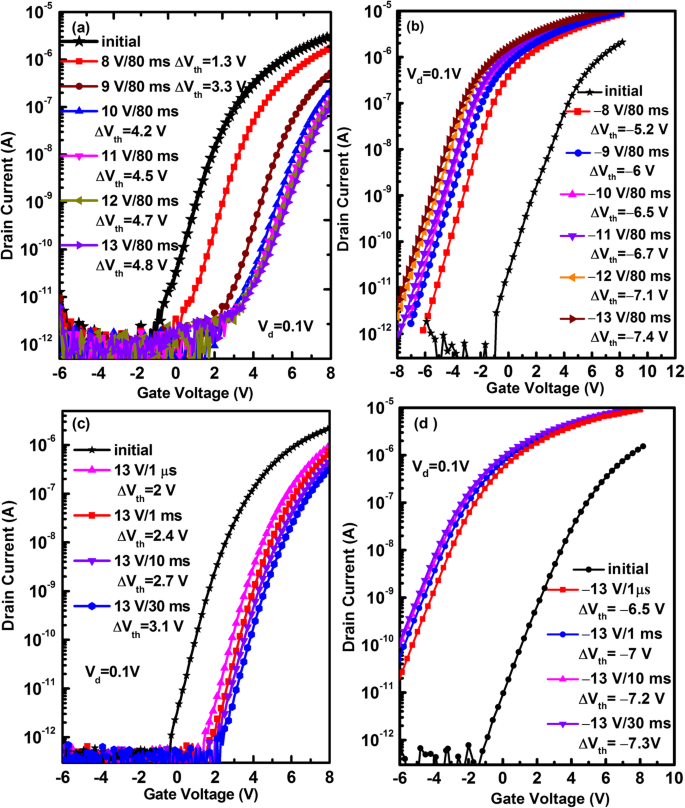
De overdrachtscurves van het a-IGZO TFT-geheugenapparaat en die geprogrammeerd a bij verschillende positieve poortvoorspanningen gedurende een constante tijd van 80 ms, b bij verschillende negatieve poortvoorspanningen gedurende een constante tijd van 80 ms, c bij 13 V voor verschillende programmeertijden, en d bij −13 V voor verschillende programmeertijden. Alle overdrachtscurven voor elk cijfer werden op hetzelfde apparaat gemeten en alle programmeerbewerkingen werden in volgorde uitgevoerd.
Om het ladingvangeffect van de ZnO-laag te begrijpen, worden ter vergelijking ook a-IGZO TFT's zonder ZnO CTL gefabriceerd als controleapparaten. Figuur 3 toont de overdrachtskarakteristieken van de regelapparaten wanneer ze respectievelijk onder verschillende positieve en negatieve vooroordelen worden geprogrammeerd. Het is gebleken dat het apparaat geen waarneembare ΔVde . vertoont ongeacht de polariteit en amplitude van de programmeerspanning. Dit geeft aan dat de eerder genoemde duidelijke ΔVde voor de geheugenapparaten moet worden toegeschreven aan de ZnO CTL. Aan de andere kant wordt opgemerkt dat IGZO een natuurlijke n-type halfgeleider is, dus elektronen in het IGZO-kanaal kunnen gemakkelijk in de ZnO CTL worden geïnjecteerd onder een positieve gate-bias (bijv.. , +9V). Wanneer echter een negatieve programmeerbias wordt toegepast op de poortelektrode van het apparaat, heeft het a-IGZO-kanaal de neiging leeg te raken en wordt de gatengeleiding nauwelijks bereikt [15]. In dit geval kan het apparaat niet worden geprogrammeerd via gateninjectie vanuit het kanaal, en dus moet de unieke mogelijkheid van elektrische programmering worden gerealiseerd door intrinsieke elektronen in de ongerepte ZnO-CTL te ontdoen. In feite geven onze experimentele resultaten aan dat het apparaat gemakkelijk kan worden geprogrammeerd onder negatieve poortvooroordelen, zie figuur 2d. Figuur 4 toont de duurzaamheidskenmerken van het geheugen als functie van programmeer-/wiscycli (P/E). Het apparaat heeft een geheugenvenster van 3,7 V voor 10 3 van P/E-cycli in het geval van programmering van 11 V/1 ms en wissen van −9 V/10 μs. Verder kan een geheugenvenster van wel 7,2 V worden bereikt bij 10 3 van P/E-cycli met betrekking tot 12 V/1 ms programmering en −12 V/10 μs wissen. Tabel 1 vergelijkt de programmeer- en wiskarakteristieken van verschillende a-IGZO TFT-geheugens [14, 22, 23]. In vergelijking met andere apparaten vertoont ons apparaat een veel hogere wisefficiëntie, zelfs bij een lagere voorspanning (−12 V) en een veel kortere tijd (10 μs), ondanks de niet noemenswaardige superioriteit in programmeerefficiëntie.
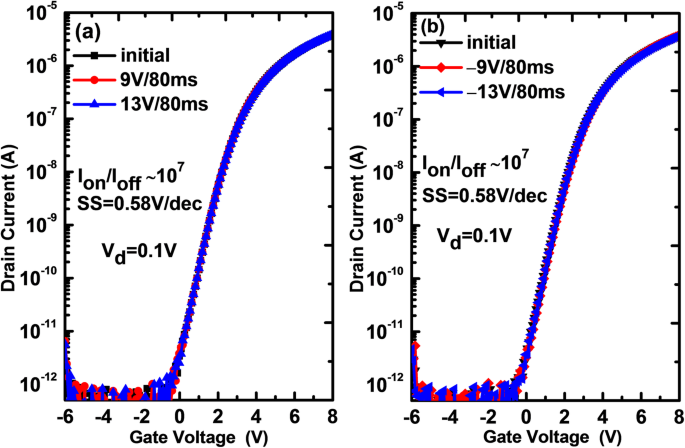
De overdrachtscurves van het a-IGZO TFT-apparaat en die geprogrammeerd a bij verschillende positieve poortvoorspanningen voor een constante tijd van 80 ms en b bij verschillende negatieve poortvoorspanningen voor een constante tijd van 80 ms
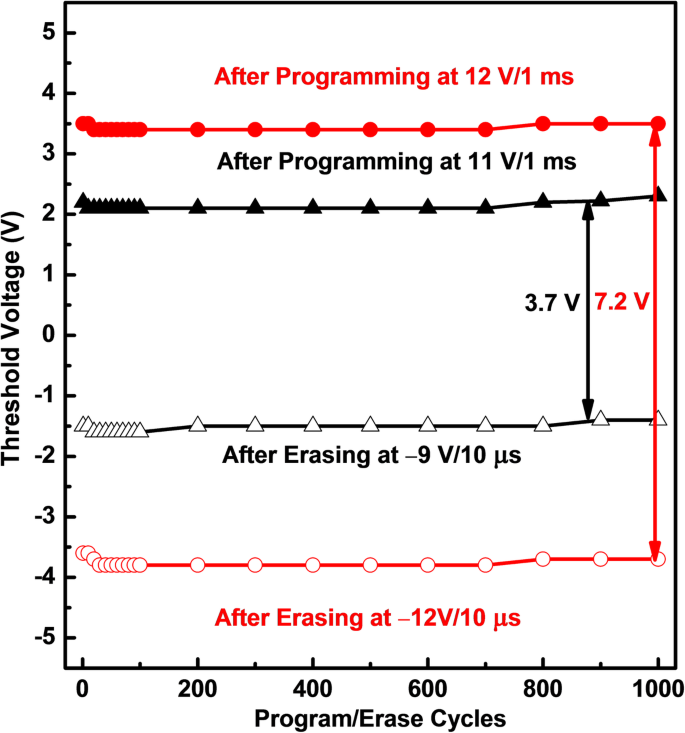
De duurzaamheidskenmerken van het a-IGZO TFT-geheugenapparaat als functie van P/E-cycli
Om de oorsprong van elektronen die uit de ongerepte ZnO-CTL zijn gehaald te verduidelijken, worden verschillende bewerkte ZnO-CTL's vergeleken in de a-IGZO TFT-geheugenapparaten. Afbeelding 5 toont de programmeerspanningsafhankelijkheid van △Vth voor de apparaten met verschillende ZnO CTL's. Opgemerkt wordt dat voor de geheugenapparaten met de as-deposited en N2 -gegloeide ZnO CTL's, de resulterende ΔVde vertoont een vergelijkbare toenemende tendens met het verhogen van de programmeerspanning ondanks de spanningspolariteiten. Voor het geheugenapparaat met de O2 -gegloeide ZnO CTL, de absolute waarde van ΔVth toont een significante afname onder dezelfde programmeerconditie, bijv. de absolute waarde van ΔVth neemt af met respectievelijk 2 en 3 V bij programmeerpulsen van 13 V/80 ms en −12 V/1 μs. Verder wordt verzadigd programmeergedrag waargenomen voor de O2 -gegloeide ZnO CTL in het geval van positieve en negatieve poortbias. Dit moet worden toegeschreven aan beperkte vallen in de CTL. Kortom, de post-annealing in O2 bij 250 °C vermindert het aantal opvangcentra in de ZnO-film, wat leidt tot een afname van de capaciteit voor het opvangen van ladingen.

De drempelspanningsverschuivingen van de a-IGZO TFT-geheugenapparaten met verschillende verwerkte ZnO-ladingvanglagen als functie van a positieve programmeerspanning voor constante programmeertijd van 80 ms en b negatieve programmeerspanning voor constante programmeertijd van 1 μs. Voor elke conditie werden vijf apparaten gemeten.
Om de invloed van post-annealing op de eigenschappen van de ZnO-film te onderzoeken, worden de zoals gedeponeerde en verwerkte ZnO-films gekarakteriseerd door Hall-effectmetingen en XPS. Zoals getoond in Fig. 6, is de ZnO-film uitgegloeid in N2 bij 250 °C toont een dragerconcentratie van 4,4×10 19 cm −3 , wat daar heel dicht bij in de buurt komt (4,5 × 10 19 cm −3 ) van de als gedeponeerde ZnO-film; echter, de ZnO-film uitgegloeid in O2 bij 250 °C vertoont een opmerkelijke afname van de dragerconcentratie, die gelijk is aan 1,8 × 10 18 cm −3 . Er is gemeld dat de intrinsieke donoren in n-type ZnO-halfgeleiderfilms zuurstofvacatures zijn [24]. Kwon et al. rapporteerde ook dat de atoomverhouding O/Zn in de ALD ZnO-film geleidelijk afnam van 0.90 tot 0.78 bij verhoging van de depositietemperatuur van 70 tot 130 °C [25]. Dit onthult het bestaan van zuurstofvacatures in ALD ZnO-films. Daarom is de O2 Door annealing geïnduceerde afname van de drager (elektronen) concentratie moet verband houden met de vermindering van zuurstofvacatures in de ZnO-film. Verdere O1s XPS-spectra met hoge resolutie van de gedeponeerde ZnO-film en die gegloeid in N2 of O2 worden geanalyseerd, zoals weergegeven in Fig. 7. De gedeconvolueerde drie pieken zijn gecentreerd op 530,0, 531,6 en 532,4 eV, wat overeenkomt met O 2− ionen gebonden met Zn 2+ (O1), zuurstofvacatures (O2) en chemisch gesorbeerd zuurstofelement (-OH, enz.) (O3), respectievelijk [26]. Vergeleken met de as-deposited ZnO-film, is de post-annealing in O2 zorgt voor een afname van 2,1% in het relatieve percentage O2. Niettemin, voor de ZnO-film gegloeid in N2 , is het relatieve percentage O2 nagenoeg onveranderd. Deze resultaten geven aan dat de O2 uitgloeien kan zuurstofvacatures in de ZnO-film passiveren, maar de N2 gloeien kan niet. Dit bevestigt verder de correlatie tussen zuurstofvacatures en dragerconcentratie.

De dragerconcentraties van de als afgezette ZnO-film en die onder verschillende omstandigheden uitgegloeid.
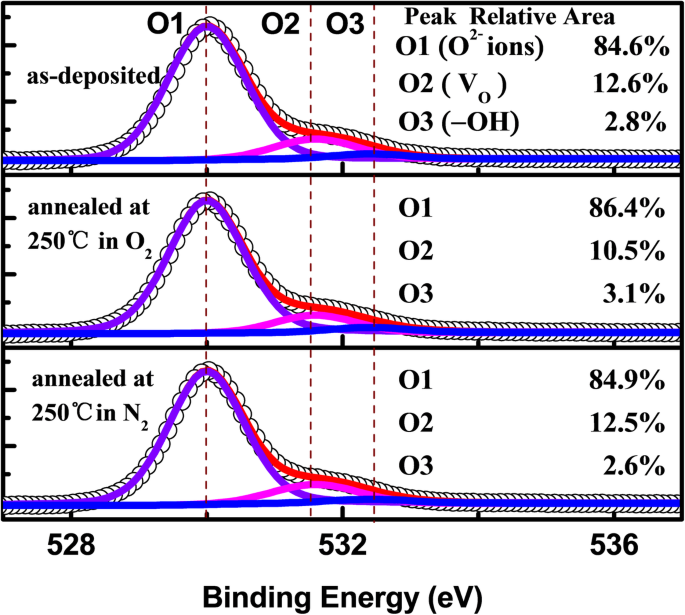
Hoge resolutie O1s XPS-spectra van de gedeponeerde ZnO-film en die gegloeid bij 250 °C in O2 en N2 , respectievelijk. O1 en O2 komen overeen met O 2− ionen gebonden met Zn 2+ en zuurstofvacatures, respectievelijk. O3 wordt toegeschreven aan chemisch gesorbeerd zuurstofelement (-OH, enz.). Om onbedoeld oppervlakteverontreinigingen te verwijderen, werden alle monsters geëtst met in situ Ar-ionenbombardement
Op basis van de bovengenoemde experimentele resultaten kan worden geconcludeerd dat de programmeerkenmerken van de ongerepte geheugenapparaten worden gedomineerd door de concentratie van zuurstofvacature-gerelateerde defecten in de ZnO-CTL. Met andere woorden, zuurstofvacatures in de ZnO-film dienen voornamelijk als opvangcentra voor het opvangen van positieve en negatieve ladingen. Het is gemeld dat zuurstoftekort-gerelateerde defecten in ZnO onder meer een neutrale zuurstoftekort (VO ), enkelvoudig geïoniseerde zuurstofvacature (VO + ), en dubbel geïoniseerde zuurstofvacature (VO 2+ ), waarvan de energieniveaus zich respectievelijk op 0,02-0,04, 0,3-0,45 en 0,61 eV bevinden, onder het geleidingsbandminimum van ZnO [27, 28]. Aangezien de als gedeponeerde ZnO-film in ons geval een hoge elektronenconcentratie vertoont, zou de concentratie van neutrale zuurstofvacatures die als ondiepe donoren dienen veel hoger moeten zijn dan die van geïoniseerde zuurstofvacatures (VO + en VO 2+ ). In termen van programmeren met een positieve gate-bias, worden elektronen in de accumulatielaag van het a-IGZO-kanaal in de ZnO-laag geïnjecteerd door het Fowler-Nordheim (FN) tunnelmechanisme, wat wordt aangetoond door een incrementele ΔVth met verbetering van de programmeerspanning in figuur 2a. Ondertussen wordt verwacht dat deze elektronen bij voorkeur worden gevangen op diepe niveaus van VO + en VO 2+ , zoals afgebeeld in Fig. 8a. Dit veroorzaakt een verschuiving van Vde naar een positieve bias. Natuurlijk, naast zuurstofvacatures die elektronen opsluiten, kunnen andere defecten ook elektronen vangen. Onze experimentele gegevens geven echter aan dat zuurstofvacatures een cruciale rol spelen bij het vangen van elektronen en het vastleggen van positieve lading, zoals onthuld in Fig. 5. Onder negatieve programmeerspanning doneren de neutrale zuurstofvacatures in de ongerepte ZnO CTL dominant elektronen vanwege de ondiepste energieniveau [27, 28], en de vrijgekomen elektronen tunnelen van de ZnO CTL in het kanaal, wat leidt tot de vorming van positief geladen zuurstofvacatures (bijv. VO + ), zoals getoond in Fig. 8b. Dit veroorzaakt een verschuiving van Vde in de richting van de negatieve bias, zoals aangegeven in figuur 2b. Verder door een hogere concentratie neutrale zuurstofvacatures (VO ) in de als gedeponeerde CTL van ZnO vertoont het ongerepte geheugenapparaat een veel hogere programmeerefficiëntie onder de negatieve poortvoorspanning dan onder de positieve poortvoorspanning. Bijvoorbeeld, de absolute waarde van ΔVth is zo groot als 6,5 V na programmering op -13 V gedurende 1 μs (zie Fig. 2d); echter, de ΔVde is gelijk aan 2 V na programmering op 13 V gedurende 1 μs (Fig. 2c). Dit komt omdat de eerste voornamelijk wordt bepaald door de concentratie van VO , en de laatste wordt gedomineerd door de concentraties van VO + en VO 2+ .
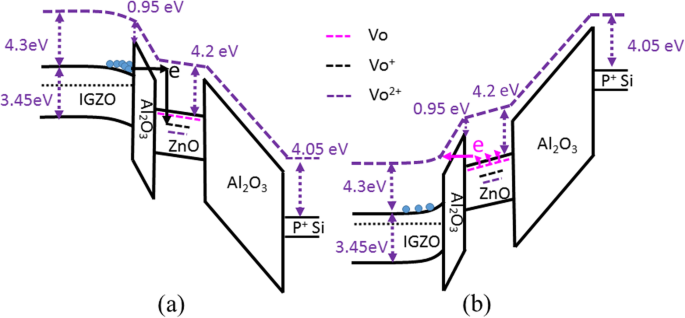
Energiebanddiagrammen van de a-IGZO TFT-geheugenapparaten geprogrammeerd op a een positieve gate-bias en b respectievelijk een negatieve gate-bias. Vo , Vo + , en Vo 2+ duiden respectievelijk neutrale zuurstofleegstand, enkel geïoniseerde zuurstofleegte en dubbel geïoniseerde zuurstofleegstand aan
Conclusies
Samenvattend hebben we een bipolair programmeerbaar a-IGZO TFT-geheugen gefabriceerd met een op een atoomlaag afgezette ZnO CTL. Vergeleken met de programmering onder een positieve gate-bias, kan de programmering onder een negatieve gate-bias een veel hogere efficiëntie genereren. De reden hiervoor is dat verschillende defecten in het zuurstoftekort optreden tijdens de spanningspolariteitsafhankelijke programmering. Dat wil zeggen, diepe defecten van VO + en VO 2+ spelen een sleutelrol bij het invangen van elektronen tijdens het programmeren van positieve bias en ondiepe defecten van VO doneren voornamelijk elektronen tijdens het programmeren van negatieve bias, wat resulteert in het genereren van positief geladen zuurstofvacatures.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit manuscript ondersteunen, zijn opgenomen in het manuscript.
Afkortingen
- a-IGZO:
-
Amorf indium-gallium-zink-oxide
- ALD:
-
Atoomlaagafzetting
- CTL:
-
Oplaadlaag
- TFT:
-
Dunne-filmtransistor
- XPS:
-
Röntgenfoto-elektronenspectroscopie
Nanomaterialen
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Zeer efficiënte omgekeerde perovskiet-zonnecellen met CdSe QDs/LiF-elektronentransportlaag
- Een onderzoek naar een kristallijn-silicium zonnecel met zwarte siliciumlaag aan de achterkant
- Verbetering van de prestaties van a-IGZO TFT-apparaten met behulp van een schoon interfaceproces via Etch-Stopper nanolagen
- Verminderde contactweerstand tussen metaal en n-Ge door invoeging van ZnO met argonplasmabehandeling
- Effect van dubbellaagse CeO2−x/ZnO en ZnO/CeO2−x heterostructuren en elektroformerende polariteit op schakeleigenschappen van niet-vluchtig geheugen
- Onderzoek naar energieband bij Atomic-Layer-Deposited ZnO/β-Ga2O3 (\( \overline{2}01 \)) Heterojuncties
- Ultra-lage specifieke weerstand laterale dubbel-diffuus metaaloxide-halfgeleidertransistor met verbeterde dubbele poort en gedeeltelijk P-begraven laag
- SnSe2-veldeffecttransistor met hoge aan/uit-verhouding en polariteitsschakelbare fotogeleiding
- Python - Extensie programmeren met C



