Verminderde contactweerstand tussen metaal en n-Ge door invoeging van ZnO met argonplasmabehandeling
Abstract
We onderzoeken de metaal-isolator-halfgeleidercontacten op n-Ge met behulp van een ZnO-interfacelaag (IL) om het Fermi-level pinning (FLP) -effect op de metaal/Ge-interface te overwinnen en de barrièrehoogte voor elektronen te verminderen. Een kleine geleidingsbandoffset van 0,22 eV op het grensvlak tussen ZnO en n-Ge wordt verkregen, en de ZnO IL leidt tot de aanzienlijk verminderde contactweerstand (R c ) in metaal/ZnO/n-Ge vergeleken met het controleapparaat zonder ZnO, vanwege de eliminatie van FLP. Er is waargenomen dat de argon (Ar) plasmabehandeling van ZnO de R verder kan verbeteren. c kenmerken in Al/ZnO/n-Ge-apparaat, wat te wijten is aan dat Ar-plasmabehandeling de concentratie van zuurstofvacature V verhoogt o , fungerend als n-type doteermiddelen in ZnO. Het ohmse contact wordt aangetoond in de Al/ZnO/n-Ge met een doteringsconcentratie van 3 × 10 16 cm −3 in Ge. Op de zwaar gedoteerde n + -Ge met een fosforion (P + ) implantatie, een specifieke contactweerstand van 2,86 × 10 − 5 Ω cm 2 wordt bereikt in Al/ZnO/n + -Ge met Ar-plasmabehandeling.
Achtergrond
Germanium (Ge) heeft veel aandacht getrokken voor de geavanceerde metaaloxide-halfgeleider veldeffecttransistoren (MOSFET's) vanwege de hogere draaggolfmobiliteit in vergelijking met Si [1, 2]. Voor de Ge p-kanaal MOSFET's is grote vooruitgang geboekt in de groei van gespannen Ge-kanaal [3,4,5], oppervlaktepassivering [6,7,8,9] en source/drain (S/D) contacten [ 10] en de ultrageschaalde Ge pFinFET's [11] hebben de superieure elektrische prestaties van de Si-apparaten aangetoond. Ge n-kanaaltransistoren staan daarentegen nog steeds voor uitdagingen, die het obstakel vormen voor de integratie van Ge CMOS, waaronder de slechte interfacekwaliteit, resulterend in de lage elektronenmobiliteit en de hoge S/D-weerstand vanwege de beperkte activering snelheid van n-type doteermiddelen in Ge [12] en de Fermi-level pinning (FLP) op metaal/n-Ge-interface [13]. FLP leidt tot een Schottky-barrièrehoogte van ongeveer 0,5 eV voor elektronen voor de meeste metalen op n-Ge, waardoor de zeer grote contactweerstand R ontstaat c [13,14,15].
Depinning op fermi-niveau kan worden gedaan door een dunne grenslaag (IL) aan te brengen, bijv. TiO2 [16] en ZnO [17], tussen de metalen en n-Ge [18], waardoor de dunne IL de metaalgolffunctie in Ge kan blokkeren om de metaalgeïnduceerde spleettoestanden te verminderen [19, 20]. ZnO heeft een kleine conductieband-offset (CBO) ten opzichte van Ge, wat kan leiden tot de kleinere R c in metaal/ZnO/n-Ge, vergeleken met metaal/TiO2 /n-Ge met TiO2 /Ge met de positieve CBO [16]. De diëlektrische constante van ZnO is kleiner dan die van TiO2 , zodat ZnO IL een dunner uitputtingsgebied tussen het metaal en n-Ge kan verkrijgen in vergelijking met TiO2 . Bovendien is het gemakkelijk om n-type doping in ZnO te realiseren door niet-stoichiometrische defecten te introduceren, zoals zuurstofvacatures V o [21, 22], wat aanleiding geeft tot een nog kleiner ZnO-depletiegebied tussen het metaal en n-Ge. Tot dusverre, in metaal/ZnO/n-Ge contacten, doping van ZnO door V o werd uitgevoerd door uitgloeien in een stikstofatmosfeer [16], wat echter zou kunnen leiden tot de interdiffusie van ZnO en Ge tijdens het uitgloeien [23], en diffusie van doteringsatomen in n-Ge tijdens het uitgloeien [24, 25], waardoor de huidige prestaties van het apparaat afnemen. Sindsdien moet een proces bij lage temperatuur voor het afzetten en dopen van ZnO worden ontwikkeld.
In dit werk onderzoeken we het Fermi-niveau dat wordt bepaald op het grensvlak tussen metaal en n-Ge door invoeging van ALD-afgezet ZnO IL. De verbeteringseffecten van argon (Ar) plasmabehandeling van de ZnO-laag op de contactweerstandskenmerken van Al/ZnO/n-Ge worden bestudeerd.
Methoden
Er werden metalen contacten gevormd op zowel licht als zwaar gedoteerde n-Ge (001) wafels. De licht gedoteerde Ge-monsters hebben een dopingconcentratie van ongeveer 3 × 10 16 cm −3 . Om het zwaar gedoteerde n-Ge te verkrijgen, moet een fosforion (P + ) implantaat met een dosis van 1 × 10 15 cm −2 en een energie van 30 keV werd uitgevoerd op de n-Ge (001), die werd gevolgd door een snelle thermische uitgloeiing bij 600 ° C gedurende 60 s. Na wafelreiniging met behulp van verschillende cycli van gedeïoniseerd water en verdund HCl, werden Ge-wafels onmiddellijk in de ALD (Beneq TSF-200) kamer geladen om ZnO af te zetten, en vervolgens werden aluminium (Al) contacten afgezet door op Ge te sputteren met behulp van een lift-off-proces . Hier werden drie ZnO-diktes van 1, 2 en 3 nm gebruikt, die werden bevestigd door spectroscopische ellipsometrie (SE) (J.A. Woollam M2000). Tijdens de ZnO-afzetting worden diethylzink (DEZn) en gedeïoniseerd water (H2 O) werden respectievelijk gebruikt als de Zn- en O-precursoren en de substraattemperatuur werd op 150°C gehouden om de vorming van GeOx te elimineren . Het gedetailleerde ZnO-afzettingsproces met behulp van ALD werd gerapporteerd in onze eerdere werken in ref. [26, 27]. Om de geleidbaarheid van ZnO-film verder te verbeteren, werden sommige ZnO op Ge-monsters behandeld met argon (Ar) plasma. Controle Al/n-Ge-monster zonder ZnO IL werd ook gefabriceerd. De R c van Al op ZnO/Ge werd geëxtraheerd met behulp van de circulaire transmissielijnmethode (CTLM), die werd gevormd door opstijgen. Het blootgestelde ZnO werd volledig geëtst door plasma-ets om volledige isolatie tussen aangrenzende apparaten te garanderen [16].
Keithley 4200 SCS werd gebruikt om de elektrische kenmerken van de Al/ZnO/n-Ge-contracten te meten en CTLM-structuren, transmissie-elektronenmicroscoop met hoge resolutie (HRTEM) en röntgenfoto-elektronspectroscopie (XPS) werden gebruikt om de microstructuur en interface te bepalen eigenschappen van de monsters, en de UV-VIS-spectrofotometer (LAMBDA 950, PerkinElmer) werd gebruikt om de bandgap E te bepalen g van afgezette ZnO-film.
Resultaten en discussie
Materiaalkarakterisering van Al/ZnO/n-Ge
XPS-valentiebandspectra van Ge/ZnO en transmissiespectrum van ZnO worden weergegeven in Fig. 1 en 2, respectievelijk, die werden gebruikt om het mechanisme van het bepalende effect op Fermi-niveau op de Al / ZnO / n-Ge-interface te onderzoeken. We hebben de XPS-metingen uitgevoerd voor dik ZnO-monster, ZnO/n-Ge-interfacemonster en puur Ge-monster, om de valentiebandoffset (VBO) van ZnO/Ge te verkrijgen, zoals weergegeven in figuur 1. De Zn 2 p piekpositie en VBM voor dik ZnO-monster zijn respectievelijk 1021,9 eV en 2,59 eV. De Zn 2p en Ge 3d piekpositie voor ZnO/Ge-interfacemonster zijn respectievelijk 1021,7 eV en 29,1 eV. De Ge 3d piekpositie en VBM voor puur Ge-monster zijn respectievelijk 29 eV en 0,06 eV. Dit geeft aan dat de VBO van ZnO/Ge 2,33 eV [30] is.

XPS-spectra voor valentiebanden van ZnO/Ge-monster. een Zn 2p en b valentiebandspectra voor dik ZnO-monster c ZnO 2p en d Ge 3d spectra voor ZnO/Ge-interfacemonster, en e Ge 3d en f valentiebandspectra voor bulk Ge-monster
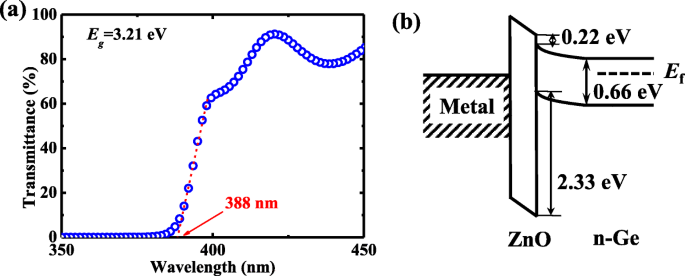
een Transmissiespectrum voor de gedeponeerde ZnO-film die de E . demonstreert g van 3,21 eV. b De banduitlijning voor Al/ZnO/Ge-contact
Afbeelding 2a toont de transmissiegrafiek verkregen uit UV-VIS-spectroscopie voor dik ZnO-monster en de E g van ZnO is vastgesteld op 3,21 eV, in overeenstemming met de gerapporteerde waarden in [28, 29]. Door de verkregen E . te gebruiken g van ZnO en VBO hierboven, wordt een CBO van 0,22 eV tussen ZnO en Ge bepaald, zoals weergegeven in figuur 2b. Dit geeft aan dat depinning op Fermi-niveau kan worden bereikt op de Al/n-Ge-interface met behulp van de ZnO-insertielaag, die de lage R kan produceren c voor Al/ZnO/n-Ge-contact.
Figuur 3 toont het TEM-beeld van de Al/ZnO/n-Ge-structuur met een ZnO-dikte van 3 nm. Een uniforme en conforme ZnO-laag wordt waargenomen tussen Al en n-Ge. De inzet in de rechterbovenhoek illustreert het HRTEM-beeld van de ingezoomde weergave van de Al/ZnO/n-Ge-interface. De dikte van de ZnO-film wordt gemeten als 3 nm, wat consistent is met het resultaat verkregen door SE-meting, en de ZnO-film heeft een amorfe vorm.
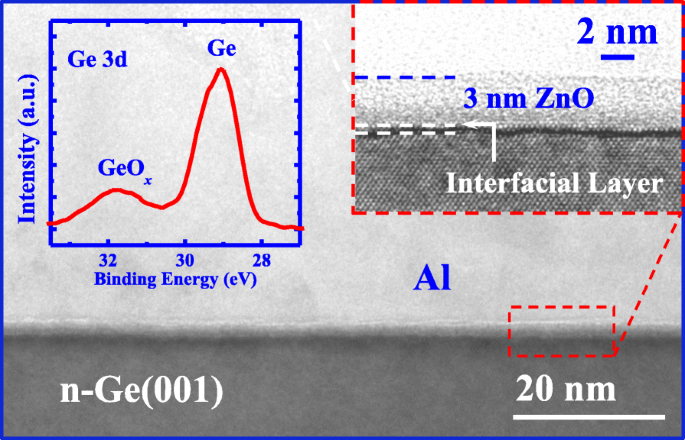
TEM-afbeelding voor een Al/ZnO/n-Ge-monster met de uniforme ZnO-laag tussen Al en Ge. De inzet rechtsboven toont het HRTEM-beeld van de Al/ZnO/n-Ge-interface en de inzet linksboven toont de XPS Ge 3d resultaat van het monster dat het bestaan van GeOx . aantoont grenslaag
Een dunne GeOx grenslaag wordt gevormd tussen Ge en ZnO, die veel kleiner is in vergelijking met [31] vanwege de lagere depositietemperatuur die in dit werk wordt gebruikt. Dit wordt toegeschreven aan het feit dat, tijdens de afzetting van ZnO, Ge reactief is met O-voorloper, wat leidt tot de vorming van GeOx IL. GeOx wordt ook aangetoond door de XPS Ge 3d resulteren in de inzet in de linkerbovenhoek.
De elektrische geleidbaarheid van ZnO-film kan worden verbeterd door Ar-plasmabehandeling, waardoor de concentratie van zuurstofvacatures V toeneemt o , optredend als de donoren in ZnO [32, 33]. Afbeelding 4 toont de XPS-resultaten van O 1s voor als gedeponeerd ZnO en het monster met Ar-plasmabehandeling met een vermogen van 50 W, een Ar-gasstroom van 60 sccm en een duur van 45 s. De O 1s piek wordt gedeconvolueerd in twee pieken met behulp van de Gauss-fitting. De piek bij ~ 530 eV komt overeen met roosterzuurstof in ZnO [34, 35]. Voor het als gedeponeerde monster komt de piek bij 531,7 eV overeen met V o (~ 531,5 eV) en chemisch gesorbeerde zuurstof op het oppervlak van dunne ZnO-films, zoals carbonyl- en hydroxylgroepen [35, 37]. Voor het monster met Ar-plasmabehandeling ligt de piek bij ~ -531,5 eV, wat verschuift naar een lagere bindingsenergie, en veel meer uitgesproken wordt in vergelijking met het als-afgezette monster, wat aangeeft dat meer V o worden gegenereerd als gevolg van Ar-plasmabehandeling en chemisch geabsorbeerde zuurstof wordt effectief verwijderd. De toename van n-type doteermiddelen in ZnO resulteert in de dunnere tunnelbarrière en lagere serieweerstand aan het grensvlak, wat verantwoordelijk is voor de vermindering van R c [36].

XPS-resultaten van O 1s en de gedeconvolueerde resultaten voor als gedeponeerde (bovenste) en met Ar plasma behandelde (onderste) ZnO (3 nm)/n-Ge-monsters
We deden de XPS-metingen met behulp van dik ZnO-monster en ZnO/Ge-interfacemonster met en zonder Ar-plasmabehandeling, zoals weergegeven in Fig. 5. We ontdekten dat er na Ar-plasmabehandeling een verschuiving van -0,05 eV was. Dit kan erop wijzen dat de ZnO/Ge VBO ongeveer 2,38 eV is na behandeling met Ar-plasma en de CBO van 0,17 eV.

VBM voor ZnO/Ge-interfacemonster met en zonder Ar-plasmabehandeling. een Zn 2p en b valentiebandspectra voor dik ZnO-monster c ZnO 2p spectra voor ZnO/Ge-interfacemonster. d Banduitlijningsdiagram voor met Ar plasma behandeld metaal/ZnO/n-Ge
Elektrische prestaties van Al/ZnO/n-Ge-contacten
Afbeelding 6a toont de gemeten stroomdichtheid J als functie van de aangelegde spanning V kenmerken voor Al contacten op licht gedoteerde n-Ge. De Al/ZnO/n − -Ge-apparaten hebben de verschillende diktes van de ZnO-laag. Het schema van het apparaat wordt getoond in de inzet van Fig. 6.
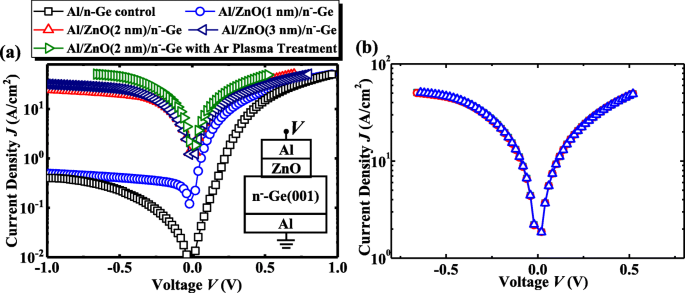
een J -V kenmerken voor Al/n − -Ge controle, Al/ZnO/n − -Ge met ZnO-diktes van 1 nm, 2 nm en 3 nm, en Al/2 nm Ar plasmabehandeld ZnO/Ge, b J -V-kenmerken voor drie met Al/2 nm Ar plasmabehandelde ZnO/Ge-apparaten
Zoals voorspeld, vertoont het Al/n-Ge controleapparaat zonder ZnO de gelijkrichtende eigenschappen met de hoge barrièrehoogte voor elektronen als gevolg van de Fermi-niveau pinning op Al/n − -Ge [38]. Vergeleken met het controle-Al/n-Ge-monster zonder ZnO, vertonen Al/ZnO/n-Ge-apparaten de verbeterde omgekeerde J , wat te wijten is aan de Fermi-niveau-depinning die wordt veroorzaakt door de reductie van metaal-geïnduceerde-gap-states (MIGS) op het metaal / Ge-interface [18, 19]. Deze verbetering wordt nog versterkt met dikker ZnO, wat te wijten is aan het feit dat er meer MIGS worden geëlimineerd. Maar de voorwaartse stroomdichtheid voor een 3 nm ZnO-ingevoegd apparaat is kleiner dan die van een 2 nm. Dit kan als volgt worden uitgelegd. De belangrijkste stroomdichtheid voor Al/ZnO/n-Ge is tunnelstroom. Als de ZnO niet dik genoeg is, wordt MIGS niet effectief geëlimineerd en vertoont het nog steeds corrigerende eigenschappen. Maar als de ZnO te dik is, zal de serieweerstand van ZnO de hele weerstand domineren en wordt de stroom kleiner. Er is dus een wisselwerking tussen eliminatie van MIGS en toename van de serieweerstand van ZnO, en dus is er een kritische dikte voor de IL [19]. Kortom, 2 nm wordt beschouwd als de optimale dikte voor Al/ZnO/n-Ge-contact.
Met de Ar-plasmabehandeling worden de prestaties van Al/ZnO/n − -Ge apparaat is verder verbeterd. Wat ook voor het achteruit of voorwaarts vegen van aangelegde spanning V , Al/2 nm ZnO/n − -Ge-apparaat met Ar-plasmabehandeling bereikt de verbeterde J vergeleken met het apparaat met 2 nm ZnO of 3 nm ZnO, wat te wijten is aan een grote hoeveelheid V o worden gegenereerd in ZnO-film tijdens de Ar-plasmabehandeling. De hogere doteringsconcentratie in ZnO kan de serieweerstand van ZnO effectief verminderen en de tunnelbarrière voor elektronen op het grensvlak tussen ZnO en Al verminderen, waardoor de tunnelstroomdichtheid wordt verbeterd.
Afbeelding 6b toont J -V kenmerken voor drie Al/2 nm ZnO/n − -Ge-apparaat met Ar-plasmabehandeling. Het is duidelijk dat de J voor verschillende apparaten is bijna hetzelfde, wat aangeeft dat zowel het ALD-proces als de Ar-plasmabehandeling een uniform effect hebben op de verbetering van de stroomdichtheid.
Ohmse contacten worden verkregen voor de Al/2 nm ZnO/n − -Ge zonder en met verschillende Ar-plasmabehandelingsduur van respectievelijk 15 s, 30 s, 45 s en 60 s, die worden weergegeven in Fig. 7.

Ik –V krommen bij Al/2 nm ZnO/n − -Ge met verschillende d een zonder Ar-plasmabehandeling en met Ar-plasmabehandelingsduur van b 15 s, c 30 s, d 45 s, en e 60 s
De ruwe totale weerstand R tot tussen twee contacten neemt af met de afname van d , en de laatste R tot wordt gewijzigd door een correctiefactor C, die wordt berekend met de vergelijking C = (L /d )·ln(1 + d /L ) [39], waarbij L = 25 μm staat voor de straal van het binnenkussen, zoals weergegeven in de inzet in figuur 8a. Door de R . te plotten tot als een functie van d in Fig. 8a, de plaatweerstand R sh van de n − -Ge kan worden verkregen uit de lijnhelling, en dan ρ c wordt berekend vanaf het snijpunt van de lineaire paslijn met de verticale as. Voor de Al/2 nm ZnO/n − -Ge-apparaat zonder Ar-plasmabehandeling, de ρ c is 6,87 × 10 −2 Ω cm 2 , maar na 45 s Ar-plasmabehandeling is er een 17,2 keer reductie vergeleken met die zonder Ar-plasmabehandeling en heeft de contactweerstand ρ c van 3,66 × 10 −3 Ω cm 2 . We vergelijken de waarden van ρ c voor de Al/2 nm ZnO/n − -Ge-apparaten met verschillende duur van de Ar-plasmabehandeling in Fig. 8b. Opgemerkt wordt dat ρ c van het apparaat neemt af met de behandeltijd tot 30 s. Omdat de behandelingstijd echter langer is dan 30 s, ρ c blijft bijna hetzelfde. De vermindering van ρ c kan worden toegeschreven aan de dotering van ZnO, dus aan de vermindering van de tunnelbarrière en serieweerstand, zoals eerder vermeld. Maar er is geen waarneembare verandering in de bladweerstand van n − -Ge, wat aangeeft dat er geen effect is op de geleidbaarheid van n − -Ge met Ar-plasmabehandeling.
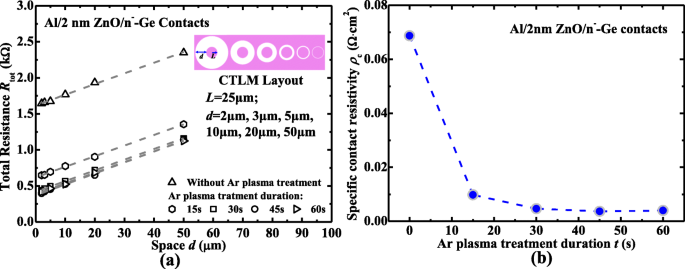
een R tot versus d krommen voor de CTLM met Al/2 nm ZnO /n − -Ge-contacten met verschillende duur van de Ar-plasmabehandeling, inzet in Fig. 5a is de informatie over de CTLM-structuur die in dit werk wordt gebruikt. b ρ c versus verschillende behandelingsduur met Ar-plasma
CTLM-structuur met Al-contacten op zwaar gedoteerd Ge wordt gebruikt om de contactweerstandskarakteristiek van Al/2 nm ZnO/n + te onderzoeken -Ge. De ZnO-laag onderging de Ar-plasmabehandeling gedurende 45 s. Afbeelding 9a toont de gemeten I -V krommen tussen de Al contacten met verschillende d , met de uitstekende ohmse prestaties. Afbeelding 9b geeft de R . weer tot als een functie van d voor Al/2 nm ZnO/n + -Ge CTLM en R sh en ρ c worden geëxtraheerd tot 64 Ω/□ en 2,86 × 10 −5 Ω cm 2 , respectievelijk.
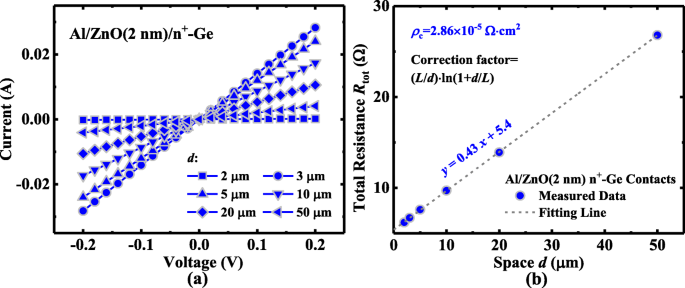
een Ik –V krommen bij Al/ZnO(2 nm)/n + -Ge met verschillende d met ZnO behandeld met Ar-plasma. b R tot versus d krommen voor de CTLM met Al/ZnO(2 nm)/n + -Ge contacten
We vergelijken de ρ c van ZnO behandeld door Ar plasma Al/ZnO/n + -Ge-apparaten in dit werk met de apparaten die in de literatuur worden vermeld, zoals weergegeven in Fig. 10. Voor de zwaar gedoteerde n + -Ge contact monster, Al/ZnO/n + -Ge contacten getoond de kleinere ρ c in vergelijking met die van Ni/GeSn [40, 41], Ni/Ge [42], Ti/n + -Ge in ref. [31], en Ti/TiO2 /GeO2 /Ge [31], met koolstof geïmplanteerde Ni/Ge [42] en Ti/n + -SiGe/n-Ge [43]. Metalen ohmse contacten zoals Ni/Ge, Ni/GeSn, Ti/Ge en met koolstof geïmplanteerde Ni/Ge hebben last van ernstige Fermi-niveau pinning, wat resulteert in de grote ρ c . Voor Ti/TiO2 /GeO2 /Ge contact, werd een grote tunnelweerstand geïntroduceerd door de dubbellaag van 1 nm TiO2 /1,5 nm GeO2 IL, waardoor de karakteristieken van de contactweerstand worden verslechterd. Maar de ρ c in dit werk is groter dan dat in ref. [44]. We gaan ervan uit dat dit komt door de vier keer grotere P + implantatiedosis dan die in ons werk. Een grotere implantatiedosis maakt de zwaardere oppervlaktedoping van n + . mogelijk -Ge, wat resulteert in de dunnere Schottky-barrière en kleinere ρ c . Wij zijn van mening dat met zwaardere doping van n + -Ge in Al/ZnO/n + -Ge-apparaten, kleiner ρ c zal resulteren in.
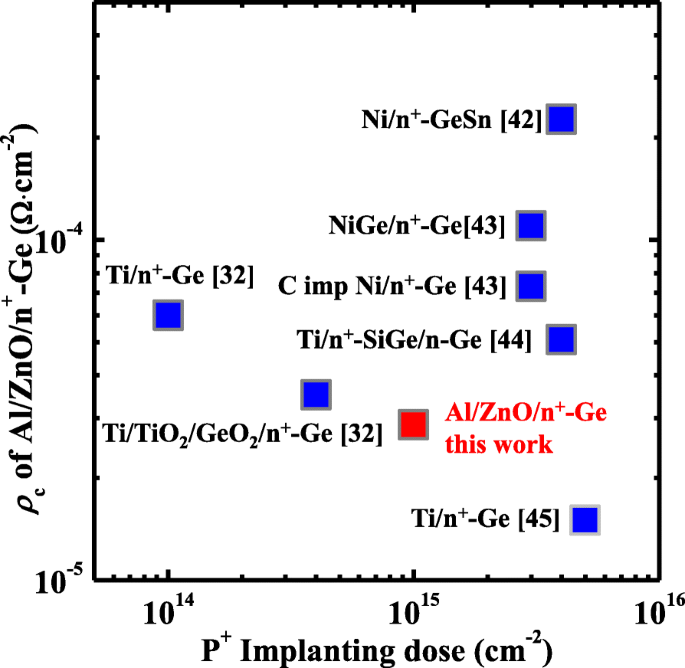
Vergelijking van ρ c van Al/ZnO/n + -Ga in dit werk samen met die van andere gerapporteerde contacten, met behulp van P + implantatiedosis als de x as
Conclusies
Het bepalende effect op Fermi-niveau geïnduceerd door ZnO IL in de Al/ZnO/n-Ge structuren wordt onderzocht. XPS-meting toonde een kleine CBO van 0,22 eV bij ZnO/n-Ge, d.w.z. er treedt eliminatie van FLP op, wat leidt tot de ohmse metalen contacten op n-Ge. Verder is gemeld dat behandeling van ZnO in Ar-plasma leidt tot een verhoging van de concentratie van V o , fungerend als de n-type doteringsmiddelen in ZnO, wat de R . verbetert c prestaties in Al/ZnO/n-Ge-apparaten. Ohmse metalen contacten worden verkregen op n − en n + -Ge met het met Ar plasma behandelde ZnO IL. Gebaseerd op de CTLM-structuren, waarden van ρ c 3.66 × 10 −3 Ω cm 2 en 2.86 × 10 − 5 Ω cm 2 worden bereikt in Al/2 nm ZnO/n − -Ge en Al/2 nm ZnO/n + -Ge, respectievelijk, met de Ar-plasmabehandeling van ZnO bij een vermogen van 50 W gedurende 45 s.
Afkortingen
- Al:
-
Aluminium
- ALD:
-
Atoomlaagafzetting
- Ar:
-
Argon
- CBO:
-
Geleidingsband offset
- CTLM:
-
Circulaire transmissielijnmethode
- DEZn:
-
Diethylzink
- E g :
-
Bandafstand
- FLP:
-
Pinning op Fermi-niveau
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxide
- GeSn:
-
Germaniumtin
- HCl:
-
Zoutzuur
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- IL:
-
Tussenlaag
- MIGS:
-
Door metaal geïnduceerde gap-states
- MOSFET's:
-
Metaaloxide-halfgeleider veldeffecttransistoren
- Ni:
-
Nikkel
- P + :
-
Fosforion
- R c :
-
Contactweerstand
- R tot :
-
Ruwe totale weerstand
- SE:
-
Spectroscopische ellipsometrie
- Si:
-
Silicium
- Ti:
-
Titanium
- TiO2 :
-
Titaandioxide
- UV-VIS:
-
Ultraviolet zichtbaar
- VBO:
-
Valentieband-offset
- V o :
-
Zuurstoftekort
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- ZnO:
-
Zinkoxide
- ρ c :
-
Specifieke contactweerstand
Nanomaterialen
- Wat is het verschil tussen Inconel en Incoloy?
- Wat is het verschil tussen metaalplaat, plaat en folie?
- Verschil tussen structuur en klasse:uitgelegd met C++-voorbeeld
- Verschil tussen while en do-while:uitgelegd met voorbeelden
- Afstemming van oppervlaktechemie van polyetheretherketon door gouden coating en plasmabehandeling
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Evolutie van het contactgebied met normale belasting voor ruwe oppervlakken:van atomaire naar macroscopische schalen
- Wat is warmtebehandeling? - Proces en methoden?
- Wat is het verschil tussen metaalfabricage en metaallassen?
- Wat is het verschil tussen metaalfabricage en lassen?
- Het verschil tussen temperen en gloeien



