Simulatiestudie van de Double-Gate Tunnel Field-Effect Transistor met stapkanaaldikte
Abstract
De veldeffecttransistor met dubbele poorttunnel (DG TFET) zal naar verwachting de beperkingen van lekstroom en helling onder de drempel uitbreiden. Het heeft echter ook last van het ambipolaire gedrag met de symmetrische source/drain-architectuur. Om de ambipolaire stroom te overwinnen, moet asymmetrie worden geïntroduceerd tussen de source en drain. In dit artikel onderzoeken we de prestaties van DG TFET met stapkanaaldikte (SC TFET) door gebruik te maken van de 2D-simulatie. De asymmetrie tussen source en drain wordt geïntroduceerd door de stapkanaaldikte; daarom wordt verwacht dat het ambipolaire gedrag zal worden verlicht. De resultaten laten zien dat de SC TFET een significante vermindering van ambipolaire stroom vertoont in vergelijking met de conventionele DG TFET. De mechanismen van SC TFET worden grondig besproken om het fysieke inzicht te verkennen. De effecten die worden geïntroduceerd door de structuurparameters op beginspanning, helling onder de drempel, afvoerstroom in aan- en ambipolaire toestand worden ook aangetoond bij het bepalen van de optimale structuur.
Achtergrond
Naarmate het extreme schaalproces voortduurt, stuit de CMOS-technologie met conventionele MOSFET op verschillende uitdagingen, zoals de toenemende lekstroom en de helling onder de drempel (SS ). Tunnel-veldeffecttransistor (TFET), die gebruikmaakt van band-naar-band tunneling (BTBT) mechanismen, zal naar verwachting de beperkingen van lekstroom en SS uitbreiden [1,2,3,4,5,6,7,8]. Op silicium gebaseerde TFET heeft voordelen zoals hoge betrouwbaarheid en lage kosten. Conventionele op silicium gebaseerde TFET vertoont echter een relatief lage stroomsterkte in vergelijking met de MOSFET vanwege de beperkte BTBT-snelheid [9,10,11]. Om het potentieel van op silicium gebaseerde TFET te ontwikkelen, zijn recentelijk verschillende nieuwe TFET-structuren voorgesteld om de on-state stroom te verbeteren. De double-gate TFET (DG TFET) laat een verbeterde BTBT-snelheid zien, wat leidt tot een verbeterde on-current [12,13,14]. De ambipolaire stroom van DG TFET wordt echter ook verhoogd omdat de BTBT-snelheidsverbetering ook in de ambipolaire toestand wordt geactiveerd [15]. Om de ambipolaire stroom verder te overwinnen, moet asymmetrie worden geïntroduceerd tussen source en drain [16]. DG TFET's met gate-drain underlap en minder drain-dopingconcentratie zijn gebruikelijke methoden om het ambipolaire probleem te verlichten [17,18,19]. Maar de gate-drain underlap vereist een grotere S/D-afstand en een lagere drain-dopingconcentratie verhoogt de serieweerstanden [15]. Een eerder werk heeft aangetoond dat de ambipolaire effecten in de TFET met drain-underlap verder kunnen worden verlicht door de low-k spacers te gebruiken en door de contacten in de boven- en onderconfiguratie te plaatsen [15], wat suggereert dat gecombineerde asymmetriestrategieën zinvol kunnen zijn in het verbeteren van de prestaties van de TFET. In ons eerdere werk is aangetoond dat de FinFET met asymmetrische vinbreedte de prestaties van FinFET verbetert [20]. Er wordt ook aangenomen dat de kanaaldikte t si heeft een aanzienlijke impact op het BTBT-percentage van DG TFET [21]; daarom kan de asymmetrie tussen de brondikte en de afvoerdikte de ambipolaire stroom verder verlichten en moet grondig worden bestudeerd.
In dit artikel onderzoeken we de verschillende prestaties van DG TFET met stapkanaaldikte (SC TFET), de asymmetrie tussen de source en drain wordt geïntroduceerd door de stapkanaaldikte, zodat de ambipolaire stroom naar verwachting zal worden verminderd. De rest van dit artikel is als volgt ingedeeld:Hoofdstuk 2 presenteert de apparaatstructuur en simulatie-opstelling. In hoofdstuk 3 worden de mechanismen van de SC TFET grondig besproken. De gedetailleerde bespreking van de effecten van structuurparameters op de overdrachtscurven, aanvangsspanning (V aanvang ), gemiddelde SS en afvoerstroom in aan/ambipolaire toestand wordt ook gepresenteerd. Ten slotte worden de bevindingen van dit artikel toegelicht in sectie IV.
Structuur en simulatie
Het schematische diagram van de SC TFET die in dit artikel wordt besproken, wordt getoond in figuur 1a. De kanaaldikte nabij het brongebied is niet gelijk aan de kanaaldikte nabij het afvoergebied. De kanaaldikte verandert stapsgewijs op een bepaald punt in het kanaalgebied. De staphoogte en de stappositie worden aangeduid als H en L s respectievelijk. t si1 en t si2 zijn respectievelijk de kanaaldikte nabij het brongebied en het afvoergebied. De effectieve oxidedikte (EOT) is 1 nm in onze simulatie. Het brongebied is zeer p-gedoteerd (10 20 atomen/cm 3 ) en het afvoergebied is sterk n-gedoteerd (10 20 atomen/cm 3 ) om de serieweerstand [15] te verminderen, is het kanaalgebied licht n-gedoteerd (10 17 atomen/cm 3 ). Om de aanvangsspanning met verschillende kanaaldikte-instellingen te analyseren, is de werkfunctie van de metalen poort vastgesteld op 4,5 eV, de poortlengte is gelijk aan de kanaallengte L ch en ingesteld op 50 nm [22,23,24,25]. De simulaties zijn uitgevoerd met behulp van Sentaurus TCAD release I-2013.12 [26, 27]. Het dopingafhankelijkheidsmodel en het veldafhankelijke mobiliteitsmodel zijn respectievelijk Philips unified mobility model en Lombardi mobility model. De Fermi-Dirac-statistieken, Shockley-Read-Hall en Auger-recombinatiemodel worden ook gebruikt. Om rekening te houden met de sterk gedoteerde source/drain-regio's, wordt het bandgapverkleiningsmodel geactiveerd. Het niet-lokale BTBT-model gebaseerd op Wentzel-Kramer-Brillouin (WKB) benadering afgestemd met de experimentele resultaten van [28] en het dichtheidsgradiënt-kwantisatiemodel zijn in staat gesteld om de nauwkeurige simulatie te bereiken [29, 30]. De beginspanning wordt gedefinieerd als de poortspanning waarbij de helling onder de drempel maximaal is. De gemiddelde SS wordt geëxtraheerd uit de off-state stroom naar I d =10 −11 A/μm.
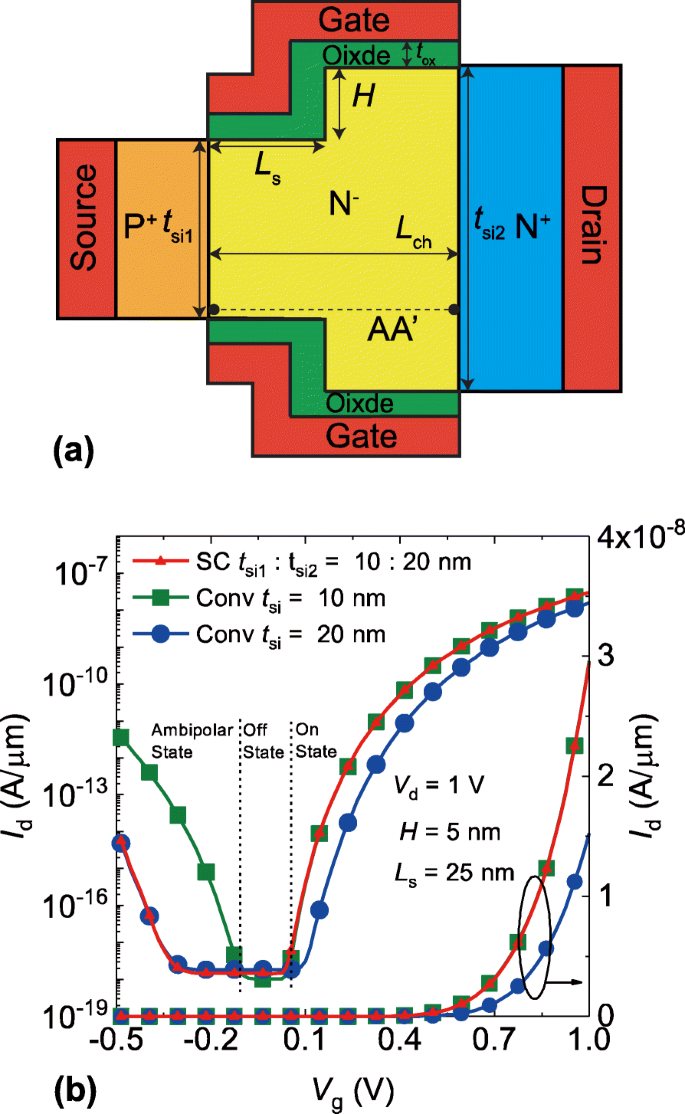
een 2D schematisch diagram van de SC TFET, t si1 en t si2 zijn de kanaaldikte nabij het brongebied en het afvoergebied, de asymmetrie tussen de bron en de afvoer is duidelijk geïntroduceerd. Snijlijn AA' is de snijlijn langs de horizontale richting. De verticale afstand tussen de snijlijn en het oppervlak van het brongebied is 0,5 nm. b Overdrachtscurven van de SC TFET en de conventionele DG TFET's in log- en lineaire schaal
Resultaten en discussie
Overdrachtscurven en mechanisme
Figuur 1b toont de overdrachtscurven van SC TFET en conventionele DG TFET in respectievelijk log- en lineaire schaal. We markeren de on-state, off-state en ambipolaire toestand in figuur 1b. Voor TFET's zijn altijd een hogere stroom van de aan-status en een lagere stroom van de ambipolaire status gewenst, wat vereist dat de V aanvang en SS laag moet zijn, terwijl de uit-toestand een breed spanningsbereik moet hebben. Zoals getoond in Fig. 1b, is de V aanvang van conventionele DG TFET met kanaaldikte van 10 nm zijn lager dan die van DG TFET met kanaaldikte van 20 nm. De geëxtraheerde V aanvang van DG TFET met t si =10 nm is 0,04 V en het geëxtraheerde gemiddelde SS is 44,8 mV/dec, de V aanvang en de gemiddelde SS van conventionele DG TFET met t si =20 nm is respectievelijk 0,1 V en 50,6 mV/dec. De afvoerstroom van conventionele DG TFET met t si =10 nm is met 94,7% verbeterd vergeleken met de conventionele DG TFET met t si =20nm. De belangrijkste reden van deze verbetering van de afvoerstroom is de verminderde SS en V aanvang . Het off-state bereik van de conventionele DG TFET met t si =10 nm is slechts 0,17 V. De conventionele DG TFET met t si =20 nm vertoont in vergelijking daarmee een off-state bereik van 0,45 V. Als resultaat is de ambipolaire-state stroom van de conventionele DG TFET met t si =20 nm wordt met 3 ordes van grootte verminderd in vergelijking met de conventionele DG TFET met t si =10 nm.
Voor de eerlijke vergelijking, de t si1 en t si2 van SC TFET's zijn gelijk aan de kanaaldiktes van respectievelijk boven conventionele DG TFET's. De smallere kanaaldikte t si1 van SC TFET is 10 nm en de bredere kanaaldikte t si2 van SC TFET is 20 nm. De positie van de stap wordt aangenomen in het midden van het kanaal en de L s is 25nm. Men kan constateren dat de SC TFET veelbelovende eigenschappen vertoont, waaronder de hoge afvoerstroom in de aan-toestand evenals de brede waaier uit-toestand. De afvoerstroom van SC TFET in de aan-toestand is vergelijkbaar met de conventionele DG TFET met t si =10 nm, de gemiddelde SS is 45,8 mV/dec en de V aanvang is 0,03 V. Het off-state bereik van SC TFET is echter verbeterd tot 123,5% en de stroom in ambipolaire toestand is ook verminderd met 3 ordes van grootte in vergelijking met de conventionele DG TFET met t si =10nm. Als gevolg hiervan zijn de on-state kenmerken van SC TFET vergelijkbaar met de conventionele DG TFET met smalle kanaaldikte, de SC TFET vertoont ook bijna parallelle uit/ambipolaire curven aan de conventionele DG TFET met brede kanaaldikte. Daarom kan de SC TFET lage SS . bereiken , verminderde V aanvang , en een breed off-state bereik tegelijkertijd.
Om het fysieke mechanisme van de SC TFET te onderzoeken, vergelijken we de BTBT-snelheden en energiebanddiagrammen in respectievelijk de on-state, near onset point en ambipolaire-state. Figuur 2a toont de BTBT-percentages van de SC TFET en de conventionele DG TFET's. Het is te zien dat de BTBT-snelheid sterk afhangt van de kanaaldikte. In feite is de relatie tussen de kanaaldikte en de BTBT-stroom I BTBT kan worden uitgedrukt als [31].
$$ {I}_{BTBT}\propto \exp \left(-\frac{4\lambda \sqrt{2{m}^{\ast }{E_g}^{2/3}}}{3\mathrm {\hslash}\left(\Delta \Phi +{E}_g\right)}\right) $$ (1)
een BTBT-tarieven en b energiebanddiagram van de SC TFET en de conventionele DG TFET's in de on-state, afstand is de laterale positie van de snijlijn AA' in Fig. 1
Waar λ =(ε si t si t os /2ε os ) 1/2 is de natuurlijke lengte, ε si en ε os zijn respectievelijk de permittiviteit van silicium en oxide en t os is de oxidedikte. ΔΦ is het energiebereik waarover tunneling kan plaatsvinden, E g is de band gap bij het tunnelknooppunt, en m * is de tunnelmassa. Vergelijking (1) geeft aan dat de I BTBT zou moeten toenemen als t si vermindert. Daarom is de BTBT-snelheid van conventionele DG TFET met t si =10 nm moet groter zijn dan die van de conventionele DG TFET met t si =20nm. De SC TFET toont een vergelijkbare verdeling van de BTBT-snelheid als de conventionele DG TFET met t si =10nm. Dit komt omdat de BTBT voornamelijk optreedt in de buurt van de bronovergang in de aan-toestand, vandaar dat de kanaaldikte nabij de bronovergang de BTBT-snelheid in de aan-stand zal bepalen. Figuur 2b toont het energiebanddiagram van de SC TFET en de conventionele DG TFET's. Aangezien de BTBT-snelheid fundamenteel gerelateerd is aan de tunnelafstand, zal het energiebanddiagram, dat de tunnelingafstand duidelijk kan weergeven, de oorsprong van de variatie in de BTBT-snelheid verklaren. In figuur 2b bevindt de minimale tunnelafstand van de SC TFET zich nabij de source junction en is min of meer gelijk aan die van de conventionele DG TFET met t si =10nm. De minimale tunnelafstand van conventionele DG TFET met t si =20 nm is aanzienlijk breder; daarom is de BTBT-snelheid verlaagd in vergelijking met de SC TFET en de conventionele DG TFET met een dunnere kanaaldikte.
Figuur 3a toont de BTBT-snelheden wanneer de poortspanning nul is en dicht bij de beginspanning ligt. Het is te zien dat de SC TFET het hoogste BTBT-percentage heeft, gevolgd door de conventionele DG TFET met t si =10nm. De conventionele DG TFET met t si =20 nm geeft de laagste BTBT-snelheid weer. Figuur 3b toont het bijbehorende energiebanddiagram. Men kan zien dat de locatie van de minimale afstand van de valentieband tot de geleidingsband zich in het midden van het kanaalgebied bevindt. Bovendien is de minimale afstand van de conventionele DG TFET met bredere kanaaldikte langer dan die van de SC TFET en conventionele DG TFET met dunnere kanaaldikte. Het geeft aan dat de kanaaldikte ook een significante invloed heeft op de BTBT-snelheid op het beginpunt. Vandaar dat de V aanvang is ook afhankelijk van de kanaaldikte. Een ander feit is dat de SC TFET een hogere BTBT-snelheid vertoont dan die van de conventionele DG TFET met t si =10 nm hoewel hun minimale kanaaldikte gelijk is. Dit fenomeen wordt toegeschreven aan de variatie van de potentiaalverdeling die wordt geïntroduceerd door de hoek van de poortelektrode, zoals ook kan worden waargenomen in ander werk [32, 33]. Als resultaat toont de SC TFET de laagste V aanvang , gevolgd door de conventionele DG TFET met dunne kanaaldikte, en de conventionele DG TFET met brede kanaaldikte vertoont de hoogste V aanvang .

een BTBT-tarieven en b energiebanddiagram van de SC TFET en de conventionele DG TFET's in het nabije beginpunt, afstand is de laterale positie van de snijlijn AA' in Fig. 1
Figuur 4a toont de vergelijking van BTBT-snelheden in de ambipolaire toestand. Aangezien de BTBT-snelheid sterk afhankelijk is van de kanaaldikte, is de conventionele TFET met t si =10 nm toont de meest significante BTBT-snelheid in vergelijking met de andere twee TFET-structuren. De SC TFET toont echter de vergelijkbare BTBT-snelheid als de conventionele DG TFET met t si =20nm. Het is omdat de tunneling voornamelijk wordt gegenereerd nabij het afvoergebied en de SC TFET een grotere kanaaldikte heeft nabij het afvoergebied. In figuur 4b wordt ook het energiebanddiagram in de ambipolaire toestand getoond. Het is duidelijk te zien dat de minimale tunnelafstand zich in de buurt van het afvoergebied bevindt. Bovendien zijn de tunnelafstanden van SC TFET en conventionele DG TFET met bredere kanaaldikte groter dan die van de conventionele DG TFET met dunnere kanaaldikte, wat resulteert in de lage ambipolaire stroom van SC TFET en conventionele DG TFET met bredere kanaaldikte.

een BTBT-tarieven en b energiebanddiagram van de SC TFET en de conventionele DG TFET's in de ambipolaire toestand, afstand is de laterale positie van de snijlijn AA' in Fig. 1
Gevolgen van H en LS op DC-kenmerken
Figuur 5a toont de overdrachtscurves van de SC TFET met verschillende H en t si1 =10nm. Het is te zien dat de H heeft minder invloed op de aan-staat stroom. De ambipolaire stroom neemt echter aanzienlijk af naarmate de H neemt toe, het off-state bereik verbetert met de stijging van H ook. Het is ook te zien dat de reductie van de ambipolaire stroom afneemt naarmate de H neemt toe. De reden hiervoor is dat het koppelingseffect van de dubbele poortstructuur meestal minder significant is bij een grotere kanaaldikte [31]. Daarom, als de H toeneemt, worden de BTBT-snelheden onafhankelijker van de kanaaldikte, wat leidt tot de verzadiging van ambipolaire stroom. Om de optimale structuurparameter verder te onderzoeken, zijn de effecten van H varieert van 0 tot 15 nm op de apparaatprestaties worden geëxtraheerd en weergegeven in Fig. 5b-d. Figuur 5b toont de V aanvang en de BTBT-snelheidsvariatie met verschillende H en t si1 . Het is te zien dat de V aanvang neemt monotoon af met de toename van H . Dit komt omdat de hoek van de poortelektrode de variatie van de potentiaalverdeling in het kanaalgebied [32, 33] zou introduceren, wat resulteert in de wijziging van de BTBT-snelheid en de V aanvang . Figuur 5b laat zien dat de BTBT-snelheid toeneemt naarmate de H verbetert. Het resultaat is dat de afgenomen V aanvang kan worden gevonden met de verhoogde H . Men kan ook zien dat V aanvang neemt toe naarmate de t si1 neemt toe. De belangrijkste reden is dat de toegenomen t si1 verzwakt de BTBT-snelheid, wat resulteert in een hogere V aanvang . In Fig. 5c, de geëxtraheerde gemiddelde SS van SC TFET met verschillende H en t si1 wordt getoond. De trend van de SS met verschillende H is tegengesteld aan die van de V aanvang . Met andere woorden, de SS stijgt als de H neemt toe. We hebben vermeld dat de afvoerstroom in de toestand afhankelijk is van de t si1 , zodat de SC TFET's met verschillende H maar met dezelfde t si1 zou de vergelijkbare afvoerstroom in de aan-status moeten hebben. Bovendien is het ook bekend dat de V aanvang neemt af met de toename van H . Dit houdt in dat het bereik van de poortspanning om dezelfde afvoerstroom aan te sturen is verbeterd als de H neemt toe. Als gevolg hiervan is de gemiddelde SS neemt monotoon toe met de stijging van H . Het is ook te zien dat de toename van t si1 ondermijnt de SS , wat te wijten is aan het verminderde vermogen van de poortbesturing. Figuur 5d toont de afvoerstroom in de aan- en ambipolaire toestand met verschillende H en t si1 , respectievelijk. De aan-toestandstroom is bijna onafhankelijk van de H , maar het wordt sterk beïnvloed door de t si1 , wat overeenkomt met ons eerdere resultaat dat de on-state tunneling voornamelijk plaatsvindt in de buurt van het brongebied en sterk afhankelijk is van de kanaaldikte nabij het brongebied. De ambipolaire stroom neemt echter af naarmate de H neemt toe. Aangezien de tunneling in de ambipolaire toestand wordt gedomineerd in de buurt van het afvoergebied, neemt de toename van H verbetert de kanaaldikte aan de afvoerzijde en verzwakt zo de ambipolaire stroom. Het is ook te zien dat de ambipolaire stroom aanzienlijk daalt wanneer de H is minder dan 10 nm, wat te wijten is aan het grotere koppelingseffect met dunnere kanaaldikte.

De effecten van H op de a overdrachtscurven, b V aanvang en BTBT-snelheid, c gemiddelde SS , en d afvoerstroom in aan/ambipolaire toestand, H is de hoogte van de stap en H =0 nm staat voor de conventionele DG TFET
In Fig. 6a zijn de overdrachtscurven van SC TFET met verschillende L s respectievelijk worden gepresenteerd. L s =0 nm staat voor de conventionele DG TFET met bijbehorende t si2 en L s =50 nm staat voor de conventionele DG TFET met bijbehorende t si1 . Het kan worden gezien dat de locatie van de stap een significante invloed heeft op de ambipolaire stroom en het off-state bereik. De SC TFET's met L s minder dan 30 nm vertonen een vergelijkbaar ambipolair stroom- en off-state-bereik. Als de L s overschrijdt 30 nm, wordt de ambipolaire stroom sterk verbeterd. Fig. 6b toont de V aanvang en de BTBT-snelheidsvariatie met verschillende L s en t si1 , de trend dat de V aanvang neemt toe naarmate de t si1 verbeteringen zijn ook duidelijk waarneembaar. Het veranderingsbuigpunt op de L s =10 nm is een resultaat van de variëteit van de t si1 . Sinds L s =0 nm is de conventionele DG TFET met een grotere kanaaldikte, de BTBT-snelheid zou afnemen, wat leidt tot een verhoogde V aanvang en een verminderde on-state stroom. Afgezien van het geval van conventionele DG TFET, is de V aanvang van SC TFET wordt monotoon verhoogd als de L s stijgt, wat te wijten is aan de verminderde BTBT-snelheid die wordt veroorzaakt door de structuur van het stapkanaal. Afbeelding 6c toont de effecten van de L s en t si1 op de SS van SC TFET's. De verhoogde t si1 resulteert in de gedegradeerde SS . Volgens vgl. (1), een verhoogde kanaaldikte zou de koppelingseffecten tussen de poortelektroden verlagen, wat leidt tot een verminderde poortbesturingscapaciteit en een verhoogde SS [12]. Als de L s daalt, zal het gebied met een grotere kanaaldikte uitzetten en het algehele vermogen van de poortbesturing verzwakken. Als gevolg hiervan wordt een verminderde L s ondermijnt de SS van SC TFET's, die duidelijk te zien zijn in figuur 6c. Figuur 6d geeft de afvoerstroom weer in de aan- en ambipolaire toestand met verschillende L s en t si1 , respectievelijk. Men kan zien dat de aan-toestandstroom van SC TFET min of meer gelijk is aan de conventionele DG TFET met bijbehorende t si1 . Wat betreft de ambipolaire stroom, de SC TFET's met L s minder dan 30 nm tonen de gelijkaardige stroom aan de conventionele DG TFET's met overeenkomstige t si2 . Wanneer de L s stijgt tot 40 nm, stijgt de ambipolaire stroom dramatisch. In feite, voor het geval van SC TFET met L s =40 nm en t si1 =20 nm, zijn ambipolaire stroom is zelfs groter dan die van de conventionele DG TFET met t si1 =20nm. Dit komt omdat het verticale deel van de poortelektrode het tunnelgebied kan vergroten, vooral wanneer het verticale deel van de poortelektrode zich dicht bij de PN-overgang [34] bevindt. Het geeft aan dat de L s moet kleiner zijn dan 40 nm om de ambipolaire stroom te verminderen.

De effecten van L s op de a overdrachtscurven, b V aanvang en BTBT-snelheid, c gemiddelde SS , en d afvoerstroom in aan/ambipolaire toestand, L s is de laterale afstand van het brongebied tot de stap, L s =0 nm staat voor de conventionele DG TFET met bijbehorende t si2 en L s =50 nm staat voor de conventionele DG TFET met bijbehorende t si1.
Om de optimale structuurparameters van de SC TFET te bepalen, wordt een orthogonale simulatie uitgevoerd door het gecombineerde effect van de H te bestuderen. en de L s op de prestaties van het apparaat. De t si1 is vastgezet op 10 nm om een grotere aan-toestandstroom te bereiken. In Fig. 7a wordt de ambipolaire stroom geëxtraheerd als een functie van de L s met verschillende H . Het is duidelijk te zien dat de ambipolaire stroom aanzienlijk afneemt naarmate de H neemt af, wat suggereert dat een hogere H is veelbelovend in termen van het bereiken van een lagere ambipolaire stroom. Men kan echter constateren dat het voordeel van een grotere H is minder belangrijk. Daarom een H =15 nm zou de optimale waarde zijn, aangezien een grotere H kon het apparaatgebied alleen maar vergroten. Ondertussen een afgenomen L s zal ook de ambipolaire stroom verlagen, vooral met een grotere H . Vandaar een lagere L s is gewenst met het oog op een minimale ambipolaire stroom. Niettemin, een lagere L s kan ook leiden tot een toename van de helling onder de drempel, zoals te zien is in figuur 7b. De helling onder de drempel neemt langzaam toe met een hogere L s maar stijgt snel met een lagere L s , wat aangeeft dat een L s ongeveer 25 nm zou de compromiswaarde zijn. Als resultaat zouden de optimale apparaatparameters H . zijn =15 nm en L s =25 nm waarbij zowel de ambipolaire stroom als de helling onder de drempel relatief laag zijn.
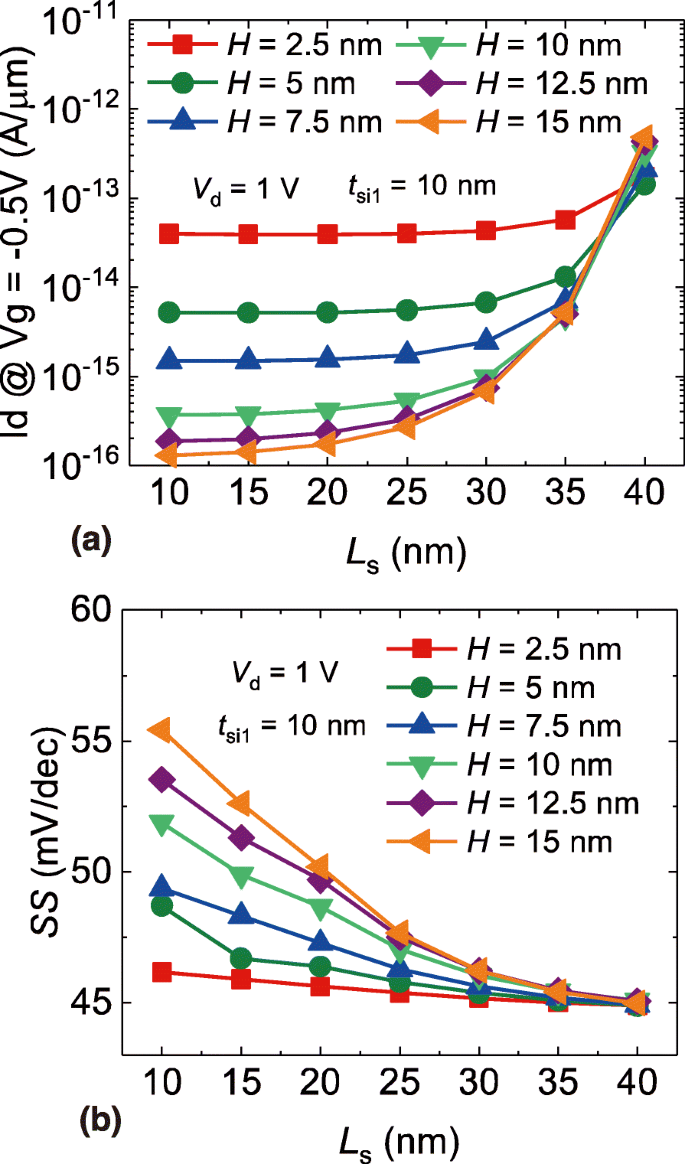
een De ambipolaire stroom en b de subdrempelhelling van de SC TFET als functie van de L S met verschillende H
Vervaardigingsmethode
Een haalbaar fabricageproces van de SC TFET wordt getoond in Fig. 8. Vanwege de unieke vorm van het kanaal kan de dikte van het stapkanaal gemakkelijker worden bereikt door de verticale structuur aan te nemen. Het proces begint met het voorbereiden van het siliciumsubstraat met SiN en fotoresistafzetting, zoals weergegeven in figuur 8a. In Fig. 8b wordt de SiN-patroonvorming bereikt door lithografie, gevolgd door het etsen om het kanaalgebied te vormen, vervolgens de N + gebied wordt geïntroduceerd door een verticale As-implantatie en annealing [35]. Daarna wordt het isolatieoxide afgezet om te voorkomen dat het draingebied in het volgende proces etst, zoals weergegeven in figuur 8c. In figuur 8d worden het verassen en bijsnijden toegepast door gebruik te maken van het reactie-ion-etsen [36] om de dikte en breedte van SiN te verminderen. De dikte van het stapkanaal wordt vervolgens geïntroduceerd door etsen, zoals weergegeven in figuur 8e. De overige processen zijn vergelijkbaar met de conventionele verticale TFET, waarbij gate-oxidevorming, gate-afzetting, siliciumblootstelling en brongebiedimplantatie [35, 37] betrokken zijn, zoals weergegeven in Fig. 8f.
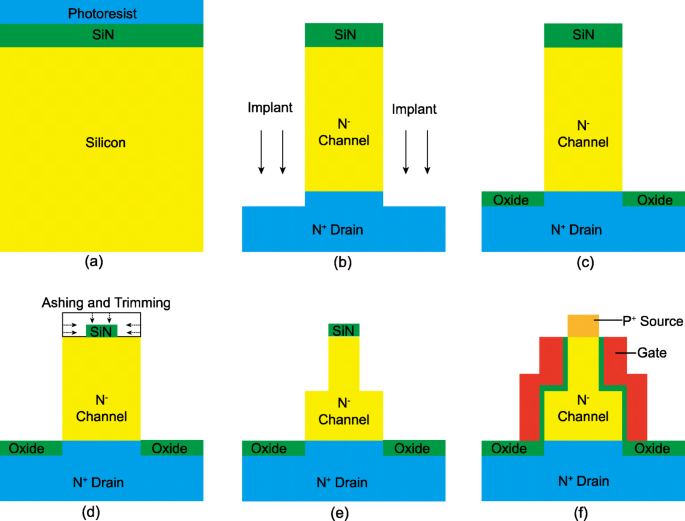
Fabricageproces van de SC TFET. een Siliciumsubstraatvoorbereiding met SiN en fotoresistafzetting. b Etsen, implanteren en gloeien. c Isolatie oxide afzetting. d Het verminderen van de dikte en breedte van SiN door verassing en trimmen. e De dikte van het stapkanaal wordt geïntroduceerd. v Poortoxidevorming, poortafzetting, poortplanarisatie en implantatie van het brongebied
Conclusie
We onderzoeken de elektrische prestaties van DG TFET met stapkanaaldikte (SC TFET) door gebruik te maken van de 2D-simulatie. De asymmetrie tussen source en drain wordt geïntroduceerd door de dikte van het stapkanaal; daarom is het ambipolaire gedrag aanzienlijk verlicht. De SC TFET vertoont vergelijkbare on-state kenmerken van de conventionele DG TFET met bijbehorende t si1 en parallelle uit/ambipolaire curven van de conventionele DG TFET met bijbehorende t si2 . Als gevolg hiervan kan de SC TFET een breed off-state bereik, lage ambipolaire stroom bereiken en de lage SS behouden tegelijkertijd. De mechanismen van SC TFET worden grondig besproken om het fysieke inzicht te verkennen. De effecten van de structuurparameters op de aanvangsspanning, de helling onder de drempel, de afvoerstroom in de aan-toestand en de ambipolaire toestand worden ook bestudeerd om de optimale structuur te bepalen. De SC TFET met H van 15 nm en L s van 25 nm toont de optimale prestaties. Bovendien biedt de architectuur van de dikte van het stapkanaal een alternatieve asymmetriemethode. Aangezien is bewezen dat de gecombineerde asymmetriestrategieën effectief zijn, zou ons werk de prestatie van de TFET verder kunnen verbeteren.
Beschikbaarheid van gegevens en materialen
Alle gegevens zijn onbeperkt beschikbaar.
Afkortingen
- DG TFET:
-
Tunnelveldeffecttransistor met dubbele poort
- SC TFET:
-
DG TFET met getrapte kanaaldikte
- SS :
-
Helling onder de drempel
- BTBT:
-
Band-naar-band tunneling
- EOT:
-
Effectieve oxidedikte
- V aanvang :
-
Beginspanning
- H :
-
Staphoogte
- L s :
-
Stap positie
- L ch :
-
Kanaallengte
- t si :
-
Kanaaldikte
- t si1 :
-
Kanaaldikte nabij het brongebied
- t si2 :
-
Kanaaldikte nabij het afvoergebied
Nanomaterialen
- De onderdelen verbinden:een aan het gezicht conforme draagbare component integreren met een simulatieomgeving
- De Junction Field-effect Transistor (JFET) als switch
- De lekstroomcomponenten in MOS-transistoren met korte kanalen begrijpen
- In harmonie met het hart van een koperatoom
- MoS2 met gecontroleerde dikte voor elektrokatalytische waterstofevolutie
- Oppervlakte-effect op olietransport in Nanochannel:een onderzoek naar moleculaire dynamiek
- De studie van een nieuw, door nanodeeltjes versterkt, wormachtig micellair systeem
- De programmeeroptimalisatie van condensatorloze 1T DRAM op basis van de Dual-Gate TFET
- Enkelwandige koolstof nanobuis gedomineerde micron-brede streeppatroon-gebaseerde ferro-elektrische veldeffect transistoren met HfO2-defect controlelaag
- Kanaalplasmonnanodraadlasers met V-groefholten
- Analoge/RF-prestaties van T-Shape Gate Dual-Source Tunnel Field-Effect Transistor



