Analoge/RF-prestaties van T-Shape Gate Dual-Source Tunnel Field-Effect Transistor
Abstract
In dit artikel wordt een op silicium gebaseerde T-shape gate dual-source tunnel-veldeffecttransistor (TGTFET) voorgesteld en onderzocht door TCAD-simulatie. Als contrastieve studie worden de structuur, karakteristieken en analoge/RF-prestaties van TGTFET, LTFET en UTFET besproken. De poortoverlapping die wordt geïntroduceerd door de T-vormige poort kan de efficiëntie van de tunnelovergang verbeteren. De dual-source regio's in TGTFET kunnen de stroom in de staat verhogen (I AAN ) door een verdubbeld knooppuntgebied voor tunnels aan te bieden. Om de prestaties van het apparaat verder te verbeteren, is de n+ pocket geïntroduceerd in TGTFET om de band-naar-band tunneling-snelheid verder te verhogen. Simulatieresultaten laten zien dat de I . van de TGTFET AAN en schakelverhouding (I AAN /Ik UIT ) bereik 81 μA/μm en 6,7 × 10 10 bij 1 V poort naar bronspanning (V g ). De gemiddelde swing onder de drempel van TGTFET (SSavg , van 0 tot 0,5 V V g ) 51,5 mV/dec bereikt en de minimale subdrempelschommeling van TGTFET (SSmin , bij 0,1 V V g ) bereikt 24,4 mV/dec. Bovendien is gevonden dat TGTFET een sterke robuustheid heeft op het drain-geïnduceerde barrièreverlagende (DIBL) effect. De effecten van dopingconcentratie, geometrische afmetingen en aangelegde spanning op de prestaties van het apparaat worden onderzocht om de TGTFET-ontwerprichtlijn te creëren. Verder is de transconductantie (g m ), uitgangsgeleiding (g ds ), poort naar broncapaciteit (C gs ), poort naar afvoercapaciteit (C gd ), afsnijfrequentie (f T ), en winstbandbreedte (GBW) van TGTFET bereiken 232 μS/μm, 214 μS/μm, 0,7 fF/μm, 3,7 fF/μm, 11,9 GHz en 2,3 GHz bij 0,5 V afvoer naar bronspanning (V d ), respectievelijk. Door te profiteren van het structurele voordeel, verkrijgt TGTFET betere DC/AC-kenmerken in vergelijking met UTFET en LTFET. Samenvattend, de aanzienlijk goede prestaties zorgen ervoor dat TGTFET een zeer aantrekkelijke keuze wordt voor de volgende generatie low-power en analoge/RF-toepassingen.
Achtergrond
De verkleining van metaaloxide-halfgeleider-veldeffecttransistoren (MOSFET's) zorgt voor een aanzienlijke verbetering van het stroomverbruik van de geïntegreerde schakeling (IC), de schakelkarakteristiek, de circuitfunctie en de IC-dichtheid [1, 2]. Maar de onverzoenlijke tegenstelling tussen de schaalvergroting van de voedingsspanning en de reductie van de lekstromen in de off-state (I UIT ) zal uiteindelijk resulteren in het onaanvaardbaar hoge stroomverbruik [3]. Tegelijkertijd wordt de achteruitgang van de betrouwbaarheid veroorzaakt door korte-kanaaleffecten (SCE's) steeds ernstiger [4, 5]. Om deze problemen aan te pakken, is het geldig om subthreshold swing (SS) en voedingsspanning van de apparaten te verminderen. Op basis van het band-naar-band tunnelmechanisme bereiken tunnel-veldeffecttransistoren (TFET's) de subthreshold swing (SS) kleiner dan 60 mV/dec en kunnen ze de voedingsspanning effectief verlagen [6,7,8,9,10] . Bovendien heeft TFET, vanwege het bestaan van de tunnelovergang nabij de bron, gewoonlijk een kleine poort-naar-broncapaciteit (C gs ) [1, 11] wat gunstig is voor de frequentieprestaties van het apparaat.
Recente studies tonen aan dat TFET een veelbelovende kandidaat lijkt te zijn voor toekomstige toepassingen met laag vermogen [12,13,14,15,16] en analoge/RF-toepassingen [17,18,19]. Vanwege het kleine effectieve tunnelgebied wordt de beperkte tunnelstroom echter een inherent nadeel van conventionele P-I-N TFET, wat leidt tot een lage bedrijfsstroom (I) AAN ). Om de TFET-prestaties te verbeteren, zijn de afgelopen jaren veel nieuwe structuren voorgesteld [20,21,22,23,24,25]. Gebruikmakend van de verzonken poort, zijn L-vormige tunnelveldeffecttransistor (LTFET) [23, 24] en U-vormige tunnelveldeffecttransistor (UTFET) [25] voorgesteld om hoge I AAN met een compacte apparaatstructuur. Er is echter nog veel ruimte voor verbetering in LTFET en UTFET en er moet meer moeite worden gedaan om de analoge/RF-prestaties van deze apparaten te bestuderen.
In dit artikel wordt een T-vormige poort dual-source tunnel-veldeffecttransistor (TGTFET) met dubbele bron naar voren gebracht en bestudeerd door TCAD-simulatie. De ontworpen TGTFET kan het knooppuntgebied voor tunnels verdubbelen in vergelijking met LTFET en UTFET. De poortoverlapping die wordt geïntroduceerd door de ontworpen T-vormige poort kan de band-naar-band-tunnelingsnelheid (BBT-snelheid) verbeteren. De simulatieresultaten laten zien dat de voorgestelde TGTFET een hogere I . krijgt AAN (8.1 × 10 − 5 A/μm om V d = 1 V) dan de LTFET en UTFET onder dezelfde voorwaarde. Beide SSmin (bij V g = 0.1 V) en de SSgem (0~0,5 V V g ) van TGTFET lager zijn dan 60 mV/dec (respectievelijk 24,4 mV/dec en 51,5 mV/dec). TGTFET krijgt betere input/output-karakteristiek (g m = 232 μS/μm, g ds = 214 μS/μm) dan de UTFET en LTFET. Bovendien worden de capaciteitskenmerken van TGTFET, UTFET en LTFET in detail besproken. Ten slotte krijgt TGTFET betere analoge/RF-prestaties (f T = 11,9 GHz en GBW =2,3 GHz) vergeleken met UTFET en LTFET. Als resultaat kan TGTFET met aanzienlijk goede prestaties worden verkregen. De structuren van dit document zijn als volgt:de sectie "Methoden" bevat de beschrijving van de structuur en de parameters van TGTFET, LTFET [23, 24] en UTFET [25] ] evenals de TCAD-simulatiemethoden. De sectie "Resultaten en discussie" bevat de beschrijving van de simulatieresultaten. In deze sectie worden het mechanisme, de karakteristieken en de analoge/RF-prestaties van TGTFET bestudeerd en vergeleken met de LTFET en UTFET. De invloed van de apparaatparameters op TGTFET wordt ook in detail geanalyseerd. De sectie “Conclusies” geeft een conclusie van dit artikel.
Methoden
De structuur van T-vormige poort dual-source tunnel-veldeffecttransistor (TGTFET) wordt geïllustreerd in figuur 1. De vorm van de poort is vergelijkbaar met de alfabetletter "T" (groen gebied). De dual-source regio's bevinden zich aan twee zijden van de poort (saffier regio's). Twee n+-pockets (gele gebieden) worden ingevoegd om de kanaaltunnelingsnelheid te verhogen [20,21,22]. De n+ drain wordt in de bodem van de goot geplaatst. Daarom overlapt de T-vormige poort de n+ holtes in zowel de verticale als de laterale richting. Op deze manier kan het elektrische veld aan de bovenkant van de tunnelovergang worden vergroot. De elektrische veldversterking zorgt ervoor dat de energieband steiler buigt. Ten slotte wordt de snelheid van elektronentunneling verbeterd door de hoekversterking van het elektrisch veld [26].
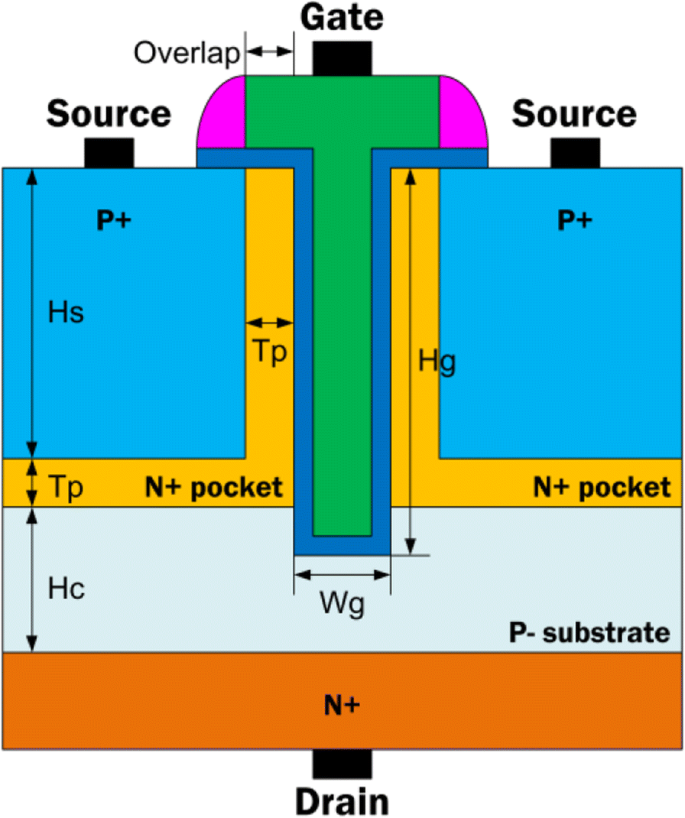
Schema van de voorgestelde T-vormige poort dual-source tunnel-veldeffecttransistor (TGTFET)
Afbeelding 2 toont de apparaatstructuur van LTFET [23, 24], UTFET [25] en TGTFET. De poortoverlap kan helpen om de tunnelefficiëntie van TGTFET te verbeteren. De dual-source regio's in TGTFET kunnen het gebied van de tunneling junction verdubbelen in vergelijking met LTFET en UTFET.
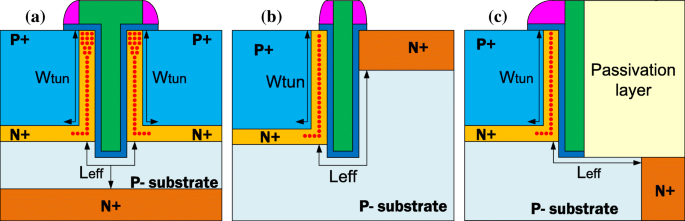
Vergelijking van a de voorgestelde TGTFET, b UTFET en c LTFET
De parameters van op silicium gebaseerde TGTFET, UTFET en LTFET die in simulaties worden gebruikt, zijn als volgt:Hs =30 nm (hoogte van het brongebied), Hg =40 nm (hoogte van de verzonken poort), Wg =6 nm (breedte van de poortgebied), Hc =15 nm (hoogte van het kanaalgebied), Tp =5 nm (dikte van de n+ pocket), ϕ = 4. 33 eV (poortwerkfunctie), Tox =2 nm (dikte van de HfO2 poortdiëlektricum), N S = 1 × 10 20 cm −3 (p+ bron dopingconcentratie), N D = 1 × 10 19 cm −3 (n+ dopingconcentratie), N sub = 1 × 10 17 cm −3 (p− substraat doteringsconcentratie), en N P = 5 × 10 18 cm −3 (n+ pocket dopingconcentratie). De breedtecoëfficiënt in simulatie is standaard 1 μm.
Simulaties van TGTFET, UTFET en LTFET worden uitgevoerd in Silvaco Atlas TCAD-tools. In deze simulatie wordt een niet-lokaal BTBT-model geïntroduceerd om rekening te houden met de ruimtelijke variatie in de energieband, wat kan helpen om de nauwkeurigheid van het BTBT-tunnelproces te vergemakkelijken. Het Lombardi-mobiliteitsmodel wordt geacht de kanaalmobiliteit nauwkeuriger te maken (door rekening te houden met de oppervlakteverstrooiing inclusief het transversale veld en de dopingconcentratie). Er wordt rekening gehouden met Fermi-statistieken en het bandgapverkleiningsmodel om te passen bij het effect van de sterk gedoteerde regio's. In dit artikel wordt ook rekening gehouden met het Shockley-Read-Hall-recombinatiemodel.
Resultaten en discussie
Apparaatmechanisme en DC-kenmerken met verschillende parameters
Figuur 3a toont de overdrachtskenmerken van de TGTFET met en zonder de poortoverlapping. Met de extra poortoverlap, de I AAN neemt toe van 7,5 × 10 −5 tot 8.1 × 10 −5 A/μ m bij V g = V d = 1 V. Figuur 3b toont de overdrachtskarakteristieken van TGTFET, UTFET en LTFET. Om de vergelijking nauwkeuriger te maken, zijn de simulatiemodellen en geometrische afmetingen van deze drie apparaten identiek ingesteld. Als gevolg hiervan heeft de TGTFET een ongeveer tweevoudige toename van I AAN vergeleken met LTFET en UTFET, zoals weergegeven in figuur 3b. SSmin van TGTFET is 24,4 mV/dec bij V g = 0.1 V, en SSgem is 51,5 mV/dec wanneer 0 V < V g < 0,5 V. De schakelverhoudingen (I AAN /Ik UIT ) zijn 6,7 × 10 10 bij V g = V d = 1 V en 6.5 × 10 8 bij V g = V d = 0,5 V.
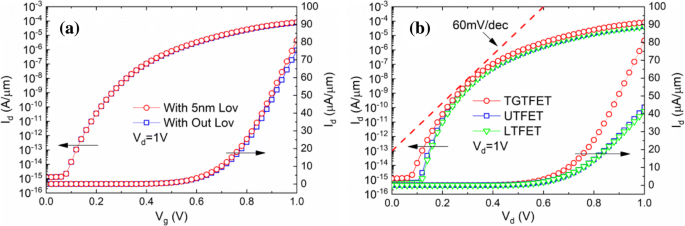
Gesimuleerd a overdrachtskenmerken van TGTFET met/zonder poortoverlapping en b overdrachtskenmerken van TGTFET, UTFET en LTFET
Afbeelding 4a, b toont de BBT-snelheid van TGTFET met en zonder een poortoverlapping van 5 nm. Uit figuur 4c kunnen we duidelijk zien dat het apparaat met een poortoverlap van 5 nm een groter elektronentunnelgebied onder het apparaatoppervlak heeft, wat kan leiden tot de I AAN toenemen.
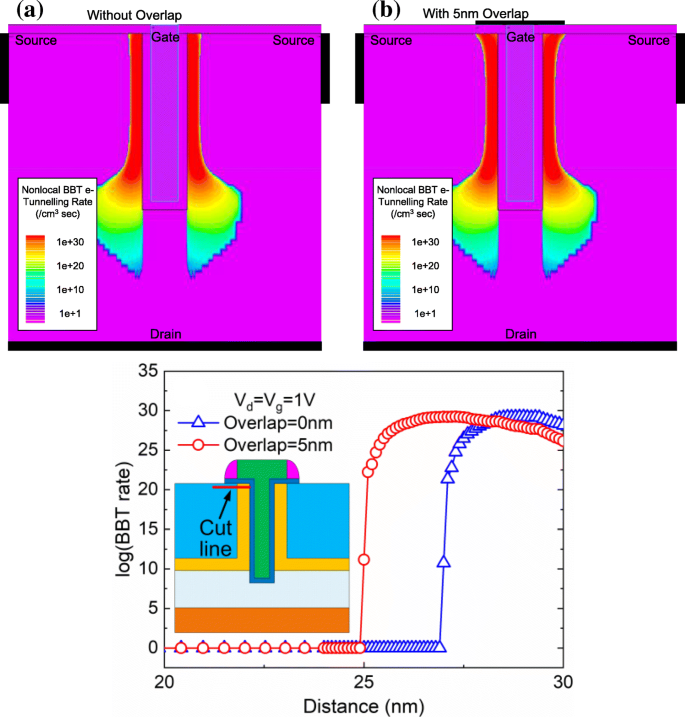
Gesimuleerde BBT-elektronentunneling-snelheidsdiagrammen van a apparaat zonder poortoverlapping, b apparaat met poortoverlapping van 5 nm, en c de BBT-elektronentunnelingsnelheid van twee apparaten, op 1 nm onder het apparaatoppervlak; V g = V d = 1 V
Figuur 5a, b toont het 3D-diagram van elektrische velden van TGTFET met en zonder poortoverlapping. Twee elektrische veldpieken verschijnen in TGTFET met een poortoverlap van 5 nm, zoals weergegeven in de gestippelde cirkel in figuur 5a. Er verschijnt geen elektrische veldpiek in figuur 5b die wordt toegeschreven aan de afwezigheid van de poortoverlap. Afbeelding 5c toont de energiebandstructuur onder het oppervlak van het apparaat. De inzet in Fig. 5c toont de locatie van de snijlijn. Met de poortoverlapping kan een groter tunnelvenster worden verkregen. Dus een hoger BBT-percentage en I AAN kan worden bereikt.
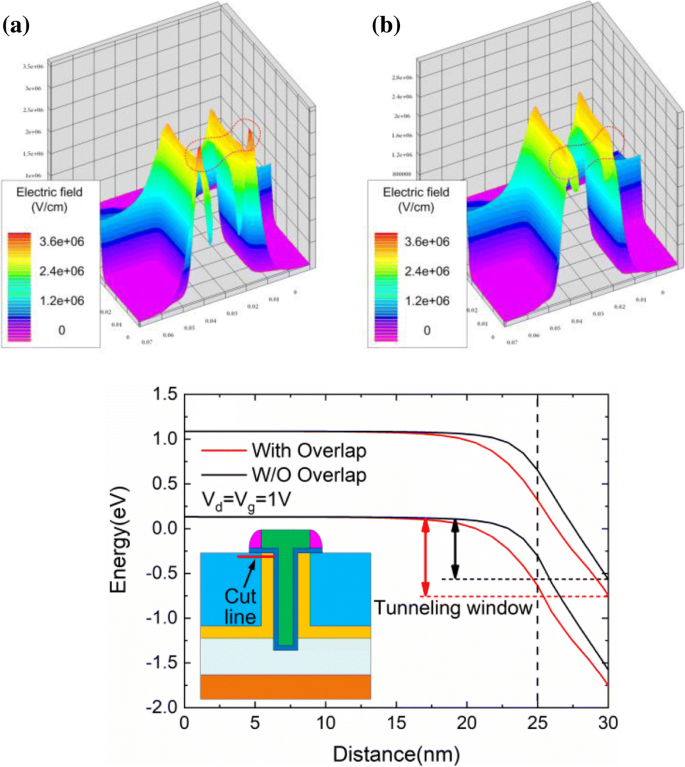
3D schematisch diagram van elektrische velden van het apparaat a met overlap en b zonder overlap; gesimuleerde c energiebanddiagrammen van bron tot zakgebied (1 nm onder de oxide-interface)
Afbeelding 6 toont de effecten van n+ pocket op de prestaties van de TGTFET. De ik UIT neemt snel toe met de toename van de n+ pocket-dopingconcentratie, zoals weergegeven in figuur 6a. De lagere SS en grotere I AAN kan worden verkregen door de dikte van n+ pocket (Tp) te verminderen van 7 naar 3 nm wanneer N P = 5 × 10 18 cm −3 , zoals weergegeven in Fig. 6b. Tegelijkertijd wordt in figuur 6b geen significante subdrempelstroom opgemerkt. Uit Fig. 6a kan worden bevestigd dat een relatief lage doteringsconcentratie van n+ pocket zal helpen om de subdrempelstroom te onderdrukken.
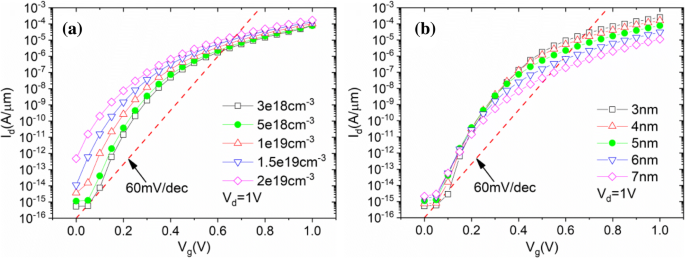
Gesimuleerde afvoerstromen met verschillende n+ pocket a concentraties en b diktes bij V d = 1 V
De impact van de poorthoogte (Hg) en kanaaldikte (Hc) wordt afzonderlijk weergegeven in Fig. 7a, b. Een kleine ik AAN en SS-verbetering verschijnt wanneer Hg toeneemt. Omdat wanneer Hg = 35 nm, er een duidelijke energiebandbult is op het stroompad in de toestand, wat een zeker obstakel wordt voor de gelukkige elektronen (elektronen die de tunnelovergang zijn gepasseerd), zoals weergegeven in figuur 7c, wat kan resulteren in Ik aan verminderen. Wanneer Hg toeneemt, wordt de energieband bult verzwakt, waardoor de I AAN en SS-verbetering. Een lichte ik AAN verbetering wordt verkregen bij afnemende Hc, zoals weergegeven in figuur 7b. Er kan echter ernstige degradatie van de subdrempelkarakteristiek worden waargenomen wanneer Hc daalt tot 5 nm. Dit kan worden verklaard door de toenemende tunnelstroom onder de drempel in de hoek van de n+-pocket, zoals weergegeven in figuur 8. Figuur 8a toont het voor de hand liggende off-state band-naar-band tunneling-fenomeen wanneer Hc = 5 nm terwijl figuur 8b laat zien de ik UIT stroomdichtheid wanneer Hc = 5 nm.

Gesimuleerde overdrachtskenmerken van TGTFET met a verschillende Hg, b verschillende Hc en c de geleidingsbandbult op het huidige pad
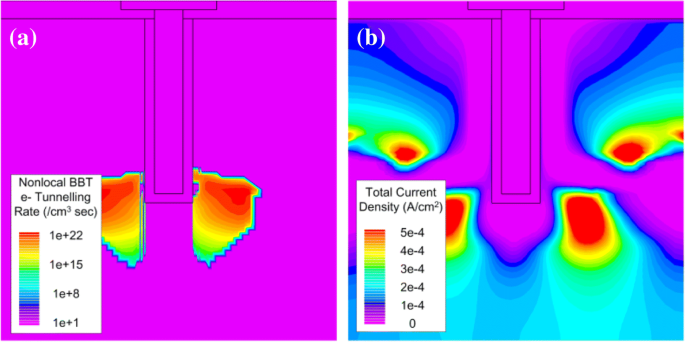
Gesimuleerde diagrammen van off-state a BTBT-elektronentunnelingsnelheid en b stroomdichtheid wanneer Hc = 5 nm
Zoals getoond in Fig. 9, is de invloed van afvoer naar bronspanning (V d ) wordt in dit document ook in aanmerking genomen. Voor V d < 0.6 V, I AAN neemt duidelijk toe met de toenemende V d , zoals weergegeven in Fig. 9a. Dit wordt verklaard door het feit dat het potentieel van het p-kanaal langzaam groeit als reactie op de toenemende V d en resulteert in de afnemende weerstand van p-kanaal. Voor V d> 1.8 V, weergegeven in Fig. 9b, de I AAN neemt bijna niet toe met toenemende V d , maar ik UIT neemt aanzienlijk toe. Dit komt doordat de tunnelstroom onder de drempel in de hoek van de n+ pocket snel toeneemt met de toenemende V d . Ten slotte, voor 0,6 V < V d < 1.8 V, TGTFET vertoont goede en stabiele prestaties. Als gevolg hiervan is TGTFET robuust tegen drain-geïnduceerde barrièreverlaging (DIBL) en vertoont het goede en stabiele prestaties in een groter dynamisch spanningsbereik.

Gesimuleerde afvoerstromen voor a V d ≤ 1 V en b V d ≥ 1 V
Analoge/RF-prestaties van TGTFET, UTFET en LTFET
Afbeelding 10 toont de overdrachtskenmerken en transconductantiecurves van TGTFET, UTFET en LTFET bij V d = 0,5 V. De transconductantie (g m ) kan worden verkregen uit de eerste afgeleide van de overdrachtskarakteristiek, zoals weergegeven in Vgl. (1) [27,28,29]:
$$ {g}_{\mathrm{m}}={dI}_{\mathrm{d}s}/{dV}_{\mathrm{gs}} $$ (1)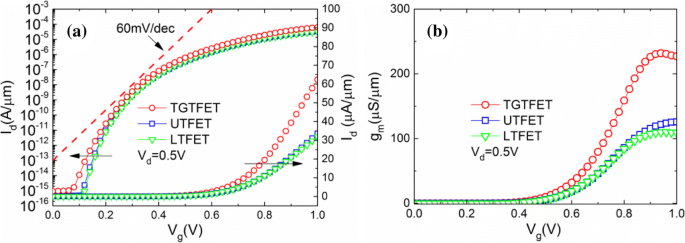
een Overdrachtskenmerken en b transconductantiecurves van TGTFET, UTFET en LTFET bij V d = 0,5 V
Als gevolg hiervan is de maximale transconductantie van TGTFET (232 S/μm) ongeveer twee keer groter dan die van UTFET (120 μS/μm) en LTFET (110 μS/μm), zoals weergegeven in figuur 10. Dit is gunstig voor de huidige versterking die wordt bijgedragen door overlapping van dubbele bron en poort.
Afbeelding 11 toont de uitgangskarakteristieken, uitgangsgeleiding (g ds ), en uitgangsimpedantie (R o ) curven van de TGTFET, UTFET en LTFET. Zoals weergegeven in Afb. 11a, is duidelijk te zien dat de uitgangsstroom van het apparaat toeneemt met de toename van V d , maar wanneer V d boven 0,6 V bereikt, heeft de uitgangsstroom de neiging te verzadigen. Door observatie is het gemakkelijk te vinden dat de uitgangsstroom van TGTFET twee keer groter is dan die van UTFET en LTFET. Afbeelding 11b toont de uitgangsgeleiding (g ds ) en uitgangsimpedantie (R o ) curven van de TGTFET, UTFET en LTFET. De g ds kan worden verkregen door de afleiding van de uitgangsstroom, zoals weergegeven in Vgl. (2) [27, 29] terwijl R o kan worden uitgedrukt als het omgekeerde van de uitgangsgeleiding.
$$ {g}_{\mathrm{ds}}={dI}_{\mathrm{ds}}/{dV}_{\mathrm{ds}} $$ (2)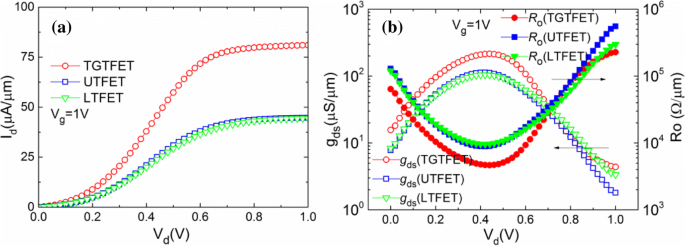
een Uitgangskenmerken, b uitgangsgeleiding (g ds ), en c uitgangsimpedantie (R o ) curven van de TGTFET, UTFET en LTFET
Vanwege de voordelen op uitgangsstroom krijgt TGTFET de hoogste g ds en de minimale R o van deze drie apparaten. Onder 1-V gate bias-conditie verkreeg TGTFET de maximale g ds van 214 μS/μm en de minimale R o van 4,6 kΩ/μm onder 0,45 V V d . Onder dezelfde gate-biasconditie behaalden UTFET en LTFET de maximale g ds van 113 μS/μm en 105 μS/μm en de minimale R o van 9,0 kΩ/μm en 9,6 kΩ/μm onder 0,4 V V d .
Bovendien is het in figuur 11 niet moeilijk om erachter te komen dat het lineaire gebied van de uitgangskarakteristieken van het apparaat een zekere niet-lineariteit vertoont. Zoals weergegeven in Afb. 11a, R o neemt eerst af en neemt dan toe met de toenemende V d . Sommige onderzoeksgroepen geven het bijbehorende fysieke proces over dit fenomeen [7, 30], maar er zijn nog steeds enkele problemen die niet duidelijk zijn uitgelegd. Zoals we weten, R o wordt bepaald door de weerstand van het kanaalgebied en de tunnelovergang. Wanneer V d < 0,4 V, R o neemt af met toenemende V d . Overweeg de volgende situaties, wanneer V d = 0 V en V g =-1 V, geen van de gelukkige elektronen kan naar de afvoerzijde worden geveegd en bijna alle elektronen worden in het kanaalgebied gevangen door een relatief hoge afvoerbarrière, zoals weergegeven in het rode stippellijnframe in Fig. 12a, b. Wanneer 0 V < V d < 0,4 V, met toenemende V d , wordt de afvoerbarrière zwakker (zoals weergegeven in Fig. 12b). De elektronen die in het kanaalgebied zijn gevangen, kunnen dus door de afvoerbarrière gaan en vervolgens door afvoer worden verzameld. Dit is een thermisch excitatieproces van elektronen van kanaal naar afvoer. Ten slotte, aangezien het tunnelknooppunt volledig is ingeschakeld (wanneer V g =-1 V), is de tunnelstroom altijd in een staat van overmaat en kan de weerstand die wordt geïntroduceerd door de tunnelovergang worden genegeerd. Op dit moment, R o wordt bepaald door de kanaalweerstand en R o wordt bepaald door het elektron thermische excitatieproces over de afvoerbarrière. Dus, R o neemt af met toenemende V d . Wanneer V d> 0,6 V, deze drie apparaten komen geleidelijk in het verzadigingsgebied en R o groter wordt. Dit komt omdat wanneer V d groot is, worden bijna alle elektronen door de tunnelovergang naar de afvoerzijde geveegd door het relatief hoge elektrische veld. De tunnelstroom wordt de limiet van de afvoerstroom. In deze toestand, R o wordt voornamelijk bepaald door het tunnelknooppunt. De tunnelefficiëntie kan echter niet significant toenemen terwijl V d neemt toe. V d heeft een klein effect op de energiebandstructuur van de tunnelovergang (n+ pocketzijde), zoals weergegeven in figuur 12b. Als gevolg hiervan kan de tunnelstroom niet duidelijk toenemen en is er bijna geen I AAN toenemen met de voortdurend toenemende V d (wanneer V d> 0,6 V), wat betekent dat een impedantie toeneemt. Bovendien, wanneer 0,4 V < V d < 0.6 V, R o wordt bepaald door zowel de kanaalweerstand als de tunnelovergang.
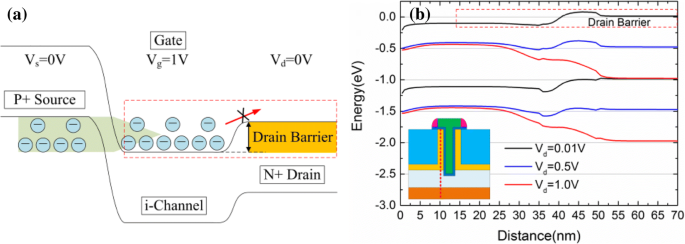
een Schematisch diagram van de energieband bij V d = 0 V en V g = 1 V. b Simulatieresultaten van het energiebanddiagram bij verschillende vooroordelen van V d
Uit de bovenstaande analyse kan worden afgeleid dat de R o van TFET wordt beïnvloed door zowel het tunnelingproces als het kanaalelektron thermische excitatieproces. De belangrijkste fysieke mechanismen kunnen R dominate domineren o schakelt met V d variatie. Eindelijk, de R o neemt eerst af en neemt vervolgens toe, waardoor de niet-lineariteit van de uitgangskarakteristieken wordt veroorzaakt. Overigens is het door de observatie van figuur 11b gemakkelijk te vinden dat de uitgangsimpedantie van TGTFET veel kleiner is dan die van de UTFET en LTFET. Dit komt door de betere tunneling-efficiëntie van de dual-source en de laterale gate-overlapstructuur van TGTFET.
Afbeelding 13 toont de energiebandstructuur van TGTFET, UTFET en LTFET met verschillende toegepaste spanningen. De rode stippellijnen in de inzet vertegenwoordigen de positie om de energieband te tekenen (die 15 nm onder het oppervlak is, net op de halve hoogte van het brongebied). Het is te zien dat met een V d toename van 0,1 naar 0,5 V, de bandstructuur van TGTFET, UTFET en LTFET heeft een duidelijke trend van buigen. Dit komt omdat de afvoerspanning de elektrische potentiaal van de tunnelovergang nabij de afvoerzijde naar beneden kan trekken. Dit geeft aan dat voor TGTFET, UTFET en LTFET de toename van V d van 0,1 tot 0,5 V is gunstig voor de efficiëntie van tunnels. Echter, wanneer V d> 0,5 V, de verandering van de energieband met V d verhoging is niet het vermelden waard. Dit komt overeen met de analyseresultaten in figuur 12b.
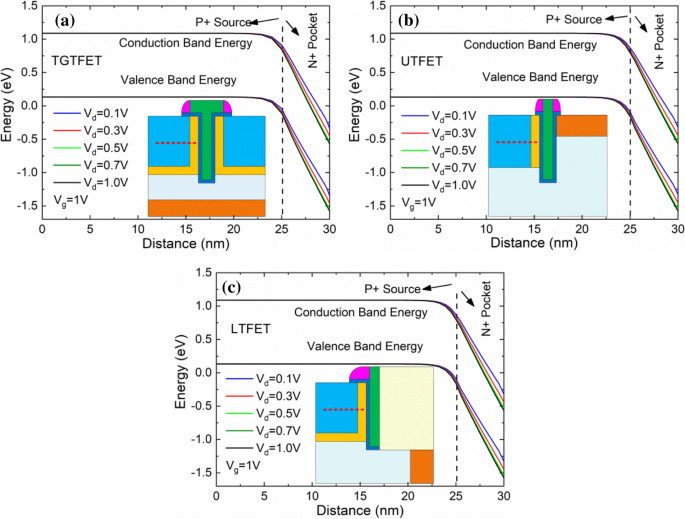
De energiebandstructuur van a TGTFET, b UTFET en c LTFET op V g = 1
Zoals we weten, is de poortcapaciteit (C gg ) van het apparaat kan de frequentiekarakteristieken van de geïntegreerde schakelingen sterk beïnvloeden. Voor TGTFET, UTFET en LTFET, C gg bestaat over het algemeen uit C gs (capaciteit van poort naar bron) en C gd (poort om capaciteit af te voeren). Daarom is het kenmerk van C gg , C gs , en C gd is van groot belang om de frequentiekarakteristieken en het analoge toepassingsvermogen van apparaten te evalueren. Vooral voor TFET zijn de capaciteitskenmerken behoorlijk anders dan die van MOSFET. Vanwege het bestaan van de tunneling junction in het brongebied, heeft TFET meestal een kleine C gs [1, 11]. Daarom is de C gg van TFET wordt voornamelijk bepaald door C gd . Afbeelding 14 toont de capaciteit van TGTFET, UTFET en LTFET versus V g onder V d = 0,5 V en V d = 0 V, afzonderlijk.

Capaciteit van TGTFET versus V g onder a V d = 0 V en b V d = 0,5 V. Capaciteit van UTFET versus V g onder c V d = 0 V en d V d = 0,5 V. Capaciteit van LTFET versus V g onder e V d = 0 V en f V d = 0,5 V
Door de waarneming van Fig. 14a, b, is het gemakkelijk te vinden dat de C gs van TGTFET onder 1-V poortspanning is 0,15 fF/μm bij V d = 0 V en 0,7 fF/μm bij V d = 0,5 V, wat veel kleiner is dan die van de C gd (5,8 fF/μm bij V d = 0 V en 3,7 fF/μm bij V d = 0,5 V). Dus de C gg van TGTFET wordt voornamelijk bepaald door C gd . Wanneer V d = 0 V, C gg en C gd snel toenemen met de toenemende V g , zoals weergegeven in Fig. 14a. Dit komt omdat met de toename van V g , worden elektronen geaggregeerd naar de poortinterface in het apparaatkanaal, waardoor de capaciteit snel stijgt. Wanneer V d = 0,5 V, C gd neemt duidelijk niet toe tot V g wordt verhoogd tot meer dan 0,6 V, zoals weergegeven in Fig. 14b. Dit komt omdat wanneer V g laag is, kunnen slechts enkele gelukkige elektronen door de tunnelovergang gaan en het kanaal in gaan. Sommige van deze gelukkige elektronen zullen deelnemen aan het recombinatieproces en de meeste andere zullen snel worden verzameld door de afvoer vanwege de afvoerspanning van 0,5 V. Daarom is het erg moeilijk voor deze gelukkige elektronen om in het apparaatkanaal te blijven. Met de V g toenemen, neemt het aantal gelukkige elektronen snel toe. Op dit moment kan noch van de afvoerverzameling, noch van het elektron-gat-recombinatieproces deze gelukkige elektronen snel uitputten. Zo neemt de elektronenconcentratie in het kanaal toe en neemt de capaciteit snel toe. Als gevolg hiervan heeft de capaciteitskarakteristiek de neiging om naar rechts te verschuiven terwijl V d neemt toe, zoals weergegeven in Fig. 14a, b. De bovenstaande analyse en verschijnselen zijn ook van toepassing op UTFET en LTFET, zoals weergegeven in figuur 14c-f. Bovendien is de poortcapaciteit van UTFET bij 0 V en 0,5 V V d bereikte respectievelijk 6,2 fF/μm en 5,1 fF/μm, en die van de LTFET bereikte respectievelijk 3,4 fF/μm en 2,7 fF/μm.
Aangezien er geen directe overlap is tussen de gate en de drain van de LTFET, en de afstand tussen de gate en de drain relatief groot is, heeft LTFET de beste capaciteitskenmerken en de kleinste C gg . Daarentegen is er een directe overlap tussen de gate en de drain van de UTFET. Daarom worden elektronen nabij de afvoerzijde gemakkelijker gecontroleerd door de poort, wat resulteert in een grote C gg van UTFET. Voor TGTFET, hoewel de afstand tussen de poort en de afvoer klein is, is er een licht gedoteerd kanaalgebied dat de poort en de afvoer kan isoleren. De capaciteit van TGTFET is dus beter dan die van UTFET, maar iets inferieur aan LTFET. Afbeelding 15 toont de C gd kenmerken van TGTFET, UTFET en LTFET versus V d onder verschillende V g . Uit de waarneming van Fig. 15a–v is het niet moeilijk te vinden dat de C gd kenmerken van deze drie apparaten zijn vergelijkbaar. Dat wil zeggen, voor een vaste V g , C gd neemt af met de toename van de V d . Aan de andere kant, voor een vaste V d , C gd neemt toe met de toename van V g .

C gd kenmerken van a TGTFET, b UTFET en c LTFET versus V d onder verschillende V g
Zoals we weten, zijn zowel de afsnijfrequentie (f T ) en versterkingsbandbreedte (GBW) zijn de evaluatiecriteria voor het evalueren van de frequentiekarakteristieken van apparaten. f T hangt af van de verhouding van g m naar C gg , zoals getoond in Vgl. (3) [30, 31]. Voor een bepaalde DC-versterking die gelijk is aan 10, kan GBW worden uitgedrukt door de verhouding van g m naar C gd , zoals getoond in Vgl. (4) [17]:
$$ {f}_T=\frac{g_{\mathrm{m}}}{2\pi {C}_{\mathrm{gs}}\sqrt{1+2{C}_{\mathrm{gd} }/{C}_{\mathrm{gs}}}}\circa \frac{g_{\mathrm{m}}}{2\pi \left({C}_{\mathrm{gs}}+{C }_{\mathrm{gd}}\right)}=\frac{g_{\mathrm{m}}}{2\pi {C}_{\mathrm{gg}}} $$ (3) $$ \ mathrm{GWB}={g}_{\mathrm{m}}/2\pi 10{C}_{\mathrm{gd}} $$ (4)Afbeelding 16 toont de karakteristieken van de f T en GBW van TGTFET, UTFET en LTFET. Door te profiteren van structurele voordelen, zoals dubbele bron- en laterale poortoverlapping, geïntroduceerd door de T-vormige poort, verkrijgt TGTFET de meest opmerkelijke frequentiekarakteristieken in vergelijking met UTFET en LTFET. Onder de voorwaarde van V d = 0,5 V, de f T en GBW van TGTFET bereikten de maximale waarden van respectievelijk 11,9 GHz en 2,3 GHz. Dankzij de grote afstand tussen poort en afvoer en zonder overlap tussen poort en afvoer, krijgt LTFET een kleine C gg en goede frequentiekarakteristieken. De f T en GBW aan LTFET bereiken afzonderlijk de 8,7 GHz en 2,1 GHz. De capaciteitskenmerken van UTFET zijn inferieur in vergelijking met die van TGTFET en LTFET. Dit komt doordat de directe poort/afvoer overlapt. Als gevolg hiervan is de maximale waarde van f T and GBW of UTFET can only reach 4.1 GHz and 0.5 GHz separately.
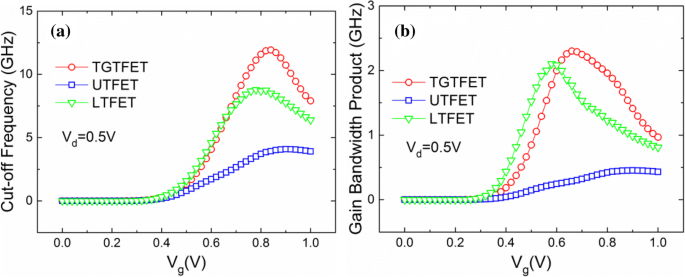
The characteristic curves of a f T en b GBW of TGTFET, UTFET, and LTFET versus V g at V d = 0.5 V
Conclusies
In this paper, a T-shape gate dual-source tunnel field-effect transistor (TGTFET) with good performance is proposed and investigated. The structure, mechanism, and the influence of device parameter on the characteristic of TGTFET are discussed. In addition, the characteristics of TGTFET, UTFET, and LTFET are discussed and compared in this paper. The dual-source regions are introduced to double the area of the tunneling junction. The gate overlap and the n+ pockets can obviously enhance the tunneling efficiency of the tunneling junction in TGTFET. Finally, the TGTFET with impressive characteristics (I ON = 8.1 × 10 −5 A/μm, I ON /Ik OFF = 6.7 × 10 10 and SSmin = 24.4 mV/dec) is obtained. At the same time, TGTFET is robust to DIBL, which means TGTFET can exhibit a good and stable performance in a larger applied voltage dynamic range. Furthermore, the analog/RF performance of TGTFET is studied and compared with UTFET and LTFET. The key parameter such as input/output characteristics, capacitance characteristics, GBW, and f T are analyzed. Benefiting from the no direct overlap between the gate and drain, TGTFET obtains a relatively small C gd en C gg . Finally, TGTFET with remarkable frequency characteristics (f T = 11.9 GHz and GBW = 2.3 GHz) is obtained. As a conclusion, it is expected that TGTFET can be one of the promising alternatives for the next generation of device in low-power and analog/RF applications.
Afkortingen
- C gd :
-
Gate to drain capacitance
- C gs :
-
Gate to source capacitance
- f T :
-
Cut-off frequency
- GBW:
-
Gain bandwidth
- g ds :
-
Output conductance
- g m :
-
Transconductance
- Hc:
-
Height of the channel layer
- Hg:
-
Height of the gate electrode
- Hs:
-
Height of the source layer
- LTFET:
-
L-shape gate tunnel field-effect transistor
- N D :
-
Doping concentration of n+ drain
- N P :
-
Doping concentration of n+ pocket
- N S :
-
Doping concentration of p+ source
- N sub :
-
Doping concentration of p− substrate
- R o :
-
Output impedance
- TGTFET:
-
T-shape gate dual-source tunnel field-effect transistor
- Tox:
-
Thickness of the HfO2 gate dielectric
- Tp:
-
Thickness of n+ pocket
- UTFET:
-
U-shape gate tunnel field-effect transistor
- V d :
-
Drain to source voltage
- V g :
-
Gate to source voltage
- Wg:
-
Width of the gate electrode
Nanomaterialen
- Transistors, junction field-effect (JFET)
- Transistors, Insulated-gate Field-effect (IGFET of MOSFET)
- Junction Field-effect Transistors
- Insulated-gate Field-effect Transistors (MOSFET)
- De Junction Field-effect Transistor (JFET) als switch
- Tunnel
- 's Werelds eerste ultrasnelle volledig optische kamertemperatuurtransistor
- Zichtbare, door licht aangedreven fotokatalytische prestaties van N-gedoteerde ZnO/g-C3N4-nanocomposieten
- Voorbereiding en fotokatalytische prestaties van LiNb3O8-fotokatalysatoren met holle structuur
- Een nieuwe Bi4Ti3O12/Ag3PO4 heterojunctie-fotokatalysator met verbeterde fotokatalytische prestaties
- Grafeen-gebaseerde nanoschaal vacuümkanaaltransistor



