Een onderzoek naar het effect van de structurele parameters en het interne mechanisme van een bilaterale poortgestuurde S/D-symmetrische en verwisselbare bidirectionele tunnelveldeffecttransistor
Abstract
In dit artikel wordt een bilaterale poortgestuurde S/D-symmetrische en uitwisselbare bidirectionele tunnelveldeffecttransistor (B-TFET) voorgesteld, die het voordeel laat zien van bidirectionele schakelkarakteristieken en compatibiliteit met CMOS-geïntegreerde schakelingen in vergelijking met de conventionele asymmetrische TFET. De effecten van de structurele parameters, bijvoorbeeld de dopingconcentraties van de N + regio en P + regio, lengte van de N + regio en lengte van de intrinsieke regio, op de apparaatprestaties, bijv. de overdrachtskenmerken, I aan –Ik uit ratio en subthreshold swing, en het interne mechanisme worden in detail besproken en uitgelegd.
Inleiding
Stroomverbruik is een van de belangrijkste problemen van de industrie voor geïntegreerde schakelingen. Als een apparaat in de aan-status werkt, moet de geleidingsstroom een bepaalde kritische waarde bereiken; wanneer de stroom een kritische waarde bereikt, wordt de overeenkomstige poortspanning gedefinieerd als de drempelspanning. Wanneer het apparaat in de uit-stand staat, moet de bijbehorende poortspanning een andere waarde hebben dan die in de kritieke aan-stand, die vaak de uit-stand-spanning wordt genoemd. Het concept van subthreshold swing (SS) is van toepassing op het apparaat dat werkt tussen de uit-toestand en de kritieke aan-toestand, wat gelijk is aan de verandering in poortspanning wanneer de stroom met een orde van grootte toeneemt. Wanneer het apparaat goed is ontworpen, zijn de kritische stroomwaarde, drempelspanning en off-state spanning van het apparaat bepaald; dan komt een kleinere SS overeen met sterkere stroomveranderingen in het subdrempelgebied, een kleinere statische stroom van het apparaat in de uit-stand en een lager statisch stroomverbruik van het apparaat. De SS van metaaloxidehalfgeleider-veldeffecttransistoren (MOSFET's), de basiseenheidscellen die veel worden gebruikt in geïntegreerde schakelingen, wordt beperkt door het fysieke mechanisme van de stroom die wordt gegenereerd terwijl het apparaat werkt en kan niet lager zijn dan de grenswaarde van 60 mV/dec. Om deze beperking te doorbreken, is de afgelopen jaren een tunnelveldeffecttransistor (PIN of NIP TFET's) voorgesteld op basis van op silicium gebaseerde technologie. Een conventionele TFET wordt gevormd door een laag intrinsieke halfgeleiders met lage dotering toe te voegen tussen p - en n -type halfgeleidermaterialen. Vergeleken met MOSFET heeft de TFET de voordelen van een hoge gevoeligheid en een laag statisch stroomverbruik [1]. TFET wordt geschakeld door kwantumtunneling door een barrière te moduleren in plaats van de thermionische emissie over een barrière te moduleren zoals in de traditionele MOSFET. TFET wordt dus niet beperkt door de thermische Maxwell-Boltzmann-staart van dragers, die de SS van MOSFET beperkt tot 60 mV/dec bij kamertemperatuur [2] (precies 63 mV/dec bij 300 K). Het concept werd voorgesteld door Chang et al. terwijl ik bij IBM werkte [3]. Voor de eerste keer toonden Joerg Appenzeller en zijn collega's bij IBM aan dat de SS van TFET lager zou kunnen zijn dan 60 mV/dec. TFET kan worden gebruikt als energiezuinige elektronische schakelaars [4], die de bottleneck van MOSFET's doorbreken en het IC-stroomverbruik aanzienlijk verminderen. Het productieproces is compatibel met MOSFET's. Het zal waarschijnlijk de MOSFET-transistor vervangen als de basiseenheid van de volgende generatie geïntegreerde schakelingen. Daarom zijn TFET's de afgelopen jaren een hot topic geworden [5, 6]. Om de prestaties van TFET's in termen van SS, voorwaartse geleidende stroom en omgekeerde lekkage te verbeteren, zijn er veel onderzoeken uitgevoerd naar het structuurontwerp en de optimalisatie van TFET-apparaten, die zich voornamelijk richten op het verbeteren van de structuurvorm van het apparaatkanaal en de poortelektrode [7] ,8,9,10,11,12] en de gate-diëlektrische materialen met verschillende werkfuncties. De karakteristieke analyse en structuuroptimalisatie van het gate-diëlektrische materiaal [13,14,15] en gate-diëlektrica met verschillende diëlektrische constanten zijn uitgevoerd [15,16,17,18,19,20]. In de apparaatfysica heeft de analytische modellering van TFET's met de dubbele poortstructuur [21,22,23,24,25,26,27] en omringende poortstructuur [28,29,30,31,32,33] ook uitgebreid uitgevoerd. Een nadeel van op silicium gebaseerde TFET's in vergelijking met MOSFET's is de kleinere voorwaartse stroom, en de grootte van de voorwaartse stroom wordt bepaald door de efficiëntie van de tunnelstroomopwekking. De efficiëntie van het genereren van tunnelstroom kan worden verhoogd door de bandafstand tussen valentieband en geleidingsband te verkleinen in het gebied dat wordt gebruikt om de band-naar-band tunnelstroom te genereren of door de dikte van het tunnelgebied te verminderen. Daarom zijn in de materiaaltechniek TFET-apparaten op basis van halfgeleidermaterialen met smalle bandafstand en heterojunctietunnelstructuren uitgebreid ontwikkeld [34,35,36,37,38]. Ondertussen is de introductie van tweedimensionale materialen in TFET's als tunnellagen met ultradunne dikte uitgebreid bestudeerd [39,40,41,42,43,44]. Daarnaast hebben sommige artikelen de betrouwbaarheid van TFET's gerapporteerd, zoals het effect van brondoping op band gap interleaving [45], het effect van trap-geassisteerde tunneling op de subdrempelkenmerken van TFET's [46], en het effect van willekeurige doping op de prestatieverstoring van het apparaat [47]. De huidige onderzoeksresultaten zijn echter voornamelijk gericht op de fundamentele werkkenmerken en werkingsprincipes van afzonderlijke TFET's, en het belangrijkste fundamentele doel van het onderzoek en de ontwikkeling van TFET's is om een structurele basiseenheid met een lager stroomverbruik te bieden en de bestaande MOSFET-structuur te vervangen . Om dit fundamentele doel te bereiken, moet het in een specifiek circuit worden geplaatst om de compatibiliteit met MOSFET-technologie te verifiëren. Op dit moment wordt geleidelijk onderzoek gedaan naar de circuitontwerpstrategie op basis van TFET-apparaten, zoals het analoge en gemengde signaalcircuit [48,49,50], digitaal logisch circuit [50, 51], stroombeheercircuitontwerp [52]. Er zijn ook onderzoeken naar het ontwerp van hybride circuits op basis van MOSFET's en TFET's [53]. De doteringstypen van het brongebied en het afvoergebied zijn echter tegengesteld aan elkaar, wat een asymmetrie van het brongebied en het afvoergebied creëert. Deze asymmetrische structuur maakt het onmogelijk om de MOSFET volledig te vervangen door de source/drain-symmetrie.
Neem de n -type TFET als voorbeeld. De kant met p -type onzuiverheid wordt gebruikt als het brongebied, terwijl de andere kant met n -type onzuiverheid wordt gebruikt als het afvoergebied. Wanneer het apparaat werkt, moet een positief potentiaalverschil worden aangelegd van het afvoergebied naar het brongebied. Als de source-elektrode en de drain-elektrode zijn verwisseld, d.w.z. de p -type onzuiverheidsgebied is ingesteld op een hoger potentieel ten opzichte van de n -type onzuiverheidsgebied, dan de PN-overgang gevormd door de p -type onzuiverheidsgebied en n -type onzuiverheidsgebied zal altijd in de positieve voorspanningstoestand zijn, wat het falen van de besturingsfunctie van de poortelektrode veroorzaakt, de TFET zal bijna altijd in de aan-toestand zijn en kan niet worden uitgeschakeld. Met andere woorden, het veroorzaakt het falen van de TFET-schakelfunctie. Met andere woorden, de functionele circuitmodules (zoals transmissiepoorten), die de bidirectionele schakelkarakteristieken van transistors moeten gebruiken om normaal te werken, zijn moeilijk te realiseren met conventionele TFET's met een asymmetrische structuur van source en drain, om deze problemen op te lossen , hebben we een source drain symmetrische en uitwisselbare bidirectionele TFET (B-TFET) [54] voorgesteld, die het voordeel laat zien van bidirectionele schakelkarakteristieken en compatibiliteit met CMOS-geïntegreerde schakelingen in vergelijking met de traditionele asymmetrische TFET's. In dit artikel hebben we een gemodificeerde bilaterale gate-gecontroleerde B-TFET met een vlak kanaal voorgesteld. De effecten van belangrijke structurele parameters, zoals de dopingconcentraties van de N + regio en P + regio, lengte van de N + regio en lengte van de intrinsieke regio, op de apparaatprestaties, bijv. de overdrachtskenmerken, I aan –Ik uit ratio en subthreshold swing, worden in detail uitgelegd op basis van fysieke analyse. Daarna worden deze belangrijke structurele parameters geoptimaliseerd.
Methoden
Figuur 1a toont een schematisch bovenaanzicht van de bilaterale poortgestuurde N-Type B-TFET met een vlak kanaal. Afbeelding 1b toont een dwarsdoorsnede van de bilaterale gate-gestuurde N-Type B-TFET. In tegenstelling tot de conventionele TFET is de voorgestelde B-TFET volledig symmetrisch, de source/drain verwisselbare P + -gedoteerde gebieden liggen aan weerszijden van het siliciumlichaam en de poortelektrode ligt aan beide zijden van het siliciumlichaam. De gehele apparaatstructuur is symmetrisch. De N + -gedoteerde regio bevindt zich in het centrale deel van het siliciumlichaam. L en W zijn respectievelijk de gehele lengte en gehele breedte van het voorgestelde apparaat. L ik is de lengte van het intrinsieke gebied; L N+ is de lengte van de N + regio; L S/D en W S/D zijn de lengte en breedte van de P + source/drain verwisselbare regio's, respectievelijk; \(T\) is de dikte van het siliciumlichaam; \(t_{{{\text{ox}}}}\) is de dikte van het poortoxide; \(t_{i}\) is de dikte van het intrinsieke tunnelgebied tussen S/D-gebied en poortoxide.
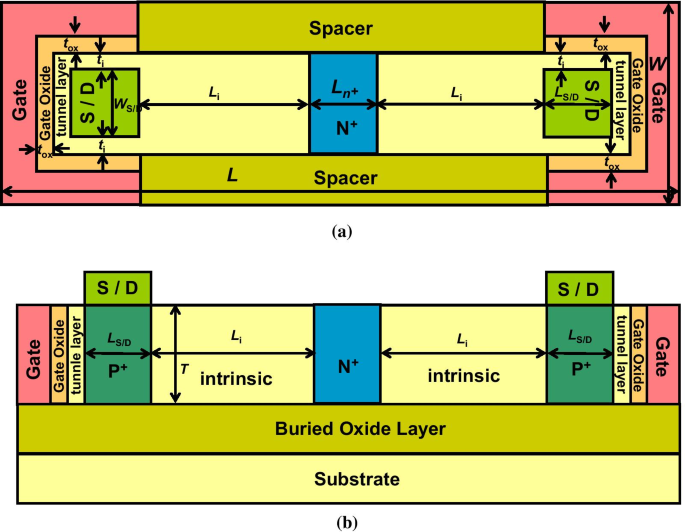
een Schematisch bovenaanzicht van de bilaterale poortgestuurde N-Type B-TFET met vlak kanaal. b Dwarsdoorsnede van de bilaterale poortgestuurde N-Type B-TFET
In dit artikel worden alle fysieke modellen zoals het Fermi-statistisch model, het CVT-mobiliteitsmodel, het Auger-recombinatiemodel, het band-gap-narrowing-model en een standaard band-to-band tunnelingmodel ingeschakeld. Alle parameters van het apparaat in dit document staan vermeld in Tabel 1.
Resultaten en discussie
Figuur 2a, b tonen de overdrachtskarakteristiek, \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) verhouding en gemiddelde SS met verschillende \(N_{ D}\) (\(10^{18}\)–\(10^{21} \,{\text{cm}}^{ - 3}\)). In figuur 2a beïnvloedt \(N_{D}\) de intensiteit van de omgekeerd voorgespannen lekstroom van afvoer naar bron. Met de toename van de doteringsconcentratie wordt de lekstroom aanzienlijk onderdrukt en verandert de voorwaartse stroom niet significant. In Fig. 2b worden de SS en \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) ook beïnvloed door \(N_{D}\ ). Met de toename van de doteringsconcentratie, omdat de omgekeerde lekstroom aanzienlijk wordt onderdrukt, neemt de stroom op het statische werkpunt af, dus de gemiddelde SS neemt ook af. Omdat de voorwaartse stroom veel minder wordt beïnvloed dan de omgekeerde lekkage, neemt de verhouding \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}}}\) toe met de toename in dopingconcentratie. Afbeelding 2c, d toont de tweedimensionale potentiaalverdelingen van de voorgestelde B-TFET met \(N_{D}\) gelijk aan 10 19 cm −3 en 10 21 cm −3 , respectievelijk. Wanneer de poortelektrode in tegengestelde richting is voorgespannen, zal een sterk elektrisch veld worden gegenereerd tussen de voorwaarts voorgespannen afvoerelektrode en de in tegengestelde richting voorgespannen poortelektrode, wat resulteert in een sterke band-naar-band tunneling nabij het afvoergebied. Van de resulterende gegenereerde elektron-gatparen kunnen de elektronen direct uit de afvoerelektrode stromen, terwijl de valentiebandgaten door de N + moeten stromen. gebied, vervolgens naar het intrinsieke gebied aan de bronzijde en worden ontladen door de bronelektrode om de continue lekstroom te vormen. Om de lekstroom te minimaliseren, moeten de gaten die worden geproduceerd door band-naar-band tunneling effectief worden geblokkeerd om uit het N + -gebied te stromen. Vergeleken met het N +gebied met lagere concentratie vormt het N + gebied met hogere concentratie een groter potentiaalverschil tussen P + gebied en N + gebied, dwz de potentiaalwaarde op de grens tussen het intrinsieke gebied en het N +gebied zal toenemen met de toename van \(N_{D}\) omdat het N + gebied met hogere concentratie een groter elektronisch concentratieverschil tussen source en drain kan produceren. Dan kunnen meer elektronen worden gediffundeerd van het N +-gebied naar de intrinsieke gebieden aan beide zijden van het N +-gebied, wat de hoeveelheid positieve lading (voornamelijk bestaande uit donor) in het N +-gebied na ionisatie verhoogt en bijgevolg de potentiaal vergroot. verschil tussen de P + regio en N + regio. Juist omdat het N + -gebied met hogere doteringsconcentratie een hoger potentieel heeft dan zowel de source- als de drainzijde na ionisatie, kunnen de gaten die worden gegenereerd door de band-naar-band tunneling nabij het draingebied effectiever worden geblokkeerd, wat effectiever de lekstroom.
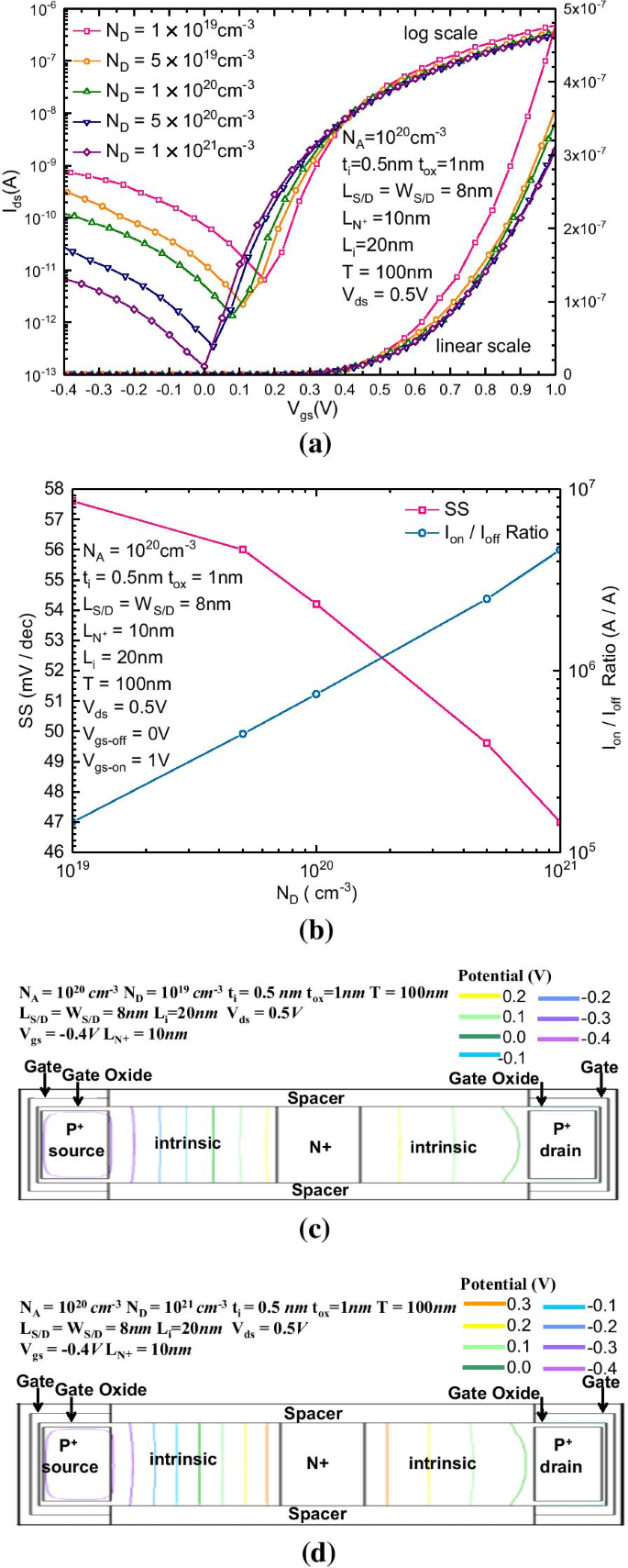
een \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) overdrachtskenmerken en b variatie in SS en de \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) verhouding van de voorgestelde B-TFET met verschillende \(N_{D }\); de omgekeerd bevooroordeelde 2-dimensionale potentiaalverdeling met c N D = 10 19 cm −3 en d N D = 10 21 cm −3
Naast de doteringsconcentratie van het N + -gebied, is een andere belangrijke parameter van het N +-gebied, die de omgekeerd voorgespannen lekstroom aanzienlijk kan beïnvloeden, de lengte van het N +-gebied. Figuur 3a, b tonen de \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) overdrachtskenmerken van de voorgestelde B-TFET met verschillende L N+ . De omgekeerd voorgespannen lekstroom neemt grotendeels af met toenemende L N+ . Zoals figuur 2b laat zien, worden de subdrempelzwaai en \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) ook beïnvloed door L N+ . Met de toename van L N+ Omdat de omgekeerde lekstroom aanzienlijk wordt onderdrukt, worden ook de stroom op het statische werkpunt en de gemiddelde SS verminderd. De voorwaartse stroom wordt veel minder beïnvloed dan de omgekeerde lekkage, en de verhouding \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}}}\) neemt toe met de toename in L N+ . Afbeelding 3c, d toont de tweedimensionale verdeling van de gatenconcentratie van de voorgestelde B-TFET met L N+ gelijk aan respectievelijk 2 nm en 80 nm. Wanneer L N+ gelijk is aan 2 nm, is de minimale gatenconcentratie in de N + regio groter dan 10 17 cm −3 , terwijl wanneer L N+ is gelijk aan 80 nm, de minimale gatenconcentratie is minder dan 10 14 cm −3 . De toename in lengte van het N + -gebied vergroot het vermogen om te voorkomen dat gaten door het N +-gebied gaan. Als een niet-evenwichtsminderheidsdrager in het N + -gebied, wanneer het N +-gebied langer is, zullen meer gaten worden gerecombineerd met elektronen voordat ze door het N +-gebied gaan, dus de toename in lengte van het N +-gebied kan ook een continue omgekeerd voorgespannen lekstroom. De gemiddelde SS kan worden teruggebracht tot 40,2 mV/dec en de verhouding \(I_{{{\text{on}}}}{-}I_{{{{\text{off}}}}\) kan groter zijn dan 10 10 .
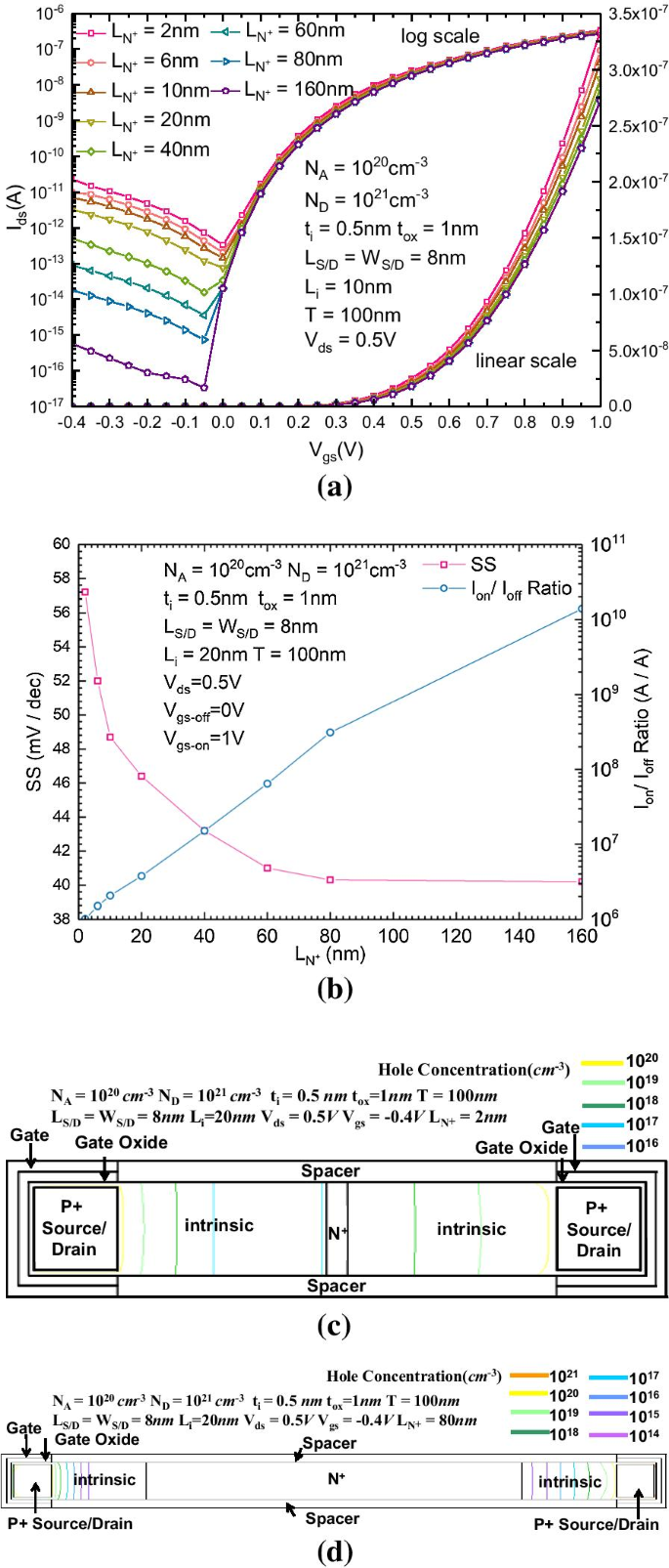
een \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) kenmerken; b variatie in de SS en de \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) verhouding van de voorgestelde B-TFET met verschillende L N+; 2-dimensionale gatconcentratieverdeling van de voorgestelde B-TFET onder omgekeerde voorspanning voor L N+ gelijk aan (3) 2 nm en (4) 80 nm
Figuur 4a, b tonen de \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) overdrachtskenmerken en veranderingen in SS en \(I_{{{ \text{on}}}}{-}I_{{{\text{off}}}}\) verhouding van de voorgestelde B-TFET met verschillende L ik , respectievelijk. De voorwaartse stroom neemt af met toenemende L ik omdat de weerstand van het intrinsieke gebied evenredig is met de lengte van zichzelf. Om de voorwaartse stroom te maximaliseren, moet de lengte van het intrinsieke gebied worden geminimaliseerd. De afname in lengte van het intrinsieke gebied versterkt echter het elektrische veld in het intrinsieke gebied tussen het source P + -gebied en het N + -gebied, dus de bandbuiging nabij dit gebied is groter dan het intrinsieke gebied nabij de afvoerelektrode, wat leidt tot meer omgekeerd voorgespannen lekstroom. Afbeelding 4c, d toont de tweedimensionale omgekeerde potentiaalverdeling van de voorgestelde B-TFET voor L ik gelijk aan respectievelijk 4 nm en 100 nm. Voor de kortste L ik (4 nm) geval is het elektrische veld in het intrinsieke gebied tussen de source P +regio en de N +regio nabij de source-elektrode veel sterker dan dat in het intrinsieke gebied tussen de drain P + regio en de N +regio nabij de afvoer elektrode. Dan blijft de lekstroom bijna constant, wat onafhankelijk is van de verandering in poortspanning. Afbeelding 4b laat zien dat het optimale waardebereik van L ik is ongeveer 7-10 nm, waarbij de SS afneemt tot een dalwaarde van 41 mV/dec en de \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}} }\) ratio neemt toe tot een maximale waarde van bijna 10 8 .
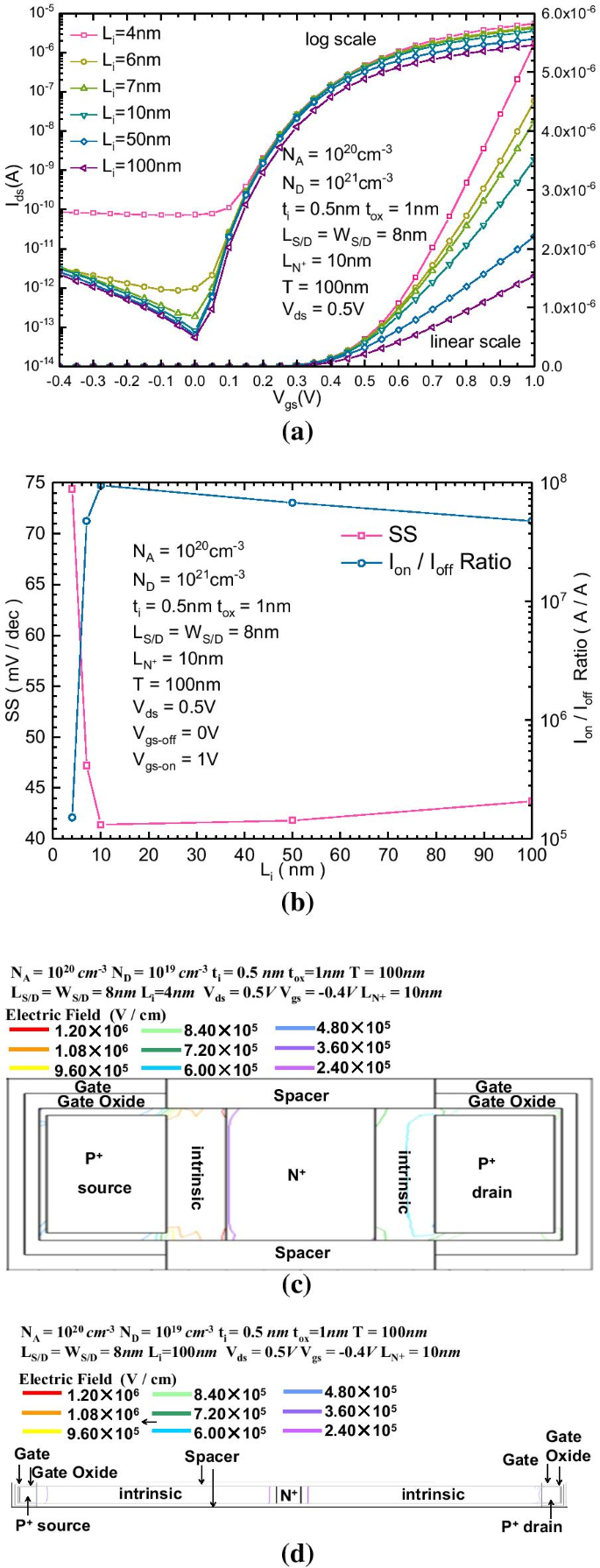
een \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) kenmerken van B-TFET en b variatie in SS en de \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) verhouding met verschillende \(L_{i}\); 2-dimensionale omgekeerd bevooroordeelde potentiaalverdeling van de voorgestelde B-TFET voor L ik gelijk aan c 20 nm en d 100 nm
Figuur 5a, b tonen de \(I_{{{\text{ds}}}}{-}V_{{{\text{ds}}}}\) overdrachtskenmerken en verandering in SS en \(I_{{{ \text{on}}}}{-}I_{{{\text{off}}}}\) verhouding van de voorgestelde B-TFET met verschillende \(N_{A}\). Figuur 5a laat zien dat door de concentratie van het P + -gedoteerde gebied te verhogen, we minder SS en een grotere voorwaartse stroom kunnen verkrijgen. De omgekeerd voorgespannen lekstroom wordt niet duidelijk beïnvloed door de verandering in \(N_{A}\), maar de voorwaartse stroom kan worden verhoogd met de toename in \(N_{A}\). In Fig. 5b kunnen zowel de SS- als de \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\)-verhouding worden verbeterd door \(N_{A }\). Figuur 5c, d toont de 2-dimensionale elektrische veldverdeling van de voorgestelde B-TFET met \(N_{A}\) gelijk aan 10 19 cm −3 en 10 21 cm −3 , respectievelijk. De toename in \(N_{A}\) versterkt het elektrische veld in het intrinsieke tunnelgebied; dan kunnen meer elektron-gatparen worden gegenereerd door band-naar-band tunneling, wat de voorwaartse stroom van de voorgestelde B-TFET verbetert.
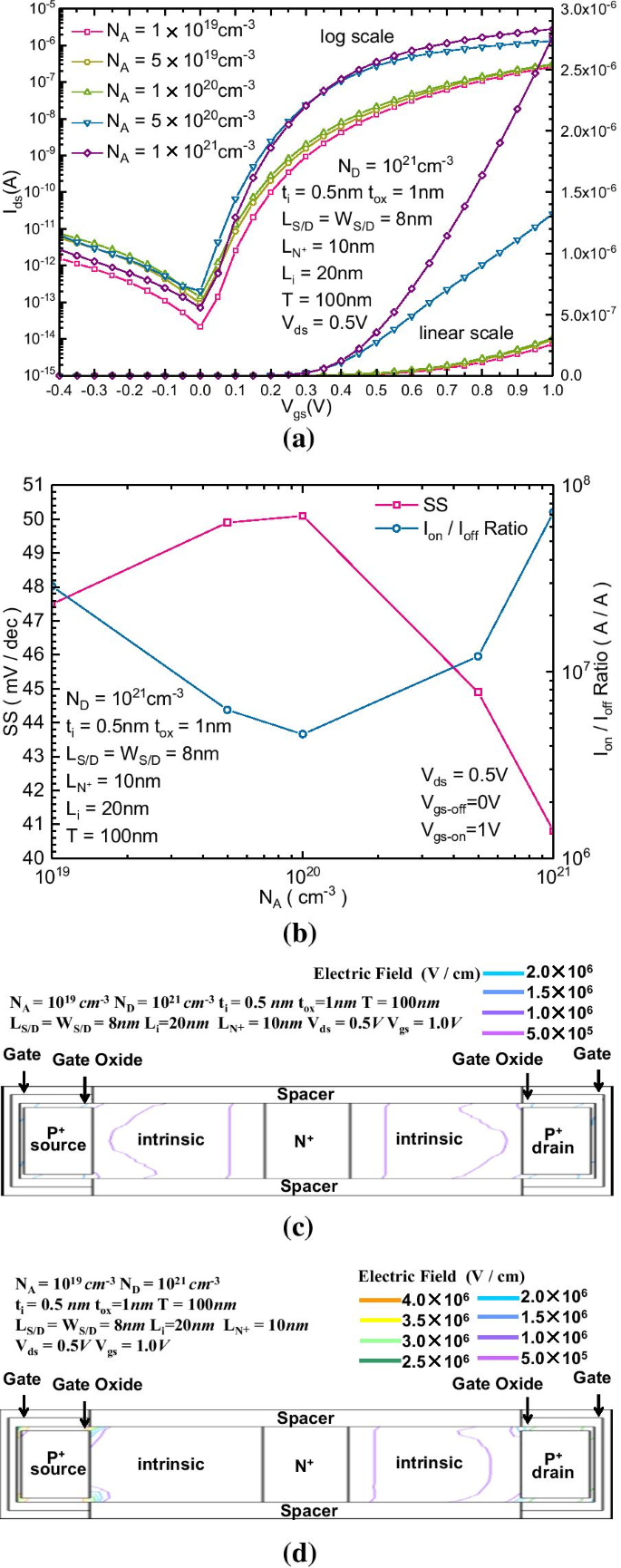
een \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) overdrachtskenmerken, b variatie in SS en \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) verhouding van de voorgestelde B-TFET met verschillende \(N_{A} \). Tweedimensionale omgekeerd voorgespannen elektrische veldverdeling van de voorgestelde B-TFET voor \(N_{A}\) gelijk aan (3) 10 19 cm −3 en (4) 10 21 cm −3
Volgens de bovenstaande discussie moeten zowel \(N_{D}\) als \(N_{A}\) op de maximaal mogelijke waarde worden ingesteld. Het optimale waardebereik van L ik is 7-10 nm. Er is echter een afweging tussen het statische stroomverbruik en L N+ . Afbeelding 6 toont de \(I_{{{\text{ds}}}}{-}V_{{{\text{ds}}}}\) overdrachtskenmerken van de geoptimaliseerde B-TFET met verschillende L N+ . L N+ kan worden geselecteerd op basis van verschillende ontwerpvereisten voor statische stroomverbruik. Als compromis, om ervoor te zorgen dat de verhouding \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) hoger is dan 10 8 , LN+ wordt aanbevolen boven 20 nm te zijn. De aan-stroom wordt verhoogd tot ongeveer 6 × 10 –6 A, en de SS wordt teruggebracht tot 38 mV/dec.
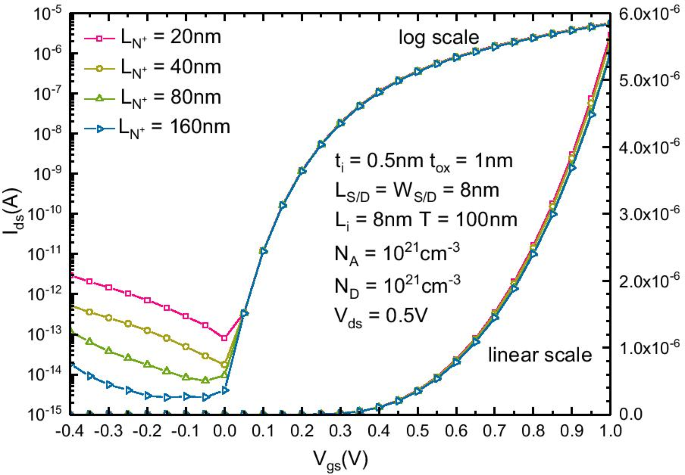
\(I_{{{\text{ds}}}}{-}V_{{{\text{ds}}}}\) overdrachtskenmerken van de geoptimaliseerde B-TFET met verschillende LN+
Conclusies
In dit artikel worden de effecten van de structurele parameters en het interne mechanisme van een bilaterale poortgestuurde S/D-symmetrische en uitwisselbare bidirectionele tunneling-veldeffecttransistor geanalyseerd. De effecten van de belangrijkste parameters zoals de concentratie en lengte van het N + -gebied, lengte van het intrinsieke gebied tussen het P + en N + -gebied en concentratie van het P +-gebied zijn uitvoerig besproken. Vergeleken met de conventionele TFET heeft de B-TFET het voordeel van een sterke weerstand tegen de omgekeerd voorgespannen lekstroom. Daarna kunnen goede prestaties worden verkregen, zoals een lagere gemiddelde SS en een hogere \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) ratio. Bovendien is het vanwege de structurele symmetrie en de verwisselbare en bidirectionele schakelkarakteristieken van source/drain beter compatibel met het CMOS-circuit.
Beschikbaarheid van gegevens en materialen
We hebben een verklaring van beschikbaarheid van gegevens en materiaal voor onszelf en namens onze coauteurs opgenomen onder de "Concurrerende belangen". Alle beschikbare gegevens en materiaal zijn origineel werk. Alle gegevens zijn duidelijk in het manuscript vermeld zonder aanvullende gegevens en ondersteunend materiaal.
Afkortingen
- L :
-
Gehele lengte van het voorgestelde apparaat
- W :
-
Gehele breedte van het voorgestelde apparaat
- L ik :
-
Lengte van het intrinsieke gebied
- L N + :
-
Lengte van de N + regio
- L S / D :
-
Lengte van de P + source/drain verwisselbare regio's
- W S / D :
-
Breedte van de P + source/drain verwisselbare regio's
- \(T\) :
-
Dikte siliciumlichaam
- \(t_{{{\text{ox}}}}\) :
-
Dikte van het poortoxide
- \(t_{i}\) :
-
Dikte van het intrinsieke tunnelgebied tussen S/D-gebied en poortoxide
- MOSFET:
-
Metaaloxide halfgeleider veldeffecttransistor
- TFET:
-
Tunnelveldeffecttransistor
Nanomaterialen
- De Shockley-diode
- First-Principles Study on the Stability and STM Image of Borophene
- Effect van gouden nanodeeltjesdistributie in TiO2 op de optische en elektrische kenmerken van kleurstofgevoelige zonnecellen
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Effect van in situ gloeibehandeling op de mobiliteit en morfologie van op TIPS pentaceen gebaseerde organische veldeffecttransistoren
- Experimenteel onderzoek naar de stromings- en warmteoverdrachtskenmerken van TiO2-water-nanovloeistoffen in een spiraalvormig gecanneleerde buis
- TiO2-nanobuisarrays:gefabriceerd op basis van een zacht-hard sjabloon en de korrelgrootte-afhankelijkheid van veldemissieprestaties
- Onderzoek naar het weerstandsschakelgeheugen op meerdere niveaus en de van de geheugentoestand afhankelijke fotospanning in Pt/Nd:SrTiO3-knooppunten
- Ontwerp en aanpassing van de grafeen-werkfunctie via grootte, modificatie, defecten en doping:een eerste-principe theorie-onderzoek
- Een onderzoek naar koolstofnanovezels en actieve koolstof als symmetrische supercondensator in waterige elektrolyt:een vergelijkend onderzoek
- De structurele, elektronische en magnetische eigenschappen van Ag n V-clusters (n = 1–12) onderzoeken



