Laagspanningsbedrijf 2D MoS2 ferro-elektrische geheugentransistor met Hf1-xZrxO2-poortstructuur
Abstract
Ferro-elektrische veldeffecttransistor (FeFET) komt naar voren als een intrigerende niet-vluchtige geheugentechnologie vanwege zijn veelbelovende werksnelheid en uithoudingsvermogen. Het omdraaien van de polarisatie vereist echter een hoge spanning in vergelijking met die van lezen, waardoor het stroomverbruik van het schrijven van een cel wordt beïnvloed. Hier rapporteren we een CMOS-compatibele FeFET-cel met een lage bedrijfsspanning. We engineeren de ferro-elektrische Hf1-x Zrx O2 (HZO) dunne film om negatieve capacitantie (NC) poortdiëlektrica te vormen, die een tegenklokhysterese-lus van polarisatiedomein genereert in het weiniglagige molybdeendisulfide (MoS2 ) FeFET. De niet-gestabiliseerde negatieve condensator ondersteunt inherent de subthermionische zwaaisnelheid en maakt het dus mogelijk om de ferro-elektrische polarisatie te schakelen met het hysteresevenster dat veel minder is dan de helft van de bedrijfsspanning. De FeFET vertoont een hoge aan/uit-stroomverhouding van meer dan 10 7 en een geheugenvenster (MW) tegen de klok in van 0,1 V bij een minimale programma- (P)/wis- (E) spanning van 3 V. Robuust uithoudingsvermogen (10 3 cycli) en retentie (10 4 s) eigenschappen worden ook gedemonstreerd. Onze resultaten tonen aan dat de HZO/MoS2 ferro-elektrische geheugentransistor kan nieuwe kansen bieden in niet-vluchtige geheugentoepassingen met schaalbare grootte en spanning.
Achtergrond
De markt voor systeem-op-chip (SoC) embedded geheugen bevindt zich momenteel in een tijdperk van enorme groei, wat vereist dat het geheugen in staat is om een snellere werking, kleinere celgrootte en minder stroomverbruik te bereiken [1,2,3,4,5,6 ]. Ferro-elektrisch geheugen, een van de meest veelbelovende kandidaten, is heroverwogen vanwege de ontdekking van ferro-elektrisch hafniumoxide in 2011 [7].
In de afgelopen decennia presteerde FeFET niet goed in al deze aspecten, waaronder lage spanningsvereisten voor geheugenwerking, de eenvoud van de processtap en het minimaal complementaire metaaloxide-halfgeleider (CMOS) integratieproces en beperkte zorgen over verontreiniging [8,9,10, 11]. Om dit aan te pakken, is onlangs enorm veel onderzoek gedaan naar 2D FeFET niet-vluchtig geheugen (NVM) op basis van verschillende ferro-elektrische materialen, waaronder PbZrTiO3 (PZT), en [P(VDF-TrFE)] polymeer [12,13,14,15,16,17,18], wat te wijten is aan de veelbelovende eigenschappen van 2D-materiaal in "meer dan het Moore-tijdperk". In de FeFET worden de twee stabiele spontane polarisatietoestanden van een ferro-elektrisch materiaal opgenomen in een transistorpoortstapel gebruikt voor gegevensopslag via de regelbare drempelspanning die mogelijk wordt gemaakt door aangelegde gekrompen P/E-poortspanningen. Het is gemeld dat het reproduceerbare hysteresisgedrag, een hoge aan/uit-verhouding van 10 4 , goede retentie-eigenschappen tot 10 4 s, en stabiele schakelwerking is bereikt in PZT/MoS2 FeFET [19]. Opvallend is een maximale mobiliteit van 625 cm 2 /V∙s, een groot MW van 16 V voor een poortspanningsbereik van ± 26 V en een hoge aan/uit-verhouding van 8 × 10 5 zijn ook aangetoond door een n-type [P(VDF-TrFE)] polymeer/MoS2 FeFET [15]. Er zijn echter zoveel fundamentele problemen die de praktische toepassing ervan in de weg kunnen staan, zoals CMOS-compatibiliteit, schaalbaarheid en de interfacestatus tussen Fe en 2D-materiaal. Ferro-elektrisch hafniumoxide, een soort nieuw ferro-elektrisch materiaal, heeft uitstekende CMOS-compatibiliteit en schaalbaarheid, wat in de komende 5-10 jaar zou kunnen dienen voor de geavanceerde FeFET NVM op sub-5 nm-technologieknooppunt [20]. Dienovereenkomstig, een partij HfO2 -gebaseerde diëlektrische stapels zijn opgenomen in 2D FeFET's, die bedoeld zijn om veldeffecttransistoren met negatieve capaciteit (NCFET) te bereiken met steile AAN / UIT-schakeling via een helling van minder dan 60 mV / decennium en hysteresisvrije kenmerken [21,22,23 ,24,25,26], hoewel massa-experimenten gebaseerd op NC-diëlektrische stapel met alternatieve 2D-kanaalmaterialen fantastische conclusies hebben getrokken, benadrukten ze de piekvereisten om onderscheid te maken tussen NCFET's en FeFET's. Er is nog steeds een gebrek aan systematisch onderzoek naar de fysica en levensvatbaarheid van de apparaattechnologie op een ferro-elektrisch geheugen met één transistor op basis van MoS2 en ferro-elektrische HZO.
In dit werk, een FeFET met een paar lagen HZO MoS2 transistor is voorgesteld. Het is in staat om de P/E-spanning te schalen via het NC-effect dat wordt veroorzaakt door gate-stack-engineering onder een gekrompen P/E-spanning. We hebben experimenteel aangetoond dat een MW tegen de klok in van 0,1 V met een helling van minder dan 60 mV/decennium is bereikt in HZO MoS2 FeFET, dat kan worden toegeschreven aan lokale modulatie van draaggolfdichtheid in het 2D-kanaal door snel omdraaien van ferro-elektrische dipool. We schreven de verminderde hysterese van de HZO/MoS2 . toe FeFET als drainspanning die toeneemt tot negatief drain-geïnduceerde barrièreverlagende (DIBL) effect. Daarnaast werd ook systematisch onderzoek gedaan naar retentie, uithoudingsvermogen en de afhankelijkheid van de drempelspanning van de afvoerspanning van HZO MoS2 FeFET, het openen van een haalbaar pad voor het ontwerpen van HZO MoS2 FeFET NVM en zijn praktische toepassingen.
Methoden
6 nm Hf1-x Zrx O2 film en 2 nm Al2 O3 is gestort op p + Si-substraat met ALD bij 300 °C, met [(CH3 )2 N]4 Hf(TDMAHf), [(CH3 )2 N]4 Zr(TDMAZr), en H2 O-damp als respectievelijk de Hf-precursor, Zr-precursor en oxidatiemiddelprecursor. Vervolgens onderging het substraat een snelle thermische annealing (RTA) bij 450 °C gedurende 30 s in N2 omgeving. Daarna enkele laag MoS2 vlokken werden mechanisch geëxfolieerd en overgebracht op het substraat. De diameter van p + Si-substraat gebruikt om HZO (6 nm)/AI2 . af te zetten O3 (2 nm) is 6 inch. We hebben elektronenstraallithografie (EBL) gebruikt om contactvlakken in poly (methylmethacrylaat) (PMMA) A5-resist te patroon. De spinparameters, bakparameters en beeldparameters zijn respectievelijk 500 r/min (9 s) + 4000 r/min (40 s), 170 °C (5 min), MIBK:IPA =1:3 (15 s), respectievelijk . Vervolgens werden de source/drain-elektroden (Ti/Au, 5/65 nm dikte) verdampt met behulp van een e-beam evaporation (EBE) systeem en geëtst met acetonoplossing. Na het opstijgen werd het apparaat gedurende 2 uur bij 300 ° C uitgegloeid om het contact te verbeteren. We voerden de elektrische karakterisering uit van onze gefabriceerde MoS2 /HZO-veldeffecttransistoren met behulp van een sondestation met een micromanipulator. De backgate-spanning (V GS ) werd aangebracht op het p-type zwaar gedoteerde Si-substraat. Een halfgeleiderkarakteriseringssysteem (PDA) werd gebruikt om de source-drain-spanning (V DS ), de backgate-spanning (V GS ), en de bron-afvoerstroom (I DS ).
Resultaten en discussie
We hebben een paar lagen MoS2 . gemaakt door mechanische afschilfering van bulkkristal en overgedragen MoS2 nanoflake op de 2 nm Al2 O3 /6 nm HZO/p + Si-substraat (zie meer details in de sectie "Experimenteel"). Figuur 1a en b tonen een 3D schematisch aanzicht en dwarsdoorsnede van de HZO/MoS2 FeFET-structuur, respectievelijk. Een bovenaanzicht scanning elektronenmicroscopie (SEM) beeld van de HZO/MoS2 FeFET wordt getoond in figuur 1c. De breedte en lengte van de MoS2 kanaal zijn respectievelijk 2 m en 12 m. Zoals getoond in Fig. 1d, is de dikte van de MoS2 kanaal werd bevestigd met behulp van atomaire krachtmicroscopie (AFM). De gemeten dikte van 1,57 nm duidt op de aanwezigheid van 4 lagen MoS2 [26].
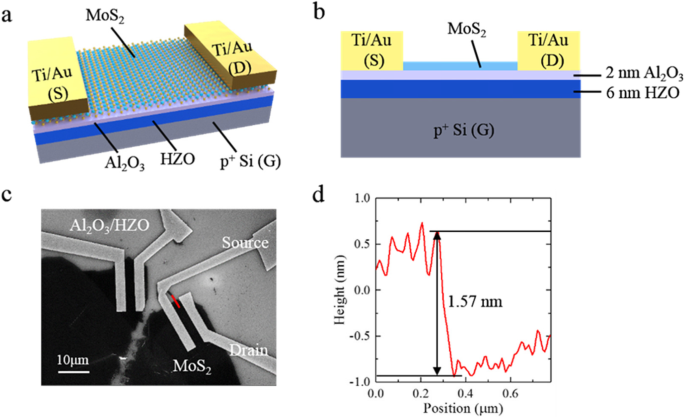
Apparaatstructuur en basiseigenschappen van de MoS2 /HZO FeFET. een Driedimensionale schematische weergave van de MoS2 /HZO FeFET. b Schematische dwarsdoorsnede van de MoS2 /HZO FeFET. c SEM-afbeelding van bovenaf van de gefabriceerde MoS2 /HZO FeFET met Ti/Au source/drain-elektroden, HZO ferro-elektrische gate-isolatoren en MoS2 kanalen. d Hoogteprofiel met contactmodus AFM langs de rode lijn in c , valideren van de hoogte van de MoS2 kanaal.
Zoals getoond in Fig. S1c en d, werd de elementaire en bindingssamenstelling van HZO onderzocht door de röntgenfoto-elektron (XPS) -metingen. Pieken blijken 19,05 eV, 17,6 eV, 185,5 eV en 183.2 eV te zijn, wat overeenkomt met de Hf 4f5/2 , Hf 4f7/2 , Zr 3d3/2 , en Zr 3d5/2 , respectievelijk [27]. De atomaire concentratie langs het diepteprofiel in Fig. S1e bevestigt verder de verdeling van de Al2 O3 /HZO/p + Si drielaagse structuur. Al het bovenstaande bevestigt dat de HZO-film die is gegroeid via ons atomic layer deposition (ALD) -systeem zeer kristallijn is.
Alvorens de karakterisering van HZO/MoS2 te onderzoeken FeFET, het ferro-elektrische gedrag van de Au/2 nm Al2 O3 /6 nm HZO/p + Si-poortstapel met behulp van polarisatie-spanningsmeting wordt getoond in figuur 2a. Het is duidelijk dat onze gefabriceerde 6 nm HZO/2 nm Al2 O3 condensatoren vertonen polarisatie-spanningshysteresislussen (gemeten bij 1 kHz). Ondertussen is de resterende polarisatie P r en de dwangspanning V c verhogen met het verhogen van de maximale zwaaispanning, wat de P-V . impliceert hysteresislussen transformeren van kleine lus naar grote lus. Naarmate de maximale zwaaispanning toeneemt van 2 naar 4 V, P r bereikt 0,66 μC/cm 2 , 0,86 μC/cm 2 , en 1,1 μC/cm 2 , respectievelijk en V c bereikt respectievelijk 1,12 V, 1,9 V en 2,04 V. Geëxtraheerde P r en V c binnen 10 5 duurzame DC-veegcycli worden getoond in Fig. 2b en c. Duidelijk significante effecten van wakker worden en vermoeidheid binnen 10 5 cycli worden waargenomen in de 6 nm HZO/2 nm Al2 O3 condensator. Het wakker worden en de vermoeidheid kunnen worden toegeschreven aan de diffusie en herverdeling van de zuurstofvacatures onder het elektrische veld. Het vermoeidheidseffect wordt over het algemeen geassocieerd met het vasthouden van lading op de defectlocaties die verband houden met zuurstofvacatures [28]. Het hysteresisgedrag voor de PR-fase en vlindervormige lus voor de PRampl met behulp van piëzoresponskrachtmicroscopie (PFM) worden weergegeven in Fig. S1b en c, wat een polarisatieomschakeling aangeeft als een functie van de sweep-biasspanning. Rekening houdend met verschillende contactweerstanden tussen polarisatie-spanningsmeting en piëzo-respons-spanningsmeting, is de gemeten V c in Fig. S1b en c is niet zo consistent met de waarden verkregen in Fig. 2a.

een PV-hysteresislussen voor de HZO (6 nm)/Al2 O3 (2 nm) condensator met verschillende spanningsbereiken. Afhankelijkheid van (b ) P r en c V c op fietsen voor de HZO (6 nm)/Al2 O3 (2 nm) condensator met ± 4 V/1 kHz cycli
Bovendien wordt waargenomen dat er een toename is in MW die gepaard gaat met het verhoogde zwaaiende spanningsbereik van de poortspanning (V GS,bereik ). Gewoonlijk bestaat polykristallijne HZO-film als multi-domeinstatus [29], en de coërcitieve veldverdeling van deze domeinen voldoet aan de Gauss-verdeling. Er moet dus een verhoogde afhankelijkheid zijn van de verhoogde V GS,bereik . De dwangbevel ingediend E C komt overeen met de waarde van het externe elektrische veld dat de remanente polarisatie tot nul kan reduceren. Daarom is de V GS ,bereik gebruikt om de polarisatie in de HZO-film te schakelen wordt groter met een hogere gerelateerde dwangspanning V C . Dit is de reden waarom polarisatie-spanningslussen van HZO-film worden verlengd met een grotere V GS,bereik , wat is aangetoond in Fig. 2a. Met andere woorden, de verhoogde polarisatie-intensiteit en ferro-elektrische omschakeling treden op met de verhoogde V GS,bereik , wat leidt tot de bovengenoemde verschijnselen van de verlengde MW tegen de klok in geproduceerd door de verhoogde V GS,bereik . Bij V GS,bereik =(−2, 2 V), de MW is bijna verdwenen en er komen bijna hysterese-vrije kenmerken naar voren, wat de bijna volledige compensatie betekent tussen de effecten van ferro-elektrisch schakelen en het opvangen/ontvangen van lading.
Om het effect van ferro-elektrisch schakelen verder te onderzoeken, is de V GS,bereik is continu verhoogd tot (−6, 6 V) en (−6.5, 6.5 V). De gemeten I DS -V GS curven van de HZO MoS2 FeFET op V GS,bereik =(−6, 6 V) en (−6.5, 6.5 V) worden getoond in Fig. 3a. Evenzo wordt het geheugenvenster tegen de klok in vergroot met de uitgebreide V GS,bereik . Bij V GS,bereik =(−6.5, 6.5 V), de MW tegen de klok in is hoger dan 4 V en de aan/uit-verhouding neemt ook toe tot 10 7 , wat te wijten is aan de verbeterde polarisatie-omschakeling onder een grotere externe aangelegde spanning. Over het algemeen is het mechanisme dat ten grondslag ligt aan het hysteresegedrag dat wordt weergegeven in de I DS -V GS krommen tijdens het vegen in twee richtingen van V GS is drempelspanningsverschuiving, die kan worden gewijzigd door de overheersende effecten van polarisatieschakeling, dat wil zeggen NC-effect [30,31,32], resulterend in hysterese tegen de klok in. Een verdere studie van verbeterde subthreshold-kenmerken werd uitgevoerd in het andere apparaat onder een gekrompen V GS,bereik . De gemeten I DS -V GS en geëxtraheerd punt SS—I DS krommen van het andere apparaat bij V GS,bereik =(−3, 3 V) zijn uitgezet in Fig. 3b. Het is aangetoond dat bij V GS,bereik =(−3, 3 V), HZO/MoS2 FeFET vertoont SSFor =51,2 mV/decade en SSRev =respectievelijk 66,5 mV/decennium. Dat wil zeggen dat de SS van minder dan 60 mV/decennium en een MW van 0,48 V tegelijkertijd kunnen worden bereikt in HZO/MoS2 FeFET bij kamertemperatuur, wat een hint zal zijn om onderscheid te maken tussen NCFET en FeFET.
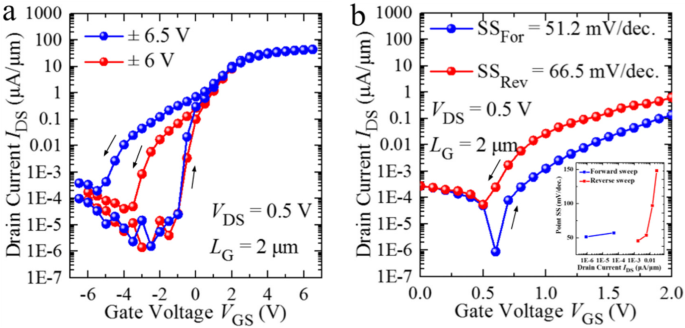
De gelijkstroom (DC) test van de HZO/MoS2 FeFET bij afvoerspanning (V DS ) is 0,5 V. a De vergelijking tussen overdrachtscurven met 6 V en 6.5 V als maximum van de backgate-spanning. b Vergrote weergave van overdrachtscurven met een interval van 0 tot −2 V van V GS,bereik =(−3, 3 V). Punt onderdrempel helling (SS) als functie van afvoerstroom (I DS ) van de HZO/MoS2 FeFET is (b ) inzet. Het apparaat vertoont SSFor =51,2 mV/dec
Zoals bekend kan de SS in NCFET kleiner zijn dan 60 mV/decade bij kamertemperatuur vanwege de opname van de negatieve gate-diëlektrische capaciteit (C ins ), die kan worden verkregen via het negatieve hellingssegment van dP /dE <0 geïnduceerd door ferro-elektrische film, wat bijdraagt aan de gate-stackfactor (m) <1. Het mechanisme dat ten grondslag ligt aan het NC-effect [33] is het depolarisatieveld dat wordt gegenereerd door ferro-elektrische film [34,35,36,37,38]. Er is experimenteel gerapporteerd dat als gevolg van de onvolledige screening op het grensvlak van ferro-elektrische film [39], de resterende polarisatielading een intern elektrisch veld over ferro-elektrische film zou kunnen produceren, dat de tegenovergestelde richting heeft met de extern aangelegde spanning, wat leidt tot de re- verdeling van de spanning over de gate-stack en de versterkte kanaaloppervlaktepotentiaal, genoemd als "spanningsversterkingseffect" [40,41,42]. De spanningsversterking kan meestal in twee delen worden verdeeld, de versnelde variatie van het kanaaloppervlaktepotentieel en de daaropvolgende verhoogde waarde, wat zorgt voor de steile AAN / UIT-schakeling en verbeterde I AAN /Ik UIT , respectievelijk. Voor FeFET is er echter een ander verhaal. Volgens het concept van capaciteitsaanpassing tussen ferro-elektrische capaciteit (C FE ) en metaaloxide-halfgeleidercapaciteit (C MOS ) [43,44,45], wanneer |C FE |> C MOS , de theoretische totale capaciteit (C totaal ) is positief en het systeem is stabiel, wat resulteert in hetzelfde polarisatiegedrag tijdens het in twee richtingen vegen van V GS en de stabiele hysteresevrije NCFET. Een goede afstemming resulterend in verbeterde SS en transconductantie is echter erg lastig te bereiken, aangezien zowel C MOS en C FE zijn zeer niet-lineaire, bias-afhankelijke condensatoren. Bovendien, |C FE |> C MOS moet worden gewaarborgd voor het hele bedrijfsspanningsbereik om hysterese te voorkomen. In plaats daarvan, een keer |C FE | <C MOS , de theoretische C totaal negatief is en het systeem onstabiel is, moet er een gescheiden polarisatiegedrag optreden tijdens het bi-switchen van V GS om de C . te behouden totaal positief, wat de hysterese tegen de klok in zou kunnen produceren in FeFET voor NVM-toepassing. Hier wordt vermeld dat het hysteretische gedrag het daaropvolgende effect is van gescheiden polarisatieomschakeling, wat betekent dat de breedte van het hysteresevenster eenvoudig kan worden aangepast op basis van het concept van capaciteitsaanpassing, zoals, dat kan worden gemanipuleerd door de variatie van V DS . Met een geschikte capaciteitsaanpassing, zelfs met een sterk gekrompen V GS,bereik =(−3, 3 V), HZO/MoS2 FeFET vertoont nog steeds een duidelijk hysteresisvenster en de steile omschakeling van SSFor =51,2 mV / dec tegelijkertijd, wat verder suggereert dat het NC-effect (ferro-elektrisch polarisatie-effect) ook in het subdrempelgebied bestaat. Hoewel NCFET en FeFET verschillend zijn, kan FeFET ook worden gebruikt als logische apparaten met een vergelijkbare kleinere MW, met behoud van een diepe sub-60 mV/dec SS en een hogere I AAN /Ik UIT ook vanwege het NC-effect.
De impact van V DS op de breedte van MW is zorgvuldig onderzocht. De ik DS -V GS krommen op logaritmische schalen onder verschillende V DS worden gekenmerkt in Fig. S3. Er wordt getoond dat, bij een vaste V GS,bereik =(−2, 2 V), de waarden van V GS geëxtraheerd op I DS =70 nA voor het bidirectioneel vegen van V GS alle verschuiven naar de negatieve richting. Ondertussen is ook aangetoond dat de variatie in voorwaarts vegen van V GS is veel duidelijker dan dat van reverse sweeping, wat wijst op de significante verschijnselen van negatieve DIBL. Opgemerkt moet worden dat het negatieve DIBL-effect altijd optreedt bij een NC-effect [46, 47].
Na de bovenstaande gelijkstroom (DC) test van de HZO/MoS2 FeFET, we hebben verder de gemeten MW's uitgevoerd voor verschillende P/E V GS pulsen met een breedte van 10 ms in Fig. 4a. MW wordt gedefinieerd als de maximale verandering ΔV TH na P/E V GS pulsen. Tijdens de gepulseerde V GS toepassing waren de andere terminals vastgezet op V S =V D =0 V. Voor de leesbewerking (R), V GS varieerde van −1 V tot 1 V met V D =0,5 V en V S =0 V Zoals weergegeven in figuur 4a, worden de geëxtraheerde MW's groter als P/E V GS pulsen nemen toe. Wanneer de opgelegde P/E V GS puls is ± 3 V, de geëxtraheerde MW is 0,1 V. Wanneer de opgelegde P/E V GS puls is ± 5,5 V, de geëxtraheerde MW is 0,275 V. Vergeleken met de MW's tegen de klok in van 4 V en 0,48 V in Fig. 3a en b, zijn de geëxtraheerde MW's na P/E V GS pols wordt sterk verminderd. Dit is mogelijk te wijten aan een hogere dichtheid van invangtoestanden veroorzaakt door een hoge luchtvochtigheid [48]. Het mechanisme voor het invangen/ontvangen van lading wordt dus verbeterd en de hysteresislus tegen de klok in wordt uiteindelijk verkleind. Verder hebben we het fietsuithoudingsvermogen en de dataretentie van de HZO/MoS2 . bestudeerd FeFET onder P/E-pulsen met ± 5,5 V hoogte in figuur 4b. Het programma V GS puls was 10 ms breed met V S =V D =0 V Figuur 4b illustreert de gemeten MW's als functie van uithoudingscycli. De uithoudingscyclus wordt gevormd door periodieke P/R/E/R-pulsen van de back-gate-spanning. Spanningen toegepast op de achterpoort van de hoogte van P, E, R waren respectievelijk + 5,5 V, -5,5 V en 0 V. En de pulsbreedte van P en E was 10 ms. Het is duidelijk dat een MW van 0,3 V kan worden gehandhaafd zonder significante degradatie na 10 3 P/E cycli. Naarmate het aantal uithoudingscycli toenam, nam de MW toe tot 0,38 V na 10 cycli en nam vervolgens weer af tot 0,28 V na 600 cycli. Het eerste verbrede MW wordt wake-up-effect genoemd en het latere verkleinde MW wordt vermoeidheidseffect genoemd. Het wake-up-effect komt overeen met de-pinning van domeinen, wat leidt tot een toename van schakelbare polarisatiedomeinen van de HZO-film [49]. Het vermoeidheidseffect komt overeen met nieuw geïnjecteerde ladingen die de domeinwanden vastzetten na een groot aantal P/E-cycli [50]. De gegevensretentie bij kamertemperatuur wordt getoond in figuur 4c. Hier is de MW-degradatie verwaarloosbaar na 10 4 s. Daarom kan worden verwacht dat een MW van ongeveer 0,3 V over 10 jaar duurzaam is volgens de gestippelde extrapolatielijnen. Zoals weergegeven in Fig. 4d, is het apparaat stabiel na 10 3 cycli onder de P/E-pulsen met ± 3 V hoogtes. De stabiliteit van de HZO/MoS2 FeFET toont een geweldig perspectief van toepassingen in niet-vluchtige geheugentechnologie.

Geheugenprestaties van de HZO/MoS2 FeFET onder P/E-pulsen. een Geëxtraheerde MW's (MW's) onder P/E-pulsen met ± 3 V, ± 4 V, ± 5 V, ± 5,5 V en ± 6 V hoogtes. b Duurmetingen onder P/E-pulscondities. c Retentiekenmerk van de HZO/MoS2 FeFET. d Uithoudingsvermogen van de HZO/MoS2 FeFET voor 10 3 cycli onder de P/E-pulsen met ± 3 V hoogtes
Een vergelijking van verdienste met op FeFET gebaseerde apparaten die MoS2 . combineren en ferro-elektrische poortdiëlektrica wordt gegeven in Tabel 1. Hier worden de apparaatstructuur, resterende polarisatie, dwingend elektrisch veld, hysteresislusrichting, MW, werkspanning, uithoudingscycli en retentietijd vermeld. Het is duidelijk dat het apparaat dat we hebben gefabriceerd de dunste ferro-elektrische laag van 6 nm HZO en de laagste werkspanning vertoont in vergelijking met andere werken [12,13,14,15,16,17,18], wat belangrijk is voor de toekomstige 2 nm of 3 nm-procesknooppunt van het back-end of line-geheugen (BEOL). Door de dikte van de ferro-elektrische laag te schalen, werd een MW van ongeveer 0,1 V bereikt onder een lage werkspanning van ± 3 V. Een dergelijke lage werkspanning kan worden toegeschreven aan de intrinsieke kenmerken van de HZO-laag in vergelijking met hun tegenhangers, zoals P (VDF-TrFE) of HfO2 , die een veel hogere dikte heeft. Bovendien heeft ons apparaat een lagere restpolarisatie P r van 1,1 C/cm 2 vergeleken met andere gerapporteerde FeFET's. Het snelle verval van retentieverlies in een FeFET is te wijten aan het bestaan van het depolarisatieveld E dep , die voortkomt uit de onvolledige compensatie vanwege het bestaan van de Al2 O3 laag. Hier, E dep is recht evenredig met de remanente polarisatie P r [51]. Dus de hoge E c en lage P r maak de verhouding E dep /E c in MoS2 /HZO FeFET veel klein, wat leidt tot een veel klein retentieverlies in verband met het depolarisatieveldeffect. Hoewel de retentieprestaties van MoS2 FeFET's op basis van HZO en P(VDF-TrFE) liggen beide rond de 10 4 s, moet de P(VDF-TrFE)-film 150 nm [17] zijn.
Conclusies
Concluderend hebben we MoS2 . met weinig lagen onderzocht -gebaseerde ferro-elektrische geheugentransistorapparaten die een HZO-achterpoortdiëlektricum gebruiken. Onze gefabriceerde apparaten vertonen een hysterese tegen de klok in die wordt veroorzaakt door ferro-elektrische polarisatie. Daarnaast is onze HZO/MoS2 ferro-elektrische geheugentransistor vertoonde uitstekende apparaatprestaties:een hoge aan/uit-stroomverhouding van meer dan 10 7 en een MW tegen de klok in van 0,1 V bij een P/E-spanning van 3 V, die het uithoudingsvermogen heeft (10 3 cycli) en retentie (10 4 s) prestaties. We zijn dan ook van mening dat de resultaten van onze MoS2 -gebaseerde niet-vluchtige ferro-elektrische geheugentransistors bieden veelbelovende perspectieven voor de toekomst van 2D low-power niet-vluchtige geheugentoepassingen.
Beschikbaarheid van gegevens en materialen
De auteurs verklaren dat de materialen, gegevens en bijbehorende protocollen beschikbaar zijn voor de lezers en dat alle gegevens die voor de analyse zijn gebruikt, in dit artikel zijn opgenomen.
Nanomaterialen
- Transistorclassificaties en pakketten (BJT)
- Enkele voorbeelden met wisselstroomcircuits
- American Control Electronics:laagspannings-DC-aandrijving met programmeerbare module op snap-on
- MoS2 met gecontroleerde dikte voor elektrokatalytische waterstofevolutie
- Monodispergerende koolstofnanosferen met hiërarchische poreuze structuur als elektrodemateriaal voor supercondensator
- UV-uitgeharde inkjet-geprinte zilveren poortelektrode met lage elektrische weerstand
- Frequentiemodulatie en absorptieverbetering van THz-microbolometer met microbrugstructuur door spiraalvormige antennes
- Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
- Enkelwandige koolstof nanobuis gedomineerde micron-brede streeppatroon-gebaseerde ferro-elektrische veldeffect transistoren met HfO2-defect controlelaag
- Analoge/RF-prestaties van T-Shape Gate Dual-Source Tunnel Field-Effect Transistor
- Marktgroei voor laagspanningsregeling



