High Mobility Ge pMOSFET's met ZrO2-diëlektricum:effecten van nagloeien
Abstract
Dit artikel onderzoekt de effecten van post metal annealing (PMA) en post deposition annealing (PDA) op de elektrische prestaties van Ge p-type metaaloxide-halfgeleider veldeffecttransistoren (pMOSFET's) met ZrO2 diëlektrisch. Voor de transistors zonder PDA, aan-statusstroom (I AAN ), subthreshold swing (SS) en capacitieve equivalente dikte (CET) karakteristieken worden verbeterd met een PMA-temperatuur die stijgt van 350 tot 500 °C. Kristallisatie van ZrO2 diëlektricum bij de hogere PMA-temperatuur draagt bij aan de toename van de permittiviteit van ZrO2 en de afname van de dichtheid van interfacetoestanden (D het ), wat resulteert in een verminderde CET en een hoge effectieve mobiliteit van gaten (μ eff ). Het is aangetoond dat Ge pMOSFET's met een PDA-behandeling bij 400 °C een lagere CET en een steilere SS hebben, maar een lagere μ eff vergeleken met apparaten zonder PDA.
Achtergrond
Germanium (Ge) wordt beschouwd als een van de aantrekkelijke p-kanaalmaterialen voor geavanceerde CMOS omdat het een veel grotere gatenmobiliteit biedt dan Si [1,2,3]. Een poortdiëlektricum van hoge kwaliteit en effectieve passivering van het Ge-oppervlak zijn de sleutels tot het realiseren van de superieure effectieve mobiliteit van de drager (μ eff ) en hoge stuurstroom in Ge-transistor [4,5,6,7]. Verschillende high-κ materialen zoals HfO2 [8], ZrO2 [7, 9], La2 O3 [10], en Y2 O3 [11] zijn bestudeerd als de alternatieve poortdiëlektrica voor Ge p-type metaaloxide-halfgeleider veldeffecttransistoren (pMOSFET's) om schaalbaarheid van capaciteitsequivalentdikte (CET) naar sub-1 nm te bereiken. Onder deze ZrO2 diëlektricum heeft de meeste aandacht getrokken vanwege de veel hogere κ-waarde [12, 13] en de betere grensvlakkwaliteit [14] in vergelijking met de op Hf gebaseerde. Er is algemeen gerapporteerd dat kristallisatie van ZrO2 kan de elektrische prestaties van Ge pMOSFET verder verbeteren, bijv. CET verminderen en μ verhogen eff [15, 16]. Er is echter een gebrek aan onderzoek naar de effecten van processtappen voor ZrO2 kristallisatie op apparaatprestaties van Ge-transistors.
In dit artikel onderzoeken we de effecten van post-metal annealing (PMA) en post deposition annealing (PDA) op de elektrische prestaties van Ge pMOSFET's met ZrO2 diëlektrisch. Aanzienlijk verbeterd μ eff en lagere CET kan worden bereikt in apparaten met een hogere PMA-temperatuur.
Methoden
Belangrijkste processtappen voor het fabriceren van Ge pMOSFET's met ZrO2 diëlektricum worden getoond in Fig. 1a. De Ge pMOSFET's werden gefabriceerd op n-type Ge (001) wafer met een soortelijke weerstand van 0,088-0,14 Ω∙cm. Na de verschillende cycli van chemisch reinigen in de verdunde HF (1:50) oplossing en spoelen in DI-water. Ge-wafer werd in een atomaire laagafzettingskamer (ALD) geladen. Het Ge-oppervlak werd gepassiveerd door een ozon-post-oxidatie (OPO), d.w.z. een ultradunne Al2 O3 laag werd afgezet bij 300 ° C en vervolgens werd de in situ OPO gedurende 15 minuten bij 300 ° C uitgevoerd. Daarna een 5 nm dikke ZrO2 werd gedeponeerd bij 250°C in dezelfde ALD-kamer met behulp van TDMAZr en H2 O als voorlopers van respectievelijk Zr en O. Tijdens de afzetting Zr[N(CH3 )2 ]4 bron werd verwarmd tot 85°C. Het PDA-proces werd uitgevoerd op een monster bij 400 ° C gedurende 60 seconden met behulp van snel thermisch uitgloeien. Monsters met en zonder PDA werden respectievelijk wafer II en I genoemd. Vervolgens werd een 100 nm dikke TaN-poortelektrode afgezet door reactief sputteren. Na het poortpatroon en het etsen werden de source/drain (S/D)-regio's gevormd door BF2 + implantatie bij een energie van 30 keV en een dosis van 1 × 10 15 cm −2 . Vijftien nanometer nikkel S/D-contacten werden gevormd door een lift-off-proces. Ten slotte werd de PMA bij 350, 400, 450 en 500 ° C gedurende 30 ° C uitgevoerd voor doteringsactivering en S/D-metallisatie.
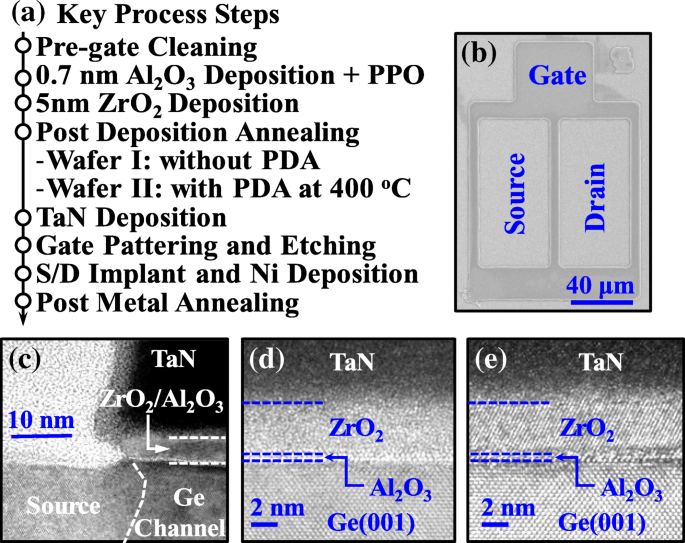
een Belangrijkste processtappen voor het fabriceren van Ge pMOSFET's met ZrO2 diëlektrisch. b SEM-afbeelding van de gefabriceerde transistor. c XTEM-afbeelding van Ge pMOSFET met de poort- en S/D-regio's. d , e HRTEM-beelden van gate-stacks van Ge pMOSFET's op wafer I, gegloeid bij respectievelijk 400 °C en 500 °C
Figuur 1b toont het beeld van de scanning elektronenmicroscoop (SEM) van een gefabriceerde Ge pMOSFET. Figuur 1c toont het transversale transmissie-elektronenmicroscoop (XTEM) beeld van Ge pMOSFET, met het source/drain-gebied, de metalen poort en ZrO2 diëlektrisch. Figuur 1d en e tonen de TEM-beelden (HRTEM) met hoge resolutie van de gate-stacks van Ge pMOSFET's met een PMA bij respectievelijk 400 en 500 °C op wafer I. Er wordt waargenomen dat de ZrO2 diëlektricum was volledig gekristalliseerd en onderging een PMA bij 500°C. De dikte van Al2 O3 grensvlaklaag is ongeveer 0,7 nm.
Resultaten en discussie
Inversiecapaciteit C inv vs. V GS curven gemeten met een frequentie van 300 kHz voor de apparaten op wafer I worden getoond in Fig. 2. De CET-waarden worden geëxtraheerd om -1,95, 1,80, 1,67 en 1,52 nm te zijn voor de apparaten met PMA op 350, 400, 450, en respectievelijk 500 °C. De kleinere CET wordt bereikt bij een hogere PMA-temperatuur door de kristallisatie van ZrO2 . In het algemeen zijn de κ-waarden voor amorf en kristallijn ZrO2 zijn respectievelijk ongeveer 20-23 en 28-30. Een 5 nm dik kristallijn ZrO2 draagt bij aan een EOT van ~ 0.7 nm. De verschuiving van C-V krommen met verschillende PMA-temperaturen is te wijten aan het feit dat kristallisatie de dichtheid van bulkvallen in ZrO2 vermindert diëlektrisch.
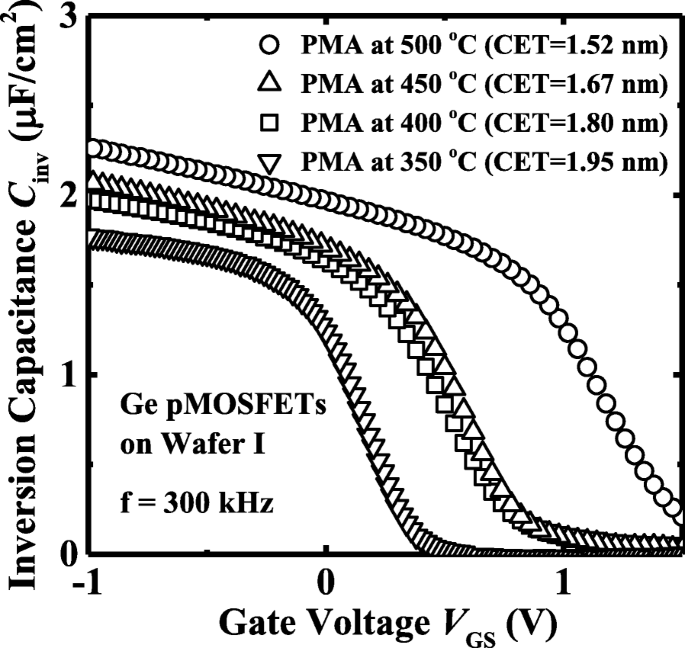
Inversie C inv -V GS krommen voor de Ge pMOSFET's op wafer I met een PMA bij 350 °C, 400 °C, 450 °C en 500 °C
Figuur 3a toont de gemeten overdrachtskarakteristieken en poortlekstromen I G van Ge pMOSFET's op wafer I met de verschillende PMA-temperaturen. Alle apparaten hebben een poortlengte L G van 4 μm en een poortbreedte W van 100 urn. Ge pMOSFET's vertonen de veel lagere I G vergeleken met ik DS voor alle PMA-temperaturen. Een ik AAN /Ik UIT verhouding boven 10 4 wordt bereikt voor het apparaat met een PMA bij 500 °C. De ik DS -V DS curven van de apparaten gemeten bij de verschillende gate overdrive |V GS -V TH | worden getoond in Fig. 3b. Opgemerkt wordt dat de drempelspanning V TH wordt gedefinieerd als de V GS bij ik DS van 10 −7 A/μm. De Ge-transistor met een PMA bij 500 °C behaalt de ~-47% en 118% aandrijfstroomverbetering vergeleken met de apparaten die zijn uitgegloeid bij respectievelijk 450 °C en 350 °C bij een V DS van − 1.0 V en een |V GS -V TH | van 0,8 V. Figuur 3c toont de statistische grafiek van de I AAN op een V DS van − 0,5 V en een V GS -V TH van − 1 V voor Ge pMOSFET's met de verschillende PMA-temperaturen. Alle transistors in deze plot hebben een L G van 4 μm en een W van 100 urn. Apparaten met een PMA bij 500 °C vertonen een verbeterde I AAN in vergelijking met die met de lagere PMA-temperaturen, wat wordt toegeschreven aan de verminderde S/D-weerstand, de verminderde CET en de hogere μ eff , die later zal worden besproken.

een Gemeten I D , ik S , en ik G tegen. V GS krommen van Ge pMOSFET's op wafer I met de PMA bij 350, 400, 450 en 500 ° C. b Ik DS -V DS krommen gemeten bij de verschillende V GS -V TH voor de apparaten. c Apparaat gegloeid bij 500 °C heeft een hogere stroomsterkte I AAN vergeleken met de transistors met de PMA bij de lagere temperaturen
Figuur 4 toont de statistische plots van midgap D het , SS en V TH kenmerken voor de apparaten met de verschillende PMA-temperaturen. Zoals getoond in Fig. 4a, gebaseerd op de maximale geleidingsmethode [17], de midgap D het waarden worden geëxtraheerd om 1,3 × 10 13 . te zijn , 9,5 × 10 12 , 9,2 × 10 12 , en 6,3 × 10 12 cm −2 eV −1 voor de apparaten met de PMA bij respectievelijk 350, 400, 450 en 500 °C. Figuur 4b laat zien dat Ge pMOSFET's gegloeid bij 500 ° C de verbeterde SS-kenmerken hebben dan de transistors die zijn uitgegloeid bij de lagere temperaturen, vanwege de kleinere midgap D het en CET. De waarden van D het en SS van Ge pMOSFET's met PMA zijn nog steeds hoger dan die van de best gerapporteerde Ge-transistoren. Het kan mogelijk worden verminderd door de OPO-passiveringsmodule te optimaliseren, bijvoorbeeld Al2 O3 dikte en ozon oxidatie temperatuur en duur. V TH verschuift naar de positieve V GS met de stijging van de PMA-temperatuur, die afkomstig is van de verlaagde CET en D het . Er wordt geconcludeerd dat de beste elektrische prestaties worden bereikt voor Ge pMOSFET's met een PMA bij 500 °C.
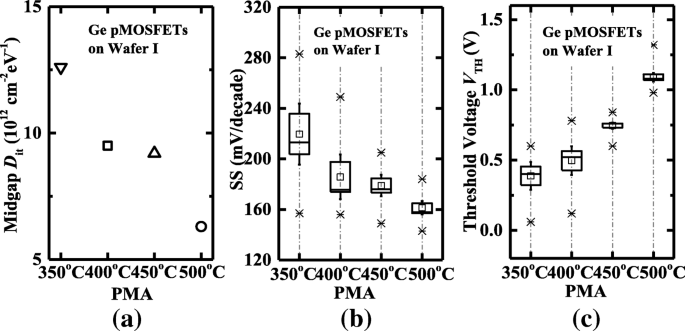
Vergelijking van a midgap D het , b SS en c V TH voor Ge pMOSFET's op wafer I met de PMA bij 350, 400, 450 en 500 °C
μ eff , als een cruciale factor die de aandrijfstroom en transconductantie van het apparaat in Ge pMOSFET's beïnvloedt, werd gemeten met behulp van de ΔR tot /ΔL G methode [18]. Een groot aantal apparaten is gemeten met L G variërend van 1,5 tot 9 m. Figuur 5a illustreert de totale weerstand R tot geëxtraheerd met een |V GS -V TH | van − 1 V en een V DS van − 0,05 V als functie van L G . De R SD is de waarde waarbij de gepaste lijn snijdt op de y -as. De R SD waarden werden geschat op ongeveer 7,85, 7,15, 6,10 en 4,35 kΩ ·μm voor apparaten met PMA bij respectievelijk 350, 400, 450 en 500 °C. Dit is indicatief voor de betere doteringsactivering van S/D bij hogere PMA-temperatuur. μ eff kan worden geëxtraheerd door μ eff = 1/[WQ inv (ΔR tot /ΔL G )], waarbij Q inv is de inversieladingsdichtheid in het Ge-kanaal en ΔR tot /ΔL G is de helling van de R tot vs. L G zoals getoond in Fig. 5a. De kleinere ΔR tot /ΔL G voor apparaten met PMA bij 500 °C duidt op een verbetering in μ eff in vergelijking met transistors met PMA bij 450 °C. Afbeelding 5b toont μ eff als een functie van Q inv curven, geëxtraheerd met behulp van de split C -V methode. De mobiliteit van het piekgat is 384 cm 2 /V ·s voor apparaten met een PMA bij 500 °C, wat 31% hoger is dan die van de apparaten met een PMA bij 400 °C. Bij een hoge Q inv van 1 × 10 13 cm −2 , Ge pMOSFET's die een PMA bij 500 ° C hebben ondergaan, bereiken een mobiliteitsverbetering in vergelijking met de apparaten die zijn uitgegloeid bij 400 ° C. Ge-transistors met kristallijn ZrO2 hebben de lagere dichtheid van de bulktraplading, wat resulteert in een lagere Coulomb-verstrooiing op afstand van gaten, vergeleken met de apparaten met amorf ZrO2 . Dankzij de gladde interface tussen kristallijn ZrO2 en Ge, Ge-apparaten gegloeid bij 500 °C hebben een lagere verstrooiing van de oppervlakteruwheid en vertonen een verschuiving van piekmobiliteit naar de hogere Q inv .
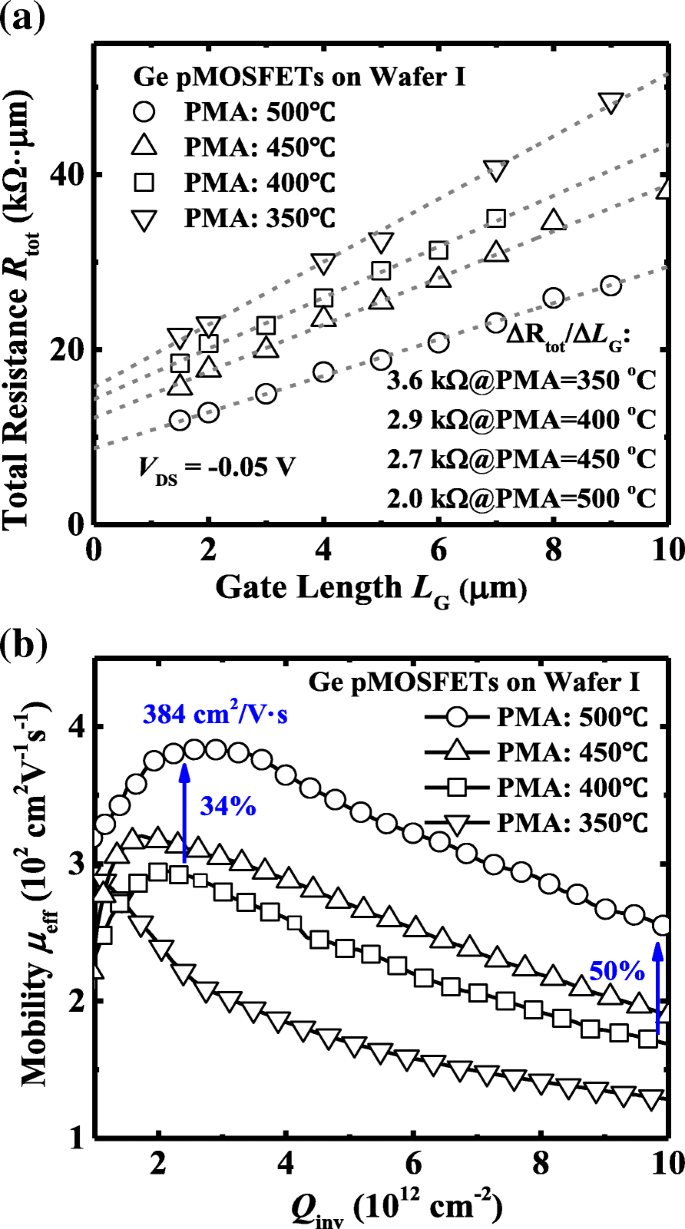
een R tot als een functie van L G op een V GS -V TH van − 1 V en een V DS van − 0,05 V voor apparaten op wafer I met verschillende PMA-temperaturen. b μ eff tegen. V inv geëxtraheerd door de splitsing C -V methode. De hoogste mobiliteit wordt verkregen in apparaten met een PMA bij 500 °C
Vervolgens bespreken we de effecten van PDA op de elektrische kenmerken van Ge pMOSFET's. Afbeelding 6 toont de gemeten C inv vs. V GS van de Ge pMOSFET's op wafer I en wafer II met een PMA bij 400 °C. Het apparaat dat een PDA heeft ondergaan bij 400 °C heeft een veel lagere CET-waarde van 1.29 nm vergeleken met het apparaat zonder PDA, 1.80 nm. Afbeelding 7a toont de I D , ik S , en ik G -V GS karakteristieke curven van Ge pMOSFET's op wafer I en wafer II, en de apparaten die een PMA ondergingen bij 400 °C. Een grotere gate-lekstroom wordt verkregen voor het apparaat met PDA in vergelijking met de transistor zonder PDA, wat te wijten is aan de lagere CET. De bijbehorende I DS -V DS curven van de apparaten gemeten bij verschillende gate overdrive V GS -V TH worden getoond in Fig. 7b. De Ge-transistor zonder PDA vertoont een verbetering van ~-24% in stuurstroom ten opzichte van die met PDA bij 400 °C bij dezelfde overdrive van -0,8 V in het verzadigingsgebied.
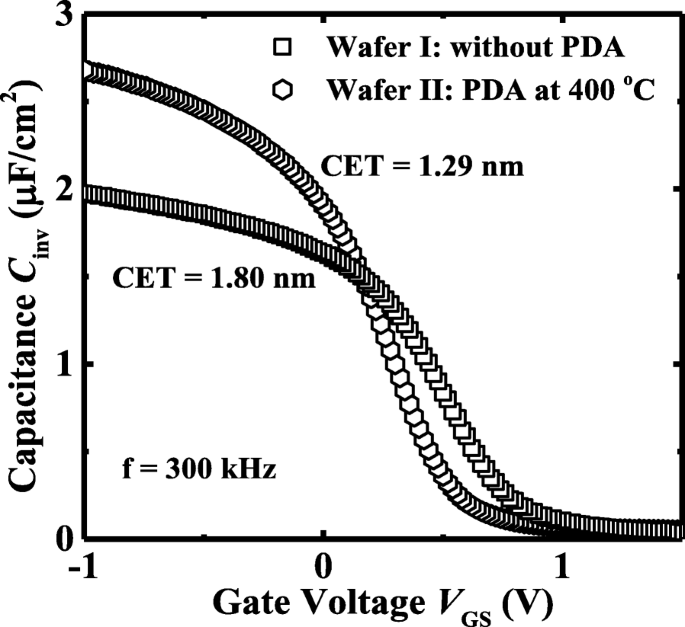
C inv -V GS plots voor de apparaten op wafer I en II met een PMA bij 400 °C
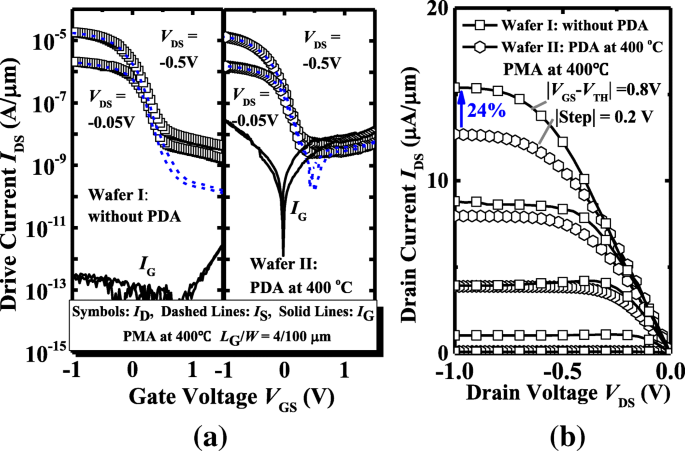
een Ik D , ik S , en ik G tegen. V GS krommen van Ge pMOSFET's op wafer I en II met PMA bij 400 °C. b Ik DS -V DS krommen gemeten bij verschillende V GS -V TH voor de apparaten
Figuur 8 plot de statistische resultaten van midgap D het , SS en V TH van de Ge pMOSFET's met en zonder PDA. Figuur 8a laat zien dat de kleinere D het wordt bereikt in Ge pMOSFET's met PDA bij 400 ° C in vergelijking met apparaten zonder PDA. In Fig. 8b wordt de lagere waarde van de gemiddelde subdrempelzwaai van 142 mV/decade bereikt voor apparaten met PDA bij 400 °C, wat overeenkomt met de lagere CET en de lagere D het . Het geeft aan dat apparaten met PDA bij 400 °C een superieure ZrO2 . hebben /Ge-interface. Afbeelding 8c laat zien dat apparaten met en zonder PDA een verschillende V . hebben TH; het kan worden toegeschreven aan de dichtheid van vallen in de onderste bandgap die half dominant is in de V TH .
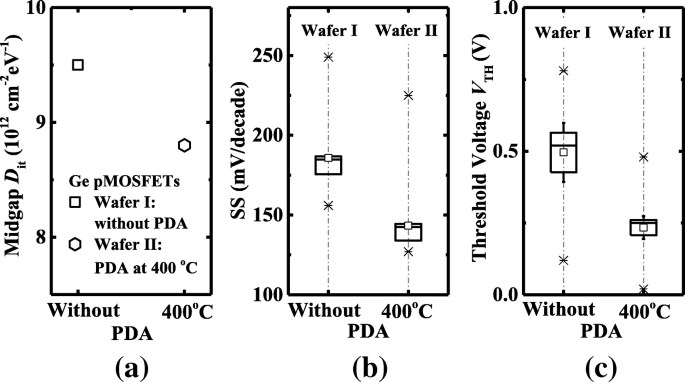
Vergelijking van a midgap D het , b SS en c V TH voor Ge pMOSFET's op wafer I en II met PMA bij 400 °C
Afbeelding 9a toont de R tot vs. L G bochten bij een gate-overdrive van − 1 V en V DS van − 0,05 V voor apparaten met een PMA bij 400 °C. De R SD waarden worden geschat op respectievelijk 7,15 en 7,30 kΩ·μm voor apparaten zonder en met PDA bij 400 °C. Zoals getoond in Fig. 9b, een opmerkelijk hogere piek μ eff wordt bereikt voor Ge pMOSFET's zonder PDA, wat overeenkomt met de kleinere ΔR tot /ΔL G in Fig. 9a, vergeleken met apparaten met PDA. De apparaten met een PDA bij 400 °C vertonen een piek μ eff van 211 cm 2 /V·s; de mobiliteit van het onderste gat kan voornamelijk worden toegeschreven aan de sterke Coulomb-verstrooiing op afstand die wordt bijgedragen door de vaste lading in ZrO2 diëlektrisch.
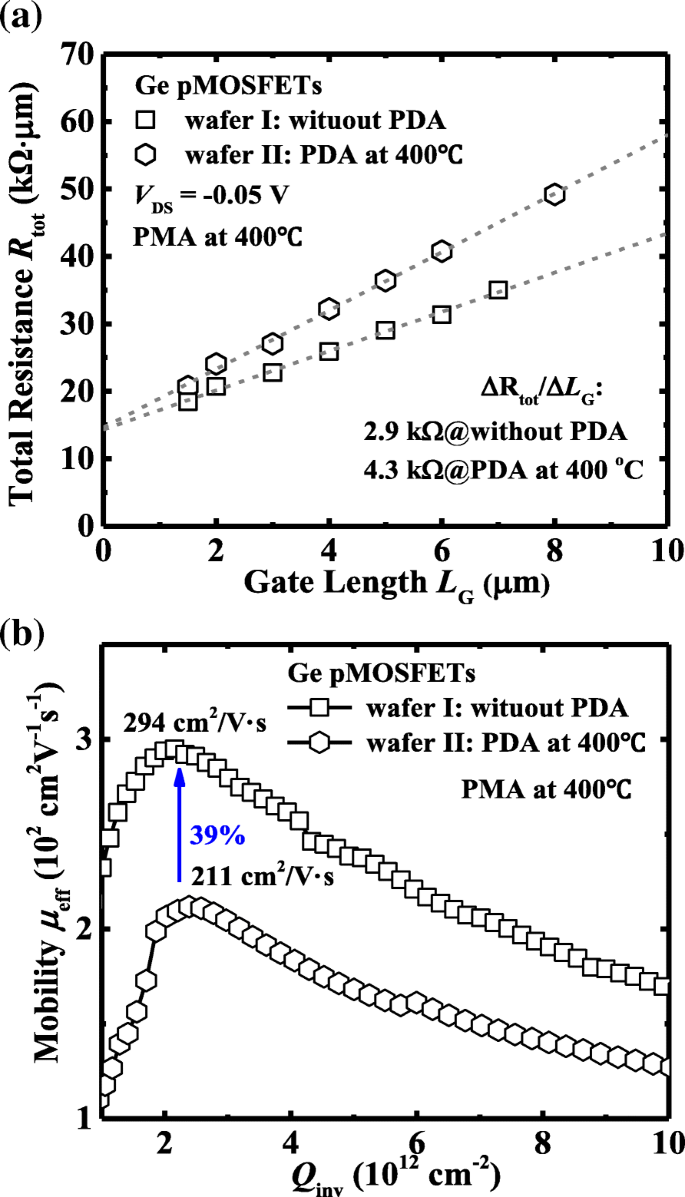
een R tot vs. L G curven voor apparaten op wafer I en wafer II met PMA bij 400 °C. b Gatenmobiliteit μ eff vs. Q inv voor apparaten met en zonder PDA
Conclusies
Samenvattend, de effecten van PMA en PDA op Ge pMOSFET met ZrO2 diëlektricum werden uitgebreid onderzocht. Kristallisatie van ZrO2 gate-diëlektricum zorgt voor aanzienlijk verbeterde gatenmobiliteit en verminderde CET in vergelijking met apparaten bij de lagere PMA-temperatuur. Een piekgatmobiliteit van 384 cm 2 /V·s en verbeterde aandrijfstroom zijn bereikt in apparaten met PMA bij 500 °C. Apparaten met PDA bij 400 °C vertoonden de lagere CET en de kleinere D het maar de slechte mobiliteit van de gaten en de grotere lekstroom vergeleken met transistors zonder PDA.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- BF2 + :
-
Boorfluoride-ion
- CET:
-
Capacitieve effectieve dikte
- Ge:
-
Germanium
- HF:
-
Fluorwaterstofzuur
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- IL:
-
Tussenlaag
- MOSFET's:
-
Metaaloxide-halfgeleider veldeffecttransistoren
- Ni:
-
Nikkel
- PDA:
-
Uitgloeien na depositie
- PMA:
-
Na metaalgloeien
- SS:
-
Subdrempelzwaai
- TaN:
-
Tantaalnitride
- TDMAZr:
-
Tetrakis (dimethylamido) hafnium
- ZrO2 :
-
Zirkoniumdioxide
- μ eff :
-
Effectieve vervoerdermobiliteit
Nanomaterialen
- KUHMUTE herontwerpt mobiliteit met SLS 3D Printing
- 3D-printen met hoge snelheid met AFPM
- 3D-printen met hoge snelheid met AION500MK3
- Volledige Terahertz-polarisatiecontrole met verbrede bandbreedte via diëlektrische metasurfaces
- Compliance-vrij ZrO2/ZrO2 − x /ZrO2 resistief geheugen met controleerbaar interfaciaal multistate schakelgedrag
- Polarisatieconverter met regelbare dubbele breking op basis van hybride volledig diëlektrisch grafeenmetasurface
- Hoge prestatie organisch-nanogestructureerde silicium hybride zonnecel met aangepaste oppervlaktestructuur
- Diëlektrische verbetering van door atoomlaag afgezette Al2O3/ZrO2/Al2O3 MIM-condensatoren door middel van microgolfgloeien
- Een nanoschaal low-power weerstandloze spanningsreferentie met hoge PSRR
- Ge pMOSFET's met hoge mobiliteit met amorfe Si-passivering:impact van oppervlakteoriëntatie
- Verbeterde Si-passivering en PERC-zonnecelefficiëntie door atomaire laag afgezet aluminiumoxide met tweestaps nagloeiing



