Vergelijkende analyse van defecten in Mg-geïmplanteerde en Mg-gedoteerde GaN-lagen op vrijstaande GaN-substraten
Abstract
Inefficiënte Mg-geïnduceerde p-type doping is een belangrijk obstakel gebleven bij de ontwikkeling van op GaN gebaseerde elektronische apparaten voor solid-state verlichting en stroomtoepassingen. Deze studie rapporteert een vergelijkende structurele analyse van defecten in GaN-lagen op vrijstaande GaN-substraten waar Mg-opname wordt uitgevoerd via twee benaderingen:ionenimplantatie en epitaxiale doping. Scanning-transmissie-elektronenmicroscopie onthulde het bestaan van piramidale en lijndefecten alleen in Mg-geïmplanteerde monsters, terwijl Mg-gedoteerde monsters de aanwezigheid van deze defecten niet vertoonden, wat suggereert dat de aard van defecten afhangt van de opnamemethode. Uit secundaire ionenmassaspectrometrie wordt een directe overeenkomst waargenomen tussen Mg-concentraties en locatie en type van deze defecten. Onze onderzoeken suggereren dat deze piramidale en lijndefecten Mg-rijke soorten zijn en dat hun vorming kan leiden tot verminderde dichtheid van vrije gaten, wat nog steeds een grote zorg is voor op p-GaN gebaseerd materiaal en apparaten. Aangezien vrijstaande GaN-substraten een platform bieden voor de realisatie van op pn-junctie gebaseerde verticale apparaten, zal vergelijkend structureel onderzoek van defecten die zijn ontstaan door verschillende Mg-opnameprocessen in GaN-lagen op dergelijke substraten waarschijnlijk meer inzicht geven in het begrijpen van Mg-zelfcompensatiemechanismen en vervolgens het optimaliseren van het Mg-doping- en/of implantatieproces voor de vooruitgang van op GaN gebaseerde apparaattechnologie.
Inleiding
In de afgelopen drie decennia is GaN naar voren gekomen als een van de meest onderzochte samengestelde halfgeleiders over de hele wereld. Dit is voornamelijk te danken aan het enorme potentieel, niet alleen in solid-state verlichtingstoepassingen, maar ook in toepassingen met hoog vermogen, hoge frequentie en hoge temperatuur [1,2,3,4,5,6,7,8]. Voor een succesvolle inzet van apparaten op basis van GaN en gerelateerde heterostructuren in dergelijke toepassingen en operaties, is controleerbare n-type en p-type doping de belangrijkste vereiste. In dit aspect is het bereiken en beheersen van n-type doping in GaN-epilagen of eenkristallen nu in hoge mate geoptimaliseerd in vergelijking met zijn p-type tegenhanger, die nog steeds een knelpunt is voor zowel de academische wereld als de industrie. Tot nu toe heeft Mg bewezen de meest efficiënte p-type doteringsstof te zijn, ondanks de hoge activeringsenergie die een grote hoeveelheid Mg-concentraties vereist (ongeveer 10 19 cm −3 of meer) die moeten worden opgenomen om redelijke vrije-gatconcentraties van bijna 10 18 . te bereiken cm −3 . Elke verhoging van Mg-atoomconcentraties boven 10 19 cm −3 leiden tot een afname van de vrije-gatconcentratie [9,10,11]. Dit fenomeen wordt voornamelijk toegeschreven aan het ontstaan van N-vacatures [12,13,14], Mg-gerelateerde puntdefecten [10, 15], of Mg-vacature-gerelateerde geladen en/of neutrale complexen die het Fermi-niveau verlagen en het vrije gat verzadigen. concentraties [16, 17]. Op basis van fotoluminescentiemetingen die aanleiding geven tot een piek bij 2,9 eV, een diep donordefectcomplex Mg-VN werd ook beschouwd als een van de belangrijkste redenen voor het zelfcompensatiemechanisme. [17,18,19]. Ondanks het aantal significante onderzoekspogingen die zijn ondernomen om de Mg-opname in GaN te begrijpen, blijft dit probleem dus nog steeds onduidelijk en moet verdere analyse worden uitgevoerd.
De meeste van de eerdere rapporten over defectanalyse met behulp van microscopische studies op atomaire schaal zijn gebaseerd op Mg-gedoteerde GaN-lagen die op saffier zijn gegroeid met behulp van metaal-organische chemische dampafzetting (MOCVD) of moleculaire bundelepitaxie (MBE). Voor zover wij weten, zijn er maar weinig rapporten over defectanalyse in met Mg gedoteerde vrijstaande GaN-substraten en er is geen rapport over op transmissie-elektronenmicroscopie gebaseerde defectenanalyse in vrijstaande GaN-substraten waar Mg is opgenomen via ionenimplantatie. Het is nu algemeen aanvaard dat vrijstaande GaN-substraten verschillende voordelen hebben ten opzichte van met MOCVD/MBE gegroeide GaN-lagen op vreemde substraten vanwege het verminderde niveau van dislocatiedichtheden en hun toepassingen in efficiënte verticale apparaten. Het bereiken van voldoende p-type doteringsactiviteit in dergelijke substraten via ionenimplantatie moet worden onderzocht voor de commercialisering en ontwikkeling van op GaN gebaseerde solid-state verlichting en krachtige apparaten. Met al deze problemen als primaire doelstelling, hebben we een gedetailleerde structurele analyse uitgevoerd van Mg-geïntegreerde defecten in vrijstaande GaN-lagen waar Mg-opname wordt bereikt door zowel doping als ionenimplantatie.
Experimentele methoden
In onze studie worden vrijstaande n-GaN-substraten gebruikt die zijn gekweekt met behulp van hydridedampfase-epitaxie. Daarna worden epitaxiale lagen door MOCVD op deze substraten gekweekt. Mg-opname wordt uitgevoerd via twee benaderingen:ionenimplantatie en epitaxiale doping. In het eerste geval wordt Mg geïmplanteerd in een 4 μm dikke ongedoteerde GaN-epitaxiale laag zonder enige beschermingslaag af te zetten op ongedoteerde GaN-lagen, terwijl in het tweede geval 1 μm dikke Mg-gedoteerde GaN epitaxiaal wordt gekweekt op 4 μm -dikke ongedoteerde GaN-lagen continu. Voor een betrouwbare vergelijking wordt het niveau van Mg-opname hetzelfde gehouden als 4 × 10 19 cm −3 in beide gevallen. De Mg-implantatie wordt uitgevoerd bij 500 ° C, gevolgd door uitgloeien bij 1350 ° C voor activering van doteerstoffen. De implantatie-energieën worden genomen als 15, 30, 55, 95 en 180 keV met respectievelijke doseringen van 3,0 × 10 13 , 5,5 × 10 15 , 1.1 × 10 14 , 1,9 × 10 14 , en 8 × 10 14 cm −2 , om een 200 nm diep doosprofiel te verkrijgen. Hall-metingen worden uitgevoerd om de elektrische eigenschappen van zowel met Mg gedoteerde als met Mg geïmplanteerde GaN-monsters te evalueren. Voor Mg-gedoteerde GaN-monsters zijn de gatenconcentratie en mobiliteit 3,4 × 10 17 cm −3 en 9,5 cm 2 /V-s. Aan de andere kant konden de elektrische eigenschappen van het Mg-geïmplanteerde monster niet goed worden geëvalueerd vanwege de hoge weerstand. De verdeling van Mg als functie van de diepte wordt onderzocht met behulp van secundaire ionenmassaspectrometrie (SIMS), terwijl scanning transmissie-elektronenmicroscopie (STEM) -analyse wordt gebruikt voor structureel onderzoek van Mg-geïnduceerde defecten. Hiervoor zijn STEM- en elektronenenergie-dispersieve röntgenspectroscopie (EDS) uitgevoerd door JEOL JEM-ARM200F die werkt op 200 en 80 kV. Voor deze onderzoeken werden TEM-specimens bereid door gefocusseerd ionenbundelfrezen met behulp van Ga-bundels, gevolgd door een met vloeibare stikstof gekoeld laag-energetisch Ar-ionenfrezen.
Resultaten en discussie
Defectenanalyse in Mg-geïmplanteerde GaN-laag
Afbeelding 1(a) toont het heldere veld (BF)-STEM-beeld van Mg-geïmplanteerde GaN, terwijl (b) het bijbehorende SIMS-profiel toont. De pijl in Fig. 1(a) vertegenwoordigt de positieve richting [0001] en afbeeldingen worden bekeken langs de zone-as [11\( \overline{2} \)0]. Men kan zien dat defecten niet uniform verdeeld zijn als functie van de diepte, in feite wordt er een directe correlatie gezien tussen de concentraties van Mg en defecten. De meeste defecten worden verzameld op ongeveer 150 nm van het oppervlak waar de Mg-concentratie meer dan 10 19 is cm −3 zoals waargenomen bij SIMS-metingen. Voor een beter begrip van defecten en hun visualisaties als gevolg van Mg-implantatie in GaN, wordt beeldvorming uitgevoerd in off-zone asconditie door het monster 10° rond de c-as te kantelen vanaf de [11\( \overline{2} \)0]-as . Deze toestand verzwakt het diffractiecontrast als gevolg van perfect kristal en verbetert het defectencontrast, wat een betere visualisatie van de defecten mogelijk maakt in vergelijking met de omgeving. BF-STEM-beeld van Mg-geïmplanteerd GaN-monster genomen onder deze off-zone as-omstandigheden wordt getoond in Fig. 1 (c), waar enkele lijndefecten worden gezien op een diepte van ongeveer 200 nm vanaf het oppervlak. Het overeenkomstige Mg SIMS-profiel wordt weergegeven in (d) op lineaire schaal waar een directe overeenkomst wordt waargenomen tussen het bestaan van deze lijndefecten en de Mg-concentratie. Deze defecten blijken zich te bevinden in een smal gebied waar de Mg-concentratie ongeveer midden 10 19 is cm −3 bereik.
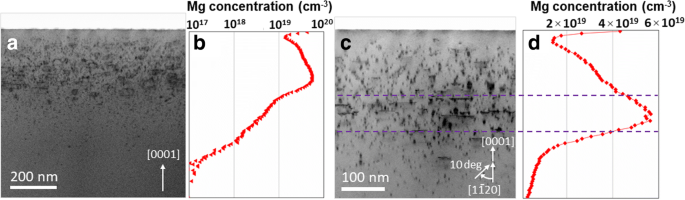
een Dwarsdoorsnede helder veld STEM-beeld van Mg geïmplanteerd GaN-monster verkregen langs de as [11\( \overline{2} \)0] en b overeenkomstig diepteprofiel van Mg verkregen met behulp van SIMS. Voor een betere visualisatie van de defecten en hun relatie tot de Mg-concentratie, wordt beeldvorming uitgevoerd onder off-zone as-conditie zoals weergegeven in c . Mg-profiel dat overeenkomt met c wordt weergegeven in d op lineaire schaal waar lijndefecten worden waargenomen in een smal gebied met de hoogste Mg-concentratie
Verder wordt BF-STEM-beeldvorming met hoge vergroting uitgevoerd onder off-zone-asconditie zoals weergegeven in figuur 2 (a) waarbij (b) het geselecteerde gebied van (a) met een hogere vergroting laat zien. Zoals weergegeven in (b), worden vier soorten structuren gelabeld als A, B, C en D waargenomen. De defecten die zijn aangeduid als "A" hebben een piramidale vorm, terwijl "B" verschijnen als lijndefecten.

een Dwarsdoorsnede helder veld STEM-beeld van Mg geïmplanteerd GaN-monster verkregen in off-zone as-conditie om de defectencontrasten te versterken. Vergrote weergave van gemarkeerd gebied in (a ) wordt gepresenteerd in (b ) waar vier verschillende soorten defecten gelabeld als A, B, C en D worden waargenomen. TEM-afbeelding met hoge resolutie van de piramidale domeinen gelabeld als A in (b ) wordt weergegeven in (c ) met schematische weergave rechtsonder. Het vervormde rooster op het piramidale domein wordt weergegeven door te knijpen (c ) zoals weergegeven in (d ). TEM-beeld met hoge resolutie van een typisch C- of D-type defect wordt weergegeven in (e ) met geperste afbeelding in (f ), met spanningsveldcontrast rond het defect
De structurele observaties van deze defecten zijn belangrijk vanuit het oogpunt van het begrijpen van Mg-compensatiemechanismen, en de volgende secties van het manuscript zijn voornamelijk gewijd aan structurele analyse van type "A" en "B" defecten. De structuren weergegeven als "A" zijn piramidale defecten met een positieve richting gericht naar hun hoofd, hun basis op een [0001] vlak met zes wanden op [11\( \overline{2} \)3] vlakken hellend zoals getoond door TEM-beeld met hoge resolutie van een dergelijk defect in Fig. 2 (c). De schematische weergave van een dergelijk piramidaal domein wordt ook getoond in figuur 2 (c). Figuur 2 (c) wordt loodrecht op de richting van [0001] geperst, zoals weergegeven in (d) waar het rooster lijkt te zijn vervormd in het piramidale domein in vergelijking met de omringende GaN-matrix, wat wijst op verplaatsing tussen de Ga- en N-subroosters binnen en buiten deze piramidale domeinen . Dit komt overeen met de bevindingen van Vennegues et al. [20] waar soortgelijke piramidale domeinen worden waargenomen. De soortgelijke piramidale vormdefecten zijn eerder waargenomen in met Mg gedoteerde GaN-films en hun bestaan wordt meestal verklaard door modificatie in de GaN-atoomstructuur als gevolg van Mg-introductie [19,20,21,22,23,24]. Liliental-Weber et al. [25, 26] stelden voor dat dergelijke piramidale defecten afkomstig zijn van Mg-rijke clusters die aanwezig zijn nabij de kop van deze piramides. De GaN-structuur in de wurtzietfase wordt meestal beschreven door hexagonale stapeling van N-vlakken waarbij de helft van de N-subrooster-tetraëders gevuld zijn met Ga-atomen. Vennegues et al. [27] op basis van hun onderzoek stelden ze voor dat de introductie van een hoger Mg-gehalte in GaN resulteert in de vervanging van Ga door Mg, waardoor Mg3 N2 , een Mg-N-verbinding waarvan is gemeld dat deze een antibixbyietstructuur heeft. De antibixbyte-structuur van Mg3 N2 komt overeen met de vulling van N-subrooster-tetraëders door Mg, dat drie van de vier plaatsen inneemt. Volgens het model voorgesteld door Vennegues et al. [27] kan een piramidaal domein worden beschouwd als twee GaN-kristallen met tegengestelde polariteit, gescheiden door een monolaag van Mg3 N2 . Dit wordt verder ondersteund door de onderzoeken van Hansen et al. [28] waar deze piramidale domeinen werden voorgesteld als Mg3 N2 insluitsels. Vennegues et al. [27] en Leroux et al. [23] meldde ook dat de vorming van dergelijke piramidale domeinen met een nanometergrootte ook een Mg-opname vereist van laag tot midden 10 19 cm −3 bereik. Dit komt overeen met onze bevindingen waar de piramidale vormdefecten worden waargenomen bij lagere tot medio-10 19 cm −3 Mg-concentraties zoals blijkt uit de correlatie tussen STEM-afbeelding (Fig. 1 (c)) en het bijbehorende SIMS-profiel (Fig. 1 (d)). Daarom wordt aangenomen dat de piramidale vormdefecten die zijn aangeduid als structuren "A" in figuur 2 (b) van onze studie Mg-rijke piramidale domeinen zijn en dat hun vorming direct kan worden gekoppeld aan het Mg-compensatiemechanisme in p-GaN-lagen. Andere soorten defecten zoals weergegeven in Fig. 2(b) zijn type "C" en "D" defecten die in wezen vergelijkbare structuren zijn met variatie in hun afmetingen. Het contrast dat langwerpig lijkt te zijn langs de richting [0001], gezien vanaf de as [11\( \overline{2} \)0], is waarschijnlijk afkomstig van spanning. Om dit verder te verduidelijken, wordt een TEM-beeld met hoge resolutie van een dergelijk soortgelijk defect weergegeven in Fig. 2 (e) waarbij (f) hetzelfde beeld laat zien, loodrecht op de richting [0001] geperst. Het vervormde rooster in de richting [0001] suggereert een verschillende roosterconstante als gevolg van een verschillend spanningsveld in deze richting. Omdat Mg kleiner is in vergelijking met Ga, wordt verwacht dat de opname ervan op de Ga-sites spanning in het rooster veroorzaakt, wat kan leiden tot dit contrast rond deze defecten.
Een ander type defect, aangeduid als "B" in figuur 2 (b), lijkt lijndefecten loodrecht op de richting [0001] te zijn, gezien vanaf de as [11\( \overline{2} \)0]. Het is belangrijk op te merken dat dergelijke defecten lijken te worden geaccumuleerd in een smal gebied met hogere Mg-concentraties (zoals waargenomen uit de overeenkomst tussen het BF-STEM-beeld en het Mg SIMS-profiel getoond in Fig. 1(c) en (d)) die suggereert dat hun vorming wordt geassocieerd met de overmatige opname van Mg. Een andere observatie is de aanwezigheid van de piramidale domeinen aan de randen van deze lijndefecten, wat erop wijst dat accumulatie van deze domeinen kan leiden tot hun vorming. Men moet echter niet uitsluiten dat het gewoon een willekeurige overlap van piramidale en lijndefecten kan zijn en dat verder onderzoek in deze richting nodig is. Het BF-STEM-beeld dat dit soort defecten laat zien, wordt weergegeven in figuur 3(a). Voor een beter begrip van deze defecten wordt het monster gekanteld op ongeveer 10 ° rond de as loodrecht op de richting [0001] en het verkregen BF-STEM-beeld wordt getoond in figuur 3(b). Deze kanteling van het monster prikkelt de diffractievlekken sterk in de richting van 1-100, wat resulteert in een verbeterd contrast van het spanningsveld in de richting rond het defect. Uit dit spanningsveldcontrast bestaat het defect dat verscheen als de lijn (zie Fig. 2(a) en (b)) in feite uit een paar lijnen gescheiden door enkele nm, dieper in de richting [0001].

een Dwarsdoorsnede helder veld STEM-beeld van Mg-geïmplanteerd bulk GaN-monster voor het analyseren van type B-defecten die eruitzien als afgeknotte piramides of trapeziumvormige vorm. b geeft het beeld weer dat is genomen door het monster op 10° rond de as loodrecht op c . te kantelen -as waar een ander contrast wordt waargenomen aan de randen van deze defecten
Er kan een mogelijkheid zijn van aanwezigheid van Mg in deze defecten, aangezien ze zich voordoen in het smallere gebied waar de Mg-concentratie hoger is dan 10 19 cm −3 zoals waargenomen uit de overeenkomst tussen STEM-afbeelding (Fig. 1 (c)) en Mg SIMS-profiel (Fig. 1 (d)). Om deze overtuiging van dit soort defecten met Mg te valideren, hebben we scanning-transmissie-elektronenmicroscopie-energie-dispersieve spectroscopie (STEM-EDS) metingen uitgevoerd met een EDS-sondediameter van minder dan 0,2 nm, in twee verschillende regio's:"weg van defect" en "bij defect" aangeduid als respectievelijk punten 1 en 2, zoals weergegeven in Fig. 4(a). De vergelijkende EDS-spectra van punten 1 en 2 in het energiebereik van 1.19 keV tot 1.35 keV waar Mg-piek wordt verwacht, zijn uitgezet in Fig. 4 (b) met inzet die volledige EDS-spectra toont. De aanwezigheid van Mg is duidelijk te zien bij defect (punt 2). Om dit verder te rechtvaardigen, hebben we STEM-EDS-mapping uitgevoerd op een vergelijkbaar Mg-geïmplanteerd GaN-monster. Figuur 4 (c) geeft een STEM-beeld weer van een Mg-geïmplanteerd GaN-monster met neerwaartse pijlen die deze lijndefecten tonen, en de overeenkomstige EDS-kaart van Mg wordt getoond in figuur 4 (d). De aanwezigheid van Mg is duidelijk te zien in deze defecten. Daarom bevatten deze defecten Mg en hun vorming bij Mg-concentraties hoger dan 10 19 cm −3 is waarschijnlijk een andere oorzaak van Mg-compensatie.

een Dwarsdoorsnede STEM-beeld van Mg geïmplanteerd GaN-monster met een individueel type "B" -defect. Punten 1 en 2 vertegenwoordigen regio's waar EDS-metingen worden uitgevoerd en resulterende EDS-spectra worden weergegeven in b . EDS-spectra in het energiebereik van 1,19–1,40 keV zijn uitgezet in b met inzet met de volledige EDS-spectra met Ga- en N-pieken. c en d huidige STEM-afbeelding en bijbehorende Mg-kaart van een vergelijkbaar Mg-geïmplanteerd bulkmonster dat de aanwezigheid van Mg in dit soort defecten laat zien
Defectenanalyse in Mg-gedoteerde GaN-laag
Vervolgens hebben we structureel onderzoek uitgevoerd op het GaN-monster waar 1 m dikke Mg-gedoteerde GaN-laag epitaxiaal wordt gekweekt op een 4 μm dikke ongedoteerde GaN-epitaxiale laag. Het is de moeite waard nogmaals te vermelden dat het Mg-niveau hetzelfde blijft, d.w.z. 4 × 10 19 cm −3 voor een zinvolle vergelijking tussen twee benaderingen van Mg-opname:epitaxiaal gedoteerd en ionenimplantatie. Figuur 5(a) toont een BF-STEM-afbeelding van met Mg gedoteerd GaN epitaxiaal gegroeid op vrijstaande GaN-substraten, gezien langs [11\( \overline{2} \)0], terwijl (b) het Mg-profiel laat zien als een functie van de GaN-diepte verkregen met behulp van SIMS. Merk op dat de Mg-concentratie bijna constant blijft op ongeveer 4 × 10 19 cm −3 binnen het gezichtsveld van Fig. 5(a) (tot 700 nm) in tegenstelling tot het eerdere geval van Mg-geïmplanteerd GaN waar de Mg-concentratie een functie bleek te zijn van de GaN-diepte (zie Fig. 1 (a)-(d )).
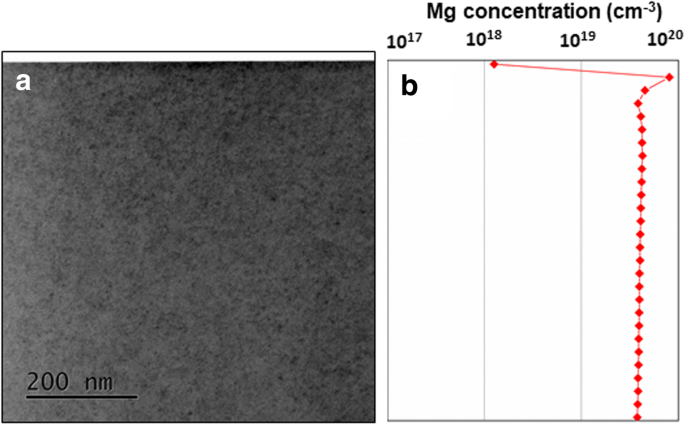
een Helderveld STEM-beeld in dwarsdoorsnede van met Mg gedoteerd bulk-GaN-monster verkregen langs de as [112 ̅0] en b overeenkomstig diepteprofiel van Mg verkregen met behulp van SIMS. Puntachtige defecten blijken gelijkmatig over het monster te zijn verdeeld
Om defectenanalyse uit te voeren in met Mg gedoteerd GaN-monster, STEM-beeldvorming in off-zone-asconditie door het monster op 10° rond c te kantelen -as van de as [11\( \overline{2} \)0] wordt uitgevoerd. Figuren 6 (a) en (b) vertegenwoordigen de BF-STEM- en DF-STEM-afbeeldingen waarbij puntachtige defecten met een grootte van ongeveer 5 nm gelijkmatig over het monster worden verdeeld. Merk hier op dat het Mg-profiel in dit geval ook uniform lijkt te zijn, zoals blijkt uit het SIMS-profiel (zie figuur 5(b)). De uniforme verdeling van Mg en deze defecten over het GaN-monster suggereert een directe correlatie tussen deze defecten en de opname van Mg. Deze puntachtige defecten van ongeveer 5 nm zijn waarschijnlijk precipitaties van Mg (en mogelijk veroorzaakte stapelfouten daardoor). Vanwege hun kleine omvang kon Mg-neerslag zelf niet direct worden bevestigd door EDS-metingen (Ga- en Mg-pieken liggen vrij dicht bij elkaar, wat het in kaart brengen van kleine concentratieverschillen uiterst moeilijk maakt).
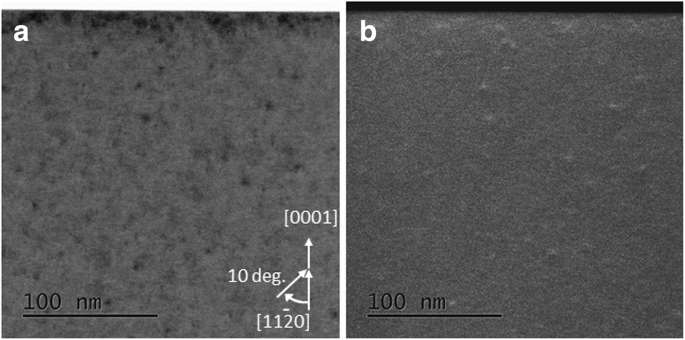
Dwarsdoorsnede a STEM-BF en b STEM-ADF-beelden van met Mg gedoteerd bulk-GaN-monster verkregen in off-zone-asconditie om de defectencontrasten te versterken
Deze waarneming is compleet anders dan het eerdere geval van een Mg-geïmplanteerd monster waar defecten zich ophopen op 200 nm vanaf het oppervlak waar de Mg-concentratie maximaal was. Bovendien hebben we, in tegenstelling tot het met Mg geïmplanteerde monster, geen piramidale en tweelijnsdefecten waargenomen (aangeduid als A en B in Fig. 2 (b)) in met Mg gedoteerd GaN-monster. Interessant is dat piramidale en lijndefecten ook worden gerapporteerd in de GaN-monsters waar Mg wordt opgenomen door andere technieken dan ionenimplantatie. Bijvoorbeeld, Khromov et al. [29] rapporteerde het bestaan van piramidale defecten in met Mg gedoteerde GaN-monsters gekweekt door MOCVD. Ze namen dergelijke defecten echter alleen waar in een hoger gedoteerd GaN-monster waar de Mg-concentratie ongeveer ~ 5 × 10 19 was. cm −3 . In monsters met Mg ~ 2 × 10 18 cm −3 , werden deze piramidale domeinen niet waargenomen. Vennegues et al. [27] nam ook dergelijke piramidale domeinen waar in MOCVD-gegroeide Mg-gedoteerde GaN-monsters met Mg-concentraties die in het midden van de 10 19 lagen. cm −3 bereik. Ze hebben dergelijke defecten niet waargenomen in monsters met Mg-concentraties lager dan 10 19 cm −3 . In ons werk, vergelijkbaar niveau van Mg ~ 4 × 10 19 cm −3 wordt opgenomen via ionenimplantatie en epitaxiale doping om de aanwezigheid van deze defecten te analyseren. Deze defecten worden alleen waargenomen in met Mg geïmplanteerde monsters, niet in met Mg gedoteerde monsters, wat suggereert dat Mg-distributie ook moet worden overwogen om hun bestaan te verklaren. Uit SIMS-metingen blijkt dat Mg niet-uniform verdeeld is in het met Mg geïmplanteerde monster (Fig. 1 (b) en (d)), terwijl Mg-gedoteerde monster een uniforme verdeling van Mg vertoonde (Fig. 5 (b)). Bovendien bleken deze defecten in een Mg-geïmplanteerd monster alleen te bestaan in een smal venster met een hogere Mg-concentratie in vergelijking met de omringende matrix. Daarom is de vorming van deze defecten gekoppeld aan het niveau van opgenomen Mg en de distributie van Mg en ze zullen waarschijnlijk worden gevormd in de regio's waar Mg in het bereik van 10 19 ligt. cm −3 . Het lijkt erop dat een niet-uniform Mg-profiel in een Mg-geïmplanteerd monster leidt tot een niet-uniforme verdeling van defecten. Men moet echter de mogelijkheden niet ontkennen, zoals niet-uniform verdeelde defecten die een niet-uniforme Mg-verdeling of afhankelijkheid van het Mg-implantatieprofiel van het bestaan van dergelijke defecten veroorzaken; daarom is verder onderzoek in deze richting nodig. Onze vergelijkende analyse van defecten in Mg-geïntegreerd GaN suggereert dat de aard en het type van de defecten afhankelijk zijn van de opnamemethode.
Conclusies
Samenvattend, op scanning transmissie-elektronenmicroscopie gebaseerde structurele onderzoeken van defecten in Mg-geïmplanteerde en Mg-gedoteerde epi-lagen op vrijstaande GaN-substraten onthulden dat de aard van defecten sterk afhangt van de methode van Mg-opname. Met Mg geïmplanteerd GaN toonde de aanwezigheid van piramidale domeinen die in de richting van de [0001] wijzen en tweelijnsdefecten met kenmerken die enkele nanometers dieper in de richting van de [0001] liggen. Piramidale domeinen worden verondersteld Mg3 . te zijn N2 gebaseerde structuren, terwijl lijndefecten ook Mg blijken te hebben, zoals waargenomen bij energiedispersieve spectroscopie. Deze lijndefecten blijken zich op een diepte van ongeveer 200 nm van het oppervlak te bevinden, in een smal gebied met een Mg-concentratie van ongeveer 10 19 cm −3 die suggereren dat hun vorming verband houdt met het niveau van geïmplanteerde Mg-concentratie. De vorming van deze defecten in GaN op Mg-implantatie zal naar verwachting aanzienlijk bijdragen aan Mg-zelfcompensatiemechanismen die leiden tot inefficiënte p-type doping. Integendeel, het met Mg gedoteerde GaN-monster vertoonde alleen de aanwezigheid van puntachtige defecten die uniform over het hele monster werden verdeeld. De huidige studie die de afhankelijkheid van de Mg-opnamemethode en de concentraties ervan op de aard en het type defecten benadrukt, kan nuttig zijn voor het kiezen van de juiste hoeveelheid Mg die moet worden opgenomen voor het bereiken van een hoge p-type geleidbaarheid in op GaN gebaseerde materialen voor een efficiënte werking van het apparaat.
Afkortingen
- ADF:
-
Ringvormig donker veld
- BF:
-
Helder veld
- EDS:
-
Energiedispersieve spectroscopie
- MBE:
-
Moleculaire bundelepitaxie
- MOCVD:
-
Metaal-organische chemische dampafzetting
- SIMS:
-
Secundaire ionenmassaspectrometrie
- STEM:
-
Scanning transmissie-elektronenmicroscopie
Nanomaterialen
- Voorbeelden van circuits en netlijsten
- Mesh huidige methode en analyse
- 5G en GaN:de verschuiving van LDMOS naar GaN
- 5G en GaN:toekomstige innovaties
- Analyse van actine en focale adhesieorganisatie in U2OS-cellen op polymeernanostructuren
- Infraroodreflectieanalyse van epitaxiale n-type gedoteerde GaN-lagen gegroeid op saffier
- Elektrospinnen op isolerende ondergronden door de bevochtiging en vochtigheid van het oppervlak te regelen
- Vervaardiging van SrGe2 dunne films op Ge (100), (110) en (111) substraten
- Een onderzoek naar koolstofnanovezels en actieve koolstof als symmetrische supercondensator in waterige elektrolyt:een vergelijkend onderzoek
- Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
- Vergelijkende studie van de elektrochemische, biomedische en thermische eigenschappen van natuurlijke en synthetische nanomaterialen



