Effect van dubbellaagse CeO2−x/ZnO en ZnO/CeO2−x heterostructuren en elektroformerende polariteit op schakeleigenschappen van niet-vluchtig geheugen
Abstract
Geheugenapparaten met dubbellaagse CeO2−x /ZnO en ZnO/CeO2−x heterostructuren ingeklemd tussen Ti-top- en Pt-bodemelektroden werden vervaardigd door RF-magnetron-sputteren bij kamertemperatuur. N-type halfgeleidermaterialen werden gebruikt in beide heterostructuren van apparaten, maar interessant genoeg veroorzaakte verandering in heterostructuur en elektroformerende polariteit significante variaties in resistieve schakeleigenschappen (RS). Resultaten hebben aangetoond dat de polariteit van elektroforming grote invloed heeft op zowel CeO2−x /ZnO en ZnO/CeO2−x heterostructuurprestaties zoals elektroformeringsspanning, goed uithoudingsvermogen van cyclus tot cyclus (~ 10 2 ), en AAN/UIT-verhouding. Een apparaat met CeO2−x /ZnO heterostructuur onthult goede RS-prestaties vanwege de vorming van Schottky-barrière aan de boven- en onderkant van de interfaces. Het dominante geleidingsmechanisme van de hoge weerstandstoestand (HRS) was Schottky-emissie in een hoog veldgebied. Aard van de temperatuurafhankelijkheid van toestand met lage weerstand en HRS bevestigde dat RS wordt veroorzaakt door de vorming en breuk van geleidende filamenten bestaande uit zuurstofvacatures.
Achtergrond
Conventionele flashgeheugens worden geconfronteerd met hun fysieke en praktische grenzen, dus het zoeken naar nieuwe mogelijke kandidaten voor niet-vluchtige geheugentoepassingen is zeer noodzakelijk geworden. In dit verband zijn verschillende nieuwe geheugentypes gesuggereerd als de volgende generatie niet-vluchtige geheugenkandidaten [1, 2]. Hiervan wordt resistief willekeurig toegankelijk geheugen (RRAM) beschouwd als de beste kandidaat voor de vervanging van conventionele geheugens vanwege zijn unieke kenmerken zoals hoge schaalbaarheid, lange geheugenhoudtijd, kleinere apparaatgrootte, hoge schakelsnelheid, laag energieverbruik , niet-vluchtigheid en eenvoudige structuur [3]. De geheugencel van RRAM is een condensatorachtige, metaaloxide-metaal (MOM) structuur. Het bipolaire resistieve schakelen (BRS) en unipolaire RS (URS) gedrag tussen twee weerstandstoestanden, dwz lage weerstandstoestand (LRS) en hoge weerstandstoestand (HRS) van een weerstandsfilm, kan worden bereikt door externe spanning aan te leggen met de juiste grootte en polariteiten [4,5,6].
De schakelprestaties van een RS-apparaat zijn afhankelijk van de uniformiteit van SET-spanning, RESET-spanning en stroomniveaus bij LRS en HRS [7]. Deze schakelparameters worden beïnvloed door de filmdiëlektrica, elektrodematerialen en fabricage-/bedieningstechniek. Er zijn tot dusver talrijke modellen voorgesteld om de afhankelijkheid van schakelkarakteristieken van deze parameters te verklaren. Het schakelgedrag kan worden gecategoriseerd als bulk-beperkt of interface-beperkt [8]. Voor schakelen van het bulkbeperkte type zijn de schakelparameters sterk afhankelijk van de permittiviteit van de diëlektrische films [9]. Elektrodebeperkt schakelen is echter te wijten aan elektronencorrelatie op de metaal-diëlektrische interface en de werkfunctie van elektrodematerialen [10]. De interface tussen een anode en diëlektrische film kan ook de RS-parameters van een geheugenapparaat beïnvloeden [10, 11].
Onder verschillende oxiden, ceria (CeO2 ) is een veelbelovend materiaal gebleken voor toepassingen met RS-geheugenapparaten vanwege de grote diëlektrische constante (~ 26), lagere Gibbs-vrije energie (− 1024 kJ/mol), twee oxidatie (Ce + 4 naar Ce + 3 ) toestanden en verdeling van vacatures (met name zuurstofvacatures) in een niet-stoichiometrisch patroon [12, 13]. Aan de andere kant wordt zinkoxide (ZnO) vanwege zijn uitzonderlijke eigenschappen op grote schaal gebruikt in verschillende toepassingen. Opgemerkt wordt dat ZnO wordt gebruikt als diëlektricum vanwege zijn optische transparantie, brede bandafstand, chemische stabiliteit en hoge weerstand (10 5 Ω-cm) [14]. Onlangs zijn tweelaagse RS-geheugenstructuren voorgesteld om superieure eigenschappen te vertonen ten opzichte van op enkellaags gebaseerde apparaten in termen van vermindering van elektroforming en / of SET / RESET-spanningen, uniformiteitsverbetering bij schakelen, lang uithoudingsvermogen en zelfcompliance [15]. Xu et al. [16] onderzocht het RS-gedrag van ZrO2 en ZnO dubbellaagse stapels die illustreren dat migratie van zuurstofvacatures afhankelijk is van de hoogte van de oxide-grensvlakbarrière. RS-gedrag waargenomen in de dubbellaagse MnO/CeO2 structuur werd voorgesteld als gevolg van de oxidatie- en reductiereactie van CeO2 zoals gerapporteerd door Hu et al. [17]. Yang et al. [18] onthulde goede resistieve schakeleigenschappen van dubbellaagse CuO / ZnO-apparaten in vergelijking met enkellaags ZnO-gebaseerde apparaten. Park et al. [19] toonde een betrouwbaardere en reproduceerbare RS-werking aan waargenomen in Pt/TiOx /ZnO/Pt-geheugencellen dan die vermeld in Pt/ZnO/Pt-geheugencellen. Hsieh et al. [20] beschreef dat Ni/ZnO/HfO2 /Ni-apparaten vertoonden bipolair resistief schakelgedrag met kenmerken op meerdere niveaus tijdens het RESET-proces. Al dergelijke verbeterde RS-kenmerken motiveerden diepgaand onderzoek van de dubbellaag, hetzij als ZnO/CeO2 of als CeO2 /ZnO heterostructuren, aangezien er nog geen onderzoek is gedaan naar deze stapels en de invloed van het vormen van polariteit op hun RS-kenmerken en hun geheugenprestaties.
In dit werk hebben we de invloed van dubbellaagse heterostructuur en elektroformerende polariteit op de RS-eigenschappen van ZnO/CeO2−x gerapporteerd. en CeO2−x /ZnO-gebaseerde geheugenapparaten. Resultaten hebben aangetoond dat de positief geëlektroformeerde CeO2−x /ZnO-apparaten en negatief geëlektroformeerde ZnO/CeO2−x apparaten vertonen lagere elektroformeringsspanningen en een veel beter uithoudingsvermogen van cyclus tot cyclus (~ 10 2 ) prestatie. Temperatuurafhankelijkheid van LRS- en HRS-weerstanden van deze dubbellaagse apparaten met tegengestelde polariteiten geeft aan dat het waargenomen RS-mechanisme kan worden verklaard door op zuurstofvacatures gebaseerde geleidende kanalen.
Methoden
Twee soorten Ti/CeO2 /ZnO/Pt en Ti/ZnO/CeO2 /Pt heterostructuur-apparaten werden in dit werk voorbereid voor vergelijkend onderzoek. Voor de fabricage van de eerste Ti/CeO2 /ZnO/Pt heterostructuurapparaat, een actieve laag van dunne ZnO-film (~ 10 nm) werd afgezet op commercieel Pt/Ti/SiO2 /Si (Pt) substraten bij kamertemperatuur door radiofrequentie (RF) magnetron sputteren met behulp van ZnO (99,99% zuiver) keramisch doelwit. Tijdens depositie, RF-vermogen van 75 W en druk van ~ 10 mTorr onder Ar:O2 (6:18) mengsel (stroomsnelheid a =-24 sccm) werden gehandhaafd. Dan, CeO2 laag (5 nm) werd afgezet op ZnO/Pt door middel van RF-magnetronsputteren onder dezelfde omstandigheden om dubbellaag CeO2 te vormen /ZnO heterostructuur. Ten slotte werd Pt / Ti-topelektrode (TE) op beide heterostructuren afgezet door sequentiële gelijkstroom (DC) magnetronsputtering met behulp van een metalen schaduwmasker. Deze techniek produceerde cirkelvormige apparaten (geheugencellen) met een diameter van 150 μm. Hier werd Pt gebruikt als een beschermende laag om Ti TE te beschermen tegen oxidatie. Op dezelfde manier, een tweede Ti/ZnO/CeO2 /Pt heterostructuurapparaat werd ook vervaardigd onder dezelfde omstandigheden als gehandhaafd voor Ti/CeO2 /ZnO/Pt heterostructuren. Beide Ti/CeO2 /ZnO/Pt en Ti/ZnO/CeO2 /Pt heterostructurele geheugenapparaten werden gekarakteriseerd door Agilent B1500A halfgeleiderparameteranalysator met behulp van een standaard meetmethode met twee sondes. De dubbellaagse structuur van deze apparaten werd gekarakteriseerd met behulp van cross-view hoge-resolutie transmissie-elektronenmicroscopie (HRTEM-JEM 2001F).
Resultaten en discussie
Figuur 1a, b toont de schematische configuratie van dubbellaagse Ti/CeO2 /ZnO/Pt en Ti/ZnO/CeO2 /Pt heterostructuur geheugenapparaten, respectievelijk. Afbeelding 2a–d toont typische stroom-spanning (I -V ) krommen van Ti/CeO2−x /ZnO/Pt en Ti/ZnO/CeO2−x /Pt heterostructurele geheugenapparaten, waaronder ook het initiële elektroformeringsproces, dat typische bipolaire RS-kenmerken aangeeft. Toen een +-2 V-zwaai werd toegepast op TE, trad er een plotselinge stroomsprong op bij 0, 6 V, wat wijst op de vorming van geleidende paden tussen twee elektroden (figuur 2a). Het apparaat bleef in de AAN-status (LRS) nadat de positieve elektroformeringsspanning was verwijderd. Figuur 2a laat ook zien dat het apparaat met succes terugschakelde naar HRS met een negatieve spanningszwaai van 0 tot -1 V, en opnieuw naar LRS met een positieve spanningszwaai van 0 tot +-1 V. Een tegengestelde polariteit, dwz negatieve elektroformeringsspanning, werd ook voorzien om schakelgedrag in dezelfde heterostructuurgeheugencel te activeren / initiëren. In dit opzicht, toen een 0 tot -8 V-zwaai werd toegepast op TE, vertoonde de apparaatweerstand een plotselinge daling bij -5,6 V, waardoor deze AAN werd gezet vanuit de UIT-toestand die negatieve elektroforming wordt genoemd (Fig. 2b). Na negatieve elektroformering slaagde het apparaat er niet in om positieve RESET en negatieve SET te geven vanwege de onomkeerbare storing. Opgemerkt wordt dat veel hogere negatieve elektroformeringsspanningen nodig zijn om RS-karakteristieken te initiëren dan positieve elektroformeringsspanningen. Na negatieve elektroformering werd er echter geen schakelhysterese waargenomen, aangezien het apparaat in de AAN-toestand bleef, ongeacht de toepassing van SET- en RESET-spanningen; dit feit duidt op de vorming van permanente geleidende filamenten tijdens het elektroformeringsproces. De onomkeerbare doorslag tijdens negatief elektroformeren kan het gevolg zijn van verschillende tunnelbarrièrehoogten die worden geïnitieerd door het verschil in werkfuncties van de bovenste en onderste elektrode [21]. Deze resultaten laten zien dat het apparaat met Ti/CeO2−x /ZnO/Pt heterostructuur kan alleen geschikt zijn voor niet-vluchtige kenmerken als deze wordt geëlektroformeerd met positieve polariteit, gevolgd door negatieve en positieve polariteiten van overeenkomstige RESET- en SET-bewerkingen. Het enige verschil tussen de tweede (Ti/ZnO/CeO2−x /Pt) en eerst (Ti/CeO2−x /ZnO/Pt) devices is de positie van isolerende lagen in de sandwich heterostructuur. Daarom is het apparaat met Ti/ZnO/CeO2−x /Pt heterostructuur kan ook worden geëlektroformeerd bij zowel positieve als negatieve polariteiten van voorspanningpotentialen eveneens Ti/CeO2−x /ZnO/Pt heterostructuur apparaat. Afbeelding 2c toont typische bipolaire I-V curven voor zo'n positief elektroformerings- en daaropvolgend schakelgedrag. Met een sweep van 0 tot +-4 V werd het apparaat geëlektroformeerd om het in de AAN-stand te zetten (een abrupte weerstandsverandering bij +-3 V) zoals geïllustreerd in figuur 2c. Het apparaat werd vervolgens ingeschakeld onder +-2 V (positieve SET) en UIT bij -1,5 V (negatieve RESET) tijdens herhaalbare schakelcyclus. Evenzo vertoonde het apparaat met dezelfde heterostructuur, negatief geëlektroformeerd (bij -3,5 V) positieve RESET (bij + -1,5 V) en negatieve SET (bij -2,5 V), zoals duidelijk blijkt uit figuur 2d. Om beide apparaten te beschermen tegen permanente uitval, werd een stroomsterkte van 1 mA toegepast tijdens elektroformerings- en SET-processen.
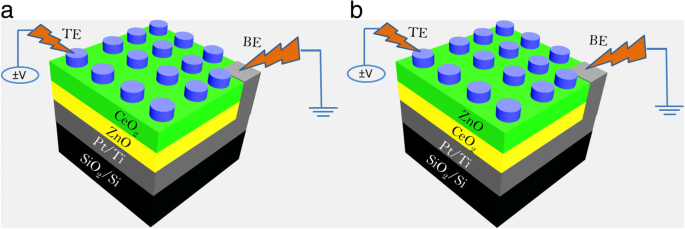
Schematische configuratie van de dubbellaag a Ti/CeO2 /ZnO/Pt en b Ti/ZnO/CeO2 /Pt-apparaten
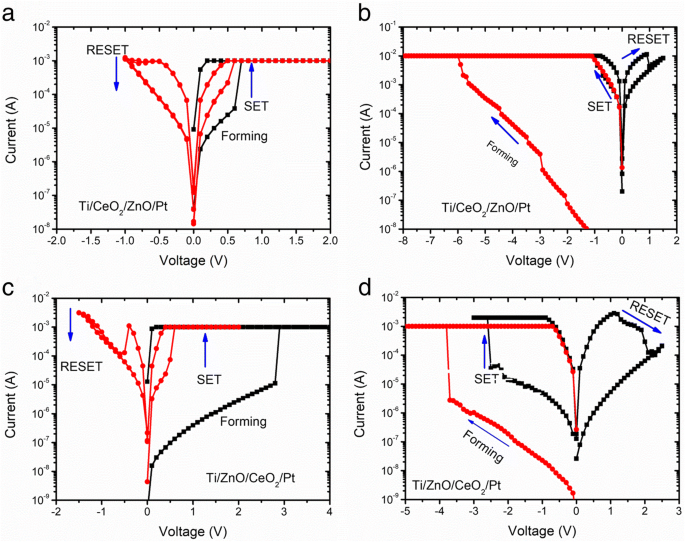
Apparaten geven het typische bipolaire gedrag weer. een Positieve (+ve) vorming en aansluitende schakelhandeling en b negatieve (−ve) vormings- en schakelbewerking van de Ti/CeO2−x /ZnO/Pt-hetrostructuren. c +ve vorm- en schakelbewerking en d −ve vorming en schakelbewerking van Ti/ZnO/CeO2−x /Pt geheugenapparaten. Pijlen geven schakelrichtingen aan
Om de uniformiteit van schakelparameters voor beide heterostructuurgeheugenapparaten te controleren, worden cumulatieve waarschijnlijkheden van operationele spanningen (SET- en RESET-spanningen) weergegeven in verschillende schakelcycli weergegeven in Fig. 3a, b. De Ti/CeO2−x /ZnO/Pt-geheugenapparaat met heterostructuur vertoont relatief kleinere variaties in SET- en RESET-spanningen in vergelijking met Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaat. Figuur 3c, d onthult de statistische analyse van gemiddelde SET-, RESET- en elektroformeringsspanningen van beide heterostructuurgeheugenapparaten. De Ti/CeO2−x /ZnO/Pt-apparaten blijken veel lagere elektroformeringsspanningen nodig te hebben dan die nodig zijn voor Ti/ZnO/CeO2−x /Pt heterostructurele geheugenapparaten, maar SET- en RESET-spanningen vertonen slechts geringe variaties. Kleinere schommelingen in de bedrijfsspanningen van beide apparaten kunnen worden geassocieerd met het ontstaan en scheuren van filamenten die plaatsvinden op de interfaces. Liu et al. [22] suggereerde dat de lage SET/RESET-spanningen en schakeluniformiteit vermeld in WOx /NbOx dubbellaagsstructuur kan worden toegeschreven aan het gecombineerde effect van zuurstofmigratie tussen twee oxidelagen en metaal-isolatorovergang. Als Gibbs vrije energie ΔG van de oxidevorming voor ZnO en CeOx heeft een enorm verschil van ongeveer 706 kJ/mol (voor CeO2 , ΔG = − 1024 kJ/mol en voor ZnO is dit − 318,52 kJ/mol) en er een gelokaliseerd verwarmingseffect optreedt, wordt de uitwisseling van zuurstof geïnduceerd. Het is bekend dat de dunne ZnO-laag veel zuurstofvacatures heeft vanwege de lage vormingsenergie [23]. Ook spelen veel initiële zuurstofvacatures in de ZnO-laag een belangrijke rol bij geleiding via ondiepe vallen [24]. Bovendien wordt gesteld dat het vormingsvrije fenomeen in op ZnO gebaseerde apparaten zou kunnen worden toegeschreven aan een hoge concentratie van zuurstofvacatures die al aanwezig zijn in ZnO-kristallen [25]. Uit alle bovengenoemde feiten kan worden geconcludeerd dat in de aanwezigheid van ZnO-film met veel zuurstofvacatures in beide heterostructuurapparaten (ZnO/CeO2−x en CeO2−x /ZnO) speelt een cruciale rol bij het verminderen van bedrijfsspanningen. Zuurstofvacatures in ZnO kunnen fungeren als ondiepe vallen voor elektronen en elektronen op deze vanglocaties kunnen gemakkelijk worden opgesloten of verwijderd bij kleine waarden van SET- en RESET-spanningen.

Cyclus-naar-cyclus cumulatieve kansverdeling van operationele spanningen in a Ti/CeO2−x /ZnO/Pt en b Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaten. c Statistische analyse van SET- en RESET-spanningen van Ti/CeO2−x /ZnO/Pt en Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaten. d Statistische evaluatie van de elektroformeringsspanningen voor zowel Ti/CeO2−x /ZnO/Pt en Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaten
Om de betrouwbaarheid van beide apparaatheterostructuren te onderzoeken, werden duurzaamheidstests bij verschillende polariteiten van biasing-potentiaal uitgevoerd. De weerstandswaarden van HRS en LRS worden verkregen bij 0,2 V uit DC-duurzaamheidsschakelcycli. Afbeelding 4a beschrijft de duurzaamheidskenmerken van Ti/CeO2−x /ZnO/Pt heterostructuur geheugenapparaat. Het blijkt dat positief geëlektroformeerde Ti/CeO2 /ZnO/Pt heterostructurele geheugenapparaten vertoonden een goed uithoudingsvermogen met een geheugenvenster van ~ 10 dat duidelijk onderscheidbare HRS en LRS kon garanderen. Vorming van Schottky-barrière bij Ti/CeO2−x interface is te wijten aan het verschil in werkfunctie tussen de Ti TE en de aangrenzende laag van CeO2−x , wat leidt tot goede RS-eigenschappen. Wanneer hetzelfde heterostructuurapparaat (Ti/CeO2−x /ZnO/Pt) negatief geëlektroformeerd was, kon het apparaat niet worden gewijzigd van LRS naar HRS, zoals weergegeven in figuur 4b. Afbeelding 4c illustreert de duurzaamheidskenmerken van positief geëlektroformeerde Ti/ZnO/CeO2−x /Pt geheugenapparaat met heterostructuur met zeer slechte uithoudingsvermogen. Het geheugenvenster lijkt bijna te zijn samengevouwen, waardoor de AAN- en UIT-statussen praktisch niet te onderscheiden zijn. Dit feit kan worden toegeschreven aan het onvermogen van ZnO om de geïnjecteerde dragers te vangen vanwege de aanwezigheid van een hoge concentratie aan vacatures, waardoor de geleidingsbaan naar Ti TE wordt gemaakt omdat er geen barrière wordt gevormd aan de Ti/ZnO-interface vanwege het verwaarloosbare verschil in werkfunctie tussen Ti (4,33 eV) en ZnO (4,35 eV), en dit leidt tot een slecht uithoudingsvermogen [26]. Een andere reden kan de hoge dichtheid van defecten zijn binnen de ZnO/CeO2−x matrix gecreëerd onder een sterk elektrisch veld, omdat de migratie van zuurstofvacatures langs de uitgebreide defecten aanzienlijk wordt verbeterd. Bovendien verhogen positief geladen zuurstofvacatures die zijn gescheiden op defectlocaties de toestand van de oppervlaktedichtheid, wat resulteert in ineenstorting van de AAN / UIT-verhouding. Het suggereert dat wanneer Ti/ZnO-blokkerend contact wordt gevormd, de Fermi-niveaus op één lijn liggen door de beweging van elektronen van Ti naar ZnO. Als gevolg hiervan worden de meeste dragers verzameld aan het oppervlak van de oxidelaag en wordt er bijna geen barrière gevormd [26]. Afbeelding 4d toont veel betere uithoudingsvermogenkenmerken van de negatief gevormde Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaat in vergelijking met die van positief gevormde apparaat. Zhu et al. [27] fabriceerde drie verschillende soorten apparaten:(i) Ag/ZnO/NSTO/In, (ii) Ag/CeO2 /NSTO/In, en (iii) Ag/CeO2 /ZnO/NSTO/In. Het dubbellaagse apparaat (CeO2−x /ZnO) vertoonde, in vergelijking met enkellaagse, beter RS-gedrag met gegevensbehoud van ongeveer 10 jaar. Ze schreven betere RS-kenmerken van dubbellaagse heterostructuren toe aan de interfacebarrière tussen CeO2−x /ZnO dubbellaagse structuur en het bestaan van een groot aantal vacatures die fungeren als valcentra in ZnO-films.
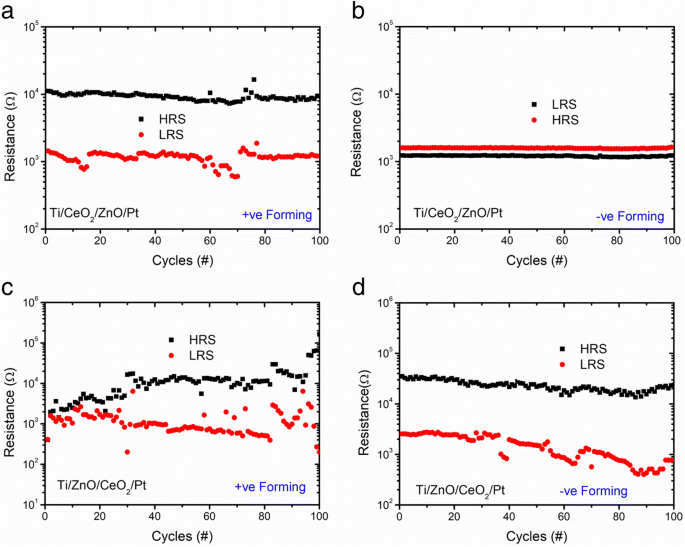
Uithoudingsvermogen kenmerken van a positief geëlektroformeerd en b negatief geëlektroformeerde Ti/CeO2−x /ZnO/Pt heterostructuur geheugenapparaten. c Positief geëlektroformeerd en d negatief geëlektroformeerde Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaten
De retentieprestaties van zowel CeO2−x /ZnO en ZnO/CeO2−x dubbellaagse heterostructuren werden ook onderzocht. De retentietijd van beide heterostructuurapparaten werd gemeten bij kamertemperatuur met een leesspanning van 0,2 V, zoals blijkt uit Fig. 5a, b. Er was geen elektrische stroom nodig om de weerstand in een bepaalde toestand constant te houden. Tot bewaartijd van 10 4 s, vertonen de weerstanden van de HRS en LRS helemaal geen tekenen van verslechtering, wat impliceert dat de informatie die is opgeslagen in beide heterostructuurapparaten veel langer kan worden bewaard dan 10 4 v.

Retentiekenmerken van a positief geëlektroformeerde Ti/CeO2−x /ZnO/Pt heterostructurele geheugenapparaten en b negatief geëlektroformeerde Ti/ZnO/CeO2−x /Pt heterostructurele geheugenapparaten bij kamertemperatuur
Om het geleidingsmechanisme te onderzoeken dat heerst in het hoge veldgebied van beide heterostructuurgeheugenapparaten, werd de curve-aanpassingsprocedure uitgevoerd onder positief (voor CeO2−x /ZnO) en negatief (voor ZnO/CeO2−x ) polariteiten van voorspanningspotentiaal. Figuur 6a, b beschrijft dat lineaire curve-aanpassingen aan experimentele gegevens goed zijn uitgelijnd met Schottky-emissiegedrag voor beide heterostructuurapparaten in hun respectieve vooringenomen polariteiten. Het is bekend dat Schottky-emissie plaatsvindt wanneer een elektrode thermisch geactiveerde elektronen over de barrière injecteert in de geleidingsband van de isolator, dus het wordt een elektrodebeperkt mechanisme genoemd. In het algemeen treedt Schottky-emissie op wanneer elektrodecontact sterk dragerinjectief is. De lineaire relatie van ln(I ) versus √V geeft aan dat de elektronen een voldoende hoeveelheid energie hebben bereikt om de energiebarrière te overwinnen. Ohmse geleiding (stroom is evenredig met aangelegde spanning) die optreedt in een laag veldgebied laat zien dat de stroom vloeit als gevolg van thermisch gegenereerde elektronen (resultaten worden hier niet getoond). Het Schottky-emissiemodel kan meestal worden beschreven met een vergelijking van de vorm [28]:\( \ln (J)=\ln {A}^{\ast }{T}^2-q\left({\varPhi} _b-\sqrt{\frac{qV}{4\pi {\varepsilon}_o{\varepsilon}_rd}}\ \right)/{k}_BT \), waarbij J is stroomdichtheid, A * is Richardson-constante, T is temperatuur, q is elektrische lading, V is eclectische spanning, ε r is diëlektrische constante, ε o is permittiviteit van vrije ruimte, d is filmdikte, en k B de Boltzmann-constante is. Verder werden temperatuurafhankelijke weerstandswaarden van LRS en HRS gemeten bij een spanning van 0,2 V in het temperatuurbereik van 200-300 K voor beide CeO2−x /ZnO en ZnO/CeO2−x heterostructurele geheugenapparaten zoals getoond in Fig. 6c, d. Het kan worden opgemerkt dat de elektrische transporteigenschappen van beide heterostructuurapparaten in lage weerstandstoestand metallisch van aard zijn, d.w.z. weerstanden in LRS nemen toe met toenemende temperatuur. In tegenstelling hiermee zijn elektrische transporteigenschappen voor beide apparaten bij HRS halfgeleidend van aard, d.w.z. weerstanden in HRS nemen af met stijgende temperaturen. Waarden van activeringsenergie (E een ) verkregen uit Arrhenius-plots van LRS van beide heterostructuurapparaten (resultaten niet getoond) zijn ~ -0,092 eV en vergelijkbaar met de energie van de eerste ionisatie van zuurstofvacatures (~ -0,1 eV) [25, 26, 29], wat aangeeft dat de eerste ionisatie van zuurstofvacatures is verantwoordelijk voor de geleiding bij HRS, wat de dominantie van Schottky-emissie als operatief geleidingsmechanisme in de HRS verder bevestigt. Het metallische gedrag in LRS en het halfgeleidende gedrag in HRS van beide heterostructuurapparaten bieden voldoende bewijs ter ondersteuning van het schakelgedrag in Ti/CeO2−x /ZnO/Pt en Ti//ZnO/CeO2−x /Pt heterostructurele geheugenapparaten die kunnen worden geassocieerd met op zuurstofvacatures gebaseerd geleidend filamentair mechanisme.
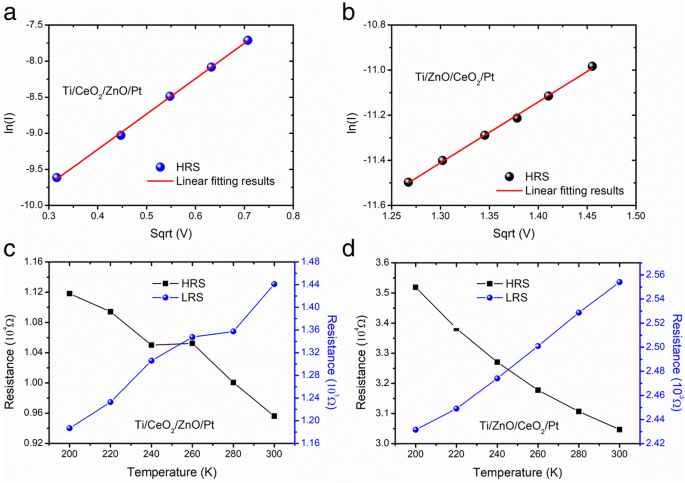
logI-V 1/2 kenmerken in de HRS van de SET-toestand. een Voor Ti/CeO2−x /ZnO/Pt. b Voor Ti/ZnO/CeO2−x /Pt heterostructuur geheugenapparaten. Temperatuurafhankelijkheid van LRS en HRS van c Ti/CeO2−x /ZnO/Pt en d Ti//ZnO/CeO2−x /Pt heterostructuur geheugenapparaten
Afbeelding 7 beschrijft het voorgestelde energiebanddiagram van CeO2 en ZnO n-n-type halfgeleidende materialen in de stationaire toestand. Het verschil tussen werkfuncties van ZnO (4,35 eV) en CeO2 (3,33 eV) is gelijk aan 1,02 eV voor dezelfde elektronische overgang op de zuurstofvacature [30]. De lagere werkfunctie van CeO2 (3,33 eV) dan die van ZnO (4,35 eV) maakt de beweging van elektronen van CeO2 mogelijk tot ZnO, waardoor hun hogere concentratie in de matrix ontstaat.
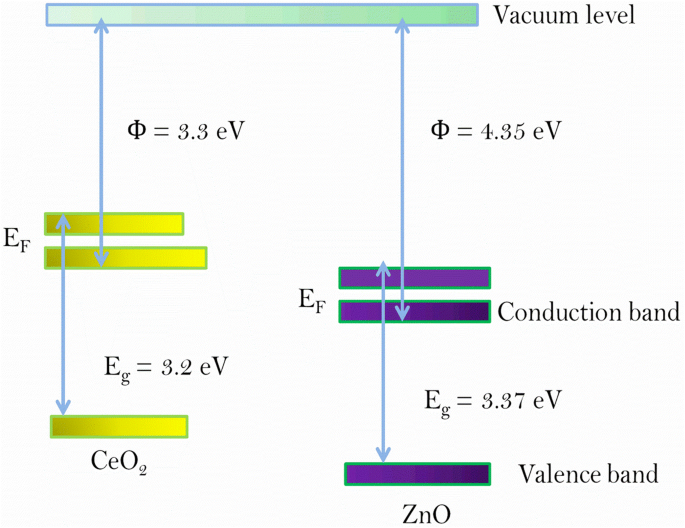
Energiebanddiagram van CeO2 en ZnO n-type halfgeleidende materialen
Volgens onze eerdere studie [31], RS-kenmerken van enkellaags Ti/CeO2−x /Pt-apparaat werden toegeschreven aan de vorming van een TiO-grensvlaklaag die een sleutelrol speelt bij het creëren en breken van geleidende filamentaire paden. Warul et al. stelde voor dat het RS-gedrag in de Ti/ZnO/Pt-apparaten werd veroorzaakt door de aanmaak en ontkoppeling van op zuurstofvacatures gebaseerde geleidende filamenten [32]. Bovendien is het vormingsvrije fenomeen in Ti/ZnO/Pt-apparaten gerelateerd aan het bestaan van een aanzienlijke hoeveelheid zuurstofvacatures in de zoals geprepareerde Ti/ZnO/Pt-apparaten [32,33,34]. Schottky-barrière op de ZnO/Pt-interface kan worden geëlimineerd door het bestaan van een voldoende hoeveelheid zuurstofvacatures in de ZnO-film, wat resulteert in een Ohms contact op de ZnO/Pt-interface. Dienovereenkomstig kan de vorming van een TiO-grensvlaklaag worden geassocieerd met het RS-effect in dubbellaags ZnO/CeO2−x en CeO2−x /ZnO heterostructuren. Het is algemeen bekend dat Ti een zeer reactief metaal is met zuurstof uit de lucht:daarom kan het gemakkelijk een TiO-laag vormen op het Ti/oxide-grensvlak [35]. In Ti/ZnO/CeO2−x /Pt heterostructure-geheugenapparaat, ZnO is een n-type halfgeleider en bevat veel zuurstofvacatures erin, dus een Ohms contact wordt gevormd op de Ti/ZnO-interface [36]. Omdat Ti en ZnO ongeveer dezelfde werkfuncties hebben, is Ti niet in staat om zuurstofionen uit ZnO te extraheren om een TiO-grensvlaklaag te creëren. Er is gemeld dat niet-roosterzuurstofionen en zuurstofatomen die verband houden met roosterdefecten voorkomen in ZnO-films [37]. Door afzetting van ceria (CeO2 ) door RF sputteren bij kamertemperatuur, gefabriceerd CeO2 films zijn polykristallijn van aard. Ceria-films kunnen dus niet-stoichiometrisch zijn, zoals we in ons eerdere onderzoekswerk al hebben bewezen dat ceria wordt gereduceerd tot CeO2−x [12]. Hu et al. [17] rapporteerde ook een dergelijke verlaging van CeO2 tijdens afzetting op CeO2−x . Defecten in de CeO2−x films zijn onvoldoende om zuurstofionen te mobiliseren. Daarom is CeO2−x laag dient als zuurstofreservoir in Ti/ZnO/CeO2−x /Pt heterostructuur. Gibb's energie voor de vorming van CeO2 is veel kleiner (− 1024 kJ/mol) dan die van ZnO (− 318,52 kJ/mol) zoals eerder beschreven, dus er bestaan niet-roosterzuurstofatomen in ZnO vanwege zijn niet-stoichiometrische aard, die naar CeO2 gaan laag zelfs in de afwezigheid van externe vooringenomenheid [37]. Daarom wordt verwacht dat, wanneer Ti TE op ZnO wordt afgezet, zich geen grenslaag vormt tussen Ti en ZnO, hoewel Gibbs-vormingsenergie van TiO kleiner is dan die van ZnO. Wanneer positieve spanning op de TE wordt aangelegd, worden zuurstofionen aangetrokken naar de CeO2−x /Pt-interface en geleidende filamenten worden gegenereerd met zuurstofvacatures vanwege hun drift- en lijnrangschikkingsvermogen.
Aan de andere kant, in Ti/CeO2−x /ZnO/Pt heterostructurele geheugenapparaten, wordt een zeer dunne grensvlak TiO-laag gevormd bij Ti/CeO2−x interface zoals duidelijk blijkt uit HRTEM-afbeelding (Fig. 1c) en zoals gesuggereerd door onze vorige studie [37]. Gibbs-vormingsenergie van TiO (− 944 kJ/mol) is relatief groter dan die van CeO2−x (− 1024 kJ/mol); vandaar dat, hoewel Ti vanwege zijn hoge zuurstofaffiniteit zuurstofionen van CeO2−x om een grensvlak TiO-laag te vormen, keert een deel van de zuurstofionen terug naar CeO2−x laag in de afwezigheid/aanwezigheid van een extern negatief veld [38]. Gibbs-energie van oxidevorming voor TiO en ZnO zijn respectievelijk − 944 kJ/mol en − 318.52 kJ/mol. Dienovereenkomstig kan men Gibbs-energie van oxidevorming verkrijgen voor (1/2)CeO2 = − 512 kJ/mol. In vergelijking met ZnO is de zuurstofaffiniteit van Ce iets hoger dan die van Zn, dus zuurstofionen diffunderen van ZnO naar CeO2−x laag en vervolgens naar de TiO-laag van waaruit deze ionen naar TE kunnen migreren, waardoor zuurstofvacatures in de oxidelagen achterblijven. Bijgevolg verzamelen alle zuurstofionen zich aan de bovenzijde en worden geleidende filamenten met zuurstofvacatures gevormd tussen de elektroden. In aanwezigheid van tegengestelde polariteit worden zuurstofionen teruggestuurd naar de oxidelagen, wat resulteert in het opvullen van zuurstofvacatures, wat leidt tot filamentbreuk.
De werkfuncties van de bovenste Ti- en onderste Pt-elektroden zijn respectievelijk 4,33 en 5,65 eV [39]. Elektronenaffiniteit en werkfunctie van ZnO (3,37 eV en 4,35 eV) zijn hoger dan die van CeO2 (3,50 eV en 3,2 eV) [40]. Dus een energiebarrière bij de ZnO/CeO2−x interface wordt verwacht, zoals de Schottky-barrière. In het positieve spanningsregime kunnen elektronen niet gemakkelijk worden geïnjecteerd door de defecten in CeO2 door Pt-bodemelektrode naar de ZnO-laag omdat de werkfunctie van ZnO hoger is dan CeO2 . Dat is de reden waarom elektronen minder in staat zijn om van ZnO naar Ti-topelektrode te drijven, omdat Ti vanwege hun vergelijkbare werkfuncties geen zuurstofionen uit ZnO kan aantrekken. De barrièrehoogte bovenaan Ti/ZnO en CeO2−x /Pt bodeminterfaces is respectievelijk 0,05 eV en 2,45 eV, barrièrehoogte bij CeO2 /Pt-bodeminterface is hoger, zodat elektronen niet gemakkelijk van metaal naar diëlektricum kunnen worden getriggerd, wat resulteert in de vorming van een Schottky-barrière bij de onderste interface [41].
De barrièrehoogte van de bovenste Ti/ZnO-interface is echter verwaarloosbaar klein vanwege vergelijkbare werkfuncties, maar is veel hoger aan de onderkant CeO2−x /Pt-interface daarom is de polariteit van het voorspanningsveld niet voldoende om de barrièrehoogten van de twee interfaces in evenwicht te brengen; bijgevolg het uithoudingsvermogen en de schakelkarakteristieken van Ti/ZnO/CeO2−x /Pt heterostructuur zijn niet zo goed in positieve polariteit van toegepaste bias. Wanneer een negatieve spanningszwaai wordt toegepast op de Ti-topelektrode, is de elektroneninjectie van Ti TE niet in staat om de barrière op de Ti/ZnO-interface te regelen omdat er geen Schottky-barrière wordt gevormd op de bovenste Ti/ZnO-interface in de Ti/ZnO/CeO 2−x /Pt heterostructuur zoals getoond in Fig. 8a, b.
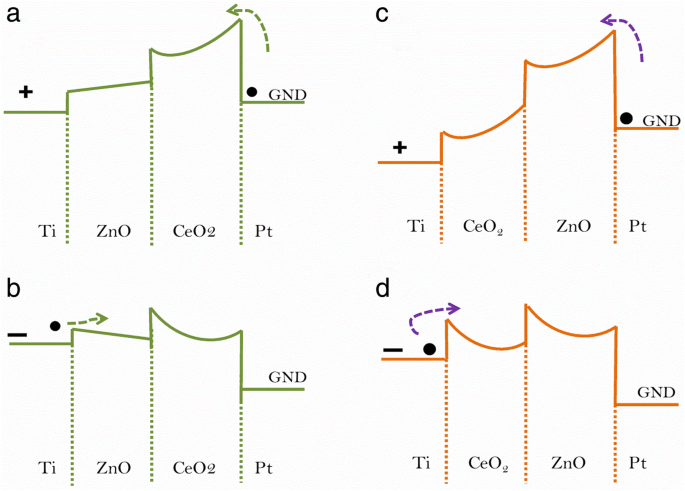
Schematische diagrammen voor de geleidingsbandoffset van a , b Ti/ZnO/CeO2−x /Pt en c , d Ti/CeO2−x /ZnO/Pt heterostructure memory devices. Arrows represent electrons drift direction according to switching polarities
In the positive voltage region, on the other hand, electrons can be easily injected through the defects in ZnO from Pt electrode to the CeO2−x laag. These electrons are then drifted from CeO2−x layer to Ti top electrode. The barrier heights of top Ti/CeO2−x (1.13 eV) and bottom ZnO/Pt (2.28 eV) interfaces suggest a Schottky emission as shown in Fig. 8c, d. When a negative voltage is swept to Ti top electrode, electron injection from top electrode is controlled by this Schottky barrier at Ti/CeO2−x interface, because trapping and de-trapping phenomena can easily occur at the lower barrier (1.13 eV). Oxygen ions can be migrated to Ti/CeO2−x interface by applying a positive voltage. The RS mechanism in Ti/CeO2−x /ZnO/Pt heterostructure memory device can be explained by the creation and dissolution of conducting filaments with oxygen vacancies in the oxide layers [41]. It means that oxygen ions can thus move back and forth between Ti/CeO2−x interface and oxide layers by two opposite polarities of the external bias. When a positive voltage is swept on Ti electrode, oxygen ions are drifted from CeO2−x /ZnO to Ti/CeO2−x interface. The conducting filaments with oxygen vacancies are formed in the oxide layer, and consequently, resistance state is switched from OFF- (HRS) to ON-state (LRS). When a negative voltage is swept on Ti TE, process of de-trapping is started and oxygen ions gathered at Ti/CeO2−x interface are moved back toward the bottom electrode. The conducting filaments are ruptured due to the migration of oxygen ions. The device is thus switched back again into HRS. Based on the current results, we have investigated the effect of device heterostructure such as CeO2−x /ZnO and ZnO/CeO2−x and electroforming polarity on resistive switching parameters for possible applications in resistive random access memory devices. We have noticed that both device structures and their electroforming polarity pose significant influence on switching parameters such as electroforming voltage, memory window, and uniformity in SET/RESET voltages. However, more attention is needed to achieve faster programing/erasing time, higher scalability, electroforming-free, and low cast devices in future research. In particular, work is needed in choosing suitable electrode material, utilizing either nanocrystals or metal ions embedded in an insulating layer and fabricating device on buffer layer structures.
Conclusies
In conclusion, deep investigations on the RS behavior have been made by changing the morphology of bilayer ZnO/CeO2−x and CeO2−x /ZnO heterostructures and sign of electroforming polarities. Significant impact is noticed on the performance, endurance characteristics, electroforming voltages, and uniformity in the operational voltages. Experimental results reveal the formation of TiO interfacial layer in Ti/CeO2−x /ZnO/Pt heterostructure on applying bias of positive polarity, and CeO2−x layer during negative polarity serves as an oxygen reservoir in Ti/ ZnO/CeO2−x /Pt heterostructures. Collectively, it can play an important role for the improvement of uniformity and repeatability of RS parameters. Dominant conduction mechanism in HRS was electrode-limited Schottky emission at a high field region. Temperature dependence of LRS and HRS resistances lead to the conclusion that observed RS mechanism is based on the movement of oxygen vacancies under the applied voltage.
Afkortingen
- BRS:
-
Bipolar resistive switching
- DC:
-
Gelijkstroom
- HRS:
-
High resistance state
- HRTEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- LRS:
-
Low resistance state
- MOM:
-
Metal-oxide-metal
- RRAM:
-
Resistive random access memory
- RS:
-
Resistive switching
- TE:
-
Top electrode
- URS:
-
Unipolar resistive switching
Nanomaterialen
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Paramagnetische eigenschappen van van fullereen afgeleide nanomaterialen en hun polymeercomposieten:drastisch uitpompeffect
- Hydrothermische synthese van In2O3 nanodeeltjes hybride tweeling hexagonale schijf ZnO heterostructuren voor verbeterde fotokatalytische activiteiten en stabiliteit
- Effecten van dubbellaagse dikte op de morfologische, optische en elektrische eigenschappen van Al2O3/ZnO-nanolaminaten
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Synthese van ZnO-nanokristallen en toepassing in omgekeerde polymeerzonnecellen
- Synergetisch effect van grafeen en MWCNT's op microstructuur en mechanische eigenschappen van Cu/Ti3SiC2/C nanocomposieten
- Vervaardiging en karakterisering van ZnO-nanoclips door het door polyol gemedieerde proces
- Optische eigenschappen van met Al-gedoteerde ZnO-films in het infraroodgebied en hun absorptietoepassingen
- Preparatie- en antibiofilmeigenschappen van zinkoxide/poreuze anodische aluminiumoxide composietfilms



