Een memristor met meerdere niveaus op basis van Al-gedoteerde HfO2-dunne film
Abstract
Niet-vluchtig geheugen (NVM) zal een zeer belangrijke rol spelen in de volgende generatie digitale technologieën, waaronder het internet der dingen. De metaaloxide-memristors, vooral op basis van HfO2 , hebben de voorkeur van veel onderzoekers vanwege de eenvoudige structuur, hoge integratie, hoge werksnelheid, laag stroomverbruik en hoge compatibiliteit met geavanceerde (complementaire metaaloxide-silicium) CMOS-technologieën. In dit artikel stelt een stabiele weerstand van 20 niveaus Al-gedoteerde HfO2 -gebaseerde memristor wordt gepresenteerd. Het uithoudingsvermogen van de cyclus, de bewaartijd van gegevens en de weerstandsverhouding zijn groter dan 10 3 ,> 10 4 s, en> 10, respectievelijk.
Achtergrond
Hoewel het negatieve resistentiefenomeen eerst werd ontdekt door Hickmott in een Al/Al2 O3 /Au-structuur in 1962 [1], en Chua stelde het concept van memristor voor in 1971 [2]. Pas toen Strukov et al. de TiO2 -gebaseerde memristor in 2008 [3] dat mensen aandacht begonnen te besteden aan het onderzoek naar memristors. Op dit moment hebben onderzoekers memristors gemaakt met meer dan tientallen actieve resistieve materialen, waaronder meerdere complexe oxiden [4, 5], metaaloxiden zoals ZnO [6], TiOx [7], TaOx [8], en tweedimensionale materialen [9, 10]. HfO2 is gebruikt als hoge-k-poortdiëlektrica in CMOS-apparaten sinds de hoge betrouwbaarheid, hoge werksnelheid en laag stroomverbruik [11, 12]. Het heeft ook de voorkeur van onderzoekers als memristief materiaal [13,14,15].
Memristor met meerdere niveaus kan op grote schaal worden gebruikt als gegevensopslag [16,17,18], logische berekening [19], elektronisch synaptisch apparaat [20,21,22,23], enzovoort. Wang Y. [16] en Gao B. et al. [24] bereide memristors op meerdere niveaus door middel van doping HfO2 met respectievelijk Cu en Gd, maar ze kunnen alleen een opslagstatus op 4 niveaus creëren, wat moeilijk is om aan de eisen van de toepassingen te voldoen. Daarom is de studie over HfO2 multi-level memristors is van groot belang.
Methoden
Ti/Al:HfO2 /Pt-apparaat werd vervaardigd zoals getoond in Fig. 1a. Het actieve celgebied werd bepaald door de vierkante Ti-topelektrode (TE). Een 20-nm Ti-kleefstoflaag werd afgezet door gelijkstroom (DC) sputteren op een siliciumsubstraat, vervolgens werd een 100-nm Pt-film afgezet als een bodemelektrode (BE). De 20-nm Al-gedoteerde HfO2 functionele laag werd afgezet door de atomic layer deposition (ALD) reactor (R-150, Picosun, Espoo, Finland) bij 300 °C met MeCp2 HfMe(OMe) (aangeduid als HfD-04) als Hf-voorloper, en H2 O als zuurstofbron [25]. De voorlopers werden gedragen door zeer zuivere N2 (>-99,999%) in de reactorkamer. Al-gedoteerde films werden verkregen door één cyclus Al2 . af te zetten O3 bij elke 8 cycli van HfO2 met het trimethylaluminium (TMA) als de Al-bron en H2 O als zuurstofbron. De Al-atoomconcentratie van 6,2% wordt gedetecteerd door röntgenfoto-elektronspectroscopie (XPS, Axis Ultra DLD, Kratos Analytical, Manchester, VK) op een Theta 300 XPS-systeem van Thermo Fisher. Een 50 nm Ti-film als TE en 100 nm Pt als deklaag werden afgezet door DC-sputteren. Apparaten worden verkregen door de TE van een patroon te voorzien door optische lithografie en een opstijgproces. Figuur 1b is de optische microfoto van de apparaten. We hebben apparaten voorbereid met verschillende gebieden variërend van 5 m × 5 m tot 500 μm × 500 m.
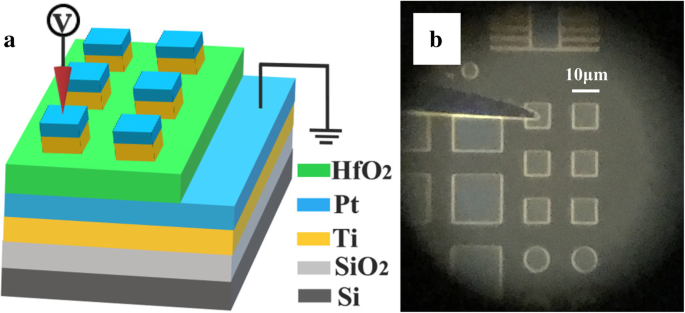
De structuur van de apparaten. een 3D-model van de memristors. b Optische microscopie van de apparaten
Resultaten en discussie
Figuur 2 toont de XPS van Al-gedoteerde en niet-gedoteerde apparaten. In vergelijking met de spectrogrammen van niet-gedoteerde apparaten, vertonen met Al gedoteerde apparaten een duidelijke 74,1 eV-piek van Al 2p in figuur 2a, en de bindingsenergie van Hf 4f heeft een zekere toename in figuur 2b. De verhouding van Hf 4f5/2 tot Hf 4f7/2 ook verhoogd voor de gedoteerde apparaten. Het is consistent met de andere rapporten [14, 26, 27]. Al-atomen binden zich aan de HfO2-structuur om Hf-Al-O te vormen, wat resulteert in de zwakkere en gemakkelijker verbroken Hf-O-bindingen.

De XPS van Al-gedoteerde en niet-gedoteerde apparaten. een Al 2p en b Hf 4f worden vergeleken
Voor alle elektrische metingen was de Ti TE voorgespannen terwijl de Pt BE was geaard. DC-sweeps werden uitgevoerd met behulp van een B1500A-parameteranalysator (Santa Clara, CA, VS) met een bron / meeteenheid, en elektrische pulsmetingen met een golfvormgenerator / snelle meeteenheid worden ook gebruikt. Alle apparaten vertonen een hoge weerstandsstatus (HRS) vóór een noodzakelijk elektrisch vormingsproces. Figuur 3a toont de vormingskarakteristiek van de 10 m × 10 μm Al-gedoteerde en niet-gedoteerde apparaten. Een stroomconformiteit tijdens het vormen is noodzakelijk om de apparaten te beschermen tegen beschadiging. De initiële weerstand en vormingsspanning van een niet-gedoteerd apparaat is groter. De oscillatie in het laagspanningsgebied van het niet-gedoteerde apparaat is omdat de stroom lager is dan de meetlimiet van het instrument. Het resetproces na de vormingsstap wordt gemotiveerd door het aanleggen van een negatieve spanning, zoals getoond in figuur 3a, en vervolgens wordt het eerste setproces gemotiveerd. Naarmate de spanningsamplitude van reset toeneemt, neemt de stroom van beide twee apparaten toe tot een maximum dat groter is dan de beperkte vormingsstroom en neemt vervolgens af. De HRS-stromen van beide twee apparaten zijn verschillende orden groter dan die van de begintoestand bij dezelfde spanning. Het suggereert dat er nog steeds geleidend filament is dat niet volledig kan worden gesmolten na reset. De typische set/reset IV-curves in Fig. 3b laten zien dat beide typologie van deze twee apparaten bipolaire bedrijfsmodus is [28]. De schakelverhouding en de set / reset-spanning van een met Al-gedoteerd apparaat zijn kleiner dan die van een niet-gedoteerd apparaat, maar het transformatieproces van de weerstandstoestand is zachter, geschikt als een opslagapparaat met meerdere waarden.
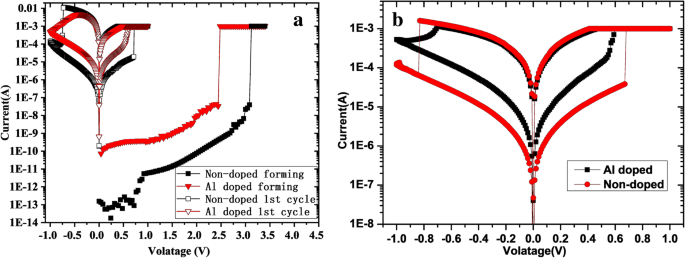
De I/V-kenmerken van de apparaten. een Het vormingsproces en de eerste cyclus. b Het typische set/reset-proces
Om de schakelmechanismen van de apparaten te verduidelijken, zijn de IV-curven opnieuw geplot op dubbele logaritmische schaal in Fig. 4. Voor beide soorten apparaten vertoont de lage weerstandscurve een lineair Ohms gedrag, wat wijst op de vorming van geleidende filamenten in HfO2 films tijdens hun setting [29, 30]. De curven met hoge weerstand zijn echter behoorlijk verschillend tussen deze twee soorten apparaten. Voor het gedoteerde apparaat is het samengesteld uit drie regio's:de Ohmse regio (I∝V), de kinderwetregio (I∝V 2 ), en het steile stroomtoenamegebied, dat overeenkomt met de typische I-V-karakteristiek van trap-gecontroleerde ruimtelading beperkte stroom (SCLC) [31, 32]. De curve met hoge weerstand van het niet-gedoteerde apparaat bestaat uit twee gebieden:de ohmse geleiding (I∝V) in het laagspanningsgebied en de lineaire pasvorm van de lnI-V 1/2 in het hoogspanningsgebied (de inzet van figuur 4), wat het Schottky-emissiemechanisme bevestigt [15, 33].
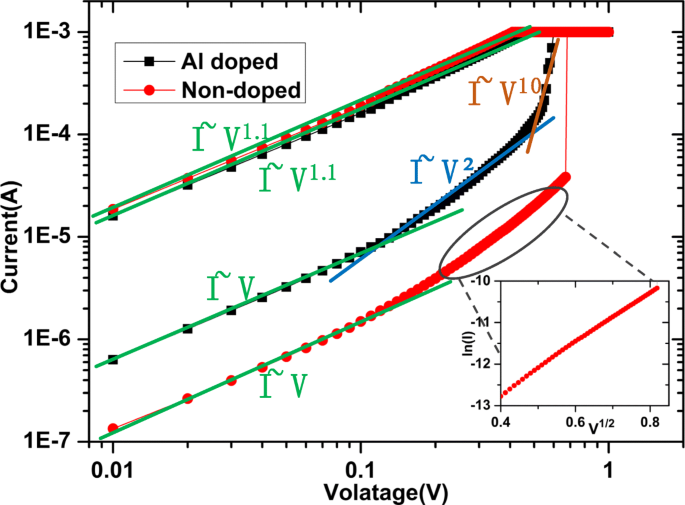
De curve-aanpassing van het SET-proces in de dubbele logaritmische coördinaten
Volgens de bovenstaande kenmerken worden de microscopische mechanismen van de memristors als volgt samengevat. Voor ongedoteerde apparaten geldt dat naarmate de positieve spanning op de titaniumelektrode toeneemt, er steeds meer zuurstofionen worden gegenereerd in de HfO2 en beweeg naar de titaniumelektrode [34], waarbij titaniumoxide [35] wordt geproduceerd. Tegelijkertijd hopen de zuurstofvacatures zich op op het grensvlak tussen de platina-elektrode en de HfO2 , waarbij geleidelijk geleidende filamenten worden gevormd [36]. Daarom neemt de stroom geleidelijk toe met de spanning. De apparaten veranderen in een toestand met lage weerstand (LRS) wanneer de zuurstofvacatures geleidende filamenten de TE en BE verbinden. Terwijl de titaniumelektrode met een negatieve spanning wordt aangelegd, combineren de zuurstofionen met de zuurstofvacatures op de HfO2 /Pt-interface [37], wat leidt tot de lagere zuurstofvacatureconcentratie en de hogere Schottky-barrière. Wanneer de resetspanning is bereikt, wordt de geleidende gloeidraad verbroken en wordt het apparaat gewijzigd in HRS.
Voor Al-gedoteerde apparaten binden Al-atomen zich aan de HfO2-structuur om Hf-Al-O te vormen, wat resulteert in de zwakkere en gemakkelijker verbroken Hf-O-bindingen. De vormingsenergie van zuurstoftekort wordt verminderd. Daarom hebben de dopingapparaten een kleinere weerstand en een lagere overgangsspanning. In ongedoteerde films hebben zuurstofvacatures de neiging zich op te hopen langs de korrelgrenzen [38, 39]. Dientengevolge zijn geleidende filamenten weinig en dik. De weerstand van de apparaten varieert sterk met de geleiding en breuk van de geleidende filamenten. In de gedoteerde films worden gemakkelijk zuurstofvacatures gevormd in de buurt van de onzuiverheidsatomen [35, 40, 41]. De uniforme verdeling van een grote hoeveelheid onzuiverheden in de dunne film maakt de geleidende filamenten die worden gevormd door zuurstofvacatures beter controleerbaar. Daarom is het gemakkelijker om meerdere weerstandswaarden te bereiken.
De apparaten kunnen worden ingesteld op verschillende stabiele weerstandstoestanden door de huidige naleving van het ingestelde proces te wijzigen. Twintig stabiele weerstandstoestanden worden verkregen door de huidige compliantie in te stellen van 0,5 mA tot 10 mA met een stap van 0,5 mA in Fig. 5a. Omdat de weerstandsstatussen zijn ingesteld door DC-sweep, is het energieverbruik groot en is de bediening gecompliceerd. Aan de andere kant kunnen de weerstandswaarden gemakkelijk worden vergrendeld in LRS wanneer een grote stroomsterkte wordt gebruikt. Deze methode is ook niet in staat om de HRS aan te passen. Weerstandstoestanden met twintig niveaus bereikt door de spanningsamplitude van de ingestelde en resetpuls te wijzigen. Om de mogelijkheid van stroomoverschrijding en set/reset-fout te voorkomen, is de spanningsamplitude beperkt tussen 1 V~1.9 V voor SET en -1 V~− 1.9 V voor reset. In het kaderdiagram (Fig. 5b) is te zien dat het toegestane spanningsbereik is verdeeld in 20 waarden en dat de opbrengst van het apparaat het 3 -niveau (99,73%). Dit is een veelvoorkomende eis in de productie. Het nadeel van deze methode is dat de apparaten niet rechtstreeks van de ene HRS (LRS) naar de andere HRS (LRS) kunnen worden ingesteld, maar eerst moeten worden gereset (ingesteld) op LRS (HRS) en vervolgens worden ingesteld op de doel-HRS (LRS) . Dit verhoogt de complexiteit en het stroomverbruik van de operatie.

De meerwaardige opslag van de apparaten. een Transformeer weerstandstoestanden door compliantiestromen in te stellen. b 20 stabiele weerstandstoestanden verkregen door het instellen van de pulsspanningsamplitude De pulsbreedte en het interval zijn beide 500 μs
Een betere benadering wordt getoond in Fig. 6. De geleiding van het apparaat wordt stapsgewijs verhoogd of verlaagd door opeenvolgende pulsen. De pulsduur en het interval zijn beide 10 s. De geleidbaarheid wordt gemeten door een leespuls van 0,1 V na elke set-/resetpuls. Zoals te zien is in Fig. 6, hangt het aantal pulsen dat nodig is om de apparaten in te stellen/resetten naar verschillende niveaus af van de toegepaste spanning. De verschillende resistente beelden met 20 niveaus worden verkregen door middel van instellen en resetten door respectievelijk 0,5 V als SET-spanning en -0,7 V als resetspanning te selecteren (Fig. 7). Het apparaat wordt elke keer teruggezet op een HRS met 10 − 0,9V opeenvolgende pulsen voordat het wordt ingesteld op de doelstatus of ingesteld op een LRS met 10 opeenvolgende pulsen van 0,8V vóór aanpassing. Aangezien dezelfde status aanwezig is bij zowel het instel- als het resetproces, zijn er in totaal 35 verschillende statussen verkregen. De afwijking van het pulsnummer dat nodig is voor de twee aangrenzende weerstandstoestanden van set (reset) overschrijdt het 3 -niveau. Het nadeel is dat als de weerstandswaarden van de apparaten sterk veranderen, het benodigde pulsgetal groot zal zijn en de werkingssnelheid laag zal zijn.
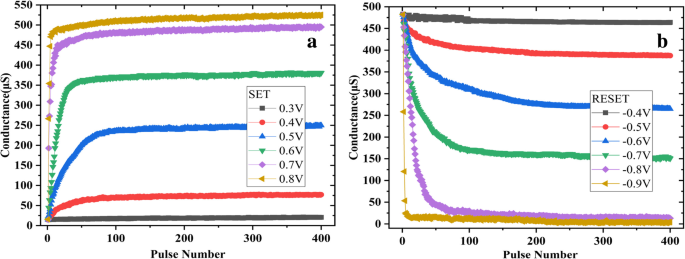
De weerstand aangepast door opeenvolgende pulsen. een Proces instellen en b resetproces

Pulsnummer nodig om in te stellen (a ) of reset (b ) de apparaten op 20 verschillende niveaus
Om de dataretentie van de apparaten te testen, worden 20 apparaten ingesteld/gereset op een reeks verschillende weerstandswaarden en ze op een verwarmingstafel bij 85 °C [42] bewaard. De weerstandswaarden werden elke 100 s gemeten met een spanning van 0,1 V. Uit Fig. 8a blijkt dat de weerstand van de apparaten stabiel blijft na 10 4 s. Om de cyclusbetrouwbaarheid van het apparaat te testen, herhaalden we de instel- en resetbewerking met een instelpuls van 1,8 V/500 s en een resetpuls van − 1,8 V/500 s. Na 10 3 cycli, is de schakelverhouding van het apparaat nog steeds groter dan 10 in Fig. 8b.
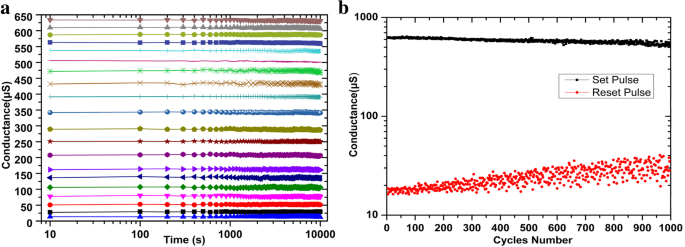
De betrouwbaarheidstesten van de apparaten. een Gegevensretentiekenmerken na set/reset-pulsbewerkingen. b Cycli uithoudingsvermogen curves voor set/reset puls operaties
Conclusies
De voorgestelde Al-gedoteerde HfO2 memristor laat een geleidelijke en stabiele set/reset prestatie zien. Door de curve van het ingestelde proces van met Al-gedoteerde en niet-gedoteerde apparaten aan te passen, is gebleken dat, in HRS, het niet-gedoteerde apparaat het Schottky-emissiemechanisme volgt, terwijl het met Al gedoteerde apparaat het SCLC-geleidende mechanisme volgt. Het microscopische fysieke mechanisme van weerstandsverandering wordt ook besproken. Bovendien werd de opslag met meerdere waarden van het apparaat bevestigd door de compliantiestroom te wijzigen, de set/reset-pulsspanningsamplitude aan te passen en de opeenvolgende korte pulsen te gebruiken. Ten slotte hebben we de betrouwbaarheid van de apparaten getest om te bewijzen dat deze een gegevensretentie hebben van meer dan 10 4 s (85 °C) en een schakelverhouding groter dan 10 na 10 3 cycli.
Beschikbaarheid van gegevens en materialen
Alle gegevens die tijdens dit onderzoek zijn gegenereerd of geanalyseerd, zijn opgenomen in dit gepubliceerde artikel.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- BE:
-
Onderste elektrode
- CMOS:
-
Complementair metaaloxide silicium
- HfD-04:
-
MeCp2 HfMe(OMe)Hf
- HRS:
-
Staat met hoge weerstand
- LRS:
-
Staat met lage weerstand
- NVM:
-
Niet-vluchtig geheugen
- SCLC:
-
Ruimte-lading-beperkte stroom
- TE:
-
Bovenste elektrode
- TMA:
-
Trimethylaluminium
- XPS:
-
Röntgenfoto-elektronenspectroscopie
Nanomaterialen
- X.509-gebaseerde apparaatverificatie in Eclipse Hono
- Nano grafeem, op silicium gebaseerd flexibel transparant geheugen
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Vervaardiging van putten op nanoschaal met hoge doorvoer op dunne polymeerfilm met behulp van AFM-tipgebaseerde dynamische ploeglithografie
- Voorbereiding en thermo-elektrische kenmerken van ITO/PtRh:PtRh Thin Film Thermokoppel
- Ultragevoelige reksensor op basis van flexibele piëzo-elektrische poly(vinylideenfluoride)film
- Verbeterde energetische prestaties op basis van integratie met de Al/PTFE-nanolaminaten
- Ontwerp van bionische cochleaire basilair membraan akoestische sensor voor frequentieselectiviteit op basis van tribo-elektrische film nanogenerator
- High-Performance Ultraviolet Fotodetector Gebaseerd op Grafeen Quantum Dots Versierd ZnO Nanorods/GaN Film Isotype Heterojunctions
- Ambarella, Lumentum en ON Semiconductor werken samen aan op AI-verwerking gebaseerde 3D-detectie voor next-gen AIoT-apparaten
- Niobium titaniumnitride dunne filmcoating



