Hoogwaardige AlGaN dubbelkanaals HEMT's met verbeterde afvoerstroomdichtheid en hoge doorslagspanning
Abstract
In dit werk wordt AlGaN dubbelkanaals heterostructuur voorgesteld en gekweekt door metaal-organische chemische dampafzetting (MOCVD), en hoogwaardige AlGaN dubbelkanaals hoge elektronenmobiliteitstransistoren (HEMT's) worden gefabriceerd en onderzocht. De implementatie van een dubbelkanaalsfunctie verbetert effectief de transporteigenschappen van AlGaN-kanaalheterostructuren. Aan de ene kant wordt de totale tweedimensionale elektronengasdichtheid (2DEG) bevorderd door de dubbele potentiaalputten in de verticale richting en de verbeterde opsluiting van de drager. Aan de andere kant wordt de gemiddelde 2DEG-dichtheid in elk kanaal verminderd en is de mobiliteit verhoogd als gevolg van de onderdrukking van het verstrooiingseffect van de draaggolfdrager. Hierdoor is de maximale afvoerstroomdichtheid (I max ) van AlGaN dubbelkanaals HEMT's bereikt 473 mA/mm met een poortspanning van 0 V. Bovendien wordt ook de superieure doorslagprestatie van de AlGaN dubbelkanaals HEMT's aangetoond. Deze resultaten tonen niet alleen het grote toepassingspotentieel van AlGaN dubbelkanaals HEMT's in microgolfvermogenselektronica, maar ontwikkelen ook een nieuwe manier van denken voor de studies van op nitride gebaseerde elektronische apparaten van groep III.
Inleiding
Op nitride gebaseerde high-elektronmobiliteitstransistoren (HEMT's) van groep III zijn geïdentificeerd als de meest veelbelovende kandidaat voor microgolfvermogenselektronica van de volgende generatie vanwege hun hoge schakelsnelheid en laag schakelverlies [1,2,3,4,5] . De laatste tijd hebben de meest geavanceerde nitride-HEMT's een initiële commercialisering bereikt tot 650 V. Met de volwassenheid van de fabricagetechnologie voor apparaten is het echter steeds moeilijker geworden om de doorslagspanningen verder op te schalen (V b ) en het verbeteren van de betrouwbaarheid van het apparaat bij hoge temperaturen. Daarom zijn, met het oog op de grotere bandgap en superieure thermische stabiliteit van AlGaN ten opzichte van GaN, AlGaN-kanaalapparaten voorgesteld als veelbelovende kandidaat om de prestatielimieten van nitride-HEMT's in toepassingen met hoge spanning en hoge temperatuur verder te verbeteren [6,7,8 ,9,10,11,12,13,14,15].
Nanjo et al. demonstreerde de opmerkelijke verbetering van de doorslagspanning van AlGaN-kanaal HEMT's, en de verkregen maximale doorslagspanningen waren 1650 V in de Al0,53 Ga0,47 N/Al0,38 Ga0,62 N HEMT's met de gate-drain-afstanden van 10 m [6]. Daarna hebben Nanjo et al. bevorderde verder de doorslagspanning van de Al0.40 Ga0.60 N/Al0,15 Ga0,85 N HEMT's tot 1700 V [8]. Zhang et al. fabriceerde de AlGaN-kanaal-HEMT's met een nieuw ohms/Schottky-hybride afvoercontact, en een recordhoge doorslagspanning van meer dan 2200 V werd verkregen voor de AlGaN-kanaal-HEMT's [11]. Xiao et al. stelde de AlGaN-kanaalheterostructuren voor met een hoge 2DEG-mobiliteit van 807 cm 2 /V·s, en de records van maximale afvoerstroom en Iaan /Iuit verhouding werden gerapporteerd voor de gefabriceerde AlGaN-kanaal HEMT's [14]. Daarna, Xiao et al. stelde voor de eerste keer de normaal uitgeschakelde HEMT's met superrooster AlGaN-kanaallaag voor, en de gefabriceerde apparaten vertoonden een doorslagspanning van meer dan 2000 V, een hoge stroomdichtheid van 768 mA / mm en een drempelspanning (V T ) van 1,0 V [15]. Onlangs hebben Baca et al. evalueerde de radiofrequentie (RF) prestaties van AlGaN-kanaal HEMT's met een 80 nm lange poort. De fT van 28,4 GHz en fMAX van 18.5 GHz werden bepaald aan de hand van S-parametermetingen met klein signaal [12]. Deze resultaten illustreren de belofte van AlGaN-kanaal-HEMT's voor RF-stroomtoepassingen.
De beperkingen van de eerder gerapporteerde AlGaN-kanaalapparaten zijn echter even duidelijk. Enerzijds is, vanwege het ongeordende verstrooiingseffect van de ternaire legering, de tweedimensionale mobiliteit van elektronengas (2DEG) in het AlGaN-kanaal veel lager dan die in het GaN-kanaal. Als gevolg hiervan is de huidige aandrijfcapaciteit van AlGaN-kanaalapparaten veel lager dan die van de traditionele GaN-kanaalapparaten. Aan de andere kant, om dezelfde hoeveelheid 2DEG in het AlGaN-kanaal te induceren, moet de AlN-component in de AlGaN-barrièrelaag hoger zijn dan die van conventionele GaN-kanaalheterostructuren, wat de moeilijkheden bij het materiaalgroeiproces zal vergroten. Deze tegenstrijdigheden belemmeren de wijdverbreide toepassing van AlGaN-kanaalapparaten ernstig en de optimalisaties van de heterostructuurlay-out zijn dringend nodig.
Dubbelkanaalstechniek is een intrigerende benadering om de kanaaldragerdichtheid van op nitride gebaseerde heterostructuren te bevorderen zonder enige nadelige invloed op de elektronenmobiliteit, en het stroomgeleidingsvermogen van de apparaten zal worden verbeterd [16,17,18]. Er zijn tot nu toe echter weinig rapporten over de AlGaN dubbelkanaals heterostructuren of elektronenapparaten. In dit werk wordt voor het eerst een AlGaN dubbelkanaals heterostructuur voorgesteld en ontwikkeld om de tegenstellingen tussen het huidige aandrijfvermogen en de doorslagprestaties van op nitride gebaseerde elektronenapparaten op te lossen. Verder worden hoogwaardige AlGaN dubbelkanaals HEMT's op basis van de nieuwe heterostructuur gefabriceerd en in detail onderzocht.
Methoden
Het dwarsdoorsnedeschema van de AlGaN dubbelkanaals heterostructuur wordt getoond in Fig. la, en de groeiprocessen kunnen als volgt worden samengevat. Eerst werd een 1600 nm GaN-bufferlaag op het saffiersubstraat gekweekt. Vervolgens werd een 500 nm gesorteerde AlGaN-bufferlaag met een AlN-samenstelling die toenam van 0 tot 10% gegroeid, wat gunstig was om de vorming van parasitair kanaal te onderdrukken. Daarna werden achtereenvolgens een 100 nm lager AlGaN-kanaal, 1 nm AlN-tussenlaag en 23 nm lager AlGaN-barrière gekweekt, en de AlN-samenstellingen in de kanaal- en barrièrelagen zijn respectievelijk 10% en 31%. Ten slotte werden 30 nm bovenste AlGaN-kanaal, 1 nm AlN-tussenlaag en 23 nm bovenste AlGaN-barrièrelagen gekweekt, waarvoor de samenstellingen hetzelfde waren met de onderste lagen. Het geleidingsbanddiagram van de AlGaN dubbelkanaals heterostructuur kan worden berekend door zelfconsistent de eendimensionale Poisson-Schrödinger-vergelijking op te lossen, die de eindige-verschilmethode gebruikt met een niet-uniforme maaswijdte [19]. Het geleidingsbanddiagram en de geëxtraheerde elektronendichtheidsverdeling van de AlGaN dubbelkanaals heterostructuur worden geïllustreerd in Fig. 2a, en de resultaten van AlGaN enkelkanaals heterostructuur worden ook gegeven in Fig. 2b voor samenstelling. Twee diepe potentiaalputten worden gevormd op het grensvlak van AlN-tussenlagen en Al0.10 Ga0,90 N-kanaallagen voor de AlGaN dubbelkanaals heterostructuur, overeenkomend met de dubbele 2DEG-kanalen. Bovendien kan worden waargenomen dat de 2DEG-dichtheid in het bovenste kanaal hoger is dan die in het onderste kanaal, wat vanuit twee aspecten kan worden verklaard. Aan de ene kant fungeert de onderste AlGaN-barrière als achterste barrière van het bovenste kanaal, wat gunstig is om de 2DEG-opsluiting van het bovenste kanaal te bevorderen. Aan de andere kant zijn de belangrijkste leverende bron van het kanaal 2DEG in nitride heterostructuren de donorachtige oppervlaktetoestanden [20], die dichter bij het bovenste kanaal liggen.
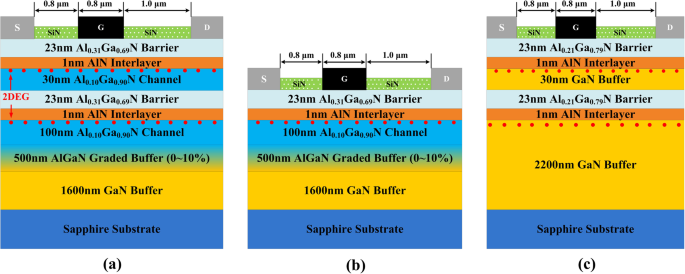
Dwarsdoorsnede (niet op schaal) van a AlGaN dubbel kanaal, b AlGaN enkel kanaal, en c GaN dubbelkanaals heterostructuren (HEMT's)
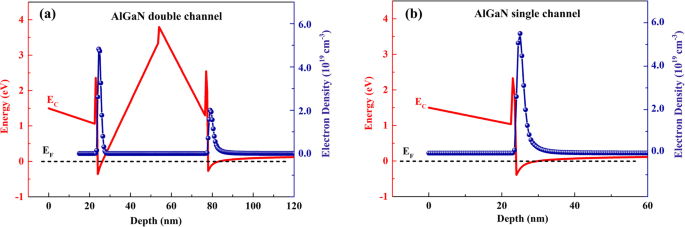
Geleidingsbanddiagrammen en elektronendichtheidsverdelingen van AlGaN dubbelkanaals en enkelkanaals heterostructuren
Resultaten en discussie
Figuur 3 toont het hoge resolutie röntgendiffractie (HRXRD) ω-2θ-scanresultaat van de AlGaN dubbelkanaals heterostructuur van symmetrische (0004) reflectie. De diffractie-intensiteit van AlN-kiemvormingslaag, GaN-buffer, AlGaN-gegradeerde buffer, AlGaN-kanaal en AlGaN-barrièrelagen kan worden waargenomen. Bovendien wordt de spectrumscan van 71,0 tot 73,2 ° weergegeven in figuur 2b met een vergroting voor de duidelijkheid, en de Lorentz-functie wordt toegepast om op de multi-pieken te passen. De diffractiepieken van GaN-buffer, AlGaN-kanaal en AlGaN-barrière bevinden zich op 71,6 °, 72,2 ° en 72,8 °, en de AlGaN-gegradeerde buffer resulteert in een platform tussen de pieken van GaN-buffer en AlGaN-kanaal. Deze resultaten duiden op de duidelijke meerlaagse structuur en de geavanceerde controle van het groeiproces, en de AlN-samenstellingen van 10% en 31% in het AlGaN-kanaal en de barrière kunnen worden geëxtraheerd.

HRXRD (0004) vlak ω-2θ scan van AlGaN dubbelkanaals heterostructuur
Meting van capaciteit en spanning (C-V) met een kwiksondeconfiguratie werd uitgevoerd om de dubbelkanaalskenmerken van de heterostructuur te onderzoeken. Zoals getoond in de inzet van Fig. 4, kunnen twee verschillende capaciteitsstappen worden waargenomen bij ongeveer − 2,5 V en − 10 V met de aangelegde spanning van 0 tot − 15 V, wat overeenkomt met de uitputting van 2DEG bij AlN/Al0.10 Ga0,90 interfaces. Bovendien kunnen de dragerdistributie-eigenschappen worden geëxtraheerd uit de C-V-curve en het resultaat wordt geïllustreerd in Fig. 4. Twee dragerconcentratiepieken bevinden zich op 24 en 78 nm met de waarden van 6,1 × 10 19 en 2,5 × 10 19 cm −3 , wat in overeenstemming is met het berekende resultaat zoals weergegeven in Fig. 2. In het bijzonder kan er geen parasitair geleidingskanaal worden waargenomen totdat de testdiepte 1 m bereikt, wat suggereert dat de dubbele kanaaleigenschappen van de heterostructuur succesvol zijn bereikt. Bovendien werden de 2DEG-plaatdichtheid en mobiliteit vastgesteld op 1,3 × 10 13 cm −2 en 1130 cm 2 /Vs door de Hall-effectmeting.
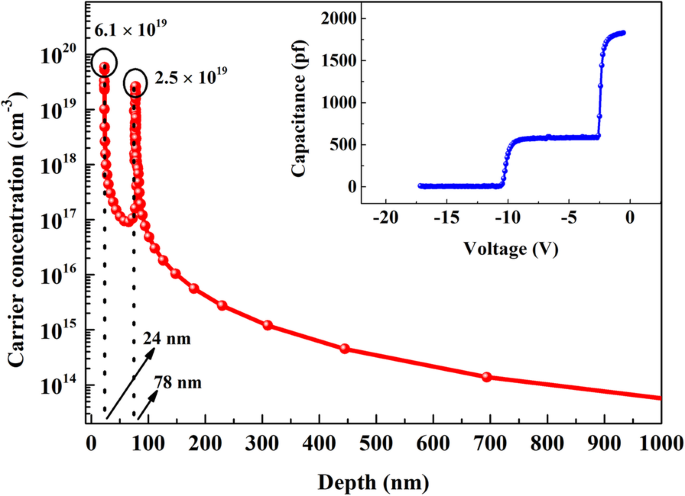
C-V-karakteristieken en elektronenverdelingscurve van AlGaN dubbelkanaals heterostructuur
Het standaard HEMT-fabricageproces werd uitgevoerd op de AlGaN dubbelkanaals heterostructuur. Het fabricageproces van het apparaat begon met ohms contact gevormd met Ti/Al/Ni/Au meerlagige metalen stapeling afgezet door elektronenstraalverdamping, gevolgd door een snelle thermische uitgloeiing bij 850 °C gedurende 30 s in N2 atmosfeer. Vervolgens werd de mesa-isolatie uitgevoerd door Cl2 /BCl3 inductief gekoppeld plasma-etsen tot een diepte van 200 nm, en een 100 nm dikke SiN-passiveringslaag werd gevormd door plasma-versterkte chemische dampafzetting. Daarna een poortgebied met een lengte (L G ) van 0,8 m werd gedefinieerd door fotolithografie na het etsen van het bovenste SiN met CF4 plasma, en vervolgens werd een Ni/Au schottky-poortelektrode afgezet. De poortbron (L GS ) en gate-drain (L GD ) afstanden zijn respectievelijk 0,8 en 1 m. Voor vergelijkingsdoeleinden werden ook twee extra HEMTs-monsters gefabriceerd op basis van de conventionele AlGaN enkelkanaals en GaN dubbelkanaals heterostructuren, en de dwarsdoorsnedeschema's worden getoond in Fig. 1b en c. Het apparaatproces en de karakteristieke parameters van de extra HEMT's-samples zijn precies hetzelfde met de AlGaN dubbelkanaals HEMT's. De uitvoer- en overdrachtseigenschappen van de apparaten zijn uitgevoerd met Keithley 4200 halfgeleiderparameteranalysator en de doorslagkarakteristieken zijn uitgevoerd met behulp van Agilent B1505A hoogspanningshalfgeleideranalysatorsysteem.
De typische uitgangskarakteristieken van de HEMT's worden geïllustreerd in Fig. 5, waarvoor de VGS en VDS werden geveegd van 0~− 10 V en 0~10 V. De maximale afvoerstroomdichtheid (I max ) en differentiële aan-weerstand (R aan ) van het AlGaN-monster met één kanaal zijn respectievelijk 265,3 mA/mm en 27,1 mm. Deze resultaten zijn in overeenstemming met de eerdere rapporten, wat suggereert dat er een tekort is aan AlGaN-kanaal-HEMT's in de huidige aandrijfcapaciteit. Voor de AlGaN dubbelkanaals HEMT's, de I max neemt dramatisch toe tot 473 mA/mm, wat 1,8 keer hoger is dan die van AlGaN enkelkanaals HEMT's. We schrijven de verbetering toe aan I max aan de superieure transporteigenschappen van de AlGaN dubbelkanaals heterostructuur. Aan de ene kant bezit de dubbele kanaalstructuur twee potentiaalputten in de verticale richting en wordt het opslagvermogen van de drager van het AlGaN-geleidingskanaal bevorderd. Aan de andere kant, hoewel de totale dichtheid van de kanaaldragers wordt verhoogd, wordt de gemiddelde elektronendichtheid in elk kanaal verlaagd. Als resultaat wordt het verstrooiingseffect van de draaggolfdrager onderdrukt en wordt de kanaalelektronenmobiliteit verhoogd. Het kan echter worden opgemerkt dat de R aan van AlGaN dubbelkanaals HEMT's is 12,5 mm, nog steeds groter dan die van GaN dubbelkanaals HEMT's. Dit fenomeen houdt verband met de grote contactbarrièrehoogte van de AlGaN-barrièrelagen, waarvoor de AlN-samenstelling maar liefst 31% is. Vanwege het zelfverhittingseffect als gevolg van de hoge vermogensdissipatie, kan het negatieve differentiële weerstandseffect worden waargenomen voor de GaN dubbelkanaals HEMT's wanneer V GS>− 4 V en V DS> 6 V. Niettemin wordt dit negatieve differentiële weerstandseffect voor de AlGaN-kanaal-HEMT's (zowel enkelkanaals als dubbelkanaals) aanzienlijk onderdrukt, wat de superieure prestaties van AlGaN-kanaal-HEMT's bij verhoogde temperatuur tot uiting brengt.

Uitgangskenmerken van AlGaN dubbelkanaals, AlGaN enkelkanaals en GaN dubbelkanaals HEMT's
Afbeelding 6 illustreert de typische overdrachtseigenschappen van de HEMT's met V DS van 10 V. De AlGaN enkelkanaals HEMT's vertonen een drempelspanning (V T ) van − 3,8 V, samen met een inferieure extrinsieke piektransconductantie (G m,max ) van 80,5 mS/mm in de buurt van V GS =− 1,5 V. Voor de AlGaN dubbelkanaals en GaN dubbelkanaals HEMT's, de V T neemt opmerkelijk af tot − 9,2 en − 11,2 V, wat het gevolg is van de hoge kanaaldraaggolfdichtheid en de relatief lange afstand van de poortelektrode tot het onderste 2DEG-kanaal. De hoge V T kan resulteren in een hoog vermogensverlies van de apparaten in de uitgeschakelde toestand, en dit probleem kan worden verbeterd door de groeiparameters van dubbelkanaalsstructuren verder te optimaliseren, zoals het correct verminderen van de dikte van de barrière- en bovenste kanaallagen. In het bijzonder kunnen dubbele bultkarakteristieken worden waargenomen van de transconductantiecurven van AlGaN dubbelkanaals en GaN dubbelkanaals HEMT's. Voor de AlGaN dubbelkanaals HEMT's kunnen twee piekwaarden van 97,9 en 42,5 mS/mm worden geëxtraheerd bij V G =− 1,0 en − 6,0 V De sub-piekwaarde bereikt 43% van de Gm,max , wat wijst op het behoorlijke poortbesturingsvermogen en de lineariteit van de AlGaN dubbelkanaals HEMT's. Bovendien kunnen, op basis van onze eerdere onderzoeksresultaten [21], de resultaten verder worden verbeterd door de structuurparameters te moduleren, zoals de dikte en samenstelling van de AlGaN dubbele kanalen, en het koppelingseffect tussen de dubbele kanalen en de lineariteit van het apparaat kan worden verbeterd.

Overdrachtskenmerken van AlGaN dubbelkanaals, AlGaN enkelkanaals en GaN dubbelkanaals HEMT's
De off-state doorslagkarakteristieken van de HEMT's op basis van verschillende heterostructuren worden gemeten en getoond in Fig. 7. De V b wordt gedefinieerd door de criteria van lekstroom die 5 μA/mm bereikt. Opgemerkt kan worden dat alle drie de monsters harde doorslagkarakteristieken vertonen, en de doorslagprestaties van AlGaN-kanaal HEMT's zijn duidelijk beter dan die van de GaN-kanaal HEMT's. De V b van de AlGaN dubbelkanaals HEMT's is 143,5 V, meer dan twee keer hoger dan die van de GaN dubbelkanaals HEMT's. De L . nemen GD =1 μm in overweging, de V b,standaard (gedefinieerd door V b /L GD ) is zo hoog als 143,5 V/μm voor de AlGaN dubbelkanaals HEMT's. De ik max en V b,standaard resultaten van de AlGaN dubbelkanaals HEMT's in dit werk worden vergeleken met de GaN-kanaal- en AlGaN-kanaal-HEMT's gerapporteerd door andere groepen in Fig. 8, en de resultaten van depletion-mode (DM) en enhancement-mode (EM) apparaten worden onderscheiden. Bovendien zijn de kernindexen van de AlGaN-kanaal-HEMT's (heterostructuren) in eerdere rapporten en dit werk samengevat in tabel 1. Zoals figuur 8 laat zien, is het duidelijk dat de afbraakprestaties van AlGaN-kanaal-HEMT's over het algemeen beter zijn dan die van GaN kanaal HEMT's, gepaard gaand met de verslechtering in I max . Opvallend is dat de I max van het AlGaN-dubbelkanaal in dit werk is vergelijkbaar met de meeste resultaten van de GaN-kanaal HEMT's. Bovendien moet worden opgemerkt dat de I max waarde in dit werk wordt verkregen bij V GS =0 V, wat conservatief is en verder kan worden verbeterd door aangelegde positieve poortspanning. Daarom demonstreren deze resultaten op overtuigende wijze het enorme potentieel van AlGaN dubbelkanaals HEMT's in toepassingen met microgolfvermogens.

Uitsplitsingskenmerken van AlGaN dubbelkanaals, AlGaN enkelkanaals en GaN dubbelkanaals HEMT's
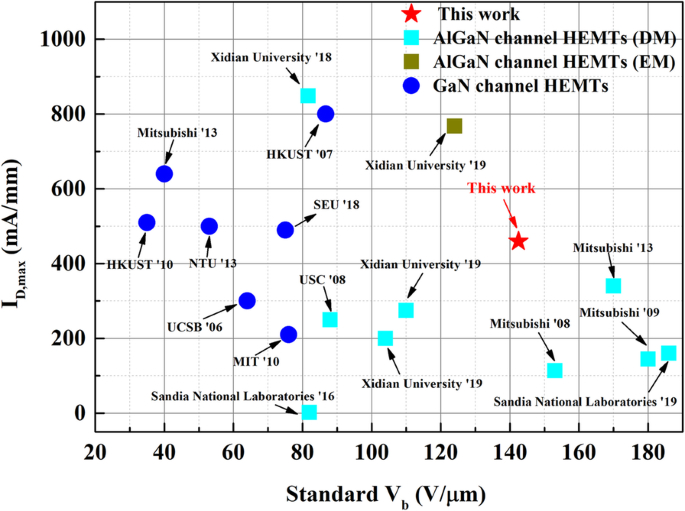
Benchmark van I max en V b,standaard voor AlGaN-kanaal en GaN-kanaal HEMT's
Conclusies
Samenvattend wordt voorgesteld om AlGaN dubbelkanaals heterostructuur te fabriceren om hoogwaardige HEMT's te fabriceren. De superieure transporteigenschappen van AlGaN dubbelkanaals heterostructuur worden onthuld, wat leidt tot het verbeterde stroomaandrijfvermogen van de HEMT's. Bovendien worden de uitstekende doorslagprestaties van de AlGaN dubbelkanaals HEMT's gedemonstreerd. De resultaten in dit werk tonen het grote potentieel van AlGaN dubbelkanaals apparaten in microgolfenergietoepassingen in de toekomst.
Beschikbaarheid van gegevens en materialen
Alle gegevens die tijdens dit onderzoek zijn gegenereerd of geanalyseerd, zijn opgenomen in dit gepubliceerde artikel en de aanvullende informatiebestanden.
Afkortingen
- MOCVD:
-
Metaal organische chemische dampafzetting
- HEMT's:
-
Transistors met hoge elektronenmobiliteit
- 2DEG:
-
Tweedimensionaal elektronengas
- Ik max :
-
Maximale afvoerstroomdichtheid
- V b :
-
Doorslagspanning
- V T :
-
Drempelspanning
- RF:
-
Radiofrequentie
- HRXRD:
-
Röntgendiffractie met hoge resolutie
- C-V:
-
Capaciteit-voltage
- L G :
-
Poortlengte
- L GS :
-
Gate-bron afstand
- L GD :
-
Afstand poort-afvoer
- R aan :
-
Aan-weerstand
- G m :
-
Transconductantie
- DM:
-
Uitputtingsmodus
- EM:
-
Verbeteringsmodus
Nanomaterialen
- Spanning en stroom
- Spanning en stroom in een praktisch circuit
- Doorslagspanning isolator
- condensatoren en calculus
- Spannings- en stroomberekeningen
- Complexe spannings- en stroomberekeningen
- Wederzijdse inductie en basisbediening
- Wat is storingsonderhoud en hoe ermee om te gaan
- Impact van oppervlaktetoestanden en aluminiummolfractie op oppervlaktepotentiaal en 2DEG in AlGaN/GaN HEMT's
- RGO en driedimensionale grafeennetwerken hebben TIM's samen gemodificeerd met hoge prestaties
- PCB-materialen en ontwerp voor hoogspanning



