Op Baliga's Figure-Of-Merits (BFOM) verbetering van een nieuwe GaN Nano-Pillar Vertical Field Effect Transistor (FET) met 2DEG-kanaal en Patroonsubstraat
Abstract
Een nieuwe verticale GaN-veldeffecttransistor (FET) met verbeteringsmodus met 2DEG voor het verminderen van de on-state weerstand (R AAN ) en substraatpatroon (SP) voor het verbeteren van de doorslagspanning (BV) wordt in dit werk voorgesteld. Door opzettelijk de breedte en hoogte van de SP te ontwerpen, kon het sterk geconcentreerde elektrische veld (E-veld) onder de p-GaN-kap worden gescheiden zonder de R dramatisch te beïnvloeden. AAN , het blijkt een verbeterde Baliga's Figure-Of-Merits (BFOM, BV 2 /R AAN ). Geverifieerd door experimenteel gekalibreerde ATLAS-simulatie, heeft het voorgestelde apparaat met een 700 nm lange en 4,6 μm brede SP een zes keer hogere BFOM in vergelijking met de FET zonder patroonsubstraat. Bovendien bezetten het voorgestelde pijlerapparaat en de SP binnenin slechts een gebied op nanoschaal, waardoor een integratie met hoge dichtheid van dergelijke apparaten mogelijk is, wat het grote potentieel ervan in toekomstige stroomtoepassingen oplevert.
Achtergrond
Tegenwoordig zijn halfgeleiders met een brede bandgap zoals ZnO, In2 O3 , SiC en galliumnitride (GaN) hebben de aandacht getrokken [1,2,3,4,5]. Terwijl, gezien de elektronische eigenschappen, de laterale AlGaN/GaN-transistor met hoge elektronenmobiliteit (HEMT) algemeen wordt beschouwd als een potentiële kandidaat voor het vervangen van het op Si gebaseerde apparaat in stroom- of frequentietoepassingen vanwege de hogere doorslagspanning (BV) en de sterkere thermische stabiliteit. Veel inspanningen, zoals p-type dop [6, 7], fluorionenimplantatie [8, 9], dunne barrière [10, 11], dubbelkanaals [5, 12] en veldgekoppelde poort [13] , zijn gemaakt over de realisatie van de HEMT van het verbeteringstype die gewenst is om het drivercircuit te vereenvoudigen.
Deze technologieën worden echter geconfronteerd met vele formidabele uitdagingen, zoals lage uniformiteit van de drempelspanning, de verspilling van verticaal chipgebied, stroominstorting, beperkte Baliga's Figure-Of-Merits (BFOM), enzovoort. Vooral de tegenstelling tussen de driftlengte en de BV heeft een negatieve invloed op het verkleinen van het apparaat [14, 15]. Met andere woorden, een kleiner apparaat leidt tot een lagere BV, waarbij het moeilijker is om de junction-terminals over te nemen die de BFOM bevorderen door de elektrische veldverdeling te optimaliseren. Hiertoe zijn achterbarrière [16], begraven junctie [17], kwantumputveldplaat [18] en andere structuren die in de laterale HEMT worden ingebracht met het kenmerk van de elektrische veldplaat voorgesteld om BV te verbeteren door gebruik te maken van het verticale gebied van de chip.
Aan de andere kant, vanwege de superieure aard van GaN, trekt de bulk GaN verticale veldeffecttransistor (VFET) steeds meer aandacht vanwege de eenvoudigere realisatie van functionaliteit van het verbeteringstype en het volledige gebruik van het verticale gebied [19] ,20,21,22]. Veel nieuwe structuren worden gepresenteerd door experimenten of simulaties om de BV te laten hellen en tegelijkertijd de weerstand in de toestand te verminderen (R AAN ) [23,24,25]. Om nog maar te zwijgen over de moeilijkheden bij het vervaardigen van de superjunctie (SJ) in GaN, het ontbreken van het tweedimensionale elektronengas met hoge mobiliteit (2DEG) leidt tot een hogere R AAN [26], wat de optimalisatie van BFOM in dergelijke apparaten belemmert.
In dit werk wordt een nieuwe verticale GaN FET met verbeteringsmodus met 2DEG voor het verminderen van de R AAN en substraatpatroon (SP) voor het verbeteren van de BV wordt voorgesteld, waarbij de combinatie van het 2DEG-kanaal en de SP de tegenstelling tussen de lage on-state weerstand en de hoge BV effectief in evenwicht brengt. Bovendien bezetten de voorgestelde apparaatpijler en de SP binnenin slechts een gebied op nanoschaal, waardoor een integratie met hoge dichtheid van dergelijke apparaten mogelijk is. Geverifieerd door numerieke simulatie gebouwd in ATLAS, heeft het voorgestelde apparaat een hogere BFOM in vergelijking met dezelfde veldeffecttransistor (FET) zonder het patroonsubstraat, waardoor het een hoog potentieel heeft in toekomstige stroomtoepassingen.
Methode
Het voorgestelde apparaat wordt gegenereerd in een normale Al0,23 GaN / GaN-wafel met een sterk geconcentreerd n-type substraat dat fungeert als de afvoerelektrode zoals weergegeven in figuur 1a, waar de dikte van de laag siliciumnitride (SiN), AlGaN en GaN 105 nm, 20 nm en 5 μm is , respectievelijk. Een n-type GaN met 2 × 10 16 cm −3 doping n D en een p-type GaN-cap met 2 × 10 17 cm −3 doping n A is ingesteld als respectievelijk de buffer en het samengestelde kanaal [27, 28]. Een ander onderdeel van het kanaal naast de poort is een dunne AlGaN-laag die wordt geïntroduceerd voor het induceren van 2DEG, zoals weergegeven in figuur 1b. Een SP, gemaakt van aluminiumoxide (Al2 O3 ) bijvoorbeeld in dit papier, wordt op het substraat gekweekt.
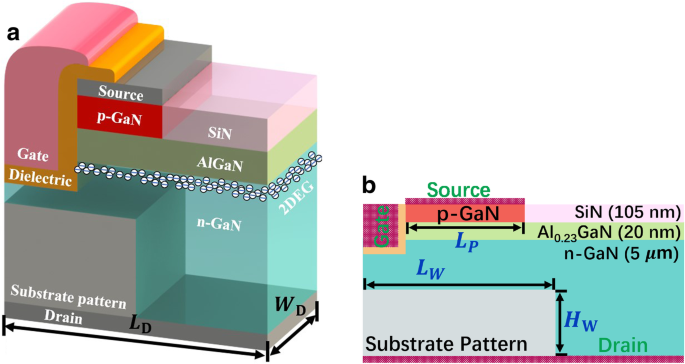
Het schema a 3D pijlerstructuur en b doorsnede met gelabelde geometrische parameters van de voorgestelde SP-VFET
Het hele apparaat zou daarom achtereenvolgens volgens een standaardproces kunnen worden vervaardigd:(1) de epitaxiale afzetting van het geleidende substraat en de geïntegreerde SP-laag, (2) het gedeeltelijk etsen van het SP-patroon, (3) de afzetting en polijsten van n- GaN-buffer, (4) de afzetting van AlGaN-barrière en p-GaN-kap, en (5) de fabricage van elektroden en passivering.
De geïmplanteerde ATLAS-simulator is gekalibreerd door de experimentele gegevens van een HEMT van het verbeteringstype met een p-GaN-dop [29, 30]. De gekalibreerde en andere specificaties van het apparaat worden weergegeven in Tabel 1. Andere configuraties zijn te vinden in ons eerdere werk [31]. Type en dichtheid van de interface-trap die zich op de SP/GaN-interface bevindt, wordt verwezen naar op capaciteit gebaseerde experimentele metingen [32,33,34]. De polarisatielading op het AlGaN/GaN-oppervlak wordt bevestigd volgens de overeenkomstige eenvoudige kwadratische aanpassingsvergelijking [35].
Natuurkundig mechanisme
In on-state, vergeleken met het apparaat zonder het 2-DEG-kanaal en de SP, heeft de voorgestelde verticale veldeffecttransistor met substraatpatroon (SP-VFET) een sterk geleidend pad dankzij de 2-DEG en een smaller verticaal stroomkanaal dat de geleiding verkleint zoals weergegeven in figuur 2. In detail, dankzij de hoge dichtheid 2DEG geconcentreerd op de AlGaN / GaN-interface, zou het laterale pad van de stroom kunnen worden gehandhaafd, wat de hele geleiding van het apparaat gedeeltelijk compenseert. Daarentegen zou de huidige transportcapaciteit van het SP-VFET-apparaat zonder 2DEG-kanaal drastisch worden beïnvloed.
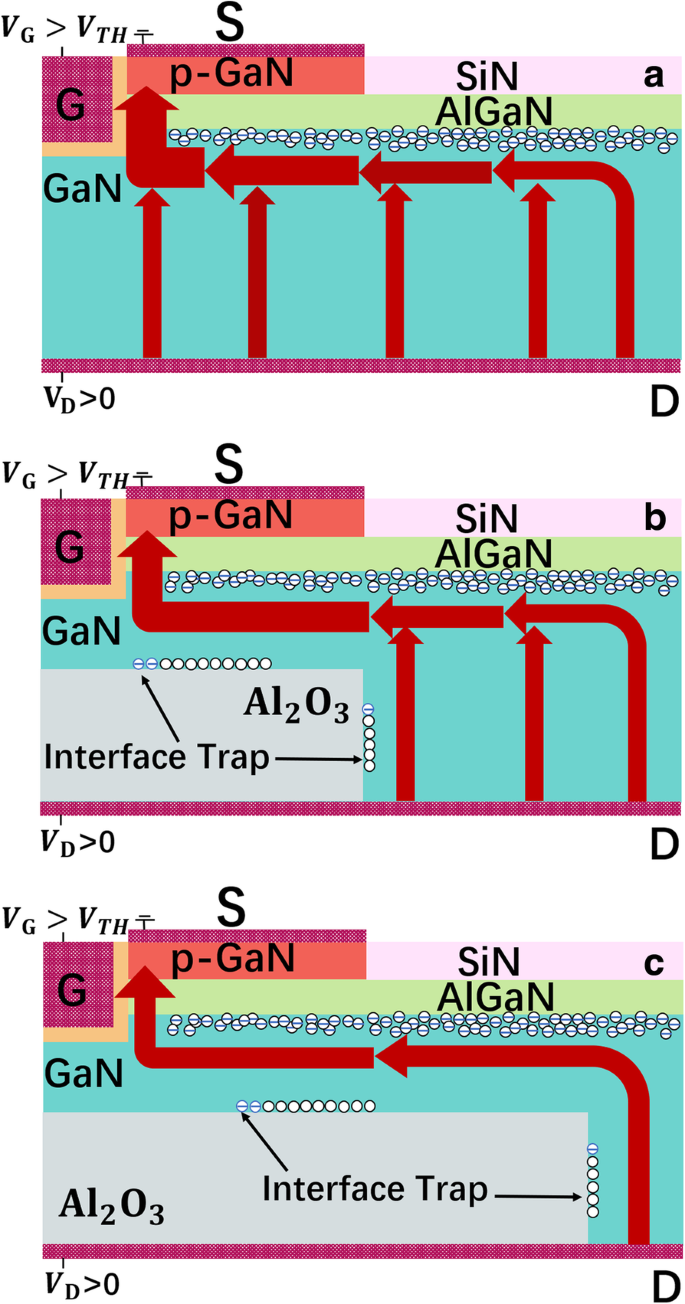
De schematische illustratie van de voorwaartse stroom in a het apparaat zonder de SP, b de voorgestelde SP-VFET met een korte SP, en c een lange SP
De lengte van de p-GaN-kap zou de concentratie van het elektrische veld (E-veld) niet dramatisch beïnvloeden totdat de lengte langer is dan 700 nm, waardoor het p-GaN bijna het hele oppervlak van het apparaat bedekt. Zoals weergegeven in figuur 3, bezit de E-veldverdeling langs de AlGaN/GaN-interface een piek rond de rechterhoek van de p-GaN. De positie van de piek verschuift samen met de variërende p-GaN-lengte en behoudt echter dezelfde grootte. Een klein verschil van de piekwaarde is te zien in Fig. 3 wanneer de p-GaN-kap langer is dan 600 nm, omdat de lange p-GaN-kap het hele E-veld in het apparaat afvlakt en hierdoor de weerstand van het apparaat vergroot vanwege tot de uitputting van de 2DEG.
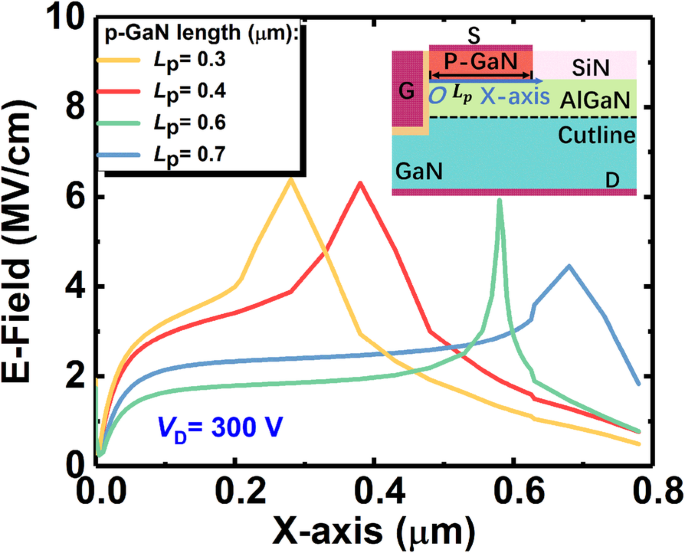
De elektrische veldverdeling van het apparaat zonder de SP langs de AlGaN/GaN-heterojunctie in verschillende p-GaN-lengtes
Om de invloed van het gelijktijdig geïntroduceerde p-GaN, 2-DEG en de SP te illustreren, kan een on-state geleidingsmodel worden gebouwd, zoals schematisch weergegeven in figuur 4a. M 1 en M 2 zijn de MIS-achtige transistors met het geleidingskanaal gevormd in respectievelijk p-GaN en AlGaN. R 1 vertegenwoordigt het oneindig kleine deel van verticale weerstand in bulk GaN. R 2 en R 3 vertegenwoordigen de oneindig kleine weerstandsdelen van 2-DEG-kanaal met en zonder respectievelijk gedeeltelijk uitgeput te zijn. Volgens de wet van weerstand, R 1 , R 2 , en R 3 kan worden verkregen als
$$ {R}_1=\frac{1}{n_1 q\mu}\bullet \frac{l}{dx\bullet {W}_D} $$$$ {R}_2=\frac{1}{n_2 q\mu}\bullet \frac{dx}{t\bullet {W}_D} $$$$ {R}_3=\frac{1}{n_3 q\mu}\bullet \frac{dx}{t\ opsommingsteken {W}_D} $$waar n 1 , n 2 , en n 3 vertegenwoordigen de elektrische concentratie in GaN, respectievelijk niet-verarmd 2-DEG en verarmd 2-DEG; q is de elektronlading en μ is de mobiliteit van elektronen in GaN; ik is de lengte van het verticale geleidende pad en dx is de oneindig kleine lengte in de horizon; W D is de breedte van het apparaat; en t is de dikte van de 2-DEG. Voor het gemak, t is ingesteld op 10 nm [7]. De concentratie van de verarmde 2-DEG onder p-GaN n 3 is gelijk aan de niet-uitgeputte concentratie n 1 minus de totale negatieve lading in de verarmde p-GaN [31], die luidt
$$ {n}_3={n}_2-{n}_A{x}_D $$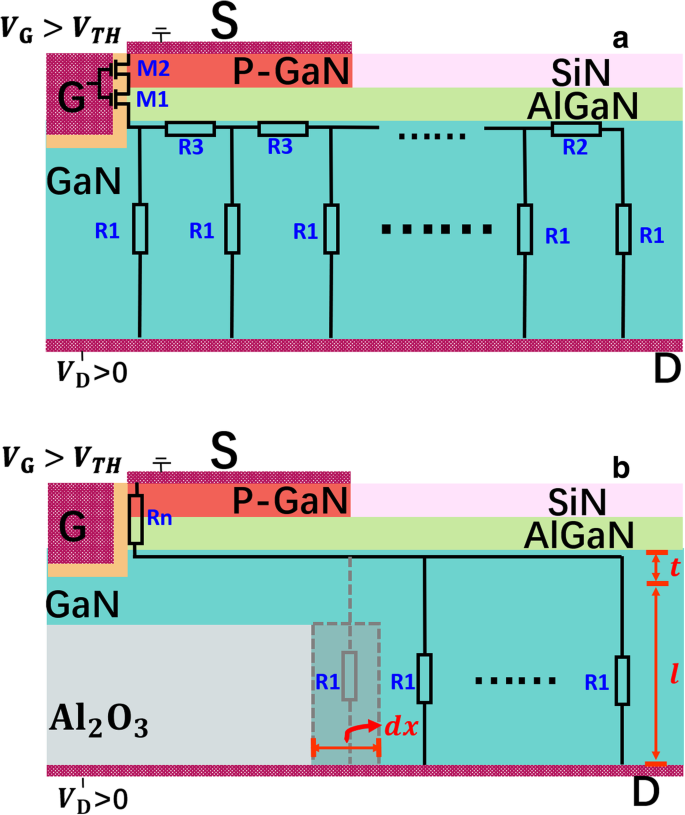
Het schema van a voorgesteld on-state model zonder SP b on-state weerstandsnetwerkmodel met SP
De p-GaN-cap kan als volledig uitgeput worden beschouwd, dus x D is gelijk aan 105 nm, de dikte van p-GaN. Vergeleken met R 1 , R 2 en R 3 zijn veel lager dan R 1 , vanwege hun hogere elektronenconcentratie en kortere geleidende weg. Daarom kan de weerstand in het 2-DEG-kanaal worden genegeerd. Bovendien, wanneer de afvoerspanning klein is en de MIS-achtige transistoren M 1 en M 2 werk in het onverzadigde model, de on-state weerstand van M 1 en M 2 kan worden beschouwd als een verwaarloosbare constante weerstand R n . Om de berekening te vereenvoudigen, is de analytische vorm van verticale stroompadgeleiding G v van het verticale stroompad kan worden verkregen als
$$ {G}_v={\int}_0^{L_D}\frac{1}{R_1}={\int}_0^{L_D}{n}_1 q\mu \bullet \frac{dx\bullet { W}_D}{l} $$waar L D is de lengte van het apparaat.
Daarom is de on-state weerstand R aan kan worden verkregen, die luidt:
$$ {R}_{on}=\frac{1}{G_v}+{R}_n=\frac{1}{n_1 q\mu}\bullet \frac{l}{L_D\bullet {W}_D }+{R}_n $$Wanneer SP bestaat, zoals weergegeven in figuur 4b, is het verticale geleidende pad gedeeltelijk geblokkeerd. De conductantie van het verticale stroompad kan dus worden uitgedrukt als
$$ {G}_v={\int}_{L_W}^{L_{\mathrm{D}}}\frac{1}{R_1}={\int}_{L_W}^{L_D}{n} _1 q\mu \bullet \frac{dx\bullet {W}_D}{l} $$waar L W is de lengte van de SP.
Daarom is de corresponderende R aan kan worden uitgedrukt als
$$ {R}_{on}=\frac{1}{G_v}+{R}_n=\frac{1}{n_1 q\mu}\bullet \frac{l}{\left({L}_D -{L}_W\right)\bullet {W}_D}+{R}_n $$In off-state, vanwege de condensatorachtige functionaliteit en de negatief geladen interface-val, zou de SP het elektrische veld onder de p-GaN-kap effectief herverdelen, waardoor een veldconcentratie rond de SP ontstaat die een grotere bandafstand bezit, zoals weergegeven in Fig. 5. Een dergelijke herverdeling van het E-veld verkleint het uitputtingsgebied dat verschijnt rond p-GaN en de poort, en verlicht daardoor de hoge veldconcentratie rond de p-GaN-kap en de poort, wat de BV van de SP-VFET zou verbeteren opmerkelijk. Aan de andere kant, zoals hierboven vermeld, zou de SP de geleiding van het apparaat zodanig beïnvloeden dat de negatieve lading die door de SP wordt geïntroduceerd, leidt tot de toename van potentiële energie nabij de poort, wat de afname van 2-DEG nabij de poort verklaart. Als gevolg hiervan zou een fluctuerende BFOM worden bereikt met het variëren van de lengte en de hoogte van de SP.
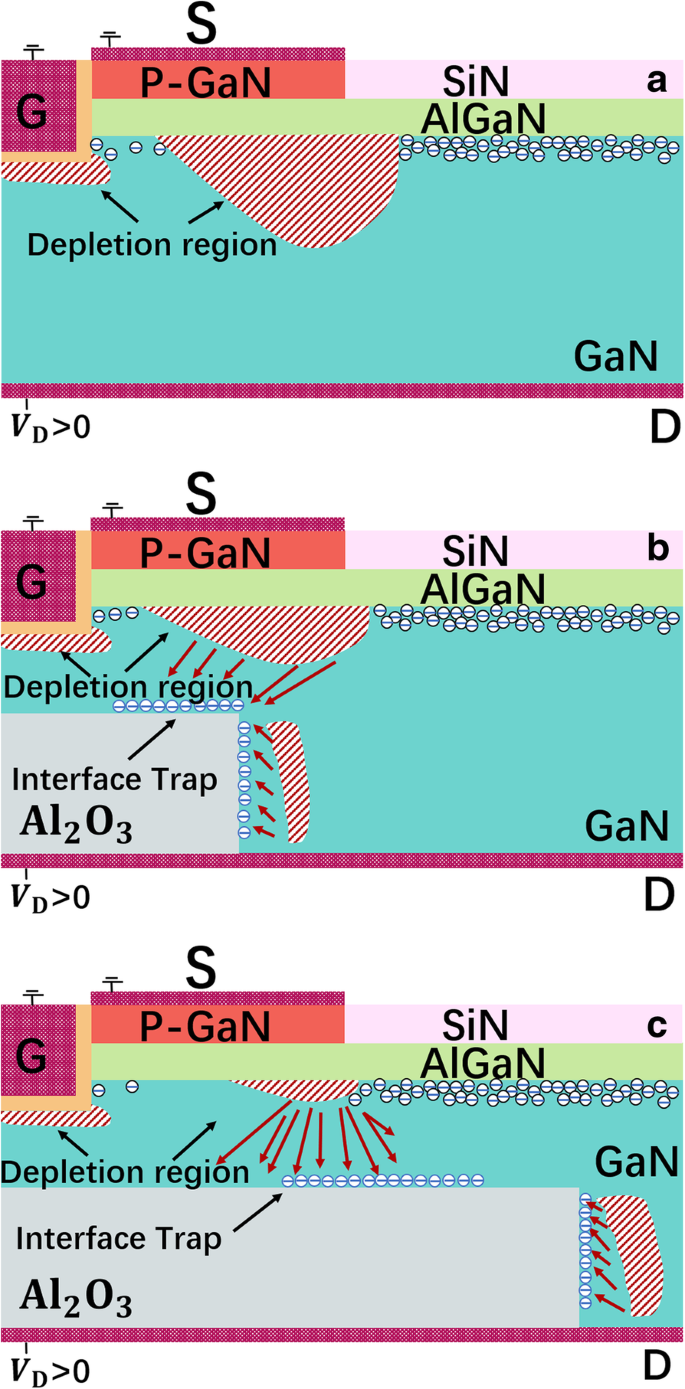
De schematische verdeling van het elektrische veld en het uitputtingsgebied in a het apparaat zonder de SP, b de voorgestelde SP-VFET met een korte SP, en c de voorgestelde SP-VFET met een lange SP
Met andere woorden, de SP zou de piek van het E-veld rond de p-GaN-hoek kunnen verminderen en tegelijkertijd het E-veld kunnen aantrekken dat zich over de SP concentreert, zoals weergegeven in Fig. 6a, b. Dankzij het hogere kritische E-veld van de SP zou een dergelijke E-veldconcentratie het apparaat echter niet breken, waardoor de SP-VFET een veel hogere BV zou vertonen.
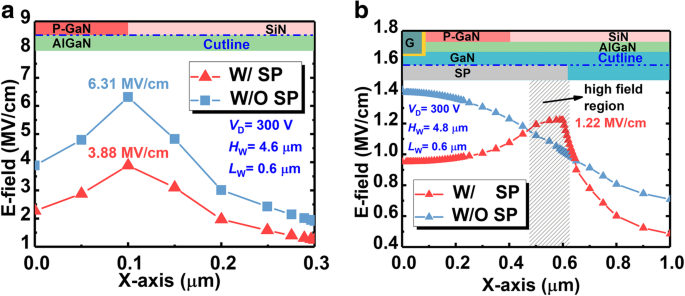
De elektrische veldverdeling van de voorgestelde SP-VFET langs de interface van a p-GaN/AlGaN en b GaN/SP
Resultaat en discussie
Afbeelding 7a, b toont respectievelijk de overdrachts- en uitvoercurves van het voorgestelde apparaat zonder de SP. Met verschillende lengtes van de p-GaN-cap overlappen deze curven elkaar in zowel subthreshold- als turn-on-regimes, wat suggereert dat de lengte van de p-GaN-cap de geleiding van het apparaat zonder de SP niet beïnvloedt. Met andere woorden, hoewel de p-GaN-cap de 2-DEG gedeeltelijk zou uitputten en hierdoor de weerstand van het 2-DEG-kanaal zou beïnvloeden, bezit de overgebleven 2-DEG nog steeds een grote concentratie n 3 die de niet-uitgeputte concentratie n . benadert 2 , wat wordt gerealiseerd door de p-type concentratie in p-GaN-cap te optimaliseren. Verder is, zoals eerder geanalyseerd, de weerstand van het 2-DEG-kanaal vrij klein vergeleken met de weerstand van het n-GaN in het verticale pad. Daarom overlappen de overdrachtscurven elkaar in Fig. 7a, b. Om de poort echter te beschermen tegen het sterk geconcentreerde E-veld, mag een dergelijke verdringing niet naast de poort zijn, wat betekent dat de lengte van de p-GaN niet te kort mag zijn. De minimale lengte van de p-GaN in ons werk is dus 400 nm, tenzij anders vermeld.
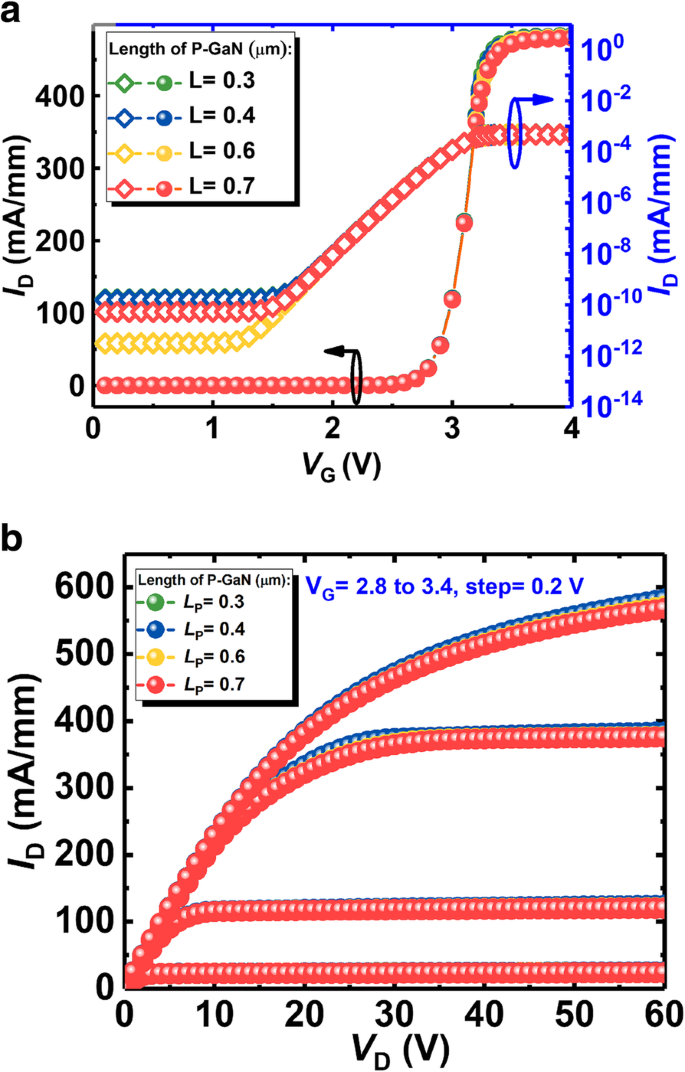
een De overdrachtscurven en b uitgangscurves van het apparaat zonder de SP in verschillende lengtes van de p-GaN-cap
Afbeelding 8 toont de outputkenmerken van de voorgestelde SP-VFET en de VFET zonder de SP. Het is te zien dat de SP de apparaatweerstand oplegt door het verticale geleidingskanaal te verkleinen. In detail is de weerstand in de staat onafhankelijk van de hoogte van de SP wanneer de hoogte lager is dan 4,7 m, terwijl deze aanzienlijk afhangt van de lengte van de SP die overeenkomt met het mechanisme dat een smal verticaal stroompad de geleiding doet krimpen. De voormalige onafhankelijkheid is omdat de 2DEG het belangrijkste laterale geleidingskanaal is dat niet zou worden verzwakt door de SP binnen zijn matige hoogte. Als de SP echter grenst aan het 2-DEG-kanaal, zal de geïntroduceerde negatieve lading rond de SP de energieband nivelleren, wat resulteert in een dramatische afname van de 2-DEG-concentratie. Dientengevolge neemt de weerstand van de 2-DEG toe en de totale weerstand R aan neemt dienovereenkomstig toe. Trouwens, de latere afhankelijkheid komt van de opmerkelijk verhoogde weerstand in het verticale kanaal zoals hierboven vermeld. Verder moet worden opgemerkt dat de roosterdefecten in 2-DEG veroorzaakt door hoge SP de hoogte van SP beperken.
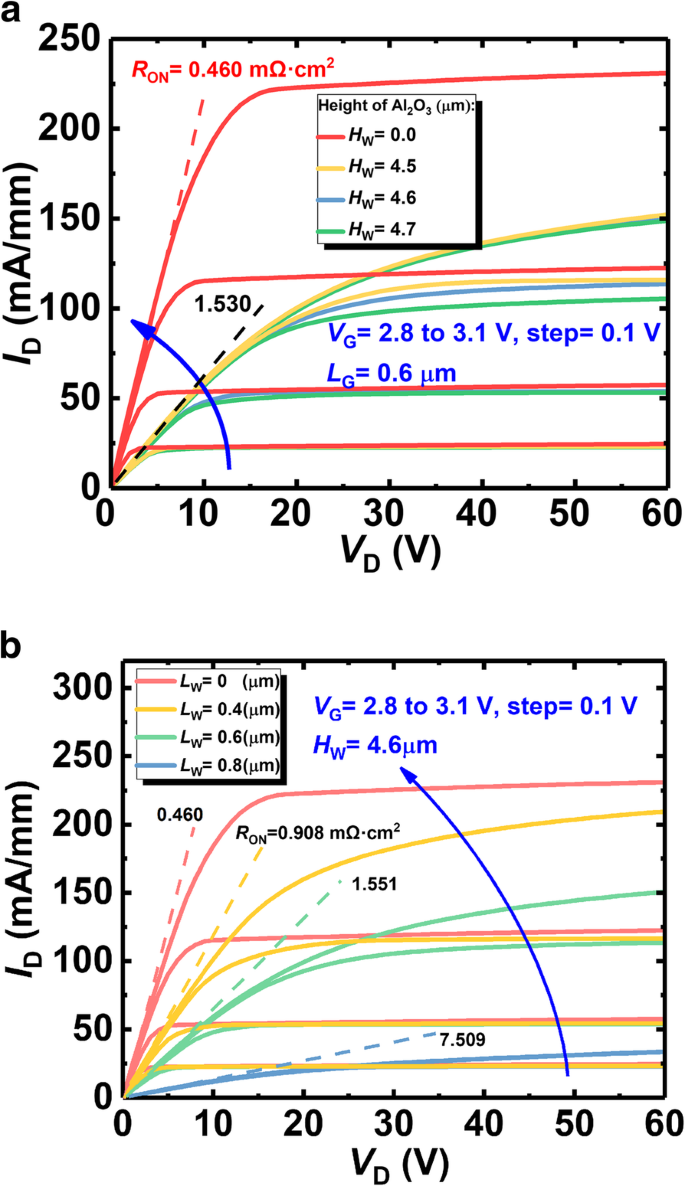
De uitgangscurven van de voorgestelde SP-VFET met variërende a SP-breedte en b SP-lengte vergeleken met het apparaat zonder SP
Figuur 9 toont de details van de stroomdichtheidsverdeling rond de poort van de VFET-apparaten met of zonder de SP, waarbij de VFET zonder de SP een hogere stroomtransportcapaciteit heeft die in lijn blijft met figuur 8a. En omgekeerd verkleint de SP-VFET de stroomgeleiding door het verticale kanaal te verkleinen. Ondertussen illustreren de gedetailleerde cijfers duidelijk dat de stroom in het zijkanaal wordt getransporteerd door de 2DEG, en de totale stroomdichtheid verandert enigszins met toenemende SP-hoogte, wat ook wordt aangetoond in de sectie over het mechanisme. De resultaten geven aan dat de weerstand van het laterale kanaal niet opmerkelijk wordt opgelegd door de SP binnen een gemiddelde hoogte.
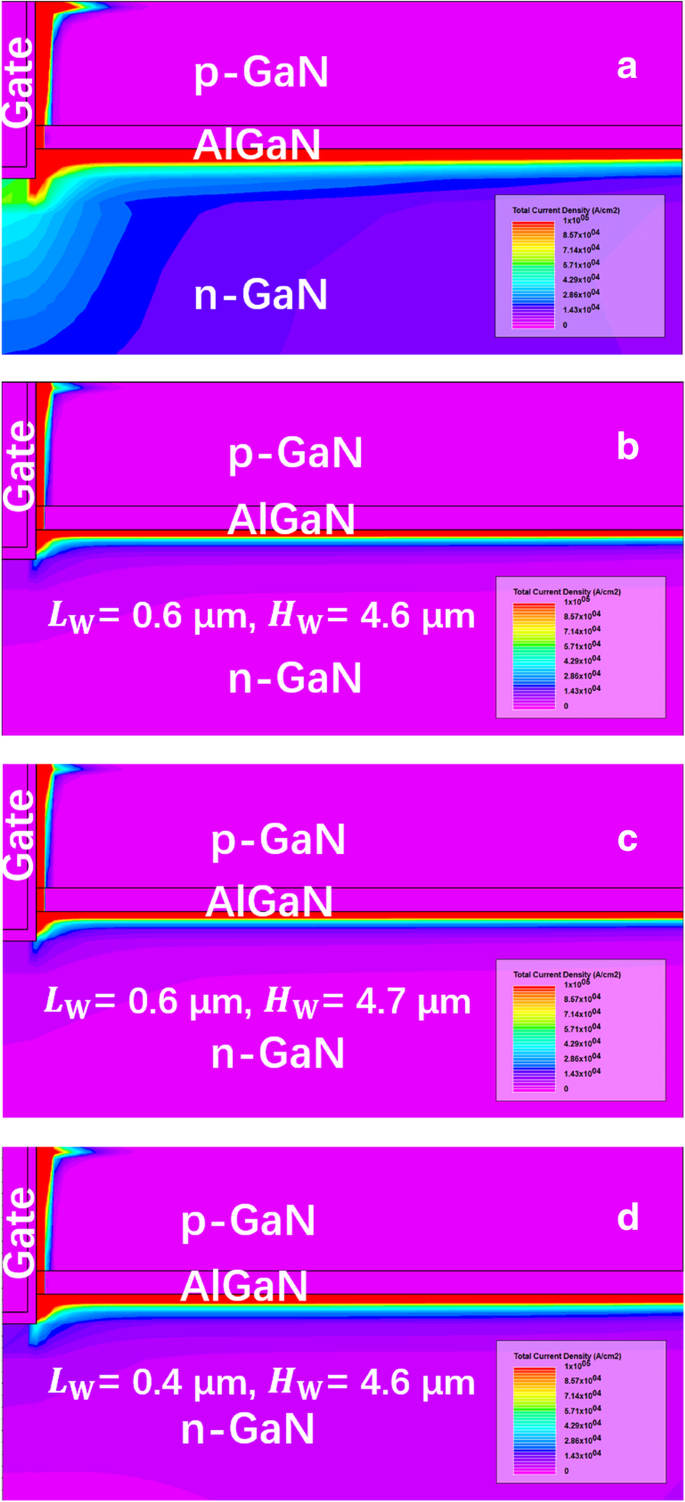
De stroomdichtheid van a het apparaat zonder de SP en b –d de voorgestelde SP-VFET met verschillende SP geometrische parameters
Afbeelding 10a toont de geëxtraheerde on-state weerstand en de bijbehorende BV. De weerstand van de SP-VFET neemt toe met langere SP. En vooral de curve van de weerstand versus de SP-lengte vertoont een hyperbolische trend, en de gradiënt van de curve neemt toe met de langere SP-lengte. Zoals eerder geanalyseerd, R aan varieert met verschillende SP lengte L W in een vorm van hyperbolische functie, die overeenkomt met het simulatieresultaat. Bovendien overlapt de weerstandscurve met verschillende SP-hoogten elkaar omdat de hoogte lager is dan 4,7 μm, wat suggereert dat 2-DEG-kanaal het belangrijkste laterale geleidende pad is en het 2-DEG-kanaal niet wordt beïnvloed, zoals hierboven vermeld.
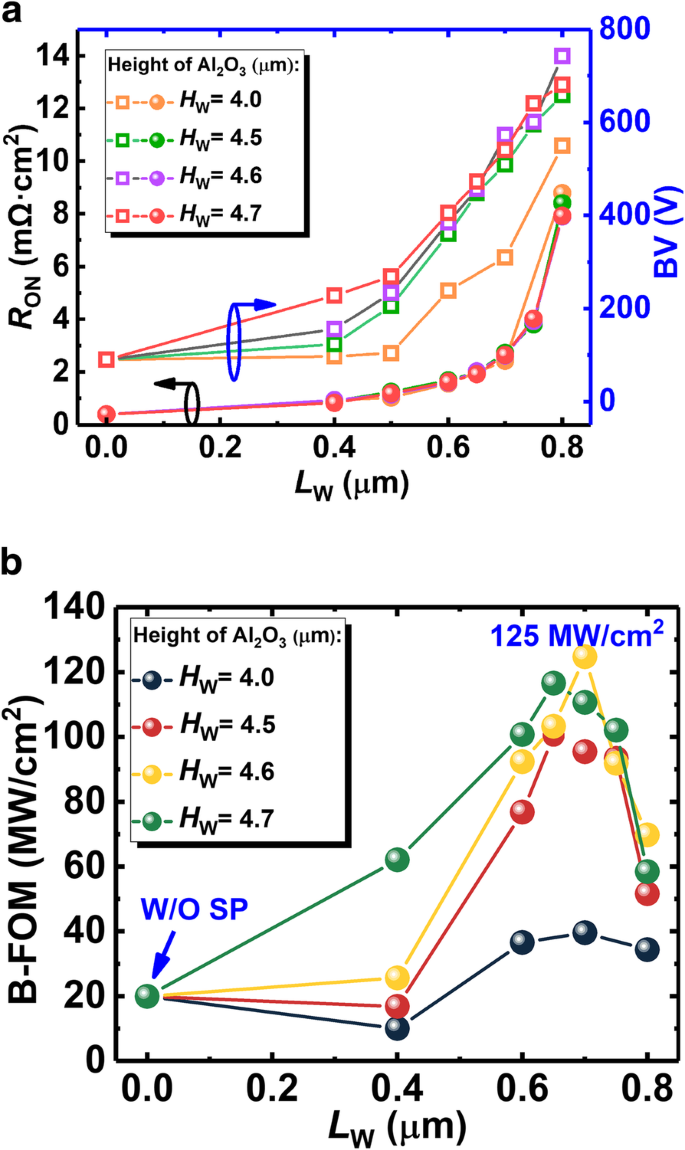
een De geëxtraheerde on-state weerstand evenals BV, en b de overeenkomstige BFOM van de voorgestelde SP-VFET in verschillende SP lengte en breedte
Afbeelding 10b toont de berekende BFOM van de SP-VFET. Vanwege de verschillende toenemende mate van BV en on-state weerstand, groeit de BFOM van alle apparaten eerst en daalt vervolgens na de lengte van de SP langer dan 400 nm. Een piek-BFOM van 125 MW/cm 2 wordt bereikt wanneer de lengte 700 nm bereikt en de hoogte 4,6 m bereikt. Vergeleken met het apparaat zonder de SP, presteert de voorgestelde SP-VFET meer dan zes keer beter in termen van de BFOM.
Deze verbetering wordt bereikt dankzij de onderdrukking van het hoge E-veld onder de p-GaN, dankzij de negatief geladen interface-val rond de SP. De interactie, die optreedt tussen de ingesloten negatieve lading op het grensvlak van de SP en het uitputtingsgebied rond de p-GaN, vormt een nieuwe verdeling van het E-veld, voornamelijk naar de ingesloten lading. Volgens de wet van Gauss wordt de elektrische flux beperkt door de omcirkelde lading. Het geïntroduceerde E-veld zal dus de elektrische flux naar elders beïnvloeden. Aangezien de negatieve lading van het uitputtingsgebied de belangrijkste bron is voor het kraaide E-veld rond p-GaN, zal het E-veld geïntroduceerd door de ingesloten lading een rol spelen bij het onderdrukken van het E-veld dat rond p-GaN kraait, en bijgevolg, BV wordt versterkt. In het bijzonder, wanneer de SP-lengte kleiner is dan 400 nm, is de door SP geïntroduceerde negatieve lading ver weg van het uitputtingsgebied. Het E-veld gevormd tussen het uitputtingsgebied en de ingesloten negatieve lading is dus te klein om een rol te spelen bij het beïnvloeden van het kraaide E-veld onder p-GaN. En als gevolg daarvan groeit de BV van het apparaat iets. Omdat de SP-lengte echter groter is dan 400 nm, vanwege de meer ingesloten negatieve lading op het grensvlak van de SP en de kortere afstand tussen het uitputtingsgebied en opgesloten negatieve lading, is het E-veld tussen het uitputtingsgebied en opgesloten negatieve lading verbeterd, wat leidt tot de groei van de BV.
Bovendien is het gebied rond de SP enorm uitgeput door de negatieve lading die door SP wordt geïntroduceerd. En zoals getoond in figuur 11, met de langere SP, vernauwt het verticale lekstroompad zich in de breedte vanwege het uitgeputte gebied dat naar de rand van het apparaat knijpt, wat ook de lekstroom blokkeert en bijgevolg de BV verbetert. Daarom stijgt de BV opmerkelijk met de toenemende SP-lengte.
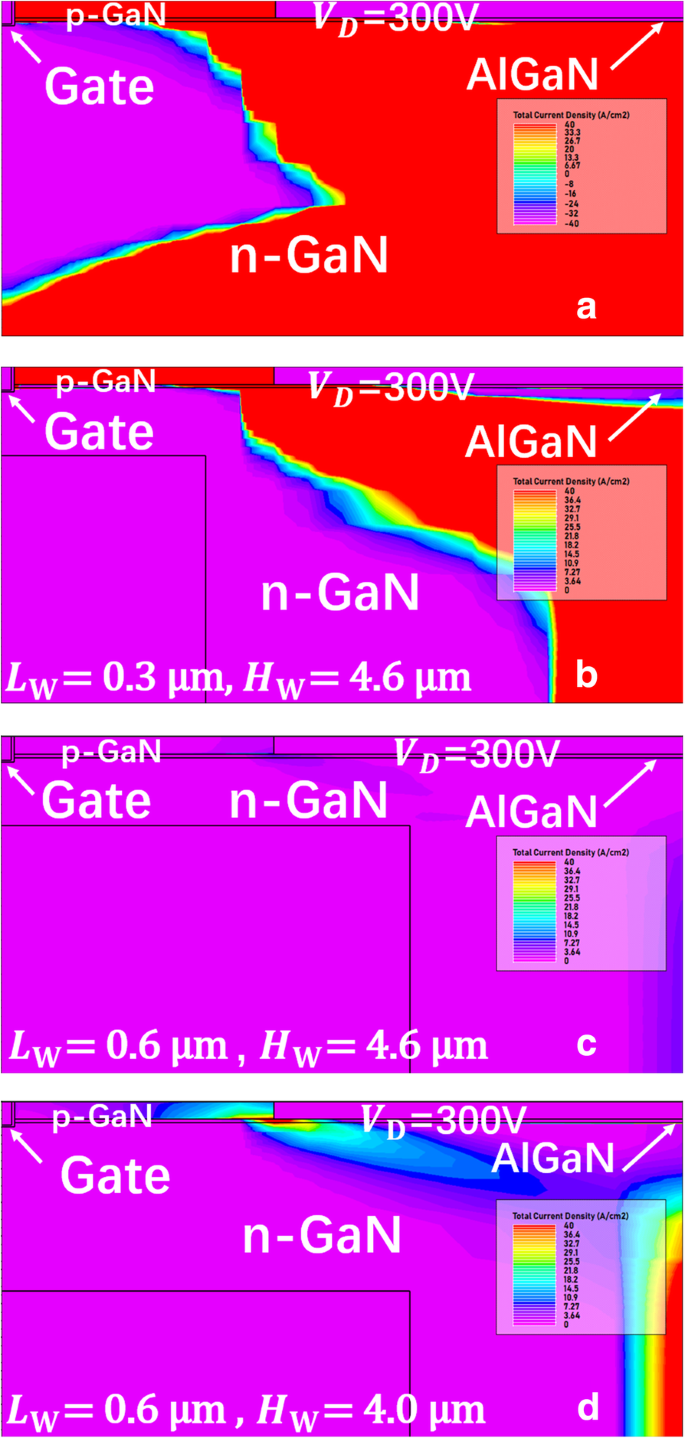
De lekstroomdichtheid van a het apparaat zonder de SP en b –d de voorgestelde SP-VFET met verschillende SP geometrische parameters
Afbeelding 12 toont de gesimuleerde E-veldverdeling in de SP-VFET wanneer de afvoerspanning 300 V is, waarbij de SP blijkbaar andere nieuwe E-veldconcentratiepunten induceert, wat betekent dat het piek E-veldgebied onder de p-GaN wordt onderdrukt . Vergeleken met de E-veldverdeling in de apparaten met verschillende SP-hoogten, onderdrukt de toename van de SP-lengte de congregatie van het E-veld en verbetert bijgevolg de BV efficiënter.

De E-veldverdeling rond de poort van de VFET a met of b –d zonder de SP wanneer de afvoerspanning 300 V is
Een dergelijk afgeplat E-veld kan ook expliciet worden waargenomen in Fig. 13, waarin de E-veldverdelingen langs de horizontale en loodrechte rand van de SP (zie de snijlijn) zijn uitgezet. Zoals aangetoond in polychrome Fig. 12, kan in Fig. 13 worden gezien dat hogere en langere SP een steeds effectievere rol speelt bij het reconstrueren van het E-veld onder p-GaN, en het aantrekken van E-veld om zich over de SP te concentreren kant. Deze herverdeling gaat het E-veld rond kwetsbaar p-GaN tegen. Zo wordt de BV van het apparaat verbeterd, waardoor de B-FOM van de voorgestelde SP-VFET wordt versterkt.
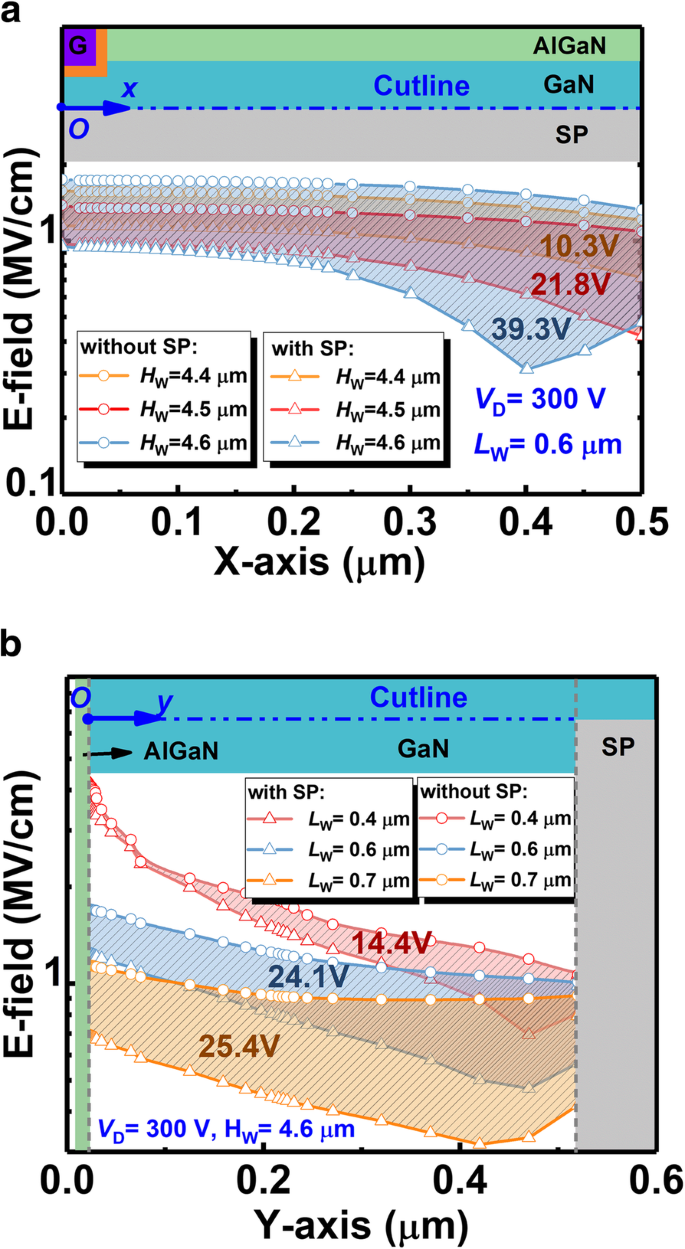
De E-veldverdeling a horizontaal en b loodrecht uitgetrokken langs de snijlijn van de SP-rand in de SP-VFET
Conclusie
In dit werk wordt een nieuwe GaN verticale FET (SP-VFET) van het versterkingstype met 2DEG-kanaal en substraatpatroon voorgesteld en onderzocht om de BFOM daarvan te verbeteren. Geverifieerd door experimenteel gekalibreerde simulatie geïmplementeerd met ATLAS, is het de SP die de E-veldpiek onder de p-GaN verlicht en tegelijkertijd nieuwe E-veldconcentratie aantrekt over de SP die een hoger kritisch E-veld bezit. Dientengevolge wordt de BV van de voorgestelde SP-VFET versterkt met een matig toenemende on-state weerstand als gevolg van de 2DEG-compensatie. De BFOM van de SP-VFET is daarom zes keer beter verbeterd dan die van het apparaat zonder de SP wanneer de SP-lengte en -hoogte respectievelijk 700 nm en 4,6 μm zijn, waardoor het veelbelovende potentieel van de voorgestelde SP-VFET in high-density-vermogen wordt weergegeven integratie.
Afkortingen
- n A :
-
Dopingconcentratie van p-type GaN
- n D :
-
Dopingconcentratie van n-type GaN
- 2DEG:
-
Tweedimensionaal elektronengas
- Al0,23 GaN:
-
Aluminium galliumnitride met een molfractie van 0,23 voor aluminium
- Al2 O3 :
-
Aluminiumoxide
- BFOM:
-
Baliga's verdiensten
- D SP :
-
Interface-valdichtheid van het substraatpatroon
- E-veld:
-
Elektrisch veld
- E T :
-
Het verschil tussen de geleidingsband en het energieniveau van de interface-trap
- FET:
-
Veldeffecttransistor
- GaN:
-
Galliumnitride
- HEMT:
-
Transistor met hoge elektronenmobiliteit
- H G :
-
Hoogte van de poort
- H W :
-
Hoogte van substraatpatroon
- L D :
-
Lengte van het apparaat
- L G :
-
Lengte van de poort
- L P :
-
Lengte van de p-GaN-cap
- L W :
-
Lengte van het substraatpatroon
- SiN:
-
Siliciumnitride
- SP:
-
Substraatpatroon
- SP-VFET:
-
Verticale veldeffecttransistor met substraatpatroon
- W D :
-
Diepte van het apparaat
- σ p :
-
Polarisatielading
Nanomaterialen
- Op pad met IoT
- Impact van oppervlaktetoestanden en aluminiummolfractie op oppervlaktepotentiaal en 2DEG in AlGaN/GaN HEMT's
- Modulatie van elektronische en optische anisotropie-eigenschappen van ML-GaS door verticaal elektrisch veld
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Effect van in situ gloeibehandeling op de mobiliteit en morfologie van op TIPS pentaceen gebaseerde organische veldeffecttransistoren
- Gecontroleerde synthese van BaYF5:Er3+, Yb3+ met verschillende morfologie voor de verbetering van upconversie-luminescentie
- Fotogeleiding, pH-gevoeligheid, ruis en kanaallengte-effecten in Si Nanowire FET-sensoren
- Groene synthese van metaal- en metaaloxidenanodeeltjes en hun effect op de eencellige alg Chlamydomonas reinhardtii
- Effect van morfologie en kristalstructuur op de thermische geleidbaarheid van Titania-nanobuisjes
- Voorbereiding van een periodieke polystyreen nanosfeer-array met behulp van de dip-drop-methode met post-depositie-etsen en de toepassing ervan om de efficiëntie van lichtextractie van InGaN/GaN te v…
- Invloed van het substraat op de LSP-koppelingsgolflengte en sterkte



