Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
Abstract
Foto-elektrische eigenschappen van de metamorfe InAs/In x Ga1 − x Als quantum dot (QD) nanostructuren werden bestudeerd bij kamertemperatuur, gebruikmakend van fotogeleiding (PC) en fotoluminescentie spectroscopie, elektrische metingen en theoretische modellering. Vier monsters met verschillende stoichiometrie van In x Ga1 − x Als bekledingslaag zijn gegroeid:indiumgehalte x was 0,15, 0,24, 0,28 en 0,31. InAs/In0,15 Ga0,85 De QD-structuur bleek lichtgevoelig te zijn in het telecombereik op 1,3 μm. Als x toeneemt, werd een roodverschuiving waargenomen voor alle monsters, de structuur met x = 0,31 bleek gevoelig te zijn in de buurt van 1,55 μm, d.w.z. bij het derde telecommunicatievenster. Tegelijkertijd werd slechts een lichte afname van de QD-pc geregistreerd voor een toename van x , waarmee een goede fotorespons wordt bevestigd die vergelijkbaar is met die van In0.15 Ga0,75 Als structuren en van op GaAs gebaseerde QD-nanostructuren. Ook correleert de pc-reductie met de vergelijkbare vermindering van de fotoluminescentie-intensiteit. Door theoretisch het kwantumenergiesysteem en de lokalisatie van de drager in QD's te simuleren, kregen we inzicht in het pc-mechanisme en konden we redenen voor de fotostroomreductie suggereren, door ze te associëren met eigenaardig gedrag van defecten in een dergelijk type structuren. Dit alles houdt in dat metamorfe QD's met een hoge x zijn geldige structuren voor opto-elektronische infrarood lichtgevoelige apparaten.
Achtergrond
Metamorfe InAs/In x Ga1 − x Omdat QD-nanostructuren het afgelopen decennium veel belangstelling hebben getrokken vanwege de vele voordelen [1,2,3,4,5,6,7]. Hun meest aantrekkelijke eigenschap is dat, door de QD's te laten groeien op een InGaAs-metamorfe buffer (MB), men een significante vermindering van de overgangsenergie tussen de QD-niveaus [8] kan bereiken met betrekking tot conventionele In(Ga)As/GaAs QD-structuren . Dit komt door de afname van de InAs QD-bandgap als gevolg van de vermindering van de roostermismatch tussen InAs QD's en InGaAs-buffer en dus de spanning in QD's [9,10,11]. De toepassing van een MB als beperkend materiaal maakt het dus mogelijk om de emissiegolflengtewaarde dieper in het infrarode (IR) bereik te verschuiven, met name in de telecommunicatievensters op 1,3 en 1,55 μm, terwijl een hoog rendement behouden blijft [4, 12, 13]. Verder hebben metamorfe QD's interessante eigenschappen laten zien, zoals (i) een hoge QD-dichtheid [14], (ii) de mogelijkheid om de QD- en bevochtigingslaag (WL)-niveaus breed af te stemmen [10, 15], en (iii) goede prestaties van actieve elementen in lichtgevende apparaten [16]. Uit recent onderzoek naar diepe niveaus in metamorfe QD's bleek echter dat, ondanks InAs/In0,15 Ga0,85 Als QD-structuren met een totale defectdichtheid dichtbij de QD-laag die vergelijkbaar is met die van InGaAs/GaAs pseudomorfe QD's, metamorfe structuren met hogere x toonde hogere defectdichtheden [17, 18].
Metamorfe InAs QD-structuren hebben succesvolle toepassingen gevonden in het ontwerp en de fabricage van IR-fotonische en lichtgevoelige apparaten, zoals lasers [19, 20], enkelvoudige fotonbronnen [3, 7, 21, 22] en zonnecellen [23 ,24,25]. In(Ga)As QD-fotodetectoren op basis van interband- en intersubbandovergangen worden momenteel actief onderzocht voor verbeterde detectie van bijna-IR tot langegolf-IR-bereiken vanwege hun reactie op de bestraling bij normale inval [26,27,28,29,30] . De intersubbandovergangen van elektronen tussen kwantumbegrensde niveaus en continuümtoestanden kunnen bijvoorbeeld worden ontworpen door InAs QD's in te bedden in InGaAs-lagen [29,30,31,32], aangezien dit ontwerp het mogelijk maakt om de detectiepiekgolflengte af te stemmen, om de reactie door een extern toegepaste bias en om de donkerstroom te verminderen [33, 34]. Tot op heden zijn er geen artikelen over de implementatie van metamorfe QD-structuren in fotodetectoren.
De sleutelrol voor de ontwikkeling van dit gebied is het behoud van een hoge emissie-efficiëntie en lichtgevoeligheid van metamorfe QD-structuren die op zijn minst vergelijkbaar moeten zijn met die van conventionele InAs/GaAs QD-structuren [1, 5, 35]. Er zijn veel studies uitgevoerd in de fundamentele en toepassingsgebieden om structuurontwerp te ontwikkelen [6, 14, 21], om foto-elektrische eigenschappen te verbeteren [5, 13], en om spanningsgerelateerde defecten in de heterostructuren te beheersen/verminderen [4, 36, 37].
Vandaar dat InAs/In x Ga1 − x Omdat metamorfe QD-nanostructuren interessante nanostructuren zijn, die emissie of fotoresponsiviteit mogelijk maken in het IR-bereik van 1,3 en 1,55 μm [1,2,3,4,5,6,7]. Verder werd door ons eerder gemeld dat verticale InAs/In0.15 Ga0,75 Omdat QD-structuren de lichtgevoeligheid kunnen behouden die vergelijkbaar is met de op GaAs gebaseerde structuren [5]. Dergelijke metamorfe structuren worden echter zelden bestudeerd in foto-elektrische metingen met een laterale geometrie, waarbij de fotostroom verloopt door transport in het vlak van dragers over kanalen tussen twee bovenste contacten. Gewoonlijk vormen de QD-lagen samen met de bijbehorende WL deze geleidbaarheidskanalen in de laterale geometrie-ontworpen GaAs-gebaseerde structuren [38]. Vanwege dit eigenaardige type geleidbaarheid wordt aangenomen dat QD-fotodetectoren met lateraal transport potentieel hebben voor een hoge fotoresponsiviteit [39, 40]. Een diepgaande studie van metamorfe InAs/InGaAs QD-nanostructuren in de laterale configuratie kan fundamentele kennis opleveren over het fotogeleidingsmechanisme (PC) en de efficiëntie van het in-plain dragertransport. In ons recente artikel gewijd aan de defecten in metamorfe QD-structuren [17], rapporteerden we laterale pc-metingen bij lage temperaturen, waarbij alleen rekening werd gehouden met de IR-spectraranden die afkomstig waren van defecten. We zijn echter van mening dat een goede karakterisering en fundamenteel onderzoek van de structuur bij kamertemperatuur waardevolle inzichten kan opleveren voor verdere verbeteringen van nieuwe lichtgevoelige apparaten zoals bijna-IR-fotodetectoren, lineaire arrays en cameramatrices, door metamorfe QD's te implementeren.
In het huidige werk hebben we in-plane foto-elektrische eigenschappen van de metamorfe InAs/In x Ga1 − x Als QD-nanostructuren gegroeid door moleculaire bundelepitaxie met verschillende In samenstelling x , gebruikmakend van pc- en fotoluminescentie (PL) spectroscopieën, laterale elektrische metingen en modelberekeningen. We hebben ons in het bijzonder gericht op de waarneming van een mogelijke roodverschuiving van de fotorespons van de QD-laag in de richting van de IR van meer dan 1,3 μm, terwijl de lichtgevoeligheid voor In0,15 gelijk bleef. Ga0,85 As en GaAs QD lichtgevoelige structuren. Een hoge lichtgevoeligheid in het bijna-IR-golflengtebereik bij kamertemperatuur is een aanwijzing dat deze nanostructuren niet alleen nuttig kunnen zijn voor apparaten die zijn gebaseerd op interbandovergangen, maar ook voor intersubbandfotodetectoren die werken boven 10 μm.
Methoden
Voorbereiding en beschrijving van monsters
De bestudeerde structuren die schematisch worden getoond in Fig. 1 werden gekweekt door moleculaire bundelepitaxie. Eerst werd een semi-isolerend (100) GaAs-substraat bedekt met een 100 nm dikke GaAs-buffer bij 600 ° C, gevolgd door de afzetting van een ongedoteerd InGaAs MB met een dikte van 500 nm bij 490 ° C. Vervolgens, na de eerdere groeionderbreking van 210 s om het substraat af te koelen, werden 3,0 ML's (monolagen) InAs gekweekt bij 460 ° C. Ten slotte werden deze zelf-geassembleerde QD's gedekt door 20 nm ongedoteerde In x Ga1 − x Zoals bij dezelfde MB-stoichiometrie. Vier monsters met verschillende stoichiometrie van In x Ga1 − x Als bekledingslaag zijn vervaardigd:In inhoud x was 0,15, 0,24, 0,28 en 0,31.
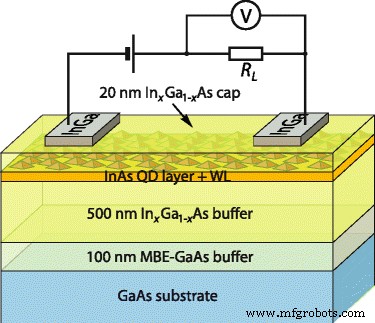
Kleur op internet. Schema van de metamorfe InAs/In x Ga1 − x Als QD-structuren en hun verbinding voor de foto-elektrische metingen
Theoretische modellering
Voor het ontwerpen van metamorfe structuren en voor het begrijpen van het energieprofiel, werden de berekeningen van het kwantumenergiesysteem samengesteld door In(Ga)As QD's, ongedoteerde MB en deklaag uitgevoerd met behulp van de Tibercad-software [41] die we hebben gedemonstreerd om voldoende zijn om de optische eigenschappen van halfgeleider laagdimensionale nanostructuren te simuleren [2, 15, 42].
We beschouwen een InAs QD met afgeknotte conische vorm en afmetingen ontleend aan experimentele atomaire krachtmicroscopiegegevens [14]; we nemen de aanwezigheid van InAs WL op, welke parameters afhankelijk zijn van de In x Ga1 − x Als metamorfe laag eigenschappen [15].
Eerst worden rekberekeningen voor de structuur gemaakt door de spanningstensorcomponenten van de QD te berekenen, veroorzaakt door de mismatch f QD tussen de QD en MB, gedefinieerd als
$$ {f}_{\mathrm{QD}}=\left[{a}_{\mathrm{InAs}}\hbox{--} {a}_{\mathrm{MB}}(x)\right ]/{a}_{\mathrm{MB}}(x) $$ (1)waar a MB (x ) is de roosterparameter van In x Ga1 − x Als MB en a InAs is de roosterparameter van InAs. Bandprofielen voor QD's en inbeddingslagen zijn dan afhankelijk van de vervormingspotentiaal van de relevante materialen (InAs voor QD's en WL's en ontspannen InGaAs voor MB).
Ten slotte de Schrödingervergelijking
$$ \boldsymbol{H}\psi =E\psi $$ (2)wordt opgelost in de benadering van de envelopfunctie door een enkelbands, effectieve massa-benadering voor elektronen en 6-banden k•p-benadering voor gaten, waarbij de 3D Hamiltoniaan is
$$ \widehat{H}=-\frac{\upeta^2}{2}{\nabla}_{\mathbf{r}}\left(\frac{1}{m\left(E,\mathbf{ r}\right)}\right){\nabla}_{\mathbf{r}}+V\left(\mathbf{r}\right), $$ (3)met V (r ) het 3D-potentieel zijn.
Een dergelijke benadering wordt als bevredigend beschouwd bij het uitvoeren van QD-grondtoestandberekeningen [2]. Zo worden grondniveaus voor elektronen en zware gaten verkregen, naast hun waarschijnlijkheidsdichtheden. Fotoluminescentie-emissie-energieën werden afgeleid door het energieverschil tussen beperkte niveaus voor elektronen en zware gaten te nemen, verminderd met 20 meV om rekening te houden met excitonische effecten.
Een meer gedetailleerde beschrijving van modelberekeningen is te vinden in Ref. [2].
Foto-elektrische karakterisering
Voor de laterale foto-elektrische metingen werden twee InGa-eutectische oppervlaktecontacten afgezet over stukken van 5 × 2 mm van de structuren. Gemeten lineair I –V kenmerken gegeven in Fig. 2 hebben de contactohmiciteit bevestigd. De stroom die door de monsters vloeide, werd gemeten met een Siglent SDM3055-multimeter, met behulp van een standaard gelijkstroomtechniek [43, 44] als een spanningsval over een seriebelastingsweerstand R L van 1 MΩ, wat veel minder was dan de monsterweerstand. Fotostroom werd opgewekt door een 250-W halogeenlamp licht verspreid met een prisma monochromer, en pc-spectra werden opgenomen in het bereik van 0,6 tot 1,6 eV [44,45,46]. De spectra werden genormaliseerd naar het excitatiekwantagetal van de lichtbron. PL-spectra werden verkregen met een laser van 532 nm als excitatiebron met een vermogensdichtheid van 5 W/cm 2 . Alle metingen zijn uitgevoerd bij kamertemperatuur (300 K).

Kleur op internet. Ik –V kenmerken van de InAs/In x Ga1 − x Als structuren met x = 0,15 (een ), 0,24 (b ), 0,28 (c ), en 0,31 (d ) voor het donker (zwart) en onder een verlichting van 350 W/cm 2 (kleur) bij energieën van PL-spectrumpiek (QD-excitatie) en 1,3 eV (effectieve absorptie in InGaAs). Insets:fotostroom afhankelijkheid van voorspanning
Resultaten en discussie
PC-spectra van de bestudeerde metamorfe InAs/In x Ga1 − x Zoals QD-structuren bij kamertemperatuur worden gegeven in Fig. 3 samen met de PL-banden, die de optische overgangen tussen QD-grondtoestanden laten zien. De relatieve intensiteiten en posities van de PL-banden worden ook getoond in figuur 4b. Kenmerken als gevolg van de QD's, InGaAs-begrenzingslagen en GaAs-onderlagen worden waargenomen op de pc-curven. Het fotostroomsignaal bij de energieën onder het begin van de PL-band kan verband houden met de eerder gedetecteerde structuurdefecten [17].

Kleur op internet. PC-spectra van de metamorfe InAs/In x Ga1 − x Als structuren bij kamertemperatuur en een bias van 11 V voor x = 0,15 (een ), 0,24 (b ), 0,28 (c ), en 0,31 (d ). De excitatie-intensiteiten voor de zwarte, rode en blauwe curven bij 1,3 eV komen overeen met 88, 350 en 1400 μW/cm 2 , respectievelijk. PL-spectra in willekeurige eenheden worden gegeven voor de energiepositionering van QD-grondtoestandovergangen. De verticale pijlen markeren de InGaAs-bandgaps (ε g ) berekend volgens Paul et al. [48] en spectrale posities, waar de pc-afhankelijkheden van de excitatie-intensiteit werden gemeten (gegeven in Fig. 5)

Kleur op internet. Modelberekeningen voor de metamorfe InAs/In x Ga1 − x Als QD-structuren:a bandprofielen in de structuren met verschillende x langs de groei-as; b de echte QD PL-banden en hun berekende piekposities (gestippelde verticale lijnen); en c waarschijnlijkheidsdichtheden van de opgesloten elektronen en gaten voor de InAs/In0,15 Ga0,85 Als QD. Alle berekeningen van gemodelleerde constructies zijn uitgevoerd voor 300 K
De onderzochte metamorfe InAs/In0.15 Ga0,85 Omdat de QD-structuur lichtgevoelig bleek te zijn in het telecombereik bij 0,95 eV (1,3 μm) (figuur 3a). Als x verhoogd, werd een roodverschuiving waargenomen voor alle monsters:de structuur met x = 0,31 bleek gevoelig te zijn in de buurt van 0,8 eV (1,55 μm) (Fig. 3d), d.w.z. bij het derde telecomvenster [47]. De verschuiving houdt verband met de vermindering van de roostermismatch tussen de materialen van InAs QD en In x Ga1 − x Als buffer met een verhoging van x en dus een afname van de stam in QD's. Dit leidt tot een vernauwing van de InAs QD-bandgap en, op zijn beurt, tot de roodverschuiving van de PL-band en het begin van de fotorespons richting IR [1,2,3,4,5,6, 19, 35].
Tegelijkertijd werd slechts een lichte afname van het QD-fotostroomsignaal geregistreerd, wat het behoud van een goede fotorespons bevestigt, vergelijkbaar met die van de In0.15 Ga0,75 Als monster. Zoals we onlangs [5] bespraken, metamorfe QD-structuren met x = 0,15 laten een fotorespons zien die erg lijkt op die van pseudomorfe InAs/GaAs QD-nanostructuren. Ook correleert de PC-reductie met de PL-reductie zoals te zien is in Fig. 3.
Een dergelijk effect voor onze samples bleek het meest opvallend in figuur 2, waar de I –V afhankelijkheden in het donker en onder verlichting op verschillende karakteristieke spectrale punten op voorspanning worden getoond, samen met de fotostroomafhankelijkheden in de inzetstukken. Net als in figuur 3, impliceert de fotostroomwaarde alleen het foto-geïnduceerde deel van de stroom die wordt verkregen uit de totale stroom onder verlichting door de donkerstroomwaarde af te trekken. Deze spectrale punten zijn de PL-bandmaxima en 1,3 eV, waar een effectieve band-naar-bandabsorptie in InGaAs MB optreedt. Evenals voor de donkere ik –V kenmerken, zijn deze afhankelijkheden lineair-achtig binnen de experimentele fout.
De beste fotorespons werd gemeten in de structuur met het minimale In-gehalte in de begrenzende lagen. Het had ook de laagste donkerstroom. De fotostroomwaarde bij het toegepaste excitatieniveau (350 μW/cm 2 ) in de InAs/In0.15 Ga0,85 Omdat de structuur twee tot drie keer hoger was dan de donkere stroom toen MB werd gepompt. De fotorespons bij QD-excitatie was vergelijkbaar met de donkerstroom; er moet echter rekening mee worden gehouden dat onze structuren slechts één QD-laag hadden. Fabricage van de meerlagige QD-structuren zou zeker leiden tot een significante toename van de IR-fotorespons. Andere structuren met een hogere x onthulde lagere fotostroomsignalen; de gedetecteerde magnitudes op beide spectraalpunten waren ongeveer een orde lager dan de donkerstroomwaarden in een breed bereik van de aangelegde spanning. De laagste fotorespons werd gevonden voor de InAs/In0.31 Ga0,69 Als structuur met de maximale MB In inhoud.
Hoogstwaarschijnlijk houdt deze afname van de fotoresponsiviteit verband met een toename van de MB-defectdichtheid met x , die eerder voor deze structuren werd bepaald, gebruikmakend van thermisch gestimuleerde stroomspectroscopie op diep niveau [17], die goed correleerde met structurele analyse van dergelijke nanostructuren [1]. We hebben gemeld dat de InAs/In0.15 Ga0,85 Aangezien de QD-structuur een totale defectdichtheid had die dicht bij de QD-laag lag, vergelijkbaar met die van InGaAs/GaAs, terwijl andere structuren met een hoger In-gehalte hogere dichtheden van defecten vertoonden, zoals de bekende GaAs-gerelateerde puntdefectcomplexen EL2, EL6, EL7, EL9 en EL10 nabij de QD-laag en drie niveaus toegeschreven aan uitgebreide defecten die zich door de buffer voortplanten.
Met betrekking tot de spectrumvorm (Fig. 3), boven de QD-excitatie, vinden lichtabsorptie en dus de dragergeneratie voornamelijk plaats in de MB bij energieën boven de InGaAs-begrenzende laag bandgap ε g , welke waarden voor verschillende x werden geschat met een empirische formule [48]. Het is echter opmerkelijk dat een toename van de fotonenergie boven ε g leidt tot een lichte afname van de fotorespons. Dit bevestigt natuurlijk dat metamorfe QD's, ondanks dat ze effectieve recombinatiecentra zijn [1, 2, 12, 22], efficiënter bijdragen aan fotostroom dan MB [5, 6, 23].
Om het pc-mechanisme van deze eigenaardigheid te begrijpen, moet men kijken naar figuur 4a, waar we de berekende QD-bandprofielen langs de groeirichting voor onze monsters laten zien. Berekeningen worden gevalideerd door het resultaat van kwantumenergieniveaus voor elektronen en gaten:de verwachte PL-emissie-energieën zijn in overeenstemming met de experimenteel gemeten PL QD-grondtoestandovergang (figuur 4b). In Fig. 4c tonen we de gesimuleerde waarschijnlijkheidsdichtheden voor opgesloten elektronen en gaten, verkregen door de draaggolffuncties berekend met de Tibercad-modellering, die wijzen op een hoger niveau van lokalisatie voor zware gaten in vergelijking met elektronen.
Om bij te dragen aan het fotostroomsignaal, moeten elektron-gatparen die worden gegenereerd door QD-interbandabsorptie uit QD's ontsnappen door thermische emissie. In een eerdere studie [49] werd vastgesteld dat in metamorfe QD's elektronen en zware gaten gelijktijdig ontsnappen uit QD's als gecorreleerde paren. Bovendien werd ook aangetoond dat de activeringsenergie voor een dergelijk proces overeenkomt met de som van de activeringsenergieën voor de twee deeltjes [50].
Tijdens het bestuderen van thermische uitdoving van PL-emissie van metamorfe QD's [10, 51], hebben we bewezen dat dergelijke activeringsenergieën gelijk zijn aan de som van de energie-afstand van de WL-niveaus en QD-toestanden en gaan van 250 meV voor x = 0,15 omlaag tot 150 meV voor x = 0,31. Zoals uitgebreid besproken in Ref. [51], deze waarden veroorzaken een sterke uitdoving van de PL-emissie bij kamertemperatuur via de thermische ontsnapping van opgesloten dragers.
Op basis hiervan kunnen we concluderen dat dragers die zijn geëxciteerd in QD's thermisch kunnen ontsnappen naar WL en MB:daar worden elektronen en zware gaten gescheiden door de bandbuiging in de QD-nabijheid (figuur 4a), wat het vasthouden van het gat naar QD's bevordert en, hoewel het een barrière vormt voor elektronen, onderdrukt het daardoor effectief hun stralingsrecombinatie. Als gevolg hiervan zijn zware gaten geconcentreerd aan de QD-periferie (figuur 4c), terwijl elektronen vrij kunnen bewegen langs de potentiaalbron van WL en MB, wat bijdraagt aan de geleidbaarheid. Het is vermeldenswaard dat in Ref. [49], wordt besproken dat, hoewel gecorreleerd tijdens het ontsnappingsproces, dragers niet kunnen worden beschouwd als excitonen bij kamertemperatuur; voortaan kunnen ze gemakkelijk worden gescheiden door het buigen van de band in de buurt van QD's.
Anders worden, wanneer de MB wordt geëxciteerd, niet-evenwichtsgaten gegenereerd in de opsluitende lagen en recombineren ze met elektronen. Hier moet worden vermeld dat de WL bekend staat als een geleidbaarheidskanaal voor nanostructuren op basis van GaAs [52] en in onze laterale structuren die zijn ontworpen met oppervlaktecontacten, is er geen heterojunctie, dus dragers worden efficiënt verzameld in de buurt van het oppervlaktevlak.
In Fig. 3, de daling van het pc-signaal net boven ε g omgezet in de stijging bij hogere energieën, bijvoorbeeld boven 1,3 of 1,1 eV voor een monster met x van respectievelijk 0,15 of 0,31. Dit werd mogelijk veroorzaakt door de optische absorptie dichter bij het oppervlak en de QD-laag, waardoor er ondiepere vallen waren. Zoals vastgesteld voor deze structuren door thermisch gestimuleerde stroomspectroscopie en transiënte spectroscopie op diep niveau [17, 18], bevinden de diepere elektronenvallen zich voornamelijk in de InGaAs MB-laag, terwijl de ondiepere geconcentreerd zijn nabij het oppervlak (in relatie tot deze monsters, nabij de QD-laag). De elektronen die in de ondiepere vallen gevangen zitten, kunnen bij kamertemperatuur gemakkelijker terug naar de geleidingsband ontsnappen. Vrije elektronen in de buurt van de QD-laag zijn dus mobieler dan die welke dieper in de MB worden geëxciteerd en leveren daarom een grotere bijdrage aan de ladingsoverdracht. Bovendien kunnen de elektronen, die nabij het oppervlak worden gegenereerd, vrijelijk worden overgedragen naar het WL-geleidingskanaal.
Een vergelijkbare daling van de fotostroom na een toename boven de GaAs-bandgap (bijna 1,4 eV) werd waargenomen. Dit effect kan te wijten zijn aan de generatie van dragers dicht bij de InGaAs/GaAs-interface, waarvan bekend is dat deze een hogere dichtheid van defecte toestanden heeft, zoals vallen en recombinatiecentra.
De relatieve bijdrage van verschillende optische overgangen aan de structuurfotorespons varieerde met de pompintensiteit. Dit wordt beter waargenomen in Fig. 5, die fotostroomwaarden laat zien als een functie van de excitatie-intensiteit op verschillende karakteristieke spectrale punten:het begin van de PL-band (resonante excitatie van het QD-ensemble) of efficiënte band-naar-bandabsorptie in InGaAs (1,3 eV) en GaAs (1,5 eV).
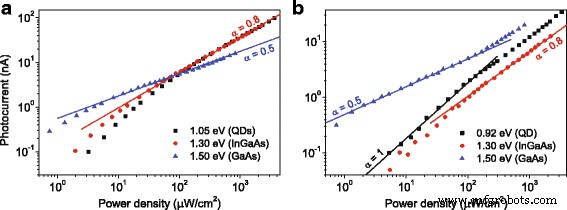
Kleur op internet. Fotostroom vs. excitatie-intensiteit voor de InAs/In x Ga1 − x Als structuren met a x = 0.15 en b 0,31. De lijnen passen bij de functies f (x ) ~ x α
De structuren met verschillende In-gehalten in de begrenzende lagen vertoonden vergelijkbare afhankelijkheden bij equivalente spectrale bereiken. Dus de band-naar-band-excitatie in GaAs (1,5 eV) vertoont een kwadratische afhankelijkheid bij de meeste intensiteitswaarden. Dit is typerend voor de band-naar-band recombinatie van niet-evenwichtsladingsdragers, bijvoorbeeld wanneer ze sterk overheersen onder de evenwichtsdragers [53]:dit is te verwachten in onze ongedoteerde structuren. De afhankelijkheden in het geval van excitatie in de QD- en InGaAs-begrenzingslagen lijken erg op elkaar, maar verschillen van die voor GaAs. Ze zijn lineair bij lage excitatie-intensiteiten en worden sublineair bij hogere intensiteiten. Dit gedrag wijst duidelijk op de recombinatie van dragers waarbij Shockley-Read-centra betrokken zijn:de lineaire afhankelijkheid wordt sublineair, aangezien sommige centra verzadigd raken bij hogere snelheden voor het genereren van dragers [54]. Deze resultaten van intensiteitsafhankelijke metingen duiden duidelijk op een efficiënte generatie van hoofdladingsdragers met een relatief lage recombinatiesnelheid in QD-inbeddingslagen en een veel hogere dichtheid van recombinatiecentra in GaAs-lagen. Tijdens de QD-excitatie in vergelijkbare karakteriseringen vertoonden InGaAs/GaAs QD-lichtgevoelige structuren bijvoorbeeld een afhankelijkheid van intensiteit als PC (Ik ) ~ Ik 0,25 , die optrad als gevolg van een hoge snelheid van de niet-stralingsrecombinatie door defectniveaus samen met QD-stralingsrecombinatie [40, 55]. Het is echter de moeite waard om op te merken dat de InGaAs/GaAs-structuur uit meerdere lagen bestond met zeven QD-lagen.
Uit deze metingen en hun interpretatie kunnen enkele indicaties voor het gebruik van metamorfe QD's voor IR-detectie worden afgeleid:(i) bij gebruik van x> 0.15 moeten geavanceerde ontwerpen worden gebruikt die het mogelijk maken om stamgerelateerde defecten te beheersen, vergelijkbaar met wat werd gedaan voor de ontwikkeling van metamorfe QD's [19, 20, 37]; (ii) er zijn meerlaagse stapels QD's (met een minimum van 10 lagen) nodig om een QD-pc boven de donkere stroom te verkrijgen [27, 56]; en (iii) aangezien een hogere opsluiting van zware gaten gunstig is voor de fotostroom die wordt verkregen bij het opwekken van QD's, kunnen geavanceerde ontwerpen met hogere barrières voor zware gaten worden overwogen [51, 57]. Daarom kunnen deze bevindingen zeer nuttig zijn voor het ontwerp van metamorfe QD's die gericht zijn op IR-detectie en de ontwikkeling van metamorfe QD-fotodetectoren.
Conclusies
Foto-elektrische eigenschappen van de metamorfe InAs/In x Ga1 − x Omdat QD-nanostructuren werden bestudeerd bij kamertemperatuur, gebruikmakend van pc- en PL-spectroscopieën, elektrische metingen en theoretische modelsimulaties. De bestudeerde metamorfe InAs/In x Ga1 − x Aangezien QD-nanostructuren lichtgevoelig bleken te zijn in de telecommunicatievensters bij 1,3 (x) = 0.15) en 1.55 μm (x = 0,31). De QD-pc en de PL-efficiëntie van de structuren met een hogere In-inhoud in MB werden echter lager geschat en niettemin vergelijkbaar met die van de InAs/In0,15 Ga0,85 Als structuur, die een gevoeligheid heeft die vergelijkbaar is met InGaAs/GaAs QD-structuren. Deze vermindering van de fotoresponsiviteit houdt verband met een toename van de MB-defectdichtheid met x . Dankzij modelberekeningen hebben we ook inzicht gegeven in het pc-mechanisme in het onderzochte type QD-structuren. Dit alles houdt in dat metamorfe QD's met een hoge x zijn geldige structuren voor opto-elektronische IR-lichtgevoelige apparaten, op voorwaarde dat enkele aandachtspunten worden aangepakt door optimalisatie van het ontwerp van de nanostructuur.
Afkortingen
- ε g :
-
Bandgap van de InGaAs-begrenzingslaag
- E c en E v :
-
Energie van geleidbaarheid en valentiebanden
- IR:
-
Infrarood
- MB:
-
Metamorfe buffer
- ML:
-
Monolaag
- PC:
-
Fotogeleiding
- PL:
-
Fotoluminescentie
- QD:
-
Kwantumpunt
- R L :
-
De belastingsweerstand
- WL:
-
Bevochtigingslaag
Nanomaterialen
- N,N-dimethylformamide die de fluorescentie van MXene Quantum Dots reguleert voor de gevoelige bepaling van Fe3+
- Heldere enkelvoudige fotonbron op 1,3 μm gebaseerd op InAs Bilayer Quantum Dot in Micropillar
- Synthese van pyridinic-rijke N, S Co-gedoteerde Carbon Quantum Dots als effectieve enzymnabootsers
- Het detecteren van ruimtelijk gelokaliseerde excitatie in zelfgeorganiseerde InAs/InGaAs Quantum Dot Superroosters:een manier om de fotovoltaïsche efficiëntie te verbeteren
- Bismut Quantum Dots in gegloeide GaAsBi/AlAs Quantum Wells
- Bipolaire effecten in fotovoltage van metamorfe InAs/InGaAs/GaAs Quantum Dot heterostructuren:karakterisering en ontwerpoplossingen voor lichtgevoelige apparaten
- Een eenvoudige aanpak voor het synthetiseren van fluorescerende koolstofkwantumstippen uit tofu-afvalwater
- Synthese van in water oplosbare antimoonsulfide Quantum Dots en hun foto-elektrische eigenschappen
- Eenstaps sonochemische synthese en fotokatalytische eigenschappen van grafeen/Ag3PO4 Quantum Dots Composites in één stap
- Eliminatie van bimodale grootte in InAs/GaAs Quantum Dots voor de voorbereiding van 1,3-μm Quantum Dot Lasers
- Een compleet overzicht van databus:Connect the Dots!



