Geleidingsmechanisme en verbeterd uithoudingsvermogen in HfO2-gebaseerd RRAM met nitridatiebehandeling
Abstract
Een nitridatiebehandelingstechnologie met een ureum/ammoniakcomplex stikstofbron verbeterde resistieve schakeleigenschappen in HfO2 -gebaseerd resistief willekeurig toegankelijk geheugen (RRAM). De nitridatiebehandeling leverde een hoogwaardig en betrouwbaar apparaat op dat resulteert in een superieur uithoudingsvermogen (meer dan 10 9 cycli) en een zelfnalevingseffect. Zo veranderde het huidige geleidingsmechanisme als gevolg van defectpassivering door stikstofatomen in de HfO2 dunne film. Bij een hoge weerstandstoestand (HRS) werd het overgebracht naar Schottky-emissie van Poole-Frenkel in HfO2 gebaseerd RRAM. Bij lage weerstandstoestand (LRS) was het stroomgeleidingsmechanisme ruimtelading beperkte stroom (SCLC) na de nitridatiebehandeling, wat suggereert dat de stikstofatomen Hf-N-Ox-vacatureclusters vormen (Vo + ) die de elektronenbeweging door de schakellaag beperken.
Achtergrond
Onlangs is RRAM (Resistant Random Access Memory), bestaande uit een isolerende laag die is ingeklemd tussen twee elektroden, uitgebreid bestudeerd als een veelbelovende kandidaat voor niet-vluchtig geheugen van de volgende generatie vanwege de superieure eigenschappen, zoals een eenvoudige structuur, een laag stroomverbruik en een snelle werking. (< 300 ps), en niet-destructieve uitlezing [1–9]. Hoewel de meeste RRAM-apparaten veel eigenschappen hebben die superieur zijn aan niet-vluchtig geheugen, zijn de hoge bedrijfsstroom van RRAM en prestatievermindering belangrijke problemen in niet-vluchtig geheugen in termen van de toepassing van draagbare elektronische producten.
De Pt/HfO2 /TiN-structuur kan een geleidingspad leveren dat een resistief schakelgedrag induceert [10-19]. De gebreken van amorf HfO2 zal het aantal lekkagepaden vergroten, wat leidt tot stroomverbruik en degradatie van joule verwarming. In dit werk wordt de resistieve schakellaag van HfO2 werd behandeld met een oplossing met een ureum/ammoniakcomplex stikstofbron als nitridatiebehandeling om de elektrische schakeleigenschappen te verbeteren.
Methoden
De patroon TiN/Ti/SiO2 /Si-substraat werd vervaardigd met een standaard depositie- en etsproces, waarna via-gaten kunnen worden gevormd (inzet van figuur 1a). Dan een 23 nm dikke HfO2 dunne film werd afgezet in via-gaten op het substraat door RF-magnetronsputtering met behulp van een zuivere HfO2 doel. Het sputtervermogen werd vastgesteld op een RF-vermogen van 150 W en werd uitgevoerd in argonomgevingstemperatuur (Ar =30 sccm) met een werkdruk van 4 mtorr bij kamertemperatuur. De HfO2 /TiN halffabrikaat werd in de reactieve kamer geplaatst en ondergedompeld in de oplossing met een ureum/ammoniakcomplex stikstofbron voor nitridatiebehandeling. Tijdens de nitridatiebehandeling werd de oplossing gedurende 30 minuten in de roestvrijstalen kamer van het systeem tot 160 ° C verwarmd. Vervolgens werd de 110 nm dikke Pt-topelektrode afgezet door middel van DC-magnetronsputteren op de HfO2 dunne film om elektrische apparaten te vormen met Pt/HfO2 /TiN-sandwichstructuren. Ten slotte werden alle elektrische kenmerken gemeten door de Agilent B1500 halfgeleiderparameteranalysator. De DC- en pulse-sweeping-bias werden toegepast op de onderste elektrode (TiN) terwijl de bovenste elektrode (Pt) werd geaard tijdens de elektrische metingen. Bovendien werd Fourier-transform infraroodspectroscopie (FTIR) gemeten met een Bruker VERTEX 70v-spectrometer in het middelste infraroodgebied.

een De vormende stroomkrommen van HfO2 gebaseerde RRAM-apparaten. b Vergelijking van DC-zwaaicycli bij een nalevingsstroom van 5 mA tussen initiële en na nitridatiebehandeling van HfO2 gebaseerd RRAM. c DC-zwaaicycli zonder externe stroomconformiteit van de HfO2 apparaat na nitridatiebehandeling. d Bewaartijd van de HfO2 -gebaseerde RRAM-apparaten bij 85°C met en zonder conformiteitsstroom na nitridatiebehandeling
Resultaten en discussie
Een elektroformingproces is vereist om alle RRAM-apparaten te activeren met behulp van een DC-bias met een compliantiestroom van 10 A, zoals weergegeven in figuur 1a. Na het vormingsproces worden de elektrische stroom-spanning (I-V) eigenschappen van de HfO2 gebaseerde RRAM werden vergeleken bij het begin en na de nitridatiebehandeling. Bij LRS was de stroom duidelijk verminderd in vergelijking met die van onbehandelde HfO2 dunne film, zoals weergegeven in Fig. 1b. De huidige reductie kan worden toegeschreven aan de defecten die zijn gepassiveerd door de NH3 molecuul in de behandelingsoplossing. We ontdekten dat de HRS-verdeling veel stabieler is na de nitridatiebehandeling, zoals in de inzet van figuur 1b. De weerstandstoestanden worden geëxtraheerd met een leesspanning van 0,1 V tijdens de 100 sweepcycli met DC-werking (inzet van figuur 1b). De weerstand aan/uit-verhouding was iets verminderd na de nitridatiebehandeling. Interessant genoeg werd een zelf-conformiteit resistieve schakeleigenschap waargenomen in deze HfO2 -gebaseerde RRAM-apparaten na de behandeling, zoals weergegeven in Fig. 1c. Na meer dan 10 3 veegcycli, werd een herhaalbare zelfbeschermende eigenschap van het apparaat zonder harde storing waargenomen. De retentietijd werd geëvalueerd bij 85°C en bleef stabiel, zelfs na 10 4 s zowel in HRS als LRS.
Om de prestaties van het apparaat verder te evalueren, zijn de duurzaamheidstests van HfO2 -gebaseerde RRAM werden uitgevoerd voor de initiële en na de nitridatiebehandeling, zoals weergegeven in Fig. 2. In het onbehandelde apparaat na 10 6 veegcycli neemt de HRS/LRS-verhouding aanzienlijk af van 100:1 tot 5:1, zoals weergegeven in figuur 2a. Na de nitridatiebehandeling, echter zelfs na meer dan 10 9 veegcycli vertoonde het apparaat een stabiele HRS / LRS-verhouding, zoals in figuur 2b. Deze resultaten geven aan dat het nitridatieproces HfO2 . verbeterde -gebaseerd RRAM om te presteren met superieure schakelfuncties en betrouwbaarheid. Om deze resultaten verder te onderzoeken, werd FTIR-analyse gebruikt om de chemische veranderingen van de HfO2 waar te nemen. dunne film, zoals weergegeven in Afb. 3. Een scherpe piek op 1589 en 1311 cm −1 verscheen na de nitridatiebehandeling, overeenkomend met de symmetrische en asymmetrische rektrillingspiek van een N–O-binding [20]. Verder is de piekintensiteit van N–H-bindingen bij 1471 cm −1 [21] nam toe als gevolg van het nitridatieproces door ureum/ammoniakcomplex stikstofbron (inzet van Fig. 3). Daarom kunnen we de vorming van stikstofhoudende verbindingen afleiden na de nitridatiebehandeling.
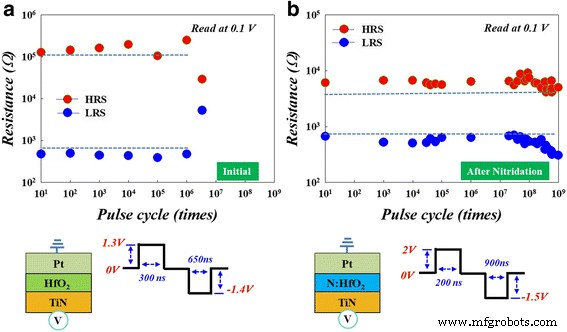
Vergelijking van uithoudingstijden in HfO2 -gebaseerd RRAM:a initiaal en b na nitridatiebehandeling. De onderste diagrammen zijn de bijbehorende apparaatstructuren en duurpulscondities

De vergelijking van FTIR-spectra van HfO2 dunne films tussen initiële en na nitridatiebehandeling
Om het resistieve schakelmechanisme te verduidelijken, analyseerden we het stroomgeleidingsmechanisme van de HfO2 dunne film met en zonder de nitridatiebehandeling, getoond in Fig. 4a en d. Voor de onbehandelde HfO2 dunne film, werden de elektronen door de defecten overgebracht, zodat het stroomgeleidingsmechanisme werd gedomineerd door Poole-Frenkel-geleiding volgens de lineaire relatie tussen ln(I/V) en de vierkantswortel van de aangelegde spanning (V 1 /2 ) op HRS, zoals weergegeven in Fig. 4b [22].
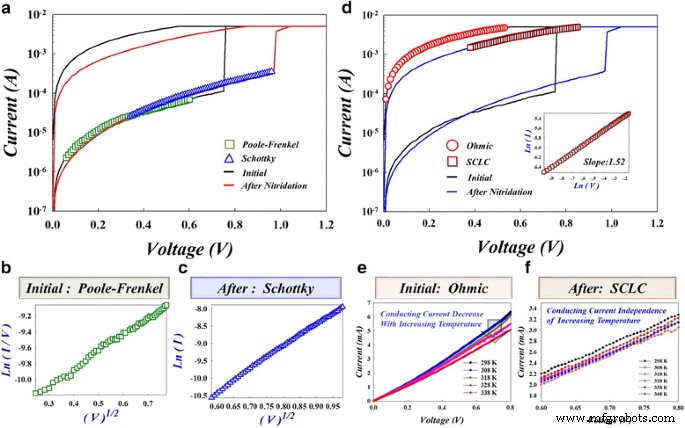
een Analyse stroomgeleidingsmechanisme van HRS uit IV-curven in HfO2 -gebaseerde RRAM tussen initiële en na nitridatiebehandeling. b Het Poole-Frenkel stroomgeleidingsmechanisme van HRS in HfO2 gebaseerd RRAM. c Het Schottky-emissiestroomgeleidingsmechanisme van HRS in HfO2 -gebaseerde RRAM na de nitridatiebehandeling. d Analyse stroomgeleidingsmechanisme van LRS dat transformeert naar SCLC van ohmse geleiding na nitridatiebehandeling in HfO2 -gebaseerd RRAM; de inzetafbeelding toont het huidige SCLC-aanpasresultaat. e Het Ohmse geleidingsmechanisme van LRS in HfO2 -gebaseerde RRAM die kenmerkend is in de huidige negatieve correlatie met temperatuur. v Het SCLC-mechanisme van LRS in HfO2 -gebaseerd RRAM dat onafhankelijk is van de temperatuur na de nitridatiebehandeling
HfO2 . daarentegen -gebaseerde RRAM vertoonde het Schottky-emissiemechanisme volgens de lineaire relatie tussen ln(I/T 2 ) en de vierkantswortel van de aangelegde spanning (V 1/2 ) van HRS, zoals weergegeven in Fig. 4c [23, 24]. Dit komt door de afname van defecten en bungelende bindingen, aangezien bindingen na de nitridatiebehandeling worden gepassiveerd door stikstofatomen. Daarnaast analyseerden we ook het huidige geleidingsmechanisme met en zonder behandeling bij LRS in HfO2 gebaseerd RRAM. Op LRS, het dragertransportmechanisme van de onbehandelde HfO2 -gebaseerde RRAM werd gedomineerd door ohmse geleiding, waarbij de stroom afneemt met toenemende temperatuur, zoals weergegeven in figuur 4e. Na nitridatiebehandeling gaat het stroomgeleidingsmechanisme over op ruimtelading beperkte stroom (SCLC) met een helling van 1,52. De I-V-curve is niet relatief aan de temperatuur, met een lineair verband tussen ln(I) en het kwadraat van de aangelegde spanning V 2 op LRS, zoals weergegeven in Afb. 4f [25].
We hebben een model voorgesteld om de kenmerken van het stroomgeleidingsmechanisme te verklaren, en het wordt getoond als Fig. 5. Er zijn dus twee compenserende dipolen geassocieerd met N- en O-atomen en een Hf-atoom (dwz de reeks O-Hf-O wordt vervangen door O–Hf–N–O) na dotering van N-atomen in HfO2 dunne film. Omdat de negativiteit van stikstofelektronen lager is dan die van zuurstof, is de dipool van de Hf-N-binding lager dan de Hf-O-binding, waardoor een gebied met een lagere diëlektrische constante ontstaat. Wanneer een positieve bias wordt toegepast tijdens het SET-proces, wordt een reeks Hf-N-Ox-vacatures gevormd vanwege hun lagere diëlektrische constante, en vormen vervolgens vacatureclusters (Vo + ). Het geleidende pad vormt zich meestal samen met de Hf-N-Ox-leegstandclusters (Vo + ) omdat stikstofatomen zuurstofionen rond de clusters vangen, zoals weergegeven in figuur 5b. De aanwezigheid van deze isolerende Hf–N–Ox leegstandclusters (Vo + ) resulteert in stroomreductie en het zelfcompliance-effect gevonden in HfO2 -gebaseerd RRAM.

Een schema van de migratie van zuurstofionen door het ingestelde proces in HfO2 -gebaseerd RRAM voor a initiaal en b na nitridatiebehandeling, die Hf-N-Ox-leegstandclusters vormen (Vo + )
Conclusies
Samenvattend werd een zelf-conformiteit resistieve schakeleigenschap waargenomen in een Pt/HfO2 /TiN RRAM-apparaat na de nitridatiebehandeling. Uithoudingstijden bereikten 10 9 cycli en een retentietijd van meer dan 10 4 s werd bereikt bij 85 ° C. Vanwege de kleinere elektronennegativiteit van het stikstofatoom in vergelijking met het zuurstofatoom, is de dipool van de Hf-N-binding kleiner dan die van de Hf-O-binding, wat een lager diëlektrisch constante gebied creëert. Tijdens het SET-proces worden de Hf–N–Ox vacatureclusters (Vo + ) vormen het geleidende pad. De isolerende Hf–N–Ox leegstandclusters (Vo + ) bescherm het apparaat tegen harde storingen en voer een zelf-conformiteitseigenschap uit.
Afkortingen
- FTIR:
-
Fourier-transformatie infrarood spectroscopie
- HRS:
-
Staat met hoge weerstand
- LRS:
-
Staat met lage weerstand
- RRAM:
-
Resistief willekeurig toegankelijk geheugen
- SCLC:
-
Ruimtelading beperkte stroom
Nanomaterialen
- Boter en margarine
- Interview met een expert:Spencer Wright van pencerw.com en nTopology
- Tractie verkrijgen met Markforged:Overmolding en 3D-geprinte wielen gieten
- Materialen:EPP-schuim met verbeterde oppervlakte-eigenschappen en geoptimaliseerd vulgedrag
- Slim nanomateriaal en nanocomposiet met geavanceerde agrochemische activiteiten
- Retentiemodel van TaO/HfO x en TaO/AlO x RRAM met zelfherstellende schakelkenmerken
- Met resveratrol geladen albumine-nanodeeltjes met verlengde bloedcirculatie en verbeterde biocompatibiliteit voor zeer effectieve gerichte pancreastumortherapie
- Verbeterde antitumorwerking en farmacokinetiek van bufalin via gePEGyleerde liposomen
- Toxiciteit van PEG-gecoate CoFe2O4-nanodeeltjes met behandelingseffect van curcumine
- Verminderde contactweerstand tussen metaal en n-Ge door invoeging van ZnO met argonplasmabehandeling
- De rol van nanomaterialen en nanotechnologieën in afvalwaterzuivering:een bibliometrische analyse



