Theoretisch onderzoek van biaxiaal trekvaste Germanium-nanodraden
Abstract
We onderzoeken theoretisch sterk gespannen Ge-nanodraden lateraal op GaSb. De eindige-elementenmethode is gebruikt om de resterende elastische spanning in de Ge-nanodraad te simuleren. De totale energietoename inclusief spanningsenergie, oppervlakte-energie en randenergie voor en na Ge-afzetting wordt in verschillende situaties berekend. Het resultaat geeft aan dat de Ge-nanodraad op GaSb de neiging heeft om langs 〈100〉 te groeien in plaats van 〈110〉 in de twee situaties en bij voorkeur wordt blootgesteld aan {105} facetten wanneer een kleine hoeveelheid Ge wordt afgezet, maar wordt blootgesteld aan {110 } wanneer de hoeveelheid Ge een kritische waarde overschrijdt. Verder zijn de geleidingsbandminima in Γ -vallei op elke positie in beide situaties vertoont lagere waarden dan die in de L-vallei, wat leidt tot een directe bandgap-overgang in Ge-nanodraad. Voor de valentieband geldt de maxima van de lichtgatband bij Γ -punt is hoger dan de maxima van de zware gatenband op elke positie en zelfs hoger dan de geleidingsbandminima voor de hydrostatische belasting van meer dan ∼5,0%, wat leidt tot een negatieve bandgap. Bovendien kan de mobiliteit van zowel elektronen als gaten worden verbeterd door de afname van de effectieve massa onder hoge trekspanning. De resultaten suggereren dat biaxiaal trekgespannen Ge-nanodraden veelbelovende eigenschappen hebben in apparaattoepassingen.
Achtergrond
Als een groep IV-element heeft germanium (Ge) de superioriteit in zowel opto-elektronica als elektronica en is het uitstekend compatibel met silicium (Si)-fotonica. Een essentieel kenmerk van Ge is dat de directe bandafstand ongeveer 0,8 eV is (1,55 μ m) bij 300 K. De mobiliteit van zowel elektron als gat in Ge is veel hoger dan die in Si. Zo is Ge gebruikt in hogesnelheidsapparaten in de huidige Si-gebaseerde geïntegreerde schakelingen [1, 2]. Interessanter is dat trekbelaste Ge optimalisatie biedt in de bovenstaande aspecten. Ge is een indirecte bandgap halfgeleider met een klein verschil van 136 meV tussen L-vallei en Γ -vallei [3]. Er wordt theoretisch voorspeld dat meer dan -4,0% uniaxiaal langs 〈111〉 [4] of -1,6-2,0% biaxiale [5, 6] trekspanning de Γ kan verlagen -vallei onder de L-vallei, waardoor Ge wordt omgezet in een materiaal met directe bandgap, wat een nieuwe route opent voor licht dat uit materialen van groep IV komt. Een ander belangrijk punt is dat trekbelaste Ge zorgt voor een significante verbetering van de mobiliteit van de drager [7, 8] voor het realiseren van complementaire metaaloxidehalfgeleiders met hoge snelheid.
Nanodraden (NW's) vertonen aantrekkelijke elektronische en optische eigenschappen vanwege de grote oppervlakte-volumeverhouding en opsluiting van zowel dragers als fotonen in twee dimensies (2D) [9]. In de afgelopen jaren zijn Ge NW's (GeNW's) op Si [10] of Ge/Si core/shell NW's [11] uitgebreid bestudeerd vanwege hun potentieel in metaaloxidehalfgeleider-veldeffecttransistoren (MOSFET's) voor Si-micro-elektronica. Zowel de geschaalde transconductantie als de aan-stroom werden drie tot vier keer verbeterd in vergelijking met conventionele Si p -MOSFET [12]. Er wordt dus verwacht dat epitaxiale groei van laterale GeNW's direct op Si hoogwaardige MOSFET's fabriceert. Zhang et al. behandeld dat ultradunne GeNW's op Si (001) worden blootgesteld met facetten van {105} [13], die de laagste voorspelde oppervlakte-energie hebben [14]. Verder werd aangetoond dat gespannen Ge MOSFET op SiGe virtueel substraat de mobiliteit van gaten verbetert [1]. Hoewel lateraal GeNW op Si met compressieve rek een significante verbetering in dragertransport kan laten zien, zoals aangenomen, kunnen ze niet worden omgezet in een directe bandgap. Voor het introduceren van trekspanning in GeNW's zijn GeSn-legeringen [15] en III-Sb-verbindingen [16] vereist, die een grotere roosterconstante hebben dan die van Ge. Ondanks dat mechanische methode is toegepast voor het fabriceren van uniaxiaal gespannen GeNW's [17, 18], kan het complex van deze fabricagetechniek nauwelijks geschikt zijn voor monolithische integratie in op Si gebaseerde fotonica en elektronica. Bovendien zal de stam gemakkelijk loslaten in vrijstaande NW's, terwijl laterale GeNW's op zichzelf veel hoge spanning kunnen opvangen. Epitaxiaal gegroeide laterale GeNW's met hoge biaxiale trekspanning zijn dus vereist voor het bereiken van een directe bandgap-overgang en verbetering van de mobiliteit van de drager.
Tot op heden hebben dislocatievrije en sterk biaxiale trekspanningsgetrainde Ge-quantumdots op InP (001) mogelijkheden getoond voor directe bandgap-emissie, gesimuleerd met de eindige-elementenmethode (FEM) [19]. Vergelijkbaar hiermee voorspellen we in dit werk theoretisch de morfologie van blootgestelde oppervlakken en groeirichting van biaxiaal trek-gespannen GeNW's op een ontspannen GaSb-sjabloon die direct op Si kan worden gekweekt met een AlSb-bufferlaag [16, 20]. We kiezen {110}, {105} en {111} als blootgestelde oppervlakken van laterale GeNW's en vergelijken de totale energieverandering in het stationaire systeem. We negeren de invloed van dislocatie en breuk [21] in dit zeer gespannen systeem voor de eenvoud. De simulatie op basis van FEM laat zien dat er een kritische hoeveelheid Ge bestaat. Onder de kritische waarde worden GeNW's blootgesteld met {105}, terwijl ze boven de kritische waarde worden blootgesteld met {110}. Bijna het hele GeNW-gebied kan worden omgezet in directe bandgap, wat het verschil is tussen de geleidingsbandminima en de lichte gatbandmaxima bij de Γ -punt. Daarnaast analyseren we ook kwalitatief de verandering van de spanningsafhankelijke effectieve massa van de drager op de Γ -punt om indirect de verbetering in zowel elektronen- als gatenmobiliteit te voorspellen.
Methoden
Laterale NW's onthullen normaal gesproken een driehoekige dwarsdoorsnede [22, 23]. Dankzij de 1D-eigenschap van NW getoond in Fig. 1a, een eindig NW-model vergelijkbaar met Zhang et al. in het aanvullende materiaal van Ref. [13] kan goed worden gebruikt voor simulatie waarin zowel begin- als eindoppervlakken vast zijn, zoals weergegeven in figuur 1b. Vanwege het grenseffect bespreken we alleen het middengedeelte van het NW en nemen aan dat de doorsnede van dit gedeelte de situatie in een oneindig lang NW weergeeft. FEM wordt gebruikt om de verdeling van trekspanning in GeNW te simuleren met 7,7% roostermismatch met GaSb. We berekenen de totale systeemenergietoename na het afzetten van dezelfde hoeveelheid Ge in stabiele toestand in drie situaties:(i) [100] groeirichting met {110} facetten blootgesteld (situatie A), (ii) [100] groeirichting maar met {105} facetten blootgesteld (situatie B), en (iii) [110] groeirichting met {111} facetten blootgesteld (situatie C). De dwarsdoorsneden van deze drie situaties zijn weergegeven in figuur 1c. De oppervlakten van de dwarsdoorsnede worden hetzelfde gehouden en vertegenwoordigen gelijke hoeveelheden Ge.
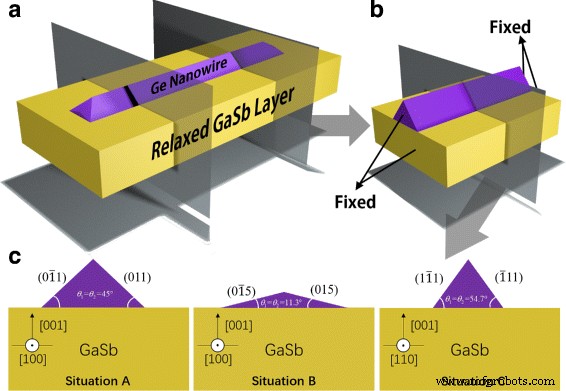
Schema's van GeNW op GaSb:a 3D-model, b vereenvoudigd eindig model, en c dwarsdoorsneden van GeNW met verschillende facetten
De totale verandering van systeemenergie per lengte-eenheid (J/nm) omvat het totale verschil in spanningsenergie, oppervlakte-energie en randenergie [24] en kan worden gegeven door:
$$ \Delta{{E}_{\text{total}}}=\Delta{{E}_{\text{strain}}}+\Delta{{E}_{\text{surface}}}+ \Delta{{E}_{\text{edge}}}. $$ (1)De eerste term Δ E s t r een ik n vertegenwoordigt het spanningsenergieverschil van het stabiele systeem voor en na Ge-afzetting en wordt uitgedrukt in eenheidsvolume,
$$ \Delta{u}=\frac{1}{2{Y}}\sum\limits_{i=j}^{{}}{\tau_{ij}^{2}}-\frac{\nu }{Y}\sum\limits_{iwaar h is de hoogte van de GeNW-doorsnede, σ ik (ik =A, B en C) is de gemiddelde oppervlakte-energie van de blootgestelde facetten onder de eenheidsoppervlakte, en de corresponderende hoek tussen de NW-facetten en het grensvlak is gelabeld met θ ik zoals schematisch getoond in Fig. 1c. De spanning in oppervlakte-energie kan worden verwaarloosd vanwege de geringe impact, aangezien de behandeling in Ref. [25]. Tabel 1 toont oppervlakte-energiewaarden uit de literatuur. De laatste term genaamd edge energy change staat voor de verandering van energiekosten voor het vormen van scherpe randen en wordt gegeven door
$$ \Delta{{E}_{\text{edge}}}=3\varGamma $$ (4)waarbij 3Γ de totale randenergie is die de bovenste en twee basale facetkruisingen bevat. De geschatte waarde van 3Γ is 3,7 eV/nm door experimentele montage [26] en de invloed van de randenergie kan worden genegeerd vanwege de nauwelijks gevarieerde waarde [25]. Daarom is het geldig om de energietoename van Δ . te berekenen E totaal −3Γ.
Na het kennen van de spanningsverdeling, neemt de spanningsafhankelijke geleidingsband af bij de Γ - en de L-vallei kan worden berekend zonder het kwantumeffect te verwaarlozen. De geleidingsband van de Γ -vallei wordt alleen verlaagd bij hydrostatische belasting met
$$ \Delta E_{c}^{\Gamma}={{a}_{c}}({{\varepsilon}_{xx}}+{{\varepsilon}_{yy}}+{{\varepsilon }_{zz}}) $$ (5)waar a c geeft hydrostatische vervormingspotentieel aan met de waarde van -8,24 eV bij de Γ -punt [27], ε xx , ε jj en ε zz zijn de stam in x , y, en z richting in het materiaalcoördinatensysteem, respectievelijk. De verschuiving van de geleidingsband op het L-punt is echter onderhevig aan zowel hydrostatische als afschuifspanning [19], gegeven door
$$ {{}\begin{aligned} \Delta{E_{c}^{\mathrm{L}}}=&\left({{\Xi}_{d}}+\frac{1}{3} {{\Xi}_{u}}\right)({{\varepsilon}_{xx}}+{{\varepsilon}_{yy}}+{{\varepsilon}_{zz}})\\&-\frac{2}{3}{{\Xi}_{u}}\left(|{{\varepsilon}_{xy}}|+|{{\varepsilon}_{yz}}|+|{ {\varepsilon}_{xz}}|\right) \end{uitgelijnd}} $$ (6)waar Ξ d en Ξ u zijn dilatatievervormingspotentieel met de waarde van -6,97 eV en uniaxiale vervormingspotentiaal met de waarde van 16,3 eV in de L-vallei, respectievelijk. Voor het omzetten van Ge in een directe bandgap-materiaal, de Γ -vallei moet lager zijn dan de L-vallei, wat betekent \(\Delta {E_{c}^{\Gamma, \text {L}}}=\Delta E_{c}^{\Gamma }-\Delta {E_{c}^{\mathrm {L}}}<-0.136\) eV. Hier gebruiken we \(\Delta {E_{\text {DT}}}=\Delta E_{c}^{\Gamma, \text {L}}+0.136\) om het verschil in de Γ weer te geven - en het L-punt. Zodra de Γ -punt daalt onder het L-punt, Δ E DT negatief zal zijn. Een reeks trekspanningsgetrainde GeNW's met verschillende afmetingen wordt gesimuleerd om de directe bandgap-overgang te tonen.
Bovendien, vanwege de hoge treksterkte in het GeNW, is de Γ -vallei ligt onder de L-vallei terwijl de maxima van de lichte gatenband de valentiemaxima worden [28]. De bandgap in zo'n hoge treksterkte GeNW zal het verschil zijn tussen de Γ -vallei en de lichte gatenband maxima bij de Γ -punt. Dus zowel de ruimtelijk verdeelde bandgap als de bandrandenergieën bij de Γ -punt dat k . is =0 inclusief geleidingsband, zwaar-gat-band en licht-gat-band worden berekend door acht-band k.p theorie [29]. We negeren het kwantumeffect omdat het erg zwak is in ons GeNW-model met een basale breedte van 40 nm. Het resultaat kan worden toegepast om de elektron-gat-recombinatie in het door trekkracht gespannen GeNW te bestuderen, evenals het mechanisme van mobiliteitsverbetering. In het algemeen kan de elektron- of gatmobiliteit worden gegeven door μ =e τ /m ∗ , waar m ∗ is de effectieve massa van de drager en τ is de elektron-fononverstrooiingstijd. In het model van een parabolische benadering voor de Γ - en L-valleien met isotrope verstrooiing, is de verstrooiingstijd evenredig met \(m_{DOS}^{*-3/2}\), wat leidt tot de conclusie dat de mobiliteitsverhouding μ bereikt Γ /μ L =182 als de Γ -vallei beweegt onder de L-vallei en zowel de elektron-fononverstrooiingstijd als de effectieve massa van elektronen zijn onveranderlijk met rek [30]. Met de overweging van de complexiteit bij de berekening van anisotrope verstrooiing en spanningsafhankelijke effectieve massa in ons NW-model, analyseren we echter alleen kwalitatief de verbetering in zowel elektronen- als gatenmobiliteit in een sterk trek-gespannen GeNW via de afname van zowel elektronen als gaten. en gat effectieve massa bij de Γ -punt.
Resultaten en discussies
We zijn van mening dat het systeem aanvankelijk onder volledige trekspanning staat vanwege de grote roostermismatch van 7,7% tussen Ge en GaSb. Figuur 2 toont de 2D-verdeling van de resterende rek, inclusief rek in het vlak ε xx , schuifspanning ε xy , en verticale spanning ε zz van situatie A met de basisbreedte van w =40 nm bijvoorbeeld in de stationaire toestand na relaxatie. De stamdefinitie hier is (a Ges −een Ge )/een Ge , waar a Ges en een Ge zijn roosterconstanten van respectievelijk gespannen en ontspannen Ge. Zoals te zien is in Fig. 2a, ε xx heeft de maximale waarde van ongeveer 15,4% aan twee basale randen, wat veel groter is dan de initiële rek, maar sterk afneemt van de rand naar het midden met de minimumwaarde van ongeveer 3,3%. In z -richting van onder naar boven van GeNW, ε xx daalt ook als gevolg van de versoepeling van GeNW. De distributie van ε zz blijkt vergelijkbare kenmerken te hebben met ε xx in afb. 2b. In tegenstelling tot biaxiale spanning in de dunne film van Ge, laat figuur 2c zien dat de asymmetrisch verdeelde afschuifspanningscomponent van GeNW een significante rol speelt bij de directe bandgap-overgang. De spanningsverdeling is vrij gelijkaardig in drie situaties. Desalniettemin zijn de waarden van rekcomponenten in drie situaties verschillend vanwege de diverse breedte-hoogteverhouding (W /H ) veroorzaakt door zijn vorm. Situatie B met GeNW blootgesteld door {105} oppervlakken heeft de grootste W /H van 10, met een hoge spanning vergelijkbaar met die in de dunne Ge-film. Situatie C met blootgestelde {111}-oppervlakken vertoont ook een hoge spanning, aangezien de NW-groeioriëntatie langs de [110] een onveranderlijke waarde van spanning blijft, waardoor de waarde van ε toeneemt xx en ε jj tegelijkertijd. De belasting in het vliegtuig kan dus nauwelijks worden versoepeld.

Restrekverdeling van een GeNW in situatie A met de basale breedte van 40 nm:a x component stam ε xx , b z component stam ε zz , en c schuifspanning in x-y vlak ε xy . De zigzagvorm onderaan geeft de gedeeltelijke substraatlaag aan (het volgende heeft dezelfde betekenis)
In overeenstemming met de spanningsverdeling kan de toename van de spanningsenergie worden verkregen. Zoals eerder besproken, heeft situatie B de hoogste spanningsenergietoename, terwijl situatie A de laagste heeft. Voor de verandering van de oppervlakte-energie geeft situatie B echter afnemende negatieve waarden met een groter dwarsdoorsnedeoppervlak en de andere twee situaties laten zeer dicht bij elkaar liggende positieve waarden zien onder hetzelfde oppervlak. De totale energietoename exclusief randenergieverandering wordt getoond in figuur 3a. Het resultaat laat zien dat het minder waarschijnlijk is om alleen in situatie C GeNW's te vormen, omdat de energietoename nooit de laagste is. Er zijn twee verschillende gevolgen van de energietoename met de toename van het gebied, en de verticale streepjeslijn is gemarkeerd om de kritieke waarde van het gebied weer te geven, A c =136.2nm 2 , wat de hoeveelheden Ge betekent. Wanneer het gebied kleiner is dan 136,2 nm 2 , GeNW's zijn geneigd om de vorm te vormen in situatie B, maar in situatie A na het afzetten van meer Ge. Het resultaat van de berekening voorspelt dat trekspanningsgetrainde GeNW's op GaSb mogelijk de voorkeur geven aan het vormen van hoge W /H driehoeksvorm in dwarsdoorsnede wanneer een lage hoeveelheid Ge wordt afgezet, terwijl lage W . wordt gevormd /H één na overschrijding van de kritische waarde. Figuur 3b-e toont de verdelingen van hydrostatische rek en de som van de absolute waarde van schuifrekcomponenten in situatie A en B onder het kritieke gebied. Door situatie A met B te vergelijken, ondanks die situatie, heeft A de grotere maximale waarde van zowel hydrostatische belasting als |ε xy |+|ε yz |+|ε xz |, situatie B heeft een grotere gemiddelde hydrostatische belasting maar een kleinere gemiddelde waarde van |ε xy |+|ε yz |+|ε xz |. Ondertussen vertoont situatie B een klein verschil in ruimtelijke verdeling van zowel hydrostatische belasting als |ε xy |+|ε yz |+|ε xz |. Deze eigenschappen lijken erg op Ge-dunne film en worden toegeschreven aan de hoge W /H waarde. Dientengevolge, verwijzend naar Vgl. (5) en (6), situatie B vertoont een kleinere waarde van Δ E DT dan die van situatie A, wat leidt tot een grote kans om Ge om te zetten in een direct bandgap-materiaal.

een De totale energieverandering exclusief de randenergieverandering 3 Γ vs. het dwarsdoorsnedegebied (de streeplijn is de kritische waarde van minima ongeveer 136,2 nm 2 in verschillende situaties). b –e hydrostatische belasting en |ε xy |+|ε yz |+|ε xz | in b , c situatie A en d , e situatie B op de kritische waarde
Vanwege de hoge treksterkte in GeNW kan bijna het hele gebied van GeNW worden omgezet in directe bandgap. Figuur 4a toont de verdeling van Δ E DT met het vergroten van de GeNW. De waarde van Δ E DT daalt van boven naar beneden in GeNW's. Interessant is dat het minimum van Δ E DT bevindt zich in de onderrand van de doorsnede in situatie B, maar in het midden onder in situatie A. De reden van deze andere verdeling is dat de significante afschuifspanning aan de onderrand in situatie A meer bijdraagt aan \(\Delta E_ {c}^{\mathrm {L}}\) dan die in situatie B. Voor GeNW in situatie B onder het kritieke gebied, het gemiddelde Δ E DT is veel lager dan die in situatie A boven het kritieke gebied zoals weergegeven in figuur 4b. Op het kritieke punt, het gemiddelde van Δ E DT stijgt plotseling van de waarde van -0,308 naar -0,137 eV. Verder geldt voor dezelfde vorm de verdeling en het gemiddelde van Δ E DT zijn in principe vergelijkbaar, zonder duidelijke relatie met de grootte. Om de inherente relatie met de rek in GeNW te ontdekken, plotten we de hydrostatische rekcomponent op de GeNW-basis met basale breedte in Fig. 5. De curven van de hydrostatische rekcomponent met verschillende groottes versus de relatieve positie van de basis in een GeNW bijna overlappend behalve het verschil in de perifere regio. De consistente gevolgen zijn te vinden in ε xx en de som van absolute afschuifcomponenten. Dus de spanningsgeïnduceerde waarde van Δ E DT bezit de identieke verdeling in GeNW met dezelfde vorm.
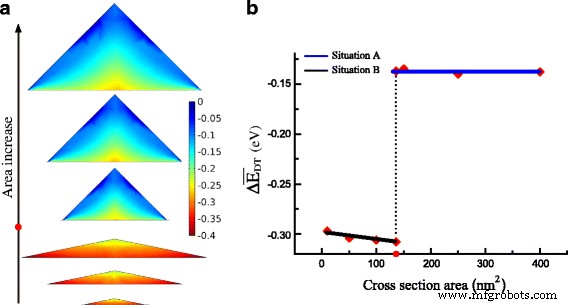
een De distributie van Δ E DT met toename van het gebied (de kleurenbalk geeft de waarde aan van Δ E DT ). b Het gemiddelde van Δ E DT versus het gebied. De kritieke waarde is gemarkeerd in rode stip in de gebiedsas

Hydrostatische rekcomponent aan de basis van GeNW vs. x/w met verschillende basale breedtes
Verder simuleren we de door spanning geïnduceerde bandgap-mapping in de dwarsdoorsnede van de 40 nm brede GeNW getoond in Fig. 6a. De ruimtelijke verdeling van bandgap is afgeleid van de variabele waarde van spanningsafhankelijke bandranden aan de Γ -punt. Figuur 6b toont de bandrandenergie bij Γ -punt langs de z -directie van het GeNW. We vinden dat zowel de geleidingsband als de randen van de valentieband, inclusief de lichte-gat-band en de zware-gat-band, significant veranderen in de eerste 15 nm en daarna enigszins. De toppen van de lichte en de zware gatenband scheiden en hebben de neiging in tegengestelde richtingen te verschuiven met toenemende trekspanning. Uit Fig. 6a, b neemt de bandgap significant toe in de eerste 15 nm om ongeveer 0, 30 eV te bereiken, en verandert dan iets rond een waarde van 0, 24 eV, wat de bandgap is in de meeste GeNW-regio's. Aangezien de maxima van de lichte gatenband hoger is dan die van de zware gatenband bij de Γ -punt in het GeNW, gaten in de valentieband situeren zich bij voorkeur op de maxima van de lichte gatenband. De elektron-gat-recombinatie zal dus plaatsvinden tussen het geleidingsbandminimum en het lichtgatbandmaximum bij de Γ -punt als we de overlap van de ruimte-afhankelijke elektron- en gatgolffuncties verwaarlozen. Interessant is dat de maxima van de lichtgatband zelfs boven de geleidingsbandminima bewegen in het gebied van de NW-bodem gemarkeerd als een zwarte curve in Fig. 6a met een hydrostatische rek van meer dan -5, 0%. De negatieve bandgap die we berekenen onder hoge trekspanning kan gecompliceerde gevolgen hebben, zoals een halfmetalen [31] of omgekeerde [32] bandstructuur.
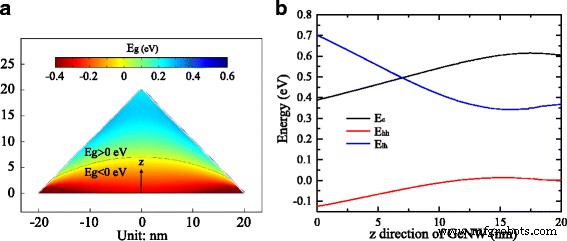
een De spanningsafhankelijke bandgap in de GeNW verdeeld over posities. b De spanningsafhankelijke bandrandenergieën langs z richting in het GeNW
Ten slotte zal de mobiliteit van elektronen en gaten worden verbeterd onder een dergelijke hoge trekspanning in het GeNW. Voor ontspannen Ge wordt het elektronentransport voornamelijk bijgedragen door elektronen die in de L-vallei zijn gevestigd. Wanneer Ge onder trekspanning staat zodat de Γ -vallei ligt onder de L-vallei zoals weergegeven in Fig. 3a, de primaire bijdrage van elektronentransport komt van de Γ -vallei. Aan de andere kant is de dominante deelname van gaten in het transport van de lichte gatenband aan de Γ -punt onder hoge trekspanning, terwijl de band met het zware gat de maximale valentieband inneemt in het ontspannen geval. Vanwege de veel kleinere effectieve massa van het elektron aan de Γ -punt dan dat op het L-punt, evenals de verminderde effectieve massa van de maxima van de zware gatenband naar de maxima van de lichte gatenband, kan de mobiliteit van niet alleen elektronen maar ook van gaten worden verbeterd. De trekspanning kan theoretisch worden voorspeld om de effectieve massa van elektronen en gaten aan de Γ te verminderen -punt in een model van kwantumpunt door Califano en Harrison [29]. Hoewel de kwantitatieve berekeningsmethode niet geschikt is voor ons NW-model, nemen we kwalitatief aan dat trekspanning de effectieve massa bij k kan wijzigen =0 door de kromming van de dispersierelatie te vergroten voor kleine k in de buurt van de Γ -punt. De mobiliteit van zowel elektronen als gaten kan dus worden verbeterd in door trekkracht gespannen GeNW's. De splitsende valentiebanden induceren ook een sterke elektron-fononkoppeling en intrabandverstrooiing [33], waardoor de mobiliteit van het gat lager is dan de mobiliteit van elektronen.
Conclusies
Samenvattend hebben we trekbelaste GeNW's op GaSb voorgesteld, waarbij we drie verschillende situaties vergelijken via totale energieverandering voor en na Ge-afzetting. Het resultaat laat zien dat de GeNW geneigd is om {105} oppervlakken te vormen langs de 〈100〉 groeirichting vóór de kritische hoeveelheid, terwijl deze wordt blootgesteld door {110} oppervlakken na de kritische hoeveelheid. Het residuele rekveld en de bandgap-analyse hebben aangetoond dat dezelfde vorm dezelfde verdeling heeft, zowel in rek als in Δ E DT ongeacht de grootte. Bovendien verminderen de belasting in het vlak en de hydrostatische belasting niet alleen van de randen naar het midden, maar ook van onder naar boven en in alle situaties. Vanwege de hoge treksterkte kan in de twee mogelijke situaties bijna het gehele GeNW op GaSb worden omgezet in een direct bandgap-materiaal. Ook nemen de lichte gaten voornamelijk deel aan de elektron-gat-recombinatie en elektrisch transport aan de Γ -punt omdat de maxima van de lichte gatband de maxima worden van de valentieband bij hoge trekspanning. De mobiliteit van niet alleen elektronen, maar ook gaten kan worden verbeterd dankzij de afname van de effectieve massa van de drager aan de Γ -punt bepaald door de trekspanning. De aantrekkelijke prestatie die theoretisch wordt voorspeld, impliceert dat trekspanningsgetrainde GeNW's veelbelovend zijn om te worden toegepast op opto-elektronica voor lichtbronnen en micro-elektronica voor hogesnelheidsapparaten in respectievelijk Si-fotonica en elektronica.
Nanomaterialen
- Strain Meters
- Materiaalwetenschappers leren nanodraden te 'dansen'
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- Theoretische studies over InGaAs/InAlAs SAGCM lawinefotodiodes
- Ultraviolet licht-ondersteund koperoxide nanodraden Waterstofgassensor
- Synthese en onderzoek van CuGeO3-nanodraden als anodematerialen voor geavanceerde natrium-ionbatterijen
- Eerste-principes onderzoek van adsorptiegedrag van kleine moleculen op penta-grafeen
- Onderzoek naar het gradiënt nanomechanisch gedrag van tandfluorose-glazuur
- Theoretische analyse van InGaAs/InAlAs enkelvoudige foton lawinefotodiodes
- Impact van N-opname op VLS-groei van GaP(N)-nanodraden die UDMH gebruiken
- Spanningsmeter begrijpen



