Variatie op de microstructuur en mechanische eigenschappen van Ti-Al-N-films geïnduceerd door RF-ICP-ionenbron Verbeterde reactieve stikstofplasma-atmosfeer
Abstract
Het verkrijgen van de optimale groeiomstandigheden van Ti-Al-N-films, de effecten van gasatmosfeer, met name het reactieve plasma op de materiële microstructuren, en mechanische eigenschappen zijn nog steeds een fundamentele en belangrijke kwestie. In deze studie worden Ti-Al-N-films reactief gedeponeerd door een radiofrequentie-inductief gekoppelde plasma-ionenbron (RF-ICPIS) verbeterd sputtersysteem. Verschillende stroomsnelheden van stikstofgas bij het binnenkomen in de ionenbron worden toegepast om stikstofplasmadichtheden te verkrijgen en de afzettingsatmosfeer te veranderen. Het is gebleken dat het gehalte aan stikstofelementen in de films behoorlijk wordt beïnvloed door de stikstofplasmadichtheid, en de maximale waarde kan oplopen tot 67,8% bij een hoge gasstroom. XRD-spectra en FESEM-afbeeldingen geven aan dat een lage plasmadichtheid een voordeel is voor de filmkristallisatie en de dichte microstructuur. Bovendien worden de mechanische eigenschappen zoals hardheid en tribologische prestaties wederzijds verbeterd door de stikstofatmosfeer aan te passen.
Inleiding
Vanwege de respectabele mechanische eigenschappen zoals hoge hardheid, anticorrosie en superieure oxidatieweerstand, heeft Ti-Ai-N veel aantrekkingskracht getrokken bij droog en snel snijden als de oppervlaktebeschermingsfilms voor werktuigmachines [1,2,3]. Tegenwoordig zijn er verschillende technieken ontwikkeld voor de fabricage van Ti-Al-N-films, waaronder chemische dampafzetting [4], boogverdamping [5], ionplating [6] en reactief DC/RF-sputteren [7]. Tijdens de voortgang van Ti-Al-N filmafzetting is de gasatmosfeer behoorlijk belangrijk en complex [8,9,10,11,12]. In de reactieve sputterdepositie is het niet-evenwichtsstikstofplasma bijvoorbeeld niet alleen afhankelijk van de argon- of stikstofionenconcentratie, maar ook beïnvloed door de secundaire elektronendichtheid of totale gasdruk die de moeilijkheden verergeren om de reactieve stikstofatmosfeer te begrijpen die wordt veroorzaakt de variatie op de Ti-Al-N filmeigenschappen. Jeong et al. hebben de groeimorfologie van Ti-Al-N-films gerapporteerd die werd beïnvloed door stikstofstroomsnelheden [13]. Irudayaraj et al. hebben gevonden dat de afzettingssnelheid, korrelgrootte en de verhouding van de concentratie van Ti tot Al van de afgezette Ti-Al-N-films afnam met toenemende N2 stroomsnelheid [14]. Vanwege het belang om waardevolle kennis te verwerven voor de selectie van optimale groeiomstandigheden, moeten de effecten van de stikstofatmosfeer, met name de reactieve plasmadichtheid op de inhoud van de materiële elementen en de bijbehorende microstructuren en mechanische eigenschappen van Ti-Al-N, nog verder worden onderzocht. .
In ons eerdere werk is geverifieerd dat radiofrequentie inductief gekoppelde plasma-ionenbron (RF-ICPIS) de Ti-Al-N-afzetting verbetert door de argongasionisatietemperatuur te verlagen en de ionisatiesnelheden te verhogen [15]. In dit artikel ioniseren we stikstofgas rechtstreeks in een ontladen RF-ICPIS-holte, en een dichte stikstofplasmastraal wordt direct in de reactieve kamer geïntroduceerd om deel te nemen aan reactieve afzetting. In vergelijking met het traditionele RF/DC-sputtersysteem, kan de stikstofplasmadichtheid die door RF-ICPIS wordt geleverd gemakkelijk worden geregeld door het RF-vermogen of de gasstroomsnelheden te wijzigen. De invloeden van stikstofplasmavariatie op de elementinhoud, microstructuren, oppervlaktemorfologieën, evenals de mechanische eigenschappen van Ti-Al-N-films, worden bestudeerd en besproken.
Methode
Filmafzetting
Ti-Al-N-films werden afgezet op Si (100) en spiegelgepolijst roestvrij staal door een RF-ICP-ionenbron verbeterd magnetronsputtersysteem met een groeitemperatuur van 200 ° C. Substraten werden op een roterende monsterhouder (20 rpm) geplaatst die loodrecht stond op een Ti0,5 Al0,5 samengesteld doelwit met een zuiverheid van 99,9%. Na het pompen van de sputterkamer tot een basisdruk lager dan 1,0 × 10 −4 Pa en doeloppervlaktereiniging door argonionen, de bufferlaag van Ti-Al werd vervolgens op substraten afgezet door DC-sputteren. Vervolgens werd het stikstofplasma geproduceerd uit RF-ICPIS in de buurt van de substraten geïntroduceerd om de reactieve afzetting voor Ti-Al-N-film bij te wonen. Het RF-ICPIS-vermogen werd geregeld op 50 W en de stroomsnelheden van stikstofgas bij het binnenkomen in de ionenbron werden gevarieerd van 5 tot 25 sccm om de stikstofplasmadichtheden te veranderen en een verschillende sputter- en afzettingsatmosfeer te verkrijgen. Ondertussen was de DC-sputterstroom vastgesteld op 0,4 en werd de totale gasdruk van de sputterkamer op 0,5 Pa gehouden. Gedetailleerde groeiparameters staan vermeld in tabel 1.
Karakterisering
De inhoud van de elementen werd gekarakteriseerd met een energiedispersieve spectrometer (EDS, Oxford X-Max 50), en kristalstructuren van Ti-Al-N-films werden onthuld door röntgendiffractie (XRD, Bruker D8 Advance) met een Cu Ka-straling (λ =1,54056 Å). Oppervlaktemorfologieën en cross-sectionele microstructuur van films werden gemeten met veldemissie scanning elektronenmicroscopie (FESEM, ZEISS Ultra 55). Atomic force microscopie (AFM, Asylum Research) werd toegepast om de oppervlakte-root-mean-square (RMS) te meten. Piramidale diamantpunt werd gebruikt voor de nano-indentatietest en de hardheid werd gemeten met MTS Nano Indenter XP en berekend via de Oliver-Pharr-indentatiemethode. Elk monster, tien afzonderlijke puntmetingen, werd genomen om een gemiddelde hardheidswaarde te krijgen. Voor het meten van de wrijvingscoëfficiënt werd een conventioneel kogel-op-schijf slijtapparaat gebruikt met een glijsnelheid van 0,2 m/s onder een belasting van 10 N.
Resultaten en discussie
Figuur 1 toont de Ti-, Al- en N-elementinhoud in Ti-Al-N-films die zijn afgezet bij verschillende stikstofgasstroomsnelheden. Het N-gehalte in Ti-Al-N-films wordt monotoon verbeterd met de toename van stikstofgasstromen die in de ionenbron worden toegelaten. Binnen het lage stikstofgasstroomgebied (5-15 sccm) wordt het N-gehalte op 45-50% gehouden en zijn de (Ti + Al) / N-rantsoenen vergelijkbaar met de (Ti, Al) N-constructie. Wanneer de stikstofgasstroomsnelheden van 15 tot 25 sccm verder worden verbeterd, wordt het N-gehalte in Ti-Al-N-films snel verhoogd. De maximale waarde van 67,8% wordt verkregen bij 25 sccm, wat meer is dan 50% in de gewone (Ti, Al) N of Tix Al1-x N-microstructuur, die wijzen op faseovergangen, komen voor in S4 en S5. Ti- en Al-gehalten in Ti-Al-N-films vertonen beide een tegengestelde trend ten opzichte van het N-element als functie van de stroomsnelheden van stikstofgas. Voor alle films is het Al-gehalte hoger dan Ti, wat vergelijkbaar is met de resultaten van Ti-Al-N-films die zijn afgezet onder een verbeterde plasmaatmosfeer. Het gehalteverschil tussen Al- en Ti-elementen kan worden toegeschreven aan het verschil in sputteropbrengst tussen Al-atoom met een lichte kwaliteit en Ti-atoom. Bovendien sijpelen Al-atomen gemakkelijk naar de oppervlaktegebieden van de film, wat er ook toe zou kunnen leiden dat de gedetecteerde Al-gehalten iets hoger zijn dan de werkelijke waarden in de binnenste films [16].

Elementinhoud van Ti-Al-N-films vervaardigd bij verschillende stroomsnelheden van stikstofgas
XRD wordt uitgevoerd voor de monsters die zijn gedeponeerd op Si (100)-wafels. Zoals getoond in Fig. 2, vertonen S1-S5 de typische NaCl-type face-centered kubieke (fcc) structuur met meerdere diffractieplannen georiënteerd op (111), (200), (220) en (311), behalve (311 ) voor S4- en S5-monsters die zijn afgezet bij hoge gasstroomsnelheden [17]. Voor f.c.c Ti-Al-N-structuur is (111) het dicht opeengepakte vlak met de laagste oppervlakte-energie, terwijl de (200) en (220) volgden. In S1-S5 vertonen alle gedeponeerde Ti-Al-N de (220) voorkeursoriëntatie in plaats van (111). In onze vorige studie ontdekten we dat de filmafzettingssnelheden waren verbeterd in het RF-ICPIS-verbeterd sputtersysteem. Dit leidde tot een kortere migratietijd van adatoms op substraten en bevordert de groei van (220) kristalvlakken met hogere oppervlakte-energie, ten koste van andere vanwege de hogere richeldichtheid en de kortere diffusieafstand naar de relatief lagere energielocaties [13] ]. Bovendien draagt roostervervorming veroorzaakt door Al-atomen met een hoge concentratie ook bij aan de (220) preferentiële groei in plaats van (111) [18]. De intensiteiten en FWHM van (220) pieken onthullen ook de afhankelijkheid van kristallisatie van de stikstofgasstroomsnelheden. In het lage gasstroombereik (5-15 sccm) worden de intensiteit en FWHM verbeterd wanneer de stikstofstroomsnelheid wordt verhoogd, wat wijst op de Ti-Al-N kristallijne korrelgroottes in films die zijn verminderd en filmkristallisatiekwaliteiten die zijn verbeterd [ 19]. Voor S4 en S5 zijn de verminderde piekintensiteiten en vergrote FWHM die hoge gasstroomsnelheden (20-25 sccm) kunnen bevestigen, nadelig voor de eigenschappen van de Ti-Al-N-films.
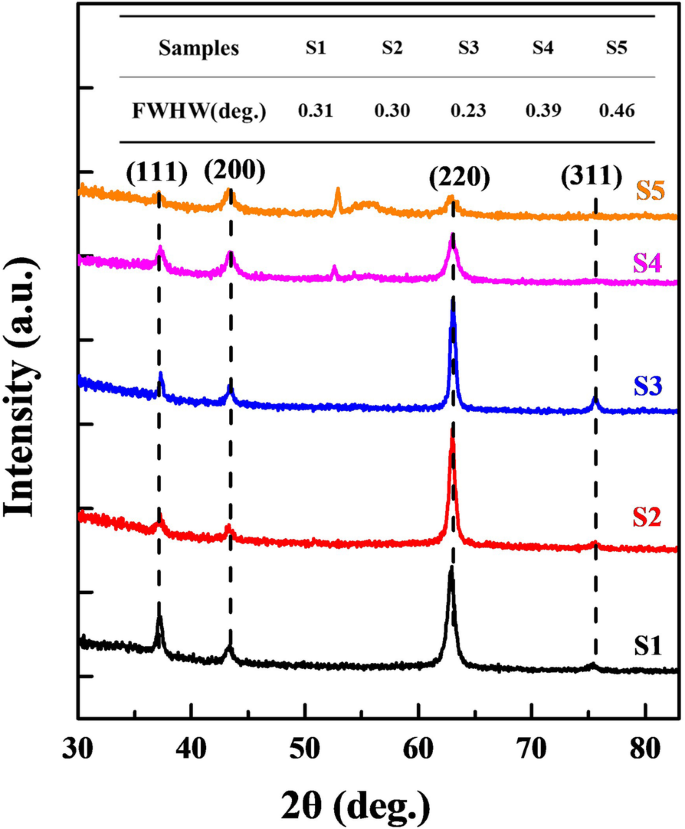
XRD-spectra van S1-S5-monsters. Tabel invoegen is de FWHW-waarde van (220) voor S1-S5
Gedegenereerde Ti-Al-N-kristalkwaliteit bij hoge stikstofgasstroomsnelheden is het resultaat van stikstofplasmavariatie afkomstig van RF-ICPIS. Er kunnen meer stikstofatomen worden geïoniseerd wanneer de stikstofstroomsnelheden in de ionenbron worden verhoogd, en de overeenkomstige plasmadichtheden in de sputterkamer worden ook verbeterd. De elektronenconcentraties in de buurt van de substraten worden gemeten met een Langmuir-sonde. Berekende resultaten laten zien dat de gemiddelde elektronenconcentraties variëren van 1,5 × 10 16 tot 2,7 × 10 16 cm −3 waarbij de stroomsnelheden van stikstofgas toenemen van 5 tot 25 sccm. De verbeterde elektronenconcentraties geven aan dat de plasmadichtheden worden verbeterd tijdens de depositievoortgang. Bovendien zijn de spanningen van de sputterbron met een vaste sputterstroom van 0,4 A tijdens depositie 482, 461, 443, 408 en 376 V voor respectievelijk 5, 10, 15, 20 en 25 sccm. De vermindering van de impedantie tussen substraten en doel weerspiegelt ook de verbeterde plasmaatmosfeer. Hoge plasmadichtheid verbetert de botsingen tussen atomen die leidden tot het gemiddelde vrije pad van gesputterde metaalatomen en verminderde filmafzettingssnelheden. Daarna hebben de geadsorbeerde atomen op de substraten meer tijd om te migreren en te kiemen en bij te dragen aan de filmkristallisaties. Wanneer stikstofstroomsnelheden een bepaalde drempel overschrijden, hoewel de plasmadichtheden verder worden verbeterd, zouden meer stikstofatomen niet volledig worden geïoniseerd onder een vast ionenbronvermogen van 50 W [20]. In vergelijking met volledig geïoniseerde stikstofatomen, bevinden die niet-volledig geïoniseerde atomen zich dichter bij het substraat en zouden ze direct deelnemen aan de groei van filmkiemvorming. Als gevolg hiervan liggen de stikstofgehalten in Ti-Al-N-films behoorlijk boven de stoichiometrische verhouding.
Figuur 3 toont de vlakke en transversale micromorfologieën van Ti-Al-N-films waargenomen door FESEM. De Ti-Al-N oppervlaktemorfologieën vertonen de typische tripartiete kegelkorrels [21]. In vergelijking met Fig. 3a, b, kunnen we zien dat de film die is afgezet bij een lage stikstofplasmadichtheid (S3) kleinere korrelgroottes en dichtere oppervlakken heeft dan S5 die is afgezet bij een hoge plasmadichtheid, wat ook in overeenstemming is met de XRD-resultaten. In een atmosfeer met een lage plasmadichtheid bevorderen volledig geïoniseerde stikstofatomen en voldoende migratietijd van adatomen de groei en kristallisatie van Ti-Al-N en dragen bij aan het dichtere oppervlak. De microstructuren van vergelijkend monster CS3, dat is afgezet via de traditionele methode van ioniserend argongas en dezelfde experimentele parameter heeft als S3, worden ook bestudeerd (zie aanvullend materiaal). In vergelijking met S3 vertoont CS3 een losser en ruwer vlak oppervlak en verschijnen er veel holtes tussen de korrelgrenzen. Ondertussen heeft de CS3 een kleinere filmdikte dan de S3. De redenen worden voornamelijk toegeschreven aan de verschillen in depositieatmosfeer tussen deze twee gasionisatiemethoden. Door stikstofgas rechtstreeks te ioniseren in RF-ICPIS, kan de gasionisatietemperatuur efficiënt worden verlaagd en kan stikstofplasma met hoge dichtheid worden verkregen. Dientengevolge zouden de adatomen op substraten een hoge migratie-energie hebben en gunstig zijn voor de groei en kristallisatie van Ti-Al-N-films. In de transversale FESEM-afbeeldingen worden kolomstructuren duidelijk waargenomen voor Ti-Al-N-films die zijn afgezet bij 15 en 25 sccm, en de films onthullen de dikte van respectievelijk 1.002 en 1.561 m. In omstandigheden met een hoge plasmadichtheid wordt de filmafzettingssnelheid met 50% verhoogd. De resultaten verschillen van de door de verbeterde atomenverstrooiing veroorzaakte lage afzettingssnelheid en komen voornamelijk voort uit de snelle groei van zwak gebonden nitride geassocieerd met die niet-volledig geïoniseerde stikstofatomen. Ondertussen vertonen de kolomvormige structuren van S3 korrelige en dichtere nanostructuren, en het S5-monster onthult de kolomvormige structuren met holtes en grenzen door de hele film. Het is verder duidelijk dat een hoge stikstofplasmadichtheid nadelig is voor de kristallisatiekwaliteiten van de Ti-Al-N-films.
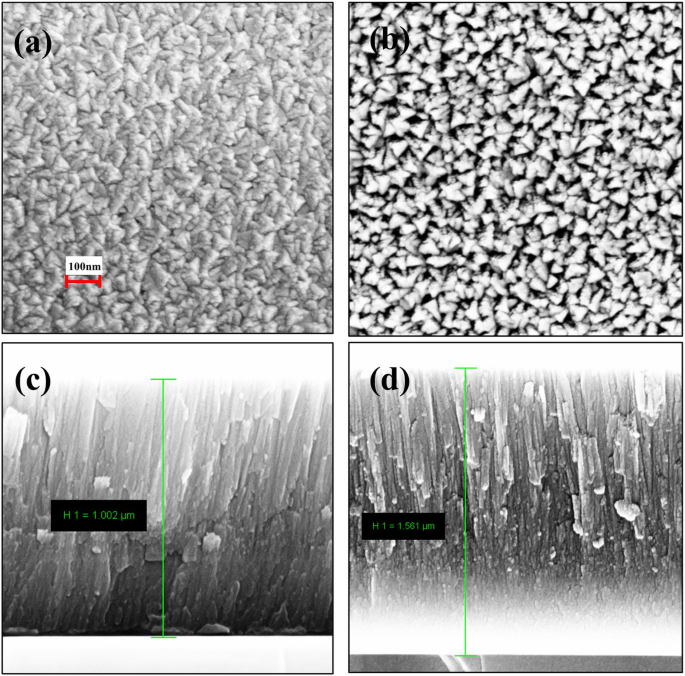
Vlakke en transversale FESEM-afbeeldingen van S3 (a , c; 15 sccm) en S5 (b , d; 25 sccm)
Verder wordt de ruwheid van Ti-Al-N-films die zijn afgezet bij verschillende stroomsnelheden van stikstofgas bestudeerd door AFM, en de RMS-ruwheidswaarden zijn uitgezet in Fig. 4. De ruwheid wordt eerst verminderd en vervolgens verhoogd met de toename van stikstofgasstroomsnelheden, en de minimumwaarde van 3.932 nm wordt verkregen bij 15 sccm. Ondertussen kunnen we, zoals getoond in figuur 4c, het filmoppervlak van het S5-monster vinden dat gevuld is met gezwollen deeltjes en het ravijn tussen deeltjes die vrij diep zijn. De ruwere oppervlakken van S5 kunnen worden toegeschreven aan de slechte kristalkwaliteiten en schaarse oppervlakken. In de Ti-Al-N-kristalstructuur is de Al / Ti-verhouding ook een belangrijke factor dat Al-atomen roosterplaatsen van Ti-atomen bezetten en roosterdefecten introduceert om de microstructuur en mechanische eigenschappen te beïnvloeden [18, 22]. Berekende Al/Ti-verhoudingen op basis van EDS-tests zijn respectievelijk 1,66, 1,54, 1,43, 1,60 en 1,85 voor S1-S5. De uitstekende kristalkwaliteit en lage Al/Ti-verhouding dragen bij aan het gladste oppervlak van het Ti-Al-N-monster dat is afgezet bij 1 sccm. Hoge Al/Ti-verhoudingen verergeren roostervervormingsstructuurdefecten in de S5-films en verergeren de oppervlakteruwheid.

een RMS-ruwheidswaarden van Ti-Al-N-films als functie van stikstofgasstroomsnelheden. Tabel invoegen is de waarden van Al/Ti-rantsoenen; b en c zijn de AFM-afbeeldingen van respectievelijk S3- en S5-samples
De hardheid van Ti-Al-N-films die zijn afgezet op roestvrijstalen substraten onder verschillende stroomsnelheden van stikstofgas wordt getoond in Fig. 5. De hardheid van Ti-Al-N-films verkregen bij 5, 10, 15, 20 en 25 sccm is respectievelijk 33.1, 33.3, 34.6, 29.1 en 26.4 GPa. In het lage stikstofstroombereik is de hardheid van Ti-Al-N-films behoorlijk hoger dan die van het traditionele Ti-N-materiaal. De verbeterde hardheid van Ti-Al-N is voornamelijk afkomstig van de evolutie van de microstructuur door de introductie van Al-gehalten dat Al-atomen die gedeeltelijke roosterplaatsen van Ti-atomen bezetten, roosterschade veroorzaken en de interne spanning van films verhogen. Bovendien zijn de Al / Ti-verhoudingen van S1-S5-monsters hoger dan de Ti-Al-N-materialen die zijn vervaardigd met een conventioneel sputtersysteem, omdat de RF-ICPIS-techniek de gasionisatietemperatuur kan verlagen en de ionisatiesnelheid tijdens het sputteren van de reactie kan verhogen, ook converteer de sputteropbrengst van metaaldeeltjes [23]. Hoge Al/Ti-verhoudingen die roostervervorming veroorzaakten, veroorzaken ook de dislocatiebewegingsweerstand en moeilijke slipbeweging, die gezamenlijk kunnen bijdragen aan de uitstekende hardheidsprestaties van Ti-Al-N-films die zijn afgezet bij lage stikstofstroomsnelheden. Ondertussen bevorderen de geoptimaliseerde kristallisatie en verminderde korrelgroottes de hardheid verder tot het maximum van 34,6 GPa bij 15 sccm.

Hardheid van Ti-Al-N-films afgezet bij verschillende stroomsnelheden van stikstofgas
Wrijvingseigenschappen van Ti-Al-N-films worden ook bestudeerd door het kogel-op-schijfslijtage-apparaat, en de gemiddelde wrijvingscoëfficiënt van Ti-Al-N-films is uitgezet in Fig. 6. De variatie van wrijvingscoëfficiënten is afhankelijk van stikstofgas stroomsnelheden is vergelijkbaar met de RMS-ruwheid. Het is duidelijk dat de gladde oppervlakken en dichte nanostructuren in dwarsdoorsnede van Ti-Al-N-films die zijn afgezet bij lage stikstofgasstroomsnelheden, gunstig zijn voor de tribologische oppervlakteprestaties. Ondertussen vertonen de S1-S3 een kleinere gemiddelde wrijvingscoëfficiënt dan CS3 (zie aanvullend materiaal).

Gemiddelde wrijvingscoëfficiënt van Ti-Al-N-films die zijn afgezet bij verschillende stroomsnelheden van stikstofgas. Inserts zijn de wrijvingscoëfficiëntcurve van respectievelijk S3 en S5
Conclusie
Samenvattend worden de microstructuur en mechanische eigenschappen van Ti-Al-N-films die in verschillende stikstofplasma-atmosfeer zijn afgezet, bestudeerd. Het is gebleken dat de elementgehalten in de Ti-Al-N-films behoorlijk worden beïnvloed door de stikstofplasmadichtheid. Lage plasmadichtheid is gunstig voor de filmkristallisatiekwaliteiten en microstructuur, die wordt ondersteund door XRD-spectra en FESEM. Bovendien kunnen de oppervlakteruwheid en mechanische eigenschappen zoals hardheid en wrijvingscoëfficiënt verder worden geoptimaliseerd bij een geschikt plasmadichtheidsbereik. Bij een hoge plasmadichtheid kan het overmatige stikstofgehalte in de films de metastabiele nitridefase induceren en verantwoordelijk zijn voor de losse microstructuur en verslechterde mechanische prestaties. Onze resultaten zouden een efficiënte manier zijn om het afzettingsatmosfeergerelateerde groeimechanisme van Ti-Al-N-films beter te begrijpen.
Beschikbaarheid van gegevens en materialen
Alle gegevens zijn onbeperkt beschikbaar.
Afkortingen
- RF-ICPIS:
-
Radiofrequentie inductief gekoppelde plasma-ionenbron
- DC:
-
Gelijkstroom
- EDS:
-
Energiedispersieve spectrometer
- XRD:
-
Röntgendiffractie
- FESEM:
-
Veldemissie scanning elektronenmicroscopie
- AFM:
-
Atoomkrachtmicroscopie
- FWHM:
-
Volledige breedte op halve maximum
- RMS:
-
Wortel-gemiddelde-kwadraat
Nanomaterialen
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Invloed van water op de structuur en diëlektrische eigenschappen van microkristallijne en nano-cellulose
- Effecten van dubbellaagse dikte op de morfologische, optische en elektrische eigenschappen van Al2O3/ZnO-nanolaminaten
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Synergetisch effect van grafeen en MWCNT's op microstructuur en mechanische eigenschappen van Cu/Ti3SiC2/C nanocomposieten
- Gemakkelijke synthese van wormgatachtig mesoporeus tinoxide via verdamping-geïnduceerde zelfassemblage en de verbeterde gasdetectie-eigenschappen
- Het bestuderen van de hechtkracht en glasovergang van dunne polystyreenfilms door Atomic Force Microscopy
- Voorbereiding en optische eigenschappen van GeBi-films met behulp van de moleculaire straal-epitaxiemethode
- De structurele, elektronische en magnetische eigenschappen van Ag n V-clusters (n = 1–12) onderzoeken
- Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
- Vergelijkende studie van de elektrochemische, biomedische en thermische eigenschappen van natuurlijke en synthetische nanomaterialen



