Tunneling atomaire laag-afgezette aluminiumoxide:een gecorreleerde structurele/elektrische prestatiestudie voor de oppervlaktepassivering van siliciumverbindingen
Abstract
Passivering is een belangrijk proces voor de optimalisatie van silicium pn-overgangen. Van de verschillende technologieën die worden gebruikt om de oppervlakte- en contactinterfaces te passiveren, wordt aluminiumoxide veel gebruikt. Een belangrijke parameter is de dikte van de passiveringslaag die gewoonlijk wordt afgezet met behulp van atomaire laagafzetting (ALD) techniek. Dit artikel heeft tot doel gecorreleerde structurele/elektrische studies te presenteren voor het passiveringseffect van aluminiumoxide op Si-juncties om een optimale dikte van de aluminiumoxidepassiveringslaag te verkrijgen. Waarnemingen met een hoge resolutie transmissie-elektronenmicroscoop (HRTEM) in combinatie met metingen van energiedispersieve röntgenstralen (EDX) worden gebruikt om de dikte van aluminiumoxide op atomaire schaal te bepalen. De gecorreleerde elektrische parameters worden gemeten met zowel de zonnesimulator als de Suns-Voc van Sinton. afmetingen. Ten slotte wordt dus een optimale aluminiumoxidedikte van 1,2 nm aangetoond.
Inleiding
De vermindering van oppervlakterecombinatieverliezen in silicium pn-overgangen is van het grootste belang om de efficiëntie van lichtabsorptie en de omzetting ervan in fotostroom te verbeteren, met zonnecellen als een hoofdtoepassing [1, 2]. Een van de belangrijkste processen die de defectrecombinatie in siliciumjuncties kunnen verbeteren, was en is altijd de passivering van het oppervlak en de contacten. Voor- en achteroppervlaktepassiveringen zijn ontwikkeld, zowel voor de verlichte niet-gemetalliseerde gebieden als voor de metalen siliciumcontacten [3, 4]. De metaal-silicium-interface heeft een grote recombinatie, dus er zijn twee opties ontwikkeld om de verliezen bij het contactgebied te minimaliseren:een klein contactoppervlak geassocieerd met een laag lokaal dopingniveau, of lokale passivering van het metaal-silicium-interface door de introductie van een dunne tunneling diëlektrische laag. Onlangs is een nieuwe route met een veelbelovend potentieel gesuggereerd met behulp van een carrier-selectieve passiveringslaag [5]. In dit geval mag één polariteit van ladingsdragers naar het metaal gaan, terwijl de andere polariteit wordt geblokkeerd.
Van alle passiveringslagen is aluminiumoxide (Al2 O3 ) afgezet door atomaire laagdepositie (ALD) is een van de meest gebruikte methoden, zelfs als plasma-enhanced chemical vapour deposition (PECVD) proces ook kan worden toegepast [6, 7]. ALD maakt een goede controle van de dikte tot op atomaire schaal mogelijk, terwijl het gebruik van aluminiumoxide leidt tot een goede chemische passivering van grensvlaktoestanden en tot een efficiënte veldeffectpassivering door gelokaliseerde ladingen in de oxidelaag [8]. Elmi et al. toonde aan dat de introductie van ingebedde Ag-nanodeeltjes in een dunne aluminiumoxidelaag de veldeffectpassivering effectief kan verbeteren [9]. Het is bekend dat het teken en de dichtheid van de gelokaliseerde ladingen evenals de dikte van de aluminiumoxidelaag belangrijke parameters zijn voor oppervlaktepassivering. Er zijn veel werken gepubliceerd om de invloed van de dikte van aluminiumoxide op de prestaties van het apparaat te bestuderen; er is echter geen consensus over de optimale dikte van aluminiumoxide, aangezien deze in de literatuur varieert van 0,24 tot 30 nm, zoals samengevat in tabel 1. Tabel 1 illustreert de verstrooiing van de geoptimaliseerde aluminiumoxidedikte. In feite hebben veel gegevens betrekking op de oppervlakterecombinatiesnelheid (Se) die niet overeenkomt met metingen op de gefabriceerde zonne-apparaten. De algemene trend is een afname van Se voor grotere diktewaarden als gevolg van een betere chemische passivering door de aanwezigheid van waterstof in de aluminiumoxidelaag die de grensvlakken tijdens het thermische gloeien na de groei passiveert.
Richter et al. meldde dat emitterverzadigingsstroom tot 30 fA/cm 2 kan worden verkregen voor een dunne laag (0,5 tot 3 nm) maar met een stapelstructuur bestaande uit aluminiumoxide en 70 nm SiNx [17]. Het beste metaal-silicium gepassiveerd contact wordt waargenomen met een 0,24-nm dik Al2 O3 [18]. Ten slotte, wat betreft de doping- en typeniveaus, is passiveren efficiënter op n + maar een SiO2 /alumina-stapelstructuur geeft de mogelijkheid om de dichtheid van gelokaliseerde ladingen af te stemmen en kan zowel op n- als p-type worden gebruikt [23]. Desalniettemin hebben slechts enkele werken de correlatie aangetoond tussen de kwaliteit van de substraat/aluminiumoxide-interface en de elektrische prestaties van apparaten. Het is dus noodzakelijk om een systematische observatie op atomaire schaal uit te voeren op de aluminiumoxidepassiveringslaag en om een optimale waarde te verkrijgen van de aluminiumoxidedikte die gecorreleerd is met elektrische prestaties.
In dit artikel werden aluminiumoxidelagen, afgezet met behulp van de ALD-techniek met verschillende diktes van 0,24 tot 1,9 nm, gebruikt om geïmplanteerde Si n + te passiveren -p kruispunten. Het grensvlak van de aluminiumoxidelaag op het vooroppervlak van de Si-junctie werd bestudeerd met behulp van een transmissie-elektronenmicroscoop met hoge resolutie (HRTEM), terwijl de dikte van de aluminiumoxidelaag werd gecorreleerd met de bijbehorende elektrische parameters zoals seriële weerstand, idealiteitsfactor, levensduur, externe kwantumefficiëntie (EQE) en energieconversie-efficiëntie (PCE). Suns-Voc . van Sinton metingen zijn uitgevoerd om de invloed van serieweerstand op te lossen. Ten slotte werd een geoptimaliseerde dikte van 1,2 nm aluminiumoxide verkregen. Opgemerkt moet worden dat we ons hier alleen concentreren op de frontcontactpassivering van silicium pn-overgangen; de efficiëntie van het apparaat is niet volledig geoptimaliseerd, wat buiten het doel van dit werk is.
Methoden
Apparaatfabricage
Afbeelding 1a toont het fabricageproces van geïmplanteerde Si n + -p knooppunten met oppervlaktepassivering van Al2 O3 /SiNx :H-stapels. Vier-inch met borium gedoteerde p-type silicium (100) wafels met een soortelijke weerstand van 5-10 Ω·cm werden gebruikt als substraten. De monsters werden schoongemaakt met piranha-oplossing en gedestilleerd water voordat n + werd gerealiseerd. bovenste laag. Implantatie van fosforionen werd uitgevoerd met een dosis van 10 14 op/cm 2 bij 180 keV, gevolgd door een annealing bij 900 °C gedurende 5 min om de doteermiddelen te activeren. Gedetailleerde beschrijvingen van het technologische proces zijn te vinden in onze eerdere werken [24, 25].

een Schema van fabricageproces van geïmplanteerde Si n + -p kruising gepassiveerd door Al2 O3 /SiNx stapel. b HRTEM-beeld genomen langs de [011] richting van het siliciumsubstraat. Intensiteitsprofiel dat overeenkomt met de witte rechthoek (een aluminiumoxidefilm met een dikte van ongeveer 0,9 nm is zichtbaar op de bovenkant van de silicalaag). c , d STEM HAADF-afbeeldingen van de twee aluminiumoxidelagen gegroeid door ALD met de overeenkomstige STEM EDX-kaarten van Al, O en Si. De helderdere contrasten in de HAADF-afbeeldingen op de bovenkant van de silicalaag zijn te wijten aan de hogere dichtheid (hogere gemiddelde Z waarde) vergeleken met die van silica of siliciumnitride. Intensiteitsprofielen geven de dikte van aluminiumoxidelagen van respectievelijk ~ 1.2 nm en 1.9 nm
Een ultradunne Al2 O3 tunnellaag met een verwachte dikte d variërend van 0,24 tot 1,9 nm werd afgezet met behulp van de ALD-techniek. Merk op dat deze dikte is afgeleid van de gemiddelde dikte bepaald door ellipsometriespectroscopie, verkregen voor dunne films van aluminiumoxide die met een verschillend aantal cycli zijn gegroeid. Eén ALD-cyclus deponeerde één monolaag die gelijk is aan 0,12 nm. Verbindingen zonder aluminiumoxide (d = 0), d.w.z. met ongepassiveerde metaal-silicium contacten, zijn gerealiseerd, maar de PCE is erg laag, slechts 0,4% [9]. De depositie van aluminiumoxide werd uitgevoerd in een PICOSUN R200-systeem door middel van een thermisch proces. De gebruikte reactanten waren trimethylaluminium (TMA) en H2 O, terwijl de groeitemperatuur 290 °C was. Tijdens het ALD-proces werden watercycli gebruikt om de TMA-precursor te oxideren. Als resultaat, een dunne SiO2 oxidelaag werd afgezet tussen het siliciumoppervlak en de aluminiumoxidelaag vanwege de natuurlijke oxidatie van het siliciumoppervlak. De dikte van een dergelijke natuurlijke oxidelaag waargenomen door TEM was bijna 1,5 nm. Ten tweede, een 80 nm dikke SiNx :H-laag die overeenkomt met de waarde die gewoonlijk wordt gebruikt in de Si-zonnecelindustrie, werd op het monster afgezet met behulp van de PECVD-benadering met een mengsel van SiH4 en NH3 . De depositietemperatuur was 340 ° C, terwijl de druk 1 ° Torr was en het vermogen 10 ° W. Het monster werd vervolgens gedurende 10 ° C gegloeid bij 650 ° C om H te laten diffunderen in Si.
Vingerelektroden van Ti/Au (20/800 nm) werden op de voorkant afgezet door sputteren met een schaduwmasker na het openen van de SiNx :H-coating door middel van reactieve ionenetsing (RIE). Het achtercontact werd vervolgens afgezet door een 400 nm dikke Ti/Au-film te verdampen. Ten slotte werden de monsters gedurende 10 min bij 400 °C uitgegloeid om ohms contact te vormen.
Karakterisering
De TEM-analyse werd uitgevoerd van dunne folies in dwarsdoorsnede, bereid door gefocusseerde ionenbundel (FIB) op een FEI Helios dual-beam Nanolab 600i. Voordat het ion dunner werd, werden een koolstoffilm en een platinalaag afgezet om het bovenoppervlak van het monster te beschermen. De TEM, STEM high-angle ringar dark field (HAADF) en STEM energy dispersive X-ray (EDX) waarnemingen werden gedaan met een dubbel gecorrigeerde JEOL ARM200F koude FEG microscoop die werkte bij 200 kV en uitgerust met een EDX spectrometer (CENTURION van JEOL ). De beeldverwerking werd uitgevoerd met behulp van DIGITALMICROGRAPH (GATAN). De beelden werden genomen met de elektronenbundel evenwijdig aan de [011]-richting van het Si (100)-georiënteerde substraat. In deze oriëntatie is de elektronenbundel evenwijdig aan het aluminiumoxide/substraat-interface.
De elektrische parameters onder verlichting werden gemeten met behulp van een zonnesimulator (Oriel®Sol3ATM) onder AM 1.5G-verlichting, terwijl de externe kwantumefficiëntie (EQE) spectra werden gemeten onder standaard meetomstandigheden op een 7-SCSpec-systeem vervaardigd door 7-STAR Co. Om de invloed van de serieweerstand te overwinnen, heeft Sinton's Suns-Voc metingen zijn uitgevoerd [26,27,28]. Suns-Voc . van Sinton techniek is een open-circuit methode om de prestatie van een pn-overgang of zonnecel aan te geven die het mogelijk maakt om de elektrische parameters die door de zonnesimulator worden gegeven te vergelijken met die afgeleid zonder de invloed van de serieweerstand. De opstelling omvat een xenon-flitslamp met een volledige set filters met neutrale dichtheid en een wafeltrap die wordt geregeld op 25°C. Een standaard IV-curveformaat met een geschatte Jsc kan worden uitgevoerd door ofwel de p+- en n+-gebieden direct te sonderen ofwel de metallisatielaag te sonderen. De gegevens kunnen direct worden gebruikt om de materiaal- en passiveringskwaliteit van zonnecellen aan te geven.
Resultaten en discussie
Figuur 1 (b) is een typisch HRTEM-beeld genomen langs de [011] richting van het siliciumsubstraat. In deze richting is de elektronenbundel noodzakelijkerwijs evenwijdig aan het grensvlak van het filmsubstraat. Merk op dat het bovenoppervlak van het substraat niet perfect vlak is. Deze observatie houdt in dat de interfaces tussen de verschillende bovengenoemde amorfe lagen (silica, aluminiumoxide en siliciumnitride) ook ruw zijn, wat hun karakterisering een zeer moeilijke taak maakt. Door deze ruwheid wordt de diktemeting namelijk altijd overschat. De inzet van Fig. 1 (b) is een intensiteitsprofiel loodrecht op het substraat en over een 10 nm breed gebied zoals aangegeven door de witte rechthoek van het HRTEM-beeld. Dit profiel geeft het verschil in contrast tussen de drie amorfe lagen op de bovenkant van het Si-substraat aan. Door het Z-contrast kan inderdaad een donkerdere 0,9 nm dikke laag worden waargenomen boven de silicalaag, wat hoogstwaarschijnlijk de aluminiumoxidelaag is die door ALD is gegroeid. Om dit resultaat te bevestigen, is een ringvormige donkerveldbeeldvorming met een hoge hoek uitgevoerd op twee verschillende aluminiumoxidelagen gecombineerd met chemische mapping verkregen door scanning transmissie-elektronenmicroscopie gekoppeld aan een energiedispersieve röntgenspectrometer. Afbeelding 1(c) en (d) zijn twee sets gegevens die twee verschillende diktes van de aluminiumoxidelaag illustreren.
Beide sets zijn samengesteld uit een HAADF-afbeelding met het bovenoppervlak van het Si-substraat (in de [011]-richting) en de drie amorfe lagen, namelijk silica (donker gebied), aluminiumoxide (witter gebied) en tenslotte siliciumnitride (intermediair contrast). Merk op dat enkele heldere stippen zichtbaar zijn, vooral in figuur 1 (d). Deze kenmerken zijn te wijten aan platinastof dat uit de beschermlaag komt tijdens de FIB-voorbereiding van de dunne folie. Voor beide structuren worden STEM EDX chemische kaarten van aluminium, zuurstof en silicium vermeld bovenaan de figuur 1 (c) en (d). De aluminiumkaarten laten mooi de aanwezigheid van aluminium zien die overeenkomt met de wittere gebieden van de HAADF-afbeeldingen. Het is gebleken dat er enkele heldere stippen aanwezig zijn in de aangrenzende gebieden, maar deze komen overeen met wat "ruis" op de achtergrond tijdens de acquisitie. Bredere regio's zijn zichtbaar op de zuurstofkaarten omdat ze de aluminiumoxide- en silicalagen afbeelden. Ten slotte tonen de siliciumkaarten een donkere lijn die overeenkomt met de aluminiumoxidelagen, de enige laag zonder silicium. Vanwege diffusieverstrooiingsverschijnselen zijn de chemische kaarten niet de beste gegevens om de diktewaarden goed in te schatten.
Om het verschillende contrast dat wordt veroorzaakt door de aanwezigheid van de aluminiumoxidelaag duidelijker te laten zien, hebben we de intensiteitsprofielen voor beide afbeeldingen uitgezet zoals weergegeven in Fig. 1 (c) en (d). Zoals duidelijk wordt aangetoond door deze profielen, geeft een brede band de helderdere gebieden aan die overeenkomen met de aluminiumoxidelaag. Aangezien het aluminiumoxide een bepaalde ruwheid heeft, is het redelijk om de laagdikte te schatten door de afstand te meten tussen twee verticale lijnen die zich in het midden van de hellingen aan weerszijden van de laag bevinden. De resultaten zijn respectievelijk ongeveer 1,2 nm en 1,9 nm.
Evolutie van de serieweerstand R s
Zoals weergegeven in Afb. 2a, R s is bijna constant (R s = 1.1 ± 0.15 Ω) van d = 0,24 tot 1,2 nm en neemt abrupt toe tot 3,1 ± 0,2 Ω voor d = 1.9 nm. De gemeten weerstand R s is de toevoeging van de emitter- en basiszones, van de metalen vingers en van de weerstand geassocieerd met het dunne SiO2 oxidelaag, samen met het label R ik , plus de weerstand R do geassocieerd met de aluminiumoxidelaag. Voor alle monsters, binnen de limiet van de reproduceerbaarheid van de technologische procedure gegeven door de foutbalken (± 0.15 Ω) in Fig. 4, R ik wordt als constant beschouwd omdat hetzelfde technologische proces wordt toegepast. d is de enige gewijzigde parameter. Dus, als R s is constant tot d = 1.2 nm en als de tunnelweerstand R do varieert uiteraard met d , concluderen we dat tot d = 1.2 nm, R do varieert, maar de variatie is minder dan de spreiding van de metingen, d.w.z. 0,15 Ω. R do is direct gebonden aan de inverse van de overdrachtscoëfficiënt γ voor tunneling, d.w.z. de tunnelkans van dragers door een rechthoekige barrière, gegeven door [29]:
$$ \gamma \circa \kern0.5em \exp \left(-\frac{2d\sqrt{2q{m}^{\ast }{\upphi}_{\mathrm{B}}}}{\overline{ h}}\rechts) $$ (1)waar m * is de effectieve massa in de aluminiumoxidebarrière (m * = 0.75 m 0 [30], met m 0 als de elektronenmassa), h is de constante van Planck, q is de elektronenlading, en ϕ B is de effectieve hoogte van de barrière, gelijk aan de offset van de geleidingsband ΔEC tussen diëlektricum en de n + siliconen contact. De tunnelweerstand wordt gegeven door:
$$ {R}_{\mathrm{thu}}=Bijl{\gamma}^{-1} $$ (2)waar A is een constante. Voor d = 1.9 nm, R do komt overeen met de stap gemeten op R s , en daarom leiden we R . af do (1,9 nm) = 2 Ω. Van deze waarde, A kan worden berekend. Daarvoor moeten we ϕ . kennen B wat gelijk is aan de geleidingsbandverschuiving tussen Si en de diëlektrische laag, aangezien het Fermi-niveau binnen het minimum van de geleidingsband in de zwaar gedoteerde n + ligt siliconen contact. In feite is de diëlektrische laag eigenlijk een paar nanometer SiO2 /Al2 O3 stapel, dus de bandoffset hangt af van deze twee diëlektrische lagen. De offset van de geleidingsband ligt in het bereik van 3,13–3,5 eV en 2,08–2,8 eV voor SiO2 en Al2 O3 [31], respectievelijk. Tabel 2 geeft de waarden van de A prefactor afgeleid van de waarde van R s gemeten bij d = 1.9 nm, voor de twee extreme waarden van ϕ B.
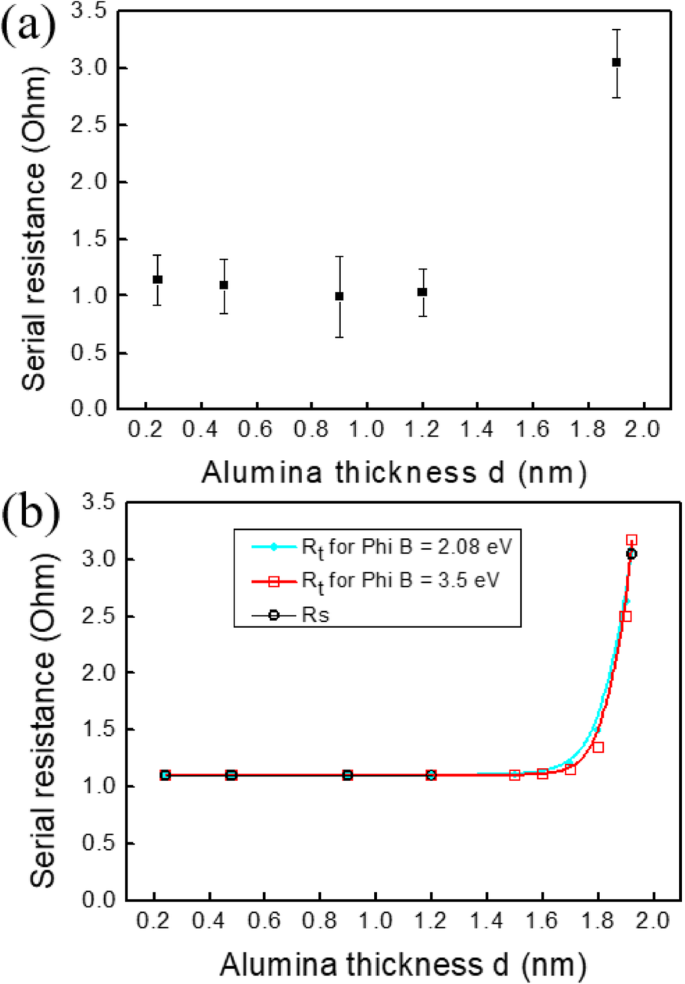
een Evolutie van de serieweerstand R s versus de dikte van het aluminiumoxide. b Experimentele waarden van R s en simuleerde een R simu berekend voor ϕ B = 2,08 en 3,5 eV versus de aluminiumoxidedikte d (nm)
In figuur 2b hebben we R . geplot s en de totale gesimuleerde weerstand R simu = R ik + R do voor de twee ϕ B waarden versus d (R s is genomen naar zijn gemiddelde waarde 1.1 Ω tussen d = 0,24 en 1,2 nm). Wat dan ook ϕ B , voor d ≤ 1.2 nm, R do verwaarloosbaar is. Het bevestigt onze starthypothese:de stap waargenomen bij 1,9 nm in de evolutie van R s wordt geassocieerd met de evolutie van de tunnelbarrière. Voor d minder dan 1,2 nm, is het belangrijkste effect van de aluminiumoxidelaag het passiveren van de n + contacten en het p-oppervlak, door middel van veldeffectpassivering geassocieerd met de vaste ladingen gelokaliseerd in het oxide. Voor grotere d waarden, introduceert de aluminiumoxidelaag een parasitaire seriecontactweerstand die de elektrische prestaties van de cellen vermindert.
Ten slotte kunnen we de soortelijke weerstand schatten ρ van de aluminiumoxidelaag. Daarvoor beschouwen we de gemeten weerstand R voor een diktewaarde van 1,9 nm. Het tunneleffect neemt af en de laag begint een "bulkachtig" gedrag te vertonen (een ruwe benadering). Met een dergelijke dikte van aluminiumoxide (d = 1.9 nm) en rekening houdend met het oppervlak S van het contact (10,54 mm 2 ), leiden we af ρ met behulp van de volgende vergelijking:
$$ R=\rho\ \frac{d}{S} $$ (3)Dat leidt tot ρ = 1.1 × 10 6 ·cm. Voor bulkmaterialen op de markt varieert de weerstandswaarde van 10 5 , afhankelijk van de groeitemperatuur en van de onzuiverheden in het aluminiumoxide. tot 10 14 Ω·cm (van Kyocera™). Onze geschatte waarde laat dus zien dat we een "pseudo-bulk" -materiaal hebben, op de grens tussen een dunne laag en een bulklaag.
Evolutie van de idealiteitsfactor n
In aanwezigheid van een serieweerstand is de I-V-curve van een zonnecel:
$$ I={I}_{\mathrm{L}}-{I}_0\ \exp \left(\frac{q\left(V+I\ {R}_{\mathrm{s}}\right )}{n\ k\ T}\right) $$ (4)waar ik is de uitgangsstroom van de cel, I L is de door licht gegenereerde stroom, V is de spanning over de cel, T is de temperatuur, k is de Boltzmann-constante, n is de idealiteitsfactor, en R S is de celreeksweerstand. Voor een laag injectieniveau, met alleen band-to-band of Schottky Read-Hall-recombinaties, is de idealiteitsfactor n kleiner is dan 2. Het bereikt de waarde van 1 wanneer recombinatie wordt beperkt door minderheidsdragers [31]. Een toename van n geeft aan dat er een ongebruikelijk recombinatiemechanisme plaatsvindt, waarbij zowel minderheids- als meerderheidsdragers betrokken zijn [32]. Dus, n is een handtekening van de recombinatie (of van de passivering) van het apparaat. Bovendien, n is ook gebonden aan R s dat verhoogt de idealiteitsfactor [33]. De evolutie van n versus de aluminiumoxidedikte wordt getoond in Fig. 3a.

een Evolutie van de idealiteitsfactor n versus de aluminiumoxidedikte d . b Evolutie van de levensduur τ versus de aluminiumoxidedikte d
Voor lage diktewaarde (0,24 nm), n groter is dan 2, wat de signatuur is van een niet-gepassiveerd oppervlak. Naarmate de dikte van het aluminiumoxide toeneemt, n neemt af en stabiliseert bij ongeveer 1,5, wat wijst op een efficiënt passiveringseffect door het aluminiumoxide. Voor een dikte van aluminiumoxide van 1,9 nm, n neemt abrupt toe tot 4, overeenkomstig de abrupte toename van R s . Dus beide R s en n laten zien dat de aluminiumoxidelaag de Si-junctie goed passiveert, geassocieerd met een lage tunnelbarrière. Voor d = 1.9 nm, de tunnelbarrière neemt toe, met een daaropvolgende degradatie van R s en dus van de idealiteitsfactor.
Levensduur
Een andere belangrijke parameter die het passiveringseffect illustreert, is de levensduur van de fotodragers, τ . De levensduur is inderdaad direct geassocieerd met de recombinatiesnelheid van de dragers, gebonden aan de concentratie van oppervlaktedefecten (recombinatiecentra). Het werd afgeleid uit de gemeten nullastspanning, de afgeleide in de tijd en het werkelijke verlichtingsniveau. De evolutie ervan ten opzichte van de dikte van het aluminiumoxide wordt gegeven in figuur 3b. De evolutie van de levensduur is in overeenstemming met de vorige resultaten. De gemiddelde waarde is laag, voornamelijk door het ongepassiveerde achtercontact. Het vertoont echter duidelijk een toename met de dikte van het aluminiumoxide, overeenkomstig een betere passivering van het frontcontact en met een optimale diktewaarde van 1,2 nm. Voor d = 1.9 nm, de levensduur neemt af. Het is mogelijk dat naarmate de dikte van het aluminiumoxide toeneemt, er minder waterstof diffundeert uit de SiNx laag op het contact tijdens het thermisch gloeien, en daardoor neemt het chemische passiveringseffect af.
Afbeelding 4 geeft de gemeten EQE versus de aluminiumoxidedikte. De beste EQE wordt waargenomen voor d = 1.2 nm. De belangrijkste verbetering wordt waargenomen voor de golflengte variërend van 600 tot 900 nm. In alle gevallen is de EQE verre van een ideale rechthoekige vorm in de IR, wat een kenmerk is van recombinatie bij het niet-gepassiveerde achtercontact.
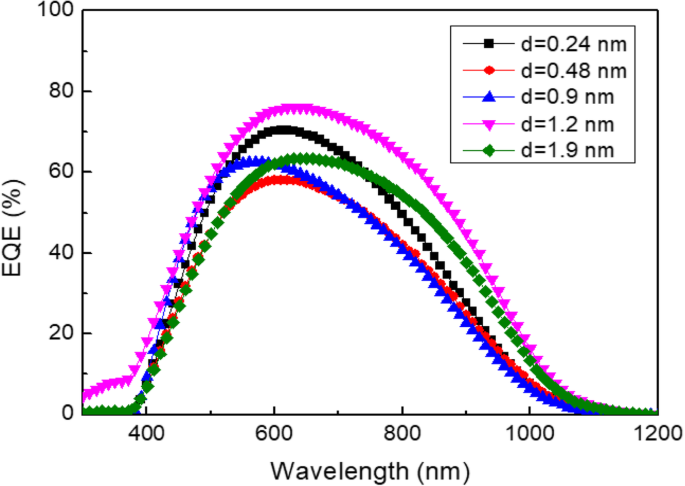
Gemeten EQE versus de golflengte voor verschillende aluminiumoxidediktes
Om de analyse te voltooien, hebben we de elektrische parameters bestudeerd onder verlichting gemeten zowel onder een zonnesimulator als met behulp van de methode van Sinton. Afbeelding 5 toont de energie-efficiëntie van de zonnecellen versus de dikte van aluminiumoxide:de gemeten met de zonnesimulator en de geoptimaliseerde zonder R s . Naarmate de dikte van het aluminiumoxide toeneemt, neemt de gemeten PCE toe dankzij een beter passiveringseffect dat een maximale waarde van 5% bereikt voor d = 1.2 nm, alvorens te verminderen voor d = 1.9 nm. De gecorrigeerde PCE voor R s = 0 heeft een vrij constante waarde rond de 11%. Deze waarde is redelijk, gezien alleen de passivering van het achtercontact. Voor d = 1.9 nm, de gecorrigeerde opbrengst daalt tot 6%, als gevolg van parasitaire shuntweerstand.
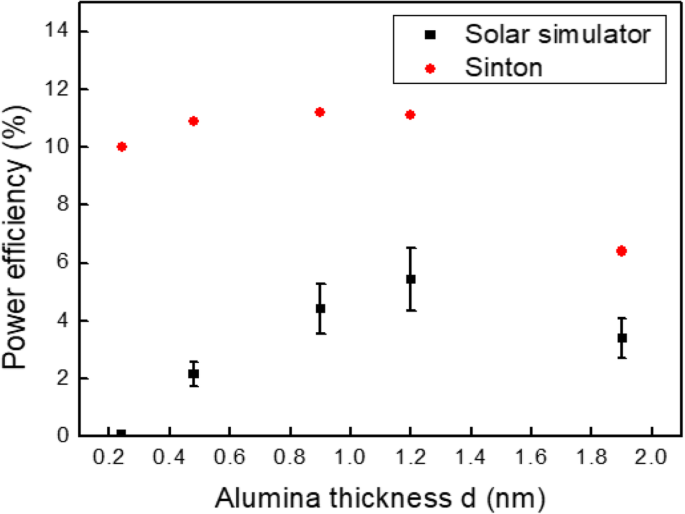
Gemeten en geëxtrapoleerde energie-efficiëntie versus de aluminiumoxidedikte d
Conclusies
Door ALD afgezet aluminiumoxide is een efficiënte methode om elektrische contacten te passiveren, een belangrijke parameter voor silicium pn-overgangen. In dit werk werd een tunneling van een atomaire laag-afgezette aluminiumoxidelaag met verschillende diktes van 0,24 tot 1,9 nm gebruikt om de geïmplanteerde Si n + te passiveren. -p kruispunten. We hebben systematische HRTEM-, STEM HAADF- en STEM EDX-structurele analyses uitgevoerd die zijn gecorreleerd met een complete set elektrische metingen met behulp van zowel een zonnesimulator als Sinton's analyses. Deze originele benadering maakt het mogelijk te beweren dat de optimale dikte van aluminiumoxide voor het bereiken van een efficiënt passiveringseffect 1,2 nm is. Hoewel de efficiëntie van het apparaat in dit werk niet volledig is geoptimaliseerd, zou de optimale passivering van aluminiumoxide gunstig kunnen zijn voor de ontwikkeling van de hoogrenderende zonnecellen op siliciumbasis.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- EDX:
-
Energiedispersieve röntgenstraling
- EQE:
-
Externe kwantumefficiëntie
- FIB:
-
Gefocuste ionenstraal
- HAADF:
-
Ringvormig donkerveld onder hoge hoek
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- PCE:
-
Energieconversie-efficiëntie
- PECVD:
-
Plasma-versterkte chemische dampafzetting
- RIE:
-
Reactieve ionenetsing
- TEM:
-
Transmissie elektronenmicroscoop
- TMA:
-
Trimethylaluminium
Nanomaterialen
- De voordelen van DevOps beoordelen voor het testen van IoT-prestaties
- De atoomherschikking van op GaN gebaseerde meerdere kwantumbronnen in H2/NH3 gemengd gas voor het verbeteren van structurele en optische eigenschappen
- Synthese van elektrisch geleidende silica nanovezel/gouden nanodeeltjescomposiet door laserpulsen en sputtertechniek
- Vorming en lichtgevende eigenschappen van Al2O3:SiOC-nanocomposieten op basis van aluminiumoxide-nanodeeltjes gemodificeerd door fenyltrimethoxysilaan
- Evolutie van het contactgebied met normale belasting voor ruwe oppervlakken:van atomaire naar macroscopische schalen
- Effect van verschillende bindmiddelen op de elektrochemische prestaties van metaaloxide-anode voor lithium-ionbatterijen
- Onderzoek naar het weerstandsschakelgeheugen op meerdere niveaus en de van de geheugentoestand afhankelijke fotospanning in Pt/Nd:SrTiO3-knooppunten
- De optimalisatie van spacer-engineering voor condensatorloze DRAM op basis van de Dual-Gate Tunneling Transistor
- De anionische oppervlakteactieve stof/ionische vloeistoffen geïntercaleerd gereduceerd grafeenoxide voor krachtige supercondensatoren
- Effectieve lichtabsorptie met behulp van de dubbelzijdige piramideroosters voor dunne-film silicium zonnecel
- Hoge prestatie organisch-nanogestructureerde silicium hybride zonnecel met aangepaste oppervlaktestructuur



