Hoogwaardige tweedimensionale InSe-veldeffecttransistors met nieuw ingeklemd ohms contact voor sub-10 nm-knooppunten:een theoretische studie
Abstract
Tweedimensionale (2D) InSe-gebaseerde veldeffecttransistor (FET) heeft in experimentele rapporten opmerkelijke mobiliteit van de draaggolf en een hoge aan-uit-verhouding laten zien. Theoretisch onderzoek prediceerde ook dat de hoge prestaties goed kunnen worden behouden op sub-10 nm-knooppunten in de ballistische limiet. Zowel experimentele ervaring als theoretische berekeningen wezen er echter op dat het bereiken van ohms van hoge kwaliteit de belangrijkste beperkende factor is geworden voor hoogwaardige 2D FET. In dit werk hebben we een nieuw gesandwiched ohms contact met indium voor InSe FET voorgesteld en de prestaties ervan uitgebreid geëvalueerd op basis van opvattingen over materiaal en apparaat op basis van ab initio-methoden. De materiaaleigenschappen geven aan dat alle fundamentele problemen van ohms contact, waaronder tunnelbarrière, de Schottky-barrière en effectieve doping, goed worden betrokken door de introductie van de sandwichstructuur, en een uitstekende contactweerstand werd bereikt. Op apparaatprestatieniveau werden apparaten met een poortlengte van 7, 5 en 3 nm onderzocht. Alle metrieken van gesandwiched gecontacteerde apparaten overtreffen veruit de vereisten van de International Technology Roadmap for Semiconductors (ITRS) en vertonen duidelijke promotie in vergelijking met conventionele structuren. Maximale stroomstoot met 69,4%, 50% en 49% wordt bereikt voor apparaten met respectievelijk 7, 5 en 3 nm poortlengte. Ondertussen wordt een maximale reductie van de intrinsieke vertraging met 20,4%, 16,7% en 18,9% bereikt. Bovendien wordt een benchmark van energy-delay product (EDP) ten opzichte van andere 2D FET's gepresenteerd. Alle InSe FET's met gesandwiched ohms contact overtreffen MoS2 FET's en vereisten van ITRS 2024. Het beste resultaat benadert de bovengrens van ideale BP FET, wat wijst op een superieur overwicht van sandwiched structuren voor InSe FET's in de volgende generatie van complementaire metaaloxide-halfgeleidertechnologie (CMOS).
Inleiding
Tweedimensionale (2D) halfgeleiders hebben veel belangstelling gewekt voor elektronische apparaten vanwege hun aantrekkelijke toepassingen voor de volgende generatie complementaire metaaloxidehalfgeleidertechnologie (CMOS) [1, 2]. Hun ultradunne dikte en goede diëlektrische eigenschap kunnen uitstekende elektrostatische poortcontrole bieden om de bekende korte-kanaaleffecten te onderdrukken [3]. Bovendien, aangezien weinig lagen van 2D-materialen gewoonlijk een glad oppervlak hebben zonder bungelbindingen, kan de superioriteit van dragermobiliteit van 2D-materialen goed behouden blijven in ultradunne lichaamssystemen in vergelijking met conventionele halfgeleiders [4]. Met uitzondering van het gapless grafeen, hebben de meeste gesynthetiseerde 2D-halfgeleiders zoals overgangsmetaal dichalcogeniden (TMD's), zwarte fosfor (BP) en indiumselenide (InSe) een bandafstand die niet nul is en waarvan is aangetoond dat ze geschikt zijn voor veldeffecttransistor (FET ). Op TMD's gebaseerde FET's hebben een hoge aan-uit-ratio laten zien van maar liefst 10 8 en lage lekstroom in apparaten met een kort kanaal, profiterend van de hoge effectieve massa [5]. BP-gebaseerde FET's hebben uitstekende stroom- en schakelkarakteristieken [6], dankzij de hoge mobiliteit van ~ 1000 cm 2 /V s en anisotrope transporteigenschap [7]. Onlangs werd aangetoond dat InSe een superieure mobiliteit van ~ 2000 cm 2 . heeft /V s bij kamertemperatuur [8, 9] en FET op basis van InSe onthulden een hoge aan-uitverhouding van 10 8 [10]. Uit eerste-principeberekeningen bleek ook dat InSe FET goed kan worden verkleind tot sub-10 nm in de ballistische limiet [11, 12]. Vanwege de verwaarlozing van contactweerstand en de hypothese van zware doping, is het naderen van de theoretische limiet echter nog steeds een uitdaging in echte toepassingen. Omdat een betrouwbare dopingmethode en een weg naar hoogwaardig ohms contact nog steeds ontbreken, zijn FET's op basis van 2D-materialen, waaronder InSe, meestal Schottky-barrière (SB) FET [13,14,15,16]. De SB in de actieve gebieden levert een grote contactweerstand op en een laag doteringsniveau verslechtert de stroomdichtheid verder. Het bereiken van een lage contactweerstand met voldoende gedoteerde actieve regio's is de belangrijkste beperkende factor geworden voor 2D-materiaalgebaseerde FET (2D FET) om hoge prestaties te bereiken [17,18,19].
Met het oog op bovenstaande problemen hebben we een nieuw gesandwiched ohms contact voor InSe FET voorgesteld. Indium werd gekozen als het elektrodemetaal, aangezien recente experimentele en theoretische studies suggereren dat indium een veelbelovende kandidaat kan zijn voor InSe FET om goede prestaties te bereiken [20,21,22]. We evalueerden theoretisch de ohmse contactkwaliteit en prestaties van apparaten met een poortlengte van 7, 5 en 3 nm volgens het raamwerk van de International Technology Roadmap for Semiconductors 2013 (ITRS) [23]. Opgemerkt moet worden dat hoewel ITRS is vervangen door de International Roadmap for Devices and Systems (IRDS) [24], ITRS2013 een duidelijke schaaltrend voor transistors laat zien en nog steeds is overgenomen in recente studies [25, 26]. Dit manuscript is als volgt ingedeeld:eerst worden de elektrische eigenschappen van ingeklemde en conventionele (top)contacten onderzocht. Ten tweede worden prestatiestatistieken van het apparaat, zoals stroom in de staat en intrinsieke vertraging, geëvalueerd en vergeleken met de vereisten van ITRS. Ten slotte wordt een benchmark van power-delay-product versus intrinsieke vertraging gepresenteerd om te vergelijken met andere op 2D-materialen gebaseerde apparaten.
Methoden
Alle atomaire structuren werden geoptimaliseerd door VASP [27]; Bij alle berekeningen werd een energiereductie van 335 eV gehanteerd. Eenheidscel van InSe werd versoepeld met een stresscriterium van 0,01 eV/Å in het kader van MetaGGA van SCAN [28]. Roosterparameters van metaalindium werden verkregen uit het handboek voor scheikunde en natuurkunde [29]. Zoals getoond in Fig. 1 is de roosterconstante van InSe 4,029 Å, wat in zeer goede overeenstemming is met experimentele rapporten [30, 31].

Bovenaanzicht van eenheidscel voor InSe (a ) en indium (b ), respectievelijk
De initiële structuur van indium op InSe werd gebouwd met respectievelijk 4 × 1 × 1 en 5 × 2 × 1 eenheidscellen van InSe en indium (001). De gemiddelde absolute rek was 1,32%, wat voldoende is om de intrinsieke eigenschappen van het materiaal te behouden. Zoals getoond in Fig. 2a, b, werd de sandwichstructuur gebouwd met indium/InSe/indium-lagen, indium van onder- en bovenzijden heeft spiegelsymmetrie met het midden van InSe. Beide hybride structuren waren ontspannen met van der Waals (vdW) functioneel van optb88 met een krachtcriterium op elk atoom lager dan 0,02 eV/Å [32, 33]. Het laatste contactoppervlak is 16,19 Å × 6,41 Å. De weerstand van ohms contact werd vervolgens geëvalueerd door een apparaat met twee sondes, zoals weergegeven in Fig. 2a, b. Het wegwerken van onnodige weerstand van halfgeleiders uit contactgebieden, InSe in de kathode was zwaar gedoteerd met 1 × 10 14 e/cm 2 voor zowel top- als sandwichcontacten.
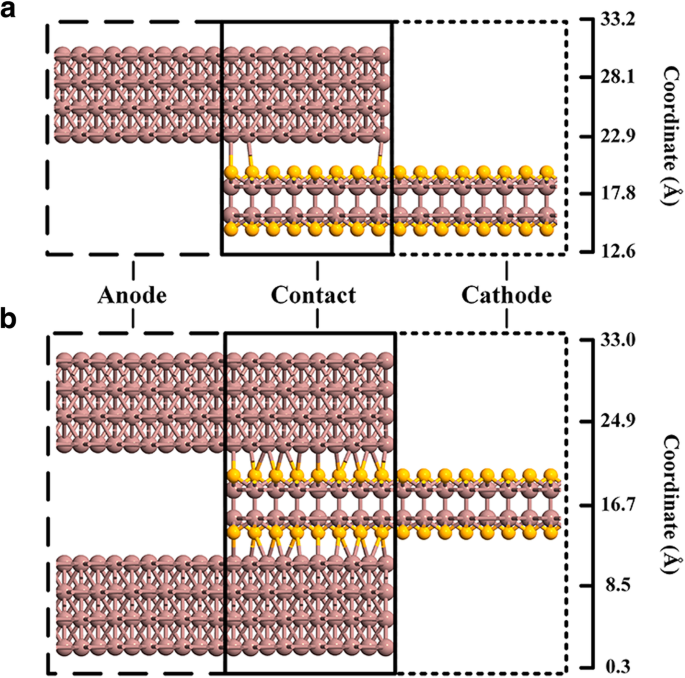
Atomaire contactstructuren en verwant apparaat met twee sondes dat wordt gebruikt voor evaluatie van contactweerstand. een , b zijn voor respectievelijk top- en sandwichcontacten. De coördinaten geven de locatie van atomen in de richting buiten het vlak aan
Wat betreft de evaluatie van de apparaatprestaties, wordt de geometrie van InSe FET met sandwiched en top ohmse contacten getoond in respectievelijk Fig. 3a, b. De naam van alle apparaten en knooppunten volgt de vereisten van respectievelijk ITRS en IRDS. Apparaatparameters worden vermeld in tabel 1. Om de intra-band tunneling te onderdrukken, werd 1 nm underlap (UL) toegepast bij een poortlengte van 3 nm. In tegenstelling tot ohmse contactmodellering, is geen van de onderdelen in apparaten opzettelijk gedoteerd. De apparaten zijn gebouwd door de bron, afvoer en kanaal samen te voegen in de transportrichting. Het kanaal en zijn twee interfaces met actieve regio's waren bovendien ontspannen met vaste source en drain. Alle simulaties waren gebaseerd op de niet-evenwichtstheorie van Green's functie (NEGF) en uitgevoerd door QuantumATK met volledig zelfconsistente berekening [34,35,36], die gewoonlijk werd gebruikt om transistors op sub-10 nm-knooppunten te ontwerpen en te onderzoeken [17] , 37,38,39]. Dubbel-zeta gepolariseerde basisset werd gebruikt met mech-cut-off van 90 Rydberg. Monkhorst pack k-point mesh werd bemonsterd met een dichtheid van 8/Å −1 × 11/Å −1 × 180/Å −1 . Parallel geconjugeerde gradiëntoplosser wordt gekozen als de Poissonoplosser omwille van efficiëntie. De stroomsterkte van alle apparaten kan dan worden verkregen door de Landauer-Büttiker-formule [40] op te lossen:
$$ I\left({V}_{\mathrm{Bias}}\right)=\frac{2e}{h}\int T\left(E,{V}_L,{V}_R\right)\ left[{f}_{\mathrm{R}}\left(E,{V}_R\right)-{f}_L\left(E,{V}_L\right)\right] dE $$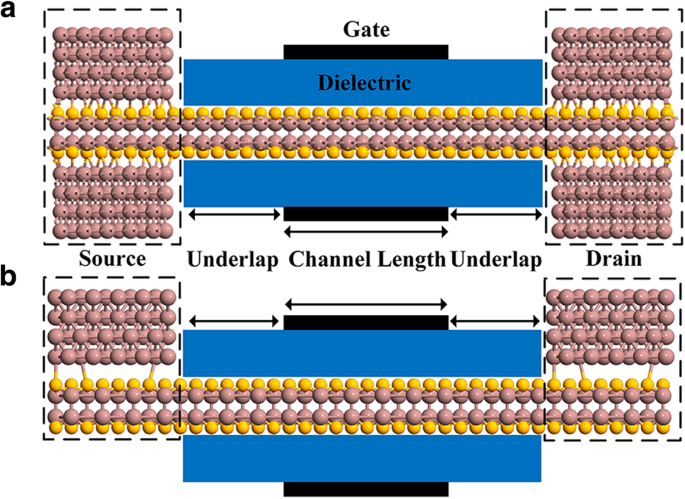
Geometrieën van InSe FET's met ingeklemde (a ) en boven (b ) contacten
Waar,V Vooroordeel is de bias en kan worden bereikt door:V Vooroordeel = V R ‐ V L , T (E , V L , V R ) is de transmissiecoëfficiënt van dragers, f R (E , V R ) en f L (E , V L ) zijn de Fermi-Dirac-verdelingsfunctie voor respectievelijk kathode (afvoer) en anode (bron).
Resultaten en discussie
Over het algemeen zijn er drie sleutelfactoren die gecorreleerd zijn aan de ohmse contactkwaliteit in 2D-materialen [18], namelijk de tunnelbarrière en afstand die wordt afgeleid van de vdW-spleet, orbitale overlap tussen elektrode en halfgeleider, en ook de SB-hoogte. Eerst werden de tunnelbarrière en de afstand beschreven door het effectieve potentieel getoond in figuur 4a. In vergelijking met het bovenste contact zorgt de introductie van een sandwichcontact niet alleen voor een extra transportpad aan de onderkant, maar zorgt het ook voor een afname van de tunnelbarrière van 5,48 naar 2,38 eV, wat een reductie van 56,6% oplevert. Ondertussen wordt de grensvlakafstand ook iets verlaagd met 0,66 , wat aangeeft dat de breedte van de tunnelbarrière ook wordt verkleind. Ten tweede kan de orbitale overlap worden geëvalueerd aan de hand van de verdeling van de volantlading in figuur 4b. Opgemerkt kan worden dat gesandwiched contact meer valance-elektronen heeft op het grensvlak in vergelijking met het bovenste contact, wat wijst op een sterkere orbitale overlapping tussen indium en InSe. Deze functie helpt ook om het doping-effect in InSe te introduceren en het overtollige aantal elektronen kan worden berekend met behulp van de Mulliken-populatie. We hebben het totale aantal elektronen in InSe geëxtraheerd van respectievelijk sandwiched en topcontacted structuren. Vervolgens kan het doteringsniveau worden verkregen door het aantal elektronen te delen door de oppervlakte van het contactgebied, aangezien de nettolading van geïsoleerd InSe altijd nul moet zijn. Zoals te zien is in het rechterpaneel van Fig. 4b, levert gesandwiched contact een zeer hoog dopingniveau op van 1,6 × 10 13 e/cm 2 , wat bijna 2,8 keer hoger is dan die van het topcontact. Een dergelijk hoog niveau heeft de hypothese benaderd in simulaties van 2D-tunneling FET, die gewoonlijk een veel hoger dopingniveau claimt dan metaaloxide-halfgeleider-FET. Ten derde wordt de dichtheid van toestanden (DOS) van InSe in ongerepte, sandwiched en topcontacted structuren getoond in Fig. 4c. Orbitale overlapping tussen indium en InSe op het grensvlak gemetalliseerd de band gap van InSe, en ingeklemd resulteert in een hoger niveau. Deze functie verbetert de injectie van dragers door de vdW-tunnelbarrière in het grensvlak aanzienlijk, omdat de gemetalliseerde toestanden in de bandgap extra tunnelingkanalen bieden. Bovendien liggen de Fermi-niveaus boven het geleidingsbandminimum, wat resulteert in energiedegeneratie van ~ -0,07 en 0,27 eV voor respectievelijk top- en sandwichcontacten. Daarom zijn de SB tussen indium en InSe volledig geëlimineerd. Ten vierde werd de ohmse contactweerstand berekend op basis van de bias-stroomcurve verkregen van de apparaten met twee sondes, en alle resultaten worden getoond in figuur 4d. We kunnen zien dat beide contacten ohms zijn vanwege de lineaire evoluties. Op theoretisch niveau, d.w.z. verwaarlozing van oppervlakteruwheid, grensvlakonzuiverheden, enz., leidt de sandwichstructuur tot een zeer lage contactwaarde van 0,032 ± 0,002 Ω mm, wat meer dan de helft van de weerstand van het bovenste contact vermindert. Op basis van bovenstaande discussies is het interessant om op te merken dat een verdubbeling van het contactgebied altijd leidt tot meer dan twee keer verbetering van het ohmse contact. Omdat recentelijk experimenteel is bevestigd dat topcontact met indium effectief is om de prestaties van op InSe gebaseerde apparaten te verbeteren [21, 22], kan een sandwichstructuur een aantrekkelijke ohmse contactoplossing zijn voor InSe FET's.

een Effectieve potentiaal loodrecht op de transportrichting. De coördinaat komt overeen met de locatie van atomen en is gedefinieerd in Fig. 1. De donkere gebieden komen overeen met de vdW-gap. b Vlakgemiddelde elektronenverdeling loodrecht op de transportrichting. Het rechterpaneel is het dopingniveau. De coördinaat komt overeen met de locatie van atomen en is gedefinieerd in Fig. 1. c DOS van InSe. Het groen komt overeen met het ongerepte InSe. d Stroomafhankelijke bias van de twee sonde-apparaten. Alle rood en blauw corresponderen met respectievelijk bovenste en gesandwiched contacten
Vervolgens werden de prestaties van het apparaat geëvalueerd en werden de overdrachtskenmerken van InSe FET op 2019, 2021 en 2024 knooppunten getoond in Fig. 5. Het kan worden waargenomen dat de subthreshold swing (SS) van alle knooppunten lager is dan 100 mV/dec , en SS op het 2019-knooppunt vertoont bijna ideale schakelkarakteristieken van respectievelijk 61,8 en 64,4 mV / dec voor apparaten met top- en sandwichcontacten, wat wijst op uitstekende elektrostatische controle in InSe FET's. Bovendien leiden gesandwiched gecontacteerde apparaten tot een duidelijke verbetering van IDS vergeleken met de beste met een maximale toename van respectievelijk 69,4%, 50% en 49% op de nodes van 2019, 2021 en 2024. Verder, ikAAN werd geëxtraheerd volgens de eis van hoge prestaties (HP) in de ITRS. Zoals getoond in Fig. 5d, ION van alle systemen ligt ver boven de HP-vereiste. Vergeleken met de meest gecontacteerde apparaten, bieden sandwiched-systemen nog steeds een promotie van 38,2%, 27,3% en 20,5% voor respectievelijk 2019, 2021 en 2024 nodes.
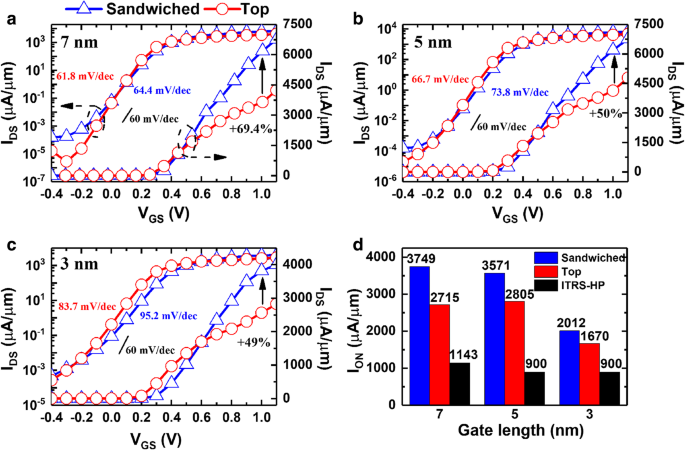
Overdrachtskenmerken van InSe FET's op knooppunt. een 2019, b 2021 en c 2024-knooppunten, respectievelijk. d Vergelijkingen van ION volgens HP-vereisten van ITRS
Een andere essentiële metriek van FET is intrinsieke vertraging (τ), die de bovengrens van de schakelsnelheid in het logische circuit aangeeft. De τ is verkregen door τ = (QAAN − QUIT )/IAAN , waar QAAN en QUIT zijn kosten in respectievelijk aan- en uittoestanden. De aan- en uitstatussen zijn beperkt tot |VDS |=0.68, 0.64 en 0.64 V voor respectievelijk 2019, 2021 en 2024 nodes. Intrinsieke vertraging als functie van de aan-uit-verhouding wordt getoond in Fig. 6. Ondanks de niet-monotone evolutie bij grote vertraging die wordt afgeleid van het tunnelen onder lage poortspanningen [41], zijn alle vertragingen minder dan 0,15 ps en voldoende verlaagd dan de ITRS-vereiste van 0,44-0,46 ps. Bovendien geven gesandwiched gecontacteerde apparaten aanleiding tot een reductie van meer dan 30% in regio's van ION /IUIT ≤ 10 7 , 10 6 , 10 5 voor respectievelijk 2019, 2021 en 2024 nodes. Op basis van de HP-vereisten die worden weergegeven in figuur 6d, kunnen sandwiched-contacted apparaten nog steeds de schakelsnelheid bevorderen met 20,4%, 16,7% en 18,9% voor respectievelijk 2019, 2021 en 2024 nodes.
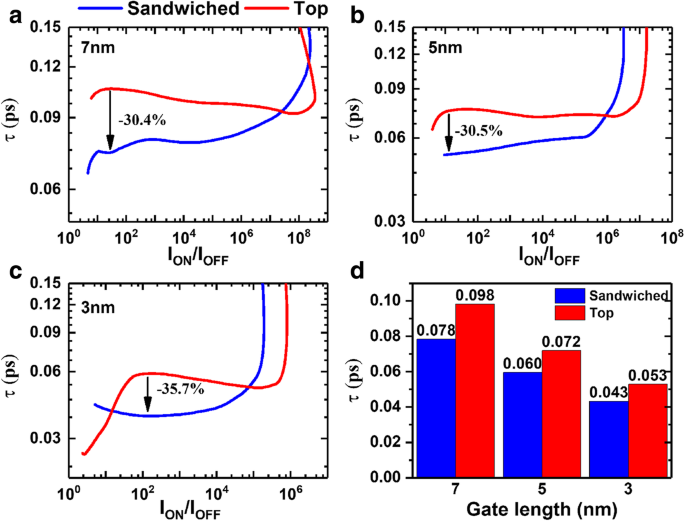
Intrinsieke vertraging als functie van de aan-uit-verhouding op het knooppunt. een 2019, b 2021 en c 2024-knooppunten, respectievelijk. d Vergelijkingen van intrinsieke vertraging na HP-vereiste van ITRS
Om de prestaties van het apparaat intuïtiever te evalueren, wordt een vermogensvertragingsproduct (PDP) versus intrinsieke vertraging geëxtraheerd. PDP komt overeen met het stroomverbruik in een enkele schakelgebeurtenis en wordt gedefinieerd door PDP = (QON − QUIT )VDS met alle parameters afgeleid van HP-vereiste van ITRS. Resultaten en vergelijking met andere 2D FET's worden getoond in Fig. 7. Ten eerste werden alle 2D FET's geselecteerd op basis van de regel dat ze voorlopig zijn geverifieerd als transistors in experimentele rapporten, wat een stap verder gaat voor CMOS-technologie. Ten tweede, behalve InSe en MoS2 [42], alle andere apparaten werden gesimuleerd met zware doping in actieve gebieden en verwaarlozing van ohmse contactweerstand [43, 44], daarom komen de resultaten overeen met de bovengrens van de prestaties. Zoals te zien is, voldoen alle energievertragingsproducten (EDP's) onder de ITRS 2024-vereiste, wat wijst op de aantrekkelijke toekomst van 2D FET's. Het maximum van EDP behoort tot MoS2 FET op 9,9 nm, en het beste is van BP FET. Wat InSe FET's betreft, presteren sandwiched-contacted devices altijd beter dan topcontacted devices op alle knooppunten. De hoogste EDP van apparaten met gesandwicht contact heeft een poortlengte van 7 nm (node 2019) en overschrijdt alle MoS2 FET's. De laagste heeft een poortlengte van 3 nm (2024 node) en nadert zelfs de bovengrens van BP FET in de fauteuilrichting, die bekend staat om de uitstekende transporteigenschappen. Dienovereenkomstig betekent de EDP van InSe FET dat apparaten met sandwichcontacten voldoende concurrentievermogen vertonen tussen 2D FET's.
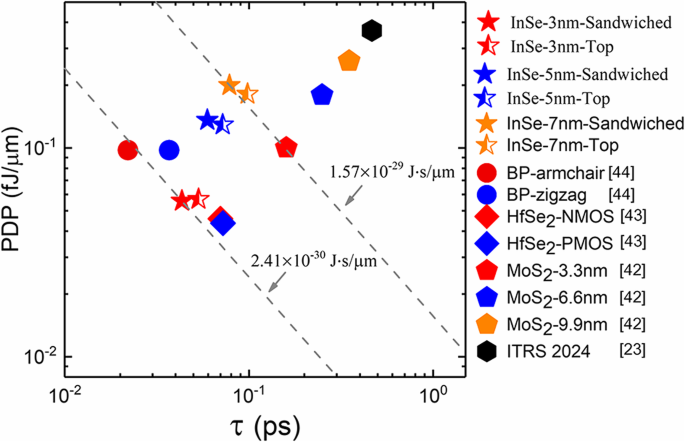
Vermogensvertragingsproduct versus intrinsieke vertraging bestaande uit InSe en andere 2D FET's. De grijs gestippelde richtlijnen komen overeen met specifieke EDP
Conclusies
In dit werk werd een nieuw gesandwiched ohms contact met indium voorgesteld voor InSe FET. Het sandwiched ohmse contact verdubbelt niet alleen het contactgebied, maar bevordert ook de contactkwaliteit meer dan twee keer, wat leidt tot een uitstekende contactweerstand. Op het prestatieniveau van het apparaat met poortlengte 7, 5 en 3 nm, bieden InSe FET's met gesandwiched ohms contact universele prestatiebevordering in vergelijking met conventionele apparaten met topcontact. Onder de eis van HP van ITRS worden de huidige en intrinsieke vertraging in de staat verbeterd met respectievelijk 38,2 ~ 20,5% en 20,4 ~ 16,7%. Een benchmark van EDP ten opzichte van andere 2D FET's laat ook zien dat InSe FET's met gesandwiched ohms contact voordelen hebben ten opzichte van andere 2D FET's. Ons onderzoek biedt een nieuwe route naar hoogwaardige InSe FET's.
Beschikbaarheid van gegevens en materialen
De datasets die tijdens het huidige onderzoek zijn gebruikt en/of geanalyseerd, zijn op redelijk verzoek verkrijgbaar bij de corresponderende auteur.
Afkortingen
- 2D:
-
Tweedimensionaal
- CMOS:
-
Complementaire metaaloxide halfgeleider
- TMD's:
-
Overgangsmetaal dichalcogeniden
- BP:
-
Zwarte fosfor
- InSe:
-
Indiumselenide
- FET:
-
Veldeffecttransistors
- SB:
-
Schottky-barrière
- 2D FET:
-
2D-materiaalgebaseerde FET
- ITRS:
-
Internationale technologieroutekaart voor halfgeleiders
- vdW:
-
van der Waals
- UL:
-
Onderlap
- NEGF:
-
Niet-evenwichtsfunctie van Groen
- DOS:
-
De dichtheid van staten
- SS:
-
Subdrempelzwaai
- HP:
-
Hoge prestaties
- τ:
-
Intrinsieke vertraging
- PDP:
-
Power-delay product
- EDP:
-
Energievertragingsproduct
Nanomaterialen
- Air spacers voor 10nm chips
- Nexam gaat Diab leveren met eigenschapverhogend nexamite voor hoogwaardig PET-schuim
- Geactiveerde koolstofvezels met hiërarchische nanostructuur afgeleid van afval katoenen handschoenen als hoogwaardige elektroden voor supercondensatoren
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- De studie van een nieuw, door nanodeeltjes versterkt, wormachtig micellair systeem
- Evolutie van het contactgebied met normale belasting voor ruwe oppervlakken:van atomaire naar macroscopische schalen
- Atomic-Layer-Deposition van indiumoxide nanofilms voor dunnefilmtransistors
- Tweedimensionale VO2 mesoporeuze microarrays voor krachtige supercondensator
- Enkelwandige koolstof nanobuis gedomineerde micron-brede streeppatroon-gebaseerde ferro-elektrische veldeffect transistoren met HfO2-defect controlelaag
- Een nieuwe nanocone-clustermicrostructuur met antireflectie en superhydrofobe eigenschappen voor fotovoltaïsche apparaten
- Een nieuwe magneto-elastische nanobiosensor voor zeer gevoelige detectie van atrazine



