IBM bij SPIE:zeven verbeteringen voor meer dan 7nm-chips
Toen we in 2015 samen met onze GLOBALFOUNDRIES- en Samsung-partners de eerste functionele 7 nanometer node (7nm) testchips in de branche aankondigden, wisten we dat het proces om de chips "productierijpheid" te bereiken - misschien al volgend jaar, snel zou gaan. Terwijl die inspanning in de halfgeleiderindustrie versnelt, blijft IBM de grens verleggen door zich te concentreren op de uitdagingen van de volgende knooppunten voorbij 7nm.
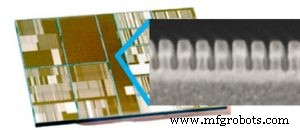 Ons IBM-team presenteert deze week zeven papers tijdens de International Society for Optics and Photonics (SPIE) Advanced Lithography-conferentie van 2017 gericht op technologie-exploratie en activering buiten het 7nm-knooppunt. En het begint met Extreme Ultraviolet (EUV) Lithografie.
Ons IBM-team presenteert deze week zeven papers tijdens de International Society for Optics and Photonics (SPIE) Advanced Lithography-conferentie van 2017 gericht op technologie-exploratie en activering buiten het 7nm-knooppunt. En het begint met Extreme Ultraviolet (EUV) Lithografie.
Met 7nm-chips maken we nu ontwerpen met betrekking tot de grootte van een transistor, of zelfs de bedrading tussen transistoren, die echt op atomair niveau zijn. Om dit soort schaalvergroting te bereiken zonder al te complexe patroonschema's, is EUV van cruciaal belang. Bij een enkele belichting kan EUV een patroon met hoge resolutie creëren dat onbereikbaar is door eerdere halfgeleiderpatronen. Het mogelijk maken van EUV-patronen vereist echter gespecialiseerde apparatuur, processen en knowhow, allemaal te vinden in de onderzoekslaboratoria van IBM in Albany, NY en Yorktown Heights, NY. Deze zeven ontwikkelingen die op SPIE worden gepresenteerd met betrekking tot EUV-maskers (sjablonen die worden gebruikt om circuitontwerpen op een siliciumwafel af te drukken) en patroonvormende materialen (door licht geactiveerde "resists" of etsbestendige materialen), kunnen allemaal worden gezien als cruciaal voor het mogelijk maken van 7nm-technologie en verder:
In Ontwerpintentieoptimalisatie op het knooppunt buiten 7nm:de kruising van DTCO en EUVL stochastische mitigatietechnieken , laat Michael Crouse zien dat hoewel de titel van zijn lezing groot is, kleine veranderingen in bedradingsontwerpen de afdrukomstandigheden drastisch kunnen verbeteren. In figuur 1 laat hij zien dat als de optimalisatie van maskervormen correct wordt uitgevoerd, doorlopende lijnen zonder breuk kunnen worden afgedrukt met de kleinste afmetingen die nodig zijn voor het 7nm-knooppunt en verder.
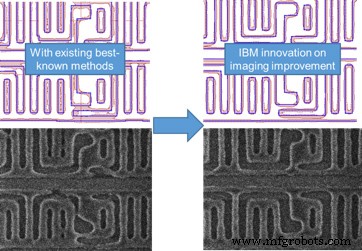
Figuur 1 :Verbetering van contrastoptimalisatie op tweedimensionale metalen bedrading gedemonstreerd met EUV-lithografie. Met het type verbetering dat rechts wordt geïllustreerd, kunnen kenmerken 20-30{ccf696850f4de51e8cea028aa388d2d2d2eef894571ad33a4aa3b26b43009887} kleiner dan die van het 7nm-knooppunt robuuster worden afgedrukt en kan de fysieke/elektrische variabiliteit drastisch worden verminderd.
In Onderzoek naar alternatieve maskerstapels in EUV-lithografie, Martin Burkhardt simuleert de prestaties van nieuwe materialen die momenteel niet worden gebruikt voor EUV-maskers. Door het hele periodiek systeem te bekijken, kan hij illustreren dat EUV-maskers die een nog beter contrast bieden binnen handbereik zijn. Het daadwerkelijk fabriceren van maskers met sommige van deze materialen zou zorgen voor patronen met een hogere getrouwheid op een siliciumwafel zonder enige verdere verandering in EUV-technologie, en zo zou de industrie gemakkelijk verder kunnen schalen dan 7nm.
In Uitgebreide analyse van lijnrand- en lijnbreedteruwheid voor EUV-lithografie , Ravi Bonam illustreert hoe kleine onvolkomenheden en kronkels in een bedradingslijn duidelijk kunnen worden gekarakteriseerd, en laat daarbij zien welke omstandigheden de meest rechte kenmerken produceren, essentieel voor het verbeteren van de maakbaarheid van het EUV-patroonvormingsproces, en de prestaties en opbrengst van de chip.
In Fundamentals of EUV resist-anorganic hardmask interactions , Dario Goldfarb probeert de filmstapel van patroonmateriaal (het punt van overdracht van patroon naar wafel) te verbeteren door de fysieke en chemische interacties op de interfaces tussen deze films, die vaak niet aan elkaar willen kleven, te verbeteren. Hij gebruikt dit begrip om specifieke chemische interacties te creëren om deze materialen bij elkaar te houden (getoond in figuur 2), wat van cruciaal belang is om ervoor te zorgen dat deze kleine vormen met EUV-patroon lang genoeg op hun plaats kunnen blijven om hun patronen in het onderliggende substraat over te brengen.

Figuur 2 :Een EUV-resist die voorheen onmogelijk kon worden gemodelleerd op een anorganisch silicium hardmasker, kan nu duidelijk van een patroon worden voorzien nadat het oppervlak is aangepast aan de combinatie van resist/hardmask.
In een soortgelijk thema als de toespraak van Dario Goldfarb, demonstreert Indira Seshadri in Ultrathin EUV-patroonstapeling met behulp van een polymeerborstel als een laag die de hechting bevordert , dat door gebruik te maken van een polymeerachtig materiaal dat een brug vormt tussen kleine EUV-patroonkenmerken en het onderliggende substraat, deze patronen met zeer hoge resolutie in het onderliggende substraat kunnen worden geëtst en de beoogde ontwerpvorm behouden, wat essentieel is om te zorgen voor meegevende chips op deze lengte schalen.
Met zoveel nieuwe dunnefilmoplossingen in het spel, is het van cruciaal belang om productiewaardige processen in een vroeg stadium van de onderzoeksfasen te onderscheiden en te verbeteren. In een lezing getiteld Driving down defect density in composiet EUV patterning film stacks Luciana Meli demonstreert systematische casestudies, met behulp van een hybride van beschikbare defectinspectietechnieken, om de proces- en materiaalverbeteringen aan te tonen die nodig zijn om de lage defectiviteit te leveren die vereist is voor 7nm en verder dan EUV-produceerbaarheid.
Door veel van deze concepten van beeldvorming en materiaalverbeteringen samen te brengen, zal Anuja De Silva een lezing houden met de titel Ontwikkeling van patronen met één belichting voor EUV-lithografie , waarin succesvolle patronen van bedradingscircuits worden getoond met afmetingen van 30 nm en lager die vereist zijn buiten het 7 nm-knooppunt. Het vermogen om dit te bereiken vertegenwoordigt een grote sprong voorwaarts ten opzichte van de mogelijkheden die voor het eerst beschikbaar waren voor het 7nm-knooppunt (zie afbeelding 3), en kan het 7nm-knooppunt zelf zelfs verbeteren, hoewel ze de uitdagingen zal benadrukken die er nog zijn om volledig functionerende, rendabele chips mogelijk te maken op afmetingen vereist voor technologie van meer dan 7 nm.
Een 7nm-chip heeft 20 miljard transistors in de ruimte, ongeveer zo groot als een vingernagel. Ze zullen hun weg vinden naar systemen en apparaten, waardoor de mogelijkheden - en de wet van Moore - worden uitgebreid om steeds veeleisender taken uit te voeren op het gebied van gegevensanalyse, cognitieve computing en wat de volgende generatie mobiele apps ook biedt. Het werk dat dit jaar op SPIE werd gepresenteerd, duwt de industrie dichter bij patroonoplossingen die niet alleen het 7nm-proces robuuster maken met EUV met enkelvoudige belichting, maar ook verdere schaalbaarheid mogelijk maken om nog meer kracht/prestatievoordeel te realiseren voor de komende jaren.

Figuur 3 :Innovatie op meerdere aspecten van het patroonproces stelt IBM in staat om een holistisch patroonproces te leveren dat de functiegroottes levert die nodig zijn buiten het 7nm-knooppunt.
Andere IBM-presentaties op SPIE 2017
Ontwerpintentieoptimalisatie op het knooppunt buiten 7nm:de kruising van DTCO en EUVL stochastische mitigatietechnieken , Michael Crouse, Nicole Saulnier, Derren Dunn
Onderzoek naar alternatieve maskerstapels in EUV-lithografie , Martin Burkhardt
Decompositie van de TCC met behulp van niet-coherente kernels voor snellere berekening van lithografische afbeeldingen, Alan Rosenbluth
Ontwikkeling van Ti-bevattende hardmaskers door PEALD-afzetting, Anuja De Silva
DSA-patroonopties voor logica en geheugentoepassingen, Charlie Liu
Elektrische studie van DSA-krimpproces en CD-rectificatie-effect bij sub-60nm met EUV-testvoertuig, Cheng Chi
Reiken naar de ware overlay in geavanceerde knooppunten, Chiew-Seng Koay
Aflakvrije strategieën voor oriëntatiecontrole van volledig organische high-block-copolymeren, Dan Sanders
Identificatie en betrouwbaarheidsgevoeligheidsanalyse van een gecorreleerd grondregelsysteem (ontwerpboog), Eric Eastman
Geavanceerde snelle 3D DSA-modelontwikkeling en kalibratie voor co-optimalisatie van ontwerptechnologie, Kafai Lai
Onverwachte effecten van RIE-gassen op lithografische films, Martin Glodde
Voorspelling van elektrische tests met hybride metrologie en machinaal leren, Mary Breton
Het verminderen van LER in Si en SiN door RIE-optimalisatie voor fotonische golfgeleidertoepassingen, Nathan Marchack
Gerichte zelf-assemblage patroonstrategieën voor Phase Change Memory-toepassingen, R. Bruce
Materialen karakterisering voor procesintegratie van meerkanaals poort rondom (GAA) apparaten, Raja Muthinti
Uitgebreide analyse van lijnrand- en lijnbreedteruwheid voor EUV-lithografie, Ravi Bonam
Nanomaterialen
- Tungsten titanium legering doel voor chips
- Hoogzuiver wolfraamdoel voor halfgeleiderchips
- Ga verder dan de minimale netwerkvereisten van Skype voor de beste resultaten
- Pleidooi voor neuromorfe chips voor AI-computing
- Neuromorfe AI-chips voor het versterken van neurale netwerken debuut
- IBM-wetenschappers vinden een thermometer uit voor de nanoschaal
- IBM 5 in 5:Medische laboratoria "op een chip" zullen dienen als gezondheidsdetectives voor het opsporen van ziekten op nanoschaal
- IBM-onderzoekers winnen innovatieprijs voor halfgeleideronderzoek
- IBM presenteert een hybride blockchain-architectuur voor Internet of Things
- Voorbij AIOps:waarneembaarheid voor effectieve IT-activiteiten
- De zeven vereisten voor geoptimaliseerde bewerkingen



