Een nieuwe, dopingloze, vinvormige SiGe-kanaal-TFET met verbeterde prestaties
Abstract
In dit artikel wordt een dopingloze vinvormige SiGe-kanaal-TFET (DF-TFET) voorgesteld en bestudeerd. Om een zeer efficiënte dopingloze lijntunnelverbinding te vormen, worden een vinvormig SiGe-kanaal en een gate/source-overlap geïnduceerd. Door deze methoden kan de DF-TFET met een hoge aan-statusstroom, schakelverhouding van 12 orden van grootte en geen duidelijk ambipolair effect worden verkregen. Hoog κ materiaalstapelpoortdiëlektricum wordt geïnduceerd om de lekkage buiten de staat, interface-eigenschappen en de betrouwbaarheid van DF-TFET te verbeteren. Bovendien kunnen door gebruik te maken van de dopingloze kanaal- en vinstructuur de problemen van het dopingproces en de vorming van asymmetrische poortoverlapping worden opgelost. Dientengevolge kan de structuur van DF-TFET een goede fabricagetoepasbaarheid bezitten en opmerkelijk de voetafdruk verminderen. Het fysieke mechanisme van het apparaat en het effect van parameters op de prestaties worden in dit werk bestudeerd. Tot slot, de huidige stroom (I AAN ) van 58,8 μA/μm, minimale schommeling onder de drempel van 2,8 mV/dec (SSmin ), gemiddelde schommeling onder de drempel (SSgem ) van 18,2 mV/dec kan worden verkregen. Met verbeterde capaciteitskenmerken kan een afsnijfrequentie van 5,04 GHz en een versterkingsbandbreedteproduct van 1,29 GHz worden verkregen. Met verbeterde prestaties en robuustheid kan DF-TFET een zeer aantrekkelijke kandidaat zijn voor ultra-low-power toepassingen.
Inleiding
Met de verkleining van MOSFET's zijn de schakelsnelheid, hoogfrequente prestaties, dichtheid, kosten en functionaliteit van geïntegreerde schakelingen (IC's) enorm verbeterd [1]. Maar met de voortdurende vooruitgang van het verlagen van de spanning, wordt het onaanvaardbare hoge stroomverbruik een serieus probleem voor moderne IC's [1, 2]. Profiteer van het band-naar-band tunnelmechanisme, tunnel-FET (TFET) met steile SS en laag stroomverbruik brengen een nieuwe oplossing voor dit probleem en trok veel aandacht [3,4,5,6,7,8,9 ]. Maar de toepassingen van conventionele op silicium gebaseerde TFET's worden beperkt door de aanzienlijk lage on-state stroom (I AAN ), lage schakelverhouding, ernstig ambipolair effect en grote gemiddelde subdrempelzwaai (SS) [1, 7]. Om de prestaties van TFET's te verbeteren, zijn de afgelopen jaren toepassingen van nieuwe structuren en nieuwe materialen op TFET's voorgesteld. In de afgelopen jaren zijn bijvoorbeeld TFET's met een verbeterde tunnellaag voorgesteld [5, 10, 11]. Met deze laag wordt de effectieve lengte van het tunnelingpad verminderd en resulteert dit in een duidelijke verbetering van de tunnelsnelheid. Bovendien worden TFET's met verbeterde poortstructuur door veel onderzoeksgroepen bestudeerd [12,13,14,15,16,17,18,19,20]. Het concept van lijntunneling wordt geïntroduceerd in L-TFET [17,18,19]. Als gevolg hiervan wordt SSgem van 42,8 mV/decade en I AAN van 10 −6 A/μm kan worden bereikt met L-TFET. Om de prestaties van TFET's verder te verbeteren, wordt een verbeterde TG-TFET met T-vormige overlap en dubbele bron gerapporteerd [20, 21]. Het resultaat is dat de I AAN van TG-TFET bereikt 81 μA/μm. Om de prestaties van het apparaat verder te verbeteren, zijn hoge eisen aan het doteringsprofiel van de tunnelverbinding vereist. Gieterijingenieurs moeten een ultrasteile abrupte kruising creëren die slechts enkele nanometers dik is, en dit is erg moeilijk te bereiken. Om deze moeilijkheid te vermijden, wordt de dopingloze TFET (DL-TFET) op dunne intrinsieke halfgeleiderfilm met gebruikmaking van het ladingsplasmaconcept gerapporteerd door onderzoeksgroepen [22, 23]. In DL-TFET kan de fabricagemoeilijkheid aanzienlijk worden verminderd door de ultrasteile abrupte kruising te verwijderen. De prestatievermindering die wordt veroorzaakt door willekeurige doteringsfluctuaties kan worden vermeden. Bovendien vereist de fabricage van de DL-TFET geen hoge thermische budgetten voor het creëren van de source en drain, wat de mogelijkheid opent om TFET's te realiseren op andere substraten zoals monokristallijn silicium op glas. Hierdoor is de SS van DL-TFET sterk verbeterd. Vanwege het lage rendement van de punttunnelverbinding is de stroom van DL-TFET echter niet hoog genoeg, wat moeilijk is om te voldoen aan de steeds toenemende eisen van moderne circuittoepassingen.
In dit artikel wordt een nieuwe dopingloze vinvormige SiGe-kanaal-TFET (DF-TFET) voorgesteld en bestudeerd. Om de prestaties en robuustheid van het apparaat te verbeteren, worden lijntunnelverbinding en SiGe-materiaal toegepast op DF-TFET. Ondertussen is de metaalwerkfunctie van de poort geoptimaliseerd om de tunnelsnelheid verder te verbeteren. Bovendien verminderde het dopingloze kanaal de moeilijkheid van het fabricageproces, terwijl de vinstructuur de asymmetrische gate/backgate-fabricage toepasbaar maakt. Als gevolg hiervan wordt de huidige (I AAN ) van 58,8 A/μm, lekstroom uit de staat (I UIT ) nabij 10 −11 μA/μm, gemiddelde schommeling onder de drempel (SSgem ) van 18,2 mV/dec en minimale schommeling onder de drempel (SSmin ) van 2,8 mV/dec kan worden bereikt met DF-TFET. Met relatief kleine poortcapaciteit (C gg ) en poort om capaciteit af te voeren (C gd ), kunnen goede analoge/RF-prestaties worden verkregen. Ten slotte is de afsnijfrequentie (f T ) bereikte 5,04 GHz en winstbandbreedteproduct (GBW) bereikte 1,29 GHz.
De structuren van dit document zijn als volgt:De sectie "Apparaatstructuur en simulatiemethode" toont de TCAD-simulatiemethoden van dit werk. De structuur en de parameter van DF-TFET worden geïntroduceerd. De verschillen en voordelen van DF-TFET in vergelijking met DL-TFET en TG-TFET worden geïllustreerd. Het mechanisme, de karakteristieken en de analoge/RF-prestaties van DF-TFET worden besproken in de sectie "Resultaten en discussie". In deze sectie wordt een prestatievergelijking gemaakt tussen DF-TFET, DL-TFET en TG-TFET. Bovendien wordt in deze sectie de invloed van de apparaatparameters op de prestaties en de typische RF-parameters van DF-TFET bestudeerd. Om het potentieel van DF-TFET's in ultra-low-power toepassingen beter te begrijpen, werden vergelijkingen van elektrische kenmerken tussen verschillende TFET's en DF-TFET's onder laagspanningsbias uitgevoerd.
Apparaatstructuur en simulatiemethode
De voorgestelde structuur van DF-TFET wordt geïllustreerd in figuur 1a. Om de prestaties van het apparaat te verbeteren, wordt een lijntunnelverbinding toegepast op het dopingloze vinvormige SiGe-kanaal door middel van een ladingsplasmaconcept [24, 25]. Het is bekend dat de diëlektrische dikte van de poort de tunnelstroom aanzienlijk kan beïnvloeden. Dit komt omdat in het resultaat van de WKB-benadering [26], zoals weergegeven in Vgl. (1), de tunnelkans hangt af van de effectieve screeninglengte (λ ), effectieve dragermassa (m * ), energiebandafstand (E g ) en effectief schermenergievenster (ΔΦ ).
$$T_{{{\text{WKB}}}} \circa \exp \left( { - \frac{{4\lambda \sqrt {2m^{ * } } \sqrt {E_{{\text{g} }}^{3} } }}{{3q\hbar (E_{{\text{g}}} + \Delta \Phi )}}} \right)$$ (1)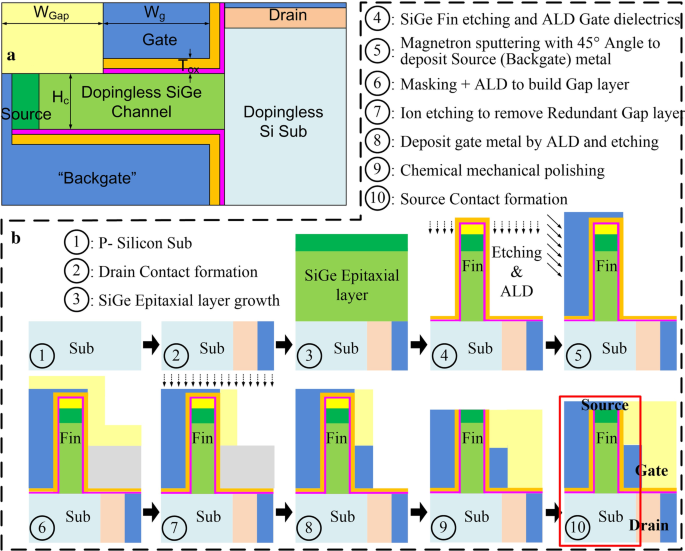
een Structuur en b fabricagestroom van DF-TFET
De dikte van het poortdiëlektricum verminderen of een hoge κ . gebruiken diëlektricum vermindert λ en verhoog ΔΦ , waardoor de kans op tunneling exponentieel toeneemt. Dus, met behulp van hoge κ diëlektrica en het verminderen van de diëlektrische dikte kunnen de on-state stroom van TFET aanzienlijk verhogen. Maar de kleine diëlektrische dikte en interfacekwaliteitsproblemen van hoge κ diëlektrica zullen ernstige betrouwbaarheidsproblemen veroorzaken. Dus een stapelpoortdiëlektricum van 0,5 nm van Al2 O3 en 2,0 nm van HfO2 is ingesteld om een goede interfacekwaliteit [27,28,29] te garanderen, wat de lekstroom aanzienlijk kan verminderen en de betrouwbaarheid van het poortdiëlektricum kan verbeteren. De bronelektrode bevindt zich aan de bovenkant van de vinstructuur. Tegelijkertijd bevindt het zich ook naast één kant van de vin en werkt het als een "achterpoort" om een nulafwijking toe te passen. Door gebruik te maken van poort- en bronelektrode met verschillende metaalbewerkingsfuncties, kan een lijntunnelverbinding worden gevormd in het dopingloze vinvormige SiGe-kanaal door middel van een ladingsplasmaconcept. De richting van band-naar-band tunneling (BTBT) staat loodrecht op het kanaal/poortoppervlak. Dit kan helpen I . te vergroten AAN door het effectieve knooppuntgebied voor tunnels te verbeteren.
Hoge schakelverhouding (I AAN /Ik UIT ) kan worden verkregen vanwege de grote aan-statusstroom (I AAN ) en kleine stroom buiten de staat (I UIT ) geleverd door de lijntunnelverbinding. Bovendien kan de toepassing van een vinstructuur in DF-TFET de voetafdruk aanzienlijk verkleinen in vergelijking met de planer line tunneling TFET [30, 31]. Figuur 1b toont een beschikbare fabricagestroom om de structuur van DF-TFET te vormen. Tabel 1 toont de belangrijkste procesparameters van DF-TFET. Eindelijk, zonder de moeilijkheid om een steile en uniforme abrupte p-n-overgang te maken, kunnen goede prestaties en robuustheid van het apparaat worden bereikt.
Om de verschillen en voordelen van DF-TFET, DL-TFET en TG-TFET beter te begrijpen, toont figuur 2 de structuur van deze drie apparaten. Met line tunneling junction, verwachten L-TFET en TG-TFET een hoge on-state stroom. Maar experimentele resultaten laten zien dat de daadwerkelijke prestatie van L-TFET niet zo hoog is als verwacht [18, 19]. Een van de belangrijkste redenen is de moeilijkheid om een steile en uniforme abrupte p-n-overgang met perfecte interface-eigenschappen te vormen. Gebaseerd op de structuur van L-TFET, maakt TG-TFET een grote verbetering ten opzichte van I AAN . Maar TG-TFET wordt nog steeds geconfronteerd met de moeilijkheid om een perfecte abrupte p-n-overgang te vormen. Om de gewenste goede prestatie te verkrijgen, zou dus een steile en uniforme abrupte p-n-overgang met een dikte van slechts enkele nanometers moeten worden verkregen, maar dit is erg moeilijk te realiseren in het fabricageproces. Door een dopingloos kanaal te gebruiken, kan DL-TFET dit probleem vermijden en een betere interfacekwaliteit in de buurt van tunneling-juncties brengen. In vergelijking met lijntunneling-TFET's [16,17,18,19,20,21] met abrupte p-n-overgangen, laat het simulatieresultaat zien dat de I AAN van DL-TFET is relatief laag [22, 23]. Voor verdere verbetering wordt in dit werk de DF-TFET voorgesteld en bestudeerd.
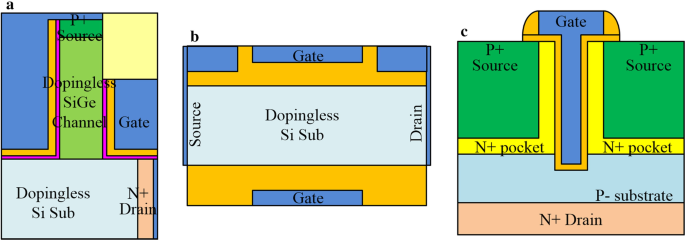
Structuur van a DF-TFET, b DL-TFET, c TG-TFET
Simulatie van DF-TFET wordt uitgevoerd in Silvaco Atlas TCAD-tools. In deze simulatie wordt een niet-lokaal BTBT-model geïntroduceerd om rekening te houden met de ruimtelijke variatie in de energieband, wat kan helpen om de nauwkeurigheid van het BTBT-tunnelingproces te verbeteren. Het Lombardi-mobiliteitsmodel wordt geacht de kanaalmobiliteit nauwkeurig te maken. Er wordt rekening gehouden met het bandgap-verkleiningsmodel om te passen bij de zwaar gedoteerde ohmse contactgebieden, en in dit artikel wordt ook rekening gehouden met het Shockley-Read-Hall-recombinatiemodel.
Resultaten en discussie
Mechanisme en vergelijking van DF-TFET, DL-TFET en TG-TFET
Afbeelding 3a toont de vergelijking van de overdrachtskenmerken van DF-TFET, DL-TFET en TG-TFET. Profiteer van de lijntunnelverbinding in het vinvormige SiGe-kanaal, DF-TFET bereikt een aan-statusstroom (I AAN ) van 58,8 μA/μm en bereikt een grote schakelverhouding van meer dan 12 orden van grootte waar geen duidelijk ambipolair effect optreedt. Bovendien, minimale schommeling onder de drempel (SSmin ) van 2,8 mV/dec en gemiddelde schommeling onder de drempel (SSgem ) van 18,2 mV/dec worden verkregen. Als resultaat heeft DF-TFET een duidelijke verbetering in I AAN vergeleken met DL-TFET en subthreshold swing vergeleken met TG-TFET. Ik AAN van DF-TFET is meer dan één orde van grootte groter dan DL-TFET bij V DS = V GS =-1 V. Figuur 3b toont de energiebandconditie van DF-TFET en illustreert de vorming van een tunnelvenster in een vinvormig kanaal. De rode stippellijn in de inzet van figuur 3b geeft de positie aan waar de energiebandcurve wordt verkregen.
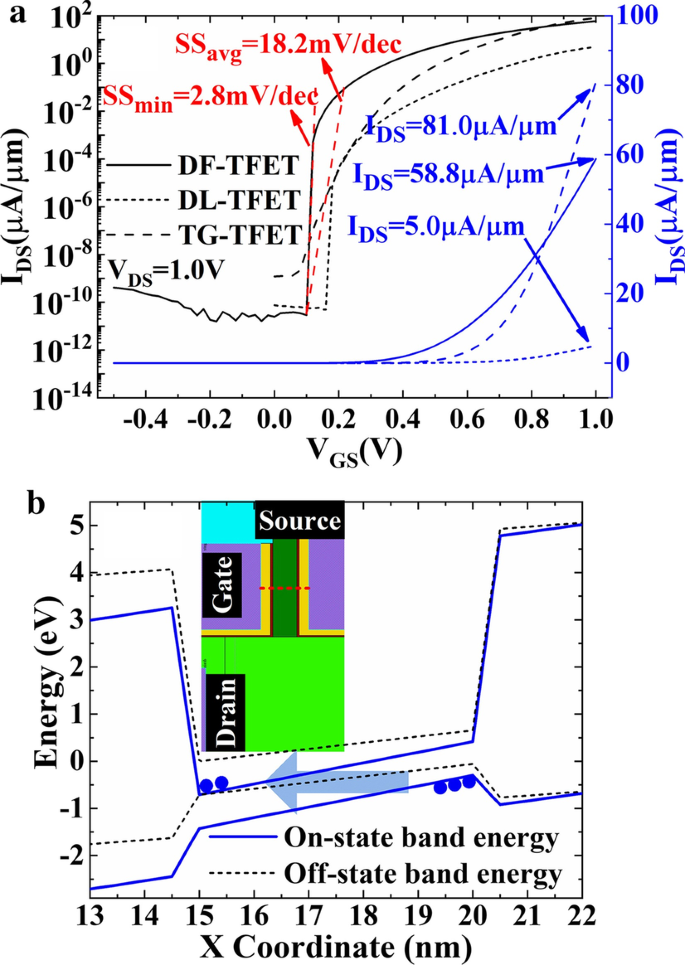
een Overdrachtskenmerken van DF-TFET, DL-TFET en TG-TFET. b Energiebandconditie van DF-TFET in verschillende werkomstandigheden (de inzet toont de snijlijnpositie)
De verdeling van belangrijke fysieke hoeveelheden in het tunnelingproces van DF-TFET wordt getoond in figuur 4, die de verdeling omvat van (a) potentiaal, (b) e tunnelingsnelheid, (c) totale stroomdichtheid en (d) recombinatiesnelheid in een werkvoorwaarde op staat. In figuur 4a kan een duidelijke potentiaalgradiënt loodrecht op de poort / kanaalinterface worden waargenomen. Er wordt dus een enorm potentiaalverschil gegenereerd in het vinvormige kanaal en dit zal de concentratie van elektronen en gaten aan beide zijden van het vinkanaal moduleren. Tegelijkertijd kan een steile energiebandbuiging in het vinvormige kanaal worden gevormd. Als resultaat kan een lijntunnelverbinding worden gevormd evenwijdig aan de poort/kanaalinterface. Afbeelding 4b toont de snelheid van e-tunneling in het kanaal van de vinstructuur. De piekwaarde van de e-tunnelingsnelheid is gelijkmatig verdeeld nabij de poort/kanaalinterface en evenwijdig aan het oppervlak. Dit bewijst dat de lijntunnelverbinding evenwijdig is aan de poort/kanaalinterface. Afbeelding 4c toont het huidige pad in DF-TFET. De valentiebandelektronen van de backgate/kanaalzijde tunnelen naar de geleidingsband nabij de gate/kanaalzijde. Onder invloed van poortspanning en afvoerspanning bewegen elektronen langs het vinkanaal naar de afvoerelektrode. Op deze manier wordt een tunneling-stroompad gevormd in DF-TFET. Figuur 4d toont de verdeling van de recombinatiesnelheid in DF-TFET; dit kan de locatie van het tunnelknooppunt duidelijker illustreren. De paarse strook in het SiGe-vinkanaal kan de locatie van de tunnelovergang voorstellen.
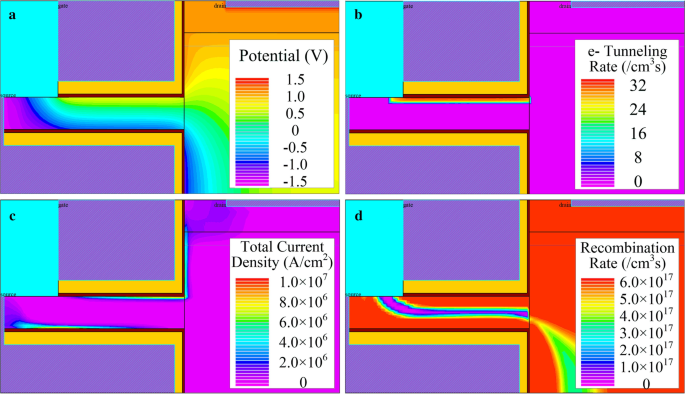
Distributie van a potentieel, b e tunnelsnelheid, c stroomdichtheid en d recombinatiesnelheid van DF-TFET
DC-kenmerken met verschillende parameters en analoge/RF-prestaties
Afbeelding 5a, b toont de invoer- en uitvoerkenmerken van DF-TFET onder verschillende vooroordelen. De toename van V DS heeft weinig effect op swingkarakteristieken onder de drempel, maar I AAN zal een lineaire groei hebben terwijl V DS neemt toe van 0,2 naar 1,2 V (bij V GS = 1.0 V). Afbeelding 5c toont de afsnijfrequentie (f T ) en winstbandbreedteproduct (GBW) berekend door Vgl. (2) en (3). Het resultaat toont aan dat een afsnijfrequentie van 5,04 GHz en een versterkingsbandbreedteproduct van 1,29 GHz kan worden verkregen.
$$f_{{\text{T}}} =\frac{{g_{{\text{m}}} }}{{2\pi C_{{{\text{gs}}}} \sqrt {1 + 2C_{{{\text{gd}}}} /C_{{{\text{gs}}}} } }} \ongeveer \frac{{g_{{\text{m}}} }}{{2 \pi \left( {C_{{{\text{gs}}}} + C_{{{\text{gd}}}} } \right)}} =\frac{{g_{{\text{m} }} }}{{2\pi C_{{{\text{gg}}}} }}$$ (2) $${\text{GBW}} =g_{{\text{m}}} /2 \pi 10C_{{{\text{gd}}}}$$ (3)
een Invoer, b uitvoer en c radiofrequentiekarakteristieken van DF-TFET
Afbeelding 6a toont het effect van de poortwerkfunctie (φ Poort ) en afvoerwerkfunctie (φ Afvoer ) over overdrachtskenmerken van DF-TFET. Met de toenemende arbeidsfunctie verschuift de overdrachtskarakteristiek naar de positieve richting. Omdat de werkfunctie varieert van 3,7 tot 4,2 eV, is de V de neemt lineair toe van 0 tot 0,5 V terwijl de I AAN neemt lineair af van 93,4 tot 18,6 A/μm. Dit maakt het mogelijk om V . aan te passen de toepassen op verschillende toepassingsvereisten. Afbeelding 6b toont het effect van compositieverhouding X van Si1−X GeX . De toename van de germaniumsamenstelling leidt tot een afname van de energiebandafstand en een toename van het tunnelvenster, zoals weergegeven in de inzet van figuur 6b. Uiteindelijk resulteert dit in de I AAN toename en overdracht karakteristieke curve vertaalt naar de negatieve richting. Echter, wanneer X> 0,7, zowel de overdrachtskarakteristiek als de I AAN weinig verandering met de toenemende X . Dit komt omdat de kanaalenergiebandstructuur ongevoelig wordt voor X wanneer X> 0,7, zoals weergegeven in de inzet van Fig. 6b. Afbeelding 6c, d toont het effect van poortlengte (W g ) en kanaaldikte (H c ) op overdrachtskenmerken. De inzet van Fig. 6c toont de afmetingen van het apparaatkanaal onder verschillende W g . Het is niet moeilijk om uit Fig. 6d op te merken dat DF-TFET zal lijden I AAN afnemen wanneer H c wordt zowel te klein als te groot. Dus een echte H c zal de prestaties van het apparaat ten goede komen.

Overdrachtskenmerken met verschillende a poortwerkfunctie (φ Poort ) en afvoerwerkfunctie (φ Afvoer ), b SiGe-samenstellingsverhouding, c poortlengte (W g ) en d kanaaldikte (H c )
Om het potentieel van DF-TFET in ultra-low-power toepassingen te begrijpen, toont Tabel 2 een prestatievergelijking van verschillende TFET's met DF-TFET. Vergeleken met TFET's met een traditionele zwaar gedoteerde p-n tunneling junction [6, 20, 32,33,34,35], heeft DF-TFET duidelijke voordelen op SS en schakelverhouding. Dit komt door de eigenschappen van DF-TFET door middel van elektrostatische doping. Vergeleken met andere dopingloze TFET's [22, 23, 36, 37] heeft DF-TFET duidelijke voordelen op ION . Dit komt door de verbeterde tunnelsnelheid door het gebruik van lijntunneling-juncties en SiGe-materiaal. Door de voordelen van een p-n-tunnelverbinding en een dopingloze tunnelverbinding te combineren, kan DF-TFET een hoge bedrijfsstroom en een laag statisch stroomverbruik leveren in toepassingen met ultralaag stroomverbruik.
Conclusie
In dit werk wordt een nieuwe DF-TFET voorgesteld en worden de elektrische kenmerken geanalyseerd met een simulatiemethode. De structuurkarakteristiek, het fysieke mechanisme, de prestaties met verschillende parameters en de analoge/RF-prestaties van DF-TFET worden besproken en bestudeerd. Profiteer van het dopingloze vinstructuurkanaal, het stapelpoortdiëlektricum, het SiGe-kanaalmateriaal en de zeer efficiënte lijntunnelverbinding, goede prestaties in schakelkarakteristieken en analoge / RF-karakteristieken kunnen worden verkregen. Bovendien kan, door de vorming van de abrupte p-n-overgang in het fabricageproces te vermijden, uniforme dotering met hoge consistentie en hoge robuustheid bij procesfluctuaties worden bereikt. Het simulatieresultaat laat zien dat, I AAN van 58,8 μA/μm, schakelverhouding van 12 orden van grootte, geen duidelijk ambipolair effect, SSmin van 2,8 mV/dec en f T van 5,04 GHz kan worden bereikt met DF-TFET. Met de grote bedrijfsstroom, hoge schakelverhouding, steile SS, goede betrouwbaarheid, stabiel fabricageproces en goede produceerbaarheid, kan worden verwacht als een van de veelbelovende kandidaten voor de toekomstige low-power IC en gevoelige sensortoepassingen.
Beschikbaarheid van gegevens en materialen
Niet van toepassing (Dit manuscript is een puur theoretische studie over analoge/RF-prestaties van TFET. De simulatiegegevens zijn in dit manuscript gegeven en hoeven hier niet te worden beschreven).
Afkortingen
- DF-TFET:
-
Dopingloze vinvormige SiGe-kanaal TFET
- IC's:
-
Geïntegreerde schakelingen
- TGTFET:
-
T-vormige poort dual-source TFET
- DL-TFET:
-
Dopingloze TFET
- Ik AAN :
-
Huidige stroom
- Ik UIT :
-
Off-state stroom
- SSmin :
-
Minimale swing onder de drempel
- SSgem :
-
Gemiddelde schommeling onder de drempel
- C gg :
-
Poortcapaciteit
- C gd :
-
Poort om capaciteit af te voeren
- f T :
-
Afsnijfrequentie
- GBW:
-
Product bandbreedte winnen
- λ :
-
Effectieve screeningduur
- m * :
-
Effectieve draagmassa
- E g :
-
Energiebandafstand
- ΔΦ :
-
Effectieve screening energievenster
- W g :
-
Lengte poort
- W Kloof :
-
Lengte van de opening
- T os :
-
Dikte van stapelpoortoxide
- H c :
-
Kanaaldikte
- φ Poort /φ Afvoer :
-
Poort en afvoer werkfunctie
- V DS :
-
Afvoer naar bronspanning
- V GS :
-
Poort naar bronspanning
Nanomaterialen
- Nieuwe aanpak zorgt voor verbeterde PUF-stabiliteit
- Verbeter de prestaties met geautomatiseerd lassen
- Blog:medische wearables met geweldige prestaties
- Een nieuwe Bi4Ti3O12/Ag3PO4 heterojunctie-fotokatalysator met verbeterde fotokatalytische prestaties
- Verbeterde prestaties van een nieuwe anodische PdAu/VGCNF-katalysator voor elektro-oxidatie in een glycerolbrandstofcel
- Geleidingsmechanisme en verbeterd uithoudingsvermogen in HfO2-gebaseerd RRAM met nitridatiebehandeling
- Vervaardiging van hiërarchische ZnO@NiO Core-Shell heterostructuren voor verbeterde fotokatalytische prestaties
- Kanaalplasmonnanodraadlasers met V-groefholten
- Effecten van etsvariaties op Ge/Si-kanaalvorming en apparaatprestaties
- Hoge prestatie organisch-nanogestructureerde silicium hybride zonnecel met aangepaste oppervlaktestructuur
- 6 manieren waarop we Protocase Designer hebben verbeterd met release 4.6



