Vervaardiging van hoogwaardige en spanningsontspannende GeSn-microschijven door integratie van selectieve epitaxiale groei en selectieve natte etsmethoden
Abstract
GeSn is een veelbelovend materiaal voor de fabricage van on-chip fotonische en nano-elektronische apparaten. Er zijn dus verwerkingstechnieken ontwikkeld die specifiek zijn voor GeSn, waaronder epitaxie, annealing, ionenimplantatie en etsen. In dit werk worden gesuspendeerde, spanningsontspannen en hoogwaardige GeSn-microschijven gerealiseerd door een nieuwe benadering zonder enige etsing op een GeSn-legering. De GeSn-legering werd gekweekt op voorgevormd Ge (001)-substraat door moleculaire bundelepitaxie bij lage temperaturen. De transmissie-elektronenmicroscopie en scanning-elektronenmicroscopie werden uitgevoerd om de microstructuren van de GeSn-monsters te bepalen. De microschijven met verschillende diameters van Ge-voetstukken werden gefabriceerd door de selectieve natte etstijd te regelen, en micro-Raman-resultaten laten zien dat de microschijven met verschillende afmetingen van de resterende Ge-voetstukken verschillende mate van spanningsrelaxatie hebben. De drukbelasting van microschijven wordt onder geschikte omstandigheden bijna volledig ontspannen. De halfgeleiderverwerkingstechnologie die in dit werk wordt gepresenteerd, kan een alternatieve methode zijn om innovatieve op GeSn en andere materialen gebaseerde micro/nano-structuren te fabriceren voor een reeks Si-compatibele fotonica, 3D-MOSFET's en micro-elektromechanische apparaattoepassingen.
Inleiding
Germanium-tin (GeSn), een complementair metaal-oxide-halfgeleider (CMOS)-compatibel materiaal uit groep IV, heeft de afgelopen jaren veel aandacht getrokken vanwege zijn toepassingen in elektronica en opto-elektronica. Het legeren van meer Sn in Ge kan de mobiliteit van de drager verbeteren en de bandgap veranderen van indirecte naar directe overgang [1, 2]. Theoretisch werk [3,4,5] en op fotoluminescentie gebaseerde experimentstudies [6,7,8] tonen aan dat de indirecte-naar-directe overgang voor een ontspannen GeSn-legering plaatsvindt bij een Sn-gehalte van niet minder dan 6,5%. De lage (1%) evenwichtsoplosbaarheid van Sn in Ge [9, 10] en de grote roostermismatch (~-15%) tussen Ge en α-Sn introduceren echter enorme uitdagingen voor de realisatie van defectvrije GeSn-legering met zelfs een weinig atoom% van substitutie Sn. Het gebruik van niet-evenwichtsgroeitechnieken zoals moleculaire bundelepitaxie bij lage temperatuur (MBE) [11,12,13,14,15], chemische dampafzetting (CVD) [16,17,18,19,20], en vaste-fase epitaxie [21, 22] heeft grote behoefte.
In het geval van een GeSn-legering die is gegroeid op een virtueel GeS-substraat of Ge-substraat, wordt verwacht dat de hoogste kwaliteit van GeSn wordt bereikt in de pseudomorfe of volledig gespannen toestand, waardoor de vorming van misfits en dislocaties met schroefdraad kan worden voorkomen. Desalniettemin wordt een dergelijke GeSn-legering compressief gespannen (~ -0,15% per 1% Sn) en deze door epitaxie geïnduceerde spanning doet het effect van het legeren van Sn met Ge voor bandgap-conversie teniet. Dientengevolge is een veel hoger Sn-gehalte van 17% voor pseudomorfe GeSn-epilaag op Ge (001) [23] vereist om de directe bandgap te bereiken, wat leidt tot extreem hoge uitdagingen voor epitaxie en lage materiaalkwaliteit. Daarom wordt het manipuleren van de stam zonder de kwaliteit van het kristal van de GeSn-epilagen op te offeren een zeer belangrijke kwestie. Selectieve verwijdering van het spanningsinducerende Ge-virtueel substraat of Ge-substraat onder de GeSn-epi-lagen om gedeeltelijk gesuspendeerde microstructuren te vormen, is een veelbelovende techniek om de compressieve spanning in de GeSn-films te overwinnen. Zo werden opgehangen GeSn-microschijven met een steunpilaar in het midden vervaardigd [24,25,26,27,28]. De structuur kan niet alleen de drukspanning in de GeSn-laag verminderen door elastische vervorming op vrije oppervlakken, maar ook optische modellen opsluiten nabij de rand van de microschijf vanwege het sterke brekingsindexcontrast tussen de GeSn en het omringende medium (lucht), zoals fluisteren -galerij-modus [16, 25]. Tot nu toe is er slechts één methode gerapporteerd om GeSn-microdisk te bereiden door middel van optische lithografie na de groei en top-down etsen van de tweedimensionale GeSn-film [16, 24, 29, 30]. Het proces kan echter thermische mismatch-effecten ondervinden tijdens het etsproces na de groei, wat zal leiden tot een verslechterde materiaalkwaliteit van GeSn-microschijven. Onlangs hebben P.Ponath et al. rapporteerde de selectieve oppervlaktegroei van zeer kristallijne c -asgeoriënteerde BTO [31], die ons inspireerde voor de fabricage van GeSn-microstructuren. Door bij de laatste stap rechtstreeks GeSn-microschijven te deponeren op een vooraf gevormd SiO2 /Ge-substraat en vervolgens selectief het Ge-substraat wegetsen volgens de offer SiO2 laagverwijderende, gesuspendeerde GeSn-microschijven kunnen worden vervaardigd zonder het conventionele en complexe etsproces na de groei. Een dergelijke methode kan, indien mogelijk, de bovengenoemde problemen vermijden en zo een hogere kwaliteit en spanningsontspannen GeSn-microstructuur verkrijgen. Bovendien is het ook een veelbelovende methode waarmee willekeurige patronen met een hoge nauwkeurigheid en een goede aspectverhouding kunnen worden bereikt, met name voor driedimensionale integratie van complexe apparaatstructuren die een exacte dikteregeling van lagen vereisen.
In dit artikel werden GeSn-microschijfstructuren met succes gefabriceerd met een nieuwe methode. Het is de eerste keer dat GeSn-microschijven worden geprepareerd door selectieve epitaxiale groei te combineren met een eenvoudige stap van selectief nat etsen. De dikte, de Sn-concentratie en de kristalkwaliteit van de GeSn-epilaag werden gekenmerkt door transmissie-elektronenmicroscopie met hoge resolutie (HRTEM) en secundaire ionenmassaspectrometrie (SIMS). Scanning-elektronenmicroscopie (SEM) en micro-Raman-spectroscopie (μ-Raman) werden gebruikt om inzicht te krijgen in de microstructuren van de gefabriceerde GeSn-microschijven. Kamertemperatuur (RT) μ-Raman-resultaten laten zien dat de microschijven met verschillende afmetingen van de resterende Ge-voetstukken verschillende mate van spanningsrelaxatie hebben. De drukbelasting van microschijven wordt onder geschikte omstandigheden bijna volledig ontspannen. Deze methode om microschijven te fabriceren zonder de GeSn zelf te hoeven etsen, is gunstig om ontspannen en hoogwaardige GeSn en andere materialen nanostructuren te verkrijgen.
Methoden
Materialen
De Ge-wafels zijn gekocht bij het bedrijf AXT. Aceton, isopropylalcohol, fluorwaterstofzuur, ethylalcohol, waterstofperoxide, ammoniak in water en kaliumhydroxide werden geleverd door Sinopharm Chemical Reagent (China). Gedeïoniseerd H2 O (18,2 MΩ·cm) werd verkregen uit een ultrafiltratiesysteem (Milli-Q, Millipore, Marlborough, MA).
Voorbereiding van het gemodelleerde Ge-substraat
Ge (001)-wafels (n-type, 0,025-0,031 Ωcm) werden eerst 3 minuten ondergedompeld in aceton en isopropylalcohol en vervolgens chemisch gereinigd met een verdunde fluorwaterstofzuuroplossing (HF:H2 O =1:20) gedurende 20 s bij kamertemperatuur. Dit werd gevolgd door een spoeling in stromend gedeïoniseerd H2 O (DI–H2 O). De reinigingsprocedure is van belang, vooral de HF-behandeling om de oorspronkelijke oxidelaag af te pellen en ervoor te zorgen dat het Ge-oppervlak schoon is en nauw contact maakt met de volgende SiO2 laag. In dit geval wordt het lift-off-profiel bereikt door de afzetting van een Si/SiO2 composiet laag. Vervolgens werden de wafels gedroogd door N2 . droog te blazen en snel geladen in de ultrahoog vacuüm (UHV) kamer van plasma-versterkte chemische dampafzetting (PECVD) en gedurende 20 minuten bij 300 ° C uitgegloeid om volledig te ontgassen. Dan een 300 nm SiO2 laag werd bij dezelfde temperatuur afgezet door PECVD gevolgd door een afzetting van 50 nm ongedoteerd polykristallijn Si door magnetronverstuiving bij kamertemperatuur, zoals getoond in Fig. la. Ronde openingen in de Si/SiO2 composietlagen worden van een patroon voorzien met behulp van standaard fotolithografietechniek (Fig. 1b) en tweestaps etsprocessen (Fig. 1c, d).
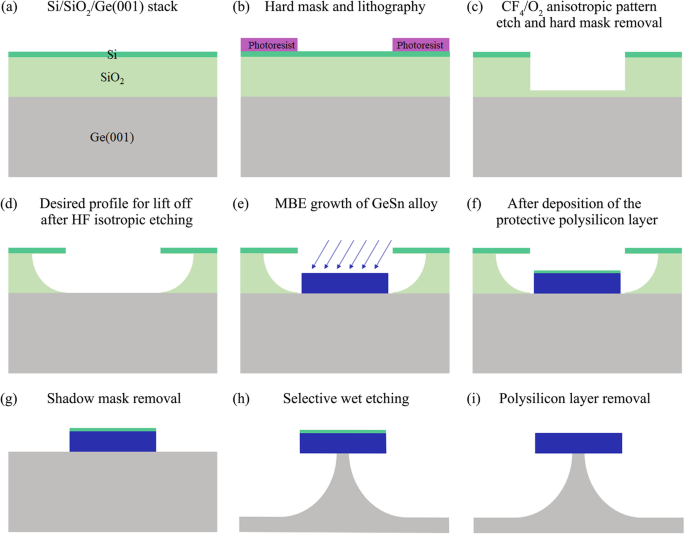
De schematische illustratie van de dwarsdoorsnede voor de fabricage van de gesuspendeerde GeSn-microschijven
In detail, voorafgaand aan het patroon van de Si/SiO2 /Ge wafel, de wafel is schoongemaakt met aceton, ethylalcohol en DI-H2 O, daarna geföhnd met N2 en voorgebakken in een oven op 90 °C. Daarna werd het 30 s spin-coated door AZ5214 fotoresist met behulp van een spin-coater met een snelheid van 4000 r/min en vervolgens op een hete plaat geplaatst voor zacht bakken bij 90 ° C gedurende 2 minuten. De machine voor het maken van platen (Heidelberg, uPG501) werd vervolgens gebruikt om cirkelvormige patroonmatrices te maken op de Si/SiO2 /Ge stapels. De cirkelvormige patronen zijn op 5 m van elkaar gefixeerd, terwijl de diameter varieert van 3 tot 5 m. De patronen werden vervolgens overgebracht naar de onderste SiO2 laag door etsen in twee stappen. Het anisotropische droog etsen door reactief ionen etsen met een gemengd gas van CF4 en O2 werd eerst gebruikt om Si/SiO2 . te etsen lagen en gestopt met ongeveer 20 nm SiO2 links. Vervolgens werd het oplossen van de fotoresist en nat etsen met verdunde HF bij RT ingehuurd om de linker SiO2 te verwijderen laag om zowel het germanium in de cirkelvormige openingen bloot te leggen als ook om lateraal onder de gedefinieerde polysiliciumrand te etsen om een overhang te creëren dat het gewenste profiel is om op te stijgen.
GeSn-groei en fabricage van microschijven
Voor de GeSn dunnefilmdepositie, een solid source MBE-systeem (Riber SSC) met een basisdruk van 2 × 10 −10 Torr werd gebruikt [32]. Een elektronenstraalverdamper en een pyrolytische BN-effusiecel met behulp van zeer zuivere vaste bronnen zijn uitgerust voor Ge- en Sn-verdamping in het MBE-systeem. Een kwartskristalmonitor werd gebruikt om de depositiesnelheid te kalibreren. Voordat de substraten met patroon in het UHV-systeem werden geladen, werden de substraten gereinigd door O2 plasma om alle door droog etsen veroorzaakte organische resten te verwijderen. Gevolgd door spoelen in aceton, isopropylalcohol en verdund HF, werden de substraten overgebracht naar de MBE-kamer voor de GeSn-groei. Na thermische desorptie bij 450 ° C gedurende 15 minuten werden de substraten in situ afgekoeld tot 150 ° C voor de groei van de GeSn-legeringslaag met een Ge-groeisnelheid van 0,5 Å s −1 en een gecontroleerde Sn-flux als de doteringsbron. Deze groeitemperatuur is laag genoeg om de Sn-oppervlaktesegregatie efficiënt te beperken. Om oxidatie te voorkomen, werd uiteindelijk de 10 nm Ge-kaplaag bij dezelfde temperatuur afgezet.
Na de groei zullen GeSn-legeringen met een nominale Sn-concentratie van 4% en 10% worden gebruikt voor de fabricage van microschijven. Een extra 30 nm dikke polysiliciumlaag werd vervolgens op de bovenkant van de monsters bij kamertemperatuur afgezet met behulp van magnetronsputteren om de GeSn-laag te beschermen tegen de volgende etsing. Dan, de offer SiO2 laag werd verwijderd met behulp van verdund HF (1:1), wat ook leidt tot de verwijdering van de overliggende polysiliciumlaag en de daarop afgezette GeSn-film. Zoals te zien is in Fig. 2, werden geïsoleerde cirkelvormige GeSn-mesas onthuld na de SiO2 laag is verwijderd. De omtrek van de cirkelvormige mesa is echter niet zo glad, wat slecht is voor optische begrenzingseffecten. De onverwachte situatie wordt veroorzaakt door de GeSn-afzetting op de rand van de onderste SiO2 laag die ontstaat door onvoldoende laterale etsing van de onderste SiO2 en de afzetting buiten de normale hoek (30°). Vervolgens ondergraaft een eenvoudige stap van selectief nat etsen de cirkelvormige mesa's bij kamertemperatuur, wat resulteert in zwevende GeSn-microschijfstructuren. Het selectieve etsmiddel (APM) bestaat uit H2 O2 (31 gew.%), NH4 OH (28 gew.%) en DI-H2 O met een volumeverhouding van 2:0,5:80 [30]. Ten slotte werd de bovenste beschermende polysiliciumlaag verwijderd door KOH. Een schema van de processtappen wordt getoond in Fig. 1e–i.
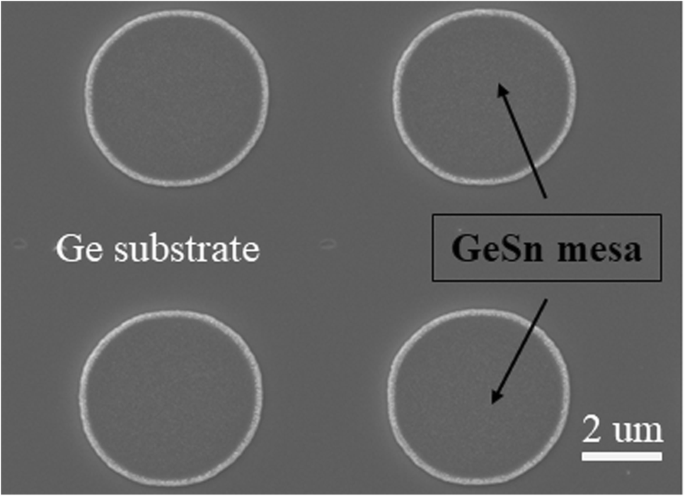
Bovenaanzicht SEM-beeld van geïsoleerde GeSn cirkelvormige mesa's met een diameter van 5 μm na verwijdering van het schaduwmasker
In onze methode om GeSn-microschijven te fabriceren, is het uiteindelijke selectieve natte etsen belangrijk vanwege de verschillende etssnelheden voor de GeSn-materialen met verschillende Sn-concentraties. De etsselectiviteit van Ge over Ge1−x Snx zal ook variëren met de Sn-concentratie. Hoe hoger de concentratie van Sn in GeSn, hoe hoger de oppervlaktedekking van SnOy zal worden ontwikkeld [33]. Het zal de natte etssnelheid van GeSn verminderen en leiden tot een hogere etsselectiviteit van Ge ten opzichte van GeSn. De vorige studie heeft gemeld dat de H2 O2 gebaseerd nat etsen (H2 O2 :NH4 OH:H2 O =2:0,5:80), hetzelfde met dit werk, bereikt een etsselectiviteit van Ge over Ge0,928 Sn0.072 van 9:1 [30].
Resultaten en discussie
Figuur 3a toont de transversale TEM-microfoto van de GeSn-cirkelvormige mesa met een diameter van 5 m zonder de bovenste polysiliciumlaag. Figuur 3b, c zijn de TEM (HRTEM)-microfoto's met hoge resolutie voor de regio's A en B, die respectievelijk overeenkomen met de GeSn/Ge-interface en het middelste gebied van de GeSn-laag. De filmdikte van de GeSn-laag is ongeveer 250 nm (Fig. 3a) onder de dikte van het schaduwmasker. Zoals te zien is in Fig. 3b, zijn defecten voornamelijk gelokaliseerd op het GeSn / Ge-interface met een dikte van 30 nm, wat resulteert in de volgende eenkristal GeSn-groei. Het HRTEM-beeld van regio B toont duidelijke roosterranden van de GeSn-laag, wat aangeeft dat de legering zeer kristallijn is en dat het snelle Fourier-transformatie (FFT) -patroon van regio B goed overeenkomt met het diffractiepatroon van GeSn zoals weergegeven in figuur 3c. Om de Sn-concentratie van de GeSn-legering te bevestigen, werd bovendien de SIMS-meting voltooid zoals weergegeven in de inzet van figuur 3a. De Sn-concentratie is 9,8 ± 0,5%, in overeenstemming met de nominale waarde van ongeveer 10%. Afgezien daarvan is de verdeling van Sn-atomen zeer uniform in het diepteprofiel van de als gegroeide GeSn-film.
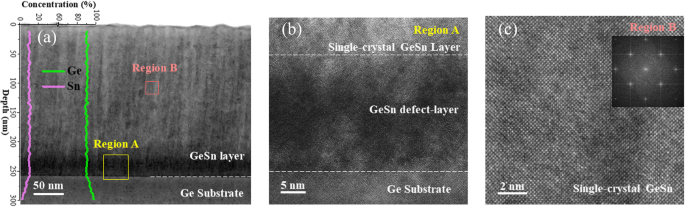
een Dwarsdoorsnede TEM-beeld van de GeSn cirkelvormige mesa met een diameter van 5 m zonder bovenste polysiliciumlaag. Inzet:SIMS-diepteprofiel van de GeSn-laag. b TEM-beeld met hoge resolutie van de GeSn/Ge-interface (regio A). c TEM-afbeelding met hoge resolutie voor het middelste gebied van de GeSn-laag (regio B). Inzet:FFT-patroon van regio B
De oppervlaktestructuur van de monsters werd bestudeerd door SEM. Figuur 4a toont het bovenaanzicht SEM-beeld van de 5 μm diameter Ge0.96 Sn0,04 cirkelvormige mesa's na 510 s selectief nat etsen door APM-oplossing bij kamertemperatuur. Opgemerkt moet worden dat de etsmiddelen vlak voor de experimenten worden bereid om de effecten van veroudering van de chemicaliën te voorkomen. Het SEM-beeld geeft aan dat niet alleen het Ge-substraat, maar ook een deel van de GeSn-mesa is weggeëtst. Het niet vormen van een schijfstructuur voor Ge0.96 Sn0,04 legering is te wijten aan de lage concentratie van Sn, wat resulteert in de lage etsselectiviteit van Ge ten opzichte van GeSn. In tegenstelling tot de Ge0.96 Sn0,04 monsters, werd het GeSn circulaire mesa-monster met een diameter van 5 m met een hogere Sn-concentratie van 9,8% ook geëtst door APM bij kamertemperatuur. Zoals getoond in Fig. 4b, c. c, er zijn met succes microschijfstructuren gevormd voor Ge0.902 Sn0.098 legering na 510 s nat etsen. Eerder hebben Han et al. [30] meldden dat ze gedeeltelijk gesuspendeerde Ge0.928 . maakten Sn0.072 microschijven (5 m in afmeting) met ongeveer 1,2 μm ondersnijding met behulp van de H2 O2 gebaseerd nat etsen met een selectiviteit van 7:1. Na het selectieve natte etsen worden de randen van hun schijf echter gebogen en gebroken vanwege de sterke aantrekkende capillaire krachten die zich ontwikkelen tussen de zwevende structuur en het substraat wanneer de etsvloeistof wordt verwijderd, waardoor de vrijgekomen microschijfstructuur in contact komt met het substraat [ 24]. Maar dit fenomeen doet zich niet voor in onze experimenten, zelfs niet als we het selectieve etsen verlengen om het onderliggende Ge-voetstuk bijna volledig te verwijderen. Het zou kunnen worden verklaard door de hogere etsselectiviteit en de dikkere GeSn-laag van ongeveer 250 nm. Interessant is dat de sokkels onverwachte facetten met verschillende oriëntaties vertonen die kunnen worden veroorzaakt door de oriëntatieafhankelijke laterale etssnelheid tijdens het selectieve natte etsproces.
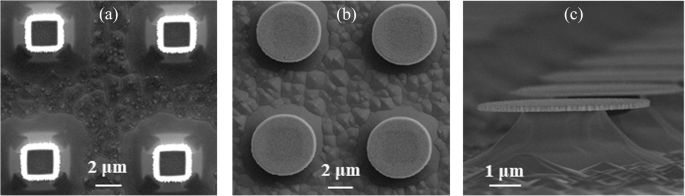
SEM-beelden na selectief nat etsen. een 5 m diameter Ge0,96 Sn0,04 cirkelvormige mesa's na 510 s etsen. b , c 5 m diameter Ge0.902 Sn0.098 cirkelvormige mesa's na 510 s etsen
Bovendien werden de microschijven met Ge-voetstukken van verschillende diameters vervaardigd door de selectieve etstijd te regelen. Figuur 5a toont de diameter van het resterende Ge-voetstuk als functie van de etstijd in APM. De foutbalken vertegenwoordigen de standaarddeviatie van de gegevens van vijf verschillende microschijven in hetzelfde monster. De vergelijkbare lijntendens geeft aan dat de etssnelheid van Ge ongeveer gelijk is voor Ge0,902 Sn0.098 schijven met verschillende diameters van 3 m en 5 μm, en komt overeen met de waarde van de etssnelheid uit Ref. [30]. Bovendien is de minimale diameter van Ge-voetstuk voor staande GeSn-microdisk ongeveer 300 nm. De hangende GeSn-microschijven zullen naar beneden worden getrokken door de sterke aantrekkende capillaire krachten als de Ge-voetstukken kleiner worden.
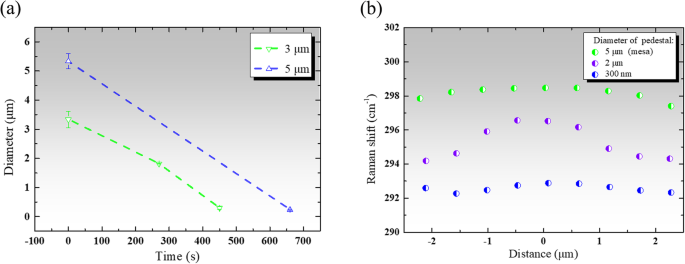
een De diameter van het Ge-voetstuk als functie van de selectieve natte etstijd voor 3 m (groene stippellijn) en 5 μm (blauwe stippellijn) diameters Ge0,902 Sn0.098 schijven. b Raman-verschuivingslijnscanmetingen uitgevoerd langs de diameter van 5 μm Ge0,902 Sn0.098 mesa (groene stip) en microschijven met een Ge-voetstuk met een diameter van 2 μm (paarse stip) en een Ge-voetstuk met een diameter van 300 nm (blauwe stip)
Om de elastische spanningsverdeling van de GeSn-microschijven te onderzoeken, werd μ-Raman uitgevoerd bij kamertemperatuur op schijven met een diameter van 5 m, met behulp van een 633 nm-laser voor excitatie met een vlekgrootte van ongeveer 600 nm. Het laservermogen is slechts 1% van het maximale vermogen (15 mw) om de thermische effecten te minimaliseren [34], en de penetratiediepte van de excitatielaser in de GeSn-films is ongeveer 50 nm [26]. De Raman-verschuiving werd gemeten door de spectra uit te rusten met Lorentz-functies.
Figuur 5b toont de eendimensionale Raman-lijnscans voor Ge0.902 Sn0.098 microstructuren. Het is duidelijk opgemerkt (1) voor de mesa met een diameter van 5 m zonder ondersnijding, de Raman-piek geassocieerd met de Ge-Ge LO-fononmodus verschuift onopvallend naar lagere golfgetallen van het midden naar de rand van de mesa, en de grote Raman-verschuiving geeft aan dat er is een grote drukspanning in de GeSn-mesa; (2) voor de microschijf met een diameter van 5 m en een Ge-voetstuk met een diameter van 2 μm, verschuift de Raman-piek geassocieerd met de Ge-Ge LO-fononmodus duidelijk naar lagere golfgetallen van het midden naar de rand van de schijf, waardoor een spanningsgradiënt wordt onthuld als gevolg van verankering naar het relatief grote Ge-voetstuk. En de 5 m GeSn-microschijf met een voetstuk met een diameter van 2 μm handhaaft nog steeds aan de periferie een zekere mate van drukbelasting; (3) de Ge-Ge-piekposities gemeten langs de diameter van de 5 μm Ge0.902 Sn0.098 microdisk met een Ge-voetstuk met een diameter van 300 nm blijft consistent en heeft een duidelijk verminderde Raman-verschuiving. Daarom wordt verwacht dat de schijven met smalle Ge-voetstukken (ongeveer 300 nm diameter) volledig ontspannen zijn.
In Fig. 6 presenteren we het typische Raman-verstrooiingsspectrum van 5 m diameter Ge0.902 Sn0.098 microschijf met 300 nm diameter Ge voetstuk. Voor de schijven vertonen de Raman-spectra een asymmetrische piek met een frequentie van 292,4 cm −1 overeenkomend met de Ge-Ge LO-modus. De Raman-spectra zoals opgenomen voor de mesa met een diameter van 5 m en het referentiebulk Ge (001) -substraat zijn ook uitgezet ter vergelijking. Merk op dat na onderbieden de Raman-verschuiving (− 6,3 cm −1 ) van de Ge-Ge-piek kan worden waargenomen voor 9,8% Sn-microschijven, aangezien de Raman-frequentieverschuiving in halfgeleiderlegeringen voornamelijk wordt beïnvloed door spanning en samenstelling. Eerdere Raman-onderzoeken [33, 35,36,37] hebben aangetoond dat de Raman-verschuiving van de Ge-Ge LO-fononmodus in GeSn kan worden uitgedrukt als een functie van de Sn-concentratie x Sn en de biaxiale rek in het vlak ε ∥ volgende vgl. (1):

Vergelijking van de Raman-spectra van de 5 μm Ge0.902 Sn0.098 microschijf met 300 nm diameter Ge-voetstuk, 5 μm Ge0.902 Sn0.098 diameter mesa en een bulk Ge-substraat als referentie. Inzet:vergrote weergave van de Raman-spectra. De Ge-Sn-pieken kunnen ook worden waargenomen rond 260 cm −1 , en terugschakelen met het verkleinen van de diameter van Ge-voetstukken
$$ \Delta \omega ={\omega}_{\mathrm{Ge}\mathrm{Sn}}-{\omega}_{\mathrm{Ge}}=\mathrm{A}\cdotp {x}_{ \mathrm{Sn}}+\mathrm{B}\cdotp {\varepsilon}_{\parallel } $$ (1)waar ω GeSn en ω Ge zijn de piekpositie van de Ge-Ge LO fonon-modus in respectievelijk GeSn en in bulk Ge, terwijl A en B coëfficiënten zijn.
De Ge-Ge LO Raman-pieken voor de mesa en schijven tonen de verschuiving van − 1,4 cm −1 en − 7,7 cm −1 vergeleken met de bulk Ge-piek (300,1 cm −1 ). Door de coëfficiënten van eerdere experimentele resultaten [37] te nemen, werd de waarde van de biaxiale kleuring in het vlak ε ∥ wordt berekend op -1,18% voor de als gegroeide GeSn-mesa. Voor de gefabriceerde microschijven, de biaxiale vlek in het vlak ε ∥ is ongeveer gelijk aan 0, wat de bijna volledige spanningsrelaxatie van de microschijven bevestigt. Volgens de recente theoretische berekening van Ge1-x Snx elektronische bandstructuur [38], de as-grown Ge0.902 Sn0.098 laag is een indirect bandgap-materiaal met een bandgap-energie van ongeveer 0,56 eV, terwijl de volledig ontspannen Ge0,902 Sn0.098 microdisk is een direct bandgap-materiaal met een bandgap-energie van 0,50 eV.
Conclusies
Concluderend werden de GeSn-microschijven met succes gefabriceerd door selectieve epitaxiale groei te combineren met een selectief nat etsproces. HRTEM en SEM werden uitgevoerd om te bevestigen dat de GeSn-legering zeer kristallijn is en dat de GeSn-microschijfstructuur gemakkelijk kan worden gevormd door eenvoudig selectief nat etsen. De μ-Raman-metingen laten zien dat de spanningsrelaxatie van de GeSn-microschijf groter zal zijn naarmate de diameter van het Ge-voetstuk kleiner wordt vanwege de gelijktijdig afnemende mechanische belasting van het kleinere Ge-voetstuk. En tot slot werden de hoogwaardige en volledig spanningsrelaxerende GeSn-microschijven bereikt door deze meer kosteneffectieve methode. Het fabricageproces is ook een veelbelovende methode om kleinere GeSn-mesa-afmetingen te bereiken totdat het laterale kwantumafmetingseffect belangrijk wordt, en om andere GeSn-nanostructuren zoals GeSn-quantumdots, GeSn-nanomesh en GeSn-nanodraden te verkrijgen voor toekomstige Si-compatibele fotonische en elektronische apparaattoepassingen.
Beschikbaarheid van gegevens en materialen
De gegevens die de bevindingen van dit werk ondersteunen, zijn op redelijk verzoek verkrijgbaar bij de corresponderende auteur.
Afkortingen
- APM:
-
Ammoniakperoxide mengsel (nat etsmiddel)
- FFT:
-
Snelle Fourier-transformatie
- HRTEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- MBE:
-
Moleculaire bundelepitaxie
- PECVD:
-
Plasma-versterkte chemische dampafzetting
- RT:
-
Kamertemperatuur
- SEM:
-
Scanning elektronenmicroscopie
- SIMS:
-
Secundaire ionenmassaspectrometrie
- μ-Raman:
-
Micro-Raman-spectroscopie
Nanomaterialen
- Java abstracte klasse en abstracte methoden
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- Vervaardiging van SrGe2 dunne films op Ge (100), (110) en (111) substraten
- Vervaardiging, karakterisering en biologische activiteit van avermectine nano-afgiftesystemen met verschillende deeltjesgroottes
- Recente ontwikkelingen in synthetische methoden en toepassingen van zilveren nanostructuren
- Vervaardiging en karakterisering van ZnO-nanoclips door het door polyol gemedieerde proces
- Vervaardiging van CA/TPU spiraalvormige nanovezels en de mechanisme-analyse
- Fabrikatie en fotokatalytische eigenschap van nieuwe SrTiO3/Bi5O7I nanocomposieten
- Het groeimechanisme van GaN epitaxiale lagen op mechanisch geëxfolieerd grafiet begrijpen
- Controlebare fabricage van niet-close-packed colloïdale nanodeeltjesarrays door ionenstraaletsen
- Laseretsen en lasergraveren



