Hoge doorslagspanning en lage dynamische AAN-weerstand AlGaN/GaN HEMT met fluorionenimplantatie in SiNx-passiveringslaag
Abstract
In deze studie hebben we een hoge doorslagspanning (BV) en een lage dynamische AAN-weerstand (R) voorgesteld en experimenteel aangetoond. AAN, D ) AlGaN/GaN-transistor met hoge elektronenmobiliteit (HEMT) door fluorionen te implanteren in het dikke SiNx passiveringslaag tussen de gate- en drain-elektroden. In plaats van de fluorionenimplantatie in de dunne AlGaN barrièrelaag, zijn de piekpositie en vacatureverdelingen ver verwijderd van het tweedimensionale elektronengas (2DEG) kanaal in het geval van fluorionenimplantatie in de dikke passiveringslaag, die effectief de directe onderdrukking van de directe huidige (DC) statische en gepulste dynamische karakteristieke degradatie. De fluorionen in de passiveringslaag verlengen ook het uitputtingsgebied en verhogen de gemiddelde sterkte van het elektrische veld (E-veld) tussen de poort en de afvoer, wat leidt tot een verbeterde BV. De BV van de voorgestelde HEMT neemt toe tot 803 V van 680 V van de conventionele AlGaN/GaN HEMT (Conv. HEMT) met dezelfde dimensionale parameters. De gemeten R AAN, D van de voorgestelde HEMT wordt slechts met 23% verhoogd bij een rustinstelling met hoge afvoer van 100 V, terwijl de R AAN, D van de HEMT met implantatie van fluorionen in de dunne AlGaN-barrièrelaag wordt met 98% verhoogd.
Achtergrond
In de afgelopen decennia zijn nieuwe halfgeleidermaterialen, zoals GaN, metaaloxiden en 2D-materialen, uitgebreid bestudeerd om de energieconversie en opslagefficiëntie verder te verbeteren, dankzij hun superieure materiaal- en apparaateigenschappen [1,2,3,4, 5,6,7,8]. Onder hen zijn op GaN gebaseerde AlGaN/GaN-transistors met hoge elektronenmobiliteit (HEMT's) goede kandidaten voor toepassingen met hoog vermogen, hoge frequentie en laag verlies vanwege het hoge kritische doorslagveld en de hoge elektronenmobiliteit [9,10,11,12,13 ,14]. De doorslagspanning (BV) is een van de belangrijkste ontwerpdoelen en de gerapporteerde waarden liggen nog steeds ver onder de theoretische limiet [15, 16]. Daarom is het van groot belang om de BV verder te verbeteren, vooral niet ten koste van het vergroten van de apparaatgrootte. Er zijn verschillende terminatietechnieken voorgesteld om de BV te verbeteren, zoals veldplaat [17,18,19], fluorionenimplantatie [20,21,22] en verzonken gate-edgeterminatie [23, 24]. Fluorionen geïmplanteerd in de dunne AlGaN-barrièrelaag (FBL) [22] heeft een eenvoudig fabricageproces zonder een extra parasitaire capaciteit te induceren; de piekpositie van het fluorprofiel en de leegstandsverdelingen ligt echter dicht bij het tweedimensionale elektronengas (2DEG) kanaal, wat onvermijdelijk een aanzienlijke degradatie van statische en dynamische kenmerken zou veroorzaken.
In dit werk wordt een hoge doorslagspanning en een lage dynamische AAN-weerstand (R AAN, D ) AlGaN/GaN HEMT met implantatie van fluorionen in de SiNx passiveringslaag (FPL HEMT) wordt experimenteel onderzocht. In tegenstelling tot de implantatie van fluorionen in de dunne AlGaN-barrièrelaag, kan implantatie van fluorionen in de dikke passiveringslaag de piekpositie van fluor- en vacatureverdelingen ver weg houden van het 2DEG-kanaal, waardoor de degradatie van statische en dynamische kenmerken effectief wordt onderdrukt . Fluorionen in de passiveringslaag als terminatietechniek worden ook gebruikt om de verdeling van het elektrisch veld aan het oppervlak (E-veld) te optimaliseren, waardoor een verbeterde BV wordt bereikt. Kortom, de FPL HEMT vertoont uitstekende statische eigenschappen en dynamische eigenschappen.
Vervaardigingsmethoden
Afbeelding 1 is het driedimensionale schema van FPL HEMT, FBL HEMT en Conv. HEMT, respectievelijk. Alle apparaten hebben een poortlengte L G van 2,5 m, een gate-source afstand L GS van 1,5 m en een gate-drain afstand L GD van 10 urn. De epitaxiale AlGaN / GaN-heterostructuur die werd gebruikt voor het vervaardigen van de FPL HEMT werd gekweekt op 6-in (111) siliciumsubstraat door metaal-organische chemische dampafzetting (MOCVD). De epitaxiale lagen bestaan uit een 2-nm GaN-kap, 23-nm Al0,25 Ga0,75 N-barrière, 1-nm AlN-tussenlaag, 150-nm GaN-kanaal en 3,5-μm GaN-buffer. De gemeten dichtheid en mobiliteit van het Hall-effect van de 2DEG was 9,5 × 10 12 cm −2 en 1500 cm 2 /V s, respectievelijk. De voorgestelde FPL HEMT begon met mesa-isolatie die werd geïmplementeerd door een krachtige Cl2 /BCl3 etsen op basis van inductief gekoppeld plasma (ICP). Vervolgens werd een 40 nm dikke lage druk chemische dampafzetting (LPCVD) SiNx laag werd afgezet bij 780 °C/300 mTorr met een NH3 stroom van 280 sccm en een SiH2 Cl2 stroom van 70 sccm, wat een afzettingssnelheid van 3,7 nm/min oplevert. De brekingsindex wordt gemeten met een ellipsometer als 1.978, en de N/Si-verhouding van SiNx bedraagt 1,31 [25]. De kristalliniteit van LPCVD SiNx is amorf, wat wordt bevestigd door een hoge resolutie transmissie-elektronenmicroscoop (HR-TEM) microfoto (zie de inzet van figuur 1a). Na het openen van de contactvensters voor bron en afvoer door SF6 plasma droog etsen, het Ti/Al/Ni/Au (20/150/45/55 nm) ohmse contact werd gedeponeerd en gegloeid bij 890 °C gedurende 30 s in N2 omgeving. De contactweerstand van 1 Ω mm en de plaatweerstand van 400 Ω/vierkant werden geëxtraheerd met de lineaire transmissielijnmethode. Vervolgens wordt de gate-metaalelektrode gevormd door Ni/Au (50 nm/150 nm) depositie- en lift-off-proces. Vervolgens wordt het fluorionenimplantatievenster (Length of window = 3 μm) gevormd door AZ5214 fotoresist, en fluorionen werden geïmplanteerd door SEN NV-GSD-HE ionimplanter met een energie van 10 keV bij een dosis van 1 × 10 12 cm −2 . Ten slotte werden de monsters gegloeid bij 400 °C gedurende 15 min in N2 ambient om de fabricagestroom van de transistor te voltooien [26].
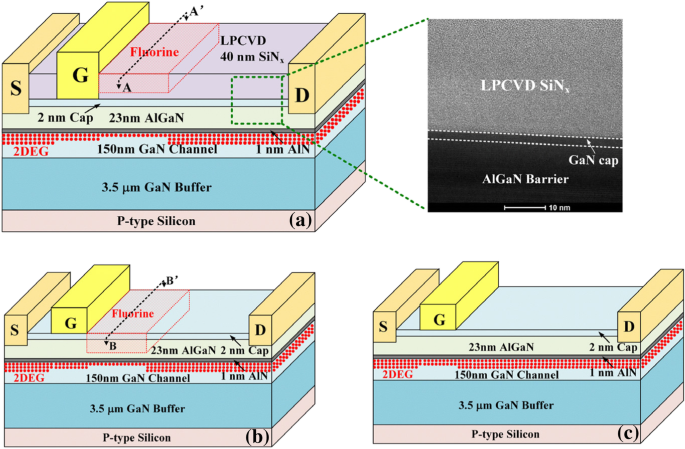
Driedimensionaal schema van a FPL HEMT (inzet:HR-TEM-microfoto van LPCVD SiNx ), b FBL HEMT en c conv. HEMT
Resultaten en discussie
Afbeelding 2 toont het gemeten secundaire ionenmassaspectroscopieprofiel (SIMS) van de fluorionconcentratie en de gesimuleerde leegstandsconcentratie door TRIM langs de snijlijnen:(a) A-A′ van FPL HEMT en (b) B-B′ van respectievelijk FBL HEMT. Bij dezelfde energie en dosis fluorionenimplantatie is de gemeten piekpositie vanaf het oppervlak en de maximale concentratie van het fluorprofiel bijna hetzelfde voor de twee structuren. In het geval van de implantatie van fluorionen in de dunne AlGaN-barrièrelaag, strekken de door fluor geïnduceerde vacatures zich uit tot het 2DEG-kanaalgebied. De verdeling van de leegstandsconcentratie is bij elk grensvlak discontinu omdat de bindingsenergie van elk materiaal anders is [27]. In het geval van de implantatie van fluorionen in het dikke SiNx passiveringslaag, de leegstandsverdeling bevindt zich binnen de SiNx passiveringslaag en ver van het 2DEG-kanaal. De vacatures die worden veroorzaakt door ionenimplantatie zouden het 2DEG-kanaal opsluiten, en 2DEG zou gemakkelijk kunnen worden opgesloten als de vacatureverdeling dicht bij de 2DEG ligt [28]. Concluderend, implantatie van fluorionen in het dikke SiNx passiveringslaag zou de invloed van ionenimplantatie op het 2DEG-kanaal aanzienlijk kunnen verminderen en de degradatie van statische en dynamische kenmerken effectief kunnen onderdrukken.

Gemeten SIMS-profiel van fluorionenconcentratie en gesimuleerde leegstandsconcentratie door TRIM langs de snijlijnen. een A-A′. b B-B′
Afbeelding 3 verlicht de gemeten I-V overdrachtskarakteristieken en gelijkstroom (DC) uitgangskarakteristieken. Vergeleken met de Conv. HEMT, zowel de FPL HEMT als de FBL HEMT laten een afname zien van I DS en een toename van de statische AAN-weerstand (R AAN ), omdat de fluorionen de geassisteerde uitputting van de 2DEG in het driftgebied veroorzaken en zo de 2DEG-dichtheid verlagen [29]. Bovendien vermindert de ionenimplantatie ook de 2DEG-mobiliteit. Het Hall-effect gemeten 2DEG-mobiliteiten van de FPL en FBL HEMT's zijn 228 cm 2 /V s en 203 cm 2 /V s na ionenimplantatie, respectievelijk. Door dezelfde dosis fluorionen, de outputkarakteristieken en R AAN van FPL HEMT en FBL HEMT zijn bijna hetzelfde bij een lage afvoerspanning (bijv. V DS < 3 V). Echter, wanneer V DS> 3 V, de instorting van de verzadigingsafvoerstroom vindt plaats in de FBL HEMT, omdat het vacatureprofiel van fluor zich uitstrekt tot het 2DEG-kanaalgebied, en de 2DEG kan gemakkelijk worden gevangen door deze diepe vacatures die worden veroorzaakt door fluor wanneer de afvoerspanning groot is dan kritisch afvoerspanning (bijv. V DS> 3 V) [30], waardoor de afvoerstroom afneemt. De leegstandsverdeling van FPL HEMT is verre van het 2DEG-kanaal, waardoor de verzadigingsafvoerstroom effectief wordt onderdrukt.

Gemeten a I-V overdrachtskenmerken, en b DC-uitgangskarakteristieken voor drie HEMT's
Afbeelding 4 toont de gemeten I-V karakteristieken en gesimuleerde oppervlakte E-veldverdelingen in de blokkerende toestand. De BV's van de FPL/FBL/Conv. HEMT's zijn respectievelijk 803/746/680 V. De BV wordt gedefinieerd als de afvoer-bronspanning bij de afvoerstroom (I DS ) van 1 μA/mm met V GS =4 V De fluorionen tussen de poort en afvoer als een terminatietechniek verminderen de E-veldpiek aan de poortrand en veroorzaken een nieuwe E-veldpiek aan het einde van het ionenimplantatiegebied, en dus FPL HEMT en FBL HEMT bereikt een meer uniforme E-veldverdeling aan het oppervlak en een hogere BV dan die van de Conv. HEMT. Vergeleken met FPL HEMT heeft FBL HEMT een verbeterd elektrisch veldmodulatie-effect, omdat het fluorionenprofiel zich dicht bij het 2DEG-kanaal bevindt. Voor de FBL HEMT zou ionenimplantatie echter onvermijdelijk extra schade veroorzaken in de AlGaN-barrière [31, 32], wat leidt tot een continu poortlekstroompad van poortbarrièrelaag-2DEG; daarom is de BV van FBL HMET iets kleiner dan die van de FPL HEMT.

een Gemeten buiten de staat I-V kenmerken met een poortspanning van −4 V, waardoor het substraat drijvend blijft. b Gesimuleerde oppervlakte E-veldverdelingen bij V DS = 150 V
Gepulseerd I DS -V DS metingen [33] onder langzaam schakelen werden uitgevoerd om het gedrag van dynamische AAN-weerstand te karakteriseren (R AAN, D ) van de gefabriceerde AlGaN/GaN HEMT's. Figuur 5a is het schema dat de toepassing van spanningsspanning weergeeft tijdens de gepulseerde I DS -V DS afmetingen. In gepulseerde I-V metingen werden de poort- en afvoerelektroden van de GaN HEMT's onderworpen aan korte spanningspulsen voor elke I-V meting om er zeker van te zijn dat de apparaten zich in de uitgeschakelde toestand bevonden. De pulsbreedte is 3 ms en de periode is 5 ms. Figuur 5 b–d toont de vergelijking van de gepulseerde uitgangskarakteristieken van de apparaten onder (V GS0 , V DS0 ) van (0 V, 0 V) en (0 V, 100 V). Het is te zien dat er een geringste degradatie (12,3%) van de dynamische AAN-weerstand is voor de Conv. HEMT, vanwege de afwezigheid van het implantatieproces van fluorionen. In vergelijking met FBL HEMT heeft FPL HEMT een lage degradatie van dynamische ON-weerstand. Door de passiveringslaag is de leegstandsverdeling ver weg van het 2DEG-kanaal en bevindt deze zich binnen de passiveringslaag, waardoor de ladingvangst in de FPL HEMT wordt onderdrukt. Afbeelding 6 geeft een samenvatting van de verhoudingswaarden van R AAN, D /R AAN voor de drie HEMT's onder (V GS0 , V DS0 ) van (0 V, 0 V) en (0 V, 100 V) in een stap van 20 V. Voor de FBL HEMT is de gemeten R AAN, D is al verhoogd met 98% van de statische waarde bij (V GS0 , V DS0 ) van (0 V, 0 V) en (0 V, 100 V), terwijl de R AAN, D van de FPL HEMT wordt met slechts 23% verhoogd bij een rustinstelling voor hoge afvoer van 100 V.
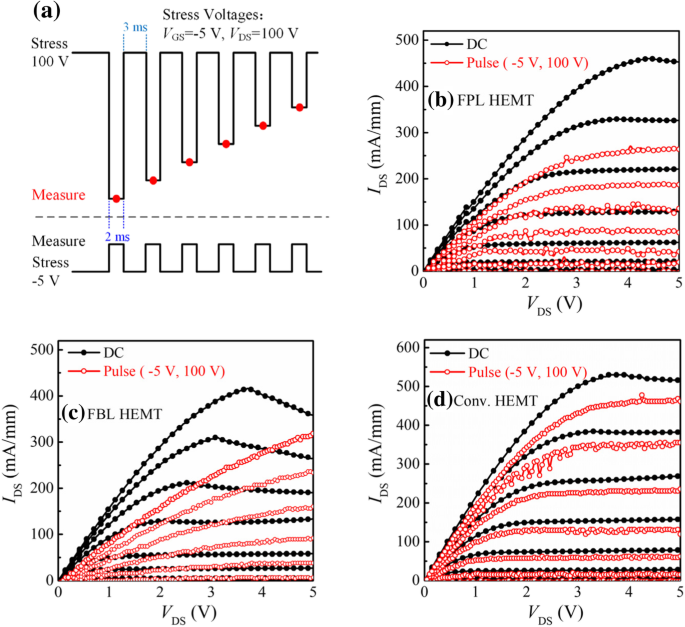
een Schematische weergave van de toepassing van spanningsspanning tijdens de gepulseerde I DS -V DS afmetingen. Gepulseerd I DS -V DS kenmerken van de gefabriceerde AlGaN/GaN HEMT's met b FPL HEMT, c FBL HEMT en d conv. HEMT (V GS = − 4~0 V; stap:0,5 V)
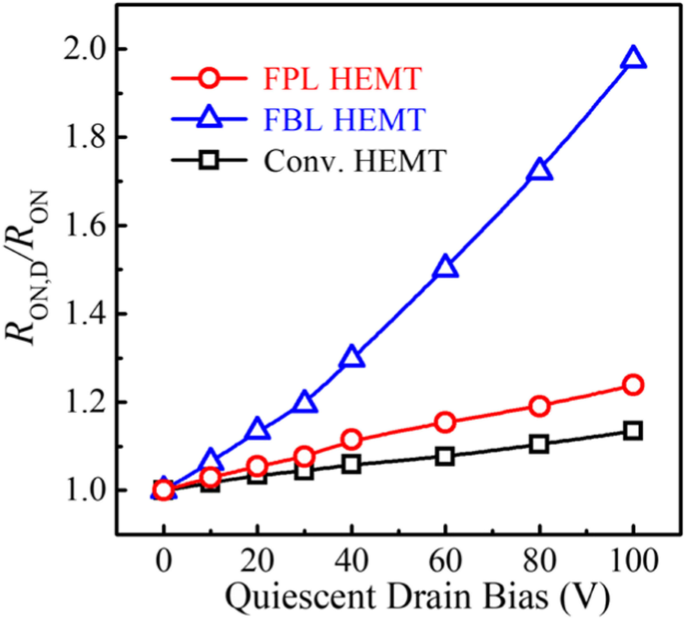
Verhouding van R AAN, D /R AAN voor de gefabriceerde HEMT's op verschillende rustige afvoerbiaspunten. De pulsduur en periode zijn respectievelijk 3 ms en 5 ms
Conclusies
Concluderend hebben we een nieuwe AlGaN/GaN HEMT voorgesteld met een hoge doorslagspanning en een lage dynamische AAN-weerstand. Het beschikt over fluorionenimplantatie in het dikke SiNx passiveringslaag. De implantatie van fluorionen in de passiveringslaag zou de degradatie van elektrische kenmerken effectief kunnen onderdrukken. De dynamische AAN-weerstand is slechts 1,23 keer zo groot als de statische AAN-weerstand na off-state V DS spanning van 100 V, terwijl het 1,98 keer is voor de FBL HEMT. Bovendien moduleren de fluorionen in de passiveringslaag ook de E-filed-verdeling en verspreiden ze het uitputtingsgebied; dus neemt de BV van de voorgestelde HEMT toe tot 803 V van 680 V van conventionele AlGaN/GaN HEMT.
Beschikbaarheid van gegevens en materialen
Alle gegevens die tijdens dit onderzoek zijn gegenereerd of geanalyseerd, zijn opgenomen in dit gepubliceerde artikel.
Afkortingen
- 2DEG:
-
Tweedimensionaal elektronengas
- HEMT:
-
Transistor met hoge elektronenmobiliteit
- ICP:
-
Inductief gekoppeld plasma
- LPCVD:
-
Chemische dampafzetting onder lage druk
- MOCVD:
-
Metaal organische chemische dampafzetting
- SIMS:
-
Secundaire ionenmassaspectroscopie
- TEM:
-
Transmissie-elektronenmicroscoop
Nanomaterialen
- Wat is storingsonderhoud en hoe ermee om te gaan
- Impact van oppervlaktetoestanden en aluminiummolfractie op oppervlaktepotentiaal en 2DEG in AlGaN/GaN HEMT's
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- RGO en driedimensionale grafeennetwerken hebben TIM's samen gemodificeerd met hoge prestaties
- Grafeen/polyaniline-aerogel met superelasticiteit en hoge capaciteit als zeer compressietolerante supercondensatorelektrode
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
- Atomic Layer-Deposited HfAlOx-Based RRAM met lage bedrijfsspanning voor computertoepassingen in het geheugen
- Ultra-lage specifieke weerstand laterale dubbel-diffuus metaaloxide-halfgeleidertransistor met verbeterde dubbele poort en gedeeltelijk P-begraven laag
- Een nanoschaal low-power weerstandloze spanningsreferentie met hoge PSRR
- Een uiterst nauwkeurige AlGaN/GaN Reverse Blocking CRD (RB-CRD) met hybride sleufkathode
- PCB-materialen en ontwerp voor hoogspanning



