Ge pMOSFET's met GeOx-passivering gevormd door ozon en plasma postoxidatie
Abstract
Een vergelijkend onderzoek naar de elektrische prestaties van Ge pMOSFET's met een GeOx passiveringslaag gevormd door ozon na oxidatie (OPO) en plasma na oxidatie (PPO) wordt uitgevoerd. PPO en OPO werden uitgevoerd op een Al2 O3 /n-Ge (001) substraat gevolgd door een 5-nm HfO2 poortdiëlektricum in situ afgezet in een ALD-kamer. De kwaliteit van de diëlektrische/Ge-interfacelaag werd gekarakteriseerd door röntgenfoto-elektronenspectroscopie en transmissie-elektronenmicroscopie. De PPO-behandeling leidt tot een positieve drempelspanning (V TH ) shift en een lagere I AAN /Ik UIT verhouding, wat een slechte interfacekwaliteit impliceert. Ge pMOSFET's met OPO vertonen een hogere I AAN /Ik UIT ratio (tot vier ordes van grootte), verbeterde subthreshold swing en verbeterde carrier-mobiliteitskenmerken in vergelijking met PPO-apparaten. Een dikkere Al2 O3 bloklaag in het OPO-proces leidt tot een hogere mobiliteit in Ge-transistors. Door twee verschillende oxidatiemethoden te vergelijken, laten de resultaten zien dat de OPO een effectieve manier is om de kwaliteit van de interfacelaag te verhogen, wat bijdraagt aan de verbeterde effectieve mobiliteit van Ge pMOSFET's.
Achtergrond
Met conventionele complementaire metaal-oxide-halfgeleider (CMOS)-apparaten die hun fysieke limiet naderen, is prestatieverbetering moeilijk te realiseren voor high-speed halfgeleiderapparaten met silicium (Si) als kanaalmateriaal. Het vervangen van substraat of kanaalmateriaal door ander materiaal met een hoge mobiliteit is een noodzakelijke optie. Germanium (Ge) wordt beschouwd als een veelbelovend alternatief kanaalmateriaal vanwege de grotere mobiliteit van de drager dan die van Si. De MOSFET heeft meestal een hoogwaardige oxide/halfgeleiderinterface nodig om een hoge effectieve mobiliteit te bereiken. Gedurende een vrij lange geschiedenis hadden Ge MOSFET's echter te lijden van de hoge interfacetoestandsdichtheid (D het ) veroorzaakt door de slechte thermische stabiliteit van GeO2 en bungelende banden [1]. Er is dus veel onderzoek gedaan naar passivering van de Ge-interface.
Er zijn verschillende benaderingen beschreven voor het bereiken van een hoogwaardige Ge/diëlektrische interfacelaag, zoals Si-passivering door het uniform afzetten van verschillende Si-monolagen op Ge-substraat vóór diëlektrische epitaxie of zelfpassivering door GeO2 te vormen met opzet [2, 3]. Om een hoogwaardige GeO2 . te vormen laag, zijn er veel oxidatieprocessen om D . te verminderen het en de thermische stabiliteit verbeteren, waaronder oxidatie onder hoge druk [4], ozonoxidatie [5], H2 O plasma [6], en elektronen cyclotron resonantie (ECR) plasma na oxidatie [7].
In de afgelopen jaren zijn er tal van werken gerapporteerd dat hoogwaardige Ge MOSFET kan worden gerealiseerd door postoxidatie via Al2 O3 /Ge-interface. In 2014 werd een Ge CMOS-omvormer gerealiseerd op een Ge-on-isolator (GeOI) substraat met GeOx gegroeid door snel thermisch gloeien in zuivere zuurstofomgeving na 1 nm Al2 O3 werd gedeponeerd op Ge [8]. In ref. [7], Ge pMOSFET's en nMOSFET's met GeOx passivering werden gefabriceerd met zuurstofplasma na oxidatie en temperatuurafhankelijkheid van GeOx dikte en elektrische prestaties werden ook besproken. Thermische oxidatie van Ge door ozon kan bij een lagere temperatuur worden uitgevoerd, omdat ozon reactiever is dan zuurstof [5]. De impact van temperatuur op GeOx dikte gegroeid door ozon op Ge-oppervlak werd aangetoond. Ge pMOSFET's met GeOx passivering gefabriceerd door ozon na oxidatie werd ook gerapporteerd [9].
In dit werk, Ge pMOSFET's met GeOx passivering worden vervaardigd met behulp van ozon na oxidatie (OPO) en zuurstof plasma na oxidatie (PPO) van de Al2 O3 /n-Ge-interface. Er wordt een vergelijkend onderzoek uitgevoerd naar de elektrische prestaties van Ge pMOSFET's met OPO en PPO. Alle processen behalve passivering worden nauwkeurig gecontroleerd om hetzelfde te zijn. De post-oxidatie werd uitgevoerd na de Al2 O3 bloklaagafzetting die verschilt van [9] waarin de postoxidatie plaatsvond na HfO2 afzetting. Het mobiliteitsdegeneratiemechanisme van Coulomb en ruwheidsverstrooiing wordt onderzocht. De impact van de dikte van de Al2 O3 bloklaag op apparaatprestaties wordt ook besproken. Over het algemeen laten we zien dat OPO een veelbelovende passiveringstechniek is voor toekomstige fabricage van Ge MOSFET.
Methoden
Ge pMOSFET's werden gefabriceerd op 4-in. n-Ge (001) wafels met een soortelijke weerstand van 0,14-0,183 Ω cm. Er werden drie verschillende passiveringsprocessen uitgevoerd en de belangrijkste processtappen worden getoond in Fig. 1a. De wafels werden gereinigd met verdund HF (1:50) en gedeïoniseerd water gedurende verschillende cycli om het natieve oxide te verwijderen en vervolgens onmiddellijk overgebracht naar een met plasma versterkte atoomlaagafzetting PEALD (Picosun R200 Advanced) kamer. Dan een dunne Al2 O3 film (~ 1 nm) werd afgezet bij 300 °C met trimethylaluminium (TMA) en gedeïoniseerd water (H2 O) als de voorlopers van respectievelijk Al en O. Omdat de Al2 O3 /GeO2 laag is te dun om een nauwkeurige zuurstofatoomverhouding te hebben, hebben we deze twee lagen gemarkeerd als AlOx /GeOx . PPO werd gedurende 60 s uitgevoerd met de Litmas-plasmabron op afstand. Een ozongenerator (IN USA AC-serie ozongeneratoren) met een zuurstoftoevoer van 750 sccm werd gebruikt voor de OPO-behandeling in 50% O3 /O2 omgeving. Zonder het vacuüm te verbreken, 60 cycli HfO2 werd vervolgens afgezet op de top van AlOx /GeOx na PPO- of OPO-behandeling bij 300 °C met tetrakis-dimethylaminohafnium (TDMAHf) en H2 O als de voorlopers van respectievelijk Hf en O. Een TaN van 100 nm werd vervolgens afgezet door reactief sputteren als poortmetaal. Na poortpatronen en etsen, zelf-uitgelijnde BF 2+ implantatie in source/drain (S/D)-regio's met een energie van 20 keV en een dosis van 1 × 10 15 cm − 2 is uitgevoerd. Een 20-nm Ni S/D-metaal werd afgezet en van een patroon voorzien door middel van een lift-off-proces. Ten slotte werd snel thermisch gloeien bij 450 °C gedurende 30 s gevolgd voor doteringsactivering en S/D ohms contact. De schematische en microscopiebeelden van de gefabriceerde Ge pMOSFET's worden respectievelijk getoond in Fig. 1b en c.
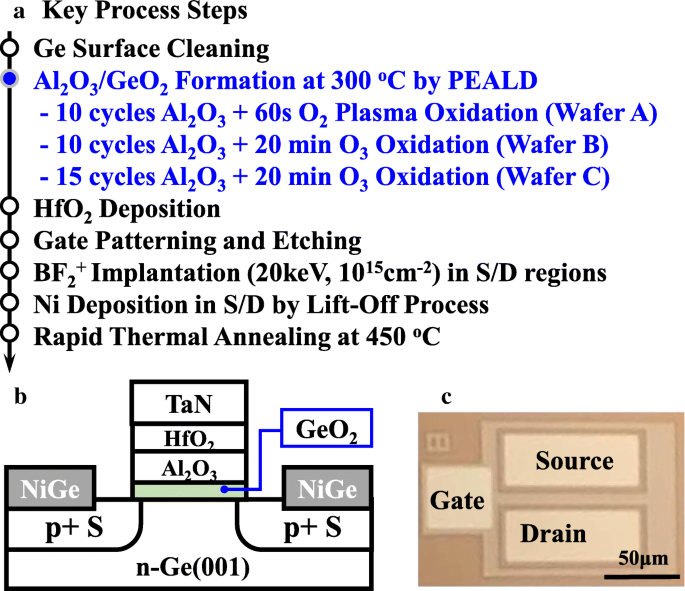
een Belangrijkste processtroom voor het fabriceren van Ge pMOSFET's met GeO2 oppervlaktepassivering met drie verschillende passiveringsmethoden. b Schematisch en c microscoopbeelden van de gefabriceerde Ge-transistor
De doorsnede van TaN/HfO2 /AlOx /GeOx /Ge-poortstapel werd afgebeeld met behulp van een transmissie-elektronenmicroscoop (TEM) om de impact van zuurstofplasma of ozon op GeOx te vergelijken vorming. Afbeelding 2a en b tonen de transversale TEM-afbeeldingen van TaN/HfO2 /AlOx /GeOx /Ge gate-stack met respectievelijk PPO en OPO. De dikte van de amorfe HfO2 laag in beide apparaten is 6 nm. Wafer A met 60s PPO-behandeling heeft een duidelijke AlOx /GeOx laag tussen de HfO2 en Ge-substraten. Deze AlOx /GeOx laag in wafer B gevormd door 20 min OPO heeft een slordige marge. De dikte van de GeOx laag is in overeenstemming met de gegevens in [10].
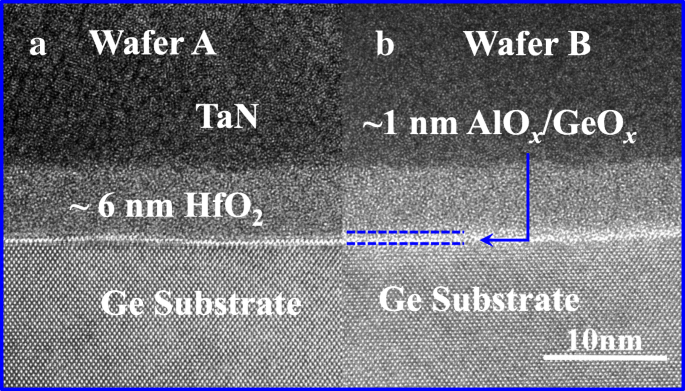
Transversale TEM-afbeeldingen van de high-k/metal gate-stack met een AlOx /GeOx grensvlaklaag (IL) vervaardigd door a OPO en b PPO op een n-Ge (001) kanaal
Resultaten en discussie
De uitgangs- en overdrachtskarakteristieken in combinatie met hoogfrequente gate-to-source capaciteitsspanning (CV) werden gemeten door Keithley 4200-SCS. Afbeelding 3 toont de vergelijking van de overdracht- en uitvoerkarakteristiek van Ge pMOSFET's met drie verschillende vormingsomstandigheden van de AlOx /GeOx passiveringslaag. Alle apparaten op verschillende wafers hebben een poortlengte (L G ) van 3 m. Apparaten op wafer A vertonen een hogere verzadigde afvoerstroom (I DS ) vergeleken met de andere twee wafels. Maar wafers B en C met OPO vertonen een veel lagere stroom in de UIT-status (I UIT ) vergeleken met wafer A met PPO. Het is ook te zien dat wafels B en C met OPO in de verbeteringsmodus werkten en dat wafel A in de uitputtingsmodus werkte. Er wordt geconcludeerd dat, na PPO-behandeling, het n-Ge-oppervlak nog steeds p-type is vanwege de hoge D het waarde die is besproken in [11]. Wafer C met een dikkere Al2 O3 bloklaag toont een positieve V TH verschuiving vergeleken met wafer B en een hogere D het dan wafer B. Uit de uitgangskarakteristieken getoond in Fig. 3b blijkt dat onder een lage poortspanning (V GS ), heeft wafer A een lagere I DS over wafers B en C vanwege de minder steile subthreshold swing (SS). Wanneer de V GS neemt toe, ik DS van wafer A wordt hoger in vergelijking met de andere twee apparaten. Daarom is uit Fig. 3 en TEM-afbeeldingen in Fig. 2 de diffusie van de AlOx /GeOx laag kan de I . onderdrukken UIT , wat resulteert in een verbetering van de passiveringseffecten.
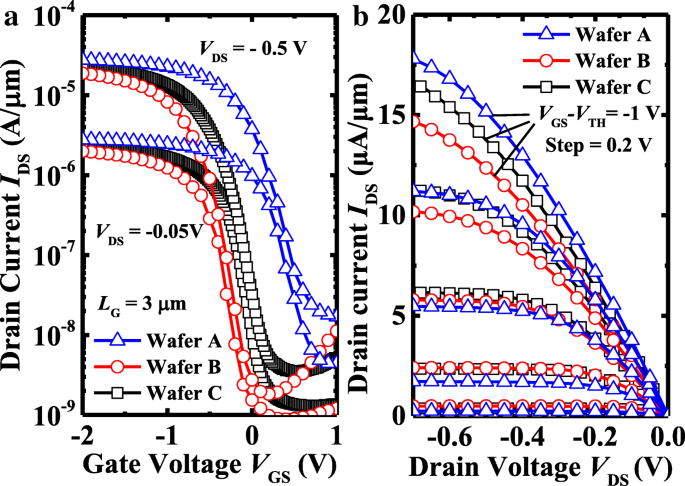
een Ik DS –V GS en b Ik DS –V DS kenmerken van Ge pMOSFET's met een Al2 O3 /GeO2 passiveringslaag vervaardigd door PPO (wafer A) en OPO (wafers B en C)
Afbeelding 4 geeft een overzicht van de statistische resultaten van de I AAN /Ik UIT ratio en subthreshold swing van de apparaten op verschillende wafers. Ge pMOSFET's met OPO vertonen een hogere I AAN /Ik UIT verhouding (~ 4 ordes van grootte) en opmerkelijk verbeterde SS in vergelijking met PPO-apparaat, wat wijst op een hogere kwaliteit van de diëlektrische / kanaalinterface. In vergelijking met wafer B vertoont wafer C een hogere ON-state stroom (I AAN ) maar een lagere I AAN /Ik UIT verhouding.
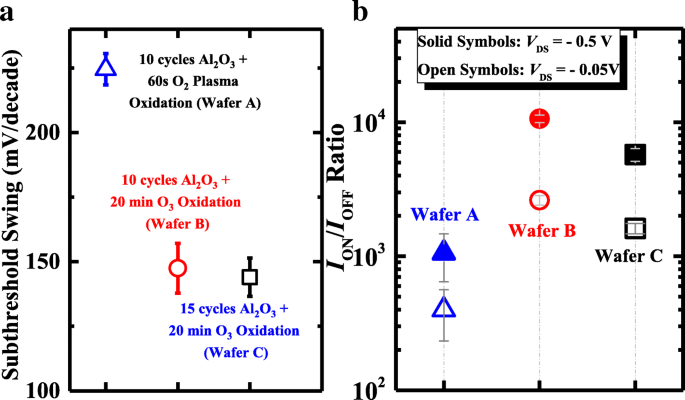
Statistische plots van a SS en b Ik AAN /I UIT verhouding voor Ge pMOSFET's met verschillende passiveringsomstandigheden
Om de kwaliteit van de grenslaag van verschillende post-oxidatiemethoden verder weer te geven, wafels A, B en C (dummy-monsters zonder HfO2 en Gate-metalen) werden getest met röntgenfoto-elektronspectroscopie (XPS). XPS-meting werd uitgevoerd op drie post-oxidatie dummy-monsters na PPO- of OPO-behandeling zonder HfO2 afzetting en TaN-sputteren. De stoichiometrie van GeOx in Al2 O3 /GeO/Ge-monsters werden onderzocht met een monochromatische zachte Al Kα (1486,6 eV) röntgenbron. Ge 3d pieken en piek-differentiërende analyse worden getoond in Fig. 5. De Ge 3d 5/2 piek van de drie monsters is verenigd bij 29,7 eV, en de chemische verschuivingen van Ge 3d 3/2 , Ge 1+ , Ge 2+ , Ge 3+ , en Ge 4+ naar Ge 3d 5/2 zijn ingesteld op respectievelijk 0,6, 0,8, 1,8, 2,75 en 3,4 eV [12]. In figuur 5b laat wafer A zien dat na een PPO van 60 seconden de belangrijkste Ge-valentie in GeOx zijn Ge 1+ en Ge 3+ . Een vergelijkbare Ge-valancetoestandsverdeling wordt waargenomen in wafer C, en een Ge 3+ component licht verhoogd. In Fig. 5b laat wafer B zien dat een OPO-apparaat met dunnere (10 cycli) Al2 O3 zal Ge 1+ . verder oxideren in Ge 2+ , Ge 3+ , en Ge 4+ , terwijl Ge 1+ wordt aanzienlijk verminderd.
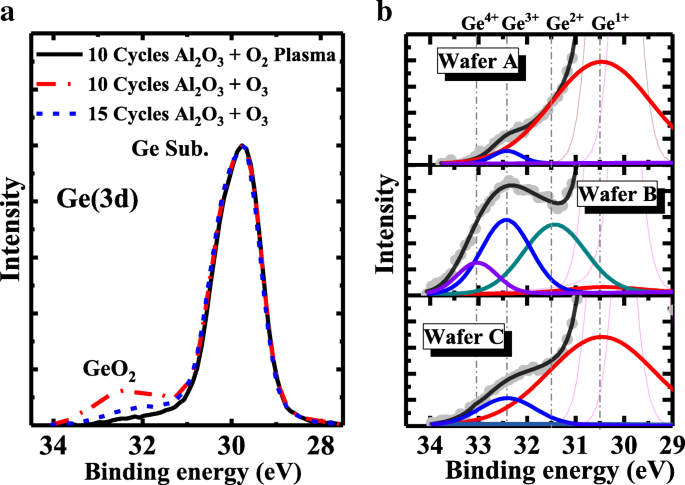
een Ge 3d XPS-spectra van Al2 O3 /GeOx /Ge gevormd door verschillende omstandigheden. b Piekfittingen van de Ge 3d XPS-spectra van de GeO2 laag voor de drie monsters
De gate-to-source CV-karakteristieken worden getoond in Fig. 6. Van de 1-MHz CV-curve, de D het bijna midgap wordt geschat door Terman's methode [13], en een equivalente oxidedikte (EOT)-waarde wordt ook geëvalueerd zoals vermeld in tabel 1. Twintig minuten OPO (wafers B en C) resulteert in een hogere EOT in vergelijking met PPO (wafer A). Wafer C vertoont een hogere EOT dan die van wafer B, vanwege het dikkere Al2 O3 als blokkeerlaag. Er is gemeld dat de dikte van GeOx op een kaal Ge-oppervlak in O3 omgevingstemperatuur bereikt binnen enkele minuten verzadiging en de verzadigingsdikte wordt gedomineerd door temperatuur in plaats van oxidatietijd [10]. Dus in dit artikel is de dikte van GeOx door ozon is na-oxidatie na een paar minuten verzadigd en de resterende oxidatietijd is alleen voor uitgloeien.
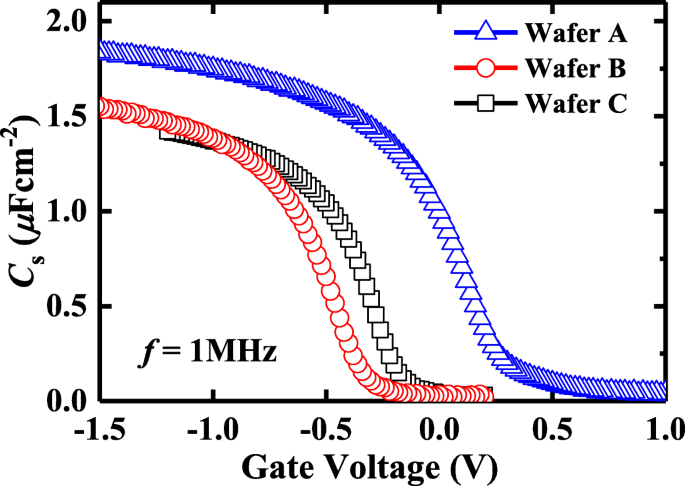
Gate-to-source capaciteit versus V GS kenmerken van Ge pMOSFET's gepassiveerd door PPO (wafers A) en OPO (wafers B en C)
Afbeelding 7 vat de totale weerstand samen (R T ) versus L G van elk apparaat in dit werk. Hier, R T is gedefinieerd als V DS /Ik DS bij V DS = 0,05 V en V GS − V TH = 1 V. De source/drain (S/D) serieweerstand (R SD ) en kanaalweerstand (R CH ) kan worden geëxtraheerd uit het snijpunt en de helling van de lineaire fitting van R T –L G lijnen zoals weergegeven in Fig. 7. De geëxtraheerde R SD en R CH resultaten zijn samengevat in Tabel 1. Figuur 7 laat zien dat de Ge pMOSFET's met PPO een lagere R vertonen SD en R CH wat consistent is met de capaciteitsresultaten getoond in Fig. 6.
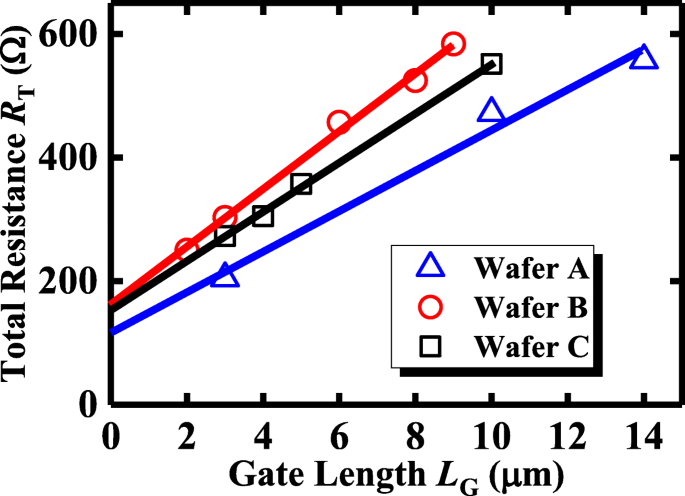
Totale weerstand (R T ) versus poortlengte (L G ) van Ge pMOSFET's
Effectieve mobiliteit van gaten μ eff werd geëxtraheerd op basis van een benadering op basis van een totale weerstandshelling. In Fig. 8 vergelijken we de μ eff van onze Ge pMOSFET's met PPO- en OPO-behandeling met die van andere gerapporteerde Ge pMOSFET's [9, 14]. V inv is de inversieladingsdichtheid in het apparaatkanaal. Ge pMOSFET's met OPO vertonen een hogere piek μ eff vergeleken met de apparaten met PPO. Wafer C met een dikkere Al2 O3 bloklaag heeft een hogere piekgatmobiliteit van 283 cm 2 /V s in vergelijking met wafer B met het dunnere Al2 O3 . Wafer A met PPO vertoont een lager hoogveldgat μ eff met de apparaten met OPO, wat wordt toegeschreven aan de lagere ruwheidsverstrooiing. Maar bij een laag veld bereiken transistors op wafer A met PPO een lagere μ eff dan de OPO-apparaten vanwege de hogere coulombverstrooiing [15]. Er zijn slechts enkele werken gerapporteerd over Ge pMOSFET's die zijn vervaardigd door ozonpassivering. Hier wordt een vergelijking gemaakt van de belangrijkste apparaatprestaties tussen onze apparaten en de gerapporteerde Ge pMOSFET's die zijn behandeld met OPO [9, 14], en de resultaten worden weergegeven in tabel 2. Er wordt geconcludeerd dat wafer C in dit werk de hoge -veld μ eff verbetering en hoger I AAN /Ik UIT in vergelijking met het gerapporteerde apparaat dat met OPO is behandeld. Trouwens, op een Q inv van 5 × 10 12 cm − 2 , wafer C toont een 2,37× hogere μ eff in vergelijking met de Si universele mobiliteit. De ik AAN van wafer C is iets lager dan die in Ref. [9] wat te wijten is aan de grotere EOT.
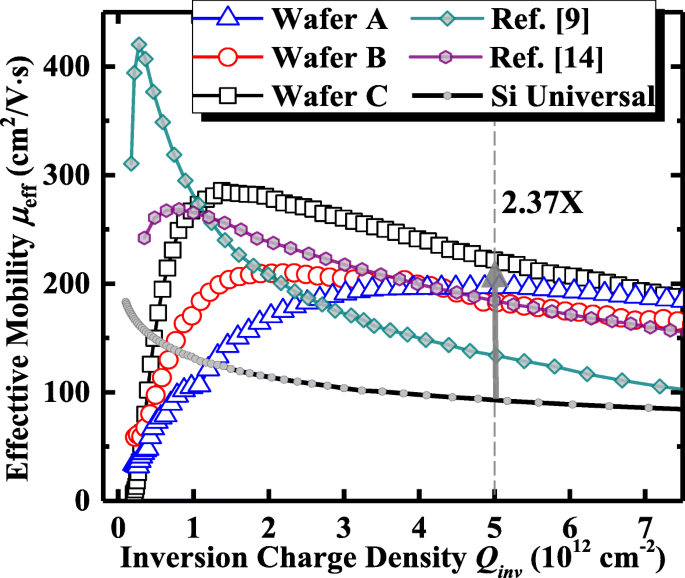
μ eff versus Q inv van Ge pMOSFET's met verschillende passiveringsomstandigheden. Ge-transistors met 15 cycli Al2 O3 + 20 min O3 oxidatie (wafer C) vertonen een piek μ eff van 283 cm 2 /Vs. De impact van S/D-weerstand op μ eff extractie werd verwijderd door de op totale weerstand gebaseerde effectieve kanaalmobiliteit extractiemethode [16]
Conclusies
Ge pMOSFET's worden gerealiseerd met GeOx passivering, die wordt gevormd door OPO- of PPO-behandeling van Al2 O3 /n-Ge in PEALD. De OPO-apparaten vertonen de betere overdrachts- en uitvoerkenmerken, des te hoger I AAN /Ik UIT ratio, de verbeterde subthreshold swing en de hogere piek μ eff vergeleken met de PPO-apparaten. Voor het 15-cyclus OPO-proces, een dikkere Al2 O3 laag leidt tot een hogere EOT-waarde en een verbeterde μ eff in apparaten in vergelijking met de behuizing met 10 cycli. Alle resultaten in dit werk geven aan dat de OPO een effectieve passiveringsmethode is om een hoogwaardige Ge/diëlektrische interface te bereiken en dus een veelbelovende kandidaat-passiveringstechniek kan zijn voor toekomstige Ge MOSFET-fabricage.
Afkortingen
- Al2 O3 :
-
Aluminiumoxide
- ALD:
-
Atoomlaagafzetting
- BF2 + :
-
Boorfluoride-ion
- EOT:
-
Equivalente oxidedikte
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxide
- HF:
-
Fluorwaterstofzuur
- HfO2 :
-
Hafniumdioxide
- TEM:
-
Transmissie elektronenmicroscoop
- MOSFET's:
-
Metaaloxide-halfgeleider veldeffecttransistoren
- OPO:
-
Ozon na oxidatie
- PPO:
-
Plasma na oxidatie
- Q inv :
-
Inversie ladingsdichtheid
- SS:
-
Subdrempelzwaai
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- μ eff :
-
Effectieve mobiliteit van gaten
Nanomaterialen
- Botten bouwen met Raspberry Pi en Python
- Leidinggevend met volharding en doorzettingsvermogen
- Portenta- en thermokoppelsensor (met MAX6675)
- C++ klasse en object met voorbeeld
- Slim nanomateriaal en nanocomposiet met geavanceerde agrochemische activiteiten
- Afstemming van oppervlaktechemie van polyetheretherketon door gouden coating en plasmabehandeling
- Verminderde contactweerstand tussen metaal en n-Ge door invoeging van ZnO met argonplasmabehandeling
- Ge pMOSFET's met hoge mobiliteit met amorfe Si-passivering:impact van oppervlakteoriëntatie
- Verbeterde Si-passivering en PERC-zonnecelefficiëntie door atomaire laag afgezet aluminiumoxide met tweestaps nagloeiing
- Wat is plasmasnijden en hoe werkt plasmasnijden?
- Node-RED en aan de slag met Docker



