Plasma-versterkte atomaire laagafzetting van kobaltfilms met Co(EtCp)2 als metaalprecursor
Abstract
Voor geavanceerde Cu-verbindingstechnologie zijn Co-films op grote schaal onderzocht om te dienen als vervanging van de voering en de zaadlaag vanwege een betere bevochtigbaarheid voor Cu dan Ta. In dit artikel worden de Co-films gekweekt door plasma-versterkte atomaire laagafzetting met behulp van Co(EtCp)2 als voorloper, en de invloeden van procesparameters op de eigenschappen van de Co-films worden uitgebreid onderzocht. De resultaten geven aan dat het procesvenster 125-225 ° C is met een groeisnelheid van ~ -0,073 Å / cyclus. Dat wil zeggen, de verbinding van de Et-groep met het Cp-ligand kan een stabiele filmgroei mogelijk maken bij 125 °C, terwijl de overeenkomstige temperatuur hoger moet zijn dan 200 °C in termen van Co(Cp)2 en Co(MeCp)2 . De afgezette films bevatten naast dominant Co en C N- en O-elementen. Verder is de verlenging van de NH3 pulstijd verbetert de geleidbaarheid van de Co-film aanzienlijk en een lage soortelijke weerstand van 117 μΩ cm kan worden bereikt met een NH3 pulstijd van 40 s. De wortelgemiddelde ruwheid vertoont een kleinere variatie met de depositietemperatuur en handhaaft een lage waarde van ~~0,3 nm, wat wijst op een vlakke Co-film.
Achtergrond
Gezien het conventionele Cu-interconnectieproces in high-speed ultragrootschalige geïntegreerde schakelingen, is een barrièrelaag zoals TaN onmisbaar om de diffusie van Cu-atomen in de omringende tussenlaagdiëlektrica (ILD) [1] te voorkomen. Naast de barrièrelaag is ook een voeringlaag zoals Ta nodig om de hechting tussen de barrièrelaag en Cu te verbeteren. Bovendien is het moeilijk voor de Cu-lijn om op de voeringlaag te worden afgezet door rechtstreeks galvaniseren vanwege de zwakke kiemvorming van Cu-atomen op het Ta-oppervlak. Als gevolg hiervan moet een Cu-kiemlaag op de voeringlaag worden aangebracht voorafgaand aan het galvaniseren van Cu. Dat wil zeggen, een stapel TaN/Ta/Cu-zaadlaag moet tussen de ILD- en Cu-lijn worden ingevoegd. Verder is deze stapel gecoat op de ILD in de vorm van loopgraven en via's. Met het verkleinen van de grootte van de apparaatfuncties, neemt het beschikbare volume voor de Cu-interconnectielijn gestaag af. Om een lagere Cu-interconnectieweerstand te bereiken, is een zaadloze barrière/voeringlaag uitgebreid onderzocht [2,3,4,5,6]. TaN werkt bijvoorbeeld nog steeds als de barrièrelaag en Co vervangt Ta als de voeringlaag. Vanwege een betere bevochtigbaarheid van Co tot Cu dan Ta, kan Cu direct op het Co-oppervlak worden gegalvaniseerd. Traditioneel wordt de barrière/voeringlaag gegroeid door middel van een fysiek dampafzettingsproces. Het afzetten van een hoogwaardige barrière / voeringlaag is echter een uitdaging, aangezien PVD een slechte stapdekkingsgraad heeft in sleuven en via's met een hoge aspectverhouding. In plaats daarvan kunnen ultradunne, continue en goede stapdekkingsfilms worden verkregen door atomaire laagafzetting (ALD) techniek dankzij de zelfbeperkende groei-eigenschap [7].
In termen van ALD Co-films is een groot aantal Co-precursoren, vooral die op basis van cyclopentadienylligand (Cp), uitgebreid bestudeerd, zoals bis-cyclopentadienylkobalt (CoCp2 ) [8,9,10,11,12,13,14], bis(η-methylcyclopentadienyl)kobalt [Co(MeCp)2 ] [15], en cyclopentadienyl isopropyl acetamidinato kobalt [Co(CpAMD)] [16]. Het dienstverband van CoCp2 maakt de groei mogelijk van Co-films met een lage soortelijke weerstand en hoge zuiverheid; de stabiele filmgroei is echter beperkt tot temperaturen boven 250 °C. Met de toevoeging van een methylgroep aan het Cp-ligand kan bij 200 °C een lagere temperatuurgroei worden bereikt, wat wordt toegeschreven aan de hogere reactiviteit van NH3 radicaal naar het MeCp-ligand in vergelijking met het Cp-ligand. Op basis van Co-filmgroei met CoCp2 en Co(MeCp)2 als voorlopers kan het procesvenster worden verplaatst naar lagere temperaturen, d.w.z. <-200 °C als de ethylgroep is verbonden met het Cp-ligand.
In dit werk werden Co-dunne films gekweekt door plasma-versterkte ALD (PE-ALD) met behulp van bis(ethylcyclopentadienyl)kobalt [Co(EtCp)2 ] en NH3 plasma als voorlopers. De invloed van verschillende procesparameters op de eigenschappen van de Co-films werd uitgebreid onderzocht. Als resultaat werd met succes een procesvenster van 125–225 °C bereikt. Bovendien vertonen de Co-films een lagere soortelijke weerstand (~ 130 cm).
Methoden
Verschillende Co dunne films werden gekweekt door PE-ALD op een 200 nm SiO2 film, die werd afgezet op p-type siliciumsubstraten door thermische oxidatie. Co(EtCp)2 werd gebruikt als de metaalprecursor, die werd bewaard in een container bij 70 °C en overgebracht naar de depositiekamer met een N2 draaggas. De NH3 plasma werd gegenereerd door een plasmagenerator op afstand met een vermogen van 2800 W, die als reductiemiddel fungeerde. De stroomsnelheid van N2 werd op 50 sccm gehouden en de werkdruk was ~-1000 Pa tijdens de filmgroei. Om het effect van depositietemperatuur op de filmgroei te onderzoeken, werd de substraattemperatuur gevarieerd van 100 tot 270 °C met een stap van 25 °C. Om de procesparameters te optimaliseren, worden bovendien de pulstijden van Co(EtCp)2 en NH3 plasma werden respectievelijk ook veranderd. Om het effect van nagloeien op de prestaties van de Co-films te onderzoeken, werden de monsters die bij verschillende temperaturen waren afgezet bovendien uitgegloeid in het vormingsgas (N2 /4%-H2 ) bij 400 °C gedurende 30 min.
De dikte en dichtheid van de film werden afgeleid door röntgenreflectie en de microstructuur van de film werd bepaald door röntgendiffractie (XRD) met grazende incidentie op een diffractometer (Bruker D8 Discover) met Cu Kα straling. De oppervlaktemorfologie van de film werd waargenomen met atomic force microscopie (AFM) (Bruker Icon) en scanning elektronenmicroscoop (SEM) (Zeiss SIGAMA HD). De elementaire samenstelling en chemische bindingen van de film werden geanalyseerd met röntgenfoto-elektronspectroscopie (XPS) (Kratos Axis Ultra DLD). De velweerstand van de film werd gemeten met een vierpuntsprobe en de filmweerstand werd berekend op basis van de filmdikte en de velweerstand.
Resultaten en discussie
Optimalisatie van de ALD-procesparameters
Figuur 1a toont de groeisnelheid van de Co-film als functie van de substraattemperatuur. Het blijkt dat de groeisnelheid toeneemt bij verhoging van de substraattemperatuur tot 125 ° C, en dan wordt een relatief stabiele groeisnelheid van 0,073 ± 0,02 Å / cyclus verkregen tussen 125 en 225 ° C. Wanneer de substraattemperatuur echter tot 250 °C of hoger stijgt, neemt de groeisnelheid toe. Daarom kan het temperatuurbereik van 125-225 ° C worden beschouwd als een geschikt procesvenster. Vergeleken met Co(Cp)2 en Co(MeCp)2 , de toevoeging van Et-groep aan Cp-ligand maakt het mogelijk dat het procesvenster naar een lagere depositietemperatuur wordt verplaatst, wat wijst op een hogere reactiviteit van EtCp-liganden met NH3 plasma. Een dergelijke lage temperatuurgroei bij 125 °C is gunstig voor het verminderen van het thermische budget. Wat betreft de substraattemperaturen lager dan 125 °C, moet de relatief langzamere filmgroei worden toegeschreven aan het ontbreken van voldoende activeringsenergie voor de chemische reactie [7]. Een dergelijke hoge groeisnelheid bij -250 °C houdt verband met thermische ontleding van de metaalprecursor [17]. Om de invloed van Co(EtCp)2 . te onderzoeken pulstijd op de groeisnelheid van de afgezette film, de pulstijd van Co(EtCp)2 neemt geleidelijk toe van 1 tot 4 s met een stap van 1 s, terwijl andere procesparameters vast zijn. Zoals weergegeven in Fig. 1b, neemt de groeisnelheid toe van ~ 0,06 tot ~ 0.073 Å/cyclus met de toename van Co(EtCp)2 pulstijd van 1 tot 2 s, en handhaaft dan een relatief stabiele waarde. Dit geeft aan dat de oppervlakte-adsorptie van Co(EtCp)2 bereikt een verzadiging bij een pulstijd van 2 s. Figuur 1b illustreert ook de invloed van NH3 -plasmapulstijd op de groeisnelheid van de film. De groeisnelheid neemt toe bij verlenging van NH3 -plasmapulstijd; wanneer de plasmapulstijd echter langer is dan 20 s, bereikt de groeisnelheid een verzadigingswaarde van ~ 0,12 /cyclus.

Afhankelijkheid van de groeisnelheid van de ALD-film op a substraattemperatuur, b Co(EtCp)2 , en NH3 pulstijd
Karakterisering van de gedeponeerde co-films
Figuur 2 toont de survey-XPS-spectra van de films die zijn afgezet bij 175 °C. De afgezette films bestaan uit Co-, N-, O- en C-elementen. Het is de moeite waard om te vermelden dat om de oppervlakteverontreiniging volledig te verwijderen, alle monsters in situ werden geëtst met Ar-ionenbombardement gedurende 6 minuten voorafgaand aan de verzameling van XPS-spectra. Tabel 1 geeft een overzicht van de elementaire percentages van de film afgezet bij 175 ° C met de etstijd en de C- en O-inhoud blijven constant na 6 minuten etsen, wat wijst op een volledige verwijdering van oppervlakteverontreiniging. Tabel 2 geeft de elementaire atoomverhouding weer van de films die zijn gegroeid bij respectievelijk 100 en 175 ° C, die zijn geëxtraheerd uit de XPS-spectra met hoge resolutie. Naarmate de substraattemperatuur stijgt van 100 tot 175 °C, neemt het relatieve C-gehalte af van 40 tot 32% en neemt het elementaire percentage N toe van 14 tot 18%. Bovendien vertoont het relatieve percentage O een lichte stijging van 5 naar 7%. Het hogere C-gehalte moet worden toegeschreven aan de gedeeltelijke verwijdering van de EtCp-liganden [15, 16]. Aangezien er geen O-element in de voorlopers zit, zijn de O-atomen in de afgezette films waarschijnlijk afkomstig van de zuurstof in de reactiekamer.
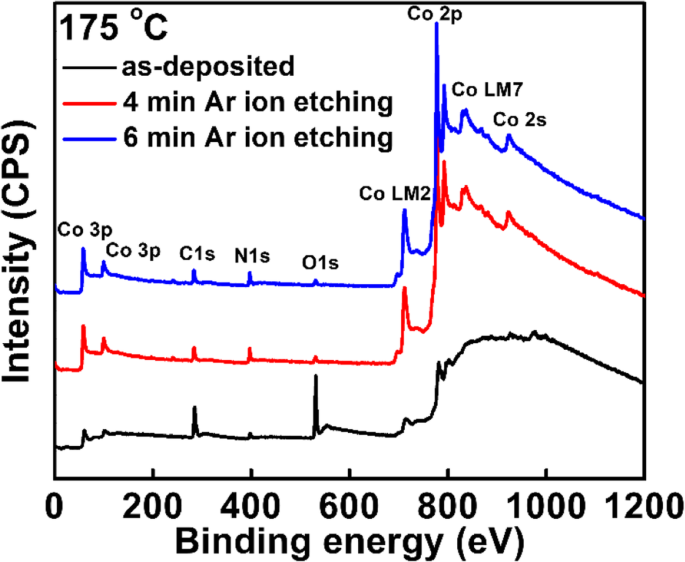
De onderzoeksspectra van de Co-films afgezet bij 100 °C met verschillende etstijden
Figuur 3a toont C 1s-spectra met hoge resolutie van de films die bij verschillende temperaturen zijn afgezet. Het C 1s-spectrum kan goed worden onderverdeeld in vier componenten bij 283.2, 284,7, 286,1 ± 0,1 eV en 288,9 eV, die het resultaat zijn van C-Co [12], CC [12, 18], CN [15, 19] en CO [12] bindingen, respectievelijk. Naarmate de temperatuur stijgt van 100 tot 175 ° C, neemt het relatieve gehalte aan C-C-binding af van 61 tot 56%, terwijl die van C-Co, C-N en C-O met respectievelijk 1%, 2% en 2% toenemen. Hieruit blijkt dat meer EtCp-liganden bij een hogere temperatuur werden ontleed, wat leidde tot een verlaging van het relatieve percentage C in de film. Figuur 3b toont de N 1s-spectra met hoge resolutie van de films die bij verschillende temperaturen zijn afgezet. Elk N 1s-spectrum kan goed worden gescheiden in twee componenten met behulp van de Gauss-Lorentz-functie. De piek op 397,8 eV moet worden geassocieerd met N-Co-binding [13], en de pieken gecentreerd op 399,2 eV moeten overeenkomen met N-C [20, 21]-binding. Naarmate de substraattemperatuur stijgt van 100 tot 175 °C, neemt het relatieve gehalte aan N-Co af van 72 tot 69%. Dit komt omdat de desorptie van stikstof uit de film wordt versterkt bij hogere temperatuur, wat resulteert in de vorming van minder N-Co-bindingen. Afbeelding 3c toont Co 2p3/2 . met hoge resolutie XPS-spectra van de Co-films afgezet bij verschillende temperaturen. Met betrekking tot het bestaan van de C-Co- en N-Co-bindingen, zoals onthuld in Fig. 3a, b, is het redelijk dat de Co 2p3/2 spectrum kan worden onderverdeeld in drie componenten, die zich respectievelijk op 778, 778,9 en 780,86 ± 0,34 eV bevinden. De piek bij de kleinste bindingsenergie moet worden toegeschreven aan de Co-Co-binding [12, 22]. Bovendien, aangezien de Pauling-elektronegativiteit van C (2,55) kleiner is dan die van N (3,04), is de positieve ladingsdichtheid op Co gebonden aan N groter dan die op Co gebonden aan C. Daarom zijn de pieken bij 778,9 en 780,86 ± 0,34 eV zou respectievelijk moeten voortkomen uit de Co-C- en Co-N-bindingen. Wanneer de depositietemperatuur wordt verhoogd van 100 tot 175 °C, neemt het relatieve gehalte aan Co-N-binding af van 48 tot 32%, wat consistent is met de evolutie van N-Co-binding in figuur 3b.

Hoge resolutie a Co 2p3/2 , b C 1s en c N 1s XPS-spectra van de films afgezet bij respectievelijk 100 °C en 175 °C
De kristaleigenschappen van de Co-films worden gekenmerkt door TEM, zoals weergegeven in Fig. 4. De Co-films die zijn afgezet bij respectievelijk 100 en 250 ° C, zijn beide gekristalliseerd. Figuur 5 toont de AFM-foto's van de Co-films die bij verschillende temperaturen zijn gekweekt. Naarmate de depositietemperatuur stijgt van 100 tot 250 °C, vertoont de RMS-ruwheid een kleinere variatie en handhaaft deze een lage waarde van ~~0,3 nm, wat wijst op een vlakke Co-film.
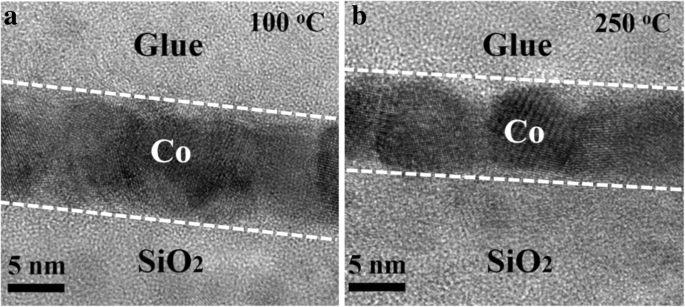
De transversale TEM-beelden van de Co-films (1200 cycli) die zijn gedeponeerd op a 100 °C en b 250 °C, respectievelijk
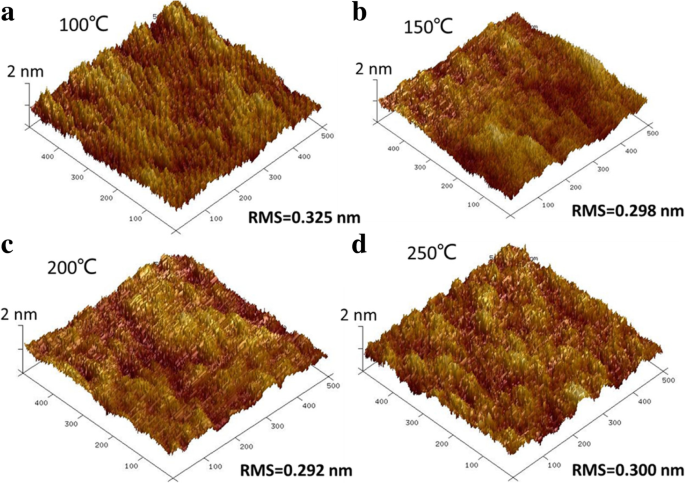
AFM-beelden van de Co-films (1200 cycli) gedeponeerd bij Co(EtCp)2 pulstijd van 2 s en NH3 plasmapulstijd van 10 s bij verschillende temperaturen:a 100 °C; b 150 °C; c 200 °C; d 250 °C
Figuur 6a, b toont de afhankelijkheid van de soortelijke weerstand van de Co-films van de substraattemperatuur en NH3 puls tijd. De soortelijke weerstand van de film neemt opmerkelijk af van 652 tot 130 Ω cm en blijft dan constant bij het verhogen van de depositietemperatuur van 100 tot 275 ° C. De resultaten moeten worden toegeschreven aan de toename van het relatieve gehalte aan metallisch Co in de film. Zoals de NH3 pulstijd neemt toe van 10 tot 40 s, de soortelijke weerstand van de Co-films neemt af van 158 tot 117 μΩ cm (zie figuur 6b). Afbeelding 7 toont de Co 2p3/2 XPS-spectra van de Co-films gedeponeerd met verschillende NH3 plasma tijden. Zoals de NH3 de plasmatijd wordt verlengd van 10 tot 40 s, het relatieve percentage van de Co-Co-bindingen neemt toe van 31 tot 34% en het relatieve gehalte van de Co-C-bindingen neemt af van 40 tot 31%. Verder neemt het koolstofgehalte met 22% af naarmate de NH3 plasmapulstijd neemt toe van 10 tot 40 s. Dit duidt op de geleidelijk toegenomen verwijdering van de EtCp-liganden, en draagt zo bij aan de afname van de weerstand van de Co-film.

De soortelijke weerstand van de Co-film als functie van de groeitemperatuur (a ) en NH3 pulstijd (b ), respectievelijk
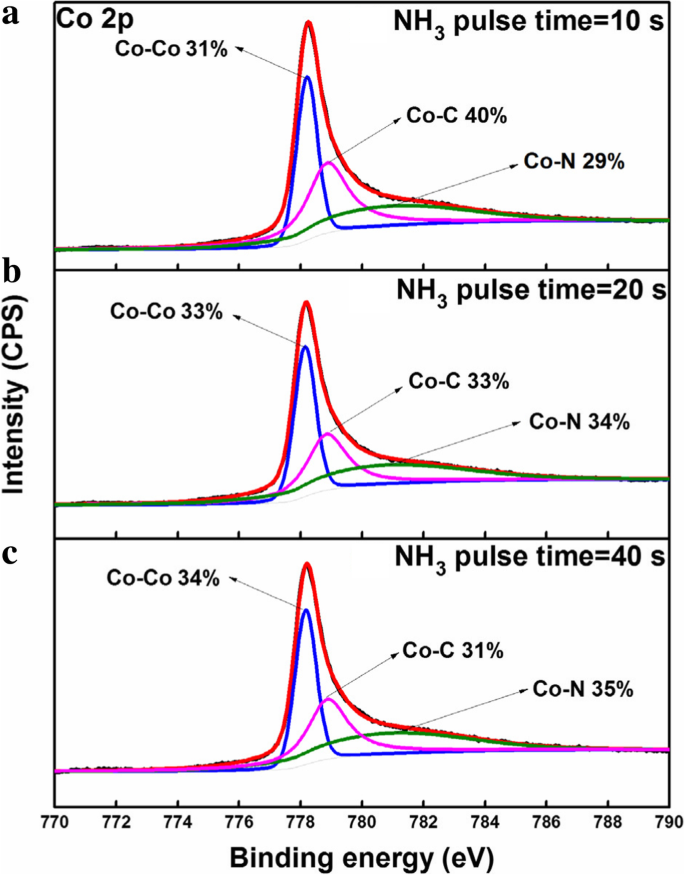
De XPS-spectra van de Co-films met verschillende NH3 plasmatijden:a 10 s; b 20 s; c 40 s
Tabel 3 toont de prestatievergelijking van de Co-films die zijn gekweekt door verschillende voorlopers. Vergeleken met CoCp2 en Co(MeCp)2 , Co(EtCp)2 maakt de afzetting van Co-films in de atomaire laag bij een lagere temperatuur mogelijk. Bovendien, met behulp van de metaalprecursor van Co(EtCp)2 leidt tot een lagere groeisnelheid. Theoretisch is het ALD-proces de groei van monolaag voor monolaag. In feite beïnvloeden het sterische hinderingseffect en de oppervlakteadsorptie van voorlopers beide de filmgroei. In termen van het sterische hinderingseffect betekent dit dat de liganden van de chemisch gesorbeerde metaalprecursorsoorten een gedeeltelijk oppervlak kunnen afschermen en voorkomen dat andere metaalprecursorsoorten volledig op het substraatoppervlak worden geadsorbeerd. Sinds Co(EtCp)2 heeft een groter ligand vergeleken met CoCp2 en Co(MeCp)2 wordt aangenomen dat tijdens het ALD-proces een significant sterisch hinderingseffect zal optreden. Dit kan leiden tot de groei van sub-monolaag, wat resulteert in een kleinere groeisnelheid. Aan de andere kant, aangezien een Co-voeringlaag zou moeten worden afgezet op een TaN-barrièrelaag voor toekomstige praktische toepassingen, werden 1200 cycli Co-films gekweekt op de ALD TaN-film bij 125 ° C. Afbeelding 8 toont het transversale TEM-beeld van de Co-film die op het TaN-oppervlak is afgezet. Er wordt waargenomen dat de Co-film continu en uniform is, wat een superieur groeigedrag onthult. Verder is gevonden dat de dikte (ongeveer 10 nm) van de Co-film afgezet op de ALD TaN-film vergelijkbaar is met die gegroeid op de SiO2 oppervlak.
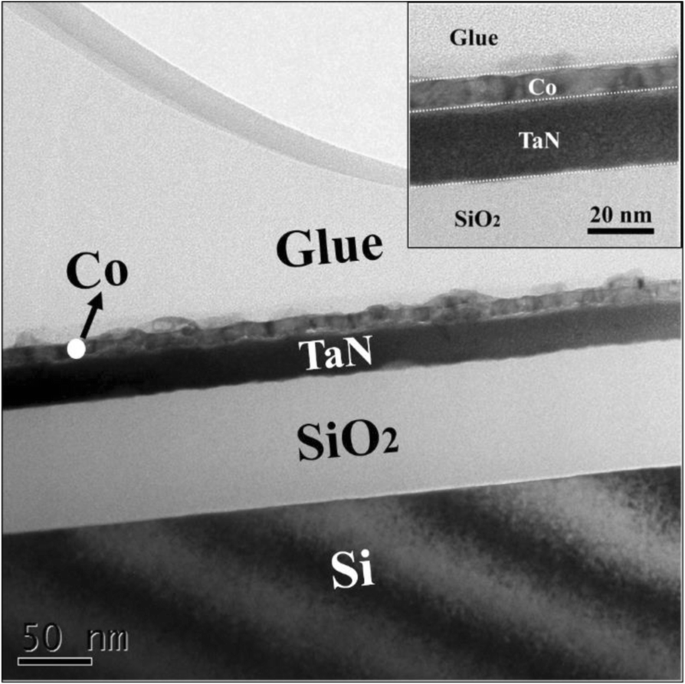
Het transversale TEM-beeld van de Co-film (1200 cycli) afgezet bij 125 °C op het ALD TaN-oppervlak en de inzet is een vergroot beeld
Conclusies
De groei van Co dunne film wordt overgedragen door PE-ALD met behulp van de voorlopers van Co(EtCp)2 , en de invloed van procesparameters op de kenmerken van de Co-films werden onderzocht. Door de toevoeging van de Et-groep aan het Cp-ligand kan het procesvenster worden verplaatst naar een lagere depositietemperatuur van 125 °C. Bovendien zijn de Co-films samengesteld uit Co- en C-elementen samen met enkele N- en O-elementen. Met het verhogen van de depositietemperatuur worden de EtCp-liganden beter verwijderd en neemt het relatieve elementaire percentage van C af. Als gevolg hiervan neemt de soortelijke weerstand van de afgezette Co-films af van 652 tot 130 μΩ cm en blijft dan een stabiele waarde wanneer de substraattemperatuur wordt verhoogd van 100 tot 275 ° C. Voor de depositietemperatuur van 125 °C wordt de soortelijke weerstand geleidelijk verlaagd met de verlenging van NH3 pulstijd en een lage soortelijke weerstand van 117 μΩ cm kunnen worden verkregen wanneer een NH3 pulstijd van 40 s wordt gebruikt. De wortelgemiddelde ruwheid vertoont een kleinere variatie met de depositietemperatuur en handhaaft een lage waarde van ~~0,3 nm, wat wijst op een vlakke Co-film.
Afkortingen
- AFM:
-
Atoomkrachtmicroscopie
- ALD:
-
Atoomlaagafzetting
- Co(CpAMD):
-
Cyclopentadienyl isopropyl acetamidinato kobalt
- Co(EtCp)2 :
-
Bis(ethylcyclopentadienyl)kobalt
- Co(MeCp)2 :
-
Bis(η-methylcyclopentadienyl)kobalt
- CoCp2 :
-
Bis-cyclopentadienyl kobalt
- Cp:
-
Cyclopentadienyl
- ILD:
-
Tussenlaag diëlektricum
- PE:
-
Plasma-verbeterd
- RMS:
-
Wortelgemiddelde kwadraat
- SEM:
-
Scanning elektronenmicroscoop
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- XRD:
-
Röntgendiffractie
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- Onderzoek naar de sorptie van zware metalen met behulp van nanocomposieten van met ijzer gemodificeerde biochar
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Depositie in twee stappen van met Al-gedoteerde ZnO op p-GaN om ohmse contacten te vormen
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Verbetering van de amperometrische transducerselectiviteit met behulp van fenyleendiaminefilms van nanoformaat
- Laagdikte meten met een microscoop
- Voordelen van het gebruik van legeringen



