Eerste-principes studie van puntdefecten in GaAs/AlAs superrooster:de fasestabiliteit en de effecten op de bandstructuur en carriermobiliteit
Abstract
Geavanceerde superroosters van halfgeleiders spelen een belangrijke rol in kritieke toekomstige hightech-toepassingen zoals ruimtevaart, hoge-energiefysica, detectie van zwaartekrachtgolven, astronomie en nucleaire gerelateerde gebieden. Onder zulke extreme omstandigheden, zoals omgevingen met veel straling, hebben deze halfgeleider-superroosters de neiging om verschillende defecten te genereren die uiteindelijk kunnen leiden tot het falen van de apparaten. In het superrooster zoals GaAs/AlAs zijn de fasestabiliteit en de impact op de apparaatprestaties van puntdefecten echter nog steeds niet duidelijk. De huidige berekeningen laten zien dat in GaAs/AlAs superrooster de antisite defecten energetisch gunstiger zijn dan leegstand en interstitiële defecten. De AsX (X =Al of Ga) en XAs defecten induceren altijd metalliciteit van GaAs/AlAs superrooster, en GaAl en AlGa antisite defecten hebben kleine effecten op de elektronische structuur. Voor GaAs/AlAs superrooster met de interstitiële of leegstandsdefecten wordt een significante vermindering van de band gap of geïnduceerde metalliciteit gevonden. Nadere berekeningen laten zien dat de interstitiële en vacaturedefecten de elektronenmobiliteit aanzienlijk verminderen, terwijl de antisitedefecten relatief kleinere invloeden hebben. De resultaten vergroten het begrip van de stralingsschade-effecten van het GaAs/AlAs-superrooster, wat dus een leidraad vormt voor het ontwerpen van zeer stabiele en duurzame op halfgeleider-superroosters gebaseerde elektronische en opto-elektronica voor extreme omgevingstoepassingen.
Achtergrond
Het superrooster (SL) is een kunstmatig materiaal dat bestaat uit afwisselend dunne lagen van twee of meer verschillende componenten. De (GaAs)n /(AlAs)m is een van de belangrijkste SL sinds de ontwikkeling van transistors met hoge elektronenmobiliteit (HEMT) en kwantumcascadelasers (QCL's) een paar decennia geleden [1,2,3,4,5,6]. Onlangs met de vooruitgang van filmepitaxie en nanofabricagetechnieken, heeft de (GaAs)n /(AlAs)m gebaseerde SL's en nanodevices met (n + m) variërend van 2 tot 10 hebben opwindende fysieke eigenschappen aangetoond met betrekking tot luminescentie en optische absorptie, twee-fononabsorptie en Raman, evenals infraroodspectra, die dus veelbelovende toepassingen vonden in opto-elektronica, detectie, Led-, energie- en lasergerelateerde civiele en industriële gebieden [7,8,9,10,11,12]. Ondertussen worden de halfgeleider-SL's en apparaten blootgesteld aan verschillende stralingsomgevingen, dwz X- straal, neutronen, elektronen, ionen, enz., wat kan resulteren in het genereren van defecten die onzuiverheden, vacatures, interstitials, antisites en een complex hiervan bevatten. Aangezien de halfgeleidermaterialen en gerelateerde fysieke eigenschappen een belangrijke rol spelen bij het functioneren en functioneren van deze elektronische apparaten en geïntegreerde schakelingen, kunnen kleine hoeveelheden defecten hun optische en transporteigenschappen drastisch veranderen, vooral in meerlaagse systemen [13].
De effecten van vreemde onzuiverheden of intrinsieke defecten op de halfgeleider-SL's en hun samenstellende materialen zijn de afgelopen decennia uitgebreid onderzocht. Zollo et al. hebben de methode van de dichtheidsfunctionaaltheorie (DFT) gebruikt om de stabiliteit van puntdefecten in GaAs te onderzoeken, en vonden dat de antisitedefecten gunstiger waren [14]. Kahalie et al. hebben de GaAs/AlAs SL-structuur bestudeerd met de DFT-methode en de arseenleegstand gevonden (VAs ) defect aan en nabij het grensvlak leidde tot een geleidende quasi 2-DEG tussen isolerend diëlektrisch arsenide [7]. Spasov et al. hebben de effecten bestudeerd van stikstofverontreinigingen op transport van dragers en elektron-gat-recombinatie in GaAs/AlAs SL-diodes [9]. Ze rapporteerden dat de N-onzuiverheden de energie van de elektronische miniband wijzigden en de elektronendiffusie door de SL-miniband belemmerden, wat kan leiden tot een sterke stralingsrecombinatie van elektron-gatparen [9]. Wang et al. bestudeerde de interdiffusie veroorzaakt door de Zn-onzuiverheid in GaAs/AlAs SL-structuren met behulp van een ab initio moleculaire dynamica (AIMD) methode [15]. Hun resultaten suggereerden dat de Zn-diffusie werd ondersteund door de groep-III-elementen, die in het interstitiële kanaal werden uitgeworpen en snel diffundeerden, waardoor het superrooster werd verstoord [15]. Mitra en Stark ontdekten dat de aanwezigheid van vacatures de Ga/Al-vermenging in GaAs/AlAs SL versterkte, als gevolg van het voorgestelde diffusiemechanisme met twee atomen [16]. Onlangs is een AIMD-simulatie van de stralingsrespons van GaAs / AlAs SL uitgevoerd [17], waarin de minimale energieën voor elk atoom dat permanent van zijn roosterplaats moet worden verplaatst, zijn bepaald, de routes voor het genereren van defecten zijn verschaft, en de soorten gecreëerde defecten zijn geïdentificeerd. Het onthulde dat het gecreëerde Ga (of Al of As) Frenkel-paar en AsGa -GaAls antisite-paar hebben diepgaande effecten op de dichtheid van toestandsdistributie en bandstructuur van GaAs/AlAs SL [17].
Tot nu toe zijn de stabiliteit van puntdefecten in de SL-structuur en de transporteigenschappen zoals vervoerdermobiliteit nog steeds onbekend. Het is dus van vitaal belang om te onderzoeken hoe de aanwezigheid van leegstand, interstitiële en antisite defecten de structurele stabiliteit en elektrische eigenschappen van GaAs/AlAs SL beïnvloeden. In deze studie is de fasestabiliteit van enkele Ga (of Al of As) leegstand, enkele Ga (of Al of As) interstitial en enkele GaAs (of AlAls of AsGa of AsAl ) antisite defecten zijn onderzocht. Het is aangetoond dat de antisite defecten energetisch gunstiger zijn dan leegstand en interstitiële defecten. De bandstructuren van deze defecte toestanden zijn onderzocht met de hybride DFT-methode, die een deel van de exacte uitwisseling van de Hartree-Fock-theorie omvat met de rest van de uitwisselingscorrelatie-energie van andere bronnen (ab initio of empirisch) [18], en zal naar verwachting een nauwkeurigere beschrijving bieden van de elektronische structuur van halfgeleidermaterialen dan de standaard DFT. In het bijzonder is de elektronenmobiliteit voorspeld. Het blijkt dat de interstitiële en vacaturedefecten de elektronenmobiliteit aanzienlijk verminderen, terwijl de antisite-defecten relatief kleinere invloeden hebben. Dit werk zal het begrip van de stralingsschade-effecten van het halfgeleider-superrooster vergroten en richtlijnen bieden voor het ontwerpen van zeer stabiele en duurzame op halfgeleider-superroosters gebaseerde elektronische en opto-elektronica voor extreme omgevingstoepassingen.
Methoden
In deze studie worden de structurele relaxaties uitgevoerd binnen het standaard DFT-raamwerk en worden de bandstructuren berekend door de hybride DFT in het raamwerk van Heyd-Scuseria-Emzefhof (HSE) [19] op basis van de ontspannen structuren. Alle berekeningen worden uitgevoerd met behulp van Vienna Ab Initio Simulatiepakket (VASP) [20]. Projector augmented-wave pseudopotentialen worden gebruikt om de interactie tussen ionen en elektronen te beschrijven, en de uitwisselingscorrelatie-effecten worden behandeld met behulp van de lokale dichtheidsbenadering in de Ceperley-Alder-parameterisatie [21]. De convergentiecriteria voor totale energieën en krachten zijn 10 −4 eV en 10 −3 eV/Å, respectievelijk. De oorsprongspuntgroep van AlAs- en GaAs-kristal is de T d groep van zinkblend, zoals getoond in Fig. 1a. De illustratie van beschouwde puntdefecten wordt gegeven in Fig. 1b. De GaAs/AlAs SL met twee monolagen van GaAs afgewisseld met twee monolagen van AlAs wordt in deze studie beschouwd en de geometrische configuratie wordt geïllustreerd in Fig. 2, samen met de beschouwde puntdefecten.

Schematische weergave van geometrische structuren van a XAs (X =Ga of Al); b de gebreken in XA's. V X :(X =Ga, Al, of As) X vacature; X int :X-interstitial; X Als :X bezet de As-roostersite; Als X :Omdat het de X-roostersite beslaat. De gele en paarse bollen vertegenwoordigen respectievelijk de vacature- en interstitiële defecten

Schematische weergave van geometrische structuren van a ideaal GaAs/AlAs superrooster; b en c GaAs/AlAs superrooster met verschillende puntdefecten. X J :(X, Y =Ga, Al of As) X bezet de Y-roosterplaats; V X :X vacature; X int :X-interstitial. De gele en karmijnrode bollen vertegenwoordigen respectievelijk de vacature- en interstitiële defecten
Resultaten en discussie
Grondtoestandseigenschappen van GaAs en AlAs
Zoals weergegeven in tabel 1, wordt bepaald dat de roosterconstanten van bulk GaAs en AlAs respectievelijk 5,61 en 5,63 A zijn, wat goed overeenkomt met de experimentele en andere theoretische waarden [22,23,24]. Het lijkt erop dat de roostermismatch tussen GaAs en AlAs klein is, en de roosterconstante van GaAs/AlAs SL is ingesteld op de tussenliggende waarde van 5,62 Å. De bulkmodulus wordt berekend door \( B=\frac{1}{3}\left({C}_{11}+2{C}_{12}\right) \) [25], waarbij de C11 en C12 vertegenwoordigen de elastische constanten. De bulkmodulus van GaAs wordt berekend op 76,3 GPa, wat dicht bij het resultaat van 76,5 GPa voor AlAs ligt. Deze resultaten komen redelijk overeen met de theoretische en experimentele gegevens [22, 26, 27].
De defecte vormingsenergie in GaAs/AlAs-superrooster
Voor GaAs/AlAs SL en bulktoestanden wordt de defectvormingsenergie berekend door \( {E}_f={E}_{def}-{E}_{undef}+\sum \limits_i\Delta {n}_i{ \mu}_i \) [28]. Hier, E def is de totale energie van de defecte simulatiecel na relaxatie, E undef is de totale energie van de ontspannen ideale supercel, Δn ik is de verandering in het aantal soorten i (ik = Ga, Al of As), en μ ik is het chemische potentieel van soorten i [28].
Voor bulk XAs (X =Al of Ga) voldoen de chemische potentialen van As en X aan de volgende beperkingen:\( {\mu}_X\le {\mu}_X^{bulk} \), \( {\mu} _{As}\le {\mu}_{As}^{bulk} \), en \( {\mu}_{As}+{\mu}_X={\mu}_{XAs}^{bulk } \), waarbij \( {\mu}_X^{bulk} \), \( {\mu}_{As}^{bulk} \), en \( {\mu}_{XAs}^{bulk } \) komen overeen met de totale energie van respectievelijk bulk X, bulk As en bulk XAs. De defectvormingsenergieën onder X-rijke toestand, dwz \( {\mu}_X={\mu}_X^{bulk} \) en \( {\mu}_{As}={\mu}_{XAs }^{bulk}-{\mu}_X^{bulk} \), en As-rijke toestand, dwz \( {\mu}_{As}={\mu}_{As}^{bulk} \ ) en \( {\mu}_X={\mu}_{XAs}^{bulk}-{\mu}_{As}^{bulk} \), zijn samengevat in Tabel 2. Voor GaAs, onder As- rijke omstandigheden de AsGa (Aangezien het de Ga-roosterplaats beslaat) blijkt het antisietdefect het meest energetisch gunstig te zijn, zoals aangegeven door de kleinste vormingsenergie van 1,57 eV. Het volgende gunstige defect is de GaAs (Ga bezet de As-roosterplaats) antisite-defect, met een vormingsenergie van 2,31 eV. De As-interstitial (Asint ) heeft de grootste vormingsenergie van 5,20 eV, wat suggereert dat het moeilijker te vormen is dan andere beschouwde puntdefecten. Onder Ga-rijke omstandigheden is de VGa , Zoalsint en AsGa defecten hebben grotere vormingsenergieën, en de VAs , Gaint en GaAls defecten hebben kleinere vormingsenergieën, in vergelijking met de As-rijke toestand. Het is duidelijk dat de stabiliteit van het defect afhangt van de chemische omgeving. In vergelijking met GaAs zijn de defectvormingsenergieën in AlAs over het algemeen groter, behalve de gevallen van Asint en AsX (X =Al of Ga) onder As-rijke omstandigheden. De AsAl en AlAls Er wordt bepaald dat antisietdefecten het gunstigste defect zijn onder respectievelijk As-rijke en Al-rijke omstandigheden. Net als in het geval van GaAs, is de Asint is ook ongunstig in AlAs. De defectvormingsenergieën onder As-rijke en X-rijke (X =Ga of Al) omstandigheden in bulk XAs zijn uitgezet in Fig. 3. Figuur 3a laat zien dat de AsGa en GaAls antisite-defecten zijn gunstiger onder respectievelijk As-rijke en Ga-rijke omstandigheden. Opgemerkt wordt dat de AsAl antisite defect heeft in de meeste gevallen de voorkeur (zie figuur 3b). Onder Al-rijke toestand, de fasestabiliteit van AlAs , VAls en AsAl defecten liggen dicht bij elkaar, zoals aangegeven door de vormingsenergieën van respectievelijk 3,0, 3,16 en 3,24 eV. Ook vinden we dat in zowel GaAs als AlAs de ongunstigheid van Asint is onafhankelijk van de chemische omgeving. Zollo et al. uitgevoerde eerste-principeberekeningen op GaAs en hun DFT-resultaten toonden aan dat de vormingsenergieën van AsGa en GaAls waren kleiner dan die voor leegstand en interstitiële defecten [14], wat consistent is met onze resultaten.
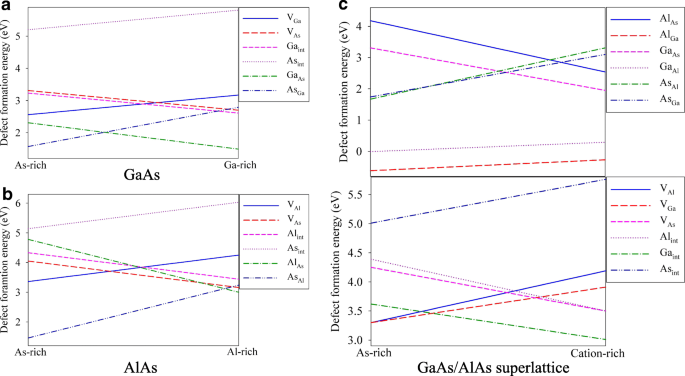
De defectvormingsenergieën onder As-rijke en kationenrijke omstandigheden in a GaAs, b AlAs en c GaAs/AlAs superrooster. X J :(X, Y =Ga, Al of As) X bezet de Y-roosterplaats; V X :X vacature; X int :X-interstitial
De E f in GaAs/AlAs SL-structuur worden ook berekend onder As-rijke conditie, dwz \( {\mu}_{As}={\mu}_{As}^{bulk} \), \( {\mu}_ {Al}={\mu}_{Al As}^{bulk}-{\mu}_{As}^{bulk} \), en \( {\mu}_{Ga}={\mu}_ {Ga As}^{bulk}-{\mu}_{As}^{bulk} \), en kationenrijke toestand, dwz \( {\mu}_{Al}={\mu}_{Al }^{bulk} \),\( {\mu}_{Ga}={\mu}_{Ga}^{bulk} \) en \( {\mu}_{As}=\left({\ mu}_{SL}^{bulk}-{n}_{Al}\times {\mu}_{Al}^{bulk}-{n}_{Ga}\times {\mu}_{Ga} ^{bulk}\right)/{n}_{As} \), waarbij n Al , n Ga , en n Als vertegenwoordigen respectievelijk het aantal Al-, Ga- en As-atomen in de simulatiecel. Zoals weergegeven in Tabel 3, is de AlGa defect negatieve vormingsenergieën heeft, d.w.z. − 0,62 en − 0,27 eV onder respectievelijk As-rijke en kation-rijke omstandigheden, wat aangeeft dat de vorming van AlGa antisite defect is een exotherm proces. Wat betreft GaAl defect, zijn de vormingsenergieën zo klein als -0,01 eV onder As-rijke toestand en 0,29 eV onder kation-rijke toestand. Het is duidelijk dat de vorming van AlGa en GaAl antisite-defecten in de GaAs/AlAs SL-structuur zijn veel gemakkelijker dan andere puntdefecten. Onder As-rijke toestand, de vormingsenergieën van de tweede gunstige defecten van AsGa en AsAl worden bepaald op respectievelijk 1,67 en 1,74 eV. Voor de interstitials volgt de fasestabiliteit beide de trend van Gaint> Alint> Alsint onder As-rijke en kation-rijke omstandigheden. De defectvormingsenergieën in de GaAs / AlAs SL-structuur zijn ook uitgezet in figuur 3c. In vergelijking met de bulk GaAs zijn de puntdefecten in GaAs/AlAs SL over het algemeen moeilijker te vormen, behalve in het geval van Asint (zie afb. 3a, c). De vormingsenergieën van Asint in bulk zijn GaAs 5,20 en 5,81 eV onder As-rijke en Ga-rijke omstandigheden, die iets groter zijn dan de overeenkomstige waarden van 5,01 en 5,76 eV in GaAs/AlAs SL. Zoals getoond in Fig. 3b en c, vertoont de stabiliteit van puntdefecten in bulk AlAs- en SL-structuur een ander karakter. De AlAs en Asint defecten zijn energetisch gunstiger in GaAs/AlAs SL dan bulk AlAs, terwijl VAs defect heeft meer de voorkeur in bulk AlAs dan SL-structuur. Het is opmerkelijk dat onder As-rijke en Al-rijke omstandigheden de vormingsenergieën van Alint in bulk zijn AlAs vergelijkbaar met die in GaAs/AlAs SL. Vergelijkbaar met het geval van Alint , de VAl defect in bulk AlAs en SL-structuur vertonen vergelijkbare gunstige eigenschappen, zoals blijkt uit de vergelijkbare vormingsenergieën. In het geval van AsAl defect is, is de vormingsenergie onder As-rijke toestand kleiner (1,46 eV) in SL-structuur, terwijl onder kationrijke toestand de waarde kleiner is (3,10 eV) in bulk AlAs, wat suggereert dat de stabiliteit van AsAl hangt af van de chemische omgeving.
Als we de defectstabiliteit in bulk AlAs, GaAs en GaAs/AlAs SL vergelijken, vinden we dat de antisite-defecten altijd meer de voorkeur hebben dan vacatures en interstitials, vooral voor de gevallen van GaAl en AlGa in GaAs/AlAs SL. Er wordt ook opgemerkt dat onder As-rijke en kation-rijke omstandigheden de Asint defect is het moeilijkst te vormen in zowel bulktoestanden als de GaAs/AlAs SL-structuur.
De effecten van puntdefecten op de bandstructuren van GaAs/AlAs-superrooster
De ongerepte staat van GaAs/AlAs-superrooster
De band gaps voor bulk GaAs, AlAs en GaAs/AlAs SL zijn samengevat in Tabel 4, en hun bandstructuren zijn weergegeven in Fig. 4. De hybride DFT-berekeningen bepalen dat de directe band gap van GaAs 1,44 eV is (zie Fig. 4a). ), wat goed overeenkomt met de experimentele waarde van 1,52 eV [29] en andere berekeningen [24]. Daarentegen voorspelt de standaard DFT een band gap-waarde van 0,5 eV, wat de band gap van GaAs grotendeels onderschat. Voor AlAs is de bandstructuur van indirecte aard en is de hybride DFT-bandafstand 2.16 eV (zie figuur 4b), wat 0,85 eV groter is dan het DFT-resultaat en in goede overeenstemming met de experimentele waarde van 2,22 eV [23]. Zoals getoond in Fig. 4c, is bepaald dat de bandafstand van GaAs/AlAs SL direct is en het is consistent met de studie van Botti et al., die de bandafstand van (GaAs)m vond. /(AlAs)m SL (m ≥ 2) direct op het Γ punt [3]. In onze berekeningen is de directe band gap voor GaAs/AlAs SL bepaald op 2,06 eV volgens de hybride DFT-methode, wat in overeenstemming is met de experimentele waarde van 2,10 eV [30].

De bandstructuren van a GaAs, b AlAs en c GaAs/AlAs superrooster. De hybride DFT-waarden worden weergegeven in de linkerpanelen en de DFT-resultaten worden weergegeven in de rechterpanelen
De effecten van antisite-defecten op de bandstructuur van GaAs/AlAs-superrooster
In de GaAs/AlAs SL-structuur is de GaAl en AlGa antisite defecten zijn energetisch gunstiger dan andere puntdefecten. Zoals getoond in Fig. 5a en b, zijn de bandstructuren van GaAl en AlGa defecte toestanden lijken erg op die van de ongerepte toestand en de bandhiaten worden bepaald op respectievelijk 1,98 en 2,01 eV. Dit zou te wijten moeten zijn aan het feit dat de chemische elementen Al en Ga een vergelijkbare valentie-elektronenconfiguratie hebben, d.w.z. 3s 2 3p 1 voor Al en 4s 2 4p 1 voor Ga, en er worden geen extra elektronen of gaten geïntroduceerd bij de vorming van GaAl en AlGa antisite defecten. De bandstructuren voor AsGa en AsAl defecte toestanden zijn afgebeeld in de Fig. 5c en d. Het blijkt dat deze twee defecten de bandstructuur van GaAs/AlAs SL aanzienlijk wijzigen. Zowel de AsGa en AsAl antisietdefecten introduceren extra elektronen en fungeren als n-type doteringsmiddelen. De onzuiverheidsniveaus blijken ver van de valentiebanden te liggen en overschrijden het fermi-niveau, zoals weergegeven in Fig. 5c en d. Deze diepe defectniveaus kunnen fungeren als het recombinatiecentrum voor dragers.

De bandstructuren van defecte GaAs/AlAs-superroosters met verschillende antisite-defecten. een :Ga bezet de Al-roostersite; b :Al bezet de Ga-roostersite; c :Zoals het bezetten van de Ga-roostersite; d :Zoals het bezetten van de Al-roostersite
Figuur 6 toont de bandstructuren en partiële staatsdichtheid (PDOS) van defecte SL met GaAs en AlAls gebreken. Zoals getoond in Fig. 6a, is de bandstructuur voor GaAs defecte SL heeft een spinsplitsend karakter. In de spin-down subbanden passeert het fermi-niveau de defectniveaus die zijn geïntroduceerd door de GaAs defect, indicatief voor het halfmetalen karakter van de defecte SL. Volgens de definitie van de halfmetalen kloof [31] is de bandafstand van GaAs defecte staat is ongeveer 0,10 eV. Zoals weergegeven in de PDOS van de defecte SL met GaAs , worden de spin-down subbanden nabij het fermi-niveau voornamelijk bijgedragen door p gedeeltelijke golven. Vanwege de vergelijkbare valentie-elektronenconfiguraties tussen Ga- en Al-atomen, zijn de berekende spin-up en spin-down bandstructuren van AlAs defecte toestand worden bepaald (zie Fig. 6b), en de bandafstand wordt berekend op 0,15 eV. Over het algemeen is de AlGa en GaAl antisite-defecten hebben verwaarloosbare effecten op de elektronische structuur van GaAs/AlAs SL. Er wordt ook opgemerkt dat de defecte SL met AsAl en AsGa defecten vertonen metalliciteit, terwijl de defecte SL's met GaAs en AlAls zijn half-metalen.

De bandstructuren en gedeeltelijke toestandsdichtheid van defect GaAs/AlAs-superrooster met a GaAls en b AlAls antisite defecten. X Als (X =Ga of Al) X bezet de As-roosterplaats
De effecten van leegstandsdefecten op de bandstructuur van GaAs/AlAs-superrooster
De bandstructuren van de SL-structuur met verschillende vacatures zijn uitgezet in figuur 7, en hun corresponderende PDOS zijn afgebeeld in figuur 8. Het spinsplitsende karakter van de bandstructuur wordt ook gevonden in het geval van defecte SL met VGa en VAl gebreken, zoals weergegeven in Fig. 7a en b. Inderdaad, het verwijderen van atomen uit hun oorspronkelijke posities laat vier bungelende banden achter die verband houden met de sp 3 orbitalen. Tijdens de structurele relaxatie worden de dichtstbijzijnde atomen rond de vacature gelijkelijk verplaatst naar de lege roosterplaats, wat resulteert in plaatssymmetrie gedefinieerd door de tetragonale D 2d punten groep. De geïnduceerde defectniveaus verschijnen in de buurt van de valentieband en bevinden zich in het verboden gebied van de GaAs/AlAs SL. De band gap wordt bepaald op 0,47 en 0,44 eV voor de SL met VGa en VAl gebreken resp. Zoals weergegeven in de PDOS van defecte SL met VGa en VAl (zie Fig. 8a en b), de belangrijkste invloed van de vacatures van groep III is op de p staten. Zoals getoond in Fig. 7c, is de bandstructuur van de defecte SL met VAs defect splitst zich in spin-up en spin-down delen, en de defectniveaus verschijnen in de buurt van de geleidingsband. Sinds de VAs defect werkt als een n-type doteringsmiddel, het fermi-niveau verschuift naar hogere energie en kruist de rand van het defectniveau. Kahalie et al. hebben de elektrische eigenschappen van de GaAs-AlAs hetero-interfaces onderzocht en ontdekt dat VAs defect aan het grensvlak leidde tot quasi 2-DEG [7], wat consistent is met onze resultaten. Onze berekeningen laten zien dat de vacatures verschillende effecten hebben op de bandstructuur van GaAs/AlAs SL, d.w.z. de VAs defect induceert metalliciteit van GaAs/AlAs SL, en de VGa en VAl defecten verminderen de band gap van de SL-structuur aanzienlijk.

De bandstructuren van defect GaAs/AlAs superrooster met a VGa , b VAl en c VAls leegstand gebreken. V X (X =Ga, Al of As) X vacature

De partiële toestandsdichtheid van defect GaAs/AlAs superrooster met a VGa , b VAl en c VAls leegstand gebreken. V X (X =Ga, Al of As) X vacature
De effecten van interstitiële defecten op de bandstructuur van GaAs/AlAs-superrooster
Figuur 9 presenteert de bandstructuren van de SL-structuur met interstitiële defecten. Opgemerkt wordt dat het fermi-niveau verschuift naar hoge energie en de rand van de geleidingsband kruist (zie Fig. 9a en b), vanwege het feit dat de interstitials van groep III donorachtige defecten zijn. Bijgevolg zijn de defecte SL's met Gaint en Alint metalen karakter tonen. Zoals getoond in Fig. 9c, verschijnen in de spin-up en spin-down delen van de bandstructuur de onzuiverheidsniveaus in de buurt van de geleidingsband en het fermi-niveau kruist de rand van het onzuiverheidsniveau, wat wijst op de geïnduceerde metalliciteit van defecte GaAs/AlAs SL met Alsint . Het is duidelijk dat de interstitiële defecten de elektronische structuren van GaAs/AlAs SL aanzienlijk veranderen en in het algemeen de metalliciteit van de defecte SL-structuur induceren.

De bandstructuren van defect GaAs/AlAs superrooster met a Gaint defect, b Alint defect en c Alsint defect. X int (X =Ga, Al of As) X interstitial
Als we de bandstructuren en representatieve PDOS van de GaAs/AlAs SL vergelijken met antisites, vacatures en interstitials, zien we dat de defecten de elektronische structuren aanzienlijk wijzigen, behalve de gevallen van GaAl en AlGa antisite defecten. Bovendien wordt de band gap smaller en zelfs metalliciteit geïnduceerd, wat de prestaties van GaAs/AlAs SL drastisch zal beïnvloeden.
De effecten van puntdefecten op de elektronenmobiliteit van GaAs/AlAs-superrooster
De elektronenmobiliteit bij 0 K kan worden berekend met de vergelijking μ = eτ /m ∗ , waar e is de elektronenlading, τ is de ontspanningstijd, en m ∗ is de effectieve massa van de drager [32]. De effectieve elektronenmassa's kunnen worden bepaald aan de hand van de kromming van de bandstructuren via de relatie \( {m}^{\ast }={\mathrm{\hslash}}^2{\left(\frac{d^2\varepsilon }{dk^2}\right)}^{-1} \) [32], waarbij ℏ de gereduceerde constante van Planck is, k is de golfvector, en ε is de energie van de geleidingsband minimum. Zoals getoond in Fig. 4a en b, verkrijgen we m * = 0.057 m e voor GaAs en m * = 0.19 m e voor AlAs, goed overeenstemmend met de experimentele waarden van 0,057 m e voor GaAs [33] en 0,124 m e voor AlAs [34], waarbij m e is de statische elektronenmassa. Er wordt aangenomen dat de relaxatietijd voor AlAs en GaAs respectievelijk 0,17 en 0,48 ps is [35]. De elektronenmobiliteit van GaAs en AlAs bij 0 K wordt berekend als 1,48 × 10 4 cm 2 /Vs en 1.57 × 10 3 cm 2 /Vs, wat vergelijkbaar is met de experimentele waarden van 0.94 × 10 4 cm 2 /Vs voor GaAs [36] en 0.28 × 10 3 cm 2 /Vs voor AlAs [37].
Zoals weergegeven in Tabel 5, wordt de effectieve massa van het elektron in het Г-punt (\( {m}_{\Gamma}^{\ast } \)) bepaald op 0,113 m e voor de ongerepte GaAs/AlAs SL en de relaxatietijd τ wordt verondersteld 0,4 ps te zijn [38]. De elektronenmobiliteit langs de z-richting, d.w.z. de Γ-X-richting in de Brillouin-zone (μ Γ − X ) wordt berekend als 0,623 × 10 4 cm 2 /Vs voor ideale GaAs/AlAs SL, vergelijkbaar met de experimentele waarde van 1,0 × 10 4 cm 2 /Vs [38]. Wat betreft de defecte SL met antisite-defecten, de waarde van μ Γ − X is vergelijkbaar met die voor de ideale SL, behalve de gevallen van GaAs en AlAls gebreken. De elektronenmobiliteit langs de Γ-X-richting wordt bepaald op 0,263 × 10 4 cm 2 /Vs en 0.311 × 10 4 cm 2 /Vs voor GaAs en AlAls defecte toestanden, die veel kleiner zijn dan die voor de ideale toestand. Opgemerkt wordt dat de Gaint , Alint en Asint defecten verminderen ook de elektronenmobiliteit aanzienlijk, zoals aangegeven door de waarden van 0.225 × 10 4 cm 2 /Vs voor Gaint , 0.243 × 10 4 cm 2 /Vs voor Alint en 0,315 × 10 4 cm 2 /Vs voor Asint . In vergelijking met antisite- en interstitiële defecten hebben de vacatures de meest ingrijpende effecten. Voor VGa en VAl defecten, de waarden van μ Γ − X zijn ongeveer zes keer kleiner dan die van ongerepte staat. De VAls defect vermindert ook significant de elektronenmobiliteit, zoals aangegeven door 0.127 × 10 4 cm 2 /Vs. Tanaka et al. hebben de effecten van elektronenbestraling op de elektrische eigenschappen van GaAs/AlGaAs-heterostructuren onderzocht en zij ontdekten dat de elektronenmobiliteit was verminderd bij doses hoger dan 5 × 10 20 cm −2 [10]. Vooral het ontstaan van defecten in het GaAs-kanaalgebied, in plaats van de n-AlGaAs-laag, wordt beschouwd als de belangrijkste oorzaak van de achteruitgang van de mobiliteit [10]. Recently, it has been suggested that the electrons are possibly trapped by defects or impurity and produce metastable states accompanied by lattice relaxation [39]. Consequently, the electronic structure and carrier mobility of GaAs/AlAs SL are influenced significantly by the point defects. Therefore, it is necessary to enhance the radiation tolerance of GaAs/AlAs SL to improve its electronic performance under radiation environment.
Conclusies
In this work, a hybrid density functional theory study is performed to investigate the effects of point defect on the electrical properties of GaAs/AlAs superlattice (SL). The calculated defect formation energies show that the antisite defects are the most favorable in bulk GaAs and AlAs. In GaAs/AlAs SL structure, the antisite defects are always dominant under cation-rich and As-rich conditions and the interstitial defects are very difficult to form during the whole range of chemical potentials. It is shown that the different point defects have various effects on the electronic structures of GaAs/AlAs SL. The AsX (X =Al or Ga) and XAs antisite defects always induce metallicity, although the defective SLs with XAs antisites show spin splitting. As for vacancies, the defective SL with VAs shows metallicity character, and the group III vacancy defects reduce the band gap of the superlattice significantly. The metallicity is also found in the defective GaAs/AlAs SL with the interstitial defects. The further carrier mobility calculations show that the interstitial and vacancy defects reduce the electron mobility significantly, while the antisite defects have relatively smaller influence.
Afkortingen
- 2-DEG:
-
Two-dimensional electron gas
- AIMD:
-
Ab initio molecular dynamics
- Al:
-
Aluminium
- AlAs:
-
Aluminum arsenide
- As:
-
Arsenic
- AsX :
-
As occupying the X lattice site
- DFT:
-
Dichtheidsfunctionaaltheorie
- Ga:
-
Gallium
- GaAs:
-
Gallium arsenide
- HEMT:
-
High electron mobility transistors
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Light-emitting diode
- N:
-
Stikstof
- PDOS:
-
Partial density of state
- QCLs:
-
Quantum cascade lasers
- SL:
-
Superlattice
- VASP:
-
Vienna Ab Initio Simulation Package
- VX (X =Ga, Al or As):
-
X vacancy
- XAs :
-
X occupying the As lattice site
- Xint :
-
X interstitial
- Zn:
-
Zinc
Nanomaterialen
- Onthulling van de atomaire en elektronische structuur van gestapelde koolstof nanovezels
- Ultra-smalle band Perfect Absorber en zijn toepassing als plasmonische sensor in het zichtbare gebied
- First-Principles Study on the Stability and STM Image of Borophene
- Effect van in situ gloeibehandeling op de mobiliteit en morfologie van op TIPS pentaceen gebaseerde organische veldeffecttransistoren
- De effecten van Li/Nb-verhouding op de voorbereiding en fotokatalytische prestaties van Li-Nb-O-verbindingen
- Invloed van water op de structuur en diëlektrische eigenschappen van microkristallijne en nano-cellulose
- Effecten van dubbellaagse dikte op de morfologische, optische en elektrische eigenschappen van Al2O3/ZnO-nanolaminaten
- Experimenteel onderzoek naar de stromings- en warmteoverdrachtskenmerken van TiO2-water-nanovloeistoffen in een spiraalvormig gecanneleerde buis
- De koppelingseffecten van oppervlakteplasmonpolaritons en magnetische dipoolresonanties in metamaterialen
- Onderzoek naar het weerstandsschakelgeheugen op meerdere niveaus en de van de geheugentoestand afhankelijke fotospanning in Pt/Nd:SrTiO3-knooppunten
- Ontwerp en aanpassing van de grafeen-werkfunctie via grootte, modificatie, defecten en doping:een eerste-principe theorie-onderzoek



