Een onderzoek naar de variabiliteit in contactresistief willekeurig toegankelijk geheugen door stochastisch vacaturemodel
Abstract
Variabiliteit in resistieve willekeurig toegankelijke geheugencellen is een van de kritieke uitdagingen geweest voor de ontwikkeling van RRAM-arrays met hoge dichtheid. Hoewel de bronnen van variabiliteit tijdens resistief schakelen variëren voor verschillende overgangsmetaaloxidefilms, wordt algemeen aangenomen dat het ontstaan/recombinatie van stochastische zuurstofvacatures de dominante oorzaak is. Door experimentele gegevens te analyseren, wordt een stochastisch model tot stand gebracht dat de daaropvolgende schakelkarakteristieken koppelt aan de initiële toestanden van contact-RRAM-cellen. Door een geleidingsnetwerkmodel en het trap-geassisteerde tunnelmechanisme te combineren, worden de effecten van concentratie en distributie van intrinsieke zuurstofvacatures in RRAM-diëlektrische film gedemonstreerd met Monte Carlo-simulatie. De meetgegevens op contact-RRAM-arrays komen goed overeen met kenmerken die door het model worden geprojecteerd op basis van de aanwezigheid van willekeurig verdeelde intrinsieke vacatures. Er is een sterke correlatie tussen vormingskenmerken en begintoestanden geverifieerd, die vormingsgedrag koppelt aan voorvormende zuurstofvacatures. Deze studie biedt een uitgebreid begrip van variabiliteitsbronnen in contact-RRAM-apparaten en een reset-trainingsschema om het variabiliteitsgedrag in de daaropvolgende RRAM-statussen te verminderen.
Achtergrond
Resistive Random Access Memory (RRAM) wordt beschouwd als een veelbelovende oplossing voor niet-vluchtige gegevensopslag, vanwege de gewenste eigenschappen, zoals laag stroomverbruik, hoge P/E-snelheid en superieure compatibiliteit met CMOS-logica-proces [1,2,3 ,4]. Er zijn echter nog veel obstakels die overwonnen moeten worden om RRAM-geheugenarrays gemakkelijk te implementeren in de huidige state-of-the-art CMOS-circuits [5, 6]. Een van de belangrijkste uitdagingen bij omvangrijke RRAM-arrays is de variatie die bestaat tussen en binnen cellen [7,8,9,10]. Er zijn veel modellen en simulaties voorgesteld om het stochastische generatie/recombinatieproces van zuurstofvacature (Vo-) in transitiemetaaloxide (TMO) film te beschrijven [11,12,13,14]. Kim en Brivio stelden netwerkmodellen voor willekeurige stroomonderbrekers voor om de typische elektrische kenmerken van respectievelijk unipolair en bipolair RRAM te emuleren [11, 12]. De weerstanden in deze onderzoeken waren echter allemaal constant ingesteld zonder rekening te houden met elektronentransport in RRAM-film. Bovendien, omdat gepresenteerde modellen stochastische processen van RRAM vanuit een enkel apparaatniveau bespreken in plaats van statistische analyse, is de variabiliteit van RRAM-gedrag in een array niet goed behandeld en besproken in eerder werk [11,12,13,14]. Bovendien is de aanwezigheid van defecten in diëlektrische film tijdens fabricage vele jaren uitgebreid bestudeerd [15, 16], maar de impact ervan op resistieve schakelkarakteristieken in RRAM moet nog uitgebreid worden geanalyseerd voordat de technologie kan worden toegepast in omvangrijke geheugenmacro's. Om het effect van intrinsieke Vo-distributie op de RRAM-karakteristieken te onderzoeken, is een weerstandsnetwerk gemodelleerd naar het trap-geassisteerde tunnelmechanisme gebouwd voor verdere statistische analyse van de variatie en tijdens operaties in deze studie [11,12,13,14, 17 ]. Bovendien wordt het stochastische generatieproces van Vo- gesimuleerd door de Monte Carlo-methode om de correlatie tussen het RRAM in zijn begintoestand en de volgende vormingskenmerken vast te stellen [18,19,20]. De sterke correlatie tussen intrinsieke Vo- en vormingsspanning wordt vastgesteld door het simulatieresultaat te verifiëren met gemeten gegevens op contact-RRAM-arrays [21]. Ten slotte worden verschillende typen geleidend filament (CF) gegenereerd en variatie in weerstandstoestanden na vormingsbewerkingen als gevolg van de intrinsieke Vo-verdeling geprojecteerd en uitgebreid onderzocht. Bovendien wordt in deze studie een oplossing voorgesteld en gedemonstreerd om de impact van het voorvormen van Voon-variabiliteit te verminderen.
Methoden
De meetgegevens voor verdere statistische analyse van variabiliteit worden verzameld uit 16 × 16 contact RRAM (CRRAM)-arrays die zijn gefabriceerd door 28-nm CMOS-logische processen, waarbij het fabricageproces van CRRAM wordt geïllustreerd in figuur 1 [21]. De weerstandsbeschermingsoxide (RPO) laag en tussenlaag diëlektricum (ILD) worden eerst afgezet nadat het front-end proces is voltooid met de gevormde transistors. Om een functionele resistieve schakelfilm te construeren, wordt de juiste grootte van de contactgaten, een contactgrootte van 30 nm × 30 nm, uitgevoerd om kortsluiting van de W-stekker en het n + diffusiegebied te voorkomen. Ten slotte worden de barrièrelaag, TiN en wolfraamplug afzonderlijk afgezet. Het transversale TEM-beeld van CRRAM wordt getoond in figuur 2a. Zoals op de afbeelding te zien is, is CRRAM serieel verbonden met een n-kanaals select-transistor. Er is een 1T1R-structuur toegepast om een juiste selectie in een array te garanderen en overshoots te voorkomen. Afbeelding 2b toont de compositietoewijzing van CRRAM. De overgangsmetaaloxidelaag (TMO), met een dikte van 9 nm, bestaande uit TiN/TiON/SiO2 gestapeld wordt gevormd tussen de bovenste wolfraam- en onderste siliciumelektroden. Na de fabricage van het apparaat worden elektrische analyse en fysieke modelbouw in deze studie voltooid door respectievelijk Aglient 4156C halfgeleiderparameteranalysator en MATLAB-softwareplatform.
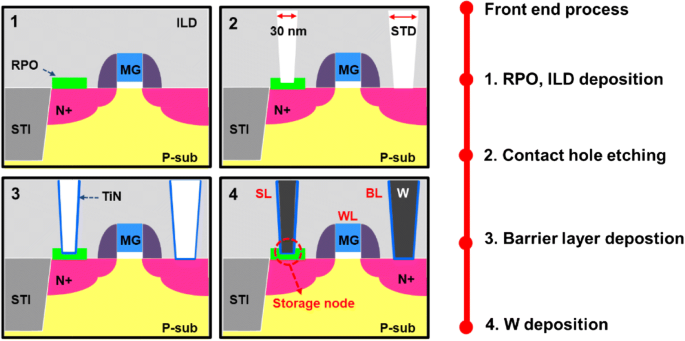
Processtroom van contact-RRAM op een 28-nm high-k metal gate CMOS logisch procesplatform. Kleinere contactgrootte voor CRRAM is ontworpen om de etsdikte te regelen om een functionele resistieve schakellaag te vormen
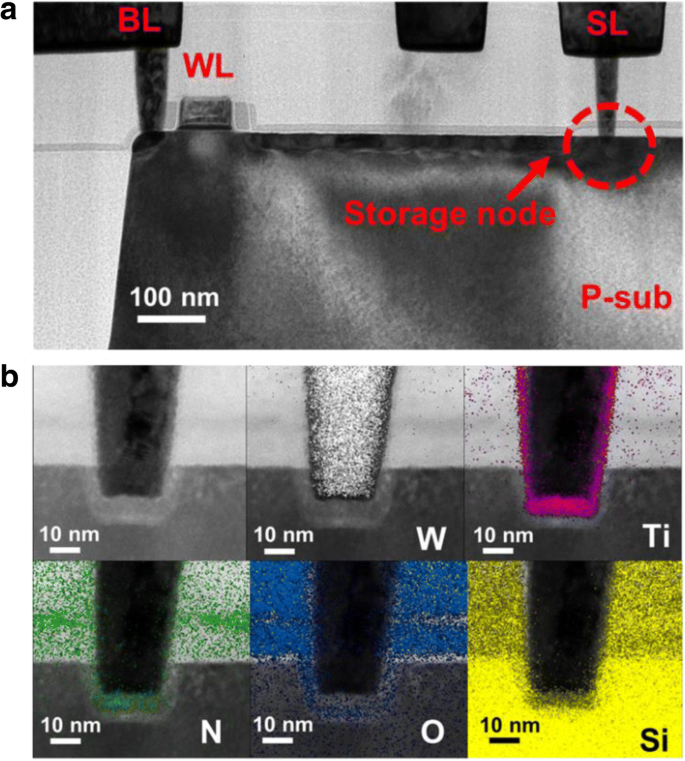
een Dwarsdoorsnede TEM-beeld van 1T1R CRRAM-structuur. b Composition mapping van CRRAM. De resistieve schakelfilm is samengesteld uit TiN/TiON/SiO2 ingeklemd tussen de bovenste wolfraamplug en de onderste Si-elektrode
Zoals gerapporteerd in een eerdere studie [22], wordt een brede verdeling van initiële toestanden gevonden op CRRAM-array. Om de oorsprong van de initiële toestandsvariatie te onderzoeken, worden eerst de dikten van de TMO-laag met verschillende initiële weerstanden vergeleken in figuur 3. Gegevens suggereren geen significant verschil in dikte tussen de twee cellen met een groot verschil in initiële weerstandsniveaus. Veel studies zijn gemeld dat Vo- wordt gegenereerd in diëlektrische of RRAM-film tijdens fabricage [23,24,25,26], wat impliceert dat het verschil in aantal en dichtheid van Vo- naar verwachting verantwoordelijk is voor de initiële geleidbaarheidsvariaties.
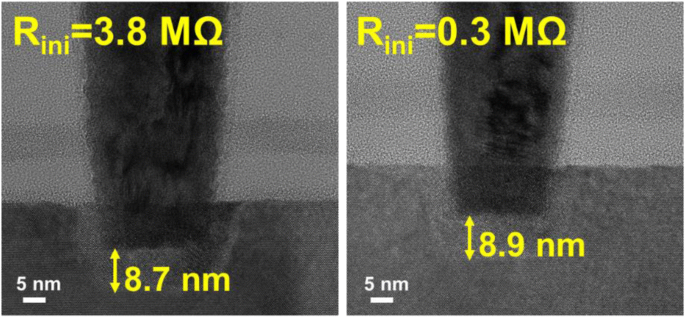
Vergelijking van TMO-laagdikte tussen twee CRRAM-cellen met groot aanvankelijk weerstandsverschil. Beide cellen worden waargenomen met een diëlektrische laagdikte van ongeveer 9 nm
Resultaten en discussie
Intrinsiek model voor vacatureverdeling
Om de interacties tussen intrinsieke Vo- na te bootsen, wordt een weerstandsnetwerkmodel weergegeven in Fig. 4a vastgesteld [11,12,13,14]. De weerstanden in elk raster worden berekend via een simulatiestroom die wordt beschreven in figuur 4b, terwijl de overeenkomstige fysieke parameters die worden gebruikt in tabel 1 worden vermeld. Gebaseerd op een TEM-afbeelding van CRRAM, een tweedimensionale structuur met een breedte van 30 nm, een dikte van 10 nm , is gedefinieerd voor het beschrijven van de TMO-laag, zoals weergegeven in figuur 5a. De weerstand van de oxideplaats, R oxide , en mesh grid worden bepaald door de materiaaleigenschap van anatase-TiO2 , dat in veel onderzoeken als resistief schakelmateriaal is gebruikt [27,28,29,30]. Vanwege de tetragonale structuur zijn de roosterconstanten van anatase-TiO2 variëren met de kristallografische as. Voor de eenvoud zijn mesh-rasters in ons model allemaal ingesteld op 1 nm door de roosterconstante in de c-richting van anatase-TiO2 te introduceren [31,32,33]. Verder worden weerstanden voor roosters ook bepaald door te verwijzen naar de soortelijke weerstand van anatase-TiO2 [34, 35]. Zoals weergegeven in figuur 5a, worden aanvankelijk willekeurig verdeelde Vo- in het 2D-mesh gegeven. De temperatuur- en elektrische veldafhankelijkheden van de geleidingsstroom van CRRAM zijn respectievelijk samengevat in Fig. 6a, b. De belangrijkste kenmerken van trap-assisted tunneling (TAT)-stroom worden aangetoond door het effect bij lage temperatuur en de lineaire afhankelijkheid tussen ln(J) en 1/E [17, 36]. Met behulp van het TAT-geleidingsmodel moet eerst het potentiaalprofiel in de TMO-film worden berekend om elke gelokaliseerde Vo-weerstand verder te verkrijgen. De verdeling van Vo- zal naar verwachting een dominante invloed hebben op de geleidende stroom, aangezien de tunnelafstand varieert tussen zuurstofvacatures. De weerstand van Vo-, R ij , wordt vervolgens berekend door Vgl. 1, die de kansen van Vo-aanwezigheid op de locatie in overweging neemt en het TAT-model gebruikt, voor het berekenen van de tunneling-kans tussen vacatures.
$$ {R}_{\mathrm{ij},N}=\frac{R_{\mathrm{oxide}}}{\alpha\ {C}_{\mathrm{Vo}-}^{\kern0.75em \beta }\ \exp \left(\frac{\phi }{d}\right)} $$ (1)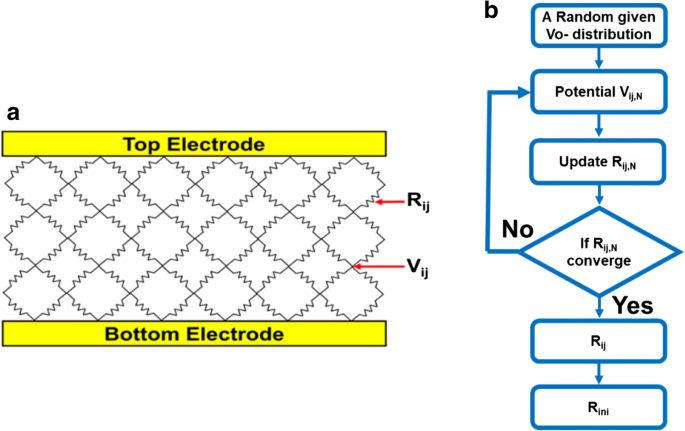
een Schema van weerstandsnetwerkmodel samengesteld door variabele gelokaliseerde weerstand van Vo-. Nodes in dit netwerk zijn met elkaar verbonden om de interactie tussen Vo- te simuleren. b Variabiliteitssimulatiestroom van het initiële weerstandsniveau. De stochastische verdeling van intrinsieke Vo-emerim tijdens fabricage wordt beschouwd volgens de Monte Carlo-methode

een Willekeurige verdeling van intrinsieke Vo- wordt aanvankelijk gegeven in RRAM-film. b Gelokaliseerde weerstandsverdeling van Vo- berekend door trap-geassisteerde tunneling-overweging. c R ini distributie van verse cellen verzameld uit CRRAM-arrays komt goed overeen met de simulatiegegevens door het TAT-geleidingsmechanisme van het voorvormen van Vo-
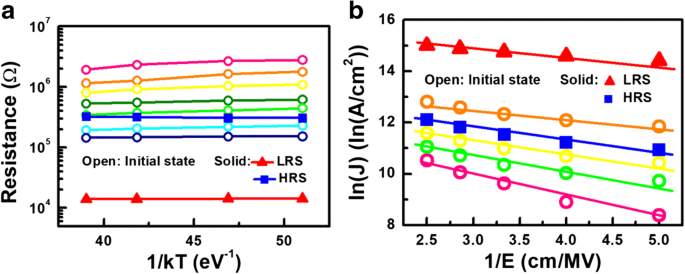
Het geleidingsmechanisme van CRRAM wordt bepaald door a . aan te vinken temperatuurafhankelijkheid en b elektrische veldafhankelijkheid. Trap-geassisteerde tunneling gevolgd door CRRAM wordt verondersteld door twee geleidingskenmerken, zwakke temperatuurafhankelijkheid en lineair passend tussen ln(J) en 1/E
Elke R ij,N wordt in elke iteratie bijgewerkt totdat het resultaat uiteindelijk convergeert. Als de laatste R ij verdeling wordt verkregen, zoals geïllustreerd in Fig. 5b, de algehele weerstand, R ini , van een verse cel kan ook later worden geprojecteerd, zoals weergegeven in figuur 5c. Zoals te zien is in figuur 5c, is de variatie van gesimuleerde R ini verdeling verkregen door voorgestelde simulatiestroom rekening houdend met stochastische verdeling en concentratie van intrinsieke Vo- redelijk goed eens met de verdeling van de R ini gemeten op CRRAM-arrays. Daarom dragen willekeurig verdeelde intrinsieke Vo-in TMO-lagen, die meerdere tunnelingpaden creëren, bij aan de wijdverspreide initiële weerstand die wordt aangetroffen bij het voorvormen van CRRAM-arrays.
Analyse van niet-uniform vormingsproces
Na het modelleren van oorzaken die worden toegeschreven aan de cel-tot-cel variatie in de verse toestand, wordt de vormingsbewerking, het initialiseren van de resistieve schakelkarakteristieken, geanalyseerd. De simulatiestroom van de vormingsbewerking in de DC-zwaaimodus wordt getoond in Fig. 7 [18,19,20]. Zoals weergegeven in figuur 8a, is een cel in serie verbonden met een geselecteerde transistor met een kanaalweerstand van ongeveer 5 KΩ in lineair gebied en een verzadigingsstroom van ongeveer 80 μA. Als gevolg van de lage vormingsspanning moeten de geleidings- en spanningsmechanismen van diëlektricum in een laag elektrisch veldregime worden overwogen. Op basis van het thermisch-chemische model dat in eerdere studies werd voorgesteld, is een nauwkeurige voorspelling van diëlektrisch falen aangetoond [37,38,39,40]. Theoretisch doorslaggedrag van TiO2 gesimuleerd door het thermische chemische model [41] heeft vergelijkbare kenmerken laten zien als die waargenomen in CRRAM. Daarom wordt de Vo-generatiesnelheid verkregen op basis van het thermische chemische model hier [42,43,44]. Zoals gesuggereerd door het thermisch-chemische model, worden de rasterpunten naast Vo- gedefinieerd als een zwakke plek in de buurt van de defecten. De aanwezigheid van Vo- induceert ook een gelokaliseerd verbeterd veld, weergegeven in figuur 8b, en versnelt het generatieproces van Vo- [45]. Gezien de tijd tot het diëlektrische doorslagproces in het thermisch-chemische model met een veldafhankelijkheid van exp.(−E), is de kans op Vo-generatie P ij wordt berekend met de volgende vergelijking [42].
$$ {P}_{\mathrm{ij}}=\gamma\ \exp \left(\mathrm{E}\right)\ \left\{\begin{array}{c}\kern1.75em \upgamma =0,\mathrm{if}\ \mathrm{site}\ \mathrm{is}\ \mathrm{niet}\ \mathrm{weak}\ \mathrm{spot}\\ {}\upgamma =1,\mathrm{if }\ \mathrm{site}\ \mathrm{is}\ \mathrm{zwak}\ \mathrm{spot}\end{array}\right. $$ (2)
Simulatiestroom van een vormingsproces op basis van het thermisch-chemische model, door uit te gaan van de diëlektrische faaltijd met elektrische veldafhankelijkheid van exp.(−E)
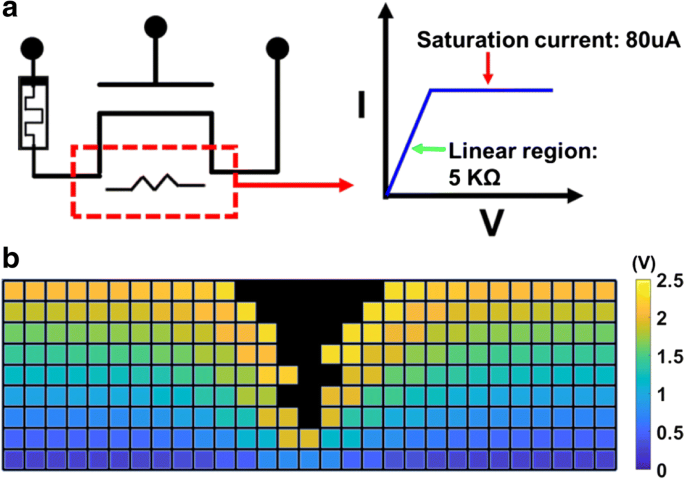
een Forming operatie wordt gesimuleerd door een CRRAM serieel verbonden met een ideale transistor. b Niet-uniforme elektrische potentiaalverdeling, als gevolg van reeds bestaande Vo-, induceert een gelokaliseerd veld en versnelt het genereren van nieuwe defecten
Een kritiek niveau, P g , en een criterium, P ij> P g , worden gedefinieerd om te bepalen of er een nieuwe Vo- wordt gegenereerd. Een ramping-proces wordt toegepast om de nieuwe Vo-verdeling bij elke iteratie bij te werken totdat de vormingsspanning 2,7 V bereikt. Ten slotte, met een willekeurig verdeelde intrinsieke Vo-, het lage weerstandsniveau R vorming na het vormen kan de verrichting worden verkregen. Gebaseerd op het bovenstaande model, de gesimuleerde R vorming de verdeling vertoonde een grote variatie, zoals weergegeven in figuur 9a, en de berekende I-V kenmerken komen goed overeen met gemeten gegevens. Verder wordt ook de correlatie tussen vormingskenmerken en begintoestanden onderzocht. Hogere concentratie en plaatselijk verdeelde Vo- versnellen het vormingsproces. Daarom positieve correlatie tussen vormingsspanning en R ini zijn te vinden in zowel simulatieresultaten als gemeten gegevens, zoals weergegeven in Fig. 9b.
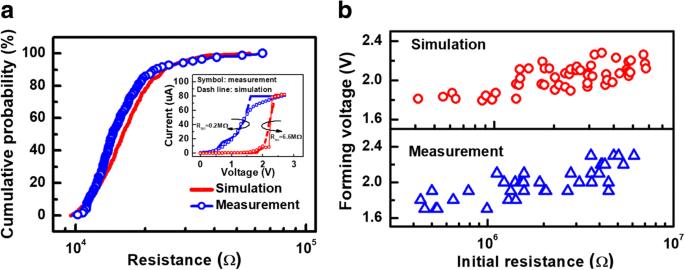
een Gesimuleerde weerstandsverdeling van vormbewerking komt goed overeen met meetresultaat. b Positieve correlaties tussen initiële weerstand en vormingsspanning worden gevonden in zowel gemeten als gesimuleerde gegevens vanwege meer zwakke punten en hogere elektrische veldsterkte geproduceerd door voorvormen. Vo-
Bovendien induceert Vo-gegenereerd tijdens het vormen een geleidend pad en resulteert in een verandering van CF in cellen, waar de evolutie van CF tijdens het vormingsproces wordt weergegeven in Fig. 10. Voor cellen met een hoge R ini , zijn er minder intrinsieke Vo- en minder zwakke plekken, zoals geïllustreerd in Fig. 10a. Na de vormingsbewerking is het waarschijnlijker dat er een enkel geleidend pad optreedt tussen de elektroden. De groei van CF in cellen met veel intrinsieke Vo- getoond in Fig. 10b is echter meer wijdverbreid; vandaar dat dendritische CF wordt gegenereerd na vorming. De correlatie tussen verschillende CF-topografieën en de Vo-verdeling in verse toestand wordt ook geverifieerd door meetgegevens. Van Vo- en CF in de TMO-laag is bekend dat ze leiden tot onderscheidende willekeurige telegraafruis (RTN) tijdens het proces voor het vangen/ontvangen van elektronen [46]. Weerstandsfluctuaties treden op als het geleidende pad wordt geblokkeerd door ingesloten elektronen, en de weerstand neemt af wanneer elektronen worden ontvangen. RTN-analyse van CRRAM na vorming is samengevat in Fig. 11. Regelmatige weerstandsfluctuatie in twee stappen wordt gevonden in cellen met een hoge R ini , wanneer het vangen/ontvangen van elektronen plaatsvindt in een apparaat met één dominante CF. Aan de andere kant wordt RTN op meerdere niveaus gevonden in cellen met een lage R ini die naar verwachting de dendritische CF met meer dan één pad zal belemmeren. Het statistische resultaat van RTN is samengevat in Fig. 12, door RTN-meting van meer dan 200 CRRAM-cellen te analyseren. Gegevens suggereren dat cellen met een hoge R ini hebben de neiging om alleen bi-level RTN te vertonen, wat waarschijnlijker voorkwam in apparaten met één dominante CF [46,47,48,49]. De weerstandsvariatie na het vormen is gerangschikt in Fig. 13. Gegevens suggereren dat hogere weerstandsvariaties worden gevonden in zowel de meet- als simulatieresultaten in de cellen met een lage R ini . Omdat de minder beperkte CF's de geselecteerde transistor het verzadigingsgebied vroeg binnendringen, wordt een cel mogelijk niet goed gevormd, wat leidt tot bredere weerstandsniveaus met een lage weerstand.

Voortgang van CF in cel met a hoge initiële weerstand en b lage initiële weerstand. Hogere intrinsieke Vo-concentratie in de TMO-laag resulteert in Vo-willekeurige generatie op zwakke plekken. Deze Vo- verbinden ook met elkaar om dendritische paden te vormen

De topografieën van CF in cel met a hoge initiële weerstand en b lage initiële weerstand worden geanalyseerd door de bijbehorende RTN-gegevens. Het optreden van meervoudige weerstandsfluctuaties in cellen met een lage initiële weerstand en meer intrinsiek Bevordert het bestaan van dendritische CF's in de TMO-laag

De correlatie tussen het initiële weerstandsniveau en het RTN-niveau op CRAM-cellen wordt samengevat. Er wordt verwacht dat er een grotere kans op bi-level weerstandsfluctuatie zal optreden voor cellen met één dominant geleidend pad, dat sterk correleerde met cellen met een hoge R ini
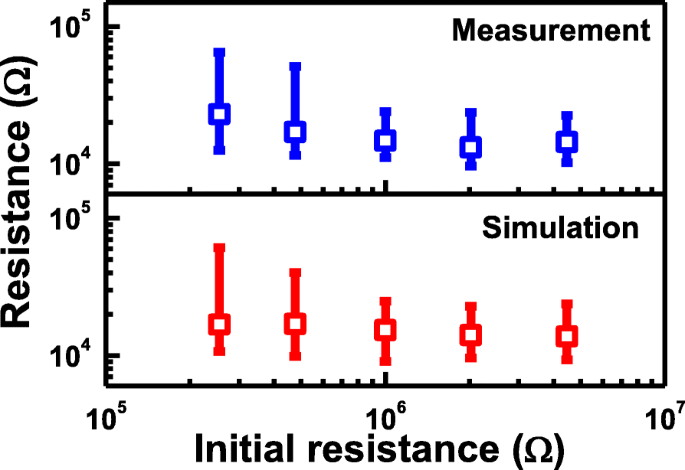
Analyse van weerstandsniveauvariatie na vormingsbewerking wordt onderzocht door zowel simulatie als meting. Hogere variatie geïnduceerd door dendritische CF-generatie wordt gevonden in cellen met een lage initiële weerstand
Om vormingsvariabiliteit veroorzaakt door intrinsieke Vo- in de TMO-laag te verminderen, wordt voorgesteld een reset-trainingsbewerking, die SL naar 1,4 V veegt onder een vaste WL-spanning van 2 V, blindelings toe te passen op hele geheugencellen in CRRAM-array voordat ze worden gevormd. Deze operatie zal naar verwachting reeds bestaande defecten vernietigen die bestaan in cellen met een lage R ini en om te zorgen voor een beter begrensde CF-groei tijdens het daaropvolgende vormingsproces. Vanwege de lage aangelegde spanning is er geen verandering in cellen met een hoge R ini na het opleidingsproces. Met een algemene reset-trainingsoperatie wordt de weerstand van cellen met een lage R ini , neemt toe zonder de cellen te storen met een hoge R ini , zoals weergegeven in Fig. 14. Vervolgens kunnen meer uniforme vormkenmerken worden verkregen.

Er wordt voorgesteld om een algemene reset-training toe te passen op de CRRAM-array. Resistentie in cellen met een lage R ini wordt verhoogd door intrinsieke defecten te vernietigen, maar cellen met een hoge R ini is niet gestoord
Conclusies
Een weerstandsnetwerkmodel dat rekening houdt met het lokale veldeffect en trap-geassisteerde tunnelgeleiding tussen Vo- is met succes tot stand gebracht. Door middel van Monte Carlo-simulatie wordt celvariabiliteit op de initiële weerstand en het vormingsproces onderzocht. De variatie in de verse toestanden van CRRAM kan met succes worden verklaard door een willekeurig gegeven verdeling van intrinsieke Vo-. Geprojecteerde weerstandsverdeling na vorming komt ook goed overeen met het meetresultaat door het thermisch-chemische model te gebruiken. De groei van CF tijdens de vorming wordt besproken en gekoppeld aan de waargenomen variabiliteit in dit proces. Ten slotte wordt een reset-trainingsoperatie voorgesteld om de vormingsvariabiliteit veroorzaakt door intrinsieke Vo-in de TMO-laag verder te verminderen. Een sterke correlatie tussen initiële toestanden en vormingskenmerken biedt richtlijnen voor nieuwe adaptieve operaties voor toekomstige ontwikkeling van RRAM-technologieën.
Afkortingen
- CF:
-
Geleidend filament
- CRRAM:
-
Contact resistief willekeurig toegankelijk geheugen
- CVo- :
-
Vo-concentratie
- d:
-
Tunnelafstand
- E:
-
Elektrisch veld
- ILD:
-
Tussenlaag diëlektricum
- N :
-
Iteratietijd
- P g :
-
Drempelwisselkans
- P ij :
-
Waarschijnlijkheid van Vo-generatie
- R vorming :
-
Weerstand na vormbewerking
- R ij :
-
Gelokaliseerde weerstand van Vosite
- R ini :
-
Initiële weerstandsstatus
- R oxide :
-
Gelokaliseerde weerstand van oxideplaats
- RPO:
-
Weerstand bescherming oxide
- RRAM:
-
Resistief willekeurig toegankelijk geheugen
- RTN:
-
Willekeurig telegraafgeluid
- TAT:
-
Trap-geassisteerde tunneling
- TMO:
-
Overgangsmetaaloxide
- V f :
-
Vormspanning
- V ij :
-
Potentieel
- Vo-:
-
Zuurstoftekort
- α :
-
Aanpasparameter
- β :
-
Aanpasparameter
- γ :
-
Aanpasparameter
- ϕ :
-
Elektrisch potentiaalverschil
Nanomaterialen
- CASE STUDY:De Honda-manier
- Yantracraft en de Gouden Tempel
- Retentiemodel van TaO/HfO x en TaO/AlO x RRAM met zelfherstellende schakelkenmerken
- De studie van een nieuw, door nanodeeltjes versterkt, wormachtig micellair systeem
- Een RRAM-geïntegreerde 4T SRAM met zelfremmende resistieve schakelbelasting door puur CMOS logisch proces
- First-Principles Study on the Stability and STM Image of Borophene
- Het effect van contactloos plasma op structurele en magnetische eigenschappen van Mn Х Fe3 − X О4 Spinels
- Onderzoek naar het weerstandsschakelgeheugen op meerdere niveaus en de van de geheugentoestand afhankelijke fotospanning in Pt/Nd:SrTiO3-knooppunten
- Een collectief onderzoek naar modellering en simulatie van resistief willekeurig toegankelijk geheugen
- Een tweestapsmethode om de invloed van aggregatie/agglomeratie van nanodeeltjes op Young's Modulus of Polymer Nanocomposites te bestuderen
- Vergelijkende studie van de elektrochemische, biomedische en thermische eigenschappen van natuurlijke en synthetische nanomaterialen



