Bipolaire effecten in fotovoltage van metamorfe InAs/InGaAs/GaAs Quantum Dot heterostructuren:karakterisering en ontwerpoplossingen voor lichtgevoelige apparaten
Abstract
Het bipolaire effect van GaAs-substraat en nabijgelegen lagen op fotovoltage van verticale metamorfe InAs/InGaAs in vergelijking met pseudomorfe (conventionele) InAs/GaAs quantum dot (QD) structuren werden bestudeerd. Zowel metamorfe als pseudomorfe structuren werden gekweekt door middel van moleculaire bundelepitaxie, met behulp van bodemcontacten op ofwel de gegroeide n + -buffers of het GaAs-substraat. De kenmerken met betrekking tot QD's, bevochtigingslagen en buffers zijn geïdentificeerd in de foto-elektrische spectra van beide met buffer in contact gebrachte structuren, terwijl de spectra van met substraat in contact gebrachte monsters het extra begin vertoonden dat werd toegeschreven aan EL2-defectcentra. De met het substraat in contact gebrachte monsters vertoonden bipolaire fotospanning; Er werd gesuggereerd dat dit zou plaatsvinden als gevolg van de concurrentie tussen componenten die verband houden met QD's en hun bekledingslagen met de substraatgerelateerde defecten en de diepst gegroeide laag. Er werden geen directe substraateffecten gevonden in de spectra van de met buffer in contact gebrachte structuren. Een opmerkelijke negatieve invloed van de n + -GaAs-bufferlaag op het fotospannings- en fotogeleidingssignaal werd waargenomen in de InAs/InGaAs-structuur. Door de verkregen resultaten en de uitgevoerde berekeningen te analyseren, hebben we inzicht kunnen verschaffen in het ontwerp van metamorfe QD-structuren, die nuttig kunnen zijn voor de ontwikkeling van nieuwe efficiënte fotonische apparaten.
Achtergrond
In de afgelopen twee decennia zijn composietmaterialen die halfgeleider-nanostructuren bevatten, veel gebruikt in fotonische toepassingen vanwege de lichtgevoeligheid, het gemak en de lage fabricagekosten, de spectrale afstembaarheid en de zeer efficiënte emissie met een korte levensduur [1,2,3,4,5 ]. In(Ga)As quantum dot (QD) heterostructuren is een belangrijke klasse van infraroodgevoelige nanostructuren, die op grote schaal is gebruikt in verschillende fotonische apparaten, zoals lasers [2, 6], single-photon sources [7, 8], fotodetectoren [9,10,11,12,13] en zonnecellen [14,15,16]. Talrijke onderzoeken zijn gewijd aan het verbeteren van de foto-elektrische eigenschappen van dergelijke lichtgevoelige inrichtingen. Het fotosensitiviteitsbereik kan bijvoorbeeld worden uitgebreid via de excitatie door middel van een tussenliggende bandgap [17, 18] of meervoudige excitongeneratie [19, 20], zodat de energieconversie-efficiëntie van op QD gebaseerde zonnecellen in theorie de limieten van enkele -bandgap zonnecellen [21]. De methoden zoals strain-balancing [22] en misfit-managementtechniek [23], evenals de thermische annealing [24] worden gebruikt om spanningen in deze structuren te verminderen, het werkbereik [25] te bedienen en de fotorespons te vergroten als gevolg van de onderdrukking van stamgerelateerde defecten [26] die kunnen fungeren als recombinatiecentra.
Een efficiënte methode voor de spanningsvermindering is gebaseerd op de groei van een InGaAs-metamorfe buffer (MB) in plaats van de conventionele GaAs-buffer. Als gevolg hiervan hebben InAs/InGaAs QD-structuren het afgelopen decennium veel belangstelling gewekt [27,28,29]. Door de QD's op de InGaAs MB te laten groeien, kunnen essentiële verschillen in het vormingsproces en de optische eigenschappen van QD worden waargenomen in vergelijking met conventionele in de GaAs-matrix [25, 30,31,32,33]. De InGaAs-begrenzende laag vermindert bijvoorbeeld de roostermismatch tussen QD's en buffer en dus spanningen in QD's. Als resultaat wordt de bandgap van InAs verminderd en wordt een significante toename van de emissiegolflengte waargenomen [34]. Toepassing van de MB als beperkend materiaal maakt het mogelijk om de waarde ervan te verschuiven naar het telecommunicatievenster op 1,3 en 1,55 μm [28, 29, 35, 36].
Er zijn ook hoopvolle pogingen gedaan om de foto-elektrische eigenschappen van de metamorfe InAs QD-structuren toe te passen op het ontwerp van lichtgevoelige apparaten zoals metamorfe infraroodfotodetectoren [11,12,13] en zonnecellen [37,38,39]. Sommige onderzoeken werden uitgevoerd om het structuurontwerp te ontwikkelen [25, 31,32,33] en andere om de foto-elektrische eigenschappen te verbeteren [39, 40]. Er zijn onderzoeken gaande om de spanningen in de heterostructuren [34, 41] te verminderen, aangezien dit leidt tot een substantiële verbetering van de fotostroomdichtheid en spectrale respons van zonnecellen [39, 40], evenals in de foto-emissie-efficiëntie van dergelijke structuren [ 29, 32, 42].
De ontwikkeling van de lichtgevoelige apparaten vereist een diepgaande studie van de foto-elektrische eigenschappen. Fotovoltage (PV) of fotogeleidingsonderzoek (PC) is een ideaal hulpmiddel voor het bepalen van de fotorespons als functie van lichtenergie, overgangen tussen niveaus, dragertransport en werkbereik van het apparaat [10, 43, 44]. Ondanks dat er in de afgelopen jaren enkele onderzoeken zijn uitgevoerd naar de foto-elektrische eigenschappen van structuren met metamorfe InAs QD's [37,38,39, 43], blijven volledige aspecten van het fotoresponsmechanisme nog steeds onduidelijk, evenals de invloed van de MB over de eigenschappen van de nanostructuren. In het bijzonder zijn de effecten van het GaAs-substraat en gerelateerde interfaces op de foto-elektrische spectra van InAs/InGaAs/GaAs QD-structuren niet in detail onderzocht. Hoewel er aanzienlijke inspanningen worden gedaan om de substraatinvloed te vermijden, wordt de fotorespons beïnvloed door zowel het substraat als de nabijgelegen lagen die zijn gegroeid door moleculaire bundelepitaxie (MBE). Dus, hoewel de toegepaste contactgeometrie is om de onderste lagen en het substraat elektrisch inactief te houden, hebben we in een eerder onderzoek een opmerkelijk negatief effect ervan op PV en fotostroom gedetecteerd [43]. Zeer recent vergeleken we de foto-elektrische eigenschappen van de metamorfe InAs/In0.15 Ga0,85 Als QD-structuur met die van een standaard InAs/GaAs QD en ontdekte dat de fotostroom van metamorfe InAs/In0,15 Ga0,85 Omdat heterostructuren niet werden beïnvloed door niveaus die verband houden met defecten in de buurt van QD [45]. Verder is geconcludeerd dat efficiënte fotonische apparaten van 1,3 μm kunnen worden ontwikkeld met vergelijkbare nanostructuren als actief materiaal.
In dit werk gaan we verder met de studie van foto-elektrische eigenschappen van de heterostructuren met InAs QD's ingebed in ofwel de metamorfe In0.15 Ga0,85 As of conventionele GaAs-buffers, gericht op het effect van GaAs-substraat en nabijgelegen MBE-lagen. Om een duidelijk begrip te krijgen van de rol van substraat- en bufferlagen, hebben we gekeken naar de structuren met bodemcontacten op (i) de In0.15 Ga0,85 Als bufferlaag of (ii) het onderste GaAs-substraat (zie Fig. 1). Dus, afhankelijk van de selectie van het onderste contact, stroomde de stroom door (i) alleen de QD's en bufferlagen en (ii) de volledige structuur inclusief de substraten en hun interfaces met MBE-lagen. De analyse van de resultaten en berekeningen stelden ons in staat om inzicht te geven in het beste ontwerp voor lichtsensoren op metamorfe QD-structuren.
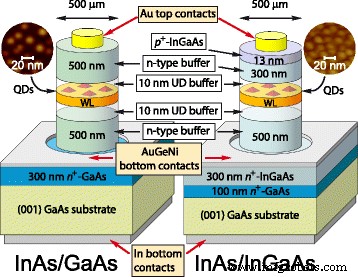
(Online kleuren) schema's van de metamorfe InAs/In0.15 Ga0,85 Als/si -GaAs (rechts) en InAs/GaAs/si -GaAs (links) QD-monsters onderzocht; AFM-beelden van de niet-afgetopte structuren worden getoond
Methoden
De structuren zijn gemaakt door MBE op (001) semi-isolerende (si .) ) GaAs-substraten. Substraten waren n -type, met waarden van 3 × 10 7 cm −3 resterende dragerconcentratie, dikte van 500 μm en een soortelijke weerstand van 2 × 10 7 Ω × cm. De metamorfe InAs/InGaAs QD-structuren bestaan uit (i) 100-nm n + -GaAs-bufferlaag gegroeid bij 600 °C, (ii) 300 nm dik n + -In0,15 Ga0,85 Als MB met n = 5 × 10 18 cm −3 gekweekt bij 490 °C, (iii) 500 nm dik n -In0,15 Ga0,85 Als MB met n = 3 × 10 16 cm −3 gekweekt bij 490 °C, (iv) 3,0 monolagen (ML's) van zelf-geassembleerde InAs QD's ingebed in een 20-nm ongedoteerde In0,15 Ga0,85 Als laag gegroeid bij 460 °C, (v) 300-nm n -In0,15 Ga0,85 Als bovenste afdeklaag met n = 3 × 10 16 cm −3 gekweekt bij 490 °C, en (vi) 13-nm p + -gedoteerde In0,15 Ga0,85 Als dop met p = 2 × 10 18 cm −3 gekweekt bij 490 ° C (Fig. 1). De groeisnelheid was 1,0 ML/s, behalve de QD's die werden gekweekt met een groeisnelheid van 0,15 ML/s. De ongedoteerde lagen zijn nodig om QD's te scheiden van n -gedoteerde gebieden en dus om de invloed van niet-stralingsrecombinatiecentra te verminderen, waardoor de efficiëntie van de QD-lichtemissie wordt gemaximaliseerd [30, 46]. De standaard InAs/GaAs QD-structuren bestaan uit (i) 300-nm n + -GaAs-bufferlaag met n = 5 × 10 18 cm −3 gekweekt bij 600 °C, (ii) 500 nm dik n -GaAs MB met n = 3 × 10 16 cm −3 gekweekt bij 600 °C, (iii) 3,0 ML's InAs QD's ingebed in een 20-nm ongedoteerde GaAs-laag gekweekt bij 460 °C, en (iv) 500-nm n -GaAs bovenste afdeklaag met n = 3 × 10 16 cm −3 gekweekt bij 600 ° C. De groeisnelheid was 1,0 ML/s, behalve de QD's die werden gekweekt met een groeisnelheid van 0,15 ML/s.
Atomic force microscopie (AFM) afbeeldingen van de niet-afgetopte structuren worden getoond in Fig. 1. Door analyse van AFM-gegevens op vergelijkbare structuren, werden de meest voorkomende waarden van QD-grootten geschat op 20 nm (diameter) en 4,9 nm (hoogte) voor metamorfe QD's en 21 nm (diameter) en 5,0 nm (hoogte) voor standaard QD's [30, 31, 45].
Voor foto-elektrische metingen werden cirkelvormige 500 μm dikke mesa's geëtst op de structuren tot aan de onderste buffer n + lagen; Au rectificerende topcontacten met een diameter van 400 m en een dikte van 70 nm werden vervolgens verdampt op de bovenkant van mesa's. Ohmse contacten aan de onderkant verkrijgen n + -InGaAs en n + -GaAs-bufferlagen, respectievelijk Au0,83 Ge0,12 Ni0,05 legering werd gedurende 1 minuut bij 400 ° C in een stikstofatmosfeer afgezet. Dikke indium ohmse contacten werden gemaakt op de bodems van substraten in andere stukken van dezelfde monsters, om ook metingen te hebben met stroom die door de GaAs-buffer en si vloeide -GaAs-substraat. De ohmiteit van de contacten is geverifieerd door de I -V metingen, contact maken met een stuk substraat; de stroom-spanningskarakteristieken bleken lineair te zijn (gegevens niet getoond).
In navolging van de benadering voorgesteld in Ref. [47] en gebruikt in andere werken [48, 49], de dunne p + -InGaAs-laag tussen het Au-contact en de n -InGaAs-laag werd gebruikt om de hoogte van de Schottky-barrière te vergroten, omdat de structuur werd verkregen door de eenvoudige afzetting van een metaal op n -InGaAs vertoonde een relatief lage Schottky-barrièrehoogte. Vandaar dat de afzetting van dunne p + -InGaAs-laag vergroot de hoogte van de Schottky-barrière zodat deze vergelijkbaar is met die van Au-GaAs-contact, waardoor de gelijkenis van het barrièreprofiel voor zowel de metamorfe als de InAs/GaAs-structuren behouden blijft.
Voor structuur- en contactontwerp en begrip van het energieprofiel voor beide constructies samengesteld door de In0.15 Ga0,85 As of GaAs MB's, In(Ga)As QD's, ongedoteerde afdeklaag en Au/AuGeNi-contacten, de berekeningen werden uitgevoerd met behulp van Tibercad-software [50]. Bandprofielen werden gemodelleerd in de drift-diffusiebenadering, rekening houdend met spanningsomstandigheden, dichtheden van vallen gerelateerd aan defecten in het InGaAs / GaAs-interfacegebied, uitputtingslagen nabij contacten en geschikte Schottky-barrièrehoogten. Voor de berekening van de metamorfe QD-bandprofielen werden afmetingen uit AFM-gegevens overwogen en werden spanningseffecten opgenomen, volgens een benadering die al is gevalideerd in Refs. [42, 51]. De berekening van QD-kwantumniveaus valt buiten het bestek van dit artikel en QD-modellering is eerder uitgevoerd in Ref. [45]. In dit werk berekenen we echter bandprofielen van de hele heterostructuur inclusief het substraat.
Verticale fotostroom en PV-spectra werden gemeten in het bereik van 0,6 tot 1,8 eV met behulp van excitatiegeometrie met normale inval bij kamertemperatuur (RT) (300 K) en dezelfde lichtbronintensiteit (1,5 mW/cm 2 ). De fotostroom werd gemeten met een stroomversterker en gelijkstroomtechniek [10, 43,44,45], met een voorspanning van 1 V. De stroom werd gemeten als een spanningssignaaldaling over een seriebelastingsweerstand van 100 kΩ (zie de inzet in Fig. 5). Fotoluminescentie (PL) geëxciteerd bij 532 nm werd gemeten bij 300 K. Sommige informatie over structuren en methoden wordt in meer detail beschreven in Ref. [45].
Resultaten en discussie
A. Foto-elektrische karakterisering
De PV-spectra van zowel InAs/In0,15 Ga0,85 As- en InAs/GaAs-samples worden weergegeven in Fig. 2. Alleen gecontacteerd met de MBE-lagen, dik n -InGaAs, of n -GaAs-buffers, de kenmerken van de spectra zijn elders beschreven [45]. De spectrumdrempel van de InAs/In0,15 Ga0,85 Omdat bij 0,88 eV gerelateerd is aan de grondtoestandabsorptie in het QD-ensemble, wat overeenkomt met het begin van de QD-band in het PL-spectrum bij RT eerder gemeten [45] (Fig. 2a). Het metamorfe QD-emissiespectrum vertoont een brede band van 0,94 eV die in het telecombereik van 1,3 μm (0,95 eV) ligt, terwijl de QD PL een goede efficiëntie vertoont, zoals is opgemerkt in eerdere artikelen [30, 45, 46, 52]. De brede band van het PV-spectrum met een piek van 1,24 eV en met een rand van 1,11 eV is te wijten aan het genereren van dragers in de In0,15 Ga0,85 Als MB en bevochtigingslaag (WL) inclusief de weg door de ondiepe niveaus. Er moet aan worden toegevoegd dat de In0.15 Ga0,85 Aangezien de berekende bandgap voor MBE-gegroeide laag 1,225 eV [53] is, en de WL PL wordt waargenomen bij 1,2 eV [45]. Verder wordt een significante scherpe daling boven 1,36 eV waargenomen, waarschijnlijk veroorzaakt door een indirect effect van de zwaar gedoteerde GaAs-bufferlaag die zich buiten het intercontactgebied bevindt dat is genoemd in Ref. [43]. De bufferlaag is gevuld met talrijke ondiepe niveaus en band non-uniformiteiten afkomstig van MBE-groeidefecten en dopingcentra die de interbandabsorptie van GaAs rood verschuiven [33, 46, 54, 55]. Voor de conventionele buffer-contacted InAs/GaAs-nanostructuur is het begin bij 1,05 eV van het PV-spectrum in Fig. 2b afkomstig van de QD-grondtoestand, zoals bevestigd door het PL-spectrum, terwijl de scherpe stap bij 1,3 eV gerelateerd kan zijn aan de overgangen in de WL [56]. Het kenmerk na 1,39 eV is duidelijk gerelateerd aan absorptie van de gedoteerde GaAs bovenste bufferlaag. Een mechanisme voor dit effect zal hieronder in detail worden besproken.

(kleur online) kamertemperatuur PV-spectra van de a metamorfe InAs/In0,15 Ga0,85 Als en b InAs/GaAs QD-structuren; PV werd gemeten in contact met alleen MBE-lagen [45] (zwarte curven) en via de semi-isolerende si -GaAs-substraat (blauw). De PV-spectra gemeten via de si -GaAs-substraten worden geïnverteerd door een teken van een spanning lager dan respectievelijk 1,68 en 1,44 eV voor a en b . Laag-energetische delen van de curven zijn weergegeven in de inzet; de QD PL-banden gemeten vóór [45] voor beide structuren worden weergegeven voor de QD-grondtoestand energiepositionering (rood)
Zoals hierboven vermeld, is de scherpe daling van het PV-signaal boven 1,36 eV in de InAs/In0,15 Ga0,85 Omdat structuur gerelateerd is aan n + -GaAs-onderlaag die het substraat afdekt. Om effecten van de lagen onder het onderste AuGeNi-contact op de fotorespons te verwijderen, hebben we foto-elektrische eigenschappen van de structuren bestudeerd met behulp van een indiumcontact aan de achterkant van het substraat. In tegenstelling tot de vorige Au- en AuGeNi-contactgeometrie die de unipolaire PV mogelijk maakt, is het bipolaire signaal waargenomen voor de structuren die in contact zijn gebracht met de bovenkant van het monster en de achterkant van het substraat (figuur 2). Het is noodzakelijk op te merken dat het PV-teken verandert langs de foton-energie-as, en in figuur 2 worden de spectra van beide monsters omgekeerd door een teken van een spanning onder 1,68 en 1,44 eV voor de InAs/In0,15 Ga0,85 As en InAs/GaAs QD structuren respectievelijk. Hier wordt PV als positief beschouwd wanneer, zoals in het geval van contact met de MBE-lagen, het positieve potentiaal wordt toegepast op het bovenste Au-contact terwijl het negatieve wordt toegepast op het onderste contact.
Alle bovengenoemde optische overgangen dragen bij aan het PV-signaal van de structuren in de substraat-topcontactgeometrie. Bij het meten van PV door het substraat vindt het signaalbegin voor de metamorfe en conventionele structuren echter plaats bij ongeveer 0,72 eV. Het begin bij 0,72 eV wordt toegeschreven aan de overgang van het EL2-defectcentrum in si -GaAs-substraat en gerelateerde interfaces nabij 0,75 eV onder de GaAs-geleidingsband [57], rekening houdend met de mogelijkheid van overgang door de ondiepe niveaus van defecten [46, 54, 55]. De aspecten met betrekking tot hun locatie en de roodverschuiving bij het begin van de EL2 PC zijn elders in detail besproken [10, 45]. Omdat er geen signaal onder de QD-gerelateerde banden werd waargenomen in de spectra van de monsters die in contact waren gebracht met de InGaAs- of GaAs-buffers (Fig. 2), concluderen we dat het substraat en gerelateerde interfaces geen substantiële invloed hebben op de eigenschappen van door MBE gegroeide heterostructuren .
Om het uiterlijk van het PV-signaal in onze monsters te begrijpen, moet men kijken naar Fig. 3, waar we de berekende bandprofielen langs de groeirichting laten zien. Gedetailleerde uitleg van de PV-oorsprong tussen de Au- en AuGeNi-contacten wordt gegeven in het vorige artikel [45]. Samenvattend:de door licht opgewekte elektronen (gaten) drijven voornamelijk naar het substraat (oppervlak), wat een positief potentiaal geeft bij het Au-contact en een negatief potentiaal bij het AuGeNi-contact.

(Online kleur) berekend bandprofiel in de metamorfe InAs/In0,15 Ga0,85 As (omhoog) en pseudomorfe InAs/GaAs (omlaag) structuren, om het PV-mechanisme te verklaren. De bandbuiging van de diepere lagen onder het AuGeNi-contact is grijs aangegeven. De optische overgangen die in de PV-spectra worden waargenomen, zijn aangegeven met verticale pijlen; dikke pijlen tonen driftrichtingen van de optisch aangeslagen ladingsdragers onder het interne veld (PV-creatie); E F is Fermi-energie. De berekeningen zijn uitgevoerd met behulp van Tibercad-software [50]
De bipolaire PV verklaren vanuit de structuren met de elektrisch actieve si -GaAs-substraten, men kan hun berekende bandstructuren bekijken in Fig. 3. Zoals eerder kunnen de dragers die in de bovenste lagen worden gegenereerd, evenals in de QD's en WL "+" bovenaan en "−" op het substraat geven. Het Fermi-niveau in het semi-isolerende substraat ligt veel lager dan dat in de n -gedoteerde MBE-lagen. Daarom buigt de band bij de n + -GaAs/substraat-interface is tegengesteld aan die in de rest van de door MBE gegroeide structuur (zie figuur 3). Vandaar dat de excitatie in de n + -GaAs-laag en -substraat (boven 1,36 eV) geven een tegengesteld PV-signaal aan dat van de QD's, WL en buffers. Hetzelfde geldt voor de excitatie van EL2-defecten (boven 0,72 eV) van het GaAs-substraat en vooral EL2-achtige defecten in n + -GaAs/GaAs gespannen gebied [46, 57]. Bijdrage van het substraat en n + -GaAs voor het totale PV-signaal is in wezen sterker dan dat van de bovenste MBE-lagen, en het negatieve signaal van PV wordt over het algemeen waargenomen bij lagere excitatie-energieën, terwijl de impact van InGaAs-lagen en nanostructuren verschijnt als valleien op de respectieve spectrale curven in Fig. 2. Dit is duidelijk te zien door de QD's, WL en bufferspectrale banden te vergelijken op de PV-curven van de structuren die in contact zijn gebracht met MBE-buffers met de valleien in spectra van de monsters die aan de bovenzijde van het substraat zijn gecontacteerd. Voor de hogere energieën wordt de excitatie echter dichter bij het monsteroppervlak geabsorbeerd en bereikt de diepere MBE-lagen en het substraat niet, wat de belangrijkste bron van negatief signaal is. Daarom wordt het PV-signaal positief bij grotere energieën. Dus de aanwezigheid van elektrisch actieve si -substraat leidt tot concurrentie tussen de spectrale componenten gerelateerd aan de bovenste MBE-gegroeide lagen en de substraatgerelateerde defecten en de n + -GaAs-absorptie.
Voor het overige is in een recent gedetailleerd onderzoek van p een soortgelijk kenmerk boven 1,35 eV waargenomen met behulp van oppervlakte-PV-spectroscopie. -gedoteerde InAs/GaAs QD en InAs/InGaAs dot-in-well-structuren op basis van si -GaAs-substraten [58]. De drastische daling van de PV-amplitude is, in tegenstelling tot ons geval, verklaard door verschillende ladingsdragers die onder en boven 1,35 eV worden gegenereerd. Rekening houdend met het drastische verschil in de structuren waarnaar wordt verwezen en die aanwezig zijn, evenals de specifieke kenmerken van de toegepaste methoden, volgen we echter onze interpretatie van de eigen resultaten.
Op basis van het concept van de bandbuiging onder het AuGeNi-contact, kan men de scherpe daling van het PV-signaal in de buffercontact metamorfe InAs/InGaAs-structuur boven 1,36 eV, waargenomen in figuur 2a, verklaren. Deze spectrale eigenschap is te wijten aan het effect van het substraat en de diepste MBE n + -GaAs-laag. Inderdaad, de elektronen die daar worden gegenereerd, bewegen onder het intrinsieke veld naar het AuGeNi-contact en roepen daar een extra elektrisch veld op, waarbij een barrière als gevolg van de bandverbuiging bij de InGaAs/GaAs-heterojunctie duidelijk te laag is om een essentieel obstakel te zijn voor de ladingsdragers. Dit lijnt de bandbuiging in de bovenste lagen uit, die direct bijdragen aan de PV, en vermindert dus de toevoer van de dragers die foto-exciteerd zijn boven de n + -GaAs-laag en als gevolg daarvan het totale PV-signaal.
Een kleine functie in de buurt van 1,39 eV wordt waargenomen in figuur 2b in het spectrum van het pseudomorfe monster dat in contact is gebracht met de MBE-buffers, hoewel een drastische daling van het signaal zoals in metamorfe structuur boven 1,36 eV moet worden verwacht, rekening houdend met een vergelijkbare bandbuiging in de buurt van n + -GaAs/substraat interface. Een dergelijk kenmerk is niet alleen een kenmerk van substraat en n + -gedoteerde GaAs; dergelijke overgangen werden gedetecteerd in In(Ga)As/GaAs QD-structuren op basis van p -gedoteerde [58] en ongedoteerde GaAs [10, 55]. Deze overgangen treden uiteraard ook op in de bovenste GaAs-lagen van onze pseudomorfe structuur, waardoor het negatieve effect van de bijna-substraatlagen op het PV-signaal grotendeels wordt gecompenseerd. Als gevolg hiervan kan slechts een verwaarloosbare invloed van de bijna-substraatlaag worden waargenomen op de zwarte curve voor InAs / GaAs-monster in figuur 2b in plaats van de daling van de curve van de metamorfe die afkomstig is van de diepere GaAs-lagen, ondanks een vergelijkbare bipolaire effect waargenomen met directe deelname van het substraat aan PV-vorming.
De reden voor de kleine functie na 1,39 eV in het spectrum van InAs/GaAs-samples dat in contact is gebracht met de MBE-buffers kan verschillen van de hierboven besproken voor metamorfe InAs/InGaAs-samples. Naar onze mening is dit te wijten aan de lichte signaaldaling veroorzaakt door de absorptierand van de bovenste MBE-gegroeide 500 nm dikke GaAs-buffer die de QD's en WL in de schaduw stelt, die efficiënter bijdragen aan PV bij die foton-energieën. Inderdaad, elektronen en gaten gegenereerd in QD's en WL worden naar verschillende kanten gedragen en voorkomen recombinatie, in tegenstelling tot de volumegeneratie, waar recombinatie veel waarschijnlijker is. Dit is de belangrijkste reden voor een effectieve detectie van fotodragers die afkomstig zijn van zelfs een enkele laag QD's en WL. Fotonen met hogere energieën worden band-tot-band geabsorbeerd in nabije oppervlakte n -GaAs-bufferlaag en elektronen ontsnappen naar het monstervolume, weg van de gaten, wat leidt tot een sterke stijging van PV boven 1,4 eV. De juistheid van de voorgestelde reden voor de 1,36 eV-functie in de buffer-contacted InAs/GaAs-structuur in plaats van die verondersteld voor de metamorfe structuur, wordt bevestigd door studies van zonnecellen op basis van InAs/GaAs-structuren met de onderste contacten op de n + -GaAs-substraten [18, 24, 59], d.w.z. met een monotone band die van contact tot contact door het hele monster buigt. Hun PV-spectra onthullen hetzelfde kenmerk zonder een barrière die verband houdt met de MBE-laaginterface naar het substraat. Verder werd een smalle dip waargenomen in hetzelfde spectrale bereik in de PC-spectra van InGaAs/GaAs-structuren met laterale contactgeometrie en zonder intrinsiek veld [10, 55].
De pc-spectra van de structuren verkregen bij een voorspanning van 1 V, gericht op het intrinsieke veld in de bovenste lagen van de structuren ("−" aan de bovenkant en "+" aan het onderste contact) worden weergegeven in Fig. 4. De pc-spectra voor de structuren die in contact komen met de MBE-lagen lijken erg op de PV-structuren in Fig. 2. De componenten van de QD's, WL's, InGaAs of GaAs-buffers evenals n + -GaAs-laag wordt waargenomen bij dezelfde energieën. Betreffende de structuren met het onderste contact op de si -GaAs-substraat, de pc-spectra hebben drempels in de buurt van 0,72 eV die verband houden met de absorptie van het EL2-defectcentrum.
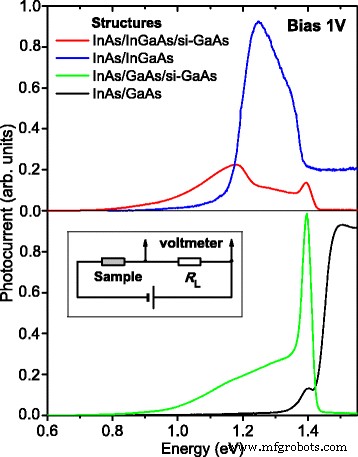
(Online kleuren) fotostroomspectra bij kamertemperatuur van de metamorfe InAs/In0,15 Ga0,85 Als/si -GaAs en conventionele InAs/GaAs/si -GaAs QD-structuren. Inzet:elektrisch schema voor het aansluiten van het monster voor pc-metingen
De kenmerken van pc-spectra voor de structuren die in contact zijn gebracht met de MBE-lagen gepresenteerd in Fig. 4 komen voornamelijk overeen met die in de PV-spectra in Fig. 2 hierboven beschouwd. Betreffende de structuren met het onderste contact op de si -GaAs-substraat met de EL2-centrumcomponent, er is een competitie tussen signaal van absorptie in de MBE-lagen en van EL2-gerelateerde niveaus, zoals hierboven besproken. De vormen van krommen laten echter toe om te concluderen dat er geen ladingsdragers zijn geëxciteerd binnen de lagen boven n + -GaAs deelnemen aan pc; dit is met name relevant voor het metamorfe QD-structuurspectrum. Het is duidelijk dat de elektronen de bodem niet bereiken vanwege de hoge potentiaalbarrière (zie figuur 3) die wordt geïnduceerd door si -substraat. Het substraat heeft een te hoge weerstand en de grootste daling van de toegepaste voorspanning vindt daarop plaats, dus er vindt geen verlaging van de barrière plaats.
Men kan dus opmerken dat PV en fotostroom negatief worden beïnvloed door de substraatgerelateerde n + -GaAs-laag:de absorptie boven 1,36 eV veroorzaakt een drastische signaalreductie. De belangrijkste oorzaak van de barrière onder het AuGeNi-contact is de si -GaAs-substraat met een vrij lage positionering van het Fermi-niveau, waardoor de band tegengesteld aan die in de structuurtop buigt. Dit is het enige effect van het substraat dat in de PV is waargenomen bij een dergelijke contactgeometrie, en het manifesteert zich zelfs bij een vrij dikke (400 nm) tussenlaag tussen het onderste contact en het substraat.
B. Substraat-heterostructuur Ontwerpoplossingen voor tussenlagen
Vanuit praktisch oogpunt kan worden geconcludeerd dat een dergelijk ontwerp van InAs/InGaAs-structuur met si -GaAs-substraat is niet bruikbaar in de verticale lichtgevoelige apparaattechniek, vooral niet in combinatie met een relatief dunne n + -gedoteerde buffer, zelfs wanneer de contactconfiguratie de stroom door het substraat elimineert. Het ruimteladingsgebied gevormd in de n + -GaAs/substraat-interfacegebied dwingt de hier geëxciteerde ladingsdragers om tegengesteld te bewegen aan degenen die zijn geëxciteerd in metamorfe structuur, zoals in Fig. 3 en 5a, waardoor een tegengesteld PV-signaal wordt gegenereerd en de totale kwantumefficiëntie van het monster wordt verminderd.
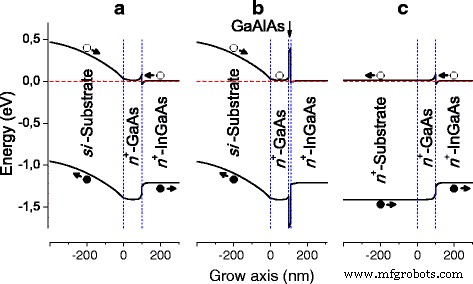
(Online kleur) berekende bandprofielen in de buurt van In0,15 Ga0,85 As/GaAs-interfaces van de metamorfe structuur gegroeid op een si -substraat met de n + -GaAs laagdikte van a 100 nm (huidig voorbeeld), b 100 nm en een 10 nm dunne Ga0.3 Al0,7 Als barrièrelaag, en c structuur zoals het heden, maar gegroeid op een n + -substraat gedoteerd vergelijkbaar met de 100 nm dikke n + -GaAs-laag erboven. De berekeningen zijn uitgevoerd met behulp van Tibercad-software [50]
Daarom moet voor apparaten op basis van lichtabsorptie een ander structuurontwerp worden overwogen. Wij zijn van mening dat een dergelijke verbetering noodzakelijk is om te worden voorgesteld, omdat veel onderzoeksgroepen overwegen si -GaAs-substraat als basis voor nieuwe p -n -type zowel QD infrarood fotodetectoren [11,12,13] als zonnecellen [15].
Eenvoudige verdikking van de n + -GaAs-buffer onder metamorfe structuur lijkt niet zo'n goed idee. Hoewel een dergelijke buffer meer excitatiequanta boven 1,37 eV zou kunnen absorberen en de interface en het onderliggende substraat zou kunnen overschaduwen, moet de dikte ervan zeer hoog zijn, omdat 800 nm InGaAs-materiaal met een nauwere bandafstand erboven onvoldoende is om de negatieve bipolaire effecten volledig te onderdrukken. Bovendien, zelfs een zeer dikke n + -GaAs-buffer kan het negatieve effect van de EL2-achtige centra die zich voornamelijk in het substraat en nabij hun grensvlak met de MBE-laag bevinden, niet uitsluiten. Desalniettemin, aangezien de ladingsdragers een beperkte gemiddelde vrije weg hebben, verdikt de n + -GaAs-laag kan het geïnduceerde negatieve veld op het AuGeNi-contact hierboven verzwakken.
Een betere verbetering zou kunnen worden bereikt door een dunne barrièrelaag aan te brengen voor de elektronen die van het substraat komen, zoals weergegeven in figuur 5b. Voor berekeningen, een 10 nm dunne ongedoteerde Ga0.3 Al0,7 Als barrièrelaag is gekozen. Een dergelijke barrière zou de elektronen die in het substraat worden geëxciteerd sterk kunnen beperken binnen de n + -GaAs-laag. Vergelijkbare hoogohmige lagen die zijn gegroeid door materialen met een brede bandgap zoals InAlAs, GaAlAs en AlAs zijn gebruikt in laserstructuren om lekkage van ladingsdragers uit het actieve gebied van opto-elektronische apparaten te voorkomen [60]. Voor het geval van GaAs-In0,15 Ga0,85 Als gebaseerd apparaat, Ga0.3 Al0,7 Als beste matchen vanwege de brede bandgap en kleine roostermismatch tussen de epitaxiale laag. Door het drager-geïnduceerde veld op het AuGeNi-contact te verminderen, kan het het negatieve effect van het substraatgebied op de fotorespons onderdrukken, vooral in combinatie met een toename van de n + -InGaAs laagdikte.
Toch lijkt een meer optimaal ontwerp van de verticale structuren gebruik te maken van een monotone gradiënt van doping, inclusief een n + -gedoteerde GaAs-substraat zoals voorgesteld in Refs [14, 39, 40]. Dit ontwerp is het meest efficiënt en tegelijkertijd het eenvoudigst. Als het substraat is gedoteerd vergelijkbaar met de dop n + -laag of zwaarder, dit veroorzaakt de bandbuiging zoals weergegeven in figuur 5c. Bovendien zou een essentieel voordeel van een dergelijk substraat zich kunnen manifesteren in het ontwerp van zonnecellen. Een substraat met lage weerstand maakt gebruik van de configuratie met het "-" contact op de monsterbodem [24, 38,39,40, 59] mogelijk, waardoor de MBE-structuur niet wordt beschaduwd door het zonlicht.
Conclusies
We hebben aangetoond dat foto-elektrische karakterisering een kritische invloed aantoont van de diepe niveaus op de foto-elektrische eigenschappen van verticale metamorfe InAs/In0.15 Ga0,85 As en pseudomorfe (conventionele) InAs/GaAs QD-structuren in het geval van elektrisch actieve si -GaAs-substraat. Beide nanostructuren vertonen een bipolaire PV veroorzaakt door een competitie van de componenten afkomstig van de tegengesteld hellende bandprofielen nabij het GaAs-substraat en onderste MBE n + -GaAs-laag aan de ene kant en de rest van MBE-gegroeide structuur aan de andere kant. Een alternatieve contactconfiguratie, die het mogelijk maakt om de stroom door de onderste lagen te vermijden, demonstreert de unipolaire PV. De laatste configuratie samen met dikke buffers op het substraat onderdrukt sterk de invloed van de fotoactieve diepe niveaus afkomstig van interfaces met de si -GaAs-substraat op foto-elektrische eigenschappen van de nanostructuren. Er wordt echter een opmerkelijk negatief indirect effect van het substraat op het fotospannings- en fotostroomsignaal van de InAs/InGaAs-structuur waargenomen wanneer de excitatie wordt geabsorbeerd in het substraat en nabij het substraat n + -GaAs MBE-laag. Door de verkregen resultaten en de uitgevoerde berekeningen te analyseren, hebben we inzicht kunnen verschaffen in het ontwerp van metamorfe QD-structuren, die nuttig kunnen zijn voor de ontwikkeling van nieuwe efficiënte fotonische apparaten.
Afkortingen
- AFM:
-
Atoomkrachtmicroscopie
- MB:
-
Metamorfe buffer
- MBE:
-
Moleculaire bundelepitaxie
- ML:
-
Monolaag
- PC:
-
Fotogeleiding
- PL:
-
Fotoluminescentie
- PV:
-
Fotospanning
- QD:
-
Kwantumpunt
- R L :
-
Belastingsweerstand
- si :
-
Semi-isolerend
- WL:
-
Bevochtigingslaag
Nanomaterialen
- Ontwerp en ontwikkeling van 5G-apparaten:5G-prestatiebereiken
- S, N co-gedoteerde grafeen Quantum Dot/TiO2-composieten voor efficiënte fotokatalytische waterstofgeneratie
- Dip-coating procestechniek en prestatie-optimalisatie voor drie-staten elektrochrome apparaten
- Heldere enkelvoudige fotonbron op 1,3 μm gebaseerd op InAs Bilayer Quantum Dot in Micropillar
- Het detecteren van ruimtelijk gelokaliseerde excitatie in zelfgeorganiseerde InAs/InGaAs Quantum Dot Superroosters:een manier om de fotovoltaïsche efficiëntie te verbeteren
- Een efficiënt en effectief ontwerp van InP-nanodraden voor maximale oogst van zonne-energie
- Evaluatie van grafeen/WO3 en grafeen/CeO x-structuren als elektroden voor supercondensatortoepassingen
- Eliminatie van bimodale grootte in InAs/GaAs Quantum Dots voor de voorbereiding van 1,3-μm Quantum Dot Lasers
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Richtlijnen voor RF- en magnetronontwerp
- Tegenslagen en oplossingen in RF PCB-ontwerp



