Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
Abstract
De oppervlaktepolarisatie van Ga-face galliumnitride (GaN) (2 nm)/AlGaN (22 nm)/GaN-kanaal (150 nm)/buffer/Si met Al2 O3 afdeklaag wordt onderzocht met hoek-opgeloste röntgenfoto-elektronspectroscopie (ARXPS). Het is gebleken dat de energieband varieert van opwaartse buiging tot neerwaartse buiging in het grensvlakgebied, waarvan wordt aangenomen dat deze overeenkomt met de polarisatievariatie. Er wordt een grenslaag gevormd tussen top GaN en Al2 O3 vanwege het optreden van Ga–N bindingsbreuk en Ga–O bindingsvorming tijdens Al2 O3 depositie via de atoomlaagafzetting (ALD). Aangenomen wordt dat deze grenslaag de GaN-polarisatie elimineert, waardoor de polarisatie-geïnduceerde negatieve ladingen worden verminderd. Bovendien speelt deze grenslaag een sleutelrol bij de introductie van de positieve ladingen die de energieband naar beneden leiden. Eindelijk een N2 Uitgloeien bij 400 ° C wordt waargenomen om de groei van de grenslaag te versterken, waardoor de dichtheid van positieve ladingen toeneemt.
Achtergrond
Galliumnitride (GaN) wordt beschouwd als een van de aantrekkelijkste halfgeleidermaterialen op vele gebieden, variërend van led-industrieën tot energie-elektronica-industrieën [1, 2]. De populariteit is te danken aan een aantal voordelen met betrekking tot silicium:hoog elektrisch doorslagveld, hoge elektronenmobiliteit en uitstekende thermische stabiliteit [3, 4]. GaN-transistor met hoge elektronenmobiliteit (HEMT) wordt veel bestudeerd voor toepassingen met hoog vermogen en hoge frequentie [1, 5, 6]. In de HEMT, als de Schottky-poort wordt gebruikt, brengt deze poortinterface grote interfacetoestanden met zich mee die de grote lekstroom en het lage doorslagveld verergeren [7]. Een isolator die wordt geïnduceerd als de passiveringslaag aan het oppervlak en het poortdiëlektricum kan de bovenstaande problemen helpen verminderen [8,9,10].
Al2 O3 heeft de voorkeur voor een dergelijke isolatortoepassing vanwege de grote bandafstand, hoge diëlektrische constante en meer negatieve Gibbs-vrije energie in vergelijking met Ga2 O3 , dus wordt aangenomen dat Al2 O3 kan de oppervlaktetoestanden passiveren en het elektrische doorslagveld verbeteren [5]. Er wordt echter onvermijdelijk een grenslaag gevormd op de GaN/Al2 O3 interface na de afzetting van de Al2 O3 [11, 12]. Aangenomen wordt dat deze grenslaag gecorreleerd is met de betrouwbaarheid van de drempelspanning en eigenschap van tweedimensionaal elektronengas (2DEG) en speelt een sleutelrol bij het beheersen van de bandbuiging [2, 13,14,15,16].
Hoewel de grenslaag door verschillende onderzoeksgroepen is bestudeerd, is de rol van de grenslaag niet diepgaand benut [12, 17]. Daarom gebruiken we in dit artikel de hoek-opgeloste röntgenfoto-elektronspectroscopie (ARXPS) om de geleidelijke veranderingen van de bandbuiging te detecteren en de atomaire structuur van de grensvlaklaag te verkrijgen [11]. Verschillende diktes van Al2 O3 worden afgezet op GaN-monsters door atomaire laagafzetting (ALD). ALD maakt gebruik van een laag-voor-laag depositietechnologie bij lage temperatuur, die de thermische reactie tussen GaN en Al2 beperkt O3 . ALD geniet dus de voorkeur van de industrieën om diëlektrica met een hoge k af te zetten vanwege de hoge vervormbaarheid en uniformiteit, de nauwkeurigheid bij de diktecontrole, de hoge filmkwaliteit en de lage defectdichtheid [4]. Dit zorgt voor een soepele en storingsarme Al2 O3 /GaN-interface. Na Al2 O3 afzetting, wordt ook een 400 ° C post-deposition annealing (PDA) monster bereid om de reactie van de grenslaag te intensiveren, waardoor de vorming van de grenslaag wordt verbeterd. Op basis van de ARXPS-resultaten is gevonden dat de band aanvankelijk omhoog buigt van het GaN-substraat naar het nabije grensvlak vanwege de polarisatie-geïnduceerde negatieve ladingen. Echter, als een toename van de detectiehoek θ , buigt de band geleidelijk naar beneden vanwege de vorming van positieve ladingen [5, 11,12,13].
Methoden
De Ga-face GaN/AlGaN/GaN-on-Si(111)-wafer is gekocht van een commercieel bedrijf (Enkris.com). De epitaxiale wurtzietstructuur omvat een 2-nm GaN-laag bovenop een 22-nm AlGaN-laag, en de twee epitaxiale lagen zijn gegroeid op een 150-nm i-GaN-laag. Een bufferlaag dient als een overgangslaag die de GaN-epilaag en het Si-substraat verbindt. Drie monsters, S1, S2 en S3, worden bereid. Alle monsters werden eerst gedurende 5 minuten in aceton verkleind, gevolgd door onderdompeling in isopropylalcohol en spoeling in stromend gedeïoniseerd (DI) water. Het natieve oxide werd vervolgens weggeëtst door het in een verdunde HCl-oplossing te dompelen (HCl:H2 O =1:10) gedurende ~ -1 min, gevolgd door een spoeling in DI-water. De Al2 O3 worden door ALD op GaN afgezet, met trimethylaluminium (TMA) en H2 O als respectievelijk de metaalvoorloper en het oxidatiemiddel. De Al2 O3 dikte is 1 nm voor monster S1 en 3 nm voor monsters S2 en S3. De dikte wordt gemeten door de ellipsometer. Bovendien werd S3 onderworpen aan PDA in N2 bij 400 °C gedurende 5 min.
ARXPS-metingen werden uitgevoerd in een Thermo Fisher Scientific Theta Probe-systeem uitgerust met een monochromatische, microfocused Al Kα (1486,6 eV) röntgenbron en een halfbolvormige elektronenenergieanalysator. De kalibratie van de bindingsenergie (BE) werd uitgevoerd met behulp van pure Ni-, Au-, Ag- en Cu-standaardmonsters door de Ni Fermi-rand, Au 4f in te stellen. 7/2 , Ag 3d 5/2 , en Cu 2p 3/2 pieken bij respectievelijk 0,00 ± 0,02, 83,98 ± 0,02, 368,26 ± 0,02 en 932,67 ± 0,02 eV. De FWHM van een bepaald componentspectrum mocht alleen binnen een smal bereik variëren (± 0,1 eV). Het laagste aantal componentspectra werd gebruikt om acceptabel lage restwaarden te verkrijgen [11]. De XPS-spectra zijn opgenomen onder verschillende detectiehoeken (θ ), variërend van 27,5° tot 72,5° ten opzichte van het monster normaal parallel zonder het monster te kantelen. Om mogelijke door positieve lading veroorzaakte BE-verschuiving te verwijderen, werden de verkregen XPS-spectra verwezen naar de C 1s piek bij 285,0 eV. Kwantitatieve analyse, inclusief bepaling van de verhouding element/binding, werd bereikt met behulp van relatieve gevoeligheidsfactoren en algoritmen die zijn ingebed in de Avantage-software [11].
Resultaten en discussie
De Ga 3d spectra op kernniveau voor S1-S3 bij verschillende foto-elektronendetectiehoeken worden respectievelijk weergegeven in Fig. 1a-c. Voor S1 is elke Ga 3d spectrum kan worden uitgerust met twee pieken, overeenkomend met de Ga-N- en Ga-O-bindingen. De Ga-O-bindingen zijn het gevolg van de oxidevorming als gevolg van de blootstelling aan zuurstof in de ALD, en de zuurstofstof dringt door in het aanvankelijke dunne Al2 O3 laag [3]. Voor S2 en S3 kunnen drie pieken worden geïdentificeerd, genoteerd als Ga–N, Ga–O en O 2s , respectievelijk. De O 2en piek wordt toegeschreven aan de Ga-O- en Al-O-bindingen, en het wordt duidelijk wanneer de detectiehoek groter wordt. Aangezien dit artikel niet op deze piek is gericht, wordt deze niet verder besproken. Figuur 2 geeft de BE van Ga–N-pieken weer als functie van θ voor S1-S3. Een afname van 0,2 eV wordt verkregen uit θ =27,5° tot 72,5° voor S1. Het suggereert een opwaartse bandbuiging, wat consistent is met de publicaties [3, 11]. Voor S2 vertoont de BE een afname van 0,1 eV, wat wijst op een lichte opwaartse bandbuiging nabij de interface in vergelijking met S1 of een vlakke energieband zonder bandbuiging in overweging van experimentele fouten. Voor S3 is er echter een toename van 0,2 eV in de BE, wat in tegenstelling is tot monsters S1 en S2, wat een neerwaartse bandbuiging adviseert. Figuur 3 registreert de Al 2p spectra voor alle monsters, en er is geen verandering in de BE's. Bovendien wordt de piek genoteerd als de Al-O-binding en bijgevolg heeft de AlGaN-laag een verwaarloosbare invloed op de Ga-N BE-variatie. Tabel 1 vat de BE's van Ga 3d . samen en Al 2p bij verschillende detectiehoeken voor alle monsters, met een fout van ± 0,1 eV.

De XPS Ga 3d kernniveau-spectra voor a S1, b S2 en c S3

De BE van de Ga–N-spectrumpiek als functie van de detectiehoek θ (ten opzichte van normaal) voor S2. De foutbalk is ± 0,1 eV

De XPS Al 2p kernniveau-spectra voor a S1, b S2 en c S3, en de piek geeft de Al-O-binding aan. Bovendien is er geen significante BE-variatie
De verhoudingen van de Ga-O tot Ga-N-piek voor alle monsters worden gegeven in Tabel 2. De verhouding is ongeveer 0,2 voor monsters S1 en S2, wat consistent is met eerdere resultaten [3]. Na de PDA-behandeling neemt de verhouding echter toe tot ~ -0,3 en duidt dit op een toename van de GaO x grensvlak laag. Bovendien wordt de Ga/N-verhouding ook gegeven in Tabel 2. De verhouding wordt berekend door de geïntegreerde intensiteiten van de Ga 3d te vergelijken. en N 1s pieken met atomaire gevoeligheidsfactoren [18]. Voor monsters S1 en S2 suggereert de verhouding rond 1,7 een Ga-rijke grenslaag. Echter, na de N2 uitgloeien, neemt de verhouding af tot ~ -1,0. Verder is voor elke hoek ook de bemonsteringsdiepte in Tabel 2 gegeven. Vanwege de exponentiële verzwakking van foto-elektronen, zijn 63 en 95% van de gedetecteerde elektronen afkomstig van binnen een afstand van 1λ (d.w.z. λ vertegenwoordigt respectievelijk het inelastische gemiddelde vrije pad van het elektron (IMFP)) en 3λ van het oppervlak. Daarom wordt de XPS-bemonsteringsdiepte gedefinieerd als 3λ nanometer onder het monsteroppervlak. In ons geval, Al2 O3 is de afdeklaag en de λ van Ga 3d foto-elektronen in Al2 O3 wordt geschat op ~ 3,4 nm. Voor een ruwe schatting wordt de bemonsteringsdiepte onder verschillende hoeken gegeven als 3λcosθ . De werkelijke Ga-N BE-bemonsteringsdiepte moet echter rekening houden met de dikte van Al2 O3 , dus de bemonsteringsdiepte wordt geschat op 3λcosθ minus de limiet Al2 O3 dikte. Omdat de GaO x laag bovenop de GaN-heterostructuur ligt, wordt het signaal van deze laag voor elke detectiehoek opgenomen. Met de toename van de detectiehoek neemt de signaalintensiteit van de Ga-N-binding echter af, wat resulteert in een toename van de Ga-O/Ga-N-verhouding. Als we S2 met S3 vergelijken, suggereren de toename van de Ga-O/Ga-N-verhouding en de afname van de Ga/N-verhouding dat de Ga-rijke laag is geoxideerd om GaO x te vormen .
Om de hier gepresenteerde experimentgegevens te illustreren, wordt schematisch een model voorgesteld in Fig. 4. Het Fermi-energieniveau van het GaN/AlGaN/GaN-substraat wordt gekalibreerd als 0 eV tijdens XPS-meting [19]. Het geleidingsbandmaximum (CBM), het valentiebandmaximum (VBM) en het kernniveau worden gegeven. De BE is het energieverschil tussen het kernniveau en het Fermi-niveau. In de ALD-afzetting zou O uit het zuurstofmiddel N in de Ga-N-binding kunnen vervangen om het GaN te oxideren en de omringende N-atomen zouden N2 kunnen vormen moleculen [20], wat leidt tot de vorming van de Ga-rijke laag en het galliumoxide (GaO x ) grenslaag [11, 18]. Dit wordt ondersteund door de Ga/N-verhouding die groter is dan 1 in Tabel 2. Deze verhouding geeft de verandering van GaN-stoichiometrie aan en het intrinsieke spontane polarisatie-effect van GaN zou moeten verdwijnen [21,22,23]. Het resultaat is dat de Ga-rijke laag, als de GaN-naar-GaO x overgangslaag, elimineert de polarisatie-geïnduceerde negatieve ladingen en resulteert in een vlakke geleidingsband [11], zoals weergegeven in Fig. 4.
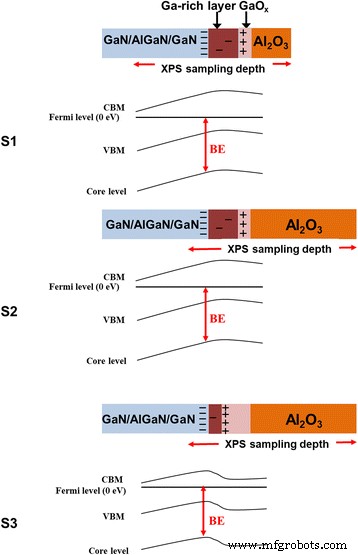
In het grensvlakgebied resulteert O, dat N vervangt in de Ga–N-binding, in een Ga-rijke laag en een GaO x laag. De Ga-rijke laag fungeert als de GaN-naar-GaO x overgangslaag. De Ga-O-formatie elimineert de polarisatie van GaN en werkt als positieve ladingen. Dientengevolge buigt de geleidingsband geleidelijk van opwaarts naar neerwaarts en varieert de BE overeenkomstig
Bovendien wordt tijdens het gloeiproces het Ga-rijke oppervlak geoxideerd om een dikker GaO x te vormen laag. Omdat de oxidatie een kinetisch beperkte reactie is en beperkt is tot ongeveer twee oppervlaktemonolagen, zal de bulk niet sterk worden verstoord [24]. Daarom is het Ga-N-bindingssignaal voornamelijk afkomstig van de niet-geoxideerde onderliggende bulk, wat resulteert in de Ga / N-stoichiometrische verhouding van 1 voor S3. De GaO x Er is gemeld dat de laag positieve ladingen binnenbrengt, mogelijk vaste ladingen aan het grensvlak met energietoestanden tussen de geleidingsbandminima van het natieve oxide en GaN, waardoor de band naar beneden zou buigen [4, 11, 13, 14]. Daarom begint de geleidingsband van de Ga-rijke laag af te nemen in het gebied nabij de GaO x laag. Een dikkere GaO x zal naar verwachting een grotere dichtheid van positieve ladingen opleveren. Met betrekking tot de constante BE van Ga–O en Al–O in S3, geeft dit aan dat de positieve lading zich moet bevinden op het grensvlak van de Ga-rijke laag/GaO x laag. De positieve ladingen en polarisatie-geïnduceerde negatieve ladingen bouwen een intern elektrisch veld op dat de bandbuiging veranderde van opwaartse bandbuiging naar neerwaartse bandbuiging, getoond in Fig. 4. Vanwege de neerwaartse bandbuiging neemt de BE toe met de toename van de detectiehoek .
De GaO x grensvlaklaag brengt positieve ladingen binnen die de hoogte van de interfacebarrière verhogen ɸb . ɸb wordt gedefinieerd als het energieverschil tussen het Fermi-niveau en het geleidingsbandminimum aan het oppervlak of grensvlak [25]. Als gevolg hiervan, na de A2 O3 afzetting wordt de mobiliteit van de 2DEG verhoogd en de elektronendichtheid van 2DEG verlaagd [16, 25, 26].
Met de verhoging van de Al2 O3 dikte, reflecteert het XPS-signaal meer op het interfacegebied tussen de afgedekte Al2 O3 en GaN/AlGaN/GaN, dat wordt gevalideerd door de XPS-bemonsteringsdiepte weergegeven in Tabel 2. Dit verklaart dat slechts een deel van het bandbuigingsprofiel kon worden gedetecteerd voor S2 [27]. Als resultaat is de BE-variatie 0,1 eV, kleiner dan 0,2 eV van S1. Voor S3, met een dikkere grenslaag, wordt de dichtheid van positieve ladingen verhoogd, wat resulteert in een neerwaartse bandbuiging.
Conclusies
Samengevat, de interface-polarisatie van Al2 O3 -afgetopte GaN/AlGaN/GaN wordt onderzocht door de ARXPS. De intrinsieke polarisatie van GaN wordt geëlimineerd vanwege een Ga-rijke laag en een GaO x laagvorming. Bovendien zijn de Ga-O-bindingen van de GaO x laag brengen positieve grensvlak vaste ladingen. Door deze polarisatievariatie varieert de band van de opwaartse buiging tot de neerwaartse buiging in het interfacegebied.
Nanomaterialen
- 5G en GaN:toekomstige innovaties
- Impact van oppervlaktetoestanden en aluminiummolfractie op oppervlaktepotentiaal en 2DEG in AlGaN/GaN HEMT's
- Infraroodreflectieanalyse van epitaxiale n-type gedoteerde GaN-lagen gegroeid op saffier
- Endotheelcellen targeten met multifunctionele GaN/Fe-nanodeeltjes
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Optimale siliciumdoteringslagen van kwantumbarrières in de groeireeks die een zacht opsluitingspotentieel vormen van acht-periode In0.2Ga0.8N/GaN Quantum Wells of Blue LED's
- Een onderzoek naar een kristallijn-silicium zonnecel met zwarte siliciumlaag aan de achterkant
- Het groeimechanisme van GaN epitaxiale lagen op mechanisch geëxfolieerd grafiet begrijpen
- Strain-gecontroleerde recombinatie in InGaN/GaN meerdere kwantumputten op siliciumsubstraten
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
- In situ hogedrukröntgendiffractie en Raman-spectroscopieonderzoek van Ti3C2Tx MXene



