Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
Abstract
In situ gevormd SiO2 werd geïntroduceerd in HfO2 gate-diëlektrica op Ge-substraat als tussenlaag door plasma-versterkte atomaire laagafzetting (PEALD). De interface-, elektrische en banduitlijningskenmerken van de HfO2 /SiO2 diëlektrische stapels met hoge k-poorten op Ge zijn goed onderzocht. Er is aangetoond dat Si-O-Ge tussenlaag wordt gevormd op het Ge-oppervlak tijdens de in situ PEALD SiO2 depositie proces. Deze tussenlaag vertoont een fantastische thermische stabiliteit tijdens het uitgloeien zonder duidelijke vorming van Hf-silicaten. Bovendien kan het ook de GeO2 . onderdrukken degradatie. De elektrische metingen tonen aan dat een capaciteitsequivalente dikte van 1,53 nm en een lekstroomdichtheid van 2,1 × 10 −3 A/cm 2 bij poortbias van Vfb +-1 V werd verkregen voor het gegloeide monster. De geleidingsband (valentieband) wordt gecompenseerd bij de HfO2 /SiO2 /Ge-interface met en zonder PDA blijken respectievelijk 2,24 (2,69) en 2,48 (2,45) eV te zijn. Deze resultaten geven aan dat in situ PEALD SiO2 kan een veelbelovende grensvlakcontrolelaag zijn voor de realisatie van hoogwaardige Ge-gebaseerde transistorapparaten. Bovendien kan worden aangetoond dat PEALD een veel krachtigere technologie is voor ultradunne afzetting van grensvlakcontrolelagen dan MOCVD.
Achtergrond
Met de voortdurende afbouw van metaaloxide-halfgeleider-veldeffecttransistoren (MOSFET's), nadert de op Si gebaseerde MOSFET zijn fysieke en technische beperking. Alternatieve kanaalmaterialen zoals germanium (Ge) [1, 2] en III-V-materialen [3-5] hebben de laatste tijd veel belangstelling gewekt voor hoogwaardige logische apparaattoepassingen. Onder hen heeft Ge het potentieel om silicium te vervangen als het kanaalmateriaal in MOSFET vanwege zijn intrinsieke hogere mobiliteit van gatendragers [6]. Directe afzetting van hoge-k-poortdiëlektrica op Ge-substraten veroorzaakt echter vaak een hoge interface-valdichtheid (Dit ) en de ongewenste vorming van een grenslaag tussen Ge en hoge-k diëlektrica [7]. Daarom is het, om hogesnelheids- en laagvermogen Ge-gebaseerde MOSFET's te bereiken, erg belangrijk om een kwalitatief hoogwaardige k /Ge-interface. Gelukkig zijn er veel methoden gemeld om de kwaliteit van de hoge-k/Ge-interface [8] te verbeteren, zoals de introductie van SiO2 [9], Si [10], GeO2 [11], Al2 O3 [12, 13], GeOx Nj [14, 15] en zeldzame aardoxiden [16, 17] als grensvlakcontrolelaag tussen Ge-substraat en hoge k poort diëlektrica. In het bijzonder de GeO2 /Ge-structuur heeft superieure interface-eigenschappen, een extreem lage interface-statusdichtheid (Dit ) van minder dan 1 × 10 11 cm −2 eV −1 kan worden bereikt [18]. Echter, GeO2 zou ontleden boven 425 ° C, en het is oplosbaar in water. Dientengevolge, een onaanvaardbare Dit wordt altijd onthuld voor de Ge-MOS-condensator (MOSCAP) [6]. Gelukkig hebben Kita et al. meldde die afdeklaag op GeO2 kan de GeO2 . onderdrukken degradatie; de keuze van het materiaal voor de deklaag zou echter zeer cruciaal moeten zijn [19-21]. Bijvoorbeeld Si of Y2 O3 werkt efficiënter dan HfO2 om de Ge-O-desorptie te vertragen. Deze resultaten geven het belang aan van materialen met een hoge k of selectie van grensvlakcontrolelagen om de GeO2 te remmen. degradatie. Nakashima et al. meldde dat een zeer dunne SiO2 /GeO2 dubbellaag door fysieke dampafzetting (PVD) is een veelbelovende tussenlaag voor Ge-passivering, een Dit van 4 × 10 11 cm -2 eV −1 werd bereikt in de buurt van de midgap [22, 23]. Li et al. introduceerde de SiO2 tussenlaag op Ge door metaal-organische chemische dampafzetting (MOCVD) en SiO2 tussenlaag kan Ge-uitdiffusie effectief onderdrukken tijdens HfO2 groei en daaropvolgend gloeiproces na depositie [9]. Daarom is SiO2 zou een prachtige grensvlakcontrolelaag voor Ge-substraat moeten zijn. In vergelijking met PVD en MOCVD kan PEALD echter een veel uniformere passiveringslaag bieden, vooral voor ultradunne diktes. Vandaar, PEALD-gevormd SiO2 kan een veelbelovende grensvlakcontrolelaag zijn om hoogwaardige op Ge-gebaseerde transistorapparaten te realiseren.
Hierin hebben we in situ PEALD-gevormd SiO2 . geïntroduceerd in HfO2 /Ge stapels als grensvlaklaag. De grensvlak-, elektrische en banduitlijningskenmerken van ALD HfO2 films op n-type Ge-substraten zijn zorgvuldig onderzocht. De SiO2 werd voor het eerst afgezet op de Ge-substraten als grensvlakcontrolelaag door PEALD. Dan, HfO2 gate-diëlektricum werd in situ afgezet door thermische ALD-modus. Uitgloeien na depositie (PDA) bij 500 °C gedurende 60 s in N2 werd uitgevoerd voor de HfO2 /SiO2 high-k gate diëlektrische stapels op Ge. De röntgenfoto-elektronspectroscopie-analyses laten zien dat Si-O-Ge-tussenlaag en GeO2 laag wordt gevormd op het Ge-oppervlak tijdens PEALD SiO2 afzetting. Deze Si-O-Ge-tussenlaag vertoont niet alleen een fantastische thermische stabiliteit, maar kan ook de thermische ontleding van GeO2 onderdrukken . Daarom werden goede elektrische eigenschappen bereikt voor de HfO2 /Si-O-Ge/GeO2 /Ge stapels. Vergeleken met MOCVD SiO2 tussenlaag, in situ PEALD SiO2 vertoont sterk verbeterde elektrische eigenschappen. Daarom is PEALD een veel krachtigere technologie dan MOCVD op het gebied van de fabricage van MOSFET's, vooral voor ultradunne afzetting van grensvlakcontrolelagen.
Methoden
N-type Sb-gedoteerde Ge (100) met een soortelijke weerstand van 0,2-0,3 Ω∙cm werden als substraten gebruikt. De substraten werden eerst gereinigd door sonicatie in aceton, ethanol, isopropanol en gedeïoniseerd water gedurende respectievelijk 5 minuten. Vervolgens een verdunde HBr-oplossing (H2 O/HBr = 3:1) werd gebruikt om de inheemse oxiden aan het oppervlak gedurende 5 minuten te etsen. Na natte chemische reiniging werden de substraten gespoeld met gedeïoniseerd water en droog geblazen in pure N2 . Vervolgens werden de substraten onmiddellijk overgebracht naar de PEALD (Picosun SUNALE TM R-200) kamer. Voor de hoge-k HfO2 filmafzetting, 10 cycli SiO2 film werd afgezet bij 250 ° C door PEALD als tussenlaag, waarbij één cyclus bestond uit 1 s Si-broninjectie, 10 s N2 zuivering, 13,5 s oxidantinjectie en 4 s N2 zuiveren. Tris-(dimethylamino)-silaan (TDMAS) en O2 plasma werden gebruikt als Si-precursor en oxidatiemiddel voor SiO2 deponering resp. TDMAS werd bij kamertemperatuur bewaard. Pure O2 gas (99,999%) werd gebruikt als O2 plasma bron. Het plasmavermogen en O2 gasstroomsnelheid waren respectievelijk 2500 W en 160 sccm. De groeisnelheid van PEALD SiO2 werd vastgesteld op ~ 0,7 Å / cyclus door ex situ spectroscopie-ellipsometrie. Dan ~4 nm dikke HfO2 film werd in situ afgezet bij 250 ° C gedurende 40 cycli door thermische ALD, waarbij één cyclus bestond uit 0,1 s Hf-brondosering, 4 s N2 opschonen, 0,1 s H2 O-dosering en 4 s N2 zuiveren. Tetrakis-(ethylmethylamino)-hafnium (TEMAH) en H2 O werden gebruikt als Hf-precursor en oxidant voor HfO2 deponering resp. TEMAH werd verdampt bij 150°C en H2 O werd op kamertemperatuur gehouden. Pure N2 (99,999%) werd gebruikt als draaggas en spoelgas. PDA werd uitgevoerd in N2 omgevingstemperatuur bij 500 °C gedurende 60 s onder atmosferische druk met behulp van snel thermisch gloeien.
De grensvlakstructuren en chemische binding van de films werden onderzocht door ex situ röntgenfoto-elektronspectroscopie (XPS, Thermo Fisher K-Alpha) met standaard Al Kα (1486,7 eV) röntgenbron. XPS-spectra werden verzameld bij een starthoek van 90°. De bindingsenergieschaal werd gekalibreerd met behulp van de Ge 3d5/2 piek op 29,4 eV. Bovendien werden XPS-spectra uitgerust met Gauss-Lorentziaanse (G-L) -functies na slimme achtergrondaftrekking. Pt-topelektroden van oppervlakte 1.55 × 10 −4 cm 2 werden afgezet op het oppervlak van HfO2 films met behulp van een schaduwmasker door de sputtermethode voor elektrische metingen. De capaciteit-spanning (C-V) en lekstroomdichtheid-spanning (J-V) karakteristieken werden gemeten door een Keithley 4200 halfgeleideranalysatorsysteem met een sondeplatform (Cascade Summit 12000B-M).
Resultaten en discussie
Voor de dunne PEALD SiO2 (~ 0,7 nm) op Ge, Si 2p vertoont een piek bij 102,4 eV die overeenkomt met Si-O-binding (Fig. 1a), die kleiner is dan de bindingsenergie van ideaal SiO2 [24]. Beide siliciumsuboxide (SiOx ) afzetting en Si-O-Ge-vorming op het Ge-oppervlak tijdens het PEALD-proces kan ervoor zorgen dat de Si 2p-verschuiving naar lagere energie gaat. Daarom werd ook het Si 2p-spectrum van dikke PEALD (~ 7 nm) op Ge uitgevoerd. Er kan worden vastgesteld dat het een hoofdpiek vertoont bij 103,6 eV, wat overeenkomt met ideaal SiO2 binding, zoals weergegeven in Fig. 1b. Dus het siliciumoxide dat hier door PEALD is afgezet is ideaal SiO2 . Naast de sterke Si-O-Si-piek is er echter een zwakke piek bij ~ 102,4 eV, wat zou moeten overeenkomen met Si-O-Ge-binding op het Ge-oppervlak. Daarom kan worden geconcludeerd dat Si-O-Ge wordt gevormd op het Ge-oppervlak in de initiële PEALD SiO2 groei. Na in situ 4 nm HfO2 afzetting neemt de Si 2p-piekintensiteit af zonder duidelijke chemische verschuiving (102,3 eV), zoals weergegeven in figuur 1a. Verder is de Si 2p piek vertoont ook geen duidelijke chemische verschuiving (102,2 eV) na de 500 °C PDA in N2 , wat wijst op de goede thermische stabiliteit van de HfO2 /SiO2 interface tijdens HfO2 depositie en PDA-proces. In Hf 4f-spectrum van als gedeponeerde HfO2 /SiO2 gate-stacks (Fig. 1c), het doublet op 16.5 en 18.2 eV kan worden toegewezen aan Hf 4f7/2 en Hf 4f5/2 pieken van HfO2 met de spin-baansplitsingsenergie van 1,7 eV, consistent met de literatuurwaarde van HfO2 [25]. Na 500 ° C PDA vertoont het Hf 4f-spectrum geen duidelijke verandering met slechts 0,1 eV verschuiving naar hogere energie. Het impliceert dat er geen duidelijke Hf-silicaten gevormd worden tijdens het PDA-proces. In Fig. 1d geeft het Ge 3d-spectrum van het als gedeponeerde monster de doubletpieken weer bij 29,4 en 30,0 eV, die kunnen worden toegewezen aan de Ge 3d5/2- en Ge 3d3/2-pieken van het Ge-substraat met de spinbaansplitsingsenergie van 0,6 eV. Behalve het signaal van Ge-substraat, is er een enorme piek bij 32,7 eV voor Ge-O-binding. De Ge-O-piek zou het resultaat moeten zijn van de vorming van Ge-O-Si en GeO2 . De GeO2 laag werd gevormd door zuurstofplasma-oxidatie aan het oppervlak tijdens PEALD SiO2 depositie proces. Daarom is de echte gefabriceerde structuur hier HfO2 /Si-O-Ge/GeO2 /Ge stapels. Bovendien vertoont het Ge 3d-spectrum geen duidelijke verandering na 500 °C PDA-behandeling, wat wijst op de thermische stabiliteit van HfO2 /Si-O-Ge/GeO2 /Ge-stacks zonder GeO2 degradatie. Het is gemeld door Kita et al. dat sommige afdeklagen op GeO2 zou de GeO2 . kunnen onderdrukken ontleding, zoals Si of La2 O3 [19]. Daarom kan de PEALD die de Si-O-Ge-tussenlaag hier heeft geïnduceerd, ook de GeO2 onderdrukken ontleding. Op basis van bovenstaande XPS-analyse kan worden geconcludeerd dat een ultradunne Si-O-Ge-tussenlaag wordt gevormd op het Ge-oppervlak. Bovendien vertoont deze tussenlaag een fantastische thermische stabiliteit zonder vorming van Hf-silicaten, het kan ook de GeO2 remmen degradatie.
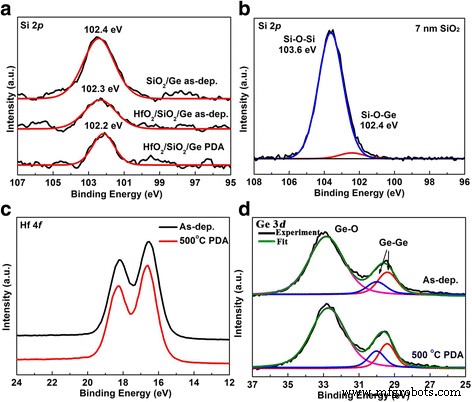
XPS-spectra van SiO2 /Ge en HfO2 /SiO2 /Ge structuren. een Si 2p-spectra van SiO2 , zoals gedeponeerd en gegloeid HfO2 /SiO2 op Ge. b Si 2p-spectra van dik SiO2 (7 nm) op Ge. c, d Hf 4f en Ge 3d-spectra van zoals gedeponeerd en uitgegloeid HfO2 /SiO2 /Ge structuren
Afbeelding 2a geeft de hoogfrequente (1 MHz) C-V-curves van HfO2 weer /SiO2 gate-stacks op Ge voor en na PDA. Het kan worden gevonden dat vlakke bandspanning (V fb ) waarden van HfO2 /SiO2 /Ge voor en na PDA zijn respectievelijk 0,42 en 0,27 V. De berekende ideale V fb waarde is 0,55 V. De licht negatieve V fb verschuiving geeft positieve vaste ladingen aan, die kunnen worden geïnduceerd door de zuurstofvacatures in de diëlektrica [26, 27]. Tijdens het gloeiproces in de inerte atmosfeer kunnen meer zuurstofvacatures worden geïnduceerd, wat resulteert in een licht negatieve V fb verschuiving. In veel gerapporteerde literatuur is aangetoond dat de GeO2 degradatie tijdens het gloeien zal de positieve V . veroorzaken fb verschuiving. Aangenomen wordt dat het desorptieproces van Ge-O extra negatieve ladingen genereert [28, 29]. Daarom kan ook worden geconcludeerd dat GeO2 ontleding wordt onderdrukt door Ge-O-Si tussenlaag van V fb verschuiving. De accumulatiecapaciteit neemt duidelijk toe van de oorspronkelijke 1,92 tot 2,25 F/cm 2 na PDA. De corresponderende capacitantie-equivalentdikte (CET)-waarden van de MOS-condensatoren kunnen worden berekend uit de accumulatiecapaciteiten van de C-V-curves met behulp van ε0 εr Aircoacc [30]. Daarom wordt een kleinere CET van 1,53 nm verkregen na PDA in vergelijking met een als gedeponeerd monster van 1,80 nm. Het kan worden toegeschreven aan het feit dat na PDA-proces een dichtere en dunnere hoge-k-laag kan worden verkregen. Afbeelding 2b toont de lekstroomkenmerken van HfO2 /SiO2 films op Ge voor en na PDA. Bij de voorspanning van V fb + 1 V, de lekstroomdichtheid is 2,1 × 10 −3 A/cm 2 en 2.2 × 10 −4 A/cm 2 voor respectievelijk het monster voor en na PDA. De verhoogde lekstroomdichtheid na PDA kan ook worden toegeschreven aan de afname van de dikte van de poortdiëlektrica.
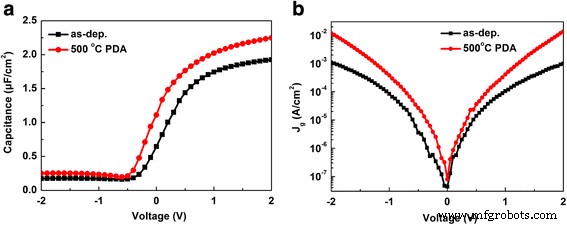
Elektrische kenmerken van HfO2 /SiO2 gate-stacks op Ge-substraten voor en na 500 ° C PDA. een Hoogfrequente (1 M Hz) CV-curven. b J-V-curven
Om de interfacekwaliteit van HfO2 . te onderzoeken /SiO2 /Ge kwantitatief, de dichtheid van de interfacetoestand (D het ) werd bepaald met de conductantiemethode [31]. Afbeelding 3 toont de verdeling van D het onder Ec in de band gap geëxtraheerd door de conductantiemethode bij kamertemperatuur voor Pt/HfO2 /SiO2 /Ge voor en na 500 °C PDA. De D het kan ruwweg worden berekend vanaf D het = 2.5 × (G p /w )max /A q, waar (G p /w )max is de piekwaarde van conductantie-spanningskarakteristieken, f (=w /2π) is de frequentie, A is het elektrodeoppervlak, en q is de elementaire lading. Daarom, D het waarden van Pt/HfO2 /SiO2 /Ge-structuren zonder en met PDA worden bepaald op 4.05 × 10 12 eV −1 cm -2 en 5.37 × 10 12 eV −1 cm −2 bij E-Ev = 0,38 eV, respectievelijk. De onderste D het waarden van 2,03 × 10 12 cm −2 eV −1 en 2.67 × 10 12 cm −2 eV -1 nabij de onderkant van de geleidingsband worden waargenomen voor respectievelijk de monsters zonder en met PDA.
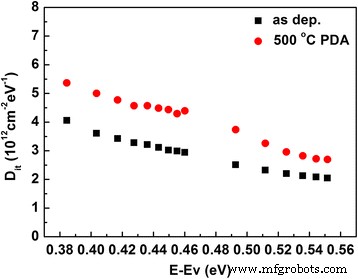
Distributie van Dit onder Ec in de band gap bij kamertemperatuur voor Pt/HfO2 /SiO2 /Ge voor en na 500 °C PDA
Afbeelding 4 illustreert de lekstroomdichtheid (J g )-CET-relatie van op Ge gebaseerde MOS-condensator met verschillende grensvlakcontrolelaag [32, 33]. Vergeleken met de S-gepassiveerde Ge zonder tussenlaag gerapporteerd door ons vorige werk [34], is de HfO2 /SiO2 /Ge in dit werk vertoont veel verbeterde eigenschappen met kleinere CET (1,53 vs 2,18 nm), lekstroomdichtheid (2,1 × 10 −3 vs 3,1 A/cm 2 ), en D het (4.37 × 10 12 vs 8.61 × 10 12 eV −1 cm −2 ). Het impliceert dat in situ PEALD-gevormd SiO2 is een prachtige passiveringslaag voor Ge. Bovendien, vergeleken met het ex situ gevormde SiO2 tussenlaag door MOCVD [9], het monster met in situ PEALD-gevormd SiO2 tussenlaag in dit werk laat betere elektrische prestaties zien met zowel kleinere CET (1,53 vs 1,75 nm) als lekstroomdichtheid (2,1 vs 3,9 mA/cm 2 ). Het kan worden toegeschreven aan het feit dat SiO2 afgezet door PEALD zijn uniformer dan MOCVD, vooral voor ultradunne diktes.
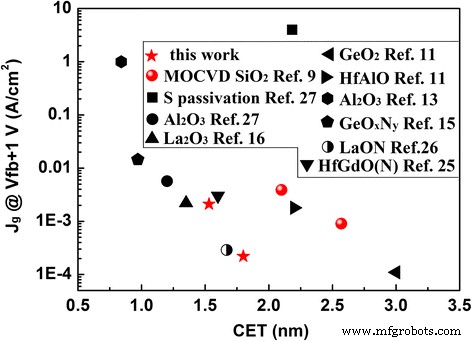
Lekstroomdichtheid (Jg)-CET-relatie voor op Ge gebaseerde MOS-condensatoren met verschillende grensvlakbesturingslaag
De banduitlijning bij HfO2 /SiO2 /Ge-interface werd ook bepaald door de valentiebandoffset te meten ∆E v (VBO) met XPS. De VBO-waarden kunnen worden verkregen op basis van de aanname dat het energieverschil tussen het kernniveau en de valentieband (VB)-rand van het substraat constant blijft met/zonder de afzetting van diëlektrica [35]. Hier werd het Ge-substraat gekozen als referentie om de VBO tussen gate-diëlektricastapel en Ge-substraat te bepalen. Figuur 5a toont de VB-spectra van het schone Ge-substraat, zoals afgezet en uitgegloeid HfO2 /SiO2 /Ge-stapels bepaald door respectievelijk lineaire extrapolatiemethode. De VB-rand van het schone Ge-substraat is vastgesteld op 0,10 eV. En de VB-randen van as-afgezet en uitgegloeid HfO2 /SiO2 monsters blijken respectievelijk 2,55 en 2,79 eV te zijn. Het kan worden opgemerkt dat er een kleine staart is in VB-spectra voor HfO2 /SiO2 /Ge-stapels, wat overeenkomt met het Ge-substraatsignaal [36]. De voorrand van deze zwakke staart wordt gemeten als 0,10 eV en is hetzelfde als de VB-rand van Ge-substraat. Daarom zijn de VBO's op het raakvlak van HfO2 /SiO2 /Ge met en zonder PDA worden geschat op respectievelijk 2,69 en 2,45 eV. De geleidingsband-offset ∆E c (CBO) kan worden verkregen door de VBO en de bandgap van het substraat af te trekken van de bandgap van HfO2 :
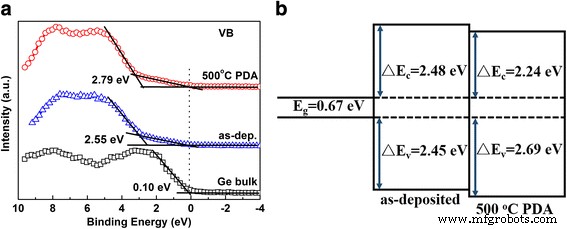
Banduitlijning van als afgezette en uitgegloeide HfO2 /SiO2 film over Ge. een Valentiebandspectra van het Ge-substraat, zoals gedeponeerd en uitgegloeid HfO2 /SiO2 films. b Schematische voorstelling van banduitlijning van als afgezette en uitgegloeide HfO2 /SiO2 film op Ge
waar E g (HfO2 ) en E g (Ge) zijn de bandgap van HfO2 en Ge, respectievelijk. De bandgaps van Ge en HfO2 zijn respectievelijk 0,67 en 5,6 eV. Daarom zijn de CBO-waarden op het raakvlak van HfO2 /SiO2 /Ge met en zonder PDA worden geschat op respectievelijk 2,24 en 2,48 eV. De CBO-waarden komen overeen met de eerder gerapporteerde gegevens van 1,8–2,6 eV [37]. Afbeelding 5b illustreert de corresponderende banduitlijning van zoals gedeponeerd en uitgegloeid HfO2 /SiO2 /Ge structuren. Het is duidelijk dat de HfO2 /SiO2 high-k gate diëlektrische stapels op Ge vertonen grote VBO- en CBO-waarden met enorme barrièrehoogten om lekstroom te voorkomen.
Conclusies
Samengevat, SiO2 tussenlaag werd geïntroduceerd in HfO2 gate-diëlektrica op n-Ge-substraten met succes door in situ PEALD. We hebben de grensvlak-, elektrische eigenschappen en banduitlijning van HfO2 . onderzocht /SiO2 /Ge MOS. Er is aangetoond dat Ge-O-Si tussenlaag en GeO2 laag wordt gevormd op het Ge-oppervlak tijdens de in situ SiO2 afzetting. Deze Ge-O-Si-tussenlaag vertoont een fantastische thermische stabiliteit tijdens PDA zonder vorming van Hf-silicaten. Bovendien kan de Ge-O-Si-tussenlaag ook de GeO2 . remmen degradatie tijdens het gloeiproces. De HfO2 /SiO2 /Ge-monster na PDA vertoont een CET-waarde van 1,53 nm met een lage lekstroomdichtheid van 2,1 × 10 −3 A/cm 2 op Vfb + 1 V. De VBO-waarden bij de HfO2 /SiO2 /Ge met en zonder PDA worden bepaald op 2,69 en 2,45 eV, en de CBO-waarden op respectievelijk 2,24 en 2,48 eV. Vergeleken met de ex situ gevormde SiO2 tussenlaag door MOCVD, het monster met in situ PEALD-gevormd SiO2 tussenlaag in dit werk vertoont verbeterde elektrische prestaties, toegeschreven aan het feit dat SiO2 gedeponeerd door PEALD zijn uniformer dan MOCVD. Daarom is PEALD een veel krachtigere technologie voor ultradunne afzetting van grensvlakcontrolelagen dan MOCVD.
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Retentiemodel van TaO/HfO x en TaO/AlO x RRAM met zelfherstellende schakelkenmerken
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Elektrische eigenschappen van composietmaterialen met elektrisch veldondersteunde uitlijning van nanokoolstofvullers
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
- Effecten van etsvariaties op Ge/Si-kanaalvorming en apparaatprestaties



