Infraroodreflectieanalyse van epitaxiale n-type gedoteerde GaN-lagen gegroeid op saffier
Abstract
Infrarood (IR) reflectiespectroscopie wordt toegepast om Si-gedoteerde meerlaagse n + te bestuderen /n0 /n + -GaN-structuur gegroeid op GaN-buffer met GaN-sjabloon / saffiersubstraat. Analyse van de onderzochte structuur door middel van foto-etsen, SEM en SIMS-methoden toonde het bestaan aan van de extra laag met het drastische verschil in Si- en O-dopingniveaus en gelokaliseerd tussen de epitaxiale GaN-buffer en sjabloon. Simulatie van de experimentele reflectiviteitsspectra werd uitgevoerd in een breed frequentiebereik. Het is aangetoond dat de modellering van het IR-reflectiespectrum met behulp van de 2 × 2-overdrachtsmatrixmethode en het opnemen in de analyse van de extra laag het mogelijk maakt om de beste pasvorm van het experimentele spectrum te verkrijgen, wat volgt bij de evaluatie van GaN-laagdiktes die in goede staat zijn. overeenkomst met de SEM- en SIMS-gegevens. Spectrale afhankelijkheid van plasmon-LO-fonon-gekoppelde modi voor elke GaN-laag wordt verkregen uit de spectrale afhankelijkheid van diëlektricum van Si-dopingonzuiverheid, die wordt toegeschreven aan compensatie-effecten door de acceptortoestanden.
Achtergrond
De laatste jaren is er veel belangstelling voor III-nitridematerialen, in het bijzonder voor GaN [1, 2]. Door de doorbraak in de groeitechnieken hebben epitaxiale GaN-films een brede toepassing gevonden in opto-elektronische apparaten zoals blauwe en ultraviolette lichtgevende diodes (LED's) [3], lasers [4] en micro-elektronische apparaten, bijv. g., hoogvermogen- en hoogfrequente veldeffecttransistoren [5, 6]. Concentratie en mobiliteit van gratis dragers zijn de belangrijkste parameters die de prestaties van het apparaat in toepassingen bepalen. Hall-meting van concentratie en mobiliteit van vrije dragers in meerlaagse GaN-gebaseerde apparaatstructuren is geen triviale en tijdrovende technologische taak waarvoor ohmse contacten aan elke meetlaag en speciale meetprocedures nodig zijn.
Fourier-transformatie infrarood (IR) reflectiespectroscopie en Raman-spectroscopie zijn contactloze en niet-destructieve methoden waarmee niet alleen de fonontrillingen kunnen worden bestudeerd, maar ook de eigenschappen van de drager [7]. Het bekende probleem van confocale micro-Raman-spectroscopie is echter een verslechtering van de ruimtelijke resolutie in diepte als gevolg van de breking van licht [8]. Het werd getoond in ref. [6] dat bij dieptescanning van meerlagige GaN-structuur met een excitatiegolflengte van 488,0 nm, de diepteresolutie slechts ongeveer 1,8 m is, terwijl de laterale resolutie ongeveer 210 nm is. IR-spectroscopie overwint dit probleem vanwege de hoge gevoeligheid voor laagdikte als gevolg van interferentie-effecten en de impact van de spreiding van de brekingsindex in een breed spectraal bereik.
IR-reflectiespectra van dunne GaN-films werden al in 1973 onderzocht door A.S. Baker [9], maar ruimtelijke inhomogeniteit en algehele lage structurele kwaliteit van dergelijke films beperkten de praktische toepassing van de verkregen resultaten aanzienlijk. Desalniettemin werd een mogelijkheid aangetoond om parameters van optische fononen en absorptie van vrije dragers in dunne films van GaN te bepalen. De gedetailleerde studies van longitudinale optische fonon– plasmon-gekoppelde (LOPC) modi in bulk GaN werden uitgevoerd door Perlin et al. [10] met behulp van Raman-spectroscopie en door Shubert et al. [11] met behulp van IR-ellipsometrie. Het effect van verschillende substraten op de optische eigenschappen van kubische en wurtziet GaN-films is ook in detail bestudeerd [12, 13]. Gezien het gebrek aan natieve GaN-substraten, werd aangetoond dat het gebruik van saffiersubstraten voor epitaxiale groei van GaN-film optimaal is voor gebruik in apparaten die bij hoge temperaturen werken. IR-reflectiespectroscopiestudies van hexagonale saffier [14] lieten een complex spectrum zien, waarvan de vorm sterk afhangt van de polarisatie en de invalshoek. Dit bemoeilijkt de metingen en bepaling van de spectrale kenmerken van fonon-modi en eigenschappen van vrije dragers in dunne GaN-film die is gegroeid op saffiersubstraten.
Een juiste selectie van het algoritme voor spectrale analyse en de vorm van de diëlektrische functie zijn dus van groot belang voor de analyse van de IR-reflectiespectra van meerlaagse GaN-op-saffierstructuren [15,16,17]. Dit artikel laat de mogelijkheid zien van toepassing van IR-reflectiespectroscopie en 2 × 2 transfermatrixmethode voor de analyse van vlakke GaN-gebaseerde meerlaagse structuren met niet-uniforme diepte- en doteringsprofielen, die in de praktijk een ander type halfgeleider kunnen zijn III-nitride- gebaseerde apparaatstructuren met verticaal ontwerp, zoals lichtemitterende en gelijkrichtende diodes, Gunn-diodes, high-elektronmobiliteitstransistoren (HEMT's), enz.
Methoden
Experimenteel
De onderzochte n + /n0 /n + -GaN-structuren werden gekweekt op MOCVD GaN-templates op Al2 O3 (0001) substraten bij een temperatuur van 800 °C door plasma-geassisteerde moleculaire bundelepitaxie met behulp van een N2 stroomsnelheid van 0,5 sccm en een RF-plasmavermogen van 350 W (Fig. 1). Dit resulteert in een groeipercentage van ∼ 0,27 ML s −1 . Eerst werd een 0, 3 m dikke GaN-buffer gekweekt op MOCVD GaN-sjabloon. Een 0,8 m dikke Si-gedoteerde GaN-laag werd gevolgd door een 1,75 μm dikke ongedoteerde GaN-laag en een 0,4 m dikke Si-gedoteerde GaN-laag (figuur 1). De nominale Si-dopingconcentratie van de n + -GaN-lagen was ∼ 10 19 cm −3 .
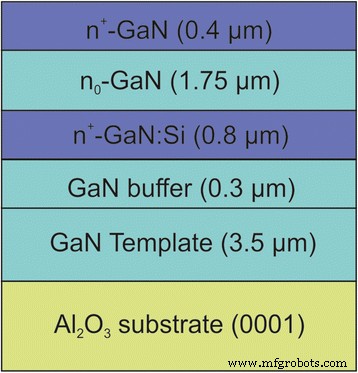
Schema van de onderzochte n + /n0 /n + -GaN-structuur gegroeid op GaN-template/(0001) saffiersubstraat
Om de gebieden met verschillende dragerconcentraties te onderzoeken, werd de gespleten rand van de onderzochte structuur onderzocht door de foto-etsmethode in een stroomloze configuratie met behulp van K2 S2 O8 –KOH waterige oplossing (KSO-D etssysteem) [18]. Deze methode maakt het mogelijk de gebieden met verschillende dragerconcentraties te onthullen en de relatieve verschillen in dragerconcentratie te visualiseren door de etssnelheid te meten met behulp van oppervlakteprofilering [19, 20]. Dwarsdoorsnede van het onderzochte monster werd gedurende 3 minuten met foto geëtst. Daarna werden monsters onderzocht door middel van scanning elektronenmicroscopie (SEM).
Secundaire ionenmassaspectroscopie (SIMS)-onderzoeken van monsters werden uitgevoerd op een CAMECA IMS6F-systeem met behulp van een cesium (Cs + ) primaire bundel, waarbij de stroom op 400 nA wordt gehouden om het profiel van de onzuiverhedenconcentratie te vinden. De grootte van het raster was ongeveer 50 × 50 μm 2 en de secundaire ionen werden verzameld uit een centraal gebied met een diameter van 30 m. Voor H, C, O en Si werden de concentraties afgeleid van respectievelijk H–, O–, C–, Si– soorten, en het matrixsignaal Ga– werd als referentie genomen.
De infraroodreflectiespectroscopiemetingen in het spectrale bereik van 300–4000 cm −1 met een spectrale resolutie van 1 cm −1 werden uitgevoerd bij kamertemperatuur met behulp van Bruker Vertex 70 V FTIR-spectrometer uitgerust met Globar-bron en een gedeutereerd triglycinesulfaat (DLaTGS) -detector met polyethyleenvenster. De invalshoek was 11°. S -gepolariseerde spectra werden gemeten met behulp van KRS-5 polarisator. Het reflectiespectrum van een gouden spiegel werd als referentie gebruikt.
Beschrijving van het optische analysemodel
De reflectie van lagen/substraatsysteem werd berekend met behulp van de 2 × 2 transfermatrixmethode [17, 21] waarin een willekeurig aantal lagen kan worden opgenomen en interferentie-effecten binnen de films automatisch worden beschouwd. 2 × 2 transfermatrixmethode voor isotrope gelaagde systemen zorgt voor een onafhankelijke berekening van s - en p - gepolariseerde reflectie- en transmissiespectra in het geval van gelaagde systemen bestaande uit homogene biaxiale of uniaxiale isotrope platen waarvan de c-as is uitgelijnd met de z-as van laboratoriumcoördinaten. In dit geval kan de 2 × 2 gelaagde systeemoverdrachtsmatrix worden weergegeven in de volgende weergave [21]:
$$ {\left(\begin{array}{c}\hfill {E}_0^{+}\hfill \\ {}\hfill {E}_0^{-}\hfill \end{array}\right) }_{s/p}=\frac{1}{t_{0,1}^{s/p}}\left(\begin{array}{cc}\hfill 1\hfill &\hfill -{r} _{1,0}^{s/p}\hfill \\ {}\hfill {r}_{1,0}^{s/p}\hfill &\hfill 1\hfill \end{array}\right ){\displaystyle \prod_{l=1}^N{T}_{l/\left(l+1\right)}^{s/p}{\left(\begin{array}{c}\hfill {E^{\prime}}_{N+1}^{+}\hfill \\ {}\hfill {E^{\prime}}_{N+1}^{-}\hfill \end{array }\right)}_{s/p}}={\left(\begin{array}{cc}\hfill {T}_{11}\hfill &\hfill {T}_{12}\hfill \\ {}\hfill {T}_{21}\hfill &\hfill {T}_{22}\hfill \end{array}\right)}_{s/p}{\left(\begin{array}{ c}\hfill {E^{\prime}}_{N+1}^{+}\hfill \\ {}\hfill {E^{\prime}}_{N+1}^{-}\hfill \end{array}\right)}_{s/p}. $$ (1)Sterretjes in de bovenste indexen van veldamplitude in het uitgangsmedium worden gebruikt in Vgl. (1) om rekening te houden met de waarden van elektrische veldcomponenten net aan de rechterkant van de N /N + 1 interface.
De \( 2\times 2\kern0.24em {T}_{l,\left(l+1\right)}^{s/p} \) overdrachtsmatrix is verantwoordelijk voor de voortplanting van vlakke golven vanuit de l -de laag, meerdere reflecties binnen deze laag, en invloed van l/(l + 1) koppel. Een dergelijke matrix kan worden bepaald als [17]:
$$ {T}_{l/\left(l+1\right)}^{s/p}=\frac{1}{t_{l/\left(l+1\right)}^{s/ p}}\left(\begin{array}{cc}\hfill \exp \left(i{\delta}_l^{s/p}\right)\hfill &\hfill -{r}_{l+1 ,l}^{s/p} \exp \left(i{\delta}_l^{s/p}\right)\hfill \\ {}\hfill {r}_{l,l+1}^{ s/p} \exp \left(-i{\delta}_l^{s/p}\right)\hfill &\hfill \exp \left(-i{\delta}_l^{s/p}\right )\hfill \end{array}\right), $$ (2)waarbij \( {r}_{l,l+1}^{s/p} \) en \( {t}_{l,l+1}^{s/p} \) partiële reflectie- en transmissiecoëfficiënten aanduiden voor l/(l + 1) interface, \( {\delta}_l^{s/p} \) is de faseverschuiving, opgelegd aan het licht na voortplanting door de l- de laag voor s - en p -gepolariseerd licht.
Faseverschuiving voor s - en p -gepolariseerd licht na het passeren van de l- de laag kan worden bepaald als [17]:
$$ {\delta}_l^{s/p}=\frac{2\pi {d}_l}{\lambda }{n}_{l,s/p} \cos {\theta}_{l, s/p}=\frac{2\pi {d}_l}{\lambda }{n}_l\sqrt{1-{\left(\frac{1}{n_{l,s/p}} \sin \theta \right)}^2}, $$ (3)waar n l is de complexe brekingsindex voor de l- de laag, d l is de dikte van de l- de laag, en θ is de invalshoek.
Gedeeltelijke reflectie- en transmissiecoëfficiënten voor de s - en p -polarisaties kunnen worden berekend met behulp van Fresnel-vergelijkingen. Bijvoorbeeld gedeeltelijke reflectie- en transmissiecoëfficiënten voor de s -polarisatie hebben de volgende vorm [21]:
$$ \begin{array}{l}{r}_{l,l+1}^s=\frac{n_{ls} \cos {\theta}_{ls}-{n}_{\left( l+1\right)s} \cos {\theta}_{\left(l+1\right)s}}{n_{ls} \cos {\theta}_{ls}-{n}_{\ left(l+1\right)s} \cos {\theta}_{\left(l+1\right)s}}\\ {}{t}_{l,l+1}^s=\frac {2{n}_{ls} \cos {\theta}_{ls}}{n_{ls} \cos {\theta}_{ls}+{n}_{\left(l+1\right) s} \cos {\theta}_{\left(l+1\right)s}}\end{array} $$ (4)De complexe reflectieverhoudingen van de meerlaagse stapel kunnen dus worden verkregen door de partiële reflectie- en transmissiecoëfficiënten te vervangen door de N + 1 interface (Vgl. (4)) in Vgl. (1) en faseverschuivingen van alle N lagen (Vergelijking (3)):
$$ {R}_{s/p}={\left|{r}_{0,N+1}^{s/p}\right|}^2={\left|\frac{T_{21 }}{T_{11}}\right|}^2. $$IR-diëlektrisch functiemodel
Brekingsindex hangt af van de complexe diëlektrische functie ε (ω ), die kan worden geschreven als:
$$ \varepsilon \left(\omega \right)={\varepsilon}^{\mathrm{lat}}\left(\omega \right)+{\varepsilon}^{\mathrm{fc}}\left(\ omega \rechts). $$ (5)De eerste term komt overeen met de bijdrage van dispersie in de roostermodus en de tweede met de excitaties van vrije dragers.
De bijdrage van roostermodi aan de IR-respons ε lat (ω ) bij fonon energie ℏω kan worden beschreven met behulp van een gefactoriseerd model met Lorentziaanse verbreding [22]:
$$ {\varepsilon}^{\mathrm{lat}}\left(\omega \right)={\varepsilon}_{\infty} {\displaystyle \prod_{k=1}^M\frac{\omega_{ \mathrm{LO}k}^2-{\omega}^2-i\omega {\gamma}_{\mathrm{LO}k}}{\omega_{\mathrm{TO}k}^2-{\ omega}^2-i\omega {\gamma}_{\mathrm{TO}k}}}, $$ (6)waar M is het aantal infrarood-actieve polaire fonon-modi voor s - of p -polarisaties naar de c- as; ωLOk en ωTOk zijn de frequentie (cm −1 ) van de k- de LO en TO fonon; γLOk en γTOk zijn hun dempingsconstanten (cm −1 ). Voor GaN de parameters ωLOk en ωTOk account voor de E 1 (LO), A 1 (LO) en E 1 (TO), en A 1 (TO) vibratiestanden [23].
De bijdrage van de vrijdragende soort ε fc (ω ) naar de diëlektrische functie kan worden beschreven met behulp van klassieke Drude-benadering [15]:
$$ {\varepsilon}^{\mathrm{fc}}\left(\omega \right)=-{\varepsilon}_{\infty}\frac{\omega_p^2}{\omega \left(\omega + i{\gamma}_p\right)}, $$ (7)met
$$ {\omega}_p={\left(\frac{N{e}^2}{\varepsilon_{\infty }{\varepsilon}_0{m}^{\ast }}\right)}^{1 /2} $$ (8) $$ {\gamma}_p=\frac{e}{m^{\ast}\mu } $$ (9)De gescreende plasmafrequenties ω p (Vgl. (8)) hangt af van de vrije dragerconcentratie N , hoogfrequente diëlektrische permittiviteit ε ∞ , en de effectieve massa m ∗ van de gratis vervoerders (ε 0 is de vacuüm permittiviteit en e is de elektrische eenheidslading). De plasmondempingsparameter γ p hangt af van de mobiliteit van optische dragers μ (Vgl. (9)) [24].
Parameters van ωLO en LOPC-modi kunnen worden bepaald uit het denkbeeldige deel van de energieverliesfunctie—\( \mathrm{I}\mathrm{m}\left(-\frac{1}{\varepsilon \left(\omega \right)}\ rechts) \) [7], waarbij ε (ω ) is de complexe diëlektrische functie, verkregen uit Vgl. (5).
Resultaten en discussie
SEM-afbeelding (Fig. 2) toont de foto-geëtste dwarsdoorsnede van n + /n0 /n + -GaN-structuur gegroeid op GaN-buffer/GaN-sjabloon/saffiersubstraat, waar zes verschillende lagen duidelijk zichtbaar zijn, dit zijn vijf GaN-lagen met verschillende dragerconcentratie en saffiersubstraat. Opgemerkt moet worden dat de totale dikte van de onderzochte GaN-structuur zoals gemeten door SEM overeenkomt met de technologische, en waargenomen GaN-lagen volgens Fig. 1 kunnen voorlopig worden toegeschreven aan nominale Si-gedoteerde n + regio (laag 1), ongedoteerd n0 regio (laag 2), onderste Si-gedoteerde n + regio (laag 3), ongedoteerde GaN-buffer (laag 4) en GaN-sjabloon.
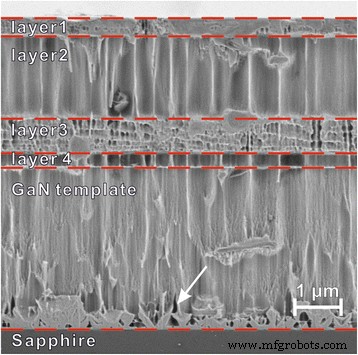
SEM-beeld van dwarsdoorsnede van de onderzochte n + /n0 /n + -GaN-structuur. Het onregelmatige patroon van verticale lijnen werd gevormd tijdens het splijten (d.w.z. vóór het foto-etsen) en is kenmerkend voor de niet-gepolijste splijtingen van Al2 O3 /GaN heterostructuren. Ruwe piramidale laag (pinholes ) bij de saffier/GaN-template aangegeven door de pijl werd onthuld door foto-etsen
Om een dieper inzicht te krijgen in het onzuiverheids-/dopingniveau van de onderzochte monsters, werden verder SIMS-metingen uitgevoerd. De verkregen SIMS-profielen (Fig. 3) zijn in goede correlatie met de nominale dikte van GaN-lagen en de totale dikte van de bestudeerde meerlaagse structuur. Alle onderzochte elementen (H, C, O, Si) waren boven de detectielimiet (3 tot 5 × 10 16 op/cm 3 ) van de SIMS-techniek.
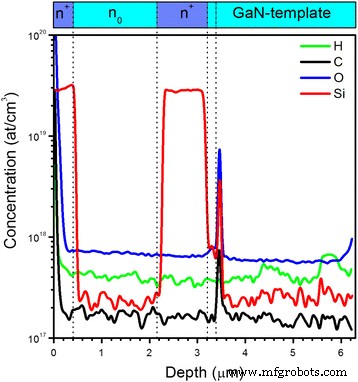
Profielen van onzuiverheidselementen van de onderzochte n + /n0 /n + -GaN-structuur gemeten door SIMS vanaf het monsteroppervlak
Profiel van opzettelijke Si-doping komt in het algemeen overeen met het nominale dopingprofiel met een concentratie van ongeveer 2,8 × 10 19 cm −3 in de gedoteerde boven- en onderkant n + regio's en van ongeveer 2,3 × 10 17 cm −3 in de ongedoteerde n0 regio. Zoals blijkt uit SIMS-gegevens, is er echter ook een dunne (<50 nm)-deltalaag met een Si-concentratie van 1,1 × 10 19 cm −3 tussen de GaN-buffer en de GaN-sjabloon. Opgemerkt moet worden dat de met Si gedoteerde deltalaag ook hogere concentraties van onbedoelde zuurstof- en koolstofverontreinigingen van 2,4 × 10 19 bevat. cm −3 en 1.4 × 10 18 cm −3 , overeenkomstig. Deze deltalaag is gerelateerd aan homo-epitaxiale hergroei-interface, die typisch voortkomt uit de GaN-template-verontreiniging met O-, Si- en C-onzuiverheden, geabsorbeerd uit de atmosfeer tijdens het technologische proces van laden of aan het begin van de hergroei [25, 26].
Zoals hierboven besproken, geven SEM-doorsnede en SIMS-analyse de structuur van GaN-lagen, die verschilt van de nominale parameters door excitatie van het extra GaN-gebied, maar met de totale dikte in overeenstemming met de nominale. Om de invloed van de hierboven gevonden extra GaN-deltalaag op het IR-reflectiespectrum van de onderzochte structuur te verduidelijken, werd de simulatie van het experimentele spectrum uitgevoerd door modellen te construeren bestaande uit zes lagen, die overeenkomen met nominale technologische parameters, SEM-afbeeldingen ( Fig. 1), en zeven lagen volgens SIMS. De berekende spectra op basis van de hierboven beschreven modellen worden gegeven in Fig. 4.

Simulaties van de IR-reflectiespectra met een verschillend aantal lagen. Het experimentele spectrum van de onderzochte n + /n0 /n + -GaN-structuur wordt weergegeven door ononderbroken lijn . een Regio Reststrahlen. b De vergrote spectra in het bereik boven 750 cm −1
Zoals te zien is in figuur 4, geeft het zevenlagenmodel op basis van het SIMS-profiel de beste benadering van het experimentele IR-reflectiespectrum. Er worden dus verdere simulaties en analyses uitgevoerd met behulp van dit model met gewijzigde parameters, in vergelijking met nominale technologische (Fig. 1), en die de extra laag tussen de technologische GaN-bufferlaag en GaN-sjabloon verklaart (Fig. 5).
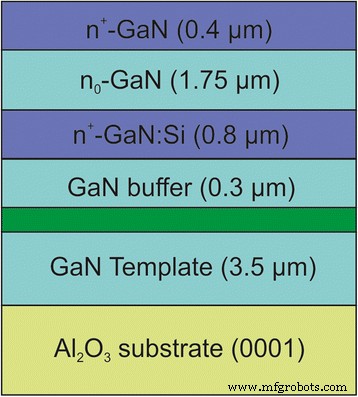
Het 7-lagenmodel dat werd gebruikt om de IR-reflectiespectra van de onderzochte n + te simuleren /n0 /n + -GaN-structuur. Een extra laag (groen ) is een dunne interfacelaag tussen GaN-sjabloon en de onderzochte GaN-lagen
Afbeelding 6 toont experimentele en aangepaste theoretische s -gepolariseerde reflectiespectra van de onderzochte structuur bij een invalshoek van 11°. Het berekende spectrum is gebaseerd op het hierboven beschreven model (Fig. 5). Dispersie van complexe brekingsindex voor de GaN-lagen en het saffiersubstraat werd bepaald met behulp van Vgl. (5). Het saffiersubstraat werd als semi-oneindig beschouwd, waardoor de interne reflecties in het substraat en van de niet-gepolijste achterkant konden worden verwaarloosd. De gecompliceerde structuur die wordt waargenomen in het reststrahlen-gebied van het spectrum is te wijten aan een combinatie van het overlappende GaN en Al2 O3 reststrahlen-banden samen met interferentie-effecten. Vergelijking van deze gegevens met de berekende spectra kan niet alleen informatie over de dikte van de verschillende lagen van de monsters opleveren, maar kan ook helpen om de gecompliceerde structuur van het reststrahlen-gebied te interpreteren in termen van de bijdragen van de verschillende materialen.

Experimenteel (ononderbroken lijn ) en best-fit berekend (streep-stippellijn ) IR-reflectiespectra van de n + /n0 /n + -GaN-structuur gegroeid op GaN-template/Al2 O3 . een Regio Reststrahlen. b Interferentiegebied
De bepaling van laagdiktes uit de vergelijking van de reflectiegegevens met het berekende spectrum is een proces in twee stappen [27]. Ten eerste de franjes in het transparante gebied boven de reststrahlen-banden (ω > 1200 cm −1 ) zijn het gevolg van interferentie-effecten op de lagen van de meerlaagse structuur. Op deze manier kan de totale dikte van de onderzochte structuur, die een som is van alle lagen, worden geschat.
Zodra de stapeldikte bekend is, kunnen de individuele diktes van elke laag worden bepaald door de berekende spectra aan te passen aan interferentie-effecten in het reststrahlen-gebied van het spectrum. Laagdiktes werden gevarieerd door rekening te houden met de eerder bepaalde totale dikte. Onder deze beperking is de reflectie boven 1200 cm −1 verandert niet wezenlijk. De interferentie-effecten in het reststrahlen-gebied kunnen worden onderscheiden van andere kenmerken zoals TO- en LO-vibratiemodi, gebaseerd op het feit dat de interferentieranden in positie verschuiven naarmate de laagdiktes worden gevarieerd [28].
Tijdens de benadering van het experimentele spectrum in het reststrahlen-gebied werden de volgende modelparameters gevarieerd:dempingsparameters γLO en γNAAR voor E 1 (LO) en E 1 (TO) fonon-modi; plasmafrequentie ω p ; plasmondempingsparameter γ p ; en laagdiktes. Opgemerkt moet worden dat alleen E 1 symmetrie fononen zijn IR actief in s -polarisatie [9]. Initiële frequenties van E 1 (LO) en E 1 (TO) fononen voor GaN en saffiersubstraat werden ontleend aan de experimenten met IR-reflectie [29] en Raman-verstrooiing [6, 14]. Typische waarden van de GaN-fononfrequentie zijn ωTO = 560 cm −1 en ωLO = 740 cm −1 . De fononfrequenties voor elke laag werden verfijnd tijdens het aanpasproces. Verkregen best-fit parameters met de foutbalken worden gegeven in Tabel 1. Opgemerkt moet worden dat de laagdiktes verkregen in het fittingproces goed in overeenstemming zijn met de SEM-gegevens.
Verwijzend naar Fig. 6a, de reflectiepiek bij ~450 cm −1 kan worden toegeschreven aan het saffiersubstraat. De kenmerken die zijn waargenomen in het bereik van 500–740 cm −1 zijn te wijten aan een combinatie van overlappende kenmerken van GaN-lagen en saffierreststrahlen-banden. Voor de diepere analyse werden de IR-reflectiespectra van bulk GaN en 6,78 μm dikke GaN-laag op saffier, waarbij de dikte van GaN overeenkomt met de totale dikte van de onderzochte structuur, gesimuleerd in het reststrahlen-bandgebied (Fig. 7) . Zoals te zien is in figuur 7, liggen de reflectiespectra van de 6,78-dikke GaN-laag op saffier en bulk-GaN in het bereik van 500-740 cm −1 zijn vergelijkbaar met het experimentele spectrum. Het kleine kenmerk van ~511 cm −1 wordt geassocieerd met het saffiersubstraat. Er moet worden vermeld dat bij ~736 cm −1 , is er een zwakke dip die overeenkomt met A 1 (LO) modus van GaN-sjabloon. Volgens de selectieregels, A 1 (LO) modus is verboden in s -gepolariseerde IR-spectra [9]. De mogelijke reden voor de registratie van deze verboden modus kan een polarisatielekkage zijn vanwege de opening van het reflectieaccessoire en micro-inhomogeniteiten van de GaN-kristalstructuur. Dit kan met name worden veroorzaakt door de helling van de c -as van de kolomachtige wurtzietstructuur van GaN vanuit de richting loodrecht op het groeivlak van de film. Met deze modus werd geen rekening gehouden in onze modellering vanwege de zwakke impact op het resulterende spectrum. De functies in het bereik van 750-1200 cm −1 zijn te wijten aan overlappende GaN:Si- en saffierreststrahlen-banden en interface-effecten. De daling bij ~775 cm −1 is gerelateerd aan het interface-effect op de rand van de reststrahlen-band van GaN-lagen en saffier. De brede duik bij ~825 cm −1 wordt geassocieerd met overlapping van de hoogfrequente tak van de plasmon-LO-phonon-gekoppelde modus (LPP + ) van de n + lagen.
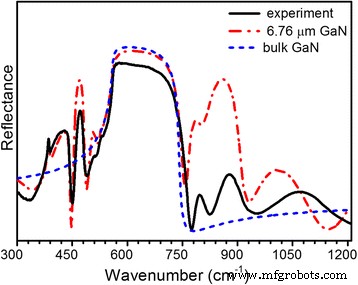
Experimenteel (ononderbroken lijn ) IR-reflectiespectra van de onderzochte n + /n0 /n + -GaN-structuur en berekende reflectiespectra van 6,78 m dikke GaN-laag op saffier (stippellijn ) en bulk GaN (streeplijn )
Figuur 8 toont de berekende imaginaire delen van de energieverliesfunctie voor elke laag volgens de oscillatorparameters in Tabel 1 voor schatting van E 1 -LOPC-modi. Zoals te zien is, is de hoogfrequente tak van de LOPC-modi (LPP + ) bij dragerconcentraties lager dan 10 17 cm −3 (n0 laag en sjabloon) vallen bijna samen met E 1 (LO) fonon-modus. De toename van de dragerconcentratie in het bereik van 2 × 10 17 –3 × 10 18 cm −3 (Fig. 5) leidt tot een significante hoogfrequente verschuiving en verbreding van de LPP + tak, die de toename in interactie tussen LO fonon en plasmon en de afname in mobiliteit van ladingsdragers aangeeft. Dit gedrag van LPP + branch komt goed overeen met de experimentele gegevens over IR-reflectie van Si-gedoteerde GaN-films gekweekt op saffier door Z.F. Li et al. [30], en Raman-meting in bulk GaN [10] en epitaxiale lagen [31]. Opgemerkt moet worden dat de laagfrequente LPP − tak van de LOPC kan in ons geval niet betrouwbaar worden gedefinieerd, zoals s -gepolariseerde IR-reflectiespectra werden niet gemeten in een laagfrequent bereik onder 300 cm −1 .

Berekend denkbeeldig deel van de diëlektrische functie verkregen voor elke geanalyseerde GaN-laag uit de best passende gegevensanalyse
Waarden van dragerconcentratie en mobiliteit vermeld in tabel 2 werden berekend met behulp van vergelijkingen. (8) en (9) met effectieve elektronenmassa m* van 0,2 m0 [32]. Het is te zien dat het berekende dragerconcentratieprofiel vergelijkbaar is met het Si-onzuiverheidsconcentratieprofiel verkregen door SIMS-metingen (Fig. 3), maar met de orde van grootte lagere dragerconcentraties in vergelijking met de concentratie Si-onzuiverheid. Een dergelijke discrepantie in concentraties van dragers en dopingonzuiverheden werd eerder waargenomen door M. Bockowski et al. [33], en was gerelateerd aan compensatie-effecten door acceptortoestanden (waarschijnlijk door galliumvacatures), waarvan de vormingsenergie afneemt met toenemende n-type doping [34]. Er moet worden vermeld dat de dragerconcentratie voor de n + lagen in de orde van ~10 18 cm −3 komt goed overeen met de resultaten van onze Raman-onderzoeken van vergelijkbare GaN-structuren op basis van analyse van LOPC-modi [6]. De verkregen afname van dragermobiliteit μ met dragerconcentratie komt ook goed overeen met Hall-experimenten in GaN [35] en theoretische modellering [36].
De waarden van hoogfrequente diëlektrische permittiviteit ε∞ bleken in het bereik van 4,99-5,35 te liggen (tabel 1). De toename van ε∞ voor de gedoteerde n + lagen in vergelijking met n0 lagen kunnen worden gerelateerd aan de roodverschuiving van de α-GaN-bandgap [37]. Opgemerkt moet worden dat waarden van ε∞ kan alleen met een relatief kleine fout worden bepaald voor laaggeleidende films. Nauwkeurigheid bij het bepalen van ε∞ afnemen met de concentratie van de drager, wat verband houdt met het feit dat de ε∞ parameter is verantwoordelijk voor "de hoogfrequente" limiet wanneer de diëlektrische modelfunctie wordt geëxtrapoleerd naar kortere golfgetallen dan de hier bestudeerde [11]. Het brede spectrale bereik van 300–4000 cm −1 werd geanalyseerd om de fout in de bepaling van ε∞ . te verminderen en andere parameters die betrokken zijn bij het modelleren van de IR-reflectiespectra van n + lagen.
Conclusies
IR-reflectiespectra van de meerlaagse structuur bestaande uit GaN-lagen gegroeid op een saffiersubstraat en gedoteerd met verschillende concentraties Si-onzuiverheid werden gemeten en in detail geanalyseerd. Analyse van de onderzochte structuur door SEM van foto-geëtste dwarsdoorsnede toonde een goede correlatie met de technologische parameters van de GaN-lagen. SIMS-analyse onthulde ook de aanwezigheid van een dunne deltalaag nabij de GaN-buffer / GaN-sjabloon-interface met een hoger gehalte aan Si- en O-onzuiverheden, wat gerelateerd is aan homo-epitaxiale hergroei-interface. Modellering van het IR-reflectiespectrum van de bestudeerde meerlaagse structuur door de extra laag in de analyse op te nemen, maakte het mogelijk om de beste aanpassing van het experimentele spectrum te verkrijgen. De verkregen dikten van GaN-lagen komen goed overeen met de SEM- en SIMS-gegevens. Berekend op basis van de spectrale afhankelijkheid van diëlektrische permittiviteit LOPC-modi voor elke GaN-laag vertoonden hoogfrequente verschuiving en verbreding van LPP + vertakking met de toename van de dragerconcentratie. Concentratie en mobiliteit van ladingsdrager voor elke GaN-laag werden berekend uit de plasmonfrequentie en dempingsparameter. Obtained carrier concentration profile is similar to those obtained by SIMS, but with values of carrier concentration one order of magnitude less than the concentration of Si doping impurity, which can be attributed to compensation effects by the defect acceptor states. Thus, it is demonstrated that IR reflectance spectroscopy and 2 × 2 transfer matrix method can be successfully used for analysis of epitaxial multilayer GaN structures with non-uniform doping profiles, and allow for the determination of the fundamental electron and phonon parameters of each GaN layer.
Change history
Afkortingen
- IR:
-
Infrared
- FTIR:
-
Fourier transform infrared spectroscopy
- SEM:
-
Scanning electron microscopy
- SIMS:
-
Secondary ion mass spectrometry
- LOPC:
-
Longitudinal optical phonon– plasmon coupled
Nanomaterialen
- Structuur en elektronische eigenschappen van met overgangsmetaal gedoteerde kaoliniet nanoklei
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- Nieuwe nanocomposieten van polystyreen met polyaniline gedoteerd met laurylzwavelzuur
- Temperatuurafhankelijkheid van bandgap in MoSe2 gegroeid door moleculaire bundelepitaxie
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- Endotheelcellen targeten met multifunctionele GaN/Fe-nanodeeltjes
- Raman Mapping-analyse van grafeen-geïntegreerde silicium-microringresonatoren
- Optimale siliciumdoteringslagen van kwantumbarrières in de groeireeks die een zacht opsluitingspotentieel vormen van acht-periode In0.2Ga0.8N/GaN Quantum Wells of Blue LED's
- Structuurverschuiving van GaN tussen Nanowall-netwerk, Nanocolumn en Compact Film Grown on Si (111) door MBE
- Het groeimechanisme van GaN epitaxiale lagen op mechanisch geëxfolieerd grafiet begrijpen
- Analyse van Bi-distributie in epitaxiale GaAsBi door aberratie-gecorrigeerde HAADF-STEM



