Testpatroonontwerp voor plasma-geïnduceerde schade aan intermetaaldiëlektricum in FinFET Cu BEOL-processen
Abstract
High-density interconnects, mogelijk gemaakt door geavanceerde CMOS Cu BEOL-technologieën, leiden tot dicht op elkaar geplaatste metaallagen. Metalen lijnen met een hoge aspectverhouding vereisen uitgebreide plasma-etsprocessen, wat betrouwbaarheidsproblemen kan veroorzaken op intermetalen diëlektrische (IMD) lagen. Deze studie presenteert nieuw voorgestelde testpatronen voor het evalueren van het effect van plasma-geïnduceerd oplaadeffect op de integriteit van IMD tussen dicht bij elkaar geplaatste metalen lijnen. Er worden sterke correlaties gevonden tussen de oplaadintensiteiten van het plasma en de schade die wordt gevonden in IMD-lagen en deze worden uitgebreid geanalyseerd.
Inleiding
Op Cu-gebaseerde back-end of line (BEOL)-processen zijn op grote schaal gebruikt bij het migreren van technologieën naar een regime van minder dan 100 nm. Strakke onderlinge verbindingen bestaan uit via's met een hoge aspectverhouding en metalen lijnen worden mogelijk gemaakt door een reeks plasma-verbeterde etsprocessen [1,2,3]. Het is algemeen bekend dat hoogenergetische plasmabehandelingen kunnen leiden tot aanzienlijke degradatie en latente schade aan de gate-diëlektrische stapels van transistors, waarvan wordt aangenomen dat ze het belangrijkste ontladingspad zijn tijdens procesgeïnduceerde laadgebeurtenissen. Om betrouwbaarheidsproblemen met betrekking tot de diëlektrische kwaliteit van de poort te voorkomen, bieden IC-fabrikanten doorgaans ontwerpregels en richtlijnen die de grootte en lengte van de metalen tussenlagen beperken [4, 5]. Met een groter aantal metaallagen in de complexe bedradingssystemen, is het moeilijk om het ontladingspad door de diëlektrische film tussen metalen te vermijden tijdens procesgeïnduceerd opladen. Met de introductie van low-k-materiaal in BEOL-processen [6, 7], verlicht verergering van RC-vertragingsproblemen, kunnen de isolatiefilms gevoeliger zijn voor laadspanningen [8, 9]. De schade als gevolg van door plasma-oplading veroorzaakte spanningen op compacte verbindingsstructuren die verantwoordelijk zijn voor het realiseren van de ingewikkelde BEOL-bedrading, kan een grote invloed hebben op de opbrengst en betrouwbaarheid van geavanceerde CMOS-IC's. In deze studie nemen we eerder gerapporteerde in situ PID-recorders [10,11,12] op, met nieuw voorgestelde differentiële testpatronen voor het bewaken van de mogelijke IMD-schade wanneer extra ontladingspad mogelijk wordt onder geavanceerde Cu BEOL-processen. De plasma-oplaadniveaus die de recorder op verschillende locaties over de wafer meldde, kunnen via de nieuwe testpatronen worden gecorreleerd met plasma-oplaadschade op IMD-films. Door stress veroorzaakt faalgedrag op de IMD-structuren kan dan gemakkelijk worden onthuld door middel van deze testpatronen die kunnen worden gebruikt in de standaard teststructuur voor routinematige monitoring van nieuwe faalwijzen en mogelijke IMD-betrouwbaarheidsproblemen.
Apparaatstructuur en -methodologie
Resultaten van faalanalyses op FinFET-geïntegreerde circuits suggereren dat latente schade van toenemende valtoestanden binnen inter-metalen diëlektrische lagen tussen twee dicht bij elkaar geplaatste geïsoleerde verbindingsstructuren kan optreden, zoals geïllustreerd in Fig. 1. Aangezien de lijnbreedte en afstand tussen via en metalen verbindingen vooraf agressief verminderen CMOS BEOL-processen, ladingen verzameld op grote metalen draden, dienen als antennes, kunnen via IMD ontladen over metalen en vias/gates en metaaldraden, wat resulteert in hoge veld- en/of hoge stroomspanningen op deze diëlektrische films. Door de in-situ PID-recorder [10,11,12] naast de twee differentiële testpatronen op elke chip te plaatsen, kunnen eerst de referentieplasmalaadniveaus over een 12-inch wafer worden vastgesteld.
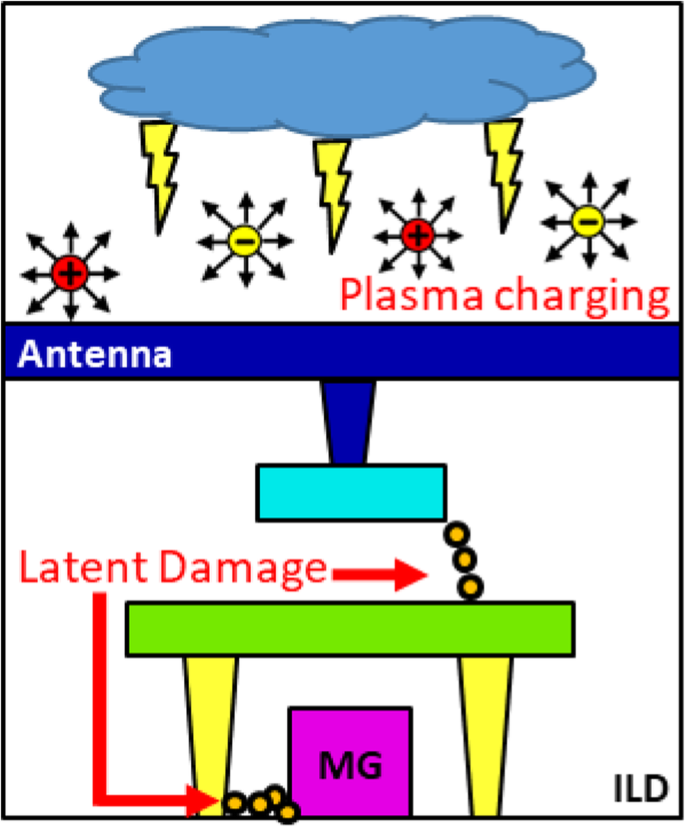
Plasma-geïnduceerde schade in intermetalen diëlektrische lagen tussen dicht opeengepakte verbindingspatronen kan verband houden met latente degradatie van de isolatie-integriteit ervan
Om ervoor te zorgen dat de plasmalaadstroom die door de diëlektrische laag tussen metaallagen gaat, het M2-knooppunt op het testpatroon in Fig. 2 wordt geïsoleerd voordat de antennestructuur wordt gemaakt. Twee nieuwe differentiële testpatroonontwerpen gericht op het vergroten van de mogelijkheid om de latente schade tijdens plasma-oplaadspanningen te veroorzaken, worden voorgesteld en geïllustreerd in Fig. 2a, b. Het apparaat met type I-patroon zal alleen hoge stroombelasting ervaren wanneer elektronen worden verzameld op de bijbehorende antenne. Dit komt omdat de ontlaadstroom wordt gelijkgericht door de n+/p-overgang in serie op het geleidende pad. Terwijl het apparaat met type II-patroon wordt blootgesteld aan spanningen I in beide richtingen [13]. Op deze bewakingsinrichting worden namelijk zowel ionenlading als elektronenlading geregistreerd. Bijgevolg zijn de monsters in deze studie gemaakt door het standaard FinFET/Cu BEOL-proces in een 16 nm-technologieknooppunt. De antennestructuren op een PID-recorder en de apparaten met type I- en II-patronen op elke die zijn allemaal ontworpen met een grote metalen 3-structuur. Beide soorten bewakingsapparatuur zijn ontworpen met een differentiële configuratie, die de ruis door verkeerde uitlijning kan accentueren en vervolgens kan minimaliseren, wat kan leiden tot foutlezingen van de PID-effecten.
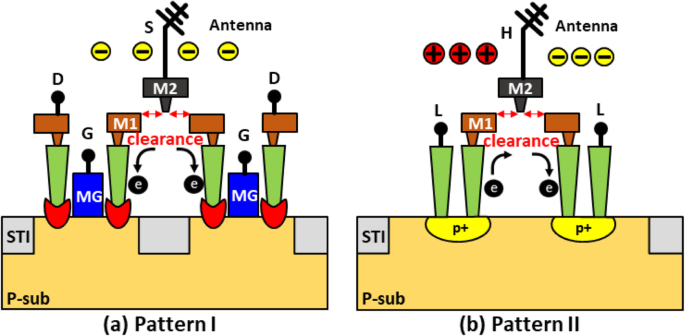
Illustraties van nieuw voorgestelde differentiële testpatronen die zijn ontworpen om het effect van latente schade veroorzaakt door plasma-geïnduceerde a te accentueren negatief en b bidirectionele spanningen, waarbij de speling tussen de metaallaag moet worden ingesteld op 14 nm
Experimentele resultaten en discussie
Gegevens in Fig. 3 worden verkregen door een spanningszwaai toe te passen op metaal 2 van 0-20 V met een zwaaisnelheid van 0,7 V / sec, terwijl de doorslagspanning en IMD-lekstroom aan weerszijden van een paar verschillende apparaten met testpatroon Ik kan dan worden opgehaald en vergeleken. Tijdens het maken van de grote M3-antenne van 82.000 μm 2 , wordt verwacht dat het plasmaproces het opladen van de antenne zal veroorzaken. De geaccumuleerde lading zal naar verwachting ontladen via het pad met de laagste weerstand. Uit gegevens blijkt dat sommige monsters een vroege diëlektrische doorslag vertonen, terwijl IMD op andere apparaten relatief intact blijft met weinig lekkage.
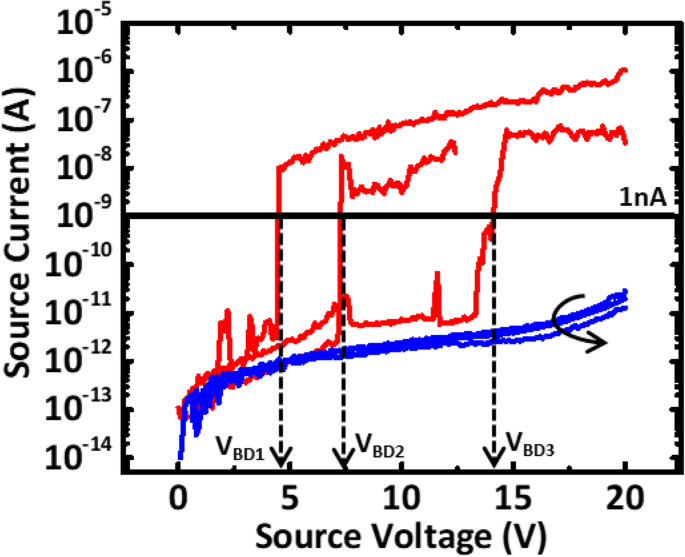
Lekstroom gemeten op apparaten met differentiële testpatronen aangesloten op metal-3 antenne van 82.000 μm 2 . V BD wordt gedefinieerd als de spanning als de stroom 1 nA bereikt voor een via-lengte van 32 nm
In een laadgebeurtenis wordt verwacht dat de zwakkere kant het dominante ontlaadpad zal dienen, wat leidt tot een meer prominente onbalans in het schadeniveau tussen links en rechts. Vandaar dat alleen de apparaten met grote V BD verschil tussen de linker- en rechterkant is waarschijnlijker het gevolg van plasma-oplading. Vandaar dat de kleinere V BD in IMD wordt de uitsplitsing van een paar geregistreerd als het niveau dat gecorreleerd is met het PID-stressniveau. Figuur 4a toont drie typische soorten kenmerken die worden gevonden op monsters op verschillende matrijzen over een wafer. Deze steekproeven kunnen worden gecategoriseerd als geen uitsplitsing aan beide zijden, eenzijdige uitsplitsing of tweezijdige uitsplitsingsgroepen. Het gedeelte van de apparaten dat de specifieke kenmerken van elke groep laat zien, wordt getoond in het cirkeldiagram van figuur 4b. We ontdekten dat op monsters zonder antenne een veel lagere kans op eenzijdige doorslagkarakteristieken heeft. Symmetrisch gedrag aan beide kanten is te vinden in de meeste apparaten die geen last hebben van plasma-oplaadstress. Deze suggereren verder dat de meeste asymmetrische kenmerken in een differentieel paar het gevolg zijn van laadspanningen wanneer de antennestructuur is bevestigd.
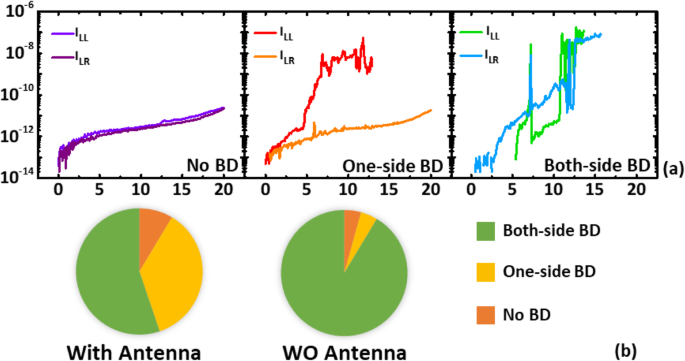
een Verschillende soorten doorslagkenmerken op de testparen over een wafer en b het vergelijken van het percentage monsters dat onderscheidende soorten storingskenmerken vertoont op apparaatparen van meer dan 60 matrijzen
De V . gebruiken BD verkregen met de bovenstaande methode, de waferkaarten van het PID-niveau en V BD van apparaten van type I en II patronen worden vergeleken in Fig. 5. Grote overeenkomst tussen waferkaarten van de V BD van beide type bewakingsapparatuur en de bijbehorende referentielaadniveaus worden verkregen uit de PID-recorder, zie Fig. 5a. Er wordt aangenomen dat PID-spanning zowel elektronen- als ionenoplaadgebeurtenissen registreert tijdens metaalprocessen [14]. Monsters over een wafer blijken echter voornamelijk onderhevig te zijn aan meer elektronenoplading dan ionenoplading [14]. We zijn van mening dat er wat regionaal gecorreleerd kan worden gezien tussen de wafer in Fig. 5a, b. Terwijl de wafelkaart in figuur 5c van patroon II, die geen duidelijke overeenkomst vertoont met die in figuur 5a, suggereert dat bidirectionele spanning [15] zou kunnen leiden tot een secundair effect op de diëlektrische lagen, die verder onderzoek behoeven. Gemeten doorslagspanningen van de nieuwe testpatronen versus de referentie-PID-niveaus vergeleken in Fig. 6 laten verder zien dat hoe hoger het PID-niveau op een dobbelsteen, hoe lager de V BD de nieuwe testpatronen. Bovendien zijn er significante negatieve correlaties tussen V BD en plasma-oplaadniveaus kunnen worden vastgesteld. Om het effect van eenrichtings- en bidirectionele spanningen op IMD-schade te onderzoeken, V BD gemeten van ontworpen met type I en type II patronen is samengevat en vergeleken in Fig. 7. De V BD distributie verkregen van apparaten op 60 matrijzen over wafers geeft aan dat de apparaten die bidirectionele laadspanningen ervaren, meer kans hebben om IMD-doorslag te vertonen bij een lagere spanning. Dit kan worden verklaard door het asymmetrische spanningsniveau als polariteit verandert over een IMD [16]. Bovendien is de spanningsgeïnduceerde lekstroom (SILC) gemeten met 10 V over de diëlektrische laag een andere indicator voor de toename van valtoestanden [17] in de IMD-film. Om het door procesvariatie veroorzaakte matrijs-tot-matrijs-variatie-effect verder te minimaliseren, wordt de lekkageverhouding van elk paar gebruikt als de index om de IMD-schade verder te evalueren. Figuur 8 toonde aan dat er in wezen geen correlatie is tussen de lekstroomverhouding op de twee soorten apparaten op dezelfde chip. Dat wil zeggen dat een verkeerde uitlijning tussen metaal 1 en via2 lagen minimale effecten heeft op beide patronen. Merkte op dat de huidige verhouding, R , gedefinieerd als I LR /Ik LL , is een betere index om ruis van die-to-die-variatie op deze patronen te verwijderen. Op volledig onpartijdige apparaten vindt de belangrijkste laadspanning rechts of links plaats, die volledig willekeurig zou moeten zijn. Hier worden enkele bias-effecten gevonden op de stroomverhoudingen, waar het distributiemedium niet op 1 staat. Om ervoor te zorgen dat alleen de schade die het gevolg is van de plasma-oplaadeffecten wordt verklaard, R is de genormaliseerde stroomverhouding, zoals beschreven in Fig. 9. In de distributieplot over het wafercentrum, R N van apparaten van type I volgt het patroon met het plasmastressniveau van PID-recorders redelijk dichtbij. Aan de andere kant, R N van apparaten die gevoelig zijn voor bidirectionele stress, kan niet volledig worden verklaard door de geregistreerde PID-niveaus. Dit kan worden veroorzaakt door een aanzienlijk hogere R N niveau in apparaten van patroon II, als gevolg van oplading van ionen over de wafer.

Schema's en de wafelkaarten die de distributies tonen van (a ) de PID-spanning en VBD van (b ) testpatroon I en (c ) II, die het regionale effect toont binnen het omcirkelde gebied van plasma-geïnduceerde schade op de back-end diëlektrische laag die kan worden toegeschreven aan de regionale plasma-oplaadniveaus
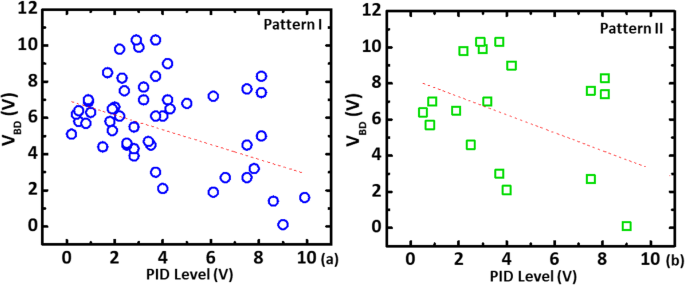
Correlaties tussen VBD van PID-niveaus voor a patroon I en b patroon II monsters, respectievelijk [10,11,12]
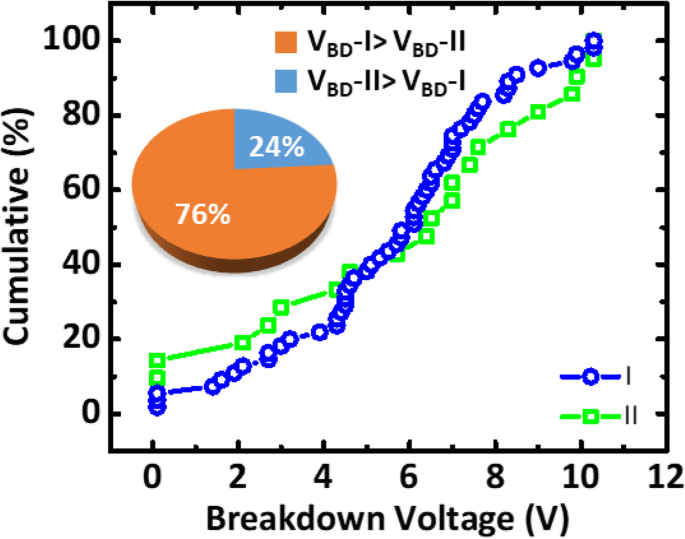
Vergelijking van cumulatieve verdeling van V BD van 60 dies over de wafer en het deel van de monsters dat hogere doorslagspanningen vertoont van patroon I versus dat van patroon II

Lekstroomverhouding van linker- en rechterkant van patroon I en II, waaruit blijkt dat deze monsters geen systematische verkeerde uitlijning hebben
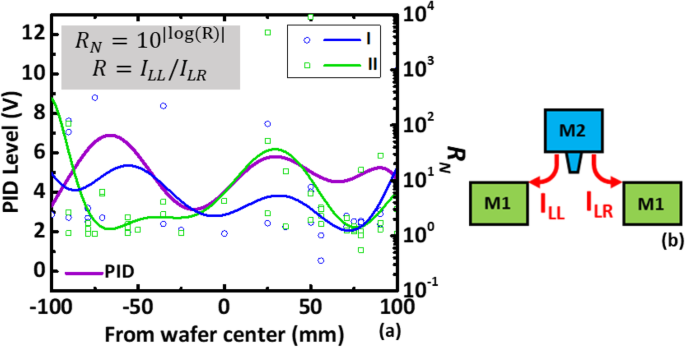
een Genormaliseerde stroomverhoudingen van patroon I- en II-monsters over het wafercentrum in vergelijking met de overeenkomstige PID-niveaus en b de definitie van lekstroom aan de linkerkant (I LL ) en rechts (I LR )
Conclusies
Het door plasma geïnduceerde oplaadeffect op de integriteit van IMD-films wordt onderzocht door middel van nieuw voorgestelde differentiële testpatronen op geavanceerde FinFET Cu BEOL-platforms. Schade in de vorm van vroegtijdige afbraak en toename van SILC in IMD-lagen blijkt direct gecorreleerd te zijn met de plasma-oplaadniveaus over 12-inch wafers.
Beschikbaarheid van gegevens en materialen
Niet van toepassing.
Nanomaterialen
- Een inleiding tot metaalfabricage
- 6 belangrijke ontwerpoverwegingen voor 3D-metaalprinten
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Richtlijnen voor ontwerp voor produceerbaarheid - deel 1
- 5 tips voor het ontwerpen van plaatwerk
- 6 tips om uw ontwerp te optimaliseren voor een metaalproductieproject
- Wat is metaalidentificatie? - Tests en tips om te identificeren?
- Hoe ontwerpen voor metaalproductieprojecten te optimaliseren
- Overwegingen bij impedantie-ontwerp voor flexibele printplaten
- Ontwerptips voor het buigen van plaatwerk
- Ontwerptips voor Direct Metal Laser Sintering 3D Printing



