Geheugenvenster en uithoudingsvermogenverbetering van op Hf0.5Zr0.5O2-gebaseerde FeFET's met ZrO2-zaadlagen gekenmerkt door snelle spanningspulsmetingen
Abstract
De HfO2 -gebaseerde ferro-elektrische veldeffecttransistor (FeFET) met een metaal/ferro-elektrische/isolator/halfgeleider (MFIS) gate-stack wordt momenteel beschouwd als een mogelijke kandidaat voor een niet-vluchtig geheugen met hoge dichtheid en hoge schrijfsnelheid. Hoewel de retentieprestaties van de HfO2 -gebaseerde FeFET met een MFIS gate-stack zou kunnen voldoen aan de eisen voor praktische toepassingen, het geheugenvenster (MW) en de betrouwbaarheid met betrekking tot uithoudingsvermogen moeten verder worden verbeterd. Dit werk onderzoekt het voordeel van het gebruik van ZrO2 zaadlagen op de MW, retentie en uithoudingsvermogen van de Hf0,5 Zr0,5 O2 (HZO) gebaseerde FeFET's met MFIS-poortstapels, door gebruik te maken van snelle spanningspulsmetingen. Het blijkt dat de op HZO gebaseerde FeFET met een ZrO2 zaadlaag vertoont een grotere initiële en 10 jaar geëxtrapoleerde MW, evenals verbeterde uithoudingsprestaties vergeleken met de op HZO gebaseerde FeFET zonder de ZrO2 zaad laag. De resultaten geven aan dat het gebruik van een directe kristallijne poortstapel met hoge k/Si het MW en de betrouwbaarheid van de HfO2 verder zou verbeteren. -gebaseerde FeFET's.
Achtergrond
HfO2 -gebaseerde ferro-elektrische dunne films worden beschouwd als veelbelovende gate-stack-materialen voor ferro-elektrische veldeffecttransistoren (FeFET's) vanwege hun complementaire metaaloxide-halfgeleider (CMOS) compatibiliteit en schaalbaarheid. Van de verschillende soorten gate-stackstructuren die kunnen worden gebruikt in FeFET's, vertegenwoordigt een metaal / ferro-elektrisch / isolator / halfgeleider (MFIS) een meer praktische configuratie omdat het de huidige MOS-apparaatarchitecturen volgt en goed past bij de moderne high-k metal-gate (HKMG) processen. Daarom zijn er grote inspanningen geleverd om FeFET's met MFIS-gate-stackstructuren te ontwerpen en te fabriceren voor toepassingen in ingebedde niet-vluchtige geheugens, veldeffecttransistoren met negatieve capaciteit, kunstmatige neuronen, synapsen en logic-in-memory-apparaten [1,2,3,4 ,5,6,7,8].
Tot nu toe zijn FeFET's met hoge dichtheid en hoge schrijfsnelheid met MFIS-gate-stackstructuren met succes gefabriceerd met behulp van HKMG-processen [9, 10]. Naast de hoge integratiedichtheid en hoge schrijfsnelheid, zijn een groot geheugenvenster (MW) en een hoge betrouwbaarheid met betrekking tot retentie en uithoudingsvermogen ook van cruciaal belang voor het gebruik van FeFET's voor niet-vluchtige geheugentoepassingen [11,12,13,14]. Vanwege een grote bandoffset naar silicium, een hoog coërcitief veld en een matige diëlektrische constante van de HfO2 -gebaseerde ferro-elektrische dunne films, HfO2 -gebaseerde FeFET's met MFIS-poortstapelstructuren vertonen betrouwbare retentie-eigenschappen (10 jaar extrapolatie) [15,16,17]. Hoewel de HfO2 -gebaseerde dunne films vertonen een gemiddeld uithoudingsvermogen van meer dan 1 × 10 9 schakelcycli [14, 18], HfO2 -gebaseerde FeFET's met MFIS-poortstapelstructuren hebben een vrij beperkt uithoudingsvermogen, variërend van 1 × 10 4 tot 1 × 10 7 schakelcycli [17, 19,20,21,22,23]. Theoretisch wordt verwacht dat het gebruik van isolatorlagen met hoge k het elektrische veld in de MFIS-poortstapel zal verminderen, wat de bandbuiging zou verminderen, waardoor de duurzaamheidseigenschappen en de MW's van de HfO2 verbeteren. -gebaseerde FeFET's [12, 14]. Experimenteel, Ali et al. geverifieerd dat het verhogen van de k-waarde van de ultradunne isolatorlaag (d.w.z. met behulp van SiON in plaats van SiO2 ) kan zowel de duurzaamheidseigenschappen als het MW van de HfO2 . effectief verbeteren -gebaseerde FeFET's [13]. In ons eerdere onderzoek [24] meldden we dat de insertie van een kristallijn ZrO2 hoge-k-laag in de MFIS-poortstapels zou de kristallijne kwaliteit kunnen verbeteren en de vorming van monokliene fase in Hf0,5 kunnen onderdrukken Zr0,5 O2 (HZO) dunne films, wat leidt tot een groot MW van 2,8 V, gekenmerkt door de DC-spanningszwaaimethode.
In dit werk rapporteren we over de karakterisering van de MW's, retentie en uithoudingsvermogen van de op HZO gebaseerde FeFET's met en zonder kristallijn ZrO2 zaadlagen door gebruik te maken van snelle positieve en negatieve spanningspulsmetingen. Bovendien is het voordeel van het gebruik van kristallijn ZrO2 zaadlagen op MW en uithoudingsvermogen komen aan bod.
Methoden
De n-kanaals FeFET's met en zonder ZrO2 zaadlagen werden gefabriceerd met behulp van een gate-last-proces, zoals beschreven in [24]. De ZrO2 zaadlaag en de HZO-laag werden beide gekweekt bij een groeitemperatuur van 300 o C door atomaire laagafzetting (ALD). Het schema van de gefabriceerde FeFET's wordt getoond in Fig. 1a, waarvan de kanaalbreedte (W ) en lengte (L ) waren respectievelijk 80 en 7 m. Ondertussen, TaN/HZO/TaN en TaN/HZO/ZrO2 /TaN-condensatoren werden ook gefabriceerd om de ferro-elektrische eigenschappen van de HZO-dunne films te evalueren. De polarisatie–spanning (P–V ) hysteresislussen van de condensatoren werden gemeten met behulp van een Radiant Technologies RT66A ferro-elektrisch testsysteem, terwijl de apparaatkenmerken van FeFET's werden gemeten door een Agilent B1500A halfgeleiderapparaatanalysator met een pulsgeneratoreenheid (B1525A) [20]. Twee hoofdtestsequenties die worden gebruikt voor MW- en uithoudingsmetingen worden getoond in Fig. 1b en c. Voor MW- en retentiemetingen werden eerst program/erase (P/E) pulsen toegepast op de poorten van FeFET's, en leesbewerkingen werden uitgevoerd op verschillende tijdsintervallen met behulp van I D –V G sweep (V D = 0.1 V) om V . te voelen TH . Over het algemeen V TH wordt bepaald als een poortspanning die overeenkomt met een afvoerstroom van 10 −7 A∙W/L [25], en de MW wordt gedefinieerd als het verschil van V TH waarden tussen geprogrammeerde en gewiste toestanden. Voor uithoudingsmetingen werd het MW gemeten na een bepaald aantal afwisselende P/E-pulsen.

een Schema van de gefabriceerde FeFET's. De extra kristallijne ZrO2 zaadlaag wordt gemarkeerd door zwarte rasterlijnen. b , c Testsequenties gebruikt voor MW- en duurmetingen
Resultaten en discussie
Figuur 2a toont de P–V hysteresislussen van de TaN/HZO/TaN en TaN/HZO/ZrO2 /TaN-condensatoren. Opmerkelijk is dat de TaN/HZO/ZrO2 /TaN-condensator heeft zelfs betere ferro-elektrische eigenschappen dan de TaN/HZO/TaN-condensator, wat consistent is met de gerapporteerde resultaten [26], wat aangeeft dat de kristallijne ZrO2 zaadlaag zou inderdaad de kristallijne kwaliteit kunnen verbeteren en de vorming van monokliene fase in HZO-dunne films kunnen onderdrukken [24]. Afbeelding 2b toont de I D –V G krommen van de op HZO gebaseerde FeFET's met en zonder extra kristallijn ZrO2 zaadlagen na P/E-pulsen. De rode symboollijnen vertegenwoordigen de I D –V G curven na het toepassen van een programmapuls van 7 V/100 ns, terwijl de blauwe symboollijnen de I vertegenwoordigen D –V G curven na het toepassen van een wispuls van − 7 V/100 n. Men kan zien dat de I D –V G curven van beide FeFET's vertonen schakelkarakteristieken tegen de klok in, wat suggereert dat de MW's van de huidige FeFET's afkomstig zijn van de polarisatieomschakeling van de HZO-lagen, in plaats van de ladingsvangst en injectie. Niettemin is de op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag vertoont een verbeterde MW van 1,4 V, ongeveer 1,8 keer groter dan die (0,8 V) van de op HZO gebaseerde FeFET zonder de extra kristallijne ZrO2 zaad laag. Bovendien is het verkregen MW van 1,4 V vergelijkbaar met de beste tot nu toe gerapporteerde resultaten [9, 11, 14, 17, 21,22,23, 27].
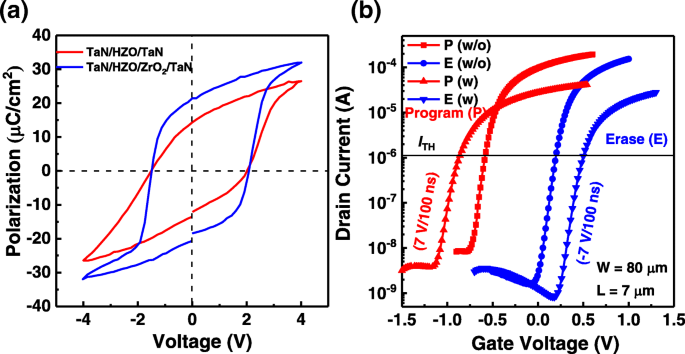
een P–V hysteresislussen van TaN/HZO/TaN en TaN/HZO/ZrO2 /TaN MFM-structuren gemeten bij 4 V en een frequentie van 5 kHz. b Ik D –V G curven van op HZO gebaseerde FeFET's met (w) en zonder (w/o) ZrO2 zaadlagen na een programmeerpuls (+ 7 V/100 ns) en een wispuls (− 7 V/100 ns)
Betrouwbaarheid met betrekking tot het behoud van de op HZO gebaseerde FeFET's met en zonder extra kristallijn ZrO2 zaadlagen werden ook geëvalueerd. Afbeelding 3 toont de V TH retentiekarakteristieken na het toepassen van een programmapuls van 7 V/100 ns en een wispuls van – 7 V/100 ns bij kamertemperatuur. Het is duidelijk dat de V TH waarden zijn ongeveer lineair met de logaritmische tijdschaal. De geëxtrapoleerde MW na 10 jaar voor de op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag is 0,9 V, groter dan die (0,6 V) voor de op HZO gebaseerde FeFET zonder de extra kristallijne ZrO2 zaad laag. Aangezien de dikke capaciteitsequivalentdikte (CET) van de ZrO2 (1,5 nm)/SiO2 (2,6 nm) gate-isolatorlagen zouden leiden tot een verbeterd depolarisatieveld in de gate-stack [13, 15], verdere verbetering van de retentie-eigenschappen zou kunnen worden verwacht als de dikte van de SiO2 laag is verkleind.

Retentiekenmerken van op HZO gebaseerde FeFET's met en zonder ZrO2 zaadlagen
Figuur 4 toont de evolutie van I D –V G curven na ± 7 V/100 ns wisselende P/E-cycli. Voor de FeFET zonder de extra kristallijne ZrO2 zaadlaag, zowel significante verschuiving als hellingsdegradatie in de I D –V G curven worden waargenomen vanaf de vroege stadia van P/E-cycli, en de I D –V G curven in de gewiste toestanden vertonen meer hellingsdegradatie in vergelijking met de programmatoestanden. Voor de FeFET met het extra kristallijne ZrO2 zaadlaag, hoewel de I D –V G curven in gewiste toestanden vertonen een duidelijke positieve verschuiving tijdens de vroege stadia van P/E-cycli die wordt toegeschreven aan het "wakker worden" -effect [13, 28,29,30,31,32], geen duidelijke verschuiving van I D –V G curven in de programmastatussen worden waargenomen tot 1 × 10 3 cycli. Bovendien, voor de FeFET met de extra kristallijne ZrO2 zaadlaag, de I D –V G curven in zowel gewiste als programmastatussen vertonen slechts een lichte hellingsdegradatie tot 1 × 10 3 cycli.
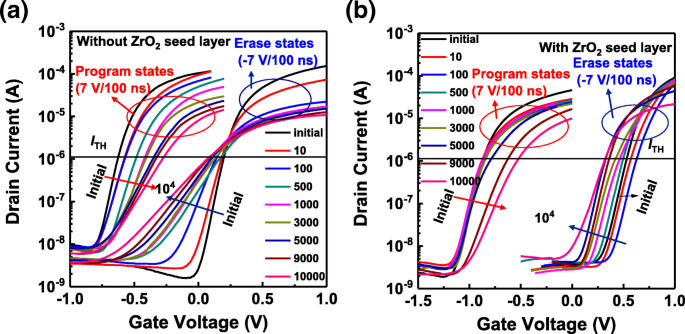
Evolutie van I D –V G curven van op HZO gebaseerde FeFET's a zonder en b met ZrO2 zaadlagen met P/E-cycli
Volgens eerdere rapporten [12, 28, 33], is de parallelle verschuiving in I D –V G krommen wordt toegeschreven aan de geleidelijke accumulatie van ingesloten ladingen in de poortstapel, terwijl de hellingsdegradatie in I D –V G curves is het resultaat van het genereren van interface-traps. Aangezien ingesloten ladingen met elektrische middelen kunnen worden ontvangen, maar het genereren van interface-traps onomkeerbaar is, is het minimaliseren van het genereren van interface-traps uiterst belangrijk voor het verbeteren van de duurzaamheidseigenschappen [28]. De interface-traps gegenereerd door P/E-cycli (ΔN het ) kan worden beschreven met Vgl. (1) [34, 35]:
$$ \Delta \mathrm{SS}=\frac{\Delta {N}_{it} kT\ln 10}{C_{FI}{\varnothing}_F} $$ (1)waarbij ΔSS de verandering van de subdrempelzwaai is, k is de Boltzmann-constante, T is de absolute temperatuur, C FI is de totale capaciteit van de poortstapel, en ∅ F is het Fermi-potentieel. De ΔN het als functie van de P/E-cyclus voor de op HZO gebaseerde FeFET's met en zonder extra kristallijn ZrO2 zaadlagen worden getoond in Fig. 5. Het is duidelijk dat voor de FeFET zonder de extra kristallijne ZrO2 zaadlaag, de ΔN het neemt duidelijk toe vanaf de vroege stadia van de P/E-cyclus, en ΔN het in de gewiste toestanden is veel groter dan die in de programmatoestanden. Echter, de ΔN het voor de FeFET met het extra kristallijne ZrO2 zaadlaag verandert bijna niet tot 1 × 10 3 cycli, en het is altijd kleiner dan die voor de FeFET zonder de extra kristallijne ZrO2 zaad laag. Omdat het invoegen van de extra ZrO2 zaadlaag vermindert het elektrische veld in de gate-stack en dus is de bandbuiging zwakker, de generatie van de interface-trap wordt verlicht [12, 14].
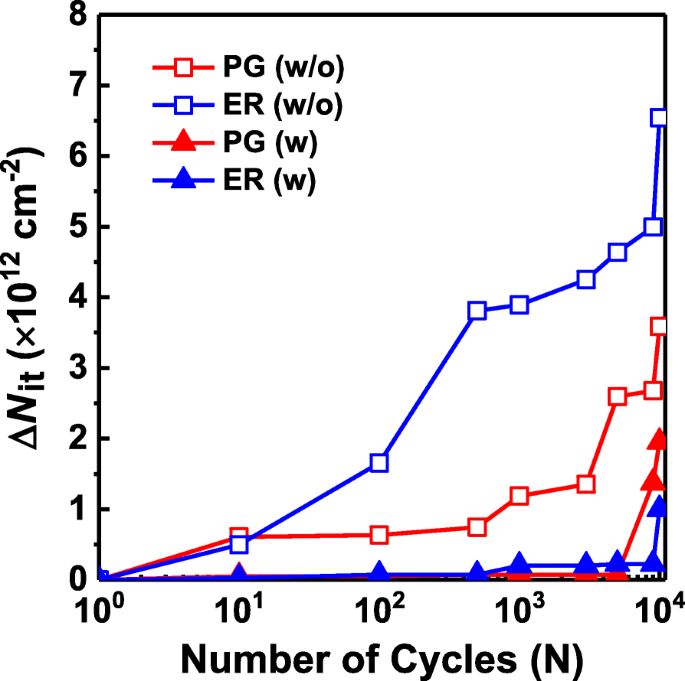
Evolutie van ∆N het met P/E fietsen
Figuur 6 toont de evolutie van poortlekstroomkarakteristieken (I G –V G curves) van op HZO gebaseerde FeFET's met en zonder ZrO2 zaadlagen met P/E-cycling. Voor de FeFET zonder de extra kristallijne ZrO2 zaadlaag neemt de gate-lekstroom dramatisch toe vanaf de vroege stadia van de P/E-cyclus. De gate-lekstroom voor de FeFET met de extra kristallijne ZrO2 zaadlaag verandert bijna niet tot 5 × 10 2 cycli, en het is altijd kleiner dan die voor de FeFET zonder de extra kristallijne ZrO2 zaad laag. Het is gemeld dat de toename van de gate-lekstroom mogelijk verband houdt met de gegenereerde interface-traps [28]. De vermindering van de gate-lekstroom met cycli voor de FeFET met de extra kristallijne ZrO2 seed-laag zou worden toegeschreven aan de onderdrukking van het genereren van interface-traps.
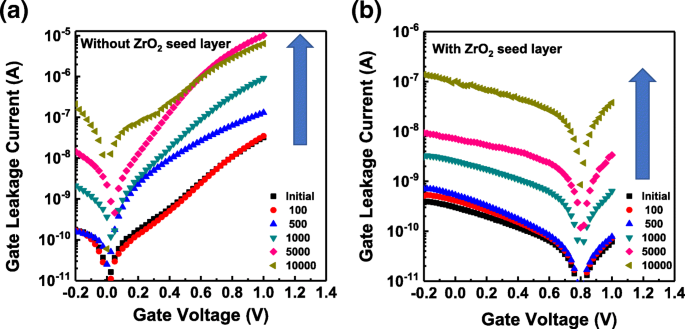
Evolutie van poortlekstroomkarakteristieken (I G –V G curves) van op HZO gebaseerde FeFET's a zonder en b met ZrO2 zaadlagen met P/E-cycli
De V TH waarden voor programma- en wisstatussen geëxtraheerd uit de I D –V G krommen van de op HZO gebaseerde FeFET's met en zonder extra kristallijn ZrO2 zaadlagen worden getoond in Fig. 7. De op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag vertoont altijd een groter MW dan de op HZO gebaseerde FeFET zonder de extra kristallijne ZrO2 zaad laag. Bovendien is het MW van de op HZO gebaseerde FeFET zonder het extra kristallijne ZrO2 zaadlaag neemt duidelijk af vanaf de vroege stadia van P/E-cycli, terwijl het MW van de op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag neemt iets af tot 1 × 10 3 cycli. Naarmate het P/E-cyclusgetal verder wordt verhoogd, wordt de op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag vertoont ook duidelijke degradatie in de helling van de I D –V G curven en de MW, dankzij de verbeterde generatie van interface-traps. Het MW van de op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag is nog steeds groter dan 0,9 V tot 1 × 10 4 cycli, wat ongeveer 2,3 keer groter is dan die (0,4 V) van de op HZO gebaseerde FeFET zonder de extra kristallijne ZrO2 zaad laag. Zoals eerder besproken, is de afname van het vereiste elektrische veld voor het verkrijgen van meer verzadigde polarisatietoestanden waarschijnlijk verantwoordelijk voor de verbeterde duurzaamheidseigenschappen.

Evolutie van V TH met P/E fietsen
Conclusies
De MW's evenals de betrouwbaarheid met betrekking tot retentie en uithoudingsvermogen van de op HZO gebaseerde FeFET's met de TaN/HZO/SiO2 /Si en TaN/HZO/ZrO2 /SiO2 /Si MFIS-poortstapels werden gekenmerkt door snelle spanningspulsmetingen. De resultaten laten zien dat de op HZO gebaseerde FeFET met het extra kristallijne ZrO2 zaadlaag vertoont een groot aanvankelijk geheugenvenster van 1,4 V en een geëxtrapoleerde retentie van 10 jaar van 0,9 V, groter dan het aanvankelijke geheugenvenster (0,8 V) van de op HZO gebaseerde FeFET zonder de extra kristallijne ZrO2 zaad laag. Bovendien kan de betrouwbaarheid met betrekking tot het uithoudingsvermogen van de op HZO gebaseerde FeFET worden verbeterd door het invoegen van de kristallijne ZrO2 zaadlaag tussen de HZO-laag en de SiO2 /Si-substraat. De verbetering van het MW en het uithoudingsvermogen van op HZO gebaseerde FeFET's met ZrO2 kiemlagen zijn voornamelijk gerelateerd aan de verbeterde kristallijne kwaliteit van de HZO-laag en de onderdrukte generatie van interface-vallen als gevolg van de afname van het vereiste elektrische veld voor het verkrijgen van meer verzadigde polarisatietoestanden. Op basis van dit werk wordt verwacht dat het gebruik van een directe kristallijne hoge-k/Si-poortstapel de MW's en betrouwbaarheid van de HfO2 verder zou verbeteren. -gebaseerde FeFET's, en rechtvaardigen dus verdere studie en ontwikkeling.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- CMOS:
-
Complementaire metaaloxide-halfgeleider
- FeFET:
-
Ferro-elektrische veldeffecttransistor
- FeFET's:
-
Ferro-elektrische veldeffecttransistors
- HKMG:
-
High-k metalen poort
- HZO:
-
Hf0,5 Zr0,5 O2
- Ik D :
-
Afvoerstroom
- L:
-
Lengte
- MFIS:
-
Metaal/ferro-elektrisch/isolator/halfgeleider
- MW:
-
Geheugenvenster
- P/E:
-
Programmeren/wissen
- P–V :
-
Polarisatie–voltage
- SS :
-
Subdrempelzwaai
- V G :
-
Poortspanning
- V TH :
-
Drempelspanning
- W:
-
Breedte
- ΔN het :
-
De gegenereerde interface-traps
Nanomaterialen
- ST:8-bit MCU's met rijk analoog en DMA in een goedkoop SO-8-pakket
- Slim nanomateriaal en nanocomposiet met geavanceerde agrochemische activiteiten
- Compliance-vrij ZrO2/ZrO2 − x /ZrO2 resistief geheugen met controleerbaar interfaciaal multistate schakelgedrag
- Geleidingsmechanisme en verbeterd uithoudingsvermogen in HfO2-gebaseerd RRAM met nitridatiebehandeling
- Frequentiemodulatie en absorptieverbetering van THz-microbolometer met microbrugstructuur door spiraalvormige antennes
- Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
- Een hoogwaardige rechthoekige Gate U-kanaal-FET's met slechts 2 nm afstand tussen bron- en afvoercontacten
- Een nanoschaal low-power weerstandloze spanningsreferentie met hoge PSRR
- Atomaire laag afgezet Hf0.5Zr0.5O2-gebaseerde flexibele memristor met korte/lange termijn synaptische plasticiteit
- Hoge doorslagspanning en lage dynamische AAN-weerstand AlGaN/GaN HEMT met fluorionenimplantatie in SiNx-passiveringslaag
- Faseovergangen en vorming van een monolaagachtige structuur in dunne oligothiofeenfilms:exploratie met een gecombineerde in-situ röntgendiffractie en elektrische metingen



