Blinde/begraven via's ontwerpen in snelle digitale circuits
Met de toenemende toepassingen van grootschalige en supergrootschalige geïntegreerde schakelingen in het systeem van schakelingen, vertonen printplaten een ontwikkelingstrend naar meerdere lagen en complexiteit als gevolg van de vergrotende integratieschaal van chips, krimpend volume, escalatie van pinnen en toenemende van snelheid. De meeste high-speed meerlaagse PCB's implementeren verbindingen tussen lagen via thru-hole via's. Voor de elektrische verbindingen die niet van boven naar beneden circuleren, zal echter mogelijk een redundante thru-hole via stub plaatsvinden, waardoor de overdrachtskwaliteit van de PCB sterk wordt beïnvloed. Daarom kan, in termen van sommige snelle digitale systemen met hoge prestaties en hoge eisen, de invloed van redundante stubs nooit worden verwaarloosd. Gebaseerd op de pogingen om kosten en prestaties in evenwicht te brengen, komt het ontwerp van blinde/begraven via's tot stand om effectief redundante stub-effecten te voorkomen en de transmissiekwaliteit van systemen te verhogen.
Met blind en begraven via ontwerp als onderzoeksobjecten en door middel van modelleringssimulatie, analyseert dit artikel voornamelijk de invloed van parameters met betrekking tot via-diameters van blinde/begraven via's, pad en antipad op signaalkenmerken zoals S-parameter en impedantiecontinuïteit en geeft praktische instructies voor hoge -speed PCB blind/begraven via ontwerp.
Belangrijkste parameters en prestatie-index van blinde/begraven via's
Voor meerlaagse PCB's met hoge snelheid en digitale schakelingen zijn via's nodig voor een snelle signaalverbinding tussen verbindingslijnen in het ene vlak en verbindingslijnen in een ander vlak. Via's zijn eigenlijk elektrische geleiders die routes tussen verschillende vlakken verbinden. Op basis van verschillen in PCB-ontwerp kunnen via's worden ingedeeld in doorlopende via, blinde via en begraven via, zoals weergegeven in figuur 1.
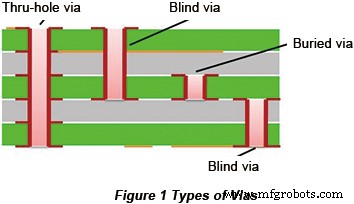
• Thru-hole via's, die door de hele printplaat circuleren, worden toegepast voor onderling verbonden routeringen tussen lagen of als positioneringsvia's voor componenten.
• Blinde via's, die niet door de hele printplaat circuleren, zijn verantwoordelijk voor de verbinding tussen de interne lagen van de printplaat en de routering van het oppervlaktevlak.
• Begraven via's zijn alleen verantwoordelijk voor de verbinding tussen interne lagen van PCB's. Ze zijn niet direct te zien aan het uiterlijk van PCB's.
Via's kunnen niet worden beschouwd als een elektrische verbinding en er moet rekening worden gehouden met hun invloed op de signaalintegriteit. Daarom is een beter begrip van de invloed van het architectuurontwerp van vias op de prestaties van snelle digitale circuits gunstig voor de uitstekende oplossing voor signaalintegriteit, zodat het ontwerp van het snelle digitale systeem kan worden geoptimaliseerd en de overdrachtskwaliteit van hogesnelheidssignalen kan worden verbeterd.
In hogesnelheidscircuits kan het equivalente elektrische model van via's worden aangegeven als figuur 2 waarin C1 , C2 en L verwijzen respectievelijk naar parasitaire capaciteit en inductantie van via's.
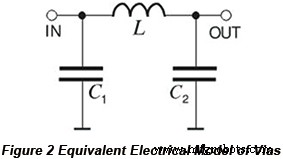
Op basis van dit model zullen alle via's in hogesnelheidscircuits parasitaire capaciteit naar aarde genereren. Parasitaire capaciteit kan worden berekend met de onderstaande formule:

In deze formule is de parasitaire capaciteit van via's gelijk aan de diameter van antipad naar de grond, diameter van pads van via's, diëlektrische constante van substraatmateriaal en de dikte van PCB. In snelle digitale circuits zorgt de parasitaire capaciteit van via's ervoor dat de stijgtijd van het signaal langzaam wordt of afneemt en de circuitsnelheid vertraagt. Voor een transmissielijn waarvan de karakteristieke impedantie Z0 . is , kan de relatie tussen parasitaire capaciteit en de stijgtijd van signalen worden aangegeven als onderstaande formule.

Wanneer hogesnelheidssignalen door via's gaan, wordt ook parasitaire inductantie gegenereerd. In snelle digitale circuits is de invloed van parasitaire inductantie van via's groter dan parasitaire capaciteit. Parasitaire inductantie kan worden berekend volgens onderstaande formule.

In deze formule is de parasitaire inductantie van via's gelijk aan de lengte van via's en de diameter van via's. Bovendien kan de equivalente impedantie die wordt veroorzaakt door parasitaire inductantie nooit worden verwaarloosd en de relatie tussen equivalente impedantie en parasitaire capaciteit en stijgtijd van signalen kan worden aangegeven met de onderstaande formule.

Op basis van bovengenoemde formules veranderen de elektrische prestaties van vias met ontwerpparameters. De veranderingen van via-diameter, lengte, pad en antipad leiden tot impedantiediscontinuïteit in hogesnelheidscircuits waarbij de signaalintegriteit sterk wordt beïnvloed. De analyse van signaalkenmerken in dit artikel ligt in de indexen van S11 (retourverlies) en S21 (insertieverlies). Wanneer de verzwakkingsgraad van invoegverlies minder is dan -3dB, wordt de effectieve bandbreedte toegepast om de signaaloverdrachtprestaties van blinde/begraven via's te beoordelen en te analyseren. Bovendien kan TDR-simulatie worden toegepast om de reflectie te analyseren die wordt veroorzaakt door impedantiediscontinuïteit.
Modelsimulatie en resultaatanalyse van blinde/begraven via's
Om de invloed van blinde/begraven via's op high-speed PCB-signaalfuncties te onderzoeken, ontwerpt dit artikel een 8-laags PCB-model met HFSS-software, dat wordt weergegeven in figuur 3 hieronder.

In deze PCB zijn de lagen 1 t/m 2, 4 t/m 5 en 7 t/m 8 allemaal signaallagen; de derde laag is de machtslaag; de zesde laag is grondlaag; de dikte van elke laag is 0,2 mm (8mil); diëlektrisch materiaal is FR4; diëlektrische coëfficiënt is 4. De routeringsbreedte van signaallijnen is 0,1 mm (4 mil), de dikte 0,13 mm (1,1 mil). In de simulatie is de stijgtijd van signalen ingesteld op 20ps en de hoogste sweepfrequentie op 100GHz.
• Vergelijking van de invloed van signaalkenmerken afkomstig van blinde/begraven via's en doorgaande via's
Wanneer een signaalleiding nodig is om van de eerste laag naar de vijfde laag te circuleren, kan blinde via worden toegepast voor verbinding. De straal van de blinde via is ingesteld op 0,1 mm (4 mil) en de lengte op 0,81 mm (32 mil).
Ter vergelijking:de doorlopende verbinding is ook ontworpen met de straal van de doorgaande opening via 0,1 mm. Onder deze voorwaarde is de lengte van de stomp van de doorgaande opening 0,6 mm.
Op basis van het simulatieresultaat, wanneer de frequentie in het bereik van 40 GHz tot 80 GHz ligt, is de parameter van terugkeerverlies van blind via (S11 ) is slechts 4dB tot 7dB. Wanneer de frequentie echter in het bereik van 40 GHz tot 80 GHz ligt, is de parameter van retourverlies van thru-hole via (S11 ) is slechts 4dB tot 10dB. Wanneer de frequentie 76GHz is, is de parameter van invoegverlies van blind via (S21 ) is de grootste. Wanneer de frequentie echter 52GHz is, is de parameter van insertion loss of thru-hole via (S21 ) is de grootste. Als het invoegverlies gegarandeerd minder dan -3dB is, zal de werkingsbandbreedte van blind via 22GHz zijn, terwijl de werkingsbandbreedte van thru-hole via slechts 15GHz zal zijn.
In termen van karakteristieke impedantie ligt de veranderingscategorie van karakteristieke impedantie van blinde via's in het bereik van 46 tot 52, terwijl de veranderingscategorie van karakteristieke impedantie van doorlopende via's van 42 tot 53 is, wat betekent dat blinde via's een betere transmissielijn hebben impedantie continuïteit. Daarom kan, op basis van de stabiliteit van S-parameters en verandering van karakteristieke impedantie TDR, worden geïllustreerd dat blinde via's een betere transmissiekwaliteit hebben dan thru-hole via's in termen van signaallijnverbinding tussen toplaag en interne laag of tussen onderste laag en interne laag. laag.
Wanneer een signaalleiding nodig is om van de tweede laag naar de vijfde laag te circuleren, kan begraven via worden toegepast voor verbinding. De straal van begraven via's is ingesteld op 0,1 mm en de lengte is 0,57 mm. Thru-hole via wordt ook toegepast ter vergelijking met de straal van 0,1 mil en de lengte van de overtollige stub tussen de eerste laag en de tweede laag is 0,23 mm, terwijl de lengte van de overtollige stub tussen de vijfde laag en de achtste laag 0,6 mm is. /P>
Op basis van het simulatieresultaat, wanneer de frequentie in het bereik van 40 GHz tot 80 GHz ligt, is de parameter van retourverlies van begraven via (S11 ) is slechts 4dB tot 8dB met een relatief soepele verandering. Wanneer de frequentie echter in het bereik van 40 GHz tot 80 GHz ligt, is de parameter van retourverlies van thru-hole via (S11 ) is slechts 4dB tot 10dB. Vooral wanneer de frequentie 32GHz is, verandert de demping onmiddellijk in 13dB, wat de stabiliteit van de transmissie beïnvloedt. Wanneer de frequentie 77GHz is, is de parameter van invoegverlies van begraven via (S21 ) is de grootste. Wanneer de frequentie echter 54GHz is, is de parameter van insertion loss of thru-hole via (S21 ) is de grootste. Als het invoegverlies gegarandeerd minder dan -3 dB is, is de operationele bandbreedte van begraven via 32 GHz, terwijl de operationele bandbreedte van thru-hole via slechts 20 GHz is.
Bovendien ligt de verandering van karakteristieke TDR van begraven via in het bereik van 41,8 tot 52, terwijl de verandering van karakteristieke TDR van thru-hole via in het bereik van 37,5 tot 52 ligt, wat betekent dat begraven via een betere continuïteit van de transmissielijnimpedantie heeft dan doorgang via. Daarom kan op basis van de stabiliteit van S-parameters en verandering van karakteristieke impedantie TDR worden geïllustreerd dat begraven via's een betere transmissiekwaliteit hebben dan doorgaande gaten in termen van signaallijnverbinding tussen interne lagen.
• Invloed van blind/begraven via diameter, pad en antipad op signaalkenmerken
Om de invloed van blinde/begraven via-diameter, pad en antipad op signaalkenmerken te bestuderen, kan de grootte van pad en antipad van blinde/begraven via's worden vastgesteld. De initiële waarde van de straal van blinde/begraven via's is ingesteld op 0,1 mm en verandert binnen de categorie van 0,1 mm in 0,175 mm.
Op basis van het resultaat van de simulatie kan worden aangegeven dat wanneer de straal van blind via veranderingen binnen de categorie van 0,1 mm naar 0,175 mm, de verandering van impedantie in de categorie van 6 naar 13,5 ligt, waarbij de mate van impedantie-discontinuïteit toeneemt die veroorzaakt de toename in termen van bereik van insertieverlies S21 . Wanneer de frequentie in het bereik van 20 GHz tot 60 GHz ligt, bereikt de grootste demping 1,7 dB. Ondertussen, wanneer de straal van begraven via verandert binnen de categorie van 4mil naar 7mil, ligt de verandering van impedantie in de categorie van 10 naar 17 met de mate van impedantiediscontinuïteit toegenomen die de toename veroorzaakt in termen van bereik van invoegverlies S21 . Wanneer de frequentie in het bereik van 20 GHz tot 60 GHz ligt, bereikt de grootste demping 1,6 dB.
Met de diameter van blinde via en antipad ongewijzigd, is de initiële waarde van de straal van blind/begraven via pad ingesteld op 0,2 mm en verandert deze binnen de categorie van 0,2 mm in 0,28 mm.
Op basis van het resultaat van de simulatie kan worden aangegeven dat wanneer de straal van blind via pad verandert binnen de categorie van 0,2 mm naar 0,28 mm, de verandering van impedantie in de categorie van 6,5 naar 10,5 ligt die de toename in bereik veroorzaakt van invoegverlies S21 . Bovendien neemt de grootste demping toe met 2dB. Ondertussen, wanneer de straal van begraven via pad verandert binnen de categorie van 0,2 mm naar 0,28 mm, ligt de verandering van impedantie in de categorie van 10,5 naar 15,5 met de mate van impedantiediscontinuïteit verhoogd die de toename veroorzaakt in termen van bereik van invoegverlies S21 . Bovendien neemt de grootste demping toe met 3,2 dB.
Met de diameter van blind/begraven via en padgrootte ongewijzigd, is de initiële waarde van antipad ingesteld op 0,3 mm en verandert deze binnen de categorie van 0,3 mm in 0,375 mm.
Op basis van het resultaat van simulatie kan worden aangegeven dat wanneer de grootte van jaloezieën via antipad verandert binnen de categorie van 0,3 mm naar 0,375 mm, de verandering van impedantie in de categorie van 6,5 naar 5,5 ligt die de afname in termen van graad veroorzaakt van impedantiediscontinuïteit en bereik van insertieverlies S21 . Bovendien neemt de grootste demping toe met 3,2 dB. Ondertussen, wanneer de grootte van begraven via antipad verandert binnen de categorie van 0,3 mm tot 0,375 mm, ligt de verandering van impedantie in de categorie van 10 naar 7,5 die de afname veroorzaakt in termen van mate van impedantiediscontinuïteit en bereik van invoegverlies S 21 . Bovendien neemt de grootste demping toe met 3dB.
Conclusie
Met een 8-laags PCB met blind en begraven via's-model tot stand gebracht via HFSS, vergelijkt dit artikel S-parameters en karakteristieke impedantie TDR van blinde/begraven via's en doorgaande gaten. Er kan worden geconcludeerd dat blinde/begraven via's een kleiner insertieverlies en een betere impedantiediscontinuïteit hebben dan doorlopende via's. Op voorwaarde dat het invoegverlies minder is dan -3dB, hebben blinde/begraven via's een grotere bandbreedte dan doorgaande via's.
Dit artikel analyseert ook de invloed van parameters zoals via diameter, pad en antipad op blinde/begraven signaalkenmerken. Met de toename van de diameter van blinde/begraven via's en padgrootte, krimpt de verzwakking van signaalinvoegverlies dienovereenkomstig en neemt de mate van impedantiediscontinuïteit toe. Echter, met de toename van de antipad-grootte van blinde/begraven via's, krimpt de verzwakking van signaalinvoegverlies en daarmee ook de impedantiediscontinuïteit.
Als het invoegverlies minder is dan -3dB en de effectieve werkingsbandbreedte 20GHz bereikt, mag de straal van blinde via's niet groter zijn dan 0,175 mm en mag de straal van begraven via's niet groter zijn dan 0,23 mm; het pad van blinde via's mag niet groter zijn dan 0,25 mm en het pad van begraven via's mag niet groter zijn dan 0,275 mm; de antipad van blinde via's mag niet kleiner zijn dan 0,25 mm en de antipad van begraven via's mag niet kleiner zijn dan 0,23 mm.
Als het veranderingsbereik van de impedantie binnen ± 10% wordt geregeld, mag de straal van zowel blinde als begraven via's niet groter zijn dan 0,125 mm; het pad van blinde via's mag niet groter zijn dan 0,25 mm en het pad van begraven via's mag niet groter zijn dan 0,175 mm; de antipad van blinde via's mag niet kleiner zijn dan 0,275 mm en de antipad van begraven via's mag niet kleiner zijn dan 0,4 mm.
PCBCart heeft de mogelijkheden om PCB's te vervaardigen met blinde via's, begraven via's en doorlopende via's.
Printplaten nodig met Blind Via's, Buried Via's en Thru-hole Via's? PCBCart heeft u gedekt! Het enige dat we vragen is het voltooide PCB-ontwerpbestand om de productie te plannen. Wanneer u het ontwerpbestand in handen heeft, vraag dan uw PCB-prijzen aan door op de onderstaande knop te klikken. De prijs verschijnt binnen enkele seconden!
Handige bronnen:
• Vergelijking tussen blinde via en begraven via
• PCBCart biedt volledige PCB-fabricageservice
• Behalve PCB-fabricage biedt PCBCart ook geavanceerde kant-en-klare PCB-assemblageservice
• Vereisten voor PCB-ontwerpbestand voor snelle offerte en productie van PCB-assemblage
• 3 belangrijke elementen die u niet weet over begraven en blinde via in HDI Flex-rigide PCB's
Industriële technologie
- Inleiding tot digitale geïntegreerde schakelingen
- Hoe word je een digitale kampioen in productie
- Via's op BGA Pads
- Koperen vulling van blinde microvia's
- Hoe het digitaliseringsproces van een bedrijf te starten?
- Hoe meet ik de digitale volwassenheid van mijn bedrijf?
- Wat is Lean Digital en hoe integreer je het?
- Hoe de prestaties van werknemers verbeteren?
- Alles wat u moet weten over blinde en begraven via's
- Tips voor snelle lay-out
- Hoe HDI-ontwerp in elektronica te optimaliseren



