Groei en selectieve etsing van met fosfor gedoteerd silicium/silicium–Germanium meerlaagse structuren voor toepassing van verticale transistoren
Abstract
Verticale gate-all-round veldeffecttransistoren (vGAAFET's) worden beschouwd als de potentiële kandidaten om FinFET's te vervangen voor geavanceerde technologie voor de fabricage van geïntegreerde schakelingen op/naast het 3-nm-technologieknooppunt. Een meerlaagse (ML) van Si/SiGe/Si wordt gewoonlijk gekweekt en verwerkt om verticale transistors te vormen. In dit werk zijn de P-opname in Si/SiGe/Si en verticaal etsen van deze ML's bestudeerd, gevolgd door selectief etsen van SiGe in laterale richting om structuren voor vGAAFET te vormen. Er werden verschillende strategieën voorgesteld voor de epitaxie, zoals waterstofzuivering om de toegang van P-atomen op het Si-oppervlak uit te putten, en/of het invoegen van een Si of Si0.93 Ge0,07 afstandhouders aan beide zijden van P-gedoteerde Si-lagen en vervangende SiH4 door SiH2 Cl2 (DCZ). Experimentele resultaten toonden aan dat de segregatie en auto-doping ook verlicht konden worden door 7% Ge aan P-gedoteerde Si toe te voegen. De structuur had een goede roosterkwaliteit en had bijna geen spanningsrelaxatie. Het selectief etsen tussen P-gedoteerde Si (of P-gedoteerde Si0.93 Ge0,07 ) en SiGe werd ook besproken door nat en droog te etsen. De prestaties en selectiviteit van verschillende etsmethoden werden ook vergeleken. Dit artikel biedt kennis over hoe om te gaan met de uitdagingen of moeilijkheden van epitaxie en etsen van n-type lagen in verticale GAAFET's-structuur.
Inleiding
Naarmate de schaalvergroting van complementaire metaaloxidehalfgeleiders (CMOS) zijn fysieke beperking bereikt, verzwakken de korte-kanaaleffecten de prestaties van de transistor aanzienlijk. Een oplossing voor deze problemen zijn nieuwe transistorontwerpen, bijv. GAAFET's (gate-all-around veldeffecttransistoren), die ook worden beschouwd als de meest veelbelovende kandidaat voor transistors op nanoschaal tot 3-nm technologieknooppunt [1,2,3 ,4,5,6]. Laterale en verticale nanodraden/nanosheets zijn volgens International Roadmap for Device and Systems (IRDS) 2020 de belangrijkste structuren ter vervanging van FinFET's [7]. Verticale GAAFET's (of vGAAFET's) hebben een vrij flexibel ontwerp op poortlengte en hebben een groot potentieel om de geïntegreerde dichtheid te vergroten [4, 8]. Er zijn twee hoofdcategorieën om verticale nanodraadstructuren te implementeren:bottom-up en top-down. De bottom-up-methode introduceerde metaalkatalysator, wat mogelijk problemen met de procescompatibiliteit met zich meebrengt [9, 10]. De top-down methode is de mainstream in de industrie vanwege de betere controle van de nanodraadconfiguratie en de compatibiliteit met FinFET [4, 11,12,13,14]. De top-down methode om verticale GAAFET's te fabriceren trekt veel aandacht. Zelfuitlijnende poort met nauwkeurige poortlengteregeling was een cruciaal probleem [15, 16]. Om een betere controle over de lengte van de poort te verkrijgen of variatie te verminderen, kon de lengte van de poort voornamelijk worden bepaald door de dikte van het kanaalmateriaal dat epitaxiaal op een plat bodemoppervlak is gegroeid, zoals Si/SiGe/Si, en SiGe was het kanaalmateriaal [17, 18,19,20]. Bovendien ligt een andere kritische integratie-uitdaging in de doping tussen kanaal- en S/D-regio's [16, 20, 21], vooral met scherpe junctiecontrole [20]. Vergeleken met het traditionele source/drain-implantatieproces, vereenvoudigt het epitaxieproces het fabricageproces, vermindert het oppervlakteschade en bereikt het een uniform dopingprofiel. De P-gedoteerde Si/SiGe/P-gedoteerde Si-sandwichstructuur is echter moeilijk epitaxiaal te groeien vanwege de segregatie, auto-doping en out-diffusie verschijnselen van de meest voorkomende n-type doteringsmiddelen, fosfor [22, 23], arseen [24, 25] en/of antimoon [26, 27] op Si/SiGe-interface in systemen voor chemische dampafzetting (CVD). Daarom zouden de gescheiden donoratomen die zijn verzameld op de Si/SiGe-interface en de SiGe-laag worden gedoteerd, wat de prestaties van de transistor kan verslechteren met hoge lekkage.
Een strategie om de doteringsafscheiding te belemmeren is het toepassen van een zeer lage groeitemperatuur. Er zijn een reeks rapporten die veel inspanningen leveren om n-type doping te laten groeien door moleculaire bundelepitaxie (MBE) [28]; ondertussen is deze methode niet toegepast voor CVD. MBE-apparatuur is meestal ontworpen met één chip en vereist een hoog vacuüm en een langzame doorvoer. Bovendien is MBE-apparatuur in de industrie niet compatibel met waferformaten van meer dan 8 inch. Daarom is MBE-technologie niet geschikt voor industriële massaproductietoepassingen. Het RPCVD-systeem heeft echter een sterke productiecapaciteit en een eenvoudige apparatuurstructuur, die geschikt is voor de IC-industrie [29]. Het eerste idee voor RPCVD-groei is om de waterstofstroom in de kamer te regelen, aangezien waterstof het dragergas is en de kinetiek van voorlopergassen kan beïnvloeden. Li et al. [23] meldde dat waterstof de bindingsstructuur van gastheeratomen in het oppervlak veranderde en de segregatie-energie verminderde door een lage groeitemperatuur toe te passen in een snel thermisch CVD (RTCVD) -systeem. Het effect van waterstof is echter niet onderzocht op het Si/SiGe-interface in een CVD (RPCVD) -systeem met verlaagde druk. Suvar et al. [30] plaatste 30-nm ongedoteerde Si-afstandslagen tussen P-gedoteerd Si en SiGe om de P-concentratie op het grensvlak met een factor 4 te verlagen (van 8 × 10 19 cm −3 tot 2 × 10 19 cm −3 ), maar de P-dopingpiek kan niet worden geëlimineerd. Bennett et al. [31] hebben het effect van spanning op n-type doping in Si bestudeerd. De vaste oplosbaarheid van doping werd verhoogd door trekspanning in Si te introduceren. Christensen et al. [32] hebben geen significante afhankelijkheid gevonden van de P-diffusiviteit van het Ge-gehalte in Si1-x Gex (0 ≤ x ≤ 0,22). En de P-diffusiecoëfficiënten hadden weinig verschil tussen ontspannen Si en biaxiaal compressie-gespannen SiGe. Zangenberg et al. [33] observeerde een verhoging van de diffusiecoëfficiënt met een factor 2 bij 825 °C voor ontspannen Si0,88 Ge0,12 .
In dit artikel zijn verschillende methoden voorgesteld om de opname van P in Si in een meerlaagse Si/SiGe/Si te verbeteren met behulp van RPCVD. In de experimenten werden verschillende strategieën zoals waterstofzuivering, het inbrengen van niet-gedoteerde spacerlagen, het veranderen van de Si-precursor van SiH4 naar SiH2 Cl2 (DCS), en het moduleren van het stamprofiel door Si0.93 . te introduceren Ge0,07 offerlaag aan beide zijden van de SiGe-laag zijn gepresenteerd. Verder werd het selectief etsen van SiGe besproken om een dunne SiGe-laag te vormen (bedoeld als kanaallaag) [6, 34]. Ook werden de etseigenschappen van natte en droge etsgereedschappen vergeleken. De uiteindelijke structuur is bedoeld om in de toekomst te worden gebruikt voor vGAAFET's voor sub-10-nm technologieknooppunten.
Methoden
Si/SiGe/Si multilayers (MLs) werden gekweekt op 200 mm Si 100> wafers met RPCVD (ASM Epsilon 2000) apparatuur. De Si-substraten werden gereinigd met een mengseloplossing van H2 SO4 en H2 O2 , gevolgd door verdund HF om natief oxide te verwijderen voordat het in de laadsloten van de epitaxiekamer wordt gestoken. De monsters werden in situ gereinigd door te gloeien bij 1050 ° C om het natuurlijke oxide te verwijderen om een hoogwaardig Si-oppervlak te verkrijgen. De voorlopers van Si, Ge en P waren SiH4 (of SiH2 Cl2 ), 10% GeH4 in H2 , en 2% PH3 in H2 . De groeitemperatuur was 650 °C, terwijl de kamerdruk tijdens epitaxie op 80 Torr werd gehouden. In sommige experimenten werd de kamerdruk verlaagd tot 10 Torr om P-gedoteerde Si0.93 te laten groeien Ge0,07 laag in de source/drain (S/D)-regio's. Het Ge-gehalte in het SiGe-kanaal werd constant gehouden op 0,22. Om de selectieve etseigenschappen te bestuderen, werd 50 nm nitride/30 nm oxide afgezet als hardmasker om de onderste ML's te beschermen. Lithografie en droge anisotrope verticale etsing werden uitgevoerd om afzonderlijke kubusvormige patronen te vormen. Selectieve etsexperimenten werden uitgevoerd met nat etsgereedschap van HF (6%):H2 O2 (30%):CH3 COOH (99,8%) = 1:2:4 en droog etsgereedschap van CF4 :O2 :He = 4:1:5 [35].
De Si/SiGe/Si ML's werden gekarakteriseerd door de technieken van hoge-resolutie (Thermo Scientific Talos F200) transmissie-elektronenmicroscopie (HRTEM), energiedispersieve röntgenspectroscopie (EDX), röntgendiffractie met hoge resolutie (HRXRD) , en een reciproke roosterkaart met hoge resolutie (HRRLM) van Bruker JV Delta-x, scanning-elektronenmicroscopie (SEM) van Hitachi (Japan) en secundaire ionenmassaspectroscopie (SIMS).
Resultaten en discussie
Epitaxie van P-gedoteerde Si/SiGe/Si ML's
In deze studie werd aanvankelijk de opname van P in Si en SiGe onderzocht. De ML-structuren worden getoond in figuur 1a. Een ML van P-gedoteerd Si/ongedopeerd Si met toenemende PH3 stroom werd gegroeid en de laagprofielen werden onderzocht door SIMS in figuur 1b. De afbeelding laat zien dat de P-concentratie toeneemt en het hoogste niveau van 2,6 × 10 19 . bereikt cm −3 . Nog twee monsters met profiel van 'P-gedoteerde Si/Si0.72 Ge0,28 /P-gedoteerde Si' en 'Si/P-gedoteerde Si0,72 Ge0,28 /Si' zijn ontworpen en het P-profiel wordt respectievelijk gedemonstreerd in Fig. 1c, d. In Fig. 1c wordt een P-stapeling waargenomen op grensvlakken van P-gedoteerde Si/Si0,72 Ge0,28 meerdere lagen. De grensvlak P-stapeling neemt toe met toenemende P-concentratie van onder naar boven in de meerlagen, en de hoogste concentratie is 1,6 × 10 20 cm −3 , wat 6 keer zoveel is als de concentratie in Fig. 1b (2.6 × 10 19 cm −3 ). In gedoteerde Si0,72 Ge0,28 lagen (Fig. 1d), P-concentraties zijn opmerkelijk hoger en er zijn geen pieken op het grensvlak. Door doping is het Ge-percentage iets verhoogd. Dit gedrag houdt verband met de verhoogde adsorptie van SiH4 en GeH4 in aanwezigheid van PH3 . Bovendien zijn door doping de laagdiktes verschillend tussen Fig. 1c, d, die dezelfde groeitijd hebben. Het betekent dat P-doping de groeisnelheid van Si0,72 . verhoogt Ge0,28 lagen en de absorptie van GeH4 , terwijl de groeisnelheid van Si wordt vertraagd door P-adsorptie. Deze verschijnselen komen overeen met de uitkomst gerapporteerd in Refs. [36,37,38]. Uit het bovenstaande blijkt dat P-segregatie en autodoping-fenomeen serieus zijn op de Si/SiGe-interface. De P-dopingpiek op de Si/SiGe-interface maakt onbedoelde doping in de SiGe-laag. Aangezien SiGe bedoeld is als de kanaallaag in de transistors, zou het inhomogene dopingprofiel of de hoge achtergronddoteringsniveaus de apparaattoepassingen beperken [39]. Verschillende methoden om de P-piek te elimineren zullen hieronder worden besproken. Voor een betere vergelijking zijn alle SiGe-lagen gespannen en is de stroomverhouding van SiH4 (SiH2 Cl2 ) en GeH4 voor de SiGe-laag werd niet tijdens alle experimenten gewijzigd.
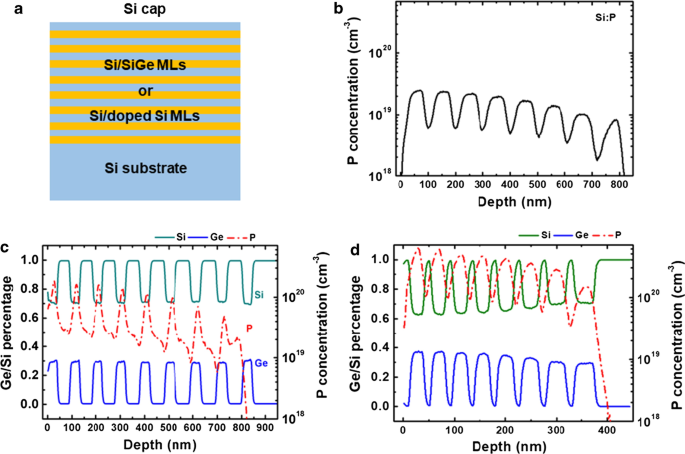
een Schematisch diagram van P-gedoteerde Si/SiGe/Si ML's. b P-dopingconcentratie van ongedoteerde Si/P-gedoteerde Si ML's. Ge/Si-percentage en P-concentratie van c ongedoteerde Si0,72 Ge0,28 /P-gedoteerde Si, d ongedoteerd Si/P-gedoteerd Si0,72 Ge0,28 ML's. Er werd geen rekening gehouden met zuivering en niet-gedoteerde afstandslaag
Impact van spacer-lagen
Niet-gedoteerde Si-afstandslagen werden ingevoegd tussen de aan de onderkant gedoteerde Si-laag en de niet-gedoteerde SiGe-laag om de overmaat aan P-atomen te absorberen. Figuur 2a toont het schematische diagram van de ontworpen structuur, en figuur 2b-d toont de profielresultaten van geïntegreerde Si-afstandhouders met een dikte van (b) 3 nm, (c) 5 nm en (d) 10 nm. De pieken van P-ophoping worden verminderd, terwijl het Si/Ge-percentage en de P-concentratie in Si-lagen constant worden gehouden zoals in Fig. 2b-d. Het P-stapelniveau is met 82% verlaagd, van 4 × 10 19 cm −3 in Afb. 2b tot 7 × 10 18 cm −3 in Fig. 2d, wanneer de afstandsdikte X b verhoogd van 3 naar 10 nm. Het vergroten van de dikte van ongedoteerde Si-afstandslagen verhoogt de absorptie van overmatige P-atomen. In figuur 2d, de helling van het P-profiel bij Si0,86 Ge0,14 /Si-oppervlak is 15,9 nm/dec, terwijl bij Si/Si0,86 Ge0,14 interface is de helling 31,3 nm/dec. Ondertussen is een te dikke Si-afstandslaag geen geschikte oplossing omdat de weerstand van het vel toeneemt. Daarom moet voor transistoren een afweging worden gemaakt tussen plaatweerstand en ongecontroleerd P-profiel. Afbeelding 2 laat ook de impact zien van de afstandslaag tussen de Si/Si0,86 Ge0,14 lagen (X b ) verschilde van de laag tussen de Si0,86 Ge0,14 /Si (X t ). In Fig. 2b, c, de afstandsdiktes tussen de Si0,86 Ge0,14 /Si waren 3 nm en 5 nm, terwijl in figuur 2d geen afstandslaag was ingevoegd. Echter, de helling van het P-profiel bij de Si0,86 Ge0,14 /Si is hetzelfde (ongeveer 15,9 nm/dec), hoewel in figuur 2d de bovenste afstandslaag is verwijderd, maar geen invloed op het doteringsprofiel werd waargenomen. Uit de bovenstaande resultaten was de P-piek alleen bij de Si/Si0,86 Ge0,14 interface, wat mogelijk te wijten was aan de oplosbaarheidslimiet; de overmaat aan P-atomen kan P-P-dimeren vormen aan het oppervlak en worden opgenomen in de SiGe-deklaag. Bovendien is er een auto-doping van P tijdens de SiGe-groei na P-gedoteerde Si. Daarom is er gezocht naar methoden om de overmaat aan P-atomen te verwijderen of de Si-oplosbaarheid te verbeteren.
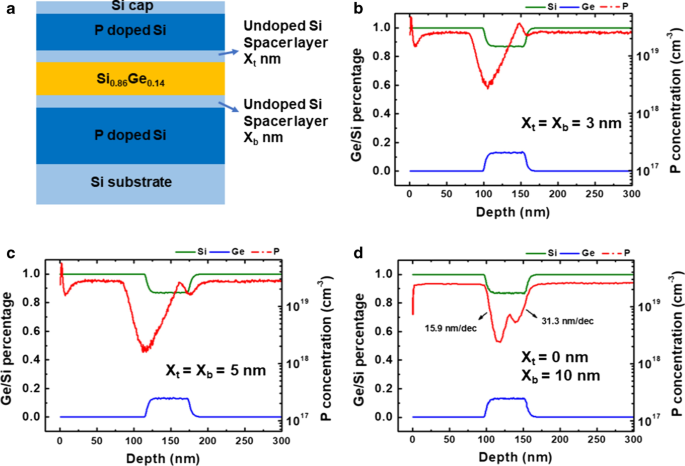
een Het schema van experimentele monsters met verschillende ongedoteerde spacerlagen. En Ge-, Si- en P-profielen van P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si ML's met ongedoteerde Si-afstandslagen van b 3 nm, in beide interfaces, c 5 nm, in beide interfaces, d 10 nm, alleen op één interface met Si0.86 Ge0,14
Impact van waterstofzuivering op het grensvlak van Si/SiGe/Si ML's
In deze sectie werd de Si-afstandslaag gefixeerd op 5 nm en werd waterstofspoeling geïntroduceerd om de overmaat aan P-atomen na de P-gedoteerde Si-groei te verwijderen. Uit figuur 3c, d blijkt dat het verhogen van de waterstofstroom van 20 naar 60 sccm en de spoeltijd van 2 naar 10 minuten geen duidelijk effect heeft op de P-piek. De dopingconcentratie in Si is 3 × 10 19 cm −3 , wat hetzelfde is als besproken in de sectie "Impact van afstandslagen". De P-piekconcentratie op het grensvlak is hetzelfde met de concentratie in Si uit figuur 3d. De laagdiktes zijn onder verschillende spoelomstandigheden gelijk. De P-atomen kunnen niet worden geklaard door waterstof; dit kan worden verklaard door de vorming van stabiele P-complexen op het oppervlak. Door parameters zoals temperatuur, druk te wijzigen, zou de spoeltijd nuttig zijn [24, 40], maar een te lange spoeltijd is niet geschikt vanwege de tijdskosten, en een hoge temperatuur (>-950 °C) veroorzaakt Si-Ge-interdiffusie [41] .
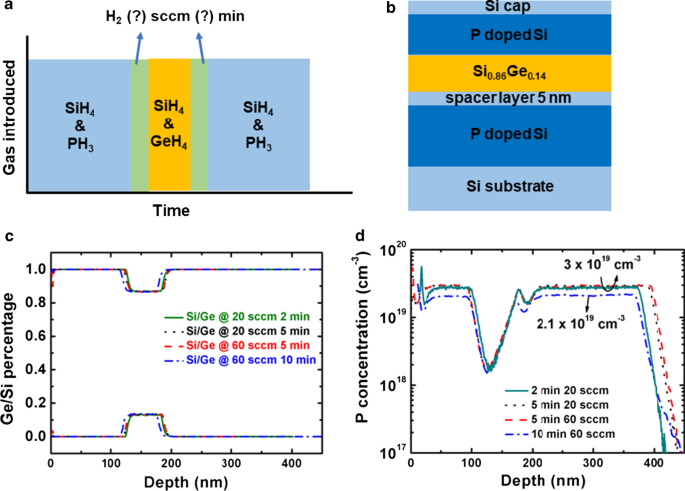
Schematische diagrammen van a dopingstrategie van H2 zuiveringsvoorwaarden, en b experimentele structuur van Si/SiGe/Si ML's. c Ge/Si-profiel en d P-concentratie van P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si ML's
Impact van groeichemie op P-opname
In deze experimenten werd de Si-precursor, SiH4 , is vervangen door SiH2 Cl2 (DCZ). In deze monsters waren de groeiparameters hetzelfde als voorheen, en de structuren bevatten een Si-afstandslaag van 5 nm en de zuiveringstijd is 5 minuten met een stroom van 60 sccm. Het idee erachter is om te onderzoeken of op Cl gebaseerde chemie de overtollige P-atomen door Si-oppervlak zou kunnen verwijderen en reacties van P-Cl, Si-Cl of Ge-Cl zouden kunnen plaatsvinden [42]. Uit Fig. 4 neemt de P-piekconcentratie af met een factor 2 (van 2.6 × 10 19 cm −3 tot 1,3 × 10 19 cm −3 ), en de P-concentraties in Si-lagen zijn 2.6 × 10 19 cm −3 . Het geschatte Ge-gehalte is 30%, wat hoger is dan SiGe met SiH4 . Het hogere Ge-gehalte toont aan dat Cl bij voorkeur de Si-atomen bij de oppervlaktereacties verwijderde. Dit resultaat kan ook worden verklaard door de verschillende relatie van gasstroomverhouding en Ge-concentratie met SiH4 en SiH2 Cl2 gasvormige voorlopers [32, 43]. Een andere verklaring was dat Ge-atomen de waterstofdesorptie verhoogden en vervolgens de vrije nucleatieplaatsen [44]. De helling van de P-concentratie van de Si0,7 Ge0.3 /Si-interface was 13,2 nm/dec, wat een beetje scherper was dan Si0,86 Ge0,14 /Si-interface (15,9 nm/dec). De helling van het P-profiel bij de Si/Si0,7 Ge0.3 interface was 20 nm/dec. Daarom, door meer HCl toe te voegen of de gasverhouding van SiH2 . te verhogen Cl2 en GeH4 , de gescheiden P-atomen aan het gedoteerde Si-oppervlak kunnen worden geëtst door HCl om P-Cl-dimeren te vormen en de P-piekconcentratie bij Si/SiGe kan lager zijn [38, 45].
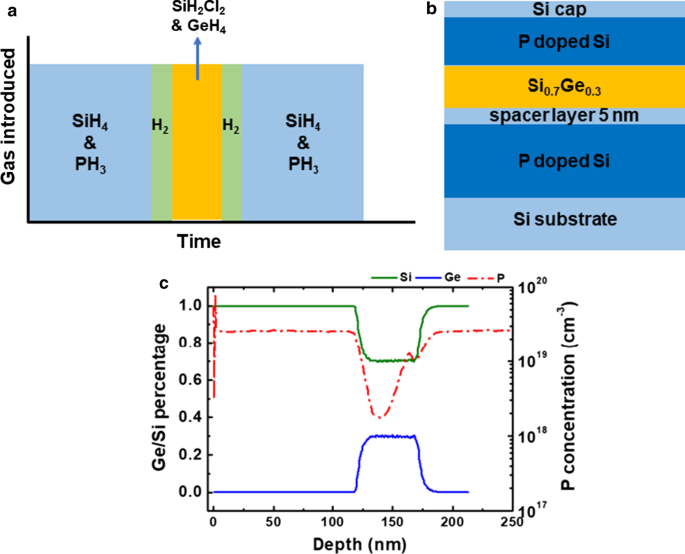
Schematische diagrammen van a dopingstrategie van veranderende groeichemie, b experimentele structuur van Si/SiGe/Si ML's. De SiGe-laag werd gekweekt met DCS. De spoeltijd was 5 minuten met een stroom van 60 sccm na gedoteerd Si. De niet-gedoteerde Si-afstandslaag was 5 nm tussen aan de onderkant gedoteerde Si en niet-gedoteerde SiGe. c Ge/Si-profiel en P-concentratie van P-gedoteerde Si/Si0,7 Ge0.3 /P-gedoteerde Si ML's
Impact van Ge-inhoud op P-profile
Zoals we eerder hebben besproken, was de opname van P in SiGe opmerkelijk hoger dan in Si. Daarom kan het idee ontstaan dat het toevoegen van een paar percentages Ge (7%) in Si-spacers (5 nm) de opname van P in Si zou kunnen verbeteren. Het is de moeite waard hier te vermelden dat ons doel niet is om het karakter van P-gedoteerde Si significant te veranderen, maar de segregatie van P in Si te belemmeren. In deze monsters verminderde de kamerdruk tot 10 Torr tijdens de groei van afstandslagen. De dopingafhankelijke groeisnelheid en het Ge-percentage zouden onder deze voorwaarde van belang zijn. Uit figuur 5b waren de bovenste en onderste lagen 110 nm Si0.93 Ge0,07 met P-concentratie van 1 × 10 20 cm −3 , de middelste laag was 40 nm Si0,78 Ge0.22 met P-concentratie van 3,5 × 10 19 cm −3 . De helling van de P-concentratie van met P-gedoteerde Si0,93 Ge0,07 /Si0,78 Ge0.22 was ongeveer 33 nm/dec. De helling was niet scherp omdat het procentuele verschil van Ge tussen de twee lagen niet groot genoeg was. In Fig. 5d, drie lagen P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 ML's werden gekweekt om de dopinguniformiteit te verifiëren, en het structuurdiagram werd getoond in Fig. 5c. Het is te zien dat van onder naar boven de P-concentratie afnam, wat kan worden verklaard door het geheugeneffect van P. De resterende P-atomen in de kamer of diffuse P-atomen hopen zich op aan het filmoppervlak en blokkeren vrije actieve plaatsen op het oppervlak [38, 39]. Hoewel de P-piek was geëlimineerd, was de scheiding tussen Si0,78 Ge0.22 en Si0.93 Ge0,07 was nog steeds serieus.
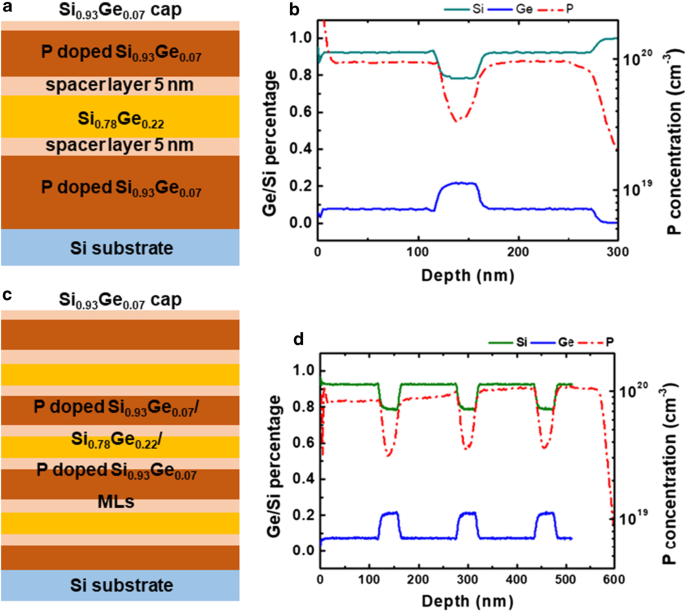
een Schematisch diagram, b Ge/Si- en P-profiel in één laag P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 ML. c Schematisch diagram, d Ge/Si- en P-profiel in drie lagen P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 ML
Selectieve etskenmerken van Si/SiGe/Si ML's
Wanneer de ML-structuur met succes is gegroeid (met behulp van de bovenstaande groeistrategieën), zijn de NW's gevormd door verticaal etsen met behulp van SiO2 /SiN als hardmasker. Daarna moet de SiGe-laag selectief worden geëtst op Si in de laterale richting om de kanaallaag met een ontworpen breedte te vormen. In deze experimenten zijn twee soorten ML-structuren gekozen:P-gedoteerde Si/SiGe/P-gedoteerde Si (monster-1, in Fig. 2c) en P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 (voorbeeld-2, in Fig. 5b). Deze keuzes zijn gemaakt op basis van bovenstaande discussies waarbij de uitdiffusie van P (gedeeltelijk) is onderdrukt, evenals de perspectieven van apparaattoepassing.
Het etsen in verticale richting werd uitgevoerd door droog etsen, terwijl voor lateraal etsen een selectieve droge of natte ets werd toegepast. De etsprofielen van monster-1 worden getoond in Fig. 6a, b. En het TEM-beeld en de EDS-afbeelding van figuur 6a zijn getoond in figuur 7. In deze experimenten is het harde masker oxide/nitride. Afbeelding 6a toont na 11,5 s droog etsen van CF4 /O2 /Hij. De etsselectiviteit van Si0,86 Ge0,14 en P-gedoteerde Si is 5,8. Figuur 6b laat zien dat na 20 min nat etsen van HF (6%)/H2 O2 (30%)/CH3 COOH (99,8%). De natte ets heeft het harde masker verwijderd (SiO2 /SiN), en als resultaat werd de Si-kaplaag ook geëtst ~ 10 nm. Zoals besproken in de sectie "Impact van Spacer Layers", is er een P-ophoping bij de P-gedoteerde Si/Si0,86 Ge0,14 koppel. De natte ets is gevoelig voor het dopingniveau; daarom was de eerste interface sneller geëtst. Als gevolg hiervan is de voorste etch-interface niet verticaal en is deze gefacetteerd of gehoekt. De gemiddelde selectiviteit was minder dan 4,2. Als we de twee etsmethoden vergelijken, is droog etsen gevoelig voor het Ge-percentage met een betere selectiviteit van SiGe, terwijl nat etsen gevoelig is voor doteringsconcentratie. De etsen van monster-2 worden ook bestudeerd in Fig. 6c, d. Soortgelijke verschijnselen werden waargenomen in dit monster, terwijl de SiGe-selectieve geëtste diepten dieper waren (Fig. 6a, c) vanwege een hoger Ge-percentage. Bij droog etsen is de selectiviteit van Si0,78 Ge0.22 en P-gedoteerde Si0.93 Ge0,07 was 6,3, terwijl bij nat etsen de gemiddelde selectiviteit minder dan 2,5 was. Daarom was droog etsen een betere keuze gezien de uniformiteit en selectiviteit van het etsen.
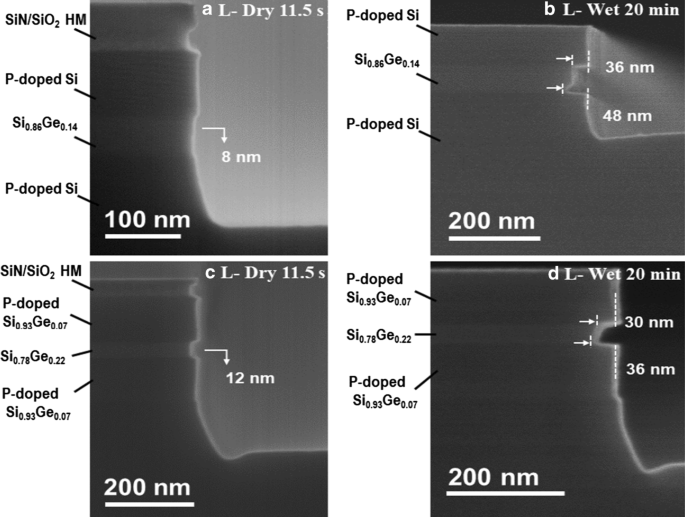
SEM-beelden van P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si in Fig. 2c met a 11,5-s droog etsen, b 20 minuten nat etsen en P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 ML's met c 11,5-s droog etsen, d 20 minuten nat etsen. De droge ets was CF4 :O2 :He = 4:1:5, en de natte ets was HF (6%):H2 O2 (30%):CH3 COOH (99,8%) = 1:2:4
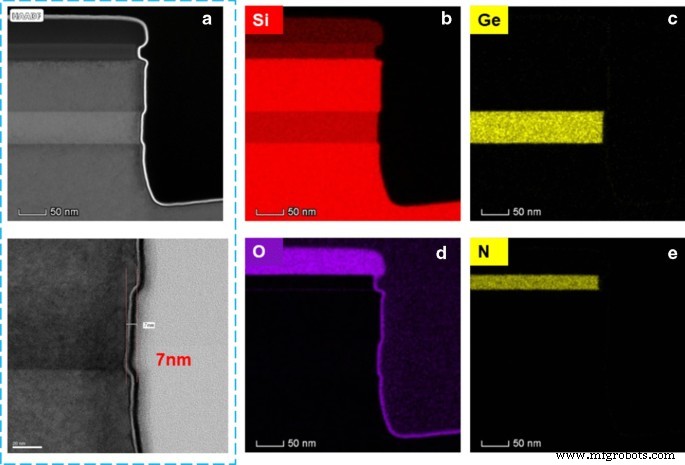
een TEM-afbeeldingen, b –e EDS-toewijzing van P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si in Fig. 6a met 11,5-s droge ets. De elementen in b is Si, in c is Ge, in d is O, en in e is N
Verdere analyses werden uitgevoerd om de stam te onderzoeken na etsstappen in monster-1 en monster-2. Afbeelding 8a-h toont (004) schommelcurven (RC's) van deze monsters als volgt:zoals gegroeid, na verticaal etsen en SiGe lateraal etsen met nat en droog etsen. In RC-analyse is de verbreding (volledige breedte-halfmaximum of FWHM) een indicator voor de defectdichtheid, en de positie van SiGe-piek in vergelijking met Si bepaalt de hoeveelheid rek in de laag. We benadrukken hier dat de piekverbreding ook kan komen door de dunne laagdikte. Daarom zal het moeilijk zijn om de bijdrage van defectdichtheid te onderscheiden van RC-analyse, maar we kunnen FWHM alleen in sommige uitbreidingen in deze analyses vergelijken. In deze RC's heeft monster-1 (Fig. 8a-d) een enkele SiGe-laag; ondertussen toont monster-2 (Fig. 8e-h) twee pieken die 7% en 22% Ge vertegenwoordigen. Voor As-grown monsters wordt een interferentie van de röntgenstraal waargenomen, die franjes van de diktelaag veroorzaakt. De opkomst van deze randen laat een SiGe/Si-interface van hoge kwaliteit zien. In RC's, van monster-1 en monster-2, is de Ge-piek verschoven naar de Si-substraatpiek, wat wijst op spanningsrelaxatie. Er is geen verdere verschuiving van de Ge-piek gedetecteerd na lateraal droog etsen van SiGe. Dit is een veelbelovend resultaat voor de prestaties van de transistor, aangezien de draaggolfmobiliteit in het kanaalgebied afhankelijk is van de belasting. Ondertussen is de spanning meer ontspannen voor de nat geëtste SiGe en is er meer verschuiving naar de substraatpiek waargenomen. Dit toont aan dat de natte ets niet geschikt is voor de laterale SiGe-ets, waardoor de kanaallaag wordt gevormd.
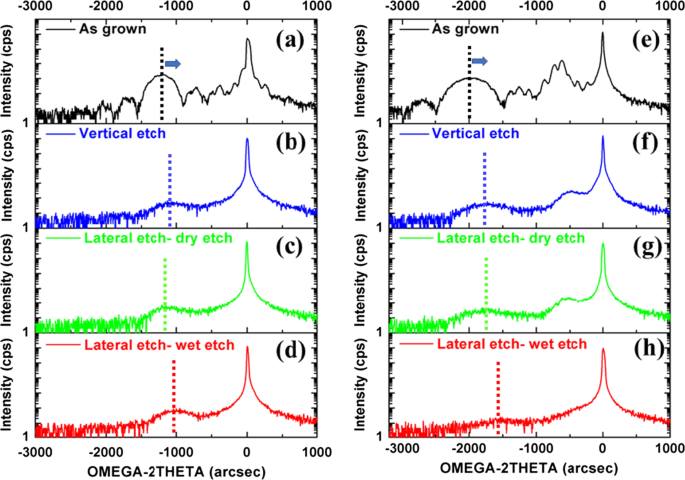
HRXRD schommelcurve rond (004) reflectie van monster-1, P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si ML's met een afstandslaag van 5 nm in a –d , en monster-2, P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 ML's in e –u . Beide monsters hebben vier panelen:zoals gegroeid, na verticaal etsen, SiGe lateraal nat etsen van HF (6%)/H2 O2 (30%)/CH3 COOH (99,8%) 20 min, en lateraal droog etsen van CF4 /O2 /Hij 11,5 s
Verdere röntgenanalyses werden uitgevoerd om meer informatie te krijgen over de defectdichtheid in de monsters in Fig. 9a-h. HRRLM's, die zijn gebaseerd op tweedimensionale metingen, werden hier uitgevoerd zoals weergegeven in Fig. 9a-h. De indicator voor de defectdichtheid in HRRLM's is de verbreding van de SiGe-laag langs de ω-richting (ω is de invallende bundelhoek). De positie van Si- en SiGe-pieken geeft de stamcomponenten parallel en loodrecht op de groeirichting. In monster-1 en monster-2 vertonen de als gegroeide SiGe-lagen een kleine ω-verbreding, en de laag is uitgelijnd met het Si en toont volledig gespannen SiGe-lagen (zie figuur 9a, e). Figuur 9b toont het monster na de verticale ets, de SiGe-piek is op een vergelijkbare manier naar het Si-substraat verschoven in RC-resultaten in figuur 8b, wat wijst op spanningsrelaxatie. Maar verrassend genoeg vertoont het laterale drooggeëtste monster (figuur 9c) een duidelijke ω-verbreding van SiGe-piek samen met een verschuiving in de reciproke ruimte, die in de richting van de uitlijning met de Si-piek is. Het nat geëtste monster (in figuur 9d) is echter volledig uitgelijnd en heeft een laagintensiteit die lager is dan het droog geëtste monster (in figuur 9c). In dit geval wordt verwacht dat de gegenereerde defecten een verschillende oorsprong hebben in deze monsters, aangezien de aard van het etsproces anders is. Sample-2 bevat twee SiGe-lagen; de Si0.93 Ge0,07 piek wordt overleefd na etsen in zowel verticale als laterale richting, terwijl Si0,78 Ge0.22 is verdwenen na verticaal etsen en toont volledige spanningsrelaxatie (Fig. 8f-h). De slechte processtabiliteit van monster-2 kan worden veroorzaakt door P-doping, wat de vorming van misfit-dislocaties bevordert.

HRRLM's van P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si ML's met 5 nm spacerlaag (sample-1) in a –d , en P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 ML's (voorbeeld-2) in e –u . De twee afbeeldingen hebben beide vier panelen:zoals gegroeid, na verticaal etsen, lateraal nat etsen van HF (6%)/H2 O2 (30%)/CH3 COOH (99,8%) 20 min, en lateraal droog etsen van CF4 /O2 /Hij 11,5 s
Conclusies
In dit werk is de epitaxie van P-gedoteerde Si/SiGe/P-gedoteerde Si ML's samen met het etsen van deze ML's als initiële structuren voor vGAAFET onderzocht. Eerst werd de incorporatie van P in Si/SiGe/Si MLs bestudeerd. Er zijn verschillende strategieën voorgesteld voor de epitaxie en ML-structuur om de P-gescheiden piek op het grensvlak van Si/SiGe-heterostructuur te elimineren. Uit experimenten kan het invoegen van een niet-gedoteerde afstandslaag de P-piek verlagen. Waterstofzuivering om de overtollige P-atomen te verwijderen was niet erg nuttig en stabiele PP-dimeren konden niet volledig worden verwijderd. SiH4 . vervangen met SiH2 Cl2 als Si-voorloper om Cl-chemie tijdens de groei te introduceren, verminderde de gescheiden P-piek opmerkelijk vanwege Cl-actieve oppervlaktereacties. De impact van Si0.93 Ge0,07 spacerlagen na P-gedoteerde Si werden ook onderzocht. De resultaten toonden aan dat de P-piek op het SiGe-interface verdween, terwijl de P-opname in deze lagen met een ordegrootte verbeterde. In het tweede deel van deze studie werd de verticale ets van Si/SiGe/Si ML uitgevoerd om NW's te vormen, en later, in deze NW's, werd de SiGe selectief nat of droog geëtst. Het nat etsen was gevoelig voor doteringsconcentratie; ondertussen was droog etsen gevoelig voor het Ge-gehalte. Droog etsen was meer geschikt voor n-type structuren met uniform etsprofiel en hogere selectiviteit. Voor P-gedoteerde Si/Si0,86 Ge0,14 /P-gedoteerde Si ML's, de selectiviteit was 5,8 bij droog etsen en 4,2 voor nat etsen. De selectiviteit van P-gedoteerde Si0.93 Ge0,07 /Si0,78 Ge0.22 /P-gedoteerde Si0,93 Ge0,07 MLs was 6.3 with dry etch and 2.5 with wet etch. The strain in SiGe was mostly preserved in Si/SiGe/Si after vertical and lateral etch; meanwhile, this strain in MLs with introduced Si0.93 Ge0.07 spacer layer had poor stability after etch process.
Beschikbaarheid van gegevens en materialen
The authors declare that the data supporting the findings of this study are available within the article.
Afkortingen
- vGAAFET:
-
Vertical gate-all-around field-effect transistors
- ML:
-
Multilayer
- CMOS:
-
Complementaire metaaloxide halfgeleider
- MBE:
-
Moleculaire bundelepitaxie
- RPCVD:
-
Reduced pressure chemical vapor deposition
- RTCVD:
-
Rapid thermal chemical vapor deposition
- S/D:
-
Source/drain
- HRTEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- HRXRD:
-
Röntgendiffractie met hoge resolutie
- HRRLM:
-
High-resolution reciprocal lattice map
- SEM:
-
Scanning elektronenmicroscopie
- SIMS:
-
Secundaire ionenmassaspectroscopie
- RC:
-
Rocking curve
- FWHM:
-
Full-width-half-maximum
- HM:
-
Hardmask
Nanomaterialen
- Applicatieprestaties beter maken voor gebruikers en klanten bij CyrusOne
- Air spacers voor 10nm chips
- Directe groei van vederachtige ZnO-structuren door een eenvoudige oplossingstechniek voor fotodetectietoepassingen
- Evaluatie van grafeen/WO3 en grafeen/CeO x-structuren als elektroden voor supercondensatortoepassingen
- Een hervatbare fluorescerende sonde BHN-Fe3O4@SiO2 hybride nanostructuur voor Fe3+ en de toepassing ervan in bioimaging
- Oppervlaktenanostructuren gevormd door fasescheiding van metaalzout-polymeer nanocomposietfilm voor antireflectie en superhydrofobe toepassingen
- Een type robotlasproces en apparatuur kiezen voor uw toepassing
- Bedrijven zetten zich schrap voor de grote technische veranderingen en uitdagingen van 2019
- Verticale draaibank voor giet-, smeed- en draaitoepassingen
- Verticale draaibank voor giet-, smeed- en draaitoepassingen(2)
- VMC Machinery voor productie en efficiëntie



