De stroomspreiding verbeteren door het dopingtype in de n-AlGaN-laag lokaal te moduleren voor op AlGaN gebaseerde diepe ultraviolette lichtgevende dioden
Abstract
In dit rapport moduleren we lokaal het dopingtype in de n -AlGaN-laag door een n-AlGaN/p-AlGaN/n-AlGaN (NPN-AlGaN)-gestructureerde stroomspreidende laag voor op AlGaN gebaseerde diepe ultraviolette lichtgevende diodes (DUV-LED's) voor te stellen. Na het inbrengen van een dunne p-AlGaN-laag in de n-AlGaN-elektronenleverancierslaag, kan een geleidingsbandbarrière worden gegenereerd in de n -type elektronenleverancierslaag, die de modulatie van de laterale stroomverdeling in de p-type gatenleverancierslaag voor DUV-LED's mogelijk maakt. Bovendien blijken volgens onze studies de Mg-dopingconcentratie, de dikte, de AlN-samenstelling voor de p-AlGaN-insertielaag en het NPN-AlGaN-junctienummer een grote invloed te hebben op het stroomspreidingseffect. Een goed ontworpen NPN-AlGaN-stroomspreidingslaag kan het optische uitgangsvermogen, de externe kwantumefficiëntie (EQE) en de wall-plug-efficiëntie (WPE) voor DUV-leds verbeteren.
Inleiding
Vanwege verschillende toepassingen zoals desinfectie, waterzuivering, medische behandeling en optische opname met hoge dichtheid [1,2,3,4,5,6,7,8], is er intensief geïnvesteerd in de ontwikkeling van zeer efficiënt AlGaN- op basis van diepe ultraviolette lichtgevende diodes (DUV-LED's). In het huidige stadium is opmerkelijke vooruitgang geboekt om de kristallijne kwaliteit voor Al-rijke AlGaN-films te verbeteren, bijv. het kweken van AlN-films op saffiersubstraten met nanopatroon door grafeen-geassisteerde quasi-Van der Waals-epitaxie kan de spanning aanzienlijk verminderen en verminderen de dislocatiedichtheid [9], die de interne kwantumefficiëntie (IQE) van 80% aangeeft [10]. Het is vermeldenswaard dat een dergelijk IQE wordt gemeten met behulp van de fotoluminescentiemethode bij lage temperatuur, waarbij geen dragerinjectie betrokken is. DUV-LED's worden echter aangedreven door elektrische voorspanning, die wordt geassocieerd met stroomstroming en vervoerdertransport [11,12,13]. Een ander zeer belangrijk aspect met betrekking tot de stroomstroom is het stroomverdringingseffect, dat gemakkelijk plaatsvindt wanneer het apparaat is vooringenomen op een zeer hoog stroomniveau [14]. DUV-LED's hebben een zeer inferieure Mg-doteringsefficiëntie in de p-AlGaN-laag met een hoge AlN-component [15, 16], wat leidt tot een lage elektrische geleidbaarheid. Bovendien nemen DUV-LED's de flip-chip-structuren over die het laterale injectieschema voor de stroom bevatten. Vandaar dat, in vergelijking met op InGaN/GaN gebaseerde UV, blauwe en groene LED's, op AlGaN gebaseerde DUV-LED's meer worden uitgedaagd door het huidige crowding-effect [17]. Het optreden van het huidige crowding-effect, hetzij aan de p-contactelektrode of aan de mesa-rand, leidt tot ongelijke elektroluminescentie-intensiteit in de meervoudige kwantumputten (MQW's) en de verhoogde junctietemperatuur [18]. Daarom is het inderdaad cruciaal om de laterale stroomspreiding voor DUV-leds te bevorderen. Voor dat doel maakt de voorgestelde p-type elektrode met smalle meervoudige strip een gelijkmatig verdeelde stroomspreiding mogelijk, waardoor de wall-plug-efficiëntie (WPE) met 60% wordt verhoogd [19]. Bovendien kan de ITO/ZGO (ZnGaO) stroomspreidingslaag de stroom beter verspreiden en de externe kwantumefficiëntie (EQE) verbeteren, maar de verhoogde grensvlakweerstand bij de ZGO/p-GaN-interfaces maakt de WPE minder verbeterd voor DUV-LED's [20] .
Daarom wordt in het huidige stadium onderzoeksaandacht besteed aan de p-kant om de stroomspreiding voor DUV-leds te vergemakkelijken. In dit werk, anders dan bij andere benaderingen, stellen we voor en bewijzen we dat de verbeterde stroomverdeling in de p-type gatenleverancierslaag voor DUV-LED's kan worden bereikt door de n-AlGaN-elektronenleverancierslaag te construeren. De energiebarrière wordt gegenereerd in de geleidingsband door het doteringstype in de elektronenleverancierslaag te moduleren, d.w.z. de n-AlGaN/p-AlGaN/n-AlGaN (NPN-AlGaN) structuur wordt voorgesteld en parametrisch bestudeerd. Onze resultaten laten zien dat de laterale verdeling voor de gaten kan worden gehomogeniseerd door gebruik te maken van de NPN-AlGaN-junctie, wat daarom het optische uitgangsvermogen, de externe kwantumefficiëntie en de efficiëntie van de muurplug voor DUV-LED's verbetert. Een ander voordeel van ons ontwerp is dat, vanuit het oogpunt van epitaxiale groei, het hebben van de huidige verspreidingslaag in de n-type elektronenleverancierslaag de epi-telers meer vrijheid geeft bij het optimaliseren van de groeiomstandigheden.
Onderzoeksmethoden en natuurkundige modellen
De NPN-AlGaN DUV LED-structuren zijn schematisch getekend in Fig. 1a. In elke bestudeerde DUV-LED hebben we een 4 μm dikke n-Al0.60 Ga0,40 N/p-Alx Ga1−x N/n-Al0.60 Ga0,40 N-laag en de Si-doteringsconcentratie van de n-Al0.60 Ga0,40 Regio N is 5 × 10 18 cm −3 . Dan vijf paar Al0,45 Ga0,55 N/Al0,56 Ga0,44 N meerdere quantum well (MQW) actieve lagen zijn ontworpen, waarvoor de diktes van quantum wells en quantum barrières respectievelijk 3 nm en 12 nm zijn. De MQW's worden afgedekt door een 18 nm dikke Mg-gedoteerde p-Al0,60 Ga0,40 N-laag die dienst doet als p-EBL, waarna een 50 nm dikke Mg-gedoteerde p-Al0.40 Ga0.60 N-laag en een 50 nm dikke Mg-gedoteerde p-GaN-laag volgen. De gatenconcentratie voor de p-EBL en de gatenleverancierslagen zijn ingesteld op 3 × 10 17 cm −3 . We ontwerpen de apparaatgeometrie met een rechthoekige mesa van 350 × 350 μm 2 . Figuur 1b toont de schematische geleidingsbandprofielen wanneer twee NPN-AlGaN-juncties (dwz NPNPN-AlGaN-structuur) worden gebruikt in de DUV LED-structuur, en we kunnen de energiebarrières zien die bestaan in de uitgeputte p-Al x Ga1−x N regio's. De energiebarrières kunnen de horizontale stroomverdeling in de p-type gatenleverancierslaag aanpassen. Let op:om de stroom door de omgekeerd voorgespannen n-AlGaN/p-AlGaN-junctie te garanderen, is het erg belangrijk dat de p-AGaN-invoeglaag volledig leeg is, zodat de NPN-AlGaN-junctie zich in een doorbraakmodus bevindt [21]. Gedetailleerde analyse en discussies zullen later worden gepresenteerd. Onze referentie DUV LED is identiek aan de NPN-AlGaN DUV LED's behalve dat de 4-μm dikke Si-gedoteerde n-Al0.60 Ga0,40 N-laag wordt gebruikt als de elektronenleverancierslaag.
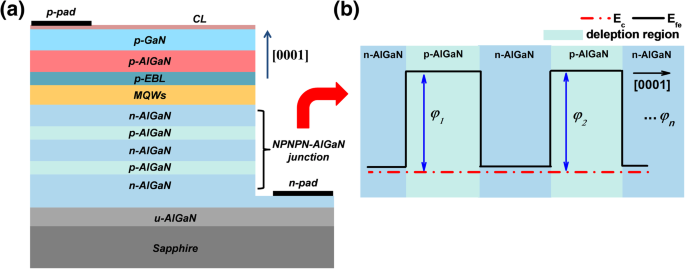
een Schematische structuren voor de NPN-AlGaN LED. b Schematisch geleidingsbandprofiel voor de NPNPN-AlGaN-structuur met twee NPN-AlGaN-juncties; we definiëren de barrièrehoogten voor elke NPN-AlGaN-junctie als φ 1 , φ 2 , en φ n , en n is het aantal NPN-AlGaN-juncties
Om het fysieke mechanisme voor het verbeterde stroomspreidingseffect dat mogelijk wordt gemaakt door de NPN-AlGaN-junctie beter te begrijpen, wordt een equivalent circuit voor de DUV-LED met een lateraal stroominjectieschema getoond in Fig. 2a. We kunnen zien dat de stroom langs zowel verticale als laterale richtingen van de p-type gatenleverancierslaag naar het n-AlGaN-gebied vloeit. Als de elektrische weerstand voor de n-AlGaN-elektronenleverancierslaag kleiner is dan die voor de stroomverspreidende laag (CL), heeft de stroom de neiging zich te verdringen in het gebied onder het p-type ohmse contact, dwz I 1> Ik 2> Ik 3> …> Ik n [14]. De opname van NPN-AlGaN-juncties in de DUV LED-structuur kan het destructieve stroomverdringingseffect onderdrukken. Vervolgens vereenvoudigen we de stroompaden voor de NPN-AlGaN DUV LED in Fig. 2b verder, zodat de totale stroom kan worden verdeeld in een verticaal deel (I 1 ) en een horizontaal gedeelte (I 2 ) vanaf punt A naar punt B . Daarom wordt de totale spanning tussen de twee punten gedeeld door de stroomspreidingslaag, de p-GaN-laag, de p-AlGaN-laag, de MQW's, de NPN-AlGaN-overgangen en de n-AlGaN-laag. Gebaseerd op de huidige paden van I 1 en ik 2 , Verg. 1 en 2 worden respectievelijk verkregen en door de vorige twee formules op te lossen, Vgl. 3 wordt dan afgeleid:
$$ {I}_1{R}_{\mathrm{CL}-\mathrm{V}}+{I}_1{R}_X+{I}_1\bullet N\bullet {R}_{npn}+{ I}_1\left({R}_{n-\mathrm{V}}+{R}_{nL}\right)={U}_{\mathrm{AB}}, $$ (1) $$ {I}_2\left({R}_{\mathrm{CL}-\mathrm{L}}+{R}_{\mathrm{CL}-\mathrm{V}}\right)+{I}_2 {R}_X+{I}_2\bullet N\bullet {R}_{npn}+{I}_2{R}_{n-\mathrm{V}}={U}_{\mathrm{AB}} , $$ (2) $$ \frac{I_1}{I_2}=1+\frac{R_{\mathrm{CL}-\mathrm{L}}-{R}_{n-\mathrm{L}} }{R_{\mathrm{CL}-\mathrm{V}}+{R}_X+{R}_n+N\bullet {R}_{npn}} $$ (3)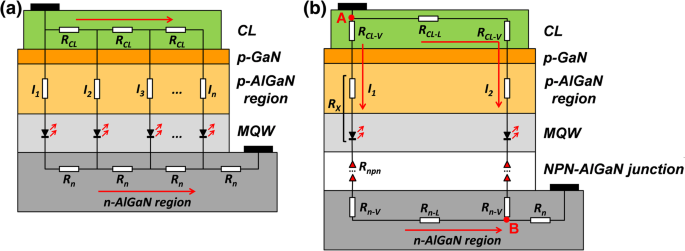
een DUV LED's met lateraal stroominjectieschema equivalent circuit (I 1> Ik 2> Ik 3> ……> Ik n ). b NPN-AlGaN-gestructureerde DUV LED vereenvoudigd equivalent circuit en stroompaden I 1 en ik 2 worden tentoongesteld
waar R CL−V en R CL−L zijn respectievelijk de verticale en horizontale weerstanden voor de huidige strooilaag; R n −V en R n −L geef respectievelijk de verticale en horizontale weerstanden voor de n-AlGaN-laag aan; R n is de som van R n −V en R n −L (d.w.z. R n =R n −V + R n −L ) voor het huidige pad I 1; de som van de weerstand voor het p-type gatinjectiegebied en het MQW-gebied wordt weergegeven door R x ; R npn is de grensvlakweerstand die wordt veroorzaakt door de barrièrehoogte in elke NPN-AlGaN-junctie; N betekent het totale aantal voor de NPN-AlGaN-junctie en de totale spanningsval tussen punten A en B wordt beschreven door U AB . Het is vermeldenswaard dat de 200 nm dikke stroomverspreidingslaag veel dunner is dan de 4 μm dikke n-AlGaN-elektronenleverancierslaag voor alle bestudeerde apparaten. Daarom wordt een CL verkregen waarvan de elektrische weerstand veel groter is dan die voor de n-AlGaN-laag, d.w.z. R CL−L − R n −L ≫ 0. Het is duidelijk dat de verhouding van I 1 /Ik 2 kan worden verminderd door N . te maken × R npn waardeverhoging. Daarom kan het stroomspreidingseffect in de p-type gatenleverancierslaag worden verbeterd door gebruik te maken van de NPN-AlGaN-junctie in de n-type elektronenleverancierslaag voor DUV LED-structuren. Aan de ene kant de N × R npn waarde kan worden verhoogd door N . te verhogen . Anderzijds is de waarde van R npn wordt beïnvloed door de AlN-component, de dikte en de Mg-doteringsconcentratie voor de p-AlGaN-insertielaag. Daarom zal in de volgende discussies een gedetailleerde analyse worden uitgevoerd.
Crosslight APSYS-simulator wordt gebruikt om de apparaatfysica te onderzoeken, en de modellen die we gebruiken zijn betrouwbaar volgens onze eerdere publicaties over blauwe, UVA- en DUV-nitride-gebaseerde LED's [22,23,24]. In onze fysieke modellen is de energieband-offsetverhouding voor de AlGaN/AlGaN-heterojunctie 50:50 [25]. De Auger-recombinatiecoëfficiënt, de Shockley-Read-Hall (SRH)-recombinatielevensduur en de lichtextractie-efficiëntie zijn ingesteld op 1,0 × 10 −30 cm 6 /s [26], 10 ns [27] en ~ 8% [28] voor respectievelijk DUV-LED's. De polarisatie-geïnduceerde interfaceladingen op het rooster-niet-overeenkomende interface worden beschouwd door uit te gaan van het polarisatieniveau van 40% [29].
Resultaten en discussies
Invloed van de NPN-AlGaN-structuur op het stroomspreidingseffect voor DUV-leds
LED A (dwz de referentie-DUV-LED zonder NPN-AlGaN-junctie) en LED B (dwz de DUV-LED met NPN-AlGaN-junctie) zijn eerst onderzocht om de invloed van de NPN-AlGaN-structuur op het homogeniseren van de stroom voor de p-type gatenleverancierslaag. Elke NPN-AlGaN-junctie heeft een 20 nm dikke p-Al0.60 Ga0,40 N insertielaag, waarvoor de Mg-dopingconcentratie 1 × 10 18 . is cm −3 . Figuur 3a toont het energiebandprofiel bij een stroomdichtheid van 170 A/cm 2 voor LED B. Twee energiebarrières in de geleidingsband worden gevormd in de NPN-AlGaN-juncties, en de vorming van de energiebarrière wordt goed toegeschreven aan het uitputtingseffect van het ingevoegde p-Al0,60 Ga0,40 N laag. De gegenereerde barrières in LED B induceren de grensvlakweerstand van R npn in het NPN-AlGaN-knooppuntgebied, wat helpt I . te verminderen 1 /Ik 2 zoals vermeld in vgl. 3, zodat er meer gaten langs het huidige pad zullen stromen I 2 . Vervolgens berekenen en tonen we de horizontale gatenconcentratie in de laatste kwantumput (LQW) voor LED's A en B wanneer de stroomdichtheid 170 A/cm is 2 , zoals weergegeven in Fig. 3b. We kunnen duidelijk zien dat LED B een betere laterale stroomspreiding verkrijgt in vergelijking met LED A. We bewijzen dus dat de NPN-AlGaN in de n-type elektronenleverancierslaag het stroomspreidingseffect in de p-type gatenleverancierslaag voor DUV-LED's.

een Energiebandprofiel voor LED B, waarin we de geleidingsband, quasi-Fermi-niveaus voor elektronen en gaten en de valentieband definiëren als E c , E fe , E fh , en E v , respectievelijk. b Horizontale gatenconcentratie in de LQW voor LED's A en B wanneer de stroomdichtheid 170 A/cm is 2
Naast het tonen van de laterale gatenconcentratie, demonstreren we ook de gatconcentratieniveaus in de MQW's voor LED's A en B in Fig. 4a. We kunnen zien dat, vanwege het verbeterde stroomspreidingseffect, de gatenconcentratie in de MQW's verbeterd is voor LED B in vergelijking met die voor LED A. Het verbeterde gatconcentratieniveau in de MQW's bevordert meer de stralingsrecombinatie voor LED B (zie Afb. 4b).
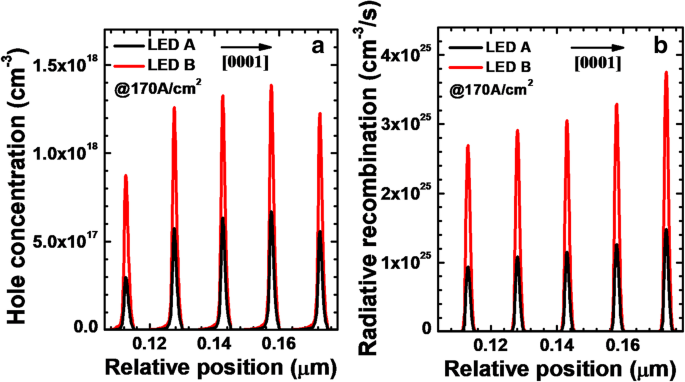
een Gatconcentratieniveaus en b stralingsrecombinatieprofielen in de MQW's voor respectievelijk LED's A en B. We verzamelen de gegevens op een locatie van 120 m verwijderd van de rechterrand van de mesa wanneer de stroomdichtheid 170 A/cm is 2
De impact van de NPN-AlGaN-junctie wordt ook gerechtvaardigd door de berekende optische en elektrische prestaties voor LED's A en B zoals weergegeven in Fig. 5. Figuur 5a toont de EQE en de optische vermogensdichtheid als functie van de geïnjecteerde stroom voor beide LED's A en B. We kunnen zien dat LED B zowel een hogere EQE als optische vermogensdichtheid heeft dan LED A, dankzij het verbeterde stroomspreidingseffect en gatinjectie-efficiëntie mogelijk gemaakt door de NPN-AlGaN-junctie. De verbetering van de optische vermogensdichtheid voor LED B is bijvoorbeeld ~-1,67% wanneer de stroomdichtheid 170 A/cm is 2 volgens Fig. 5a. Onderzoeken in Fig. 5b illustreren dat de voorwaartse spanning voor LED B met NPN-AlGaN-junctie een lichte stijging heeft in vergelijking met die voor LED A. We schrijven dit fenomeen toe aan de energiebarrières in de uitputtingsgebieden die worden veroorzaakt door de NPN-AlGaN kruispunten. Gelukkig heeft de hogere voorwaartse spanning van LED B geen nadelig effect op de efficiëntie van de wandplug (WPE), en de WPE voor LED B overschrijdt die voor LED A wanneer de injectiestroomdichtheid groter is dan ~ 56 A/cm 2 zoals getoond in Fig. 5c. We zijn van mening dat zowel verbeterde EQE als WPE kunnen worden gerealiseerd zodra de NPN-AlGaN-junctie kan worden geoptimaliseerd, wat als volgt volledig zal worden onderzocht.
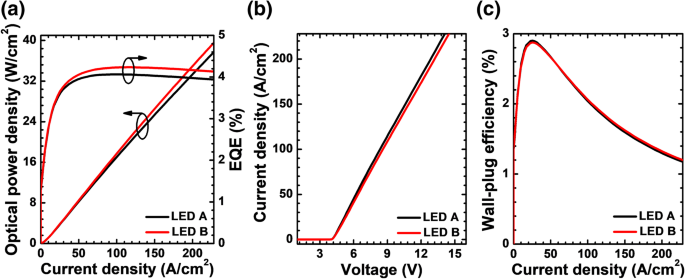
een EQE en optische vermogensdichtheid in termen van de injectiestroom, b stroom-spanningskarakteristiek, en c WPE als functie van de injectiestroom voor LED's A en B
Effect van de AlN-samenstelling voor p-AlGaN-laag op het huidige spreidingseffect
In deze sectie wordt de impact bestudeerd van de AlN-samenstelling voor de NPN-AlGaN-junctie op de optische en elektrische eigenschappen voor DUV-leds. Om dit mechanisme duidelijk te illustreren, gebruiken we vijf DUV-LED's, d.w.z. LED's Ci (ik =1, 2, 3, 4 en 5) met verschillende NPN-Alx Ga1−x N-overgangen, waarvoor de AlN-samenstellingen voor p-Alx Ga1−x N invoeglagen zijn respectievelijk 0,60, 0,63, 0,66, 0,69 en 0,72. De doteringsconcentratie en dikte voor de p-Alx Ga1−x N lagen zijn 1,8 × 10 18 cm −3 en 20 nm, respectievelijk. Voor alle onderzochte apparaten worden twee NPN-AlGaN-juncties gebruikt, d.w.z. NPNPN-AlGaN-junctie. Vervolgens berekenen we de hoogte van de geleidingsbandbarrière voor elke NPN-Alx Ga1−x N-splitsing voor LED's Ci (ik =1, 2, 3, 4 en 5) zoals weergegeven in Tabel 1. Het is duidelijk te zien dat de waarde van de geleidingsbarrièrehoogte toeneemt naarmate de AlN-samenstelling voor de p-Alx Ga1−x N invoeglaag neemt toe. Hoge geleidingsbarrièrehoogte kan de waarde van R . maken npn toename en een verlaagde verhouding van I 1 /Ik 2 wordt tegelijkertijd geactiveerd zoals vermeld in Vgl. 3. Om dat punt te bewijzen, de laterale gatenverdelingen in de laatste kwantumput voor alle bestudeerde apparaten wanneer de stroomdichtheid 170 A/cm is 2 worden berekend en weergegeven in figuur 6a. Voor LED C1 kan de gatenverdeling worden gemoduleerd na de NPN-Al0.60 Ga0,40 De N-structuur wordt aangenomen en het is duidelijk dat het huidige spreidingseffect verder wordt verbeterd zodra de AlN-component van de p-AlGaN-invoeglaag toeneemt tot 0,63 voor onze structuren.
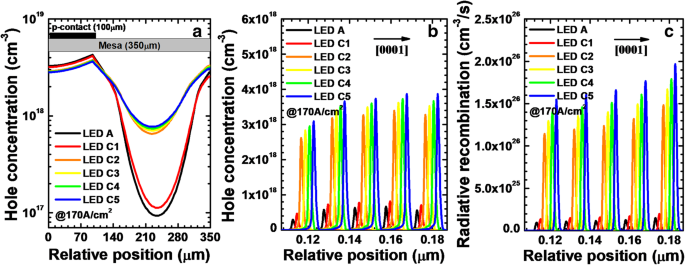
een Horizontale gatenconcentratie in de LQW, b gatenconcentratieniveaus, en c stralingsrecombinatieprofielen in de MQW's voor LED's A en Di (ik =1, 2, 3, 4 en 5) wanneer de stroomdichtheid 170 A/cm is 2 . We verschuiven doelbewust de curven voor b en c met 2 nm voor eenvoudigere identificatie
We demonstreren de gesimuleerde gatenconcentratieniveaus en stralingsrecombinatieprofielen in de MQW's voor LED's A en Ci (ik =1, 2, 3, 4 en 5) in Fig. 6b en c wanneer de stroomdichtheid 170 A/cm is 2 , respectievelijk. De gatenconcentratieniveaus en stralingsrecombinatieprofielen worden verzameld op de locatie van 120 m verwijderd van de rechterrand van de mesa. We verschuiven ruimtelijk de gatenconcentratieniveaus en stralingsrecombinatieprofielen in Fig. 6b en c voor de onderzochte DUV-LED's met respectievelijk 2 nm voor een gemakkelijkere identificatie. De laagste gatenconcentratie in de MQW's wordt duidelijk waargenomen voor LED A, en dus wordt de laagste stralingsrecombinatie ook getoond in figuur 6c. De gatenconcentratie en stralingsrecombinatie in de MQW's nemen toe door de invoering van de NPN-AlGaN-junctie, en ze kunnen nog meer worden verhoogd met de toename van de AlN-samenstelling in de p-AlGaN-invoeglaag.
De optische vermogensdichtheid en EQE als functie van de injectiestroomdichtheid worden verder berekend en getoond voor de bestudeerde LED's in figuur 7a. Zoals te zien is in de afbeelding, nemen de EQE en optische vermogensdichtheid toe zodra de NPN-AlGaN-junctie is aangenomen. Bovendien kunnen de EQE en optische vermogensdichtheid verder worden bevorderd naarmate de AlN-samenstelling voor de p-AlGaN-insertielaag toeneemt. We dragen dit bij aan de meer homogene laterale gatenverdeling in de MQW's zoals weergegeven in figuur 6a. De stroom-spanningskarakteristieken voor LED's A en Ci (ik =1, 2, 3, 4 en 5) worden weergegeven in Fig. 7b. De voorwaartse spanning voor LED C1 vertoont een kleine toename in vergelijking met LED A, en LED C5 toont de grootste voorwaartse spanning. De inzetfiguur toont de voorwaartse spanning voor alle bestudeerde LED's wanneer de stroomdichtheid 170 A/cm is 2 . Het is opmerkelijk dat de voorwaartse spanning afneemt voor LED's C2, C3 en C4 in vergelijking met LED A. Hoewel de NPN-AlGaN-overgang de verticale weerstand voor DUV-LED's verhoogt, verbetert de meer uniforme dragerconcentratie langs de horizontale richting de horizontale geleidbaarheid, wat leidt tot een verminderde voorwaartse spanning. Het geeft aan dat het verbeterde stroomspreidingseffect kan helpen om de voorwaartse bedrijfsspanning voor DUV-LED's te verlagen, zolang de stroomspreidingslaag goed is ontworpen [30]. Ons ontwerp moduleert echter het stroompad door barrières te induceren, en daarom kan een te hoge barrièrehoogte de elektrische geleiding [21] opofferen, bijvoorbeeld LED C5.
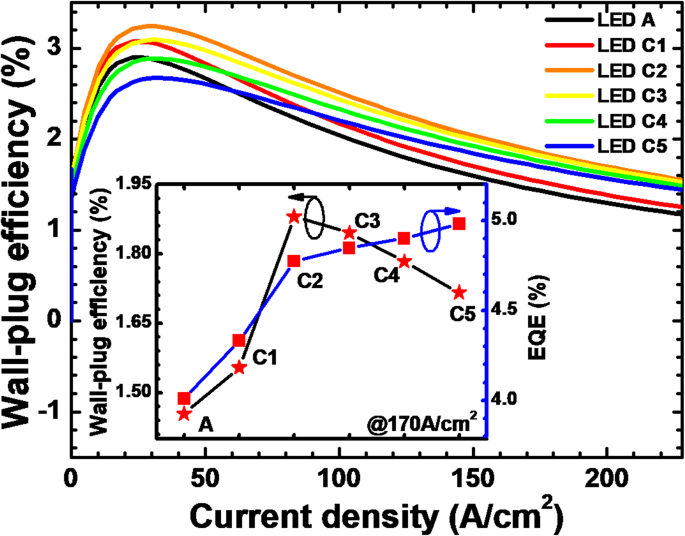
een EQE en optische vermogensdichtheid in termen van injectiestroom en b stroom-spanningskarakteristieken voor LED's A en Ci (ik =1, 2, 3, 4 en 5). Inzet:de voorwaartse spanningen voor LED's A en Ci (ik =1, 2, 3, 4 en 5) wanneer de stroomdichtheid 170 A/cm is 2
De WPE als functie van de injectiestroomdichtheid voor alle bestudeerde apparaten wordt getoond in Fig. 8. In vergelijking met LED A neemt de WPE van LED C1 toe zodra de NPN-AlGaN-junctie is aangenomen. WPE voor LED's Ci (ik =2, 3, 4 en 5) kan verder worden verbeterd wanneer de AlN-samenstelling van de p-AlGaN-laag toeneemt voor de NPN-AlGaN-overgang. LED C2 toont echter de hoogste WPE vanwege de laagste voorwaartse bedrijfsspanning ondanks de relatief lage optische vermogensdichtheid onder LED's Ci (ik =2, 3, 4 en 5). Daarnaast tonen we de WPE en EQE bij de injectiestroomdichtheid van 170 A/cm 2 voor alle onderzochte apparaten in de inzetfiguur. Het is bekend dat het stroomverdringingseffect ernstig is bij een hoge injectiestroomdichtheid. De NPN-AlGaN-junctie voor LED C5 speelt het beste in het homogeniseren van de stroom. De WPE is echter niet bevredigend als de voorwaartse bedrijfsspanning aanzienlijk toeneemt. Daarom moet men de waarde van de AlN-component van de p-AlGaN-invoeglaag voor de NPN-AlGaN-junctie volledig optimaliseren voordat men de verbetering voor zowel EQE als WPE kan krijgen.
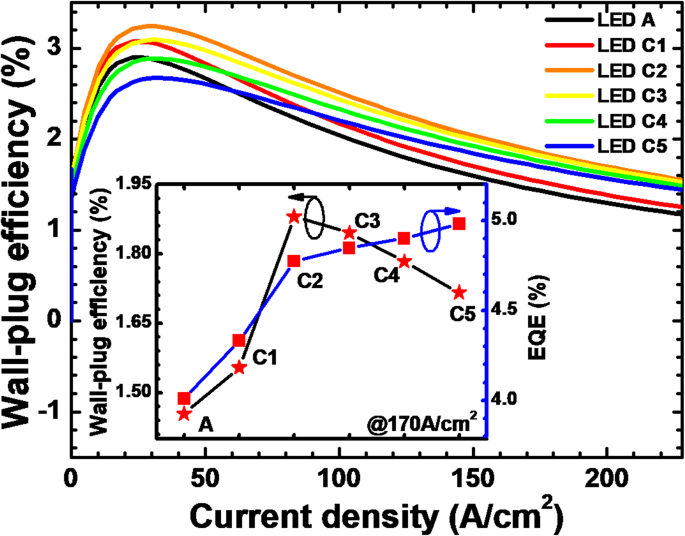
Relatie tussen WPE en de injectiestroom voor LED's A en Ci (ik =1, 2, 3, 4 en 5). Inzet:de EQE en WPE voor de onderzochte LED's gestructureerd met een p-AlGaN-laag met verschillende AlN-componenten bij een stroomdichtheid van 170 A/cm 2
Effect van de Mg-dopingconcentratie voor p-AlGaN-laag op het huidige verspreidingseffect
De breedte van het uitputtingsgebied voor de NPN-AlGaN-junctie kan worden beheerd door de Mg-dopingconcentratie voor de p-AlGaN-insertielaag te variëren, en de hoogte van de geleidingsbandbarrière zal dienovereenkomstig veranderen. Dus de waarde van R npn kan worden verhoogd zodra het uitputtingsgebied voor de NPN-AlGaN-junctie breed wordt, en de waarde van I 1 /Ik 2 wordt verminderd, d.w.z. het huidige spreidingseffect voor DUV-leds kan worden verbeterd. Om het punt beter te verduidelijken, zijn vijf DUV-LED's met verschillende Mg-dopingconcentraties voor de p-AlGaN-insertielaag in de NPN-AlGaN-junctie ontworpen en onderzocht. We hebben de Mg-dopingconcentraties voor de p-AlGaN-laag ingesteld op 3 × 10 17 , 7,5 × 10 17 , 1,7 × 10 18 , 2 × 10 18 , en 3 × 10 18 cm −3 voor LED's Di (ik =1, 2, 3, 4 en 5), respectievelijk. De dikte en de AlN-samenstelling voor de p-AlGaN-invoeglaag zijn respectievelijk 20 nm en 0,61. We gebruiken twee NPN-AlGaN-knooppunten. Zoals weergegeven in Tabel 2, wordt de barrièrehoogte van de geleidingsband groter naarmate de Mg-doteringsconcentratie voor de p-AlGaN-laag toeneemt. Vervolgens berekenen en tonen we de laterale gatenconcentratie in de laatste kwantumput wanneer de stroomdichtheid 170 A/cm is 2 in Fig. 9a, en het is duidelijk dat, vergeleken met de laterale gatenverdeling voor LED A, de laterale gatenverdeling uniformer wordt wanneer de NPN-AlGaN-overgang wordt geïntroduceerd voor DUV-LED's. Bovendien kan een nog meer gehomogeniseerde gatenverdeling worden verkregen als de Mg-doteringsconcentratie voor de p-AlGaN-laag in de NPN-AlGaN-overgang toeneemt.
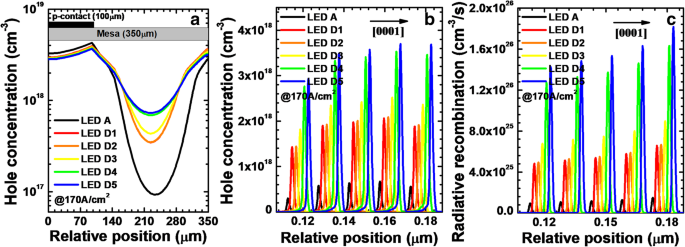
een Horizontale gatenconcentratie in de LQW, b gatenconcentratieniveaus, en c stralingsrecombinatieprofielen in de MQW's voor LED's A en Di (ik =1, 2, 3, 4 en 5) wanneer de stroomdichtheid 170 A/cm is 2 . We verschuiven doelbewust de curven voor b en c met 2 nm voor eenvoudigere identificatie
Vervolgens worden de berekende gatenconcentratieniveaus en stralingsrecombinatieprofielen in de MQW's gedemonstreerd voor alle bestudeerde LED's in Fig. 9b en c wanneer de stroomdichtheid 170 A/cm is 2 , respectievelijk, en de locatie waar de gegevens worden verzameld, is 120 m verwijderd van de rechter mesarand. Zoals verwacht, LED's Di (ik =1, 2, 3, 4 en 5) hebben de hogere gatenconcentratieniveaus en stralingsrecombinatieprofielen in de MQW's in vergelijking met LED A, terwijl de gatconcentratie en stralingsrecombinatie toenemen met de toenemende Mg-dopingconcentraties in de p-AlGaN-laag voor de LED's met NPN-AlGaN-juncties. We dragen de stijgende gatenconcentratie bij in de MQW's voor LED's Di (ik =1, 2, 3, 4 en 5) naar het verbeterde stroomspreidingseffect.
Vanwege het verminderde stroomverdringingseffect en de stijgende gatenconcentratie in de MQW's, LED's Di (ik =1, 2, 3, 4 en 5) tonen dienovereenkomstig de bevorderde EQE en optische vermogensdichtheid (zie in Fig. 10a). De stroom-spanningskarakteristieken voor LED's A en Di (ik =1, 2, 3, 4 en 5) worden geïllustreerd in Fig. 10b. Blijkbaar zijn de voorwaartse bedrijfsspanningen voor LED's Di (ik =1, 2, 3, 4 en 5) toenemen met de toenemende Mg-dopingconcentratie voor de p-AlGaN-invoeglaag. Van hen vertoont LED D5 de grootste inschakelspanning, en dit wordt toegeschreven aan de parasitaire diode die wordt veroorzaakt door de zeer hoge Mg-dopingconcentratie in de p-AlGaN-laag. Volgens de inzet van figuur 10b is ook te zien dat LED D5 de grootste voorwaartse bedrijfsspanning toont van alle bestudeerde LED's wanneer de injectiestroomdichtheid 170 A/cm is 2 .
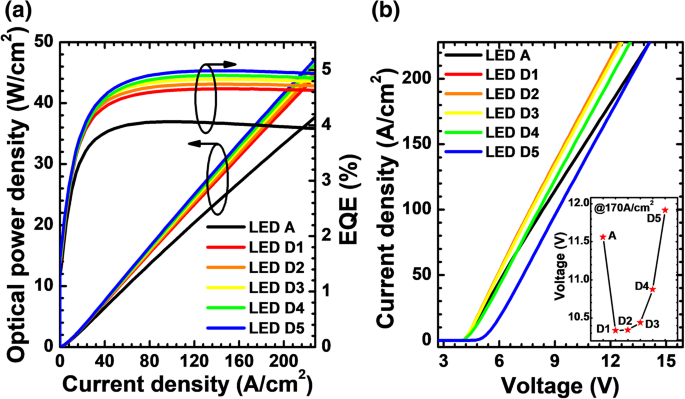
een EQE en optische vermogensdichtheid in termen van injectiestroom en b stroom-spanningskarakteristieken voor LED's A en Di (ik =1, 2, 3, 4 en 5). Inzet:de voorwaartse spanningen voor LED's A en Di (ik =1, 2, 3, 4 en 5) wanneer de stroomdichtheid 170 A/cm is 2
Voor een meer uitgebreide analyse berekenen we de WPE als functie van de injectiestroomdichtheid voor alle bestudeerde LED's zoals weergegeven in Fig. 11. De WPE's voor LED's Di (ik =1, 2, 3 en 4) zijn hoger dan die voor LED A. De WPE voor LED D5 overschrijdt die voor LED A alleen wanneer de injectiestroomdichtheid groter is dan 43 A/cm 2 . De lagere WPE voor LED D5 bij een stroomdichtheid kleiner dan 43 A/cm 2 is te wijten aan het extra voorwaartse spanningsverbruik op de NPN-AlGaN-junctie zoals eerder vermeld. Uit de bijgevoegde figuur is te zien dat de EQE een stijgende trend vertoont met de toename van de Mg-dopingconcentratie voor de p-AlGaN-laag. De WPE neemt echter af met de verdere toename van de Mg-doteringsconcentratie voor de p-AlGaN-laag. Daarom concluderen we dat het stroomspreidingseffect en de voorwaartse spanning erg gevoelig zijn voor het Mg-doteringsniveau van de p-AlGaN-insertielaag.
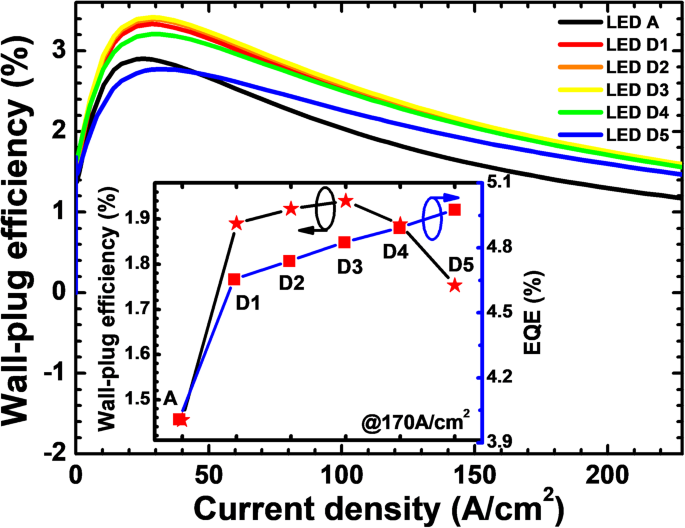
Relatie tussen WPE en de injectiestroom voor LED's A en Di (ik =1, 2, 3, 4 en 5). Inzet:de EQE en WPE voor de onderzochte LED's gestructureerd met een p-AlGaN-laag met verschillende dopingconcentraties bij een stroomdichtheid van 170 A/cm 2
Effect van de dikte voor p-AlGaN-laag op het huidige spreidingseffect
In deze sectie wordt de impact van de dikte van de p-AlGaN-invoeglaag in de NPN-AlGaN-junctie op de LED-prestaties onderzocht. Allereerst worden voor alle onderzochte DUV-leds twee NPN-AlGaN-juncties (dwz NPNPN-AlGaN-junctie) toegepast, waarvan de AlN-samenstelling en de doteringsconcentratie voor de p-AlGaN-laag in de NPN-AlGaN-junctie 0,61 en 1,5 zijn. × 10
18
cm
−3
, respectievelijk. Vervolgens stellen we verschillende diktes van 18, 20, 24, 28 en 32 nm in voor de p-AlGaN-laag in LED's Ti (ik =1, 2, 3, 4 en 5), respectievelijk. De berekende hoogten van de geleidingsbandbarrière voor elke NPN-AlGaN-junctie zijn weergegeven in Tabel 3. Het is te zien dat de barrièrehoogte van de geleidingsband toeneemt wanneer de p-AlGaN-laag in de NPN-AlGaN-junctie dik wordt, wat de reductie van
We berekenen en tonen de horizontale gatenconcentratie in de LQW voor LED's A en Ti (ik =1, 2, 3, 4 en 5) wanneer de stroomdichtheid 170 A/cm is 2 in afb. 12a. Clearly, the hole distribution becomes more homogeneous when the NPN-AlGaN junction is introduced in the DUV LED structure, and it becomes more uniform if the thickness for the p-AlGaN layer in the NPN-AlGaN junction gets larger. The reduced current crowding effect is ascribed to the higher conduction band barrier height in the depletion region caused by the thickened p-AlGaN layer in the NPN-AlGaN junction. Figure 12b and c exhibit the hole concentration levels and radiative recombination profiles, respectively, for LEDs A and Ti (ik =1, 2, 3, 4, and 5) at the injection current density of 170 A/cm 2 . The hole concentration levels and radiative recombination profiles are collected at the location of 120 μm away from the right-hand edge of the mesa. We can see that, when compared to that of LED A in the MQWs, LEDs Ti (ik =1, 2, 3, 4, and 5) show the higher hole concentration levels and thus higher radiative recombination profiles. Once the thickness of the p-AlGaN layer is increased, further enhanced hole concentration and radiative recombination in the MQWs can be obtained.
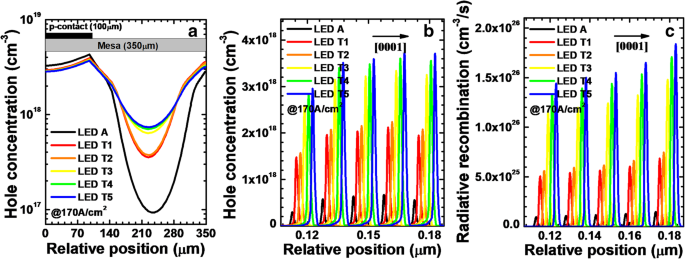
een Horizontal hole concentration in the LQW, b hole concentration levels, and c radiative recombination profiles in the MQWs for LEDs A and Ti (ik =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . We purposely shift the curves for b en c by 2 nm for easier identification
The observed optical power density and EQE for all studied LEDs in Fig. 13a agree well with the results shown in Fig. 12c, such that the increasing thickness for the p-AlGaN layer in the NPN-AlGaN junction can improve the optical power density and EQE. Moreover, we calculate and show the current-voltage characteristics for LEDs A and Ti (ik =1, 2, 3, 4, and 5) in Fig. 13b. It shows that the forward operating voltages for LEDs Ti (ik =1, 2, 3, and 4) exhibit a significant reduction when compared to that for LED A at the injection current density larger than 102 A/cm 2 , which is due to the significantly improved current spreading effect after adopting the NPN-Al0.61 Ga0.39 N junction as mentioned previously. However, a too thick p-AlGaN layer can cause an increase in the turn-on voltage owing to the parasitic N-AlGaN/P-AlGaN diode, e.g., LED T5 has the highest forward operating voltage among all the investigated LEDs when the current density is 170 A/cm 2 , which is also shown in the inset figure of Fig. 13b.
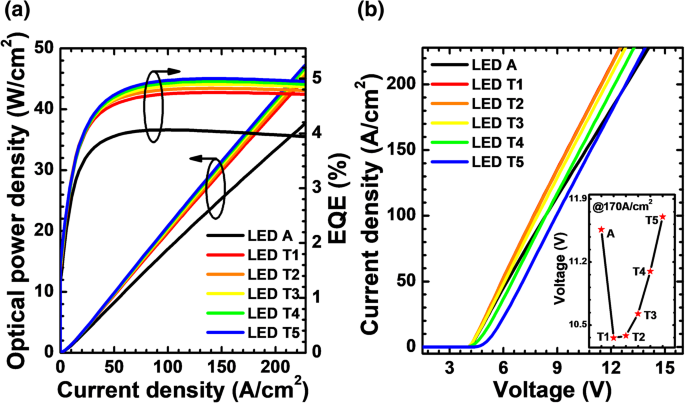
een EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ti (ik =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ti (ik =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
To this end, it is particularly important to further discuss the impact of higher forward operating voltage on DUV LED performance. Therefore, we calculate the WPE for all investigate devices and show the results in Fig. 14. We can see that the WPE for all LEDs with NPN-AlGaN junction exhibits distinct enhancement when compared to that for LED A. The presented WPEs in the inset figure also indicate that the NPN-AlGaN-structured DUV LED can save more electrical power than LED A. It is worth mentioning that the thickness for the p-AlGaN layer cannot be improved blindly, such that only when the thickness is properly set, then fully maximized WPE can be obtained.
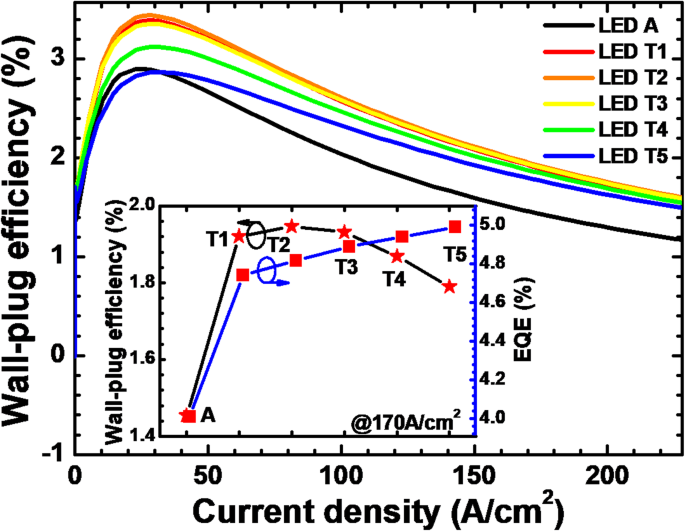
Relationship between WPE and the injection current for LEDs A and Ti (ik =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with a p-AlGaN layer with various thicknesses when the current density is 170 A/cm 2
Effect of the NPN-AlGaN Junction Number on the Current Spreading Effect
Finally, we investigate the influence of the NPN-AlGaN junction number on the current spreading effect. The p-Al0.61 Ga0.39 N layer is adopted in the NPN-AlGaN junction for the proposed DUV LEDs in this section, for which the Mg doping concentration and thickness are 1.5 × 10 18 cm −3 and 20 nm, respectively. LEDs Ni (ik =1, 2, 3, 4, and 5) have 1, 2, 3, 4, and 5 NPN-AlGaN junctions, respectively. As presented in Table 4, the conduction barrier heights of all NPN-AlGaN junctions are almost the same for LEDs Ni (ik =1, 2, 3, 4, and 5). However, the total conduction barrier height for NPN-Al0.61 Ga0.39 N junctions in each investigated DUV LED surely increases when more NPN-Al0.61 Ga0.39 N junctions are utilized. Thus, the value of N × R npn can be enhanced, which helps to better spread the current horizontally, i.e., the increased value of I 2 in verg. 3 is favored. The enhanced current spreading effect can be observed in Fig. 15a. The hole concentration in the LQW can become more uniform if the NPN-AlGaN junction number becomes more.
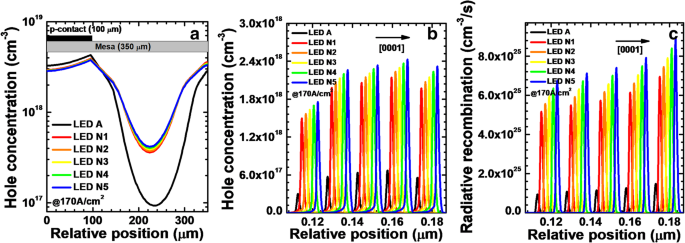
een Horizontal hole concentration in the LQW, b hole concentration, and c radiative recombination profiles in the MQWs for LEDs A and Ni (ik =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . We purposely shift the curves for b en c by 2 nm for easier identification
Then, the hole concentration levels and radiative recombination profiles in the MQWs for LEDs Ni (ik =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 are exhibited in Fig. 15b and c, respectively. We collect the hole concentration levels and radiative recombination profiles at the location of 120 μm away from the right-hand mesa edge. The hole concentration and radiative recombination are improved by using the NPN-Al0.61 Ga0.39 N junction, and further improvement can be obtained when more NPN-AlGaN junctions are included. Ascribed to the enhanced hole concentration in the MQWs, the optical power density and EQE for the DUV LEDs with NPN-AlGaN junction also shows a significant improvement. The current-voltage characteristics for all studied devices are shown in Fig. 16b, which illustrates that the forward operating voltages for LEDs Ni (ik =1, 2, 3, 4, and 5) are lower than that for LED A, and this indicates that the current spreading effect can help to reduce the forward voltage once the Mg doping concentration, thickness, and AlN composition for the p-AlGaN layer are appropriately applied to the NPN-AlGaN junction. The turn-on voltage for all LEDs with NPN-AlGaN junction is almost the same as that for LED A, which illustrates the negligible impact of the reversely biased N-AlGaN/P-AlGaN parasitic junction if the Mg doping concentration in the p-AlGaN layer is properly set, i.e., the p-AlGaN layer has to be completely depleted before the device is biased.
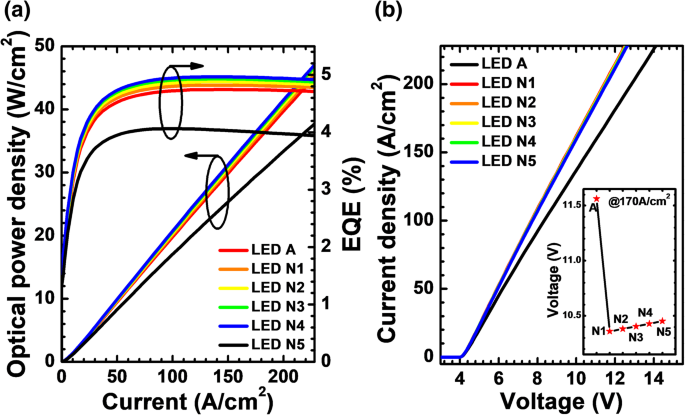
een EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ni (ik =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ni (ik =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
Last but not the least, the WPEs have also been demonstrated for LEDs Ni (ik =1, 2, 3, 4, and 5) in Fig. 17. The WPEs of all DUV LEDs with NPN-Al0.61 Ga0.39 N junction have been promoted owing to the reduced forward operating voltage. In the inset figure, we show the EQE and WPE for LEDs A and Ni (ik =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . Although the EQE and WPE for LEDs Ni (ik =1, 2, 3, 4, and 5) increase with the increasing of the NPN-AlGaN junction number, clearly, we can see that the magnitude of the increase is gradually decreasing, which indicates that the NPN-AlGaN junction number also shall be set to a proper number, and we firmly believe that the device will consume more electrical power if too many NPN-AlGaN junctions are adopted in DUV LEDs.
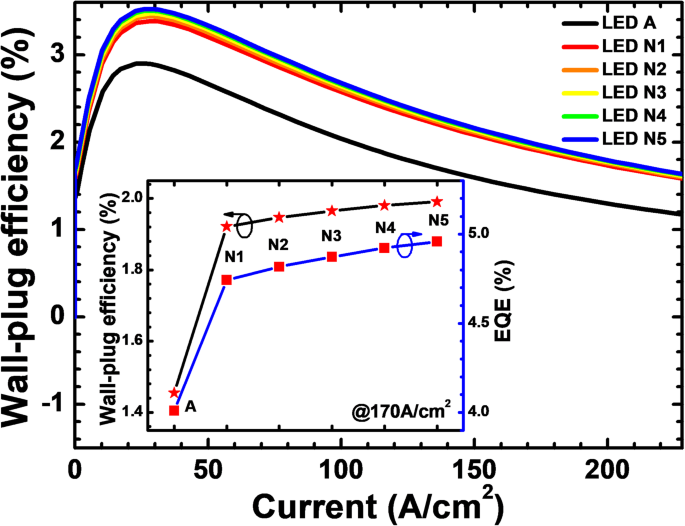
Relationship between WPE and the injection current for LEDs A and Ni (ik =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with various NPN-AlGaN number when the current density is 170 A/cm 2
Conclusies
To conclude, we have suggested embedding the NPN-AlGaN junction in the n-type electron supplier layer for DUV LEDs. After comprehensive and systematic discussions, we find that the NPN-AlGaN junction can reduce the current crowding effect in the p-type hole supplier layer and improve the hole injection for DUV LEDs. The NPN-AlGaN junction can tune the conductivity for the n-type electron supplier layer so that the current path in the p-type hole supplier layer can be manipulated. For further explorations, we have investigated the impact of different parameters for NPN-AlGaN junctions on the current spreading effect, the EQE, and the WPE. We find that the current can be further homogenized if the AlN composition, the Mg doping concentration, the thickness of the p-AlGaN insertion layer, and the NPN-AlGaN junction number are increased properly. Although the EQE can be promoted by using the proposed NPN-AlGaN junctions, the WPE is not always monotonically improving, which arises from the additional voltage drop at the barriers within the NPN-AlGaN junctions. Hence, more attention shall be made when designing NPN-AlGaN current spreading layers for DUV LEDs. However, we firmly believe that our results have provided an alternative design strategy to reduce the current crowding effect for DUV LEDs. Meanwhile, we also have introduced additional device physics and hence are very useful for the community.
Beschikbaarheid van gegevens en materialen
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
Afkortingen
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- CL:
-
Current spreading layer
- DUV LEDs:
-
Deep ultraviolet light-emitting diodes
- EQE:
-
Externe kwantumefficiëntie
- ITO:
-
Indiumtinoxide
- LQW:
-
Last quantum well
- MQW's:
-
Multiple quantum wells
- NPN-AlGaN:
-
n-AlGaN/p-AlGaN/n-AlGaN
- IQE:
-
Internal quantum efficiency
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Wall-plug efficiency
- ZGO:
-
Zinc gallate
Nanomaterialen
- De 4 primaire typen sleufschijven voor bevestigingsmiddelen
- Pleidooi voor neuromorfe chips voor AI-computing
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Groene synthese van InP/ZnS Core/Shell Quantum Dots voor toepassing in licht-emitterende diodes zonder zware metalen
- De optimale titaniumvoorloper voor het vervaardigen van een TiO2-compacte laag voor perovskietzonnecellen
- Bijna efficiëntie-Droop-Free AlGaN-gebaseerde ultraviolette lichtemitterende diodes met een speciaal ontworpen superrooster p-Type elektronenblokkerende laag voor hoge Mg-dopingefficiëntie
- Perovskiet light-emitting diodes met hoge luminantie met een alcoholoplosmiddel met hoge polariteit die PEDOT:PSS behandelen als gatentransportlaag
- Op de p-AlGaN/n-AlGaN/p-AlGaN Current Spreading Layer voor op AlGaN gebaseerde Deep Ultraviolet Light-Emitting Diodes
- Invloed van de breedte van de kwantumput op de elektroluminescentie-eigenschappen van AlGaN Deep Ultraviolet Light-Emitting Diodes bij verschillende temperaturen
- Integratie van milieuvriendelijke perovskieten voor zeer efficiënte witte lichtgevende diodes
- Effecten van meshed p-type contactstructuur op het lichtextractie-effect voor Deep Ultraviolet Flip-Chip Light-Emitting Diodes



