Verbeterde betrouwbaarheid van a-IGZO TFT's met een kleinere functiegrootte en een schone ets-stop-laagstructuur
Abstract
De effecten van diffuus Cu + in amorf indium-gallium-zink-oxide (a-IGZO) dunne-filmtransistoren (TFT's) op de microstructuur en prestaties tijdens een clean etch stopper (CL-ES) proces en een back channel etch (BCE) proces worden onderzocht en vergeleken . De CL-ES-laag gevormd met een schone component, zoals geverifieerd door TOF-SIMS, kan de a-IGZO-laag beschermen tegen het S/D-etsmiddel en Cu + voorkomen diffusie, wat helpt het aantal accepterachtige defecten te verminderen en de betrouwbaarheid van de TFT's te verbeteren. De gefabriceerde CL-ES-gestructureerde TFT's hebben een superieure uitvoerstabiliteit (laatste I ds /initial Ik ds = 82,2%) vergeleken met die van de BCE-gestructureerde TFT's (53,5%) omdat ze een betere initiële SS-waarde hebben (0,09 V/dec vs. 0,46 V/dec), en een betere uiteindelijke SS-waarde (0,16 V/dec vs 0.24 V/dec) na de evaluatie van hoge stroomspanning (HCS). Met name de variatie in de drempelspanningen heeft een groot verschil (3,5 V voor de CL-ES TFT's en 7,2 V voor de BCE TFT's), wat betekent dat de CL-ES-gestructureerde TFT's een hogere betrouwbaarheid hebben dan de BCE-gestructureerde TFT's. TFT's. Daarom wordt verwacht dat het CL-ES-proces de wijdverbreide toepassing van a-IGZO-technologie in de halfgeleiderindustrie zal bevorderen.
Achtergrond
Onlangs hebben displayproducten niet alleen de nadruk gelegd op grote oppervlakken en hoge resoluties, maar ook op esthetisch aantrekkelijke exterieurontwerpen [1,2,3]. Smalle randen zijn gebruikt als een van de essentiële kenmerken voor deze nadruk op het ontwerp [4]. Om dit te realiseren is het essentieel om de hoofdcircuits die het display aandrijven in het paneel te integreren. Gate drive IC on array (GOA) is een relatief eenvoudige en veelgebruikte methode, waarbij het poortsignaal de ene regel na de andere het paneel binnenkomt en de V aan beweegt elke keer opeenvolgend. GOA heeft meerdere voordelen, zoals lagere kosten (eliminatie van de G-IC-kosten, verwijdering van het G-IC-hechtingsproces, toegenomen gebruik van glassubstraat, enz.) en esthetisch effect (smalle randen of randloze apparaten) [5]. In tegenstelling tot individuele pixel-TFT's, vereisen GOA TFT's echter strengere betrouwbaarheidsvoorwaarden om een hogere uitgangsstroom en langere on-time prestaties te bereiken. Met de recent toenemende marktvraag naar producten met een hoge resolutie, is het verhogen van de betrouwbaarheid van de GOA-prestaties dringend en noodzakelijk geworden [6].
Amorf indium-gallium-zink-oxide (a-IGZO) wordt veel gebruikt in de beeldschermindustrie vanwege de hoge verzadigingselektronenmobiliteit (5~10 cm 2 /V s) en lage uit-stroom (< 1 pA) [7, 8]. De back channel etch-technologie (BCE) wordt vaak gebruikt voor de productie van TFT's in de industrie [9, 10]. BCE-gestructureerde a-IGZO TFT's hebben bevredigende eigenschappen voor individuele pixel TFT's en de verkleining van GOA TFT's. Sommige belangrijke TFT-kenmerken, met name de stabiliteit van de uitgangsstroom, kunnen echter niet voldoen aan de omgeving met hoge stroomspanning (HCS) die vereist is voor GOA TFT's [11,12,13], voornamelijk vanwege twee kenmerken van het BCE-proces [14]. De eerste is dat het oppervlak van een a-IGZO-film (achterkanaal van a-IGZO TFT) wordt blootgesteld aan S/D-etsmiddelen, die traditioneel bestaan uit HNO3 , H3 PO4 , en CH3 COOH, die een hoge etssnelheid hebben die niet controleerbaar is voor a-IGZO-films [15]. Een milde H2 O2 -gebaseerd etsmiddel met stabiel etsen en minimale schade aan de a-IGZO-films kan worden gebruikt voor het S/D-elektrode (Cu-metaal) etsen, maar schade aan het oppervlak van de a-IGZO-film is nog steeds onvermijdelijk [16]. Ten tweede kan het directe contact van het S/D-metaal (Mo/Cu/Mo) met de a-IGZO-film het TFT-achterkanaal [17] verontreinigen. Gelukkig kan een clean etch stopper (CL-ES)-proces, dat minder gecompliceerd en kostbaar is en contaminatie minimaliseert, worden gebruikt om op a-IGZO gebaseerde TFT's te fabriceren met verbeterde uniformiteit en stabiliteit voor displays met een groot oppervlak [18]. Hoewel de CL-ES-gestructureerde TFT verbeterde prestaties laat zien, zijn de vragen hoe het etsmiddel zal reageren met a-IGZO-film en hoe Cu + diffusie in a-IGZO-films beïnvloedt de microstructuur en de prestaties van de apparaten blijven onduidelijk.
In deze studie werden a-IGZO GOA TFT's met een kleinere functiegrootte en een schone achterkanaalstructuur gefabriceerd via een CL-ES-proces door batch-etsen van meerlagige a-IGZO/Mo/Cu/Mo. Bovendien is de invloed van het etsmiddel en Cu + diffusie op de microstructuur en prestaties van CL-ES-gestructureerde a-IGZO GOA TFT-apparaten worden bestudeerd en vergeleken met die van BCE-gestructureerde a-IGZO GOA TFT-apparaten. Wat nog belangrijker is, is dat de etsstoplaag van het CL-ES-apparaat dient als de S/D-etsbeschermingslaag en als de Cu + diffusiebarrièrelaag, die helpt om het aantal defecten te verminderen en de betrouwbaarheid van de hoge stroomspanningsbetrouwbaarheid, SS-waarden, hoge stroomspanning en drempelspanningsvariaties, enz. te verbeteren. Daarom levert dit werk direct bewijs en een inzichtelijke demonstratie dat de verbeterde prestatie van CL-ES-gestructureerde TFT's is sterk gecorreleerd met de CL-ES-structuur en de schone componenten en bevestigt dat het CL-ES-proces een efficiënte route kan zijn voor de massaproductie van schermen met bevredigende prestaties.
Experimentele methoden
Vervaardiging van a-IGZO GOA TFT's
De CL-ES-gestructureerde a-IGZO TFT-apparaten werden vervaardigd via een aangepast vijfstaps CL-ES-proces (Fig. 1), zoals gerapporteerd in ons vorige werk [15]. Eerst werd de poortelektrode gevormd met Mo/Cu-metaal en werd de poortisolator gedeponeerd met een SiNx/SiOx (3000 A/1000 A) dubbellaag met behulp van PECVD bij 340 °C. Ten tweede werd een a-IGZO-film van 300 afgezet met behulp van reactief sputteren met DC-magnetron bij kamertemperatuur met een partiële zuurstofdruk van 15%. Een etsstoplaag (SiOx, ESL) van 1000 werd afgezet met PECVD bij 240 °C en reactief geëtst door CF4 plasma voor patroonvorming, met behulp van het actieve fotolithografiemasker van het BCE-proces als het etsmasker. Voor deze stap werd de a-IGZO-film onder de ES-laagpatronen beschermd tegen blootstelling aan de CF4 plasma, terwijl de rest van de a-IGZO-film, niet beschermd door de ES-laagpatronen, ook niet werd geëtst maar werd omgezet in een geleidende film. Ten derde werden de source-drain (S/D) elektroden (Mo/Cu/Mo drievoudige lagen) door sputteren afgezet en geëtst met behulp van een H2 O2 etsmiddel dat 0,2 wt% van een fluoride-additief bevat, waarbij het S/D-fotolithografiemasker en het ES-laagpatroon dienen als het etsmasker. Ten vierde werd een passiveringslaag van 3000 afgezet. De daaropvolgende processen waren vergelijkbaar met die van een typische fabricage van een TFT LCD-backplane.

Fabricageproces van de a-IGZO GOA TFT
Ter vergelijking:BCE-gestructureerde a-IGZO TFT-apparaten werden vervaardigd met behulp van het conventionele BCE-proces en hetzelfde BCE-masker.
Karakterisering
De morfologieën, microstructuren en samenstellingen van de monsters werden gekarakteriseerd met behulp van SEM (Camscan Mx2600FE), röntgenfoto-elektronspectroscopie (XPS, PHI Quantera II) en time-of-flight secundaire ionenmassaspectrometrie (IONTOF, TOF-SIMS 5) . Elektrische metingen werden uitgevoerd met een halfgeleiderkarakteristiekanalysator (Keysight 4082A) in een donkere omgeving en bij 60 °C. Voor de eenvoud werd de HCS-betrouwbaarheid geëvalueerd voor meer dan 1000 s met V gs bij 25 V en V ds bij 25 V. Tijdens de evaluatie werd de toestand van de GOA TFT gecontroleerd door de I te meten ds stroom met intervallen van 1 s, en de trend van de I ds stroom werd geanalyseerd. De ik d -V g overdrachtskenmerken werden ook gecontroleerd met intervallen van 100 s.
Resultaten en discussie
Het GOA TFT-apparaat, dat TFT-kanalen en poort-, afvoer- en broncomponenten bevat, zoals vervaardigd door het CL-ES-proces, wordt getoond in Fig. 2. Om elke TFT-karakteristiek nauwkeurig te meten, werden alle TFT's losgekoppeld met behulp van een laser, dus onafhankelijk worden, zodat de gate, source en drain geen node kunnen delen met een andere TFT. Zoals aangegeven door de rode lijn in Fig. 2, heeft deze TFT een meerkanaals en gescheiden GOA-structuurontwerp, met een kanaalbreedte en -lengte van respectievelijk 120 m en 10 μm, voor het gemak van de elektrische metingen. Deze TFT is ook ontworpen om een gemiddeld stroomniveau naar de afzonderlijke TFT-kanalen te laten vloeien door een zwevend stuk metaal te plaatsen (in het midden van de kanalen), dat elk kanaal integreert. Voorafgaand aan de HCS-betrouwbaarheidsevaluatie wordt eerst de gescheiden werkingsbetrouwbaarheid bevestigd door de elektrische interferentie van de TFT van belang van de andere perifere TFT's te evalueren. In dit geval is de I uit ruisstroom van de gescheiden GOA-TFT's wordt gemeten als 3 pA (curve in figuur 2), wat bevestigt dat er geen elektrische interferentie is van de andere GOA-componenten in de buurt.
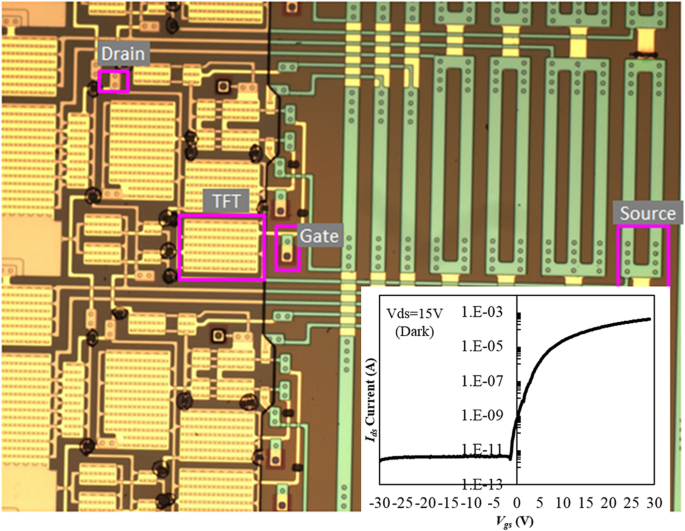
Foto's van de GOA TFT's elektrisch gescheiden van de GOA-circuits (vul in:I uit ruisstroom tussen de TFT van belang en de andere perifere TFT's)
Verschillende functiegroottes van de CL-ES-gestructureerde TFT's en BCE-gestructureerde TFT's worden gemeten en vergeleken. Voor de CL-ES-gestructureerde TFT's (Fig. 3a) zijn de breedte en lengte respectievelijk 4 m en 6 μm, vergelijkbaar met die van de BCE-gestructureerde a-IGZO TFT's in Fig. 3b. In het algemeen is het BCE-proces wenselijk voor de vervaardiging van oxide-TFT's vanwege de kleine kenmerkafmetingen. Daarom vertonen de verkregen CL-ES-gestructureerde TFT's een verminderde functiegrootte en een integratiegraad die even hoog is als de BCE-gestructureerde TFT's. Bovendien is de dwarsdoorsnede van de CL-ES-gestructureerde TFT's vergelijkbaar met die van de BCE-gestructureerde TFT's (Fig. 3c, d), terwijl de CL-ES-gestructureerde TFT's een duidelijke ES-laag vertonen die niet wordt waargenomen in de BCE TFT's. Het CL-ES-proces vormt voornamelijk ES-patronen, terwijl het batch-etsproces op meerlagig a-IGZO/Mo/Cu/Mo kan worden uitgevoerd met vergelijkbare maskers voor de actieve patronen en source-drain-elektroden als die in het BCE-proces. Daarom is het aantal fotolithografische maskers dat in het CL-ES-proces wordt gebruikt, behalve voor de ES-patronen, hetzelfde als voor het BCE-proces. Dit CL-ES-proces kan het grotere aantal maskers van het conventionele ESL-proces vermijden en heeft een kleinere functiegrootte, waardoor het economisch haalbaar is voor massaproductie. Bovendien worden, zonder gebruik te maken van de halftoonbelichting, een procesvereenvoudigingsprocedure die conventioneel wordt gebruikt in de TFT LCD-industrie, de procescomplicatie en de fabricagekosten beide verminderd.
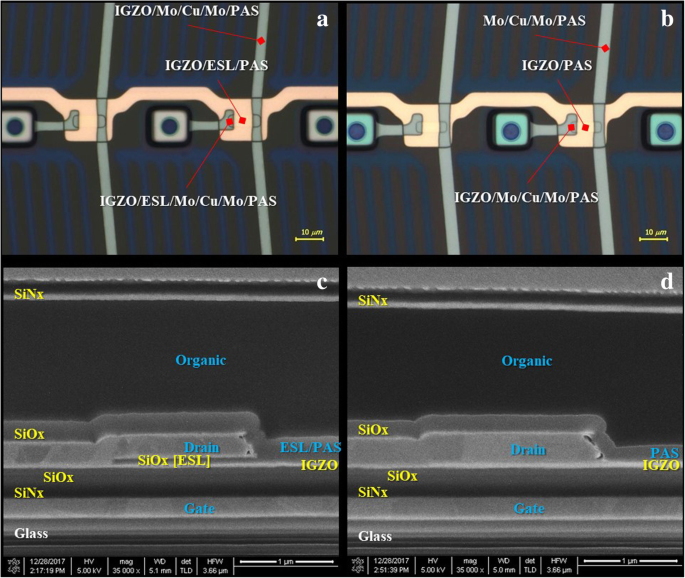
SEM-afbeeldingen van de a-IGZO TFT's:a CL-ES-gestructureerd TFT-bovenaanzicht, b BCE-gestructureerd TFT-bovenaanzicht, c CL-ES-gestructureerde TFT-dwarsdoorsnede, en d BCE-gestructureerde TFT-doorsnedeweergave
Om de oppervlaktedefecten van de BCE-gestructureerde TFT's tijdens het BCE-fabricageproces verder te observeren, de oppervlaktesamenstelling van a-IGZO-films vóór uitgloeien (monster 1), na uitgloeien (monster 2) en na blootstelling aan de H2 O2 Cu-etsmiddel (monster 3) wordt bestudeerd via XPS. In de volledig gescande spectra van a-IGZO-films (Fig. 4a-c) bestaan pieken voor In-, Ga-, Zn-, O- en C-elementen tijdens het BCE-fabricageproces. Zoals weergegeven in figuur 4d, hoewel de BCE-gestructureerde TFT geen significante verandering in de samenstelling van de a-IGZO-films vertoont vóór uitgloeien (monster 1) en na uitgloeien bij 330 ° C gedurende 1 uur (monster 2), zijn er significante veranderingen waargenomen na blootstelling aan natte chemicaliën (monster 3). Met name zink, dat een relatief lage bindingsenergie met zuurstof heeft, bleek 4,82% te zijn in monster 1 en 5,42% in monster 2, maar het is gedaald tot 3,16% in monster 3. Indium heeft minimale variatie in de samenstellingen tussen de verschillende processen, en de relatieve procentuele verandering van Zn ten opzichte van In is enorm, namelijk 44,1%, 46,0% en 27,6% voor respectievelijk monsters 1, 2 en 3. Dit is vergelijkbaar voor gallium, dat ook een sterke bindingsaffiniteit met zuurstof heeft. Met andere woorden, tijdens het natte etsproces traden ongewenste defecten op, waaronder een aanzienlijk verlies van Zn en Ga, op het blootgestelde achteroppervlak van de oxidehalfgeleider. De redenen voor dit fenomeen kunnen verband houden met hun verschillende bindingsenergieën aan zuurstof en de verschillende moleculaire structuren van de a-IGZO-film [19].

XPS-analyse van de oppervlaktesamenstelling van de a-IGZO dunne films a voor het uitgloeien, b na gloeien, en c na blootstelling aan de H2 O2 Cu-etsmiddel tijdens het BCE-proces. d Overeenkomstige atoompercentages voor het bovenstaande proces
Het is algemeen bekend dat de chemische bestendigheid van a-IGZO-films tegen zure etsmiddelen erg zwak is [20]. In het bijzonder veroorzaakt het abrupte verlies van Zn, waarvan wordt aangenomen dat het de moleculaire structuur van a-IGZO bepaalt, een verzwakking van de oppervlaktestructuur van de a-IGZO-films. Bovendien kan de reductie van Ga, dat de vorming van dragers onderdrukt via zijn sterke bindingsenergie met zuurstof, de kans op het ontwikkelen van zuurstofvacatures vergroten [Vo] [21]. Daarom kunnen BCE-gestructureerde GOA TFT's etsschade aan het TFT-achterkanaal niet voorkomen, zelfs niet in een relatief milde H2 O2 -gebaseerd Cu-etsmiddel.
Om de bescherming van de ES-laag te bevestigen, wordt de samenstelling van het a-IGZO TFT-kanaalgebied bestudeerd met behulp van TOF-SIMS voor monsters die zijn bereid door de BCE- en CL-ES-processen (clean etch stopper) (Fig. 5). Sinds Cu + in de a-IGZO-film kan defecten van het acceptertype produceren en elektronen vangen, het a-IGZO TFT-kanaal moet schoon zijn om de elektrische stabiliteit te verbeteren. Zoals waargenomen, de Cu + piek gedetecteerd in het BCE-monster is 20 keer groter dan die van het CL-ES-monster. Bovendien is het detectiegebied van Cu + overlapt met het detectiegebied van Zn + en Ga + in grote mate (Fig. 5a). Deze resultaten gaven aan dat de a-IGZO-films in de BCE-gestructureerde TFT's besmet zijn met Cu + vanwege het directe contact van de a-IGZO-film in het TFT-achterkanaalgebied met het Cu-metaal. Voor de CL-ES-gestructureerde TFT's (Fig. 5b), Cu + wordt alleen gedetecteerd in het ES-gebied, wat aangeeft dat direct contact van het a-IGZO TFT-kanaalgebied met het Cu-metaal wordt vermeden. Verrassend genoeg is er een aanzienlijke hoeveelheid Zn + verschijnt in de ESL. De diffuse Zn + wordt veroorzaakt door de hogere plasmacondities voor de behandeling en de drukcondities tijdens ESL-afzetting. Daarom is de ES-laag in CL-ES-gestructureerde TFT's essentieel om de elektrische stabiliteit te verbeteren door oppervlaktebeschadiging en verontreiniging van de a-IGZO-films te voorkomen.

TOF-SIMS-analyse van de kanaalgebieden van a-IGZO TFT's vervaardigd via a de BCE en b de CL-ES-processen
De evaluatie van hoge stroomspanning (HCS) voor de CL-ES- en BCE-gestructureerde GOA a-IGZO TFT's wordt getoond in figuur 6a. Voor dezelfde functiegroottes wordt de eerste I ds stroom van de CL-ES-gestructureerde TFT is 429 A, wat hoger is dan die van de BCE-gestructureerde TFT (343 A). Na de HCS-evaluatie voor 1000 s, de I ds stroom van de CL-ES-gestructureerde TFT is 352 μA, ongeveer 82,2% van de initiële waarde. In tegenstelling, de I ds reststroom van de BCE-gestructureerde TFT is gedaald tot 183 A en behoudt slechts 53,5% van zijn initiële waarde. Bovendien, zoals geëvalueerd door extrapolatie (Fig. 6b), is de I ds De reststroom van de CL-ES-gestructureerde TFT zal naar verwachting 302,6 A zijn, met behoud van 70,5% van zijn oorspronkelijke waarde na 10.000 s. Voor de BCE-gestructureerde TFT, de I ds reststroom neemt sterk af tot 111,7 A, waardoor slechts 33,7% van zijn oorspronkelijke waarde behouden blijft. Daarom kan onder dezelfde outputkenmerken de mate van integratie voor de GOA TFT die is vervaardigd via het CL-ES-proces met maar liefst 271% worden verhoogd in vergelijking met die van het BCE-proces.
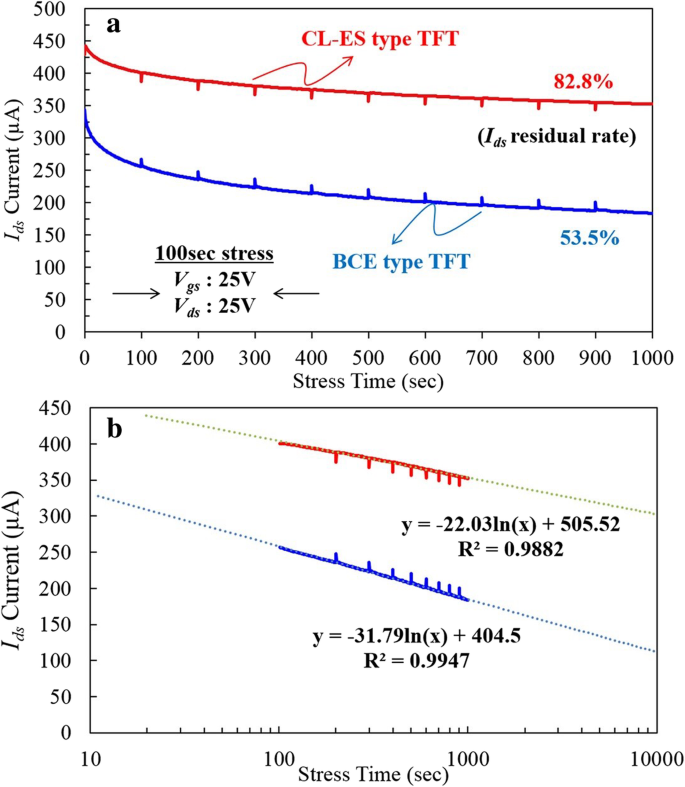
een Experimentele gegevens voor 1000 s en b extrapolatie voor HCS-evaluatie op lange termijn van de CL-ES- en BCE-gestructureerde GOA TFT's
Bovendien, de I -V overdrachtskenmerken van zowel CL-ES- als BCE-gestructureerde GOA TFT's tijdens de HCS-betrouwbaarheidsevaluatie worden ook gemeten (Fig. 7 en Tabel 1). Voor CL-ES-gestructureerde TFT (Fig. 7a) is de drempelspanning 0,0 V in de initiële HCS-evaluatie (25°C) en 3,5 V na de HCS-evaluatie bij 60 °C gedurende 1000 s. Bovendien verschuift de drempelspanning continu in de positieve richting met een totale verandering (ΔV de ) van 3,5 V. De sub-drempelwaarde swing (SS) is iets verhoogd van 0,09 tot 0,16 V/dec. Voor de BCE-gestructureerde TFT is de drempelspanning veel hoger, namelijk 4,0 V bij 25 °C, en neemt toe tot 11,2 V na HCS-evaluatie bij 60 °C gedurende 1000 s. Een mogelijke reden voor deze hoge drempelspanningen is de diffusie van Cu + in de a-IGZO-film tijdens het natte etsproces van het BCE-proces. Cu + kan fungeren als accepter-type defectlocaties in a-IGZO-films, en een hoge dichtheid van Cu + een groot aantal elektronen kan vangen. De gevangen elektronen genereren een afgeschermde coulombpotentiaal die resulteert in het voorbijgaande fenomeen van de drempelspanningsverschuiving. Over het algemeen kunnen de massa van de poortisolator en de nieuw gevormde defectlocaties in het grootste deel van de a-IGZO-films de SS-waarde van TFT's verhogen [11]. Deze resultaten verklaren duidelijk de afname van de I ds reststroom in de BCE-gestructureerde TFT's. De SS-waarde van de BCE-gestructureerde TFT vertoont echter een neiging om af te nemen van 0,46 naar 0,24 V/dec. Deze afnemende SS-waarde is het gevolg van elektronen die zich ophopen in de buurt van de a-IGZO-interface, waarna de gate-isolator snel de hoge niveaus van de aanvankelijk bestaande accepter-type trap-sites kan opvullen. Bovendien worden de vangplaatsen sneller gevuld dan dat ze worden gegenereerd door de HCS, en daarom neemt het aantal gevangen elektronen geleidelijk af in de loop van de tijd. Dit komt overeen met het positief verschuivende gedrag van de drempelspanning.

Ik -V overdrachtskenmerken gemeten tijdens de HCS-evaluatie van a de CL-ES en b de BCE-gestructureerde GOA TFT's. Gedrag van c de drempelspanning en d de sub-drempelzwaai met intervallen van 1000 s en V ds = 15 V. De initiële metingen van de I d -V d uitvoerkarakteristieken voor e de CL-ES- en f de BCE-gestructureerde GOA TFT's met V gs = 0, 5, 10, 15 en 20 V
Wat betreft de uniformiteit van de kenmerken voor CL-ES, omdat ESL actieve back-channelbescherming biedt van Cu + vervuiling en etsschade, het resultaat is stabiel in vergelijking met dat van BCE. Bovendien moet worden opgemerkt dat de kenmerken van de outputcurve geen verschillen vertonen voor BCE en CL-ES-productie en stabiliteit kunnen beloven (tabel 2, figuur 7e, f).
Figuur 7 c en d tonen de resultaten van de sub-drempelzwaai en het drempelspanningsgedrag samen met de voortgang van de HCS-evaluatie. Over het algemeen neemt de swingwaarde onder de drempel van de GOA TFT geleidelijk toe, zoals te zien is voor de CL-ES-gestructureerde TFT (Fig. 7d). De BCE-gestructureerde TFT vertoont echter abnormaal gedrag, waarbij de swingwaarde onder de drempel aanvankelijk toeneemt en vervolgens afneemt tijdens de HCS-evaluatie. De SS-waarde van de BCE-gestructureerde TFT neemt toe van 0,46 tot 0,55 V/dec wanneer de substraattemperatuur steeg van 25 tot 60 °C. Tegelijkertijd verschuift de drempelspanning negatief van 4,0 naar 2,9 V (Fig. 7c). Dit abnormale fenomeen is het gevolg van de beschadiging van het a-IGZO-filmoppervlak door de H2 O2 etsmiddel met toegevoegd fluoride. Zoals eerder vermeld, impliceert de oppervlaktebeschadiging van de a-IGZO-films een gebrek aan Zn-, Ga- en zuurstofatomen, die talrijke defectlocaties vormen, waaronder zuurstofvacatures. Er wordt aangenomen dat deze defectlocaties actief zijn als ondiepe donorachtige toestanden, die dicht bij de minimale geleidingsband liggen, en in staat zijn tot thermische excitatie en fungeren als elektronenbronnen voor de geleidingsband, wat leidt tot een degradatie van de a- IGZO TFT-kenmerken. Op basis van de bovenstaande resultaten is de CL-ES-gestructureerde TFT met kleine accepterachtige toestanden en zuurstoftekorten die fungeren als ondiepe donorachtige toestanden een veel betere structuur dan de BCE-gestructureerde TFT.
Conclusie
Concluderend laten we zien dat CL-ES-gestructureerde GOA TFT, met een kleinere apparaatfunctie en een schone etsstoplaag, de prestaties en stabiliteit van het apparaat aanzienlijk kan verbeteren. Met het voorgestelde CL-ES-gestructureerde TFT-productieproces worden de schade en vervuiling van het TFT-achterkanaal geminimaliseerd. Bovendien, voor dezelfde mate van integratie als die van de BCE-gestructureerde GOA TFT, kan het CL-ES-gestructureerde TFT-proces voldoen aan de doelstellingen van esthetisch ontwerp en productiekostenefficiëntie. De CL-ES-gestructureerde GOA TFT vertoont uitstekende elektrische prestaties vergeleken met die van de BCE-gestructureerde GOA TFT, inclusief een veel hogere restionenstroom (~ -187%), veel lagere initiële SS-waarde (0,09 V/dec), en een veel lagere variatie van de drempelspanning (3,5 V). Dit impliceert de mogelijkheid van GOA-ontwerpen met een veel hogere integratie en betrouwbaarheid. De verbeterde prestaties en stabiliteit suggereren dat de CL-ES-gestructureerde TFT, met een vereenvoudigd proces en een schone etsstoplaag, met succes de donorachtige defecten overwint die worden veroorzaakt door zuurstoftekorten en de accepterachtige defecten veroorzaakt door Cu + diffusie tijdens het BCE-proces. Daarom is een zuivere oppervlaktesamenstelling voor het a-IGZO-kanaalgebied in CL-ES-gestructureerde TFT's belangrijk voor de productie van a-IGZO TFT-backplanes met hoge betrouwbaarheid, hoge resolutie en displays met smalle bezel.
Afkortingen
- TFT:
-
Dunne-filmtransistor
- GOA:
-
Gate drive IC op array
- a-IGZO:
-
Amorf indium-gallium-zink-oxide
- LCD:
-
LCD-scherm
- PEVCD:
-
Plasma-versterkte chemische dampafzetting
- ESL:
-
Ets stoplaag
- BCE:
-
Terug kanaal etch
- HCS:
-
Hoge stroomspanning
- SiOx:
-
Siliciumoxide
- SiNx:
-
Siliciumnitride
- SS:
-
Swing onder de drempel
Nanomaterialen
- Ontwerpen met Bluetooth Mesh:knooppunten en functietypen
- MCU's bieden verbeterde prestaties, connectiviteit en beveiliging
- Betrouwbaarheid verhogen en onderhoudsresultaten verbeteren met machine learning
- Verschil tussen structuur en klasse:uitgelegd met C++-voorbeeld
- Frequentiemodulatie en absorptieverbetering van THz-microbolometer met microbrugstructuur door spiraalvormige antennes
- Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
- Verbetering van de prestaties van a-IGZO TFT-apparaten met behulp van een schoon interfaceproces via Etch-Stopper nanolagen
- Verminderde contactweerstand tussen metaal en n-Ge door invoeging van ZnO met argonplasmabehandeling
- Ultra-lage specifieke weerstand laterale dubbel-diffuus metaaloxide-halfgeleidertransistor met verbeterde dubbele poort en gedeeltelijk P-begraven laag
- Hiërarchische structuur kaoliniet nanosferen met opmerkelijk verbeterde adsorptie-eigenschappen voor methyleenblauw
- IBM:proactief zorgen voor betrouwbaarheid en veiligheid met EAM



