Onderzoek naar nitridatie op de banduitlijning op MoS2/HfO2-interfaces
Abstract
Het effect van nitridatiebehandeling op de banduitlijning tussen MoS2 en HfO2 is onderzocht met röntgenfoto-elektronspectroscopie. De valentie (geleiding) band offsets van MoS2 /HfO2 met en zonder nitridatiebehandeling werden bepaald op respectievelijk 2,09 ± 0,1 (2,41 ± 0,1) en 2,34 ± 0,1 (2,16 ± 0,1) eV. De afstembare banduitlijning kan worden toegeschreven aan de vorming van Mo-N-binding en het buigen van de oppervlakteband voor HfO2 veroorzaakt door nitridatie. Deze studie over de energieband-engineering van MoS2 /HfO2 heterojuncties kunnen ook worden uitgebreid naar andere high-k diëlektrica voor integratie met tweedimensionale materialen om hun elektronische apparaten te ontwerpen en te optimaliseren.
Achtergrond
Momenteel hebben gelaagde overgangsmetaal dichalcogeniden (TMDC's) grote belangstelling gewekt vanwege hun fascinerende eigenschappen voor potentiële toepassingen in moderne elektronica en opto-elektronica [1, 2]. In het bijzonder molybdeendisulfide (MoS2 ) heeft veel aandacht getrokken als een veelbelovend kanaalmateriaal voor het voortzetten van de schaalvergroting buiten het 7-nm-technologieknooppunt [3, 4]. Structureel gezien is de MoS2 kristal is opgebouwd uit één zeshoekig Mo-vlak, ingeklemd tussen twee zeshoekige S-vlakken. Een driehoekige prismatische opstelling werd gevormd via de covalent gebonden S-Mo-S -eenheden [5, 6]. MoS2 heeft een laagafhankelijke bandgap, variërend van een directe bandgap (1,8 eV) voor enkellaags (SL) MoS2 naar een indirecte bandgap (1,2 eV) voor bulk MoS2 [7]. In tegenstelling tot grafeen met een bandgap van nul, motiveerde de dikte-afhankelijke modulatie van bandgaps de verkenning van MoS2 in optische en elektrische apparaten [3, 8]. Gebaseerd op de fysica van MoS2 , de toestandsdichtheid van MoS met enkele lagen2 is driemaal zo hoog als bij enkellaags MoS2 , wat resulteert in hoge aandrijfstromen in de ballistische limiet [8]. In deze context is MoS2 . met weinig lagen kan aanzienlijke voordelen opleveren voor transistortoepassingen dan SL MoS2 [3].
Aan de andere kant naderen de elektronische apparaten op basis van traditionele siliciumdioxide-diëlektrica de fysieke limiet vanwege de lage diëlektrische constante [9]. Om een dunne equivalente oxidedikte (EOT) te verkrijgen, is het van cruciaal belang om diëlektrica met hoge k te integreren met MoS2 . Tot op heden zijn veel hoge-k diëlektrica onderzocht met MoS2 , inclusief Al2 O3 , ZrO2 , HfO2 en h-BN [10,11,12,13,14]. Di Stefano et al. behaalde de respectieve geleidings- en valentieband-offsets van 3,3 ± 0,2 en 1,4 ± 0,2 eV voor MoS met weinig lagen2 gegroeid door oxidedampafzetting op amorf BN [13]. Tao et al. meldde dat de conduction band offset (CBO) voor de monolaag MoS2 /Al2 O3 (ZrO2 ) heterojunctie werd afgeleid als 3,56 eV (1,22 eV), terwijl de valentiebandoffset (VBO) 3,31 eV (2,76 eV) was [15]. En een CBO van 2,09 ± 0,35 eV en VBO van 2,67 ± 0,11 eV bij de MoS2 /HfO2 interface werden gerapporteerd door McDonnell et al. [12]. Onder deze poortdiëlektrica, HfO2 werd beschouwd als een van de meest veelbelovende kandidaten vanwege de hoge diëlektrische constante (k ∼ 20), compatibiliteit met poly-SiGe, TaN-poorten en polykristallijne siliciumpoort [16]. Echter, HfO2 heeft een slechte thermische stabiliteit, grote lekstroom, hoge oxidevangerdichtheid, interface-valdichtheid, enz. [17]. Deze beperkingen hebben geleid tot uitgebreid onderzoek naar passiveringstechnieken, zoals interface-nitridatie of fluoreringsbehandelingstechnologieën [18, 19]. In dit werk hebben we de uitlijning van de energiebanden van MoS2 . met enkele lagen bestudeerd op HfO2 diëlektrica met en zonder plasmanitridatie, waarbij het effect van oppervlaktenitridatie werd gekarakteriseerd door röntgenfoto-elektronspectroscopie (XPS).
Methoden
De SiO2 (280 nm)/Si-wafel werd afwisselend gereinigd met aceton en isopropanol door middel van ultrasone reiniging voor elke 10 min, gevolgd door spoelen met gedeïoniseerd water en N2 droog. De enkele laag MoS2 films werden gedeponeerd op SiO2 /Si-substraat door chemische dampafzetting (CVD) met voorlopers van MoO3 (0,08 mg, 99%, Alfa Aesar) en S-poeder (1 g, 99%) [20, 21]. Na de groeiprocedure wordt de MoS2 film zou worden overgebracht naar HfO2 /Si-substraat door de poly (methylmethacrylaat) (PMMA) -methode [22], zoals weergegeven in Fig. 1a. In dit proces werd PMMA eerst spin-coated op MoS2 /SiO2 /Si-monsters als ondersteunende laag. Vervolgens werden de monsters ondergedompeld in KOH-oplossing om de SiO2 . weg te etsen , waarna de MoS2 laag met PMMA zou naar de bovenkant van de oplossing drijven. Uiteindelijk zou de PMMA-laag worden opgelost in aceton nadat het monster was overgebracht op HfO2 /Si-substraat. De HfO2 films werden op de siliciumwafel gekweekt door atomaire laagafzetting (ALD) bij een temperatuur van 200 ° C met behulp van Hf [N (CH3 )(C2 H5 )]4 [tetrakis (ethylmethylamido) hafnium, TEMAH] en H2 O-damp als voorlopers [23, 24]. Tijdens het optimalisatieproces van de plasmabehandelingstijd bleek dat de stikstof sterk zou diffunderen in het oxide na 70 s nitridatiebehandeling door SIMS-metingen, wat de oxidekwaliteit ernstig zou verslechteren. Hoewel de plasmabehandelingstijd 30 s is, werd er geen duidelijke N-piek aan het oxide-oppervlak waargenomen uit de SIMS-resultaten. Voor het controlemonster, 50 s N2 plasmabehandeling werd geïmplementeerd op HfO2 /Si-substraat bij een druk van 3 Pa vóór de MoS2 overdracht. Onder de plasmaconditie is de resulterende N-dosis ongeveer 8,4 × 10 14 atomen/cm 2 geschat op basis van de resultaten van de secundaire ionenmassaspectrometrie (SIMS). En de stikstofconcentratie werd berekend op ongeveer 1,5% na nitridatie op basis van de XPS-gegevens. Vier monsters 1-4# werden voorbereid voor XPS-metingen:1# enkele laag MoS2 film op SiO2 /Si-substraat (enkele lagen MoS2 ), 2# dik HfO2 film op Si-substraat (bulk HfO2 ), 3# overgedragen MoS2 film over as-grown HfO2 /Si-substraat (zoals gegroeid MoS2 /HfO2 heterojunctie), en 4# overgedragen MoS2 film op N2 met plasma behandeld HfO2 /Si-substraat (genitreerd MoS2 /HfO2 heterojunctie).
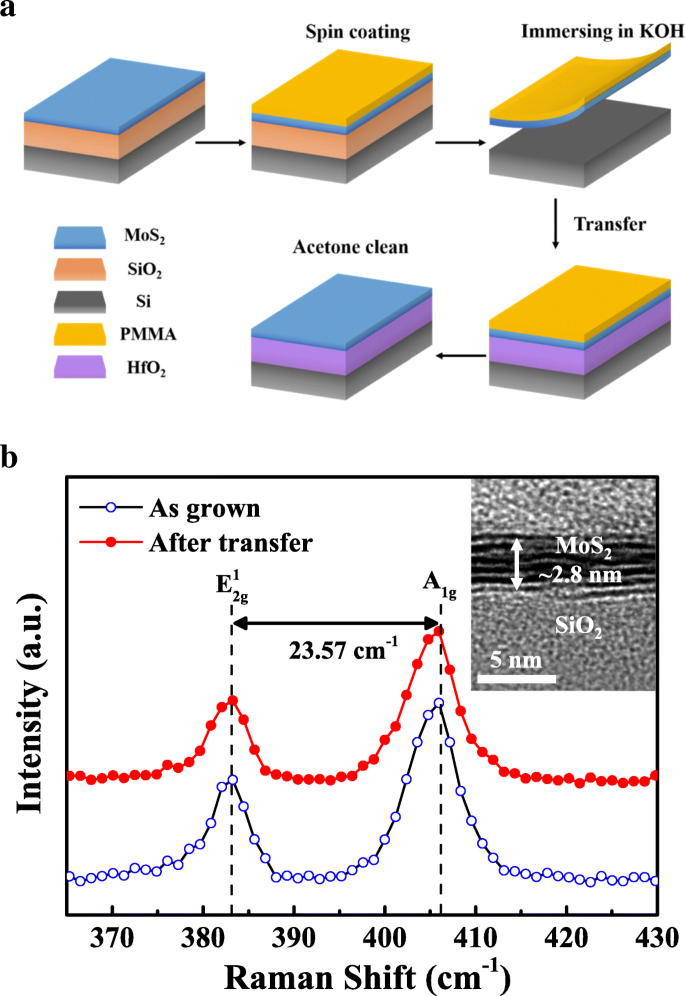
een Processtroom van PMMA-ondersteunde natte overdrachtsmethode voor de MoS2 /ALD-HfO2 heterojunctie vorming. b Respectieve Raman-spectra van zoals gegroeid en overgedragen MoS2 film. De inzet zijn de transmissie-elektronenmicroscopiebeelden van de dwarsdoorsnede van als gegroeide MoS2 op SiO2 /Si-substraat
Resultaten en discussies
RENISHAW inVia Raman-spectroscopie werd gebruikt om de Raman-spectra van MoS2 met weinig lagen te karakteriseren film voor en na de overdrachtsprocedure, zoals geïllustreerd in Fig. 1b. Twee Raman-pieken zijn te zien op ongeveer 382,86 cm −1 en 406.43 cm −1 , overeenkomend met de in-plane (\( {E}_{2g}^1 \)) en out-of-plane (A 1g ) modi, respectievelijk [25, 26]. Het bleek dat er bijna geen Raman-verschuiving is in \( {E}_{2g}^1 \) en A 1g modusfrequenties na het overdrachtsproces, wat wijst op minimale structuurwijziging. Het frequentieverschil (∆k ) tussen \( {E}_{2g}^1 \) en A 1g modus werd afgeleid van ongeveer 23,57 cm −1 , wat neerkomt op ongeveer vier tot vijf lagen MoS2 filmpje [27]. Zoals getoond in de inzet van Fig. 1b, is de dikte van MoS2 film werd geverifieerd als ongeveer 2,8 nm door transmissie-elektronenmicroscoop met hoge resolutie (HRTEM), wat in overeenstemming is met de bovengenoemde Raman-spectra. Bovendien presenteerden we SIMS-diepteprofielen van overgedragen MoS2 film op genitreerd HfO2 /Si-substraat. SIMS-meting werd uitgevoerd op een Physical Electronics ADEPT 1010 SIMS-instrument met Cs primaire ionenbundel met een energie van 1 keV, waarin positieve ionen werden verzameld en ladingscompensatie werd uitgevoerd. In deze SIMS-meting werd het stikstofelement gekwantificeerd, terwijl de andere elementen (Mo, Hf en Si) alleen bedoeld zijn als laagmarkeringen en niet gekwantificeerd. Zoals geïllustreerd in Fig. 2a, zijn de diepteprofielen voor overgedragen MoS2 film op genitreerd HfO2 /Si-substraat werden bepaald door SIMS, waarin signalen van hoofdcomponenten vertegenwoordigd door Mo, N, Hf en Si worden uitgezet tegen de diepte. De verspreiding van N in de HfO2 laag werd waargenomen, die geïntrigeerd zou kunnen zijn door de N-injectie in de onderliggende laag tijdens primaire bundelbombardementen of plasmabehandelingen. Het is ook vermeldenswaard dat diepteprofielen nabij de oppervlaktelaag normaal gesproken gecompliceerd en zinloos zijn vanwege de oppervlakteverontreiniging en oppervlakte-effecten, bijvoorbeeld de abnormale intensiteit van het N-element nabij het oppervlak [28]. Het hogere signaal van N-profiel nabij de HfO2 /Si-interface kan worden toegeschreven aan het feit dat de stikstof de neiging heeft te diffunderen naar de HfO2 /Si-interface, wat leidt tot de accumulatie van N nabij de interface [29]. De staart van Mo in HfO2 film kan voornamelijk worden veroorzaakt door primaire bundelbombardementen in SIMS-metingen [30]. Figuur 2b illustreert de respectieve Nis XPS-spectra voor monster 3# en 4#; de pieken met hoge intensiteit voor beide heterojuncties waren Mo 3p3/2 terwijl een piek van lage intensiteit bij ~-395,80 eV werd gedetecteerd voor de genitreerde heterojunctie, wat wijst op de vorming van Mo-N-binding [31].
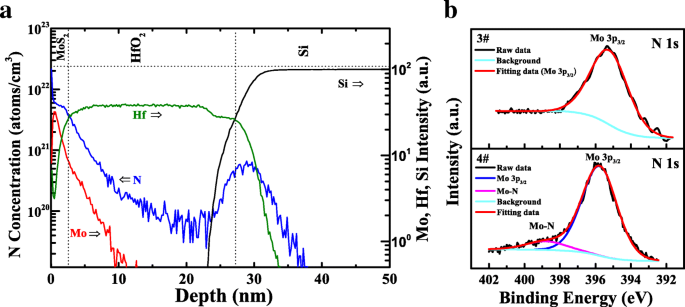
een SIMS-diepteprofielen van overgedragen MoS2 film op genitreerd HfO2 /Si-substraat. b N 1s XPS-spectra voor MoS2 /HfO2 heterojuncties met en zonder nitridatiebehandeling, respectievelijk
Om de banduitlijningen te verkrijgen tussen MoS met weinig lagen2 en HfO2 met en zonder nitridatiebehandeling werden XPS-metingen met een stap van 0,05 eV uitgevoerd op het VG ESCALAB 220i-XL-systeem met behulp van een monochromatische Al Kα-röntgenbron (hν = 1486.6 eV). De constante doorlaatenergie werd ingesteld op 20 eV. Bovendien werd de standaard C 1s (284,8 eV) gebruikt voor kalibratie van bindingsenergie (BE) [32]. VBO-waarden evalueren voor MoS2 /HfO2 heterojuncties, Mo 3d- en Hf 4f-kernniveaus (CL's) werden respectievelijk geselecteerd voor monster 1-4 #. Figuur 3a presenteert de XPS-smalle scan van Mo 3d en valentiebandspectra van monster 1 # [33]. Dus het bindingsenergieverschil (BED) tussen Mo 3d5/2 kernniveau en valentiebandmaximum (VBM) voor monster 1# werd berekend op 228,49 ± 0,1 eV. Afbeelding 3b illustreert de CL's van Hf 4f7/2 en VBM voor monster 2#; het overeenkomstige BED werd vastgesteld op 14,10 ± 0,1 eV. Afbeelding 3c toont de gemeten XPS-spectra van Mo 3d en Hf 4f CL's voor MoS2 /HfO2 heterojuncties met/zonder nitridatiebehandeling. Opgemerkt wordt dat de Mo 3d5/2 CL verschoof van 229,45 ± 0,05 eV voor monster 3# naar 229,90 ± 0,05 eV voor monster 4#. Dit kan worden toegeschreven aan het feit dat er een nitridatie-grensvlaklaag is aangebracht op de MoS2 /HfO2 grensvlak na plasmabehandeling, resulterend in de bovengenoemde Mo-N-binding. Met de aanwezigheid van Mo-N-binding droeg de daaruit voortvloeiende ladingsoverdracht tussen Mo- en N-elementen bij aan de gemeten Mo 3d5/2 CL-verschuiving. Bovendien is de Hf 4f7/2 CL van 17,40 ± 0,05 eV voor monster 3# werd verschoven naar een hogere bindingsenergie van 17,60 ± 0,05 eV voor monster 4#, terwijl O1s ook een verschuiving van 0,20 eV naar een hoger BED liet zien, zoals weergegeven in figuur 3d. Deze piekverschuivingen impliceerden de neerwaartse bandbuiging bij de HfO2 oppervlak, wat kan worden geïnterpreteerd als dat het stikstofplasma donorachtige defecten veroorzaakte voor HfO2 [34]. Op basis van de Kraut-methode [35] heeft de VBO (∆E V ) waarden kunnen worden berekend met de volgende vergelijking:
$$ \Delta {E}_V=\left({E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S }}_2}-{E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2}\right)-\left({E}_{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2}-{E}_{\mathrm{VBM}}^{{\mathrm{Hf }\mathrm{O}}_2}\right)-{\Delta E}_{\mathrm{CL}} $$ (1)waarbij \( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2} \) en \( {E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2} \) zijn bindende energieën van Mo 3d5/2 CL en VBM voor MoS2 , \( {E}_{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) en \( {E}_{\mathrm{VBM}}^{{\mathrm{HfO}}_2} \) zijn bindende energieën van Hf 4f7/2 CL en VBM voor ALD-HfO2 , ∆E CL =\( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2}-{E}_ {\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) verwijst naar de BED tussen Mo 3d 5/2 en Hf 4f7/2 CL's voor ALD-HfO2 /MoS2 heterojuncties. Vandaar dat de ∆E V van MoS2 op ALD-HfO2 met en zonder nitridatiebehandeling werden berekend op respectievelijk 2,09 ± 0,1 en 2,34 ± 0,1 eV.

een XPS-spectra van Mo 3d CL en valentieband voor de enkele laag MoS2 . b XPS-spectra van Hf 4f CL en valentieband voor bulk HfO2 . XPS-spectra van c Mo 3d, Hf 4f en d O 1s CL's voor overgedragen MoS2 film op bulk HfO2 met/zonder nitridatiebehandeling
Om de invloed van N2 . te beoordelen plasmabehandeling op de geleidingsband-offset (CBO, ∆E C ) tussen ALD-HfO2 en enkele laag MoS2 , de bandgaps van 5,9 ± 0,1 eV voor HfO2 en 1,4 ± 0,1 eV voor MoS2 werden hier respectievelijk gebruikt [7, 36]. De CBO kan dus worden bereikt door de volgende vergelijking:
$$ {\Delta E}_C={E}_g^{{\mathrm{HfO}}_2}-{E}_g^{\mathrm{Mo}{\mathrm{S}}_2}-{\Delta E }_V $$ (2)waarbij \( {E}_g^{{\mathrm{HfO}}_2} \) en \( {E}_g^{\mathrm{Mo}{\mathrm{S}}_2} \) de bandgaps van HfO zijn 2 en MoS2 , respectievelijk. Volgens vgl. (2), de ∆E C tussen MoS2 en ALD-HfO2 met en zonder nitridatiebehandeling werden berekend op respectievelijk 2,41 ± 0,1 en 2,16 ± 0,1 eV. De corresponderende banddiagrammen worden geïllustreerd in Fig. 4. Opmerkelijk is dat zowel de VBO- als CBO-waarden van deze twee heterojuncties uitstekende elektronen- en gatenopsluitingen bieden, waardoor ze geschikt zijn voor MoS2 -gebaseerde FET's [37]. Bovendien heeft de genitreerde heterojunctie een hogere CBO in vergelijking met niet-genitreerde heterojunctie, wat beter is voor n-kanaals FET's-toepassingen.
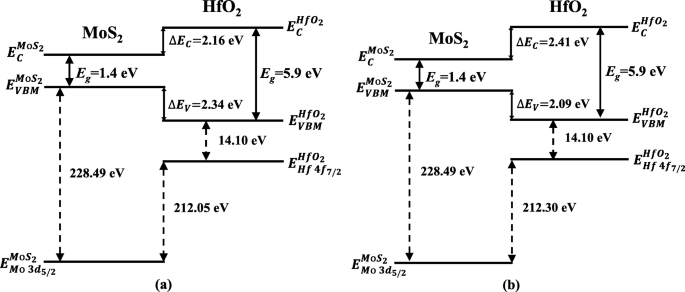
Banddiagrammen van MoS2 /HfO2 heterojunctie a zonder nitridatiebehandeling en b met nitridatiebehandeling
Conclusies
Concluderend lieten de XPS-metingen zien dat de banduitlijning op de MoS2 /HfO2 interface kan worden aangepast door nitridatie te introduceren in HfO2 oppervlak voorafgaand aan het stapelen van MoS2 film. De CBO en VBO werden bepaald op 2,16 ± 0,1 en 2,34 ± 0,1 eV voor de niet-genitreerde MoS2 /HfO2 heterojunctie, terwijl de CBO werd gewijzigd tot 2,41 ± 0,1 eV en de VBO werd gewijzigd tot 2,09 ± 0,1 eV voor de genitreerde MoS2 /HfO2 heterojunctie, respectievelijk. Op het grensvlak werd een nitridatie-grenslaag aangebracht, wat bleek te resulteren in de vorming van Mo-N-binding. Bovendien kan het stikstofplasma donorachtige defecten veroorzaken, waardoor de oppervlakteband buigt voor HfO2 . Op deze manier zou de techniek voor de uitlijning van de grensvlakken veelbelovende routes bieden naar het flexibel ontwerpen en optimaliseren van moderne elektronica.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit manuscript ondersteunen, zijn opgenomen in het manuscript.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- BE:
-
Bindende energie
- BED:
-
Bindend energieverschil
- CBO:
-
Geleidingsband offset
- CL:
-
Kernniveau
- CVD:
-
Chemische dampafzetting
- FET:
-
Veldeffecttransistor
- HfO2:
-
Hafniumoxide
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- MoS2 :
-
Molybdeendisulfide
- PMMA:
-
Poly (methylmethacrylaat)
- SIMS:
-
Secundaire ionenmassaspectrometrie
- SL:
-
Enkellaags
- TEMAH:
-
Tetrakis (ethylmethylamido) hafnium
- TMDC:
-
Overgangsmetaal dichalcogenide
- VBM:
-
Maximale valentieband
- VBO:
-
Valentieband offset
- XPS:
-
Röntgenfoto-elektronenspectroscopie
Nanomaterialen
- Inleiding tot de Terahertz Band
- MoS2 met gecontroleerde dikte voor elektrokatalytische waterstofevolutie
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- Temperatuurafhankelijke kristallisatie van MoS2-nanovlokken op grafeen-nanobladen voor elektrokatalyse
- Groot lateraal fotovoltaïsch effect in MoS2/GaAs heterojunctie
- Bias-afhankelijke fotoresponsiviteit van meerlaagse MoS2-fototransistoren
- Een onderzoek naar een kristallijn-silicium zonnecel met zwarte siliciumlaag aan de achterkant
- De belangrijkste onderdelen van de lintzaagmachines
- Hoe de zaagsnelheid kiezen?
- De krachtige lintzaag voor het snijden van metaal
- Introductie van de verticale bandzaagmolen



